碳化硅VDMOS的静态和动态辐射损伤及其比较
2022-04-25冯皓楠梁晓雯蒲晓娟崔江维李豫东余学峰
冯皓楠,杨 圣,梁晓雯,张 丹,蒲晓娟,孙 静,魏 莹,崔江维,李豫东,余学峰,*,郭 旗
(1.中国科学院 特殊环境功能材料与器件重点实验室,新疆 乌鲁木齐 830011;2.中国科学院 新疆理化技术研究所,新疆电子信息材料与器件重点实验室,新疆 乌鲁木齐 830011;3.中国科学院大学,北京 100049)
碳化硅功率场效应管(SiC VDMOS)所具有的高功率、低损耗及高频等方面的优异性能,使其在航天、电厂及恶劣环境的应用中发挥着重要作用[1-2]。然而由于空间中的恶劣辐射环境,至少在目前来说其在空间的应用方面还面临着总剂量电离效应(TID)、单粒子效应(SEE)、位移损伤效应等造成的器件电学参数退化、甚至功能失效等问题[3-5]。总剂量电离辐射导致的SiC VDMOS动态特性变化是SiC VDMOS辐射损伤的一个重要问题。SiC VDMOS常被用于高电压、高频率开关应用领域。目前我国输电产生的电能损耗占整个输电量的5%~10%,在日常生活中约有70%的电能需要通过功率半导体进行处理才能使用[6-7],随着功率密度的增加,系统总体中热设计的部分比重将会提升至16%~25%,系统中对于热损耗的控制也变得越来越重要。器件的热积累主要发生在晶体管开启关断的瞬态[8-9],辐射如果导致器件的开关响应延长,就会增加热积累风险。与其他低压器件不同,辐射损伤造成的功率器件开关时间的延长不仅会导致器件频率响应特性变差,还会增加器件短路电流冲击时间及产生较大的能源损耗问题,严重情况下还将造成器件寿命的缩短,甚至功能失效。
虽然目前大量研究表明SiC基MOS器件和栅氧层较厚的Si基MOS器件在静态参数辐射损伤效应方面有很多相似之处,其变化都是由于电离辐照在器件的Si/SiO2或SiC/SiO2界面及SiO2层中诱发产生并积累了氧化物正电荷和界面态,导致了器件转移特性曲线(Ids-Vgs)负漂、阈值电压(Vth)下降、漏电流(IDSS)增大[10-14]。在动态参数的辐射效应方面,总剂量辐射环境中普通Si基MOS器件的开关特性变化也被认为是由Si/SiO2界面及SiO2层中辐射产生的氧化物正电荷和界面态引起,因此与亚阈特性的斜率变化、特别是阈值电压的漂移具有直接的相关性[4,15-16],但冯皓楠等[17]初步研究表明:由于SiC VDMOS的SiC/SiO2界面远比Si/SiO2界面复杂,这将导致其在生产过程中更易产生界面陷阱电荷[18]。同时,作为槽型栅结构的VDMOS其本身相对于普通平面结构的MOSFET会存在着更为复杂的寄生电容结构,这都将可能对器件的动态性能产生一定的影响。因此,辐照导致SiC VDMOS动态参数的退化并不完全取决于其静态参数的改变。在常规开关特性上,国内外已有相关文献针对SiC VDMOS在具体工作环境下对寄生电感和非线性特性的敏感性展开了初步研究[19-21]。文献[16,22]采用总剂量辐射对SiC VDMOS的结构电容的影响进行了研究,但相关研究均未在SiC VDMOS的动态响应的辐射损伤上进行进一步研究。冯皓楠等[17]虽然比较了总剂量辐射环境中的SiC功率器件动态和静态特性,但缺乏更多样本、更多参数及包括退火过程在内的进一步试验验证,尤其缺乏对导致两者差异原因的进一步理论分析。
本文对比研究商用高功率大电流650 V、39 A SiC MOSFETs器件在正、负栅偏和零偏下TID效应对其动态参数的影响。采用动态参数和静态特性相结合的方式进行分析,结合器件常规应力下的退化特征,找到TID效应造成SiC VDMOS动、静态参数退化规律及机制产生差异性的主要因素,为SiC VDMOS动态辐射损伤的研究提供指导。
1 试验器件与方法
试验器件是日本ROHM公司生产的39 A、650 V N型SiC VDMOS(SCT3060ALHRC11)。图1为典型尺寸的沟槽栅VDMOS的三维示意图。试验在中国科学院新疆理化技术研究所进行,辐照源选择60Co,剂量率为50 rad(Si)/s。在常温下以不同偏置(栅源电压Vgs=-5、0、20 V,漏极和源极接地)对样品辐照至100 krad(Si)。

图1 沟槽栅VDMOS的三维结构示意图[23]Fig.1 3D structure diagram of trench-structure VDMOS[23]
采用Keithley 4200A-SCS半导体特性分析系统检测辐照前后亚阈值Ids-Vgs曲线,定义Vth为曲线Ids=10-5A的Vgs。使用BC3193半导体分立器件测试系统依据器件数据表的要求在Vgs=18 V且Ids=13 A时对导通电阻(RDS(ON))进行测试,在Vgs=22 V时对栅源泄漏电流(IGSS)进行测试。使用Agilent DSO-X-2024A示波器依据MIL-STD-750/3472标准,测量器件开关响应参数:开启时间ton、开启延迟时间td(on)、上升时间tr、关断时间toff、关断延迟时间td(off)、下降时间tf。辐照试验和开关响应测试的条件列于表1。

表1 辐照试验和开关响应测试的条件Table 1 Condition for irradiation experiment and switching response test
2 试验结果
在进行总剂量电离试验时,器件的开关响应曲线中栅极驱动电压和漏极输出电压分别通过高压探头被Agilent DSO-X-2024A示波器检测,分别在0、10、30、50、70、100 krad(Si)进行移位测试。图2为正栅Vgs=20 V偏置时SiC VDMOS栅极驱动电压曲线和漏极输出电压曲线随累积总剂量的变化。在累积剂量达到100 krad(Si)时,3种偏置中只有正栅偏置失去了开关特性,因此,图2中100 krad(Si)的曲线并未显示。可看到,辐照后器件的栅极驱动电压分别在0~200 ns和2 600~2 800 ns的米勒平台区出现了延滞,并随着累积剂量的增大变得更加恶劣。与此同时随着累积辐照剂量的增大,关断过程变缓,Ldi/dt变小,导致器件在关断末端的脉冲电压峰值也在降低,其中,L为绕圈的自感系数,di/dt为电流对时间的变化率。

a——驱动电压;b——输出电压图2 SiC VDMOS在正栅偏置下随累积辐照剂量电压曲线变化Fig.2 Voltage curve of SiC VDMOS under positive gate bias change with cumulative irradiation dose

a——开关响应;b——转移特性图3 累积辐照剂量点达到70 krad(Si)时3种偏置下SiC VDMOS电学特性曲线变化Fig.3 When cumulative dose point of irradiation reaches 70 krad(Si),electrical characteristic curves of SiC VDMOS with three biases
对比3种偏置受到总剂量辐照后仍未失去开关特性时的开关响应曲线及转移特性曲线,发现不同栅极偏置对于器件开启响应和转移特性的影响。图3为累积辐照剂量点达到70 krad(Si)时3种偏置下SiC VDMOS开关响应的变化曲线和转移特性的变化曲线。可看出,3种偏置中动态开关的辐射损伤程度对于栅极偏置的依赖性和静态参数中转移特性曲线对于栅极偏置的依赖性极其相似。3种偏置辐照后,正栅偏置下器件的关断响应时间会骤增,负栅偏置其次,零偏最弱。这与器件在不同栅极偏置辐照后的静态参数的退化规律一致。
依据MIL-STD-750/3472标准,测量器件开关响应参数,并在转移特性曲线中提取阈值电压。图4为随累积总剂量的增大3种偏置辐照时器件开启时间和关断时间与阈值变化的对比。随着累积剂量的增大,3种偏置的开启时间(ton)并未发生大幅度的变化,其中变化最剧烈的正栅偏置在累积剂量到达70 krad(Si)时从99 ns的初始标准值降低到66 ns。与ton不同的是,在此偏置和剂量点下关断时间(toff)从140 ns的初始标准值提升到313 ns。
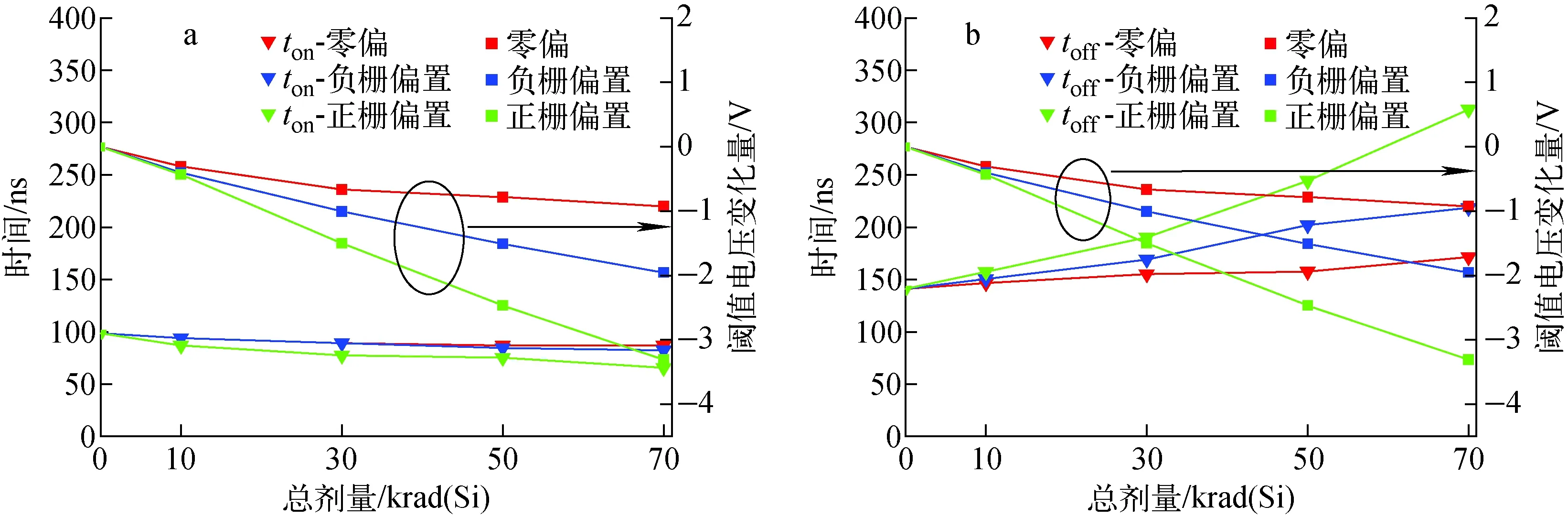
a——开启响应;b——关断响应图4 SiC VDMOS在3种偏置下随累积辐照剂量的阈值变化与响应时间变化对比Fig.4 Comparison of threshold change and response time change of SiC VDMOS with accumulation irradiation dose under three biases
在累积辐照剂量达到100 krad(Si),本文对3种偏置的器件进行常温环境下168 h的退火试验,图5为常温168 h退火后SiC VDMOS 3种偏置的输出电压变化曲线。可看到,正栅偏置器件在经过168 h常温退火后重新具有了一定的开关特性,这是由于栅氧中的氧化物陷阱电荷部分复合导致器件获得了阻断特性。另外两种偏置的开关特性也在168 h退火后得到了部分恢复,均表现为关断时间略微降低。

图5 常温168 h退火后SiC VDMOS3种偏置的输出电压变化曲线Fig.5 Output voltage variation curve of SiC VDMOS with three biases after 168 h annealing at room temperature
3 分析和讨论
为了更好地解释SiC VDMOS动态辐射损伤中的开关特性变化,本文进一步对于器件的导通电阻及栅极泄漏电流进行测试。图6为3种偏置下器件的电学参数随累积辐照剂量的变化。从测试结果来看,随着辐照剂量的积累,器件中栅极氧化物积累带正电荷的氧化物陷阱电荷,这些带正电荷的缺陷会在半导体表面吸引电子,增加表面电子浓度,从而降低器件RDS(ON),RDS(ON)并未出现特殊的变化。与此同时总剂量辐射对于栅氧的泄漏电流也并未产生影响,这和以往的研究结果是一致的。结果表明,在本次试验中总剂量电离辐照并未对器件的栅氧和衬底产生位移类缺陷性质的损伤,由此,本文回到总剂量电离辐射对栅氧产生的陷阱电荷来展开进一步的分析。
在总剂量电离试验中,γ射线在栅极氧化物中产生电子-空穴对,图7为具有正栅偏压的MOS电容器的能带图[10],其展示了辐射诱导电荷产生的主要过程。相关研究表明,在零偏状态下,栅极氧化中的电子和空穴自由复合,因此栅极氧化物中积累的陷阱电荷较少。由于栅极施加电场时会加速栅氧中空穴或电子的偏移,因此正、负栅极偏置下栅极氧化物陷阱电荷会不同程度的加速积累。SiO2中空穴迁移率远低于电子迁移率,在正栅偏辐照时电子漂移速率远大于负栅偏辐照时空穴漂移速率,进而部分空穴被氧空穴俘获形成带正电荷氧化陷阱电荷[10-11]。

a——导通电阻;b——栅极泄漏电流图6 3种偏置下器件的电学参数随累积辐照剂量的变化Fig.6 Variation of electrical parameter of device with accumulation irradiation dose under three biases

图7 具有正栅偏压的MOS电容器的能带图[10]Fig.7 Band diagram of MOS capacitor with positive gate bias[10]
器件栅氧中带正电的陷阱电荷在导致阈值降低的同时,也会对器件的耗尽层产生一定影响。图8为栅氧掺杂密度为1×1012cm-2带正电的陷阱电荷前后器件耗尽层的变化情况。可看出,在栅氧中注入的正电荷等效于在栅极添加额外的正压偏置。对于SiC VDMOS纵向器件,反馈电容Cgd可近似看作JFET的区电容。
(1)
式中:εox为氧化层介电常数;εs为空间电荷区介电常数;Sj为JFET区总面积;tox为栅氧厚度;td为耗尽层厚度。
随着辐照的累积,氧化层的正电荷缺陷变多,耗尽层厚度变薄,在低漏源电压Vds偏置条件下Cgd不断增大,这将导致米勒平台区域的延滞逐步加强。同时,在高Vds偏置条件下,耗尽层厚度不断变大,Cgd趋于饱和[24]。一方面,由于米勒平台区域的延滞,器件在开启和关断过程中对于栅极电容的充电和放电过程将会更为缓慢,器件的开启响应和关断响应随之延长;另一方面,阈值的降低往往会使器件沟道区提前进入反型区,从而更快地使器件提前开启和延迟关断。SiC VDMOS在经过总剂量电离辐照后开关特性中开启和关断响应的退化程度的差异性很有可能是由于上述两种原因的同时作用而导致的。

a——栅氧未掺杂陷阱电荷;b——栅氧掺杂带正电的陷阱电荷[24]图8 器件的耗尽层情况Fig.8 Depletion layer condition of device
4 结论
随60Co γ射线辐照时累积剂量的增加,3种栅极偏置的辐照均会导致器件开启时间略微缩短,关断时间骤增,开关损耗总体增大。同时,正栅偏置下器件退化最为显著,负栅偏置其次,零偏最弱。对于器件开启和关断响应退化程度的差异性是由以下两种原因共同导致的。一方面,由于米勒平台区域的延滞,器件在开启和关断过程中对于栅极电容的充电和放电过程将会更为缓慢,器件的开启响应和关断响应随之延长。另一方面,阈值的降低往往会使器件沟道区提前进入反型区,从而更快的让器件提前开启和延迟关断。进一步深化且细致的研究动态辐射损伤特性对于全面、系统保障SiC功率器件在空间辐射环境中的可靠性具有重大意义。
