ALD法制备二维二硫化钼薄膜的研究现状及展望*
2022-03-28常晓萌李佳保周启航杨培志
常晓萌, 李佳保, 周启航, 杨培志
(云南师范大学 能源与环境科学学院,云南 昆明 650500)
1 引言
2004年,Novoselov等[1]通过机械剥离法成功制备出石墨烯(graphene)并对其电学特性进行了研究,证明了二维材料可在自然界中稳定存在,开启了二维材料的研究序幕.但由于石墨烯没有带隙,在一定程度上制约了其在半导体领域的应用.随后,一些其他的二维材料相继被发现,其中过渡金属硫属化合物(TMDs)引起了人们的关注,由于其弱的范德瓦尔斯相互作用和缺乏表面悬挂键使其易于构建异质结,从而消除了严格的热和晶格匹配的要求.
二硫化钼(MoS2)是典型的TMDs,具有储量丰富、价格低廉和无毒等特点.与晶体材料相比,二维MoS2具有单原子层量级的厚度,且具有优异的光学性能、热电性能及光电性能,在光电器件领域有广阔的应用前景,如光电晶体管[2]、光电探测器[3]、太阳电池[4-6]和场效应晶体管(FETs)[7-8]等.室温下稳定状态时,单层MoS2制备的FETs能耗比传统晶体管小十万倍[9],电流开关比能达到1×108,载流子迁移率[9]为15 cm2V-1s-1.此外,少层的MoS2光电探测器可在最高200 ℃的工作温度及约2 MeV的光照强度下工作[4].
二维MoS2的能带结构能通过其原子层数进行调控,而原子层沉积(ALD)制备薄膜时具有优异的均匀性且能实现对层数的有效控制,因此ALD法在制备层数可控的MoS2薄膜方面有潜在的优势.在制备过程中,所采用的前驱体、衬底、温度和退火等工艺参数对薄膜质量均会产生影响.因此,明确二硫化钼的结构与制备工艺参数间的关系,对于制备可满足器件应用的高品质MoS2薄膜具有指导意义.本文首先对MoS2的结构进行了简要的介绍,然后重点对二维MoS2制备方法进行了阐述,最后对其制备方法进行了总结展望.
2 二硫化钼结构
二硫化钼属于六方晶系,具有两层硫原子夹一层钼原子的三明治层状结构,如图1(a)所示[10].层内由Mo和S原子通过共价键连接,形成稳定的六边形网络结构.层间由范德华力连接,间距约为6.5 Å.由于其层间作用力小,受力时容易发生断裂滑动,与石墨烯的二维结构类似.相较于石墨烯,MoS2具有天然的带隙并可通过原子层数进行调控,使其在光电子及半导体领域具有广阔的应用潜力.
根据堆垛次序及Mo原子的配位,块体MoS2可形成三种形态的晶体结构,如图1(b)所示,分别为六方结构的2H相、斜方六面体结构的3R相和正方结构的1T相,其中2H相与3R相为稳态的三棱柱型半导体,1T相为亚稳态的八面体型金属,3R与1T相均可通过加热或者微波辐射转变为2H相,2H相为MoS2最稳定的一种形态[11-12].2H相的MoS2在结构上是以两层为单位进行周期性排列,层数为奇数时,2H相MoS2处于空间反演对称性破缺状态,层数为偶数时则为中心对称状态.随着层数减少到单层,MoS2带隙会从1.2 eV[13]的间接带隙变成1.9 eV的直接带隙[10],其能带结构如图1(c)所示.

图1 (a)MoS2结构三维示意图[10];(b) MoS2三种形态结构;(c) 块状二硫化钼能带图(左)和单层二硫化钼能带图(右)[14]
3 ALD法制备MoS2薄膜
为满足MoS2薄膜在FET[10,15]、光电探测器[16]和太阳电池[4,17-20]等领域的应用需求,首先需要保证MoS2薄膜的面积和质量,然而目前得到的MoS2薄膜是存在大量晶界的多晶薄膜,晶界的存在会降低载流子迁移率,晶界处存在的缺陷与应力还会影响光电器件的转换效率.因此,如何制备出晶向高度一致的单层MoS2薄膜是半导体器件性能优化的关键问题.
目前,制备MoS2薄膜常见的方法有磁控溅射[21-23]、分子束外延[24]、脉冲激光沉积[25]、化学气相沉积(CVD)[26-27]和原子层沉积(ALD)等.其中,ALD是一种特殊的化学气相沉积法,具有优异的三维共形性、大面积均匀性和原子层数可控性等特点.其原理是通过将气相前驱体交替泵入反应室并在沉积基体表面发生化学反应形成薄膜,其自限制反应能够精确控制薄膜的原子层数并保证薄膜的均匀性,是制备大面积、高质量的MoS2薄膜的重要方法.
3.1 制备原理
ALD的基础在于序列的自终止不可逆的气-固吸附反应,且在反应室清洗或抽空过程中被吸附的前驱体或反应物分子不能从表面解吸.ALD制备MoS2薄膜时首先将Mo-前驱体通入反应室,与衬底表面的-OH发生化学吸附,待反应饱和后,将腔体中剩余的Mo-前驱体以及反应副产物吹出,随后通入S-前驱体,与被吸附的Mo-前驱体继续进行化学反应生成MoS2,最后将腔体中剩余的S-前驱体以及副产物吹出.一个完整的ALD周期由吸附-清洗-吸附-清洗四步组成,共包含两个吸附反应,理想状态下均需为不可逆的化学饱和吸附.
ALD有三种可能的生长模式,分别为二维生长、岛状生长及随机沉积.在理想状态下,ALD应为单原子层生长的二维生长模式,每个周期结束后会在沉积表面形成单原子层的薄膜,化学吸附的覆盖率应等于1,这种生长模式也是决定薄膜均匀性的关键.然而,具体应用中由于配位体的空间位阻效应和沉积表面反应活性位点密度的限制,实际吸附覆盖率明显小于1.当沉积表面反应活性位点不足时,容易引起岛状生长影响薄膜质量.因此,为改进ALD生长速率及薄膜沉积质量,需要对衬底表面进行不同的预处理来提高反应位点的数量,如化学溶液预处理、等离子体预处理、反应离子刻蚀和臭氧预处理等.
显然,衬底及其表面结构、前驱体以及相关工艺条件是影响ALD沉积初期生长模式并决定薄膜质量的关键参数.因此,ALD法制备MoS2薄膜的研究主要集中在两个方面,一是基于MoCl5和H2S前驱体,通过优化工艺参数以改善薄膜质量,主要针对前驱体类型和温度等方面进行优化;二是寻找新的前驱体,进行薄膜的制备研究.
3.2 不同前驱体对MoS2薄膜质量的影响
ALD沉积过程由交替发生的自饱和表面吸附和化学反应组成,因此要求反应前驱体具有挥发性好、反应活性佳、热稳定性好以及对薄膜或衬底无腐蚀作用等特点,此外,要求其副产物易挥发、易处理.由于前驱体对MoS2薄膜质量影响较大,因此寻找合适的前驱体尤为重要.
2014年,Tan等人[28]分别以MoCl5和H2S作为Mo和S的前驱体,并采用蓝宝石作为衬底,在300 ℃下制备得到MoS2薄膜,每个ALD循环(GPC)生长的MoS2薄膜厚度为0.21 nm.一个完整的沉积反应包括两个半反应,分别为(A)Mo-SH*+MoCl5→Mo-S-MoCl4*+HCl和(B)MoCl*+H2S→Mo-SH*+HCl+S,开始时,MoCl5可被衬底表面的-OH吸附,其反应为|-OH*+ MoCl5→ |-O-MoCl4*+ HCl,其中|-表示衬底表面.衬底温度为450 ℃,100个生长周期制备出的MoS2薄膜AFM图像如图2所示,晶粒边缘模糊,得到的MoS2薄膜层数可控但结晶性较差.

图2 MoS2薄膜的AFM图像[31]
H2S和MoCl5是最早也是最常用的ALD法制备MoS2薄膜的前驱体,但同时各种不同的前驱体也被尝试,例如,S、(NH4)2S及CH3S2CH3可作为S前驱体,Mo(CO)6、Mo(thd)3[29]、Mo(NMe2)4及MoF6[30]能够作为Mo前驱体等.
黄亚洲等人[32]总结了不同前驱体对MoS2薄膜结构的影响.金属有机物具有高活性,可作为Mo-前驱体,同时其高活性决定了反应一般需要在较低的温度下进行,导致得到的MoS2薄膜结晶度差,同时低温还可能造成有机污染物残留.值得注意的是,同样是在较低的温度进行MoS2薄膜的制备,采用Mo(CO)6与H2S制备出的薄膜结晶度较低,但将作为S-前驱体的H2S进行等离子处理后,能够显著提高其反应活性,从而使薄膜的结晶度得到显著提高[33].Mo(thd)3与H2S作为前驱体在Si衬底上生长纳米晶体结构MoS2薄膜时,反应温度可达300 ℃[29],是迄今金属有机化合物作为Mo-前驱体时的最高反应温度.除上述材料外,六甲基二硅硫烷(HDMST)用作Mo-前驱体在25 ℃就产生足够的蒸汽压,而MoCl5则需要达到115 ℃才能获得足够的蒸气压,之后在300 ℃下反应沉积并通过S气氛高温(900 ℃)退火处理后,两种前驱体均能够得到结晶性和均匀性良好的薄膜.
3.3 温度对MoS2薄膜质量的影响
3.3.1 沉积温度
ALD法制备MoS2薄膜时,MoS2的成核速率会显著影响其生长模式,因此沉积温度会对薄膜的生长状态产生显著影响,低温下薄膜会进行快速的垂直生长,而随着温度升高,成核速率会降低,缓慢的成核速率有利于横向生长.较高的反应温度能提高反应活性并改善MoS2薄膜的质量,但过高的温度不利于化学吸附,还会导致前驱体和官能团的分解以及MoS2薄膜的再蒸发,进而影响薄膜的质量.因此ALD法制备MoS2薄膜时,需根据前驱体特性对沉积温度进行精确调控.
制备少层乃至单层MoS2薄膜时,为保证薄膜的致密度及均匀性,保证其生长模式为缓慢的横向生长是必要的[34].较高的反应温度对前驱体的稳定性要求较高,因此MoCl5和H2S是高温生长MoS2薄膜比较理想的前驱体.Ahn等人[34]系统研究了沉积温度和MoCl5前驱体温度对MoS2生长的影响.结果表明,当MoCl5前驱体温度固定在100 ℃不变时,随着沉积温度由100 ℃上升到300 ℃, MoS2薄膜的横向生长趋势增强.在沉积温度为420 ℃时形成了以横向为主(2-3层)的生长趋势.Browning等人[35]在不经过退火处理的情况下,首次直接合成了MoS2薄膜.Huang等人[31]探究了反应温度为420~490 ℃时MoS2薄膜的生长情况,结果表明在430~470 ℃区间内,随着温度升高,薄膜结晶度提高(图3(d)-(e)),450 ℃时晶粒尺寸最大(图3(a)-(c)),但当温度超过470 ℃后,可能是过高的温度导致反应产物发生了分解,从而导致薄膜厚度减小,拉曼测试结果中特征峰消失,如图3(f).
若要在较低反应温度下制备MoS2,则可优先考虑具备较好反应活性的有机前驱体.如用Mo(CO)6和H2S为前驱体时[36],反应温度应控制在155~175 ℃.当温度低于155 ℃时,表面反应不完全,而高于175 ℃时,Mo(CO)6会发生热分解形成无序堆积,从而使得膜厚增加.而选用Mo(NMe2)4和Mo(thd)3作为Mo-前驱体时,反应温度应分别控制在60~120 ℃和275~325 ℃[29,37].

图3 MoCl5和H2S作为前驱体时,Si衬底上以(a)420 ℃、(b)450 ℃和(c)480 ℃温度生长100个周期的MoS2薄膜的AFM图像.在不同温度下,在Si衬底(d)和Al2O3衬底(e)上生长了100个周期的MoS2薄膜的拉曼光谱.(f)不同温度下进行100个生长周期得到的MoS2薄膜的厚度[31]
3.3.2 前驱体罐体温度
除了沉积温度,前驱体罐体温度对MoS2的生长也有影响.Huang等人[31]研究了不同前驱体罐体温度下生长的MoS2薄膜的质量.他们通过提高MoCl5罐的温度,使其超过MoCl5的熔点(200 ℃)以获得较高的MoCl5蒸气压.而Ahn等人在MoCl5罐体温度由100 ℃上升到160 ℃的过程中发现,当MoCl5罐体温度为160 ℃时,样品的PL谱在652 nm处出现与直接带隙跃迁有关的PL峰,如图4所示,这可能与单层MoS2薄膜有关.升高罐体温度会加剧自刻蚀效应,引起沉积速率降低.
相较于CVD法,ALD法制备MoS2薄膜时反应温度较低,薄膜均匀但结晶性较差,选用金属卤化物作为Mo-前驱体时可有较高的窗口温度,从而得到结晶度更高的薄膜.

图4 引入Al种子层后薄膜随MoCl5罐体温度变化的PL光谱图[34]
3.4 衬底对MoS2薄膜质量的影响
3.4.1 衬底种类
Si、SiO2和蓝宝石(Al2O3)等是ALD制备MoS2薄膜常用的衬底.SiO2和Al2O3作为氧化物,表面羟基的数目比Si更加丰富,因此更有利于第一个自限制反应的发生[38].此外,Al2O3衬底具有六边形结构和平滑的c平面,可能会与2H型的MoS2有更好的晶格匹配,意味着MoS2薄膜与衬底间会有更小的应力,更有利于晶核形成及薄膜生长.
实验证明,以MoCl5和H2S作为前驱体时,在Si、SiO2和Al2O3衬底上沉积1个周期,三种衬底上生长的MoS2薄膜都会出现一定的S元素缺失,其中Si衬底上薄膜中Mo与S的比率远小于1∶2,而Al2O3衬底上薄膜Mo和S的原子比接近1∶2.反应循环次数由1次增加到10次的拉曼光谱图及TEM结果如图5(a)-(c)所示,由图可见,在循环次数较少时(3个循环内),Al2O3作为衬底制得的薄膜拉曼特征峰A1g更强,结晶性明显优于Si和SiO2衬底.经过退火的Al2O3衬底上沉积的薄膜晶粒呈三角形貌[28],边缘清晰,表明结晶性良好(图6(a)-(b)).随着循环次数继续增加,可看到Al2O3衬底上生长的薄膜较同条件下Si衬底上的更厚(图6(c)-(d)).

图5 在(a)Si、(b)SiO2和(c)Al2O3衬底上,进行1~10次循环得到的MoS2薄膜的拉曼图(插图为相应的△k值及TEM图)[38]

图6 800 ℃下退火处理后蓝宝石衬底上生长的MoS2薄膜的(a)SEM与(b)AFM图[28].(c)不同温度下蓝宝石衬底与Si衬底下生长的MoS2薄膜厚度[31].(d)不同周期下蓝宝石与Si衬底上生长的MoS2薄膜厚度[31]
综上所述,在常用的三种衬底中,Al2O3表面具有更多的羟基数、且与MoS2薄膜的晶格更匹配,更适合作为ALD法沉积MoS2薄膜的衬底材料.
3.4.2 衬底预处理
为了实现在保证MoS2质量的同时提高沉积速率,可通过衬底预处理来提高衬底表面活性位点数量.衬底表面充足的活性位点可提高首次循环时前驱体的吸附率,进而实现MoS2薄膜在二维生长模式下的均匀成膜.因此,对于单层或少层MoS2薄膜的生长,衬底的预处理至关重要.
首次循环时前一个半反应一般是通过与衬底表面的分离羟基反应吸附的,酸洗和等离子处理等方法都可以提高衬底表面的羟基密度,也可以在衬底表面覆盖富含羟基的种子层以提高表面羟基的密度[32].

图7 (a)DFT计算的MoCl5吸附在SiO2(中间)和Al(右边)表面时相对于自由态(左边)的相对总能量[34].(b)引入Al种子层后薄膜随MoCl5罐温度变化的PL谱[34].未引入Al种子层(c)及引入Al种子层(d)薄膜随MoCl5罐温度变化的拉曼光谱[34]
除了提高衬底表面羟基的密度外,还可在衬底表面引入一层超薄(约5 nm)的Al种子层以促进早期MoCl5在衬底表面的吸附[34].DFT基能量计算证实了MoCl5在Al上的吸附比在SiO2上更容易,如图7(a)所示,引入Al种子层后薄膜结晶度提高并实现了单一横向生长模式,制备过程中薄膜层数及其可控性显著提高.
衬底预处理前后的微观表面结构也直接影响MoS2薄膜的生长.图8(a)[39]为在刻蚀及无刻蚀的Si/SiO2衬底上生长的MoS2薄膜的拉曼光谱.由图可知,经刻蚀后Si/SiO2衬底上所得的MoS2薄膜的结晶度明显提高.这可能是由于刻蚀残留的光刻胶能够作为额外的成核位点,增强了MoS2薄膜在SiO2未刻蚀区域的生长.张艳峰课题组发展了基于多晶Au箔的制备体系,在多晶Au箔上实现了尺寸可调的单层MoS2薄膜的制备[40].随后,他们通过熔融-固化法将多晶Au箔转化为Au(111)薄膜,并以此作为衬底,获得了晶圆级单晶单层MoS2薄膜.与多晶Au箔不同的是,Au(111)表面的台阶对MoS2晶畴生长有诱导作用,从而使MoS2沿着<110>台阶边缘成核并能够单一取向的生长[41](如图8(c)).2021年,Liu等人[42]通过对蓝宝石衬底表面进行一个小角度切割,形成小台阶,打破a平面蓝宝石的C2对称性,诱导WS2进行岛的单向对齐(图8(b)),实现了单晶单层薄膜的外延生长.这种双耦合机制也应适用于在绝缘衬底上生长其他单晶TMD材料,包括MoS2和WSe2等.

图8 (a) 375 ℃下在SiO2/Si晶圆基底微信的蚀刻和非蚀刻区域上沉积的ALD MoS2薄膜的拉曼图[39]. (b)WS2单晶高分辨力原子力显微镜(AFM)图像[42]. (c)Au(111)诱导MoS2单一取向生长示意图[41]
3.5 退火处理对MoS2薄膜质量的影响
二维晶圆级MoS2薄膜的电子特性与单晶比还有很大差距,为使二维MoS2薄膜的电子特性接近理论值,还需探索在晶圆尺度上获得单晶结构的新途径.通常,用ALD法制备MoS2薄膜时一般不会采用很高的反应温度,但这会影响到薄膜的结晶度.为解决这一关键问题,需要对薄膜进行退火处理.
Ahn等人[34]通过引入超薄Al种子层的方法,制备了结晶性良好的单层-双层MoS2薄膜,组装成结构为图9(a)所示的场效应晶体管,该器件并没有表现出满意的晶体管性能.但经过后续的退火处理,器件性能得到了显著改善,如图9(b)所示.
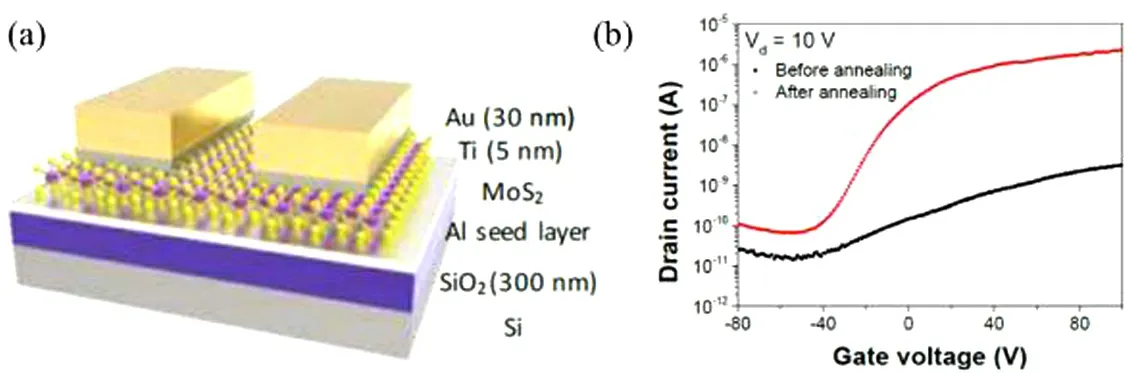
图9 (a)场效应晶体管结构示意图.(b)退火前后晶体管电学性能对比[34]
覆盖层退火工艺(CLAP)也可用于改善薄膜质量[43],能够在避免MoS2呈织构化的同时消除缺陷,以此获得高质量单晶二维MoS2薄膜.实验表明,单晶薄膜制备的场效应晶体管的电子迁移率是织构型的15倍,呈现出良好的应用前景.
4 总结与展望
二维MoS2薄膜在半导体领域具有广阔的应用前景,未来也将作为构建垂直结构晶体管和包括太阳电池在内的各类光电器件的重要材料,而实现其应用的关键在于对其高质量且可控的制备.ALD是一种制备MoS2薄膜的重要方法,但迄今还未实现晶圆级单晶MoS2薄膜的生长,从前驱体、沉积工艺参数到退火及衬底预处理等均存在大量亟待解决的问题:(1)合适的有机前驱体的探索;(2)对衬底表面进行不同的预处理,以提升晶格匹配及减小应力,诱导晶畴实现取向生长;(3)不同退火工艺如微波加热退火和快速光热退火等对MoS2薄膜的结晶性能和微结构的影响.
目前,硅基微纳器件已基本达到理论极限,新型半导体材料的研究迫在眉睫,而层状MoS2的天然半导体优势有望能够满足这一需求,ALD对制备大面积高质量MoS2薄膜十分有利,随着制备技术的不断发展和完善,MoS2薄膜的质量将得到不断提升,其应用也将不断扩展.
