化学气相沉积法在金属衬底上制备石墨烯及其H2刻蚀的研究进展
2021-09-29王宇薇
王宇薇,王 彬
(1.锦州师范高等专科学校 环境科学学院,辽宁 锦州121000;2.渤海大学 化学与材料工程学院,辽宁 锦州121013)
0 引言
石墨烯是一种性质独特的碳的同素异形体,在石墨烯的晶体结构中,碳原子以六元环形式周期性排列形成蜂窝状结构.Wallace是最早提出石墨烯概念的科学家,他提出在一定的条件下能够获得碳的二维结构[1].然而,实验上首次得到稳定的石墨烯材料是在2004年,由英国的科学家A.K.Geim和K.S.Novoselov利用胶带法获得的[2].石墨烯具有超高的电子迁移率[3]、高机械强度[4]、优异的导热性[5]和大的比表面积[6]等优点,被冠名以“神奇材料”.由于这些优异的性质,石墨烯在微电子器件[7-8]、热传导器件[9],储能材料[10]等领域具有非常广阔的应用前景.
由于制备大面积无缺陷高质量石墨烯的工艺限制,石墨烯的许多应用还仅仅停留在实验阶段.通过机械剥离法能够获得几乎没有缺陷的高质量单层石墨烯.机械剥离法操作比较简单,但是利用这种方法得到的石墨烯的面积非常小,难以应用.因此,研究人员探索了许多其他制备石墨烯的方法,例如过渡金属表面析出法[11]、碳纳米管解理法[12]以及化学气相沉积(CVD)法[13-16]等,在这些制备方法中,CVD法是制备石墨烯最有效的方法,利用这种方法制备的石墨烯具有大面积、均匀、质量较高等特点.
本文概括性地回顾了利用CVD法在金属衬底上制备高质量石墨烯薄膜的研究进展,以及所制备的石墨烯的刻蚀现象.
1 CVD法在金属衬底上制备石墨烯
1.1 制备机理
利用CVD法在金属衬底上制备石墨烯一般认为有两种机制,分别为溶解析出机制和表面吸附机制.溶解析出机制主要以Ni、Mo等对碳的溶解度较大的金属为代表.于庆凯团队[17]通过改变降温速率,提出了石墨烯在Ni箔上的生长机理,如图1(a)所示.由于Ni金属的催化作用,甲烷在高温下发生脱氢反应,能够分解出大量的碳原子,并且溶入到Ni金属中.在降温过程中,碳在Ni金属中的溶解度降低,于是在Ni金属表面析出大量的碳原子,进而形成石墨烯.图1(b)为他们在不同降温速率下获得的石墨烯的拉曼光谱.

图1 (a)Ni箔上碳的溶解析出机制原理图;(b)不同降温速率下石墨烯的拉曼光谱图
由于石墨烯在Ni上的生长是碳的溶解和析出过程,这个过程与降温速率有着密切的关系,因此,降温速率对石墨烯的厚度和质量具有重要的影响,一般的降温速率会导致大量碳原子的析出并形成较厚的石墨烯薄膜.除了降温速率,Ni金属的厚度对石墨烯的形态也有重要的影响.总的来说,在Ni衬底上制备的石墨烯薄膜一般含有单层到多层的结构,薄膜不均匀,质量较差.
表面吸附机制主要以Cu、Pt等对碳的溶解度较小的金属为代表.李雪松团队利用碳同位素标定技术进行石墨烯制备,进一步证明了石墨烯生长在Ni箔上为溶解析出机制,并且提出了石墨烯在Cu上的生长机制[18],如图2所示.在制备石墨烯的过程中,交换通入12CH4和13CH4.对所制备的石墨烯进行拉曼测试,他们发现12C和13C在Ni箔上制备的石墨烯中是随机分布的,这与石墨烯在Ni箔上的生长机制有关.而在Cu箔上制备的石墨烯中是按照通入顺序呈扩散状分布的,这是因为Cu金属对碳有很低的溶解度,即使在高温条件下,也只有很少的碳溶入到Cu金属内部,大多数的碳原子吸附在Cu箔表面,扩散成核形成石墨烯.

图2 不同生长机制下碳同位素的分布
由于石墨烯在Cu上的生长是碳的表面吸附和扩散过程,因此,Cu衬底的厚度以及降温速率对石墨烯质量的影响很小.但是,Cu衬底的表面形态、生长时CH4的分压等参数对制备的石墨烯的质量具有重要的影响.在制备过程中可以通过对Cu衬底进行高温H2气氛退火以提高Cu晶粒的尺寸,优化CH4流量等手段提高石墨烯薄膜的质量.
1.2 CVD法在金属衬底上制备石墨烯的研究进展
目前,以Cu、Ni、Ru、Mo、Pt和Au等过渡金属为衬底,已经实现了石墨烯的CVD法制备,其中以Cu作为衬底制备石墨烯具有很多优点,例如,在Cu衬底上制备石墨烯,能够很好的控制晶畴尺寸,并且石墨烯薄膜厚度均匀,缺陷密度较小等.如图3所示,为李雪松团队利用两步合成法制备石墨烯薄膜的扫描电子显微镜(SEM)图像[19].他们通过优化生长温度、CH4流速和CH4分压,降低了石墨烯晶畴的成核密度,同时提高了石墨烯晶畴的尺寸,最后进一步增大CH4流量,将大尺寸的花形石墨烯晶畴连成石墨烯薄膜.将所制备的石墨烯薄膜应用到场效应晶体管(FETs)中测得所制备的石墨烯薄膜载流子迁移率高达16 000 cm2/V·s.

图3 不同条件下制备的石墨烯晶畴的SEM图像,图中标尺为10 μm
王彬等[20]进一步优化了两步法来制备石墨烯薄膜,如图4所示.他们通过优化生长参数得到尺寸大于200 μm的六边形石墨烯晶畴,进而通过填隙法制备石墨烯薄膜.由于组成石墨烯薄膜的晶畴尺寸较大,所以薄膜具有较低的晶界密度;对石墨烯表面随机取点进行拉曼测试,得到的I2D/IG值~2,证明了制备的石墨烯为均匀的单层石墨烯薄膜.

图4 (a)和(b)石墨烯晶畴尺寸随制备时间增加而增大的光学显微镜图像;(c)没有完全成膜的石墨烯的光学显微镜图像;(d)石墨烯Raman光谱的I2D/IG值;(e)填隙法流程示意图
谢晓明团队[21]利用Cu-Ni合金作为衬底,通过对合金衬底进行局部供C,制备出毫米级的石墨烯晶畴,如图5所示.他们以不同含量比的Cu-Ni合金作为衬底,同时改变生长温度制备石墨烯晶畴.发现当Ni原子含量为15%,生长温度为1100℃时,石墨烯晶畴的生长速率最快.通过透射电子显微镜(TEM)和拉曼光谱测试证明了所制备的晶畴为单晶单层石墨烯晶畴.

图5 (a),(c)和(d)Cu85Ni15表面制备大尺寸单晶石墨烯晶畴示意图;(b)不同温度下石墨烯晶畴生长速率
近些年,研究人员在石墨烯的制备方面取得了重大进展,石墨烯晶畴的尺寸由纳米级增加到毫米级,大大降低了金属衬底上石墨烯薄膜的晶界密度,提高了石墨烯的电学质量.但是仍有一些重要而有趣的挑战.首先,对于石墨烯在微电子领域的应用而言,可控合成大尺寸单晶石墨烯非常重要.例如,能否实现厘米甚至是晶圆级尺寸的单晶石墨烯的制备,对于提高石墨烯基电子器件的性能具有重要意义.其次,控制石墨烯的层数和叠加顺序也非常重要,因为双层和三层石墨烯可能具有与单层石墨烯不同的功能和性质.
在石墨烯的制备方面,未来主要的发展方向为直接在绝缘衬底上(例如Al2O3、Si/SiO2等)制备大尺寸单晶石墨烯,这样既可以避免转移石墨烯的过程中对石墨烯造成破坏,又可以直接在绝缘衬底上对石墨烯进行功能化,实现石墨烯的原位应用.
2 CVD法制备的石墨烯的刻蚀现象
CVD石墨烯薄膜由于本身为多晶结构,因此晶界密度较大,这对其电学质量造成了极大的影响.另外,由于石墨烯和金属衬底的热膨胀系数存在较大差异,在降温过程中,石墨烯表面会产生大量的褶皱,褶皱会对石墨烯中电子的迁移造成不良影响,导致石墨烯电学质量的降低.因此,研究褶皱和晶界的形态与分布对提高石墨烯的电学质量具有重要意义.
2.1 石墨烯晶畴表面褶皱和边界的刻蚀研究
于广辉团队[22]对Cu衬底上的CVD石墨烯晶畴进行高温H2刻蚀,对刻蚀后的石墨烯晶畴进行SEM测试,如图6所示.刻蚀后的晶畴表面产生了大量的刻蚀条纹,这些刻蚀条纹被证明是石墨烯晶畴表面的褶皱发生H2刻蚀产生的,并且通过电子背散射衍射(EBSD)证明了褶皱与Cu衬底的晶向有关,不同的Cu衬底晶向,可以影响褶皱的形态和密度.他们还利用高分辨扫描电子显微镜(HRSEM)分析了晶畴表面的褶皱发生H2刻蚀的过程.
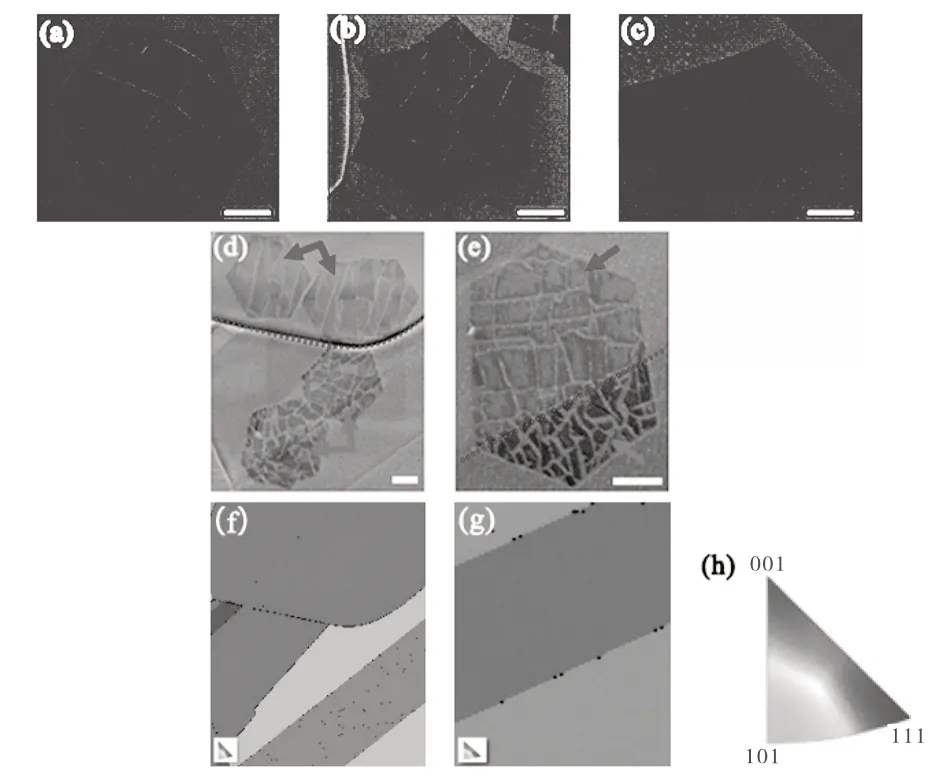
图6 (a-c)不同形状石墨烯晶畴表面刻蚀条纹的SEM图像;(d-g)不同晶向Cu晶面上刻蚀条纹形态不同及相应的Cu晶面的EBSD图像,图中标尺为20 μm
王彬等[23]同样对石墨烯晶畴进行H2刻蚀,研究了石墨烯晶畴边界在降温过程中的形态变化,如图7所示.他们通过改变刻蚀温度发现只有在较高温度(1000℃)时,石墨烯晶畴的边界才发生刻蚀,而在较低温度下只有晶畴表面的褶皱和点缺陷发生刻蚀.对所制备的石墨烯晶畴进行原子力显微镜(AFM)测试,经过分析揭示了石墨烯晶畴边缘刻蚀的机理.

图7 (a)和(c)石墨烯晶畴的生长、表面褶皱和晶畴边界刻蚀的过程示意图;(b),(d)和(e)刻蚀后石墨烯晶畴的SEM图像,图中标尺为20 μm
通过研究石墨烯晶畴的H2刻蚀现象,证明了即使在较大的石墨烯晶畴表面,仍然存在影响石墨烯质量的褶皱结构和大量的点缺陷,并且褶皱和点缺陷的形态和密度分布可以间接地通过对石墨烯进行H2刻蚀观察到.同时,石墨烯晶畴边缘的H2刻蚀现象证实了石墨烯在生长过程中边缘形态的变化,即在生长过程中,石墨烯晶畴的边缘会向着Cu衬底弯曲,在降温时,Cu衬底收缩,石墨烯膨胀,导致石墨烯晶畴边缘陷入到Cu衬底中.通过对石墨烯H2刻蚀的研究,使研究人员对石墨烯在金属衬底上的生长过程和生长机理有了进一步的了解,这对提高利用CVD法在金属衬底上制备的石墨烯的质量有着非常重要的意义.
2.2 石墨烯刻蚀的应用
大规模的石墨烯电子器件需要较窄的石墨烯纳米带(GNR)的光刻图形来实现器件集成.但是,由于光刻分辨率的限制,传统的光刻只能绘制约20 nm宽的GNR阵列,而对于室温下高开关比的FETs来说,低于5 nm宽的GNRs才是最理想的材料.戴宏杰团队[24]研究了一种从石墨烯边缘对其进行气相刻蚀的方法,而不会对石墨烯基面造成破坏.该方法是在NH3存在的微还原环境中,通过对石墨烯进行高温氧化实现的,NH3的存在可以提供可控制的蚀刻速率.他们通过该方法得到了20 nm~30 nm宽的GNRs阵列,并且第一次制备了开关比达到~104的FETs,如图8所示.

图8 (a)和(d)利用刻蚀得到的GNRs的AFM图像;(b),(c),(e)和(f)利用GNRs制备的FETs的相关性能测试
Woong Sun Lim团队[25]利用氧原子层刻蚀技术对较厚的石墨烯薄膜进行刻蚀,降低了石墨烯薄膜的厚度,将石墨烯薄膜的透光率提高了2.3%.利用这种技术,他们成功地降低了组成FETs的源、漏极的石墨烯层数,并对其性能进行了测试,如图9所示.他们首先对较厚的石墨烯薄膜进行氧吸附处理,使上层石墨烯从sp2杂化转变成C-O的sp3杂化,然后对其进行Ar气刻蚀,刻蚀掉最上面一层石墨烯,以达到减薄石墨烯的目的.

图9 (a-d)利用原子层刻蚀技术刻蚀石墨烯的流程示意图;(e)全石墨烯FETs的制备过程示意图;(f)全石墨烯FETs电学性能测试
利用氧原子层刻蚀技术可以对多层石墨烯进行层层刻蚀,降低石墨烯薄膜的厚度,这种方法相比于利用氧等离子体直接对石墨烯进行刻蚀[26]具有刻蚀效果更佳明显,产生的缺陷较少等优点,并且提供了一种制备全石墨烯FETs的有效途径.另外,通过刻蚀还可以增加石墨烯的带隙宽度,进而提高石墨烯基电子器件的开关比[27].
总之,对石墨烯进行刻蚀改性的研究还处于起步阶段,具有巨大的研究前景.未来主要的研究方向为如何通过刻蚀实现对石墨烯带隙宽度的可控调节以及将刻蚀的石墨烯纳米带同其他材料进行结合,实现高性能、多功能化的同质或异质结结构[28],满足微电子领域发展的要求.
3 结论
本文讨论了利用CVD法在Ni和Cu衬底上制备石墨烯的制备机理,并阐述了以Cu为衬底制备石墨烯的研究现状.随着制备技术的不断优化,制备的石墨烯的质量也不断提高.如果能够实现石墨烯的尺寸和层数的可控制备,对于石墨烯在微电子器件领域的应用有着重要的意义.另外,对石墨烯刻蚀现象的研究能够帮助我们理解石墨烯的生长机理,同时,利用石墨烯的刻蚀技术对石墨烯进行改性以满足微电子器件的需要也是一个技术性的挑战.随着对石墨烯生长机理的不断深入理解,石墨烯的可控生长技术和刻蚀技术不断成熟,石墨烯在微电子科学和纳米技术领域的应用将获得更多的突破.
