Mg2Si/Si雪崩光电二极管的设计与模拟*
2021-06-01王傲霜肖清泉陈豪何安娜秦铭哲谢泉
王傲霜 肖清泉 陈豪 何安娜 秦铭哲 谢泉
(贵州大学大数据与信息工程学院, 新型光电子材料与技术研究所, 贵阳 550025)
Mg2Si作为一种天然丰富的环保材料, 在近红外波段吸收系数高, 应用于光电二极管中对替代市面上普遍使用的含有毒元素的红外探测器具有重要意义.采用Silvaco软件中Atlas模块构建出以Mg2Si为吸收层的吸收层、电荷层和倍增层分离结构Mg2Si/Si雪崩光电二极管, 研究了电荷层和倍增层的厚度以及掺杂浓度对雪崩光电二极管的内部电场分布、穿通电压、击穿电压、C-V特性和瞬态响应的影响, 分析了偏置电压对IV特性和光谱响应的影响, 得到了雪崩光电二极管初步优化后的穿通电压、击穿电压、暗电流密度、增益系数(Mn)和雪崩效应后对器件电流的放大倍数(M).当入射光波长为1.31 µm, 光功率为0.01 W/cm2时, 光电二极管的穿通电压为17.5 V, 击穿电压为50 V, 在外加偏压为47.5 V (0.95倍击穿电压)下, 器件的光谱响应在波长为1.1 µm处取得峰值25 A/W, 暗电流密度约为3.6 × 10–5 A/cm2, Mn为19.6, 且Mn在器件击穿时有最大值为102, M为75.4.根据模拟计算结果, 优化了器件结构参数, 为高性能的器件结构设计和实验制备提供理论指导.
1 引 言
市面上的红外光电探测器普遍使用了铟镓砷(InGaAs)[1]、碲镉汞(HgCdTe)[2,3]材料, 这些原材料具有吸收系数高、带隙可调、增益系数高和电子迁移率高等优点[3,4], 但其含量在地壳中不多, 并且均含有重金属元素, 将其大量应用于红外光电探测器将会出现原材料匮乏, 且对环境造成的污染也不容忽视[5,6], 因此寻找其他合适的材料制备红外器件已成为解决上述问题的关键[7].
Mg2Si是红外光电探测器最理想的原材料之一, 具有天然丰富、环境友好、载流子迁移率高、在近红外波段光吸收系数高[8,9]、与Si的晶格失配小(< 5%)[10,11]、与成熟的Si工艺兼容[12]、与n型Si有良好的欧姆接触[13]、高纯的单晶Mg2Si是n型半导体[10]而掺杂银或铜后能成为p型半导体[14]等优点.但目前对Mg2Si用于光电子器件的文献报导不多, 大多数研究组都是对其基本性质进行研究.Udono等[15]和El-Amir等[16]先后通过热扩散制作了Mg2Si光电二极管, 表明其具有良好的整流特性, 在波长为0.95—1.8 µm范围内有良好的光谱响应, 在零偏压下, 波长为1.4 µm处光谱响应达到峰值为0.014 A/W, 展示了其作为红外光电探测器的应用前景, 对替代市面上含有毒元素的红外光电探测器具有重要研究意义.
为了开发基于Mg2Si薄膜的红外探测器, 此前我们研究组已经围绕Mg2Si/Si异质结光电二极管设计了pn型和pin型的器件模型[17], 所模拟的pin型器件要优于pn型器件, 光谱响应峰值为0.742 A/W, 但暗电流密度略大, 约为1×10–6A/cm2.而研究发现雪崩光电二极管(APD)具有高增益、宽带宽、响应快等[18,19]诸多优点, Nishida等[20]将吸收层和倍增层分离而提出的吸收层、电荷层和倍增层分离(SACM)结构成为当前APD普遍所采用的结构.因此本文考虑到Mg2Si/Si异质生长的晶格失配度, 在保证Mg2Si/Si异质结能良好生长的前提下, 采用Silvaco软件中Atlas模块构建出以Mg2Si为吸收层的Mg2Si/Si SACM-APD, 为高性能的器件制备提供指导, 降低器件研制经费, 提高器件性能, 使高性能Mg2Si红外探测器件的制备成为可能, 从而解决红外探测器原材料匮乏及不环保的问题.
2 SACM-APD的结构设计
理论模型采用Silvaco中的Atlas模块对Mg2Si/Si异质结SACM-APD的结构进行设计.Nishida等[20]将吸收层和倍增层分离而提出的SACM型结构成为当前APD普遍所采用的结构,此结构可以通过调节电荷层的结构参数来调节器件内部场强.本文设计的SACM-APD如图1所示, 器件衬底采用重掺杂n型Si, 衬底上生长一层n型Si作为缓冲层, 接着是弱p型掺杂的Si作为倍增层, 较高掺杂的p型Si电荷层位于倍增层与Mg2Si吸收层之间, 以调节器件内部电场分布, 最后采用较薄且掺杂浓度高的p型Mg2Si薄膜作为接触层.为形成欧姆接触, n型Si衬底通常需要高的掺杂浓度[12].
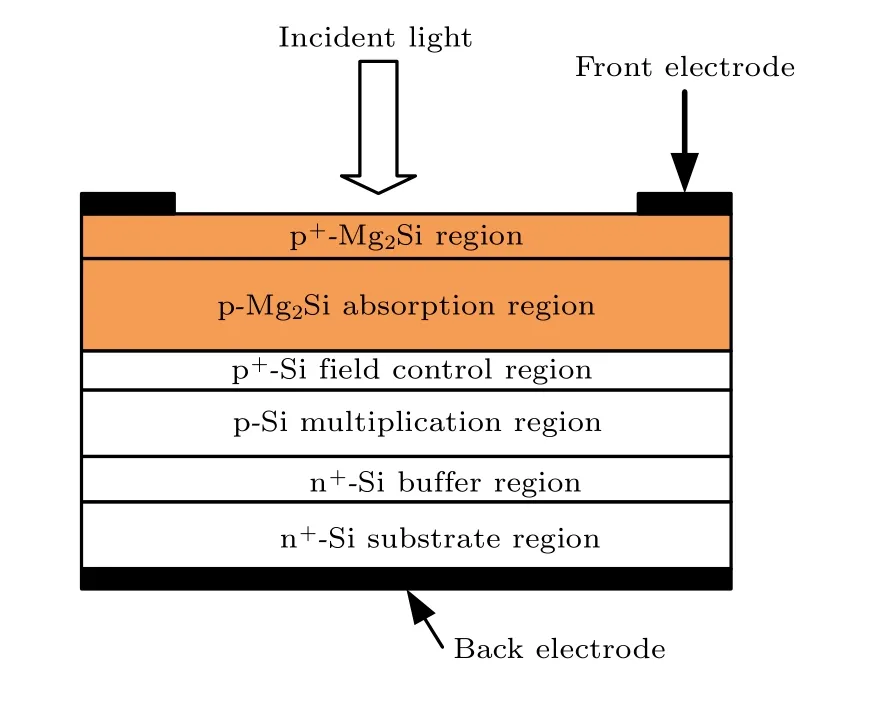
图1 SACM-APD结构示意图Fig.1.Schematic diagram of SACM-APD.
图2 为Mg2Si/Si SACM-APD的能带结构示意图, 图中建立一维的坐标系, p-Mg2Si接触层顶位置设为坐标原点,Wp,Wa,Wc,Wm,Wb与Ws分别为器件接触层、吸收层、电荷层、倍增层、缓冲层和衬底的厚度, 参数见表1.

图2 APD的能带结构图Fig.2.Energy band structure diagram of the APD.
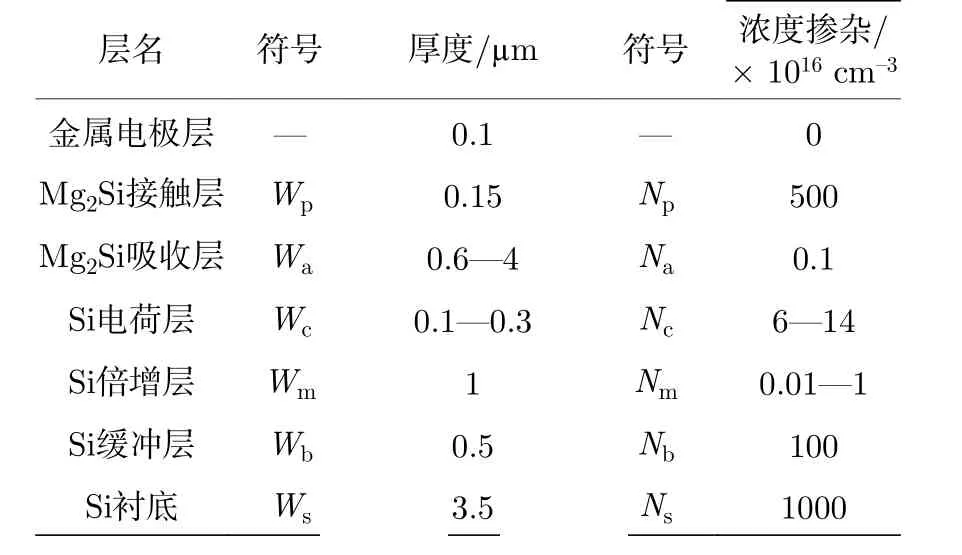
表1 APD的结构参数Table 1.Structural parameters of the APD.
物理模型中的材料参数均来自最近的文献[9,15, 21, 22]与本研究组的测试结果, 表2为Mg2Si与c-Si的一些基础的材料参数.
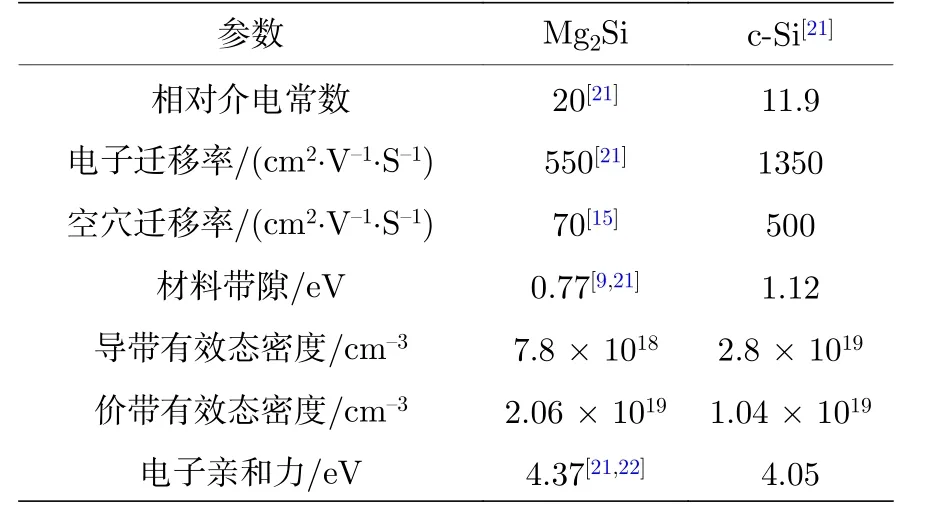
表2 模拟计算中采用的各层基本参数Table 2.The parameters of different layers in the simulation.
对于光电器件的模拟, 为了使仿真结果更接近实际, 材料表面折射率情况被考虑到, 吸收系数是光电器件模拟中重要的参数, 对光生载流子的产生率以及光生电流起着主导的作用, 文中Mg2Si[9]与c-Si[23]中的吸收系数与折射率均来自于近期文献中实验测量到的, 如图3所示.
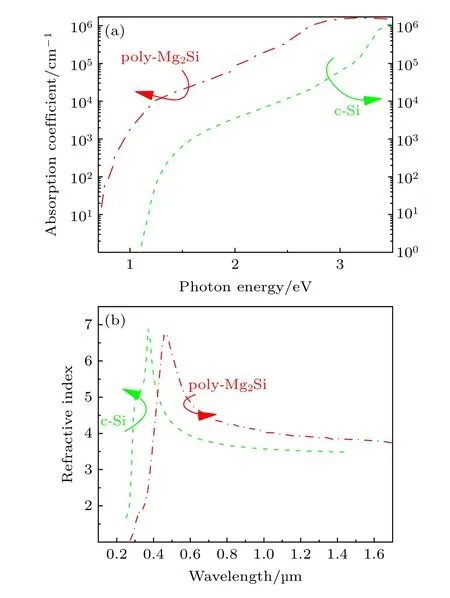
图3 Mg2Si与c-Si的光学特性 (a) Mg2Si与c-Si的吸收系数(cm–1)与入射能量的关系; (b) Mg2Si与c-Si的折射率与波长的关系Fig.3.Optical properties of Mg2Si and c-Si: (a) Absorption coefficient(cm–1) of the poly-Mg2Si and c-Si; (b) refractive Index of the poly-Mg2Si and c-Si.
3 Mg2Si/Si SACM-APD的 性 能 仿真与分析
3.1 内部电场与载流子分布
图4(a)给出了Mg2Si/Si SACM-APD在电荷层厚度为0.1 µm时随外加电压升高的内部电场分布图.由图4(a)可知, 当电荷层太薄时, 对器件的倍增层与吸收层的场强分布调控能力不足, 倍增层电场将会延伸至吸收层中, 即无法使倍增层与吸收层完全分离开来, 会使雪崩倍增效应在吸收层中加剧, 器件的隧穿电流增大, 影响器件性能.如图4(b)所示, 当电荷层厚度增加为0.2 µm时, 吸收层与倍增层分离开来, 使雪崩效应主要在倍增层中产生, 光生载流子的产生则几乎在吸收层中, 这种情况下将能显著地降低器件的暗电流, 因此电荷层厚度设置不应太薄.
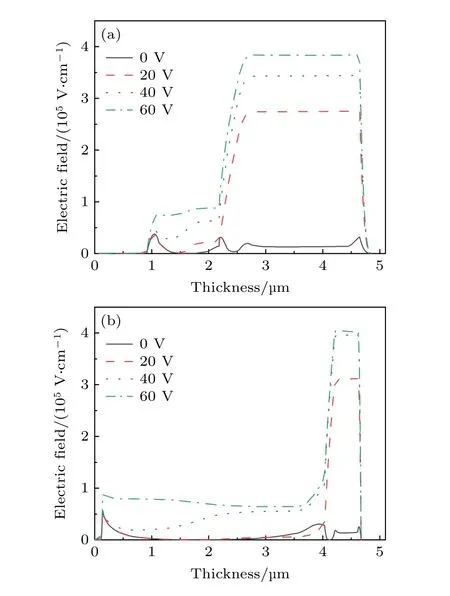
图4 (a) 电荷层厚度为0.1 µm时器件的电场分布; (b) 电荷层厚度为0.2 µm时器件的电场分布Fig.4.(a) Electric field distribution of the device with charge layer thickness of 0.1 µm; (b) electric field distribution of the device with charge layer thickness of 0.2 µm.
图5 揭示了不同外加偏压下的器件内部的载流子生成率, 由图5可知, 在偏压小于20 V时, 器件内部载流子生成率几乎只发生在倍增层中, 对应的此时暗电流增加较为平稳.但当偏压为40 V时,倍增层中的载流子生成率上升了两个数量级, 部分耗尽区中也存在载流子生成, 此时器件处于穿通状态.当偏压增大至60 V时, 倍增层中载流子生成率达到1026cm3·s数量级, 电流快速增加, 器件已处于雪崩击穿状态.
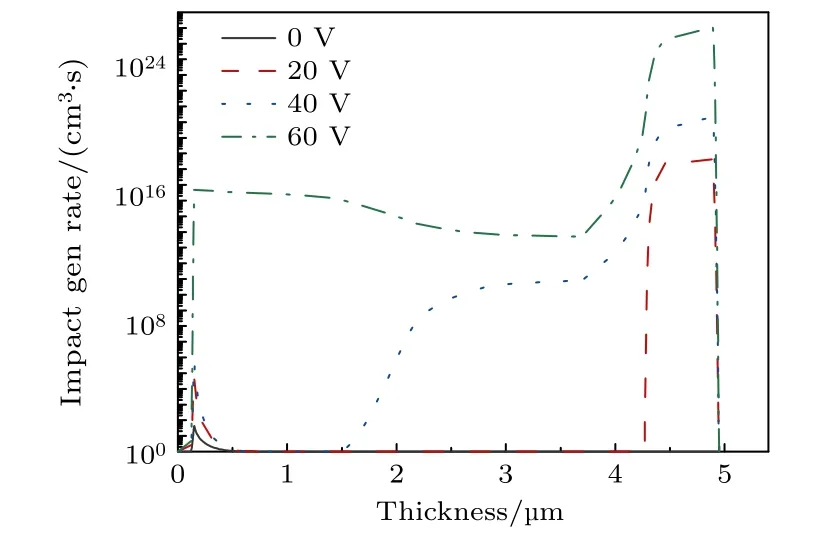
图5 Mg2Si/Si SACM-APD器件在不同偏压下内部的载流子生成率Fig.5.The influence of the different Bias voltage on the carrier generation rate.
图6为在外加偏压为40 V时, 倍增层不同掺杂浓度下倍增层的电场分布关系, 在掺杂浓度为1 × 1014cm–3, 其内部电场分布均匀, 当掺杂浓度继续增加至1 × 1015cm–3时, 整体的电场强度增加有限, 其分布呈现出较小程度的倾斜, 继续增高掺杂浓度, 倍增层整体电场强度上升很快, 且不均匀程度加剧, 此时会导致器件产生较大的暗电流,降低器件的增益系数.所以在器件制备中, 为保证倍增区的电场相对稳定, 倍增层的掺杂浓度一般不宜超过1 × 1015cm–3.另一方面接触层采用重掺杂方式, 可提高内部整体电场, 使得吸收层电场起伏变小.
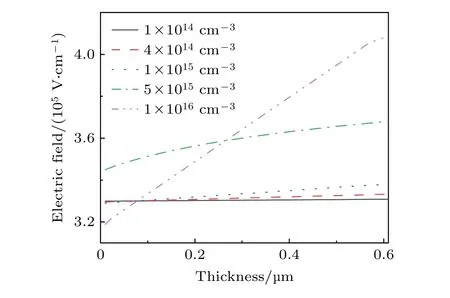
图6 倍增层不同掺杂浓度时倍增层的电场分布Fig.6.Electric field distribution of the multiplier layer under different doping concentrations.
3.2 穿通电压与击穿电压
穿通电压[20]和击穿电压均会受到APD结构参数的影响, 如各层掺杂浓度、厚度等.在模拟中,设置这些参数为变量以获得穿通电压和击穿电压的变化趋势, 对后续工艺设计具有至关重要的作用.
如图7所示, 图中上半部分呈下降趋势的四条曲线Vb为不同电荷层厚度的击穿电压, 下半部分呈上升趋势的四条曲线Vp为不同电荷层厚度下的穿通电压.若电荷层厚度一定时, 当其掺杂浓度升高, 穿通电压呈线性上升趋势, 而击穿电压呈线性下降趋势, 且下降趋势较为明显.当电荷层厚度为0.1 µm时, 穿通电压随掺杂浓度的变化趋势为1.2 V/2 × 1016cm–3, 击穿电压随掺杂浓度的变化趋势4 V/2 × 1016cm–3, 击穿电压和穿通电压之差 ∆ (Vb−Vp) 随掺杂浓度升高而降低, 在掺杂浓度为6 × 1016cm–3时, 有最大值64 V.当厚度增加至0.25 µm时, 穿通电压随掺杂浓度的变化趋势为2 V/2 × 1016cm–3, 击穿电压随掺杂浓度的变化趋势15 V/2 × 1016cm–3, 在掺杂浓度为6 ×1016cm–3时, ∆ (Vb−Vp) 有最大值37 V.在设计雪崩光电二极管的结构参数时, 如果电荷层厚度设计的较薄且掺杂浓度较低, 在小偏压情况下, 器件中的吸收层会产生耗尽, 器件提前处于穿通状态.同时电荷层对器件中倍增层的电场调控作用力度较弱, 需要外加极大的偏压才能使倍增层中形成足够大的电场产生雪崩倍增效应, 这都极大地影响器件的性能.若选用较厚且高掺杂的电荷层时, 此时电荷层对器件倍增层与吸收层电场调控作用较强, 会使倍增层中的电场加强, 吸收层中的电场削弱, 此时需要较大的外加电压才能使器件处于穿通状态,但需要不大的外加电压就会使器件处于击穿状态.例如当电荷层厚度为0.25 µm、掺杂浓度为1 ×1017cm–3, ∆ (Vb−Vp) 仅为3 V, 若再增加电荷层厚度与掺杂浓度时, 会导致器件中耗尽区尚未完全耗尽时就已处于击穿状态, 在器件制备过程中应极力避免此情况, 电荷层的设计要结合实际进行综合考虑.
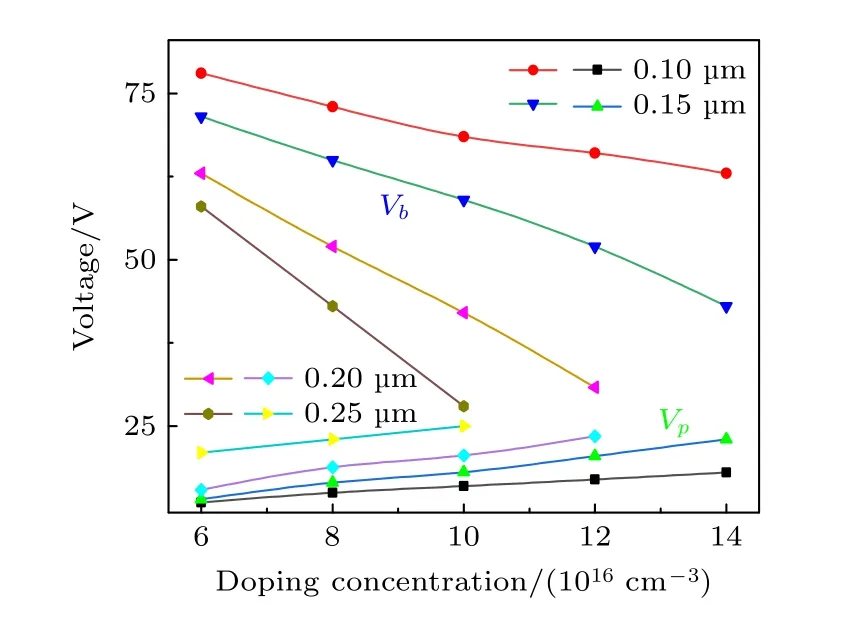
图7 电荷层厚度、掺杂浓度与击穿电压和穿通电压之间的关系Fig.7.The relation between the thickness and doping concentration of charge layer and the breakdown voltage, the punch-through voltage.
当电荷层掺杂浓度为8 × 1016cm–3、厚度为0.2 µm时, 图8揭示了倍增层厚度wm的增加对APD穿通电压与击穿电压的影响.如图8所示, 击穿电压随wm的增大出现先减小后增大的现象,wm从0.2到0.6 µm时总体呈下降趋势, 在0.6到1.2 µm时呈上升趋势, 在0.6 µm时Vb取得最小值53 V,且总体呈现非线性变化规律, 而穿通电压呈线性增加, 上述变化趋势可由APD的增益系数公式[24]来解释.若倍增区厚度太薄, 会产生较大的击穿电压与很小的穿通电压.因此在实际制作中可适当提高倍增层厚度, 提升载流子在倍增层中碰撞电离的几率, 提高器件的增益系数.
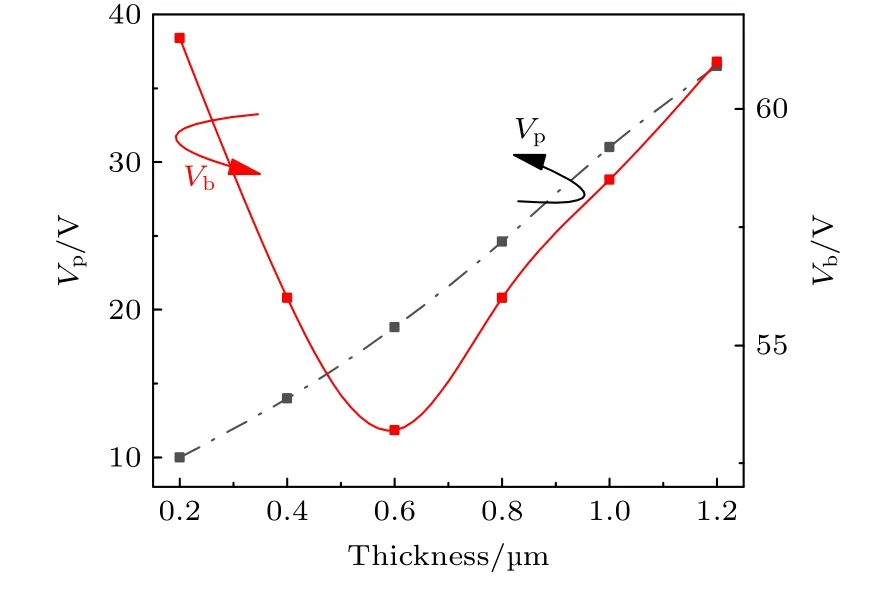
图8 不同倍增层厚度时的击穿电压与穿通电压Fig.8.Breakdown voltage and penetration voltage at different thicknesses of the multiplier layer.
图9 揭示了雪崩光电二极管中的倍增层不同掺杂浓度对器件的击穿电压与穿通电压的影响.当倍增层掺杂浓度升高, 击穿电压逐渐下降, 且下降趋势微弱, 掺杂浓度从1 × 1014cm–3上升至1 ×1015cm–3时, 击穿电压仅从56 V下降至53 V, 穿通电压则几乎没变.
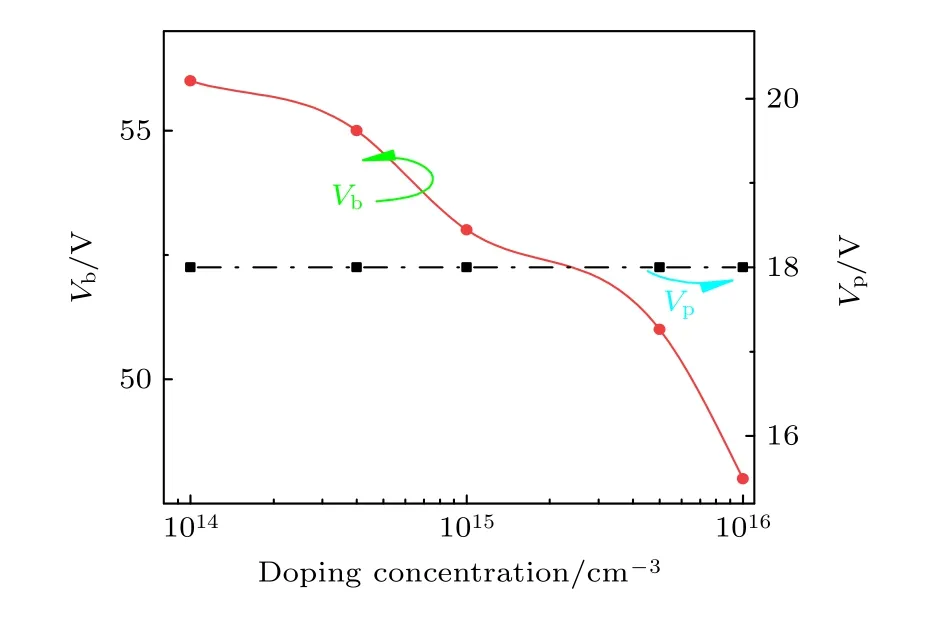
图9 倍增层不同掺杂浓度与穿通电压和击穿电压关系Fig.9.Breakdown voltage and penetration voltage at different doping concentration of the multiplier layer.
3.3 I-V特性与光谱响应
APD的内部增益机制一般为雪崩倍増, 本工作中的电子在高电场作用下的倍增层碰撞电离的几率是随机的, 因此倍增后生成的电流分布不均匀, 雪崩光电二极管产生一个附加噪音机制, 称为倍增噪音, 是雪崩光电二极管主要的噪音来源.Si中电子的碰撞电离系数比空穴高, 因此采用电子作为雪崩光电二极管的倍增机制.一般由电子倍增产生的噪音Fn为[25]

其中k代表倍増区域内有效空穴与电子的离化系数的比值;Mn为增益系数, 是APD中最基本的参数之一.增益系数一般定义为光照下产生的电流IP减去黑暗下的暗电流ID之差与有效光电流IA之比.在计算过程中一般如下公式:

如图10所示, 黑色曲线与红色曲线分别代表雪崩光电二极管在黑暗与光照下(l= 1.31 µm,光功率 = 0.01 W/cm2)下的I-V曲线.APD在偏压为12 V左右耗尽区开始逐渐向Mg2Si吸收层扩散, 提升了入射光被Mg2Si薄膜层吸收形成光生载流子的几率, 耗尽区的场强分布提高, 自由载流子越过吸收层与电荷层到达倍增层的概率升高, 暗电流会有较大幅度的提升.当偏压为18 V左右时吸收层被完全耗尽, 器件处于穿通状态.随着偏压的继续增大, 此时耗尽区会向p区与n区延伸, 倍增层雪崩效应开始显现, 此时器件的电流增加较为平缓.在50 V左右时, 器件倍增层中的电子在高电场情况下雪崩碰撞离化明显, 暗电流与光电流几乎呈指数增长, 发生击穿.当器件工作处于线性模式下(Vp 图10 APD的I-V特性与增益系数Fig.10.I-V characteristics and gain coefficient of APD. 表3 模拟结果与目前国际水平对比Table 3.Comparison of simulation results with current international level. 图11为外加偏置电压对APD光谱响应的影响, 由图可知器件的光谱响应波长能扩展至1.6 µm,因此选用Mg2Si作为吸收层能有效地扩展Si基APD的光谱响应波段.在47.5 V(0.95Vb)偏压下,波长为1.1 µm时光谱响应达到峰值, 为25 A/W,在1.31 µm处也有较高的响应度, 所以此APD可适用于光通信等光电设备领域中.总体而言, 随着偏置电压的增大, APD的光谱响应不断增强, 但其随波长的变化趋势保持了较好的一致性.越接近击穿电压, 增强的幅度越大.当在偏压为17.5 V时, APD的吸收层被完全耗尽, 器件被穿通, 此时倍增效应还未产生, 因此选取17.5 V为器件的穿通电压. 图11 不同的偏置电压对APD光谱响应的影响Fig.11.Effect of different bias voltages on the spectral response of APD. 若设IMP与IMD分别是雪崩倍增效应后的光电流与暗电流,IP与ID是未发生雪崩倍增效应的光电流与暗电流, 仿真计算时取器件穿通前光电流与暗电流之差的平均值代表倍增效应前的电流, 两者之比M如下式所示: 上式中M可表示雪崩效应后对电流的放大倍数.通过先前的工作确定17.5 V为器件的穿通电压, 取17.5 V以前光电流与暗电流之差的平均电流为倍增前的电流, 17.5 V以后为倍增后的电流.如图10所示,M在偏压大于46 V时迅速增加, 在50.8 V时有最大值1660.若取IMP与IMD之差的平均电流为倍增后的电流, 经计算此时M为75.4, 证明该结构对电流的增益效果较好. 图12为APD在频率为1 MHz下的C-V仿真曲线随倍增层厚度的变化.当外加偏压一定时,随着倍增层厚度的增加, 器件电容减小.当厚度一定时, 随着外加偏压的减小, 器件电容增大.从理论上分析时, APD中由于电极与衬底介电性产生的电容和管壳电容是由器件工艺来决定的, 在这里不做讨论, 只考虑结电容Cj, 可等效为pn结处理,如果外部交流小信号频率很高时, 电容Cj以耗尽电容Cτ为主, 可忽略Cd[28], 当外加交流偏置电压V时得到Cj关系式为[28,29] 由(4)式可推知, 当倍增层厚度和偏置电压变大时, 耗尽层宽度会相应展宽, 器件电容减小, 与模拟变化结果相一致.探测器带宽与RC关系是呈负相关[25]: 图12 倍增层厚度对器件电容的影响Fig.12.The influence of the thickness of multiplication layer on the capacitance of the device. 根据(5)式可知合理降低器件电容是有必要的.当倍增区厚度为1 µm时, 在5 V偏置电压下,器件电容密度约为1 × 10–15F/µm. 图13为不同倍增层厚度时器件的瞬态响应曲线, 增加倍增层厚度, 对器件的响应时间影响微弱,但器件的稳态光电流却是先减小后增大, 可能是因为倍增层厚度的增加会调控器件内部场强分布, 使击穿电压出现先降低后升高的趋势.本例中得到的瞬态响应曲线的偏压均为37 V, 因此倍增层厚度的不同导致了不同的稳态光电流. 图13 不同倍增层厚度时器件的瞬态响应Fig.13.Transient response of the device for different thickness of the multiplication layer. 考虑到Mg2Si/Si异质生长的晶格失配度, 建立了Mg2Si/Si SACM-APD模型, 研究了电荷层和倍增层的厚度以及掺杂浓度对雪崩光电二极管的内部电场分布、穿通电压(Vp)、击穿电压(Vb)、C-V特性和瞬态响应的影响, 分析了偏置电压对IV特性和光谱响应的影响, 得到了Mg2Si/Si SACM-APD初步优化后的Vp,Vb、暗电流密度、增益系数(Mn)和雪崩效应后对器件电流的放大倍数(M), 为高性能的器件制备奠定了良好的基础.根据模拟结果可知: 器件的光谱响应波长能扩展至1.6 µm, 选用Mg2Si作为吸收层的APD能有效地扩展Si基APD的光谱响应波段.随着电荷层厚度与掺杂浓度的升高, 器件的Vp呈线性上升趋势,而Vb呈线性下降趋势, 且下降趋势较为明显, 因此电荷层能较好地调节器件内部电场分布.当倍增层掺杂浓度大于1 × 1015cm–3后, 倍增层电场分布出现较大程度的不均衡, 会产生较大的暗电流,因此为保证倍增区的电场相对稳定, 倍增层的掺杂浓度不宜超过1 × 1015cm–3.在器件结构参数优化后, SACM-APD的Vp为17.5 V,Vb为50 V; 当偏压为47.5 V (0.95Vb)时, 器件的光谱响应在波长为1.1 µm时达到峰值25 A/W, 与先前的研究中pin型Mg2Si/Si光电二极管的光谱响应峰值0.742 A/W相比, 光谱响应得到了很大程度的提高; 暗电流密度约为3.6 × 10–5A/cm2, 该Mg2Si/Si SACM-APD与pn型和pin型Mg2Si/Si光电二极管暗电流密度1 × 10–6A/cm2相比, 暗电流密度略大;Mn为19.6, 且Mn在器件击穿时取得最大值为102,M为75.4, 器件具有较好的增益效果.在器件制备过程中, 考虑到Mg2Si/Si异质生长的晶格失配度, 界面态密度应控制在1 × 1011cm–2以内, 并且可以通过在器件表面加设保护环[30]来提高器件的反向耐压性能.
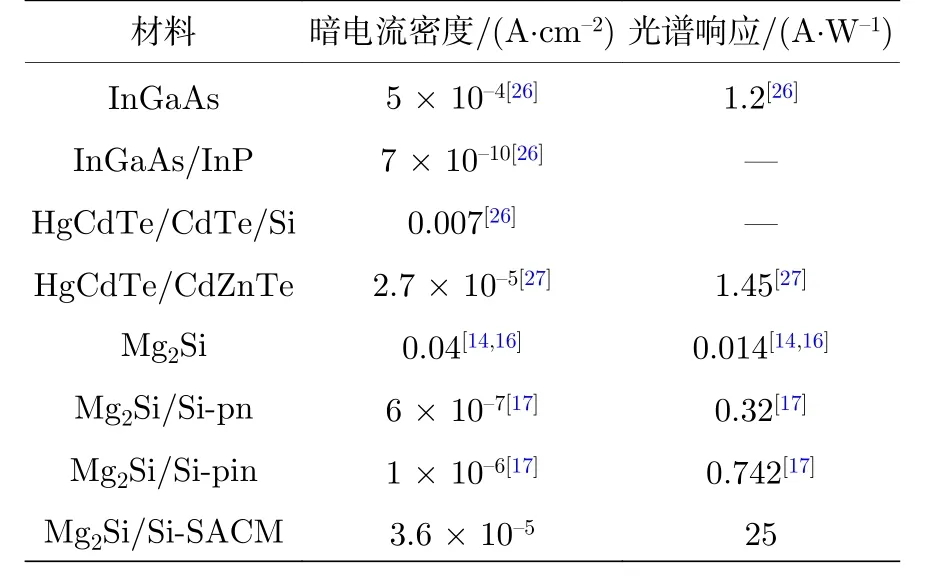
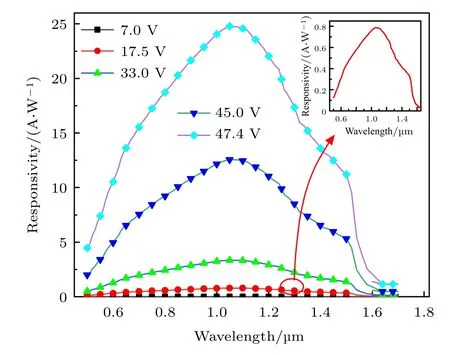

3.4 器件的C-V特性与开关特性

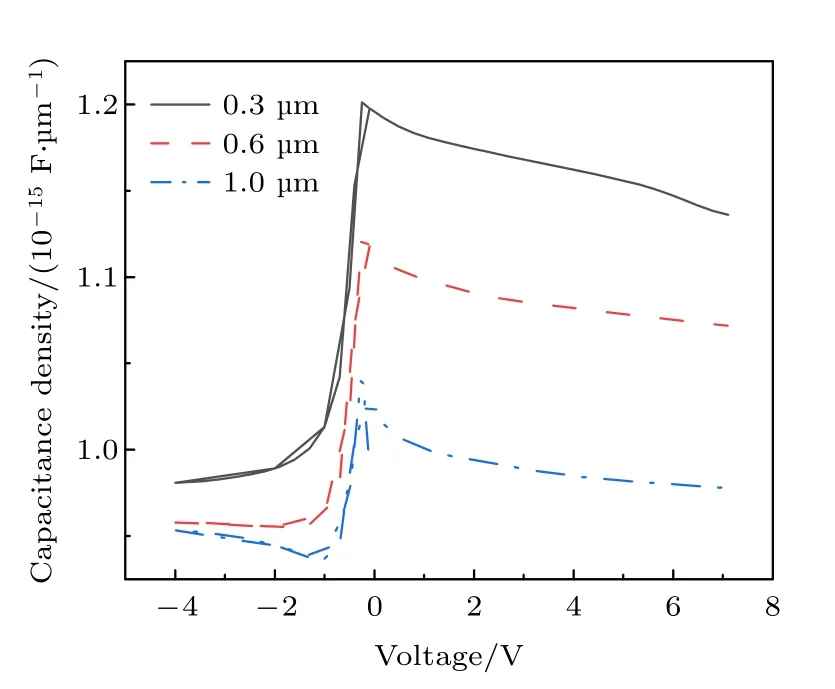


4 结 论
