LPCVD氮化硅设备对颗粒污染的影响研究
2021-05-07吴清洋
吴清洋
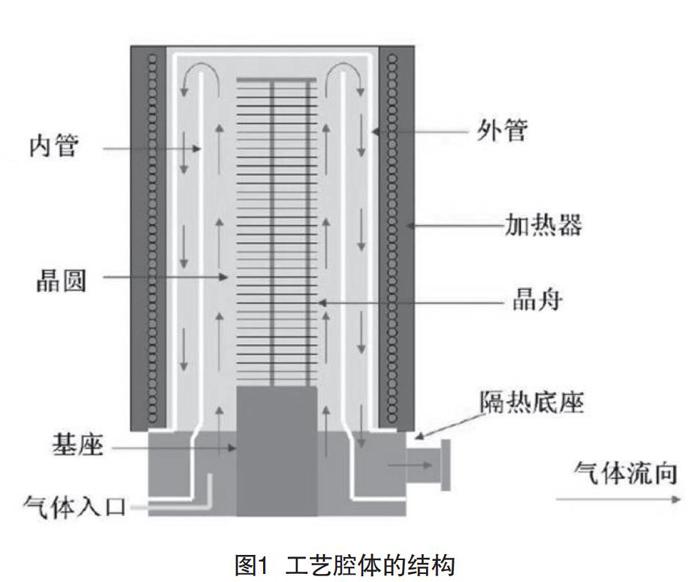

摘 要:颗粒污染在集成电路制造工艺中会引起严重的缺陷,会对后续光刻对位造成影响,甚至会导致电路性能下降、使用寿命缩短。尤其是在深亚微米集成电路制造工艺中,颗粒污染对产品良率的影响就更为严重了。在炉管低压化学气相淀积(LPCVD)工艺中,Si3N4工艺的颗粒污染问题最难控制。为了降低氮化硅薄膜制程中的颗粒污染,主要从LPCVD氮化硅薄膜生产设备出发,深入研究和探讨各环节可能存在的微粒污染问题,为低颗粒污染生产提供依据。
关键词:LPCVD;氮化硅;颗粒污染
在集成电路的生产制造过程中,总会不可避免地产生颗粒、金属离子、有机残余物、自然氧化层、静电释放(Electro Static Discharge,ESD)、微生物、气体杂质等污染物,这些污染物会在芯片生产过程中形成缺陷[1-2]。一般情况下,当混入的污染物数量较少时,不会对电路产生较大影响。但随着污染物数量的增多,电路会出现不同程度的断路、短路、漏电、电性漂移等情况,甚至会导致整个芯片报废,给生产公司造成巨大的经济损失。对产品失效原因进行分析,发现污染物引起的失效占总失效因素的60%,因此,在集成电路工艺生产过程中需特别注意各环节可能引入的污染物。在各种污染物中,颗粒污染是集成电路制造过程中最常见、也是对产品良率影响最大的一种。例如一小根毛发落在导线上,就会导致导线短路,甚至使整个器件失效[3-4]。
低压化学气相淀积(Low Pressure Chemical Vapor Deposition,LPCVD)氮化硅薄膜是利用炉管工艺设备制成的,因此,设备的基本结构和技术参数对Si3N4生产过程中的颗粒污染控制起主要作用。随着晶圆尺寸不断增大,早期的水平式炉管已无法满足薄膜淀积均匀度的要求,现在市面上的LPCVD氮化硅生产的主力设备是垂直式炉管。本研究以TEL公司的Alpha-8SE系列爐管机台为研究对象,分析其基本构造、性能和技术参数对颗粒污染的影响。
垂直式炉管是把工艺管竖立起来进行加工生产的,利用这种炉管工艺淀积的薄膜具有良好的均匀性。垂直式炉管的基本结构主要由腔体、晶圆传输系统、气体控制系统、温度控制系统、压力控制系统、尾气处理系统6个部分组成。在整个系统中,晶圆接触较多的部分就是工艺腔体、压力控制真空管、气体控制传输管以及晶圆传输系统。因此,本研究将对工艺腔体、气体控制系统、压力控制系统以及温度控制系统进行研究,分析其对Si3N4生产过程中颗粒污染的影响。
1 工艺腔体对颗粒污染的影响
工艺腔体是垂直炉管最核心的部分,是沉积Si3N4的场所,也是造成颗粒污染的主要区域。工艺腔体主要包括内管、外管、加热器、隔热底座、晶舟和基座6个部分,如图1所示,气体从下端一侧流入、另一侧流出。通常垂直炉管的工艺腔管有两种结构:单层双管型和双层单管型。单层双管型一般应用于LPCVD工艺中,而双层单管型应用于APCVD工艺中。就材质而言,IC常用的工艺腔体一般由碳化硅或是石英制成。采用两种材质的工艺腔体进行Si3N4薄膜制备,发现两种材质各有优点。
图1 工艺腔体的结构
(1)采用石英材质工艺腔体和碳化硅材质工艺腔体沉积氮化硅,氮化硅薄膜的厚度从0 μm累积到8 μm,两种工艺腔体底部颗粒污染物增加的情况都是最为严重的。同时发现,当Si3N4薄膜厚度小于4 μm时,碳化硅材质工艺腔体的颗粒污染状况要比石英材质工艺腔体好,但当腔体上的Si3N4薄膜厚度大于4 μm时,碳化硅材质工艺腔体的颗粒污染状况比较糟糕,污染物数量远超石英材质工艺腔体。
(2)由于Si3N4能与氢氟酸发生反应、不能与碳化硅发生反应,使用氢氟酸清洗碳化硅管时,炉管基本没有变化,使用寿命较长。采用石英材质制成工艺腔体时,由于石英主要由二氧化硅构成,二氧化硅能与氢氟酸发生反应。在清除表面Si3N4层时,二氧化硅参与反应,将有一部分石英被消耗掉。因此每次清洗后,石英腔管都会变薄一些,使用几次后就不能用了。为了延长石英腔管的使用寿命,可以采用水平槽式洗管机清洗管腔表面Si3N4层,同时,为了避免0.16 μm以上的颗粒数目增多影响晶圆质量,可以监测膜厚,达到临界厚度时停止生产,采用挡板试生产1~2次,待微粒减少后,再进行正常的生产。
综合分析,在氮化硅的制备工艺中,采用石英材质的工艺腔体,优势远超碳化硅材质的工艺腔体。
2 气体控制系统对颗粒污染的影响
气体控制系统的任务是将工艺要求的气流输送到工艺腔体。不同的工艺,参与气体也不同。机台会按照程序预先设定的要求,将对应的气体及其流量输送到反应腔体,进行预定的工艺。在所有的气体管路中,SiH2Cl2这条管路的颗粒污染是最严重的,主要是由于SiH2Cl2气体受外界温度的影响较大。一旦外界温度不稳定,SiH2Cl2在传输管路里就会发生分解反应,生成HCl、Cl、H和不定型硅等物质。这些物质的小颗粒会随着分解反应的发生,不断地附着在传输管壁上,并随着流通的气体一起进入工艺腔内,落在晶圆的表面,形成颗粒污染。为了避免颗粒污染的引入,实际生产中一般会在SiH2Cl2的传输管路上使用加热装置,将SiH2Cl2的温度控制在40 ℃左右。
3 压力控制系统对颗粒污染的影响
压力控制系统的任务是控制工艺腔体内的压力,由压力计、主阀、次阀和机械泵组成。压力的控制方式一般分为两种。
(1)角度控制法。这种方法采用闭环回路控制方式,主要通过调节控压阀门的开关角度来实现工艺腔体内压力的控制。这种控制方法常用于较高目标的压力控制。
(2)气体流量控制法。这种方法也是采用闭环回路的控制方法,工艺腔体的压力控制主要是通过控制阀门来控制真空管路通入的气体流量大小,气体流量的大小决定真空泵的抽气速率,实现工艺腔的压力控制。这种控制方法常用于较低目标的压力控制。
两种方法除了目标压力控制不同,还有一个重要区别是角度。角度控制法阀门只需开一个很小的角度,而气体流量控制法需将阀门全部打开,这样就会使得原来附着在真空管路腔壁上的微小颗粒随着气流进入工艺腔内,形成颗粒污染。因此,采用角度控制法控压方式在颗粒污染控制方面略优于气体流量控制法控压方式。
需要特别注意的是,压力控制系统也是一个尾气处理系统。在Si3N4的制备过程中会产生盐酸,反应式如下:
3SiH2Cl2(气)+4NH3(气)=Si3N4(固)+6HCl(气)+ 6H2(气)(1)
生产时,当NH3通气量较大时,HCl与NH3继续反应:
HCl+NH3=NH4Cl(2)
为了避免产物NH4Cl在管路中凝结,一般需要将管路温度控制在150 ℃以上,保证NH4Cl以气体形式进入尾气处理系统。但高温会使管路接口处的橡胶密封圈损坏,这样橡胶密封圈不但不能起到密封的作用,反而会引起气体泄漏,同时也会成为颗粒污染的来源。因此,管路的温度并不是越高越好。
4 温度控制系统对颗粒污染的影响
温度是LPCVD氮化硅薄膜制程中的主要参数之一。如果温度参数设置出现问题,不但会阻碍化学反应的正常进行,还会增加颗粒污染,导致氮化硅薄膜的厚度和质量不达标。工艺腔体的温度控制从生产开始一直持续到生产结束,整个过程的温度变化要经历淀积前的升温过程、淀积中的稳定过程和淀积后的降温过程3个阶段。因此,升降温过程中温度变化的快慢和温度大小的设定是研究温度控制系统对颗粒污染影响的关键。
4.1 温度变化速率
由于LPCVD腔管的材質一般都是石英的,其热膨胀系数不同于淀积的氮化硅层,腔管的急剧升温和降温将引起氮化硅的剥落,成为颗粒污染源。通过分析氮化硅薄膜制程中工艺腔体的温度变化情况,发现在整个生产制程中,温度的剧烈变化发生在两个阶段,分别是淀积前的升温阶段和淀积后的降温阶段。为了研究温度变化速率对颗粒污染的影响程度,在同一设备上完成不同升温速率和降温速率的对比实验,发现当升降温速率加快时,颗粒污染急剧增加。特别是当温度变化大于30 ℃/min时,颗粒污染数量翻倍增长。
4.2 温度的设定
在整个生产过程中,温度的设定主要分为3个区间: (1)晶舟的装载温度;(2)薄膜的生长温度;(3)晶舟的卸载温度。本研究对晶舟装载和卸载的温度设定进行了分析,发现晶舟装载和卸载温度的设定对颗粒污染影响很大。当装载和卸载温度控制在450~650 ℃时,颗粒污染最少,高于650 ℃或低于450 ℃的装载和卸载温度都会增加颗粒污染。
5 结语
通过对LPCVD氮化硅垂直式炉管设备的研究与分析,探讨了氮化硅薄膜淀积过程中设备对颗粒污染的影响,对于日常维护、降低颗粒污染、提高产品良率起到积极作用。
[参考文献]
[1]简崇玺.LPCVD制备氮化硅薄膜工艺[J].集成电路通讯,2008,26(2):18-21.
[2]伏宁娜.金属薄膜传感器中氮化硅薄膜的制备及工艺试验研究[D].太原:中北大学,2017.
[3]罗浚涛.研究和降低垂直型LPCVD制备氮化硅膜的微粒污染[D].上海:上海交通大学,2013.
[4]任瑞龙.LPCVD氮化硅炉管生产工艺中颗粒污染的研究[D].上海:上海交通大学,2009.
