LDMOS器件抗辐射关键工艺研究
2020-08-24于姝莉
刘 旸,于姝莉
(中国电子科技集团公司第四十七研究所,沈阳110032)
1 引言
功率MOS器件,特别是LDMOS(Laterally Diffused Metal Oxide Semiconductor,横向扩散金属氧化物半导体)器件的漏极、栅极和源极都在芯片表面,容易和低压MOS及TTL器件形成工艺集成,因此广泛地应用于开关稳压电源、驱动器等功率集成电路领域,目前已经成为电力电子器件发展的主流。同时,电源作为电子电力系统必不可少的模块,在航空、航天、核电等辐射环境中应用非常广泛[1]。为了保证电压类及驱动类电子元器件在复杂的辐射环境下可以稳定工作,开展LDMOS器件抗辐射工艺的研究极为必要。
2 LDMOS器件辐射失效
2.1 器件结构
LDMOS是一种双扩散结构的功率器件,纵向工艺结构如图1所示[2]。多晶硅电极伸展至漂移区的场区SiO2上方,成为场区极板。延伸的场区极板能够起到弱化漂移区表面电场的作用,有助于提高LDMOS器件的击穿电压[3-4]。
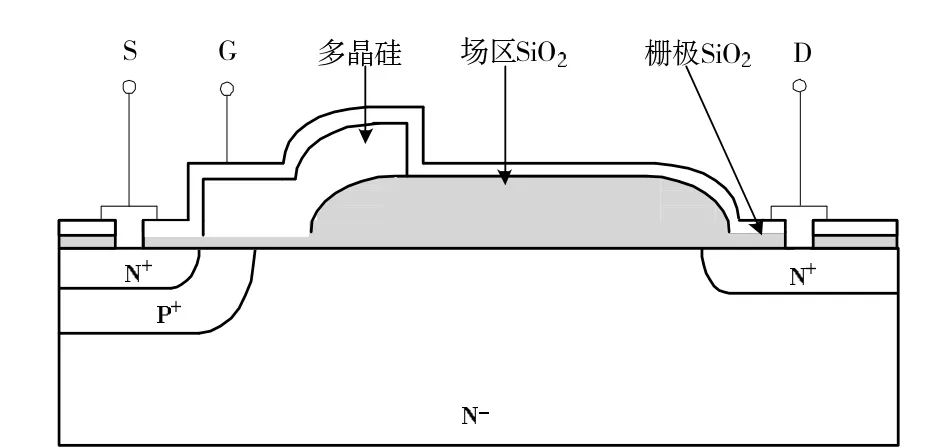
图1 LDMOS结构
2.2 辐射失效机理
LDMOS器件的结构决定了多晶硅电极下方存在较厚的SiO2。在辐射环境中,电离辐射会在SiO2中激发出电子-空穴对,电子空穴对的复合速度低于产生速度。在无外加电应力的情况下,未能及时被电子复合的空穴会被陷阱俘获形成感生界面陷阱电荷。在施加电应力的情况下,辐射感生的电子空穴对在电场的作用下被分开。由于电子的迁移率要高于空穴的迁移率,电子被电场迅速扫出,而部分未与电子复合的空穴则会被陷阱所俘获,进而形成更多界面陷阱电荷或氧化层陷阱电荷[5-6]。
在辐射环境下形成的界面陷阱电荷和氧化层陷阱电荷会造成LDMOS器件栅氧化层的耐压能力下降。在栅极施加电压时,多余的正电荷会变成额外施加到栅端的电场,使器件的阈值电压负向漂移,造成器件失效[7-8]。
3 抗辐射关键工艺研究
辐射环境下SiO2层产生的电子空穴对中,未能及时被电子复合的空穴被陷阱俘获形成的缺陷陷阱电荷是LDMOS器件在辐射环境中失效的原因之一,即增加SiO2层对空穴的复合能力,能够提高LDMOS器件的抗辐射加固能力。因此,可以考虑在热氧化生长过程中增加氧化层内的负电荷含量,增加空穴被复合的机率,提高LDMOS器件的抗辐射能力。工艺线生产过程中常用的Cl-,是一种很好的负电荷来源。
根据热运动原理,环境温度越高,原子运动速度越快,得到的能量也越高,运动中的原子在接近另一个原子时,若吸引能大于排斥能,两个原子就结合在一起,形成共价键。因此,当原子动能不足时,两个原子的键合能越低,就越容易形成共价键。Si-Cl化合物为分子结构,键合能为3.75eV,而SiO2为原子结构,Si-O键合能为4.25eV。因此,SiO2生长环境中含有Cl-离子时,Si会先与Cl-反应生成Si-Cl化合物,再与O2反应生成SiO2。而当SiO2生长温度足够低时,生长的氧化层中会固化大量的Cl-离子,达到增加氧化层内负电荷数量的目的。
SiO2生长方式有干氧氧化、H2/O2合成、水汽氧化三种。由于水汽氧化生长的氧化层致密度太低,目前已经弃用。干氧氧化方式生长的SiO2具有致密性高、针孔密度低的优点,但所需的热氧化温度也较高。常规采用的热氧化工艺氧化温度达到1000℃以上。这种温度下,能够形成稳定的Si-O键,但无法留存足够的Cl-离子。H2/O2合成方式生长的SiO2虽然致密性不如干氧氧化,但可以在更低的温度下生长SiO2。由于生长温度更低,SiO2内留存的Cl-离子数量也更多。可保证氧化层均匀性的热氧化炉最低炉温为850℃,因此,设计选用850℃下H2/O2合成的方式生长抗辐射加固SiO2。
具体工艺加工流程设计如下:
通入高纯N2→升温至850℃→载片舟出炉→装入晶圆片→载片舟入炉→停止N2输入并通入O2→通入反偏二氯乙烯→停止反偏二氯乙烯输入→5分钟后通入H2→停止H2输入→停止O2输入并通入高纯N2→载片舟出炉→取出晶圆片。
由于反偏二氯乙烯与H2同时存在于管道中会生成HCl,造成生长的SiO2质量下降,因此需将反偏二氯乙烯与H2分不同时段通入。
工艺设计完成后,用干氧氧化和抗辐射氧化的方式分别制备SiO2层,采用C-V电荷测试的方式评估氧化层中的氧化层固定电荷Qf和可动离子电荷Qm数量。测试结果如表1所示:

表1 C-V电荷测试结果
由表1的测试结果可知,抗辐射氧化工艺所生长的氧化层内的正电荷数量明显下降,在个别测试区域甚至并出现了固定电荷为负值的情况,此种情况表明在氧化层内固定了大量的负电荷,达到工艺开发的预期。
4 辐照实验验证
分别采用原工艺和新开发工艺制备LDMOS器件。采用原工艺加工的N型和P型LDMOS器件各2只,分别编号为N1Q~N2Q和P1Q~P2Q;选取采用新开发工艺加工的N型和P型LDMOS器件封装6只,分别编号为N1H~N3H和P1H~P3H。将所选取的10只试验电路同时进行总剂量辐照试验。实验结果如表2及表3所示。
由表2和表3的实验结果可见,采用新设计工艺的6只LDMOS电路在总剂量辐照试验后阈值电压和击穿电压的变化量均未超过10%。而采用原工艺的4只LDMOS电路在总剂量辐照试验后N型LDMOS已经耗尽,P型LDMOS的阈值电压变化率在50%以上,因此证明新设计工艺有效,验证了将负电荷固定在氧化层中可以提高SiO2抗辐射加固能力。

表2原工艺LDMOS器件辐照实验结果

表3新工艺LDMOS器件辐照实验结果
5 结束语
在对LDMOS器件在辐射环境中的失效机理的分析中可以预见,在氧化层中固定负电荷能够提高降低辐射环境中SiO2的缺陷电荷产生数量,进而提高LDMOS器件抗总剂量能力。通过实验验证,采用新工艺制造的器件抗总剂量能力确实高于原工艺,理论的正确性与实用性得到验证,也为高压产品抗辐射加固研究提供了有力的技术参考。
