纳米级静态随机存取存储器的a粒子软错误机理研究*
2020-07-14张战刚叶兵姬庆刚郭金龙习凯雷志锋黄云彭超何玉娟刘杰杜广华
张战刚 叶兵 姬庆刚 郭金龙 习凯 雷志锋 †黄云‡ 彭超 何玉娟 刘杰 杜广华
1) (工业和信息化部电子第五研究所,电子元器件可靠性物理及其应用技术重点实验室,广州 510610)
2) (中国科学院近代物理研究所,材料研究中心,兰州 730000)
3) (中国科学院微电子研究所,北京 100029)
本文使用镅-241作为a粒子放射源,开展65和90 nm静态随机存取存储器软错误机理研究,结合反向分析、TRIM和CREME-MC蒙特卡罗仿真揭示a粒子在器件中的能量输运过程、沉积能量谱和截面特性.结果表明,65 nm器件的软错误敏感性远高于90 nm器件,未发现翻转极性.根据西藏羊八井地区4300 m海拔的实时测量软错误率、热中子敏感性和a粒子软错误率,演算得到65 nm静态随机存取存储器在北京海平面应用的总体软错误率为429 FIT/Mb,其中a粒子的贡献占比为70.63%.基于反向分析结果构建器件三维仿真模型,研究a粒子入射角度对单粒子翻转特性的影响,发现随着入射角度从0°增大至60°,灵敏区中粒子数峰值处对应的沉积能量值减小了40%,原因为衰变a粒子的能量较低,入射角度增大导致a粒子穿过空气层和多层金属布线的厚度增大1/cos(q)倍,引起粒子能量减小,有效LET值随之减小.随着入射角度从0°增大至60°,单粒子翻转截面增大了79%,原因为65 nm器件灵敏区中明显的单粒子翻转边缘效应.
1 引 言
半导体器件的各种制造和封装材料中存在痕量的铀(U)、钍(Th)等杂质,这些杂质具有天然放射性,其释放的a粒子具有较强的电离能力,在穿过电子器件时可产生大量的电子-空穴对,电子-空穴对被器件收集进而导致软错误的出现[1].软错误虽然可以被纠正,但当其发生在关键位置(如中央处理器指令缓存)且没有被及时修正时,可能导致严重的后果.
随着集成电路 (integrated circuit,IC)工艺的持续发展,受集成度增大、供电电压降低、节点电容减小等因素的影响,电离粒子在先进工艺器件中引起的软错误成为应用可靠性的关键威胁[2−4].在大气环境中,软错误主要来源于a粒子、高能中子和热中子[5−7].其中,a粒子引起的软错误率 (soft error rate,SER)占比与器件工艺、封装材料等级、使用环境等因素密切相关[8],是总体SER的重要组成部分.随着集成电路的工艺尺寸进入纳米尺度,国内外相关研究多聚焦在集成电路的a粒子SER测量、与中子SER的贡献比例等研究[9−11],a粒子在其中引起软错误的机理尚不完全清晰,如灵敏区中的沉积能量谱特性、多角度入射下的敏感性变化及机理等,亟需开展深入研究,为加速试验方法和风险评价奠定基础.
本文从放射源选取、试验技术、仿真计算等方面开展纳米级静态随机存取存储器(SRAM)的a粒子软错误研究.在试验技术方面,基于放射源参数、封装材料a粒子发射率等级、单粒子翻转(single event upset,SEU) 截面等信息,获得器件在真实应用环境下的SER.在机理研究方面,结合使用辐照试验、反向分析和蒙卡仿真,研究a粒子能量输运特性、沉积能量谱、角度依赖性等微观特性,基于模型建立对结果进行解释.
2 试验条件
2.1 辐射源
选用镅–241(Am-241)源作为本试验使用的a粒子放射源,其衰变产物如(1)式,大多数a粒子的能量在 5.4—5.5 MeV之间,其中 84.5%的a粒子能量为5.486 MeV,13%的a粒子能量为5.443 MeV,1.6% 的 a 粒子能量为 5.388 MeV.

使用的放射源参数如表1所列,其放射率为5.73×105粒子/(2π·min),即 1.69×103粒子/(cm2·s),a粒子从放射源表面2π各向同性向外发射.根据JESD89 A标准[5],用于软错误测试的a粒子源的厚度应不小于0.04 mm,以保证其产生的a粒子能谱为分布式能谱,更接近器件真实情况.该Am-241源厚度为1 mm,产生的a粒子能谱与芯片真实环境下的a粒子能谱较为接近,但粒子通量远远高于真实环境,适合用于开展a粒子软错误率加速测试.

表1 使用的放射源参数Table 1.Parameters of the radioactive source being used.
2.2 被测器件及单粒子效应测试系统
被测器件参数如表2所列,选用CYPRESS公司的三款商用SRAM开展试验.试验前,对器件进行化学开封处理.

表2 被测器件参数Table 2.Parameters of the devices under test.
图1为测试装置示意图,测试在大气中进行,气压为 (81 ± 1) kPa.Am-241 源放置在开封后的芯片表面,放射源与硅片同轴.试验过程中,由于CY7 C1019 D 使用插座进行固定和电连接,所以放射源与其芯片之间的间距约为5 mm,其余两种器件的间距均为1 mm.使用单粒子效应测试系统监测辐照过程中SRAM芯片发生的软错误信息,包括数量、地址、错误数据等.试验过程中,需注意放射源辐射防护安全.
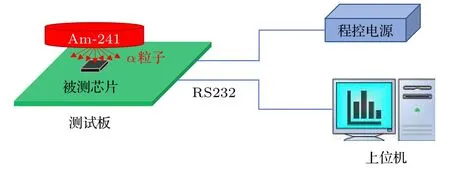
图1 测试装置示意图Fig.1.Schematic diagram of the test setup.
3 试验及仿真结果
3.1 试验结果
首先,根据具体的试验空间布局,对到达硅片表面的a粒子注量率进行建模和蒙特卡罗计算.放射源和被测器件硅片尺寸见表1和表2,a粒子从放射源表面发射,2π方向各向同性.放射源与硅片 同 轴 ,间 距 分 别 为 1 mm (65 nm SRAM)和5 mm (90 nm SRAM).对到达硅片表面的 a 粒子进行统计和分析,结果如图2和图3所示.由图可见,a粒子在两类器件表面均匀分布.统计计算后得到,相比于放射源表面发射注量率,到达65 nm SRAM和90 nm SRAM器件表面的a粒子注量率分别下降了21%和56%.根据该下降比例和a粒子放射源发射率,即可计算得到硅片表面的实际粒子注量率.

图2 蒙卡仿真得到的 65 nm SRAM 硅片表面 a 粒子分布图Fig.2.a particle distribution on the silicon surface of the 65 nm SRAM.
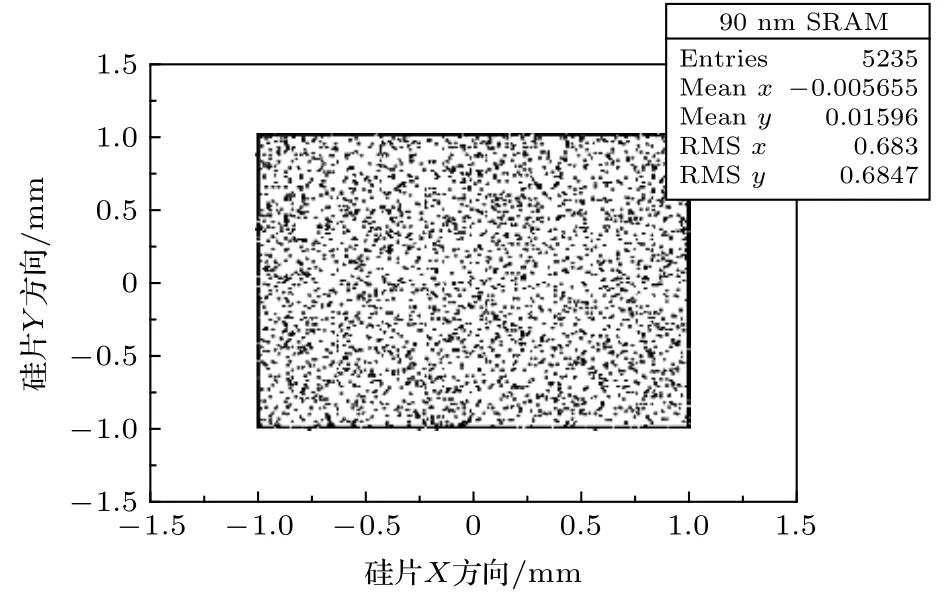
图3 蒙卡仿真得到的 90 nm SRAM 硅片表面 a 粒子分布图Fig.3.a particle distribution on the silicon surface of the 90 nm SRAM.
需要说明的是,放射源与被测器件之间空气层的存在会导致a粒子能量产生一定的衰减.例如,对于 65 nm 器件,5.486 MeV 的 a 粒子穿过 1 mm厚的空气层后能量为 5.40 MeV,减小了 1.6%;对于 90 nm 器件,5.486 MeV 的 a 粒子穿过 5 mm厚的空气层后能量为5.04 MeV,减小了8.1%.
基于之前的a粒子注量率建模计算,进一步得到三种型号器件的SEU截面测试结果如表3所列.SRAM器件的初始写入图形均为棋盘格.单粒子翻转截面s计算公式为:

其中,NSEU为 SEU 数量,Nb为测试容量 (Mb),F为粒子注量率 (cm–2·s–1),t为测试时长 (s).为了获得良好的数据统计,每种测试条件下的错误数均累积超过了 100 个.由表3 可见: 1)相比于 65 nm SRAM,90 nm SRAM 的 a 粒子 SEU 截面减小约两个数量级;2)两款65 nm器件均为同一公司的DDR-II系列SRAM,其SEU截面差别小于6%.
为了研究初始写入图形对SEU截面的影响,试验过程中针对两款65 nm器件使用了棋盘格、全0和全1三种写入图形,测得的SEU截面如图4所示.由图可见,棋盘格图形、全0和全1图形对应的SEU截面差别小于 ± 7%,且两款器件的SEU截面变化趋势无明显规律.
本文中使用的三款器件均为引线键合、塑料封装,其放射性a粒子主要来自于模塑料.假定a粒子发射率为Ra(单位为/(cm2·h)),通常分为三个等级,如表4所示.基于上述数据可进一步计算得到器件真实环境下a粒子导致的软错误率(单位为FIT/Mb):
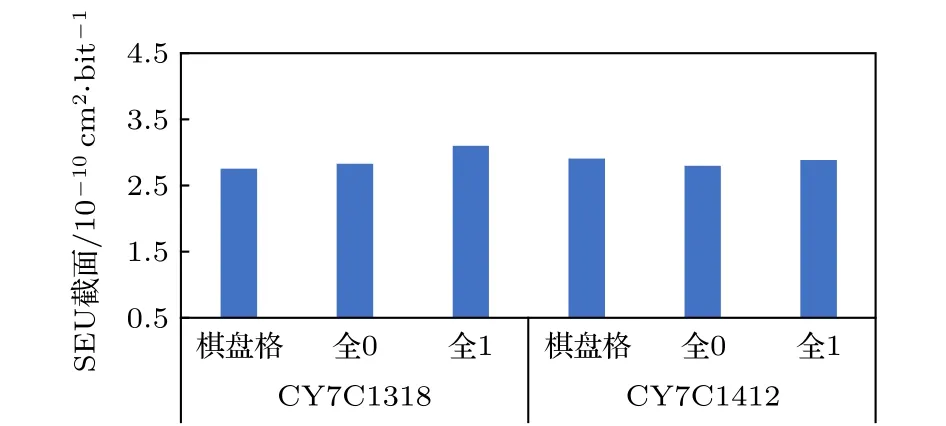
图4 初始写入图形对 SEU 截面的影响Fig.4.Impact of initial data pattern on SEU cross section.

表3 SEU 截面测试结果Table 3.Test results of SEU cross section.

表4 a 粒子发射率等级及对应的软错误率Table 4.The a particle emissivity level and corresponding soft error rate.

表5 65 nm SRAM在4300 m海拔试验地点及北京海平面使用时的软错误率及a粒子、高能中子和热中子贡献占比Table 5.Soft error rates of the 65 nm SRAM at the experimental site with an altitude of 4300 m and sea level of Beijing city being used.The contribution rates of a particle,high energy neutron and thermal neutron are analyzed,respectively.

其中s为单粒子翻转截面(单位为cm2/bit).由表4可知,当65 nm SRAM的封装材料使用提纯后的超低 a 粒子 (ultra low alpha,ULA)发射率等级时,其软错误率为 303 FIT/Mb,即 1 Mb 容量的器件在 109个工作小时 (约 11.4万年)内发生303个错误.需要说明的是,表4中SER的计算使用的SEU截面为上文中的两款器件、三种初始写入图形的平均截面.当90 nm SRAM的封装材料使用提纯后的ULA发射率等级时,其软错误率为2.97 FIT/Mb.
表5 给出了 65 nm SRAM 在 4300 m 海拔试验地点及北京海平面使用时的软错误率计算结果及a粒子、高能中子和热中子贡献占比分析.根据我们之前的研究报道[12],该类器件在4300 m海拔的西藏羊八井地区长期测量得到的实时软错误率为 2356 FIT/Mb,其中包含了 a粒子、高能中子(E>10 MeV)和热中子 (E<0.4 eV)的共同贡献.a粒子引起的软错误率与所处地点没有关系,固定为303 FIT/Mb.进一步开展的中子辐照试验和二次离子质谱 (secondary ion mass spectroscopy,SIMS)测量和分析,均表明该类器件对热中子不敏感,所以热中子对实时软错误率没有贡献.经过软件计算得到,羊八井地区的高能中子通量(118.9 n/(cm2·h))比 北 京 海 平 面 (7.3 n/(cm2·h))高16.3倍,由此可计算得到该65 nm SRAM在北京海平面使用时高能中子引起的软错误率为126 FIT/Mb.最终得到,该 65 nm SRAM 在北京海平面使用时的软错误率为429 FIT/Mb,其中a粒子的贡献占比为70.63%.
3.2 仿真分析
为了更深入地理解试验结果,对内在机理进行分析,本文基于 TRIM[13,14]和 CREME-MC[15−18]两种仿真工具,结合器件的反向分析结果,对上述试验过程进行了仿真,得到了a粒子在器件中的传播轨迹、灵敏区沉积能量、单粒子翻转截面等微观信息.
3.2.1 反向分析
图5给出了65 nm工艺SRAM的横切面和存储区图像,该SRAM共使用六层金属布线,M5为Al材料,其他 (M4—M0)为 Cu 材料.在 M0 和灵敏硅层之间发现W塞的存在.根据图5(b),该器件存储单元为六管结构,大小约为 1 µm × 0.5 µm;将“关”态NMOS的漏区作为单粒子翻转灵敏区,其大小为 0.2 µm × 0.19 µm;考虑电离电荷的漂移、扩散、漏斗长度等收集过程,将灵敏区的厚度设置为阱深,即 0.45 µm.表6 给出了 65 nm SRAM的存储单元尺寸和灵敏区参数.
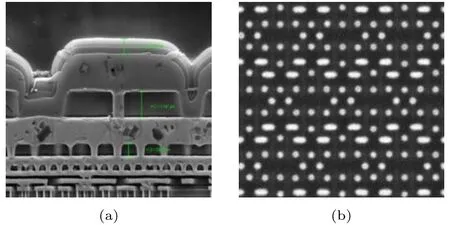
图5 65 nm SRAM 的反向分析结果 (a)横切面;(b)存储区图像Fig.5.Reverse analysis results of the 65 nm SRAM: (a) Cross section;(b) memory area image.

表6 65 nm SRAM 的存储单元尺寸和灵敏区参数Table 6.Memory cell size and SV parameters of the 65 nm SRAM device.
3.2.2 TRIM 仿真
基 于 SRIM-2008.04(stopping and range of ions in matter-version 2008.04)软件中的 TRIM(Monte Carlo transport of ions in matter) 蒙特卡罗仿真工具开展a粒子在器件中的输运仿真.如图6所示,106个a粒子从零点处垂直入射,初始能量为 5.486 MeV,经过 1 mm 的空气层后依次穿过65 nm SRAM器件的表层金属布线、灵敏层和衬底.计算类型为“ion distribution and quick calculation of damage”,考虑了 a 粒子在器件输运过程中的直接电离和库仑散射过程.TRIM工具可详细追踪粒子在器件中的轨迹,记录粒子能量、动量、位置、出射角等信息.
图6(a)中,器件灵敏区位于灵敏层中心(虚线处).由图可见: 1)a粒子可以穿透空气层和器件表层金属布线,在器件灵敏区中沉积能量,但没有粒子能穿透器件衬底;2)由于库仑散射相互作用,a粒子在器件的传播过程中呈现出较大的位置分布,产生背散射粒子的概率为 2.5 × 10–5;3) 99.75%的能量损失通过a粒子直接电离过程完成,其余过程(如反冲核、空位、声子等)占比很小.
3.2.3 CREME-MC 仿真
根据反向分析结果,建立三维器件仿真模型如图7 所示,模型大小为 10 µm (x) × 10 µm (y),器件灵敏区位于多层金属布线层下方中心处.在每次CREME-MC仿真过程中,108个a粒子随机入射,初始能量为 5.486 MeV,经过 1 mm 空气层(未在图7中绘出)后达到器件表面.由于器件实际环境和试验环境中a粒子入射至器件表面时具有方向性,因此仿真试验使用 0°,30°和 60°三种入射角度条件,探讨角度对单粒子翻转特性的影响.需要说明的是,对于倾角入射的a粒子,其到达器件表面前穿过的空气层厚度增大1/cos(q)倍(q为入射角度),a粒子的能量随之减小.计算过程中详细考虑a粒子的二次电子和核反应过程,记录灵敏区中的沉积能量分布和截面信息.使用的物理过程包括 decay,EmStandardScreened,hElasticWEL_CHIPS_HP,particles,G4 GammaLeptoNuclear-Phys,hInelastic FTFP_CEM_HP,stopping,IonInelasticLAQGSM等.
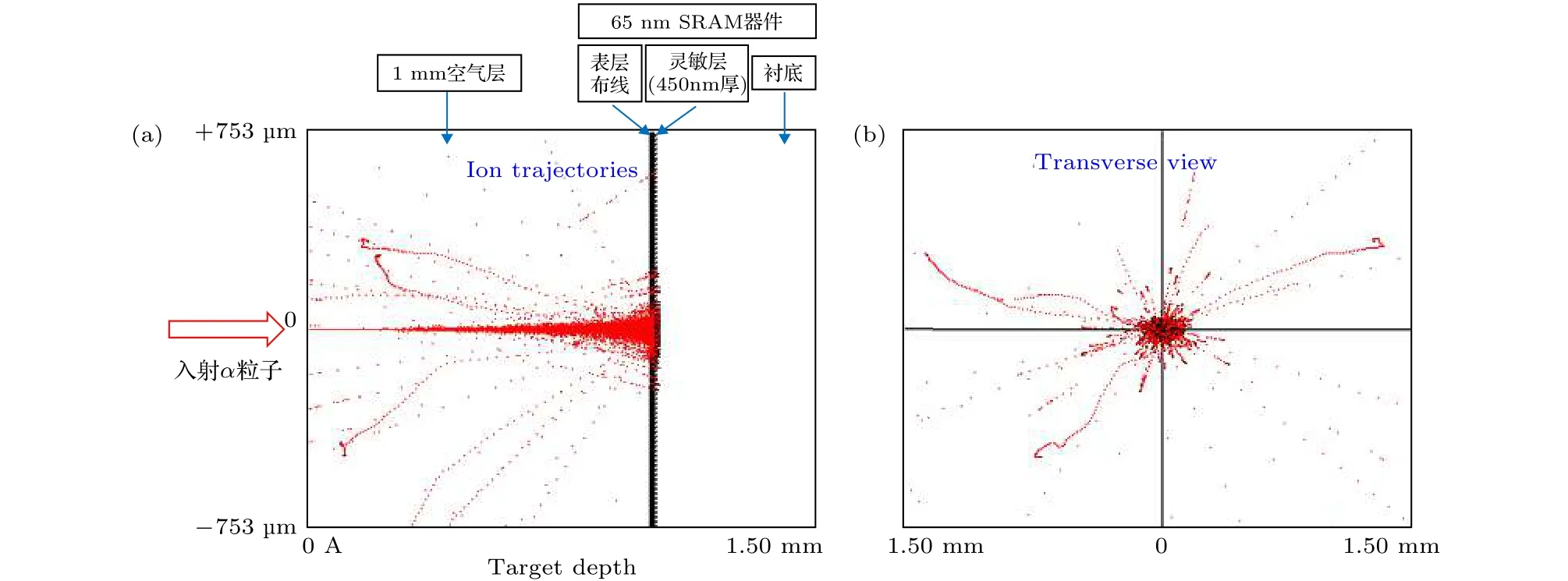
图6 TRIM仿真结果 (a) a粒子在器件中的传播轨迹;(b)器件横断面视角下的a粒子轨迹(粒子初始入射位置为中心零点处)Fig.6.TRIM simulation results: (a) The propagation trajectory of alpha particles in the device;(b) the alpha particle trajectory from the cross-sectional view of the device (the initial incident position of the particle is at the zero center).

图7 65 nm 工艺器件三维仿真模型Fig.7.3 D simulation model of the 65 nm device.
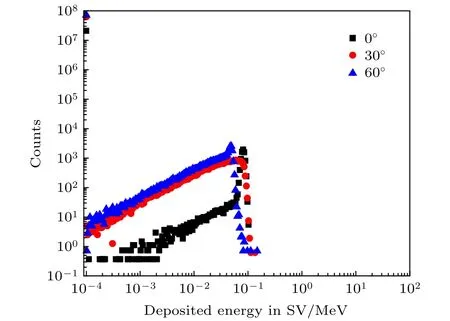
图8 不同入射角度下器件灵敏区中的沉积能量谱Fig.8.Deposited energy spectra in sensitive regions of devices at different incident angles.
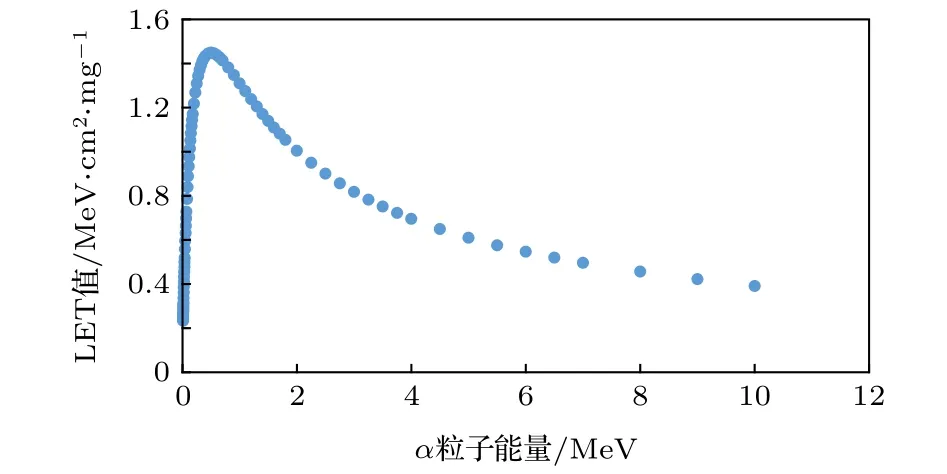
图9 a粒子在硅材料中的LET值与能量的关系Fig.9.Relationship between LET value and energy of aparticle in silicon material.
图8给出了不同入射角度下器件灵敏区中的沉积能量谱.由图可见,随着入射角度的增大,沉积能量谱表现出典型特征: 粒子数峰值处对应的沉积能量值呈减小趋势,从垂直入射时的81.3 keV减小至60°倾角入射时的49 keV,原因为随着入射角度的增大,a粒子穿过空气层和多层金属布线的厚度增大1/cos(q)倍,导致粒子能量减小,有效LET值随之减小.图9为a粒子在硅材料中的LET值与能量的关系.计算得到,垂直入射、30°和60°倾角入射条件下a粒子最终在灵敏区处的LET 值分别为 0.78,0.49 和 0.23 MeV·cm2·mg-1.
图10为不同入射角度下单粒子翻转截面与临界能量的关系,由前文可知该器件的单粒子翻转临界能量为 22.5 keV(约 1 fC),可得图11.垂直入射条件下,器件的单粒子翻转截面为 3.9 × 10–10cm2/bit,即0.039 µm2/bit,与器件灵敏区的表面积基本一致.该SEU截面略大于上一节放射源试验获得的SEU截面值(65 nm SRAM的SEU截面平均值为 2.89 × 10–10cm2/bit),差别源于放射源试验中粒子能量及入射方向与仿真不同.随着入射角度从0°增大至60°,器件的单粒子翻转截面增大了79%,该现象与图8中“粒子数峰值处对应的沉积能量值呈减小趋势”的规律相反.经分析得知原因为,虽然随着入射角度增大,粒子数峰值处对应的沉积能量值有所减小,但该能量值高于器件的临界能量,对单粒子翻转截面影响较小;另一方面,不同于以往大尺寸器件的“薄片”形灵敏区,该器件的灵敏区三维尺寸为 0.2 µm(L) × 0.19 µm(W) ×0.45 µm(D),导致明显的单粒子翻转“边缘效应”(见图12).
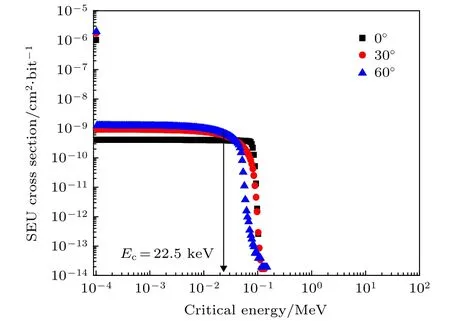
图10 不同入射角度下单粒子翻转截面与临界能量的关系Fig.10.Relationship between single event upset cross section and critical energy at different incident angles.

图11 不同入射角度下的单粒子翻转截面Fig.11.Single event upset cross section at different incident angles.
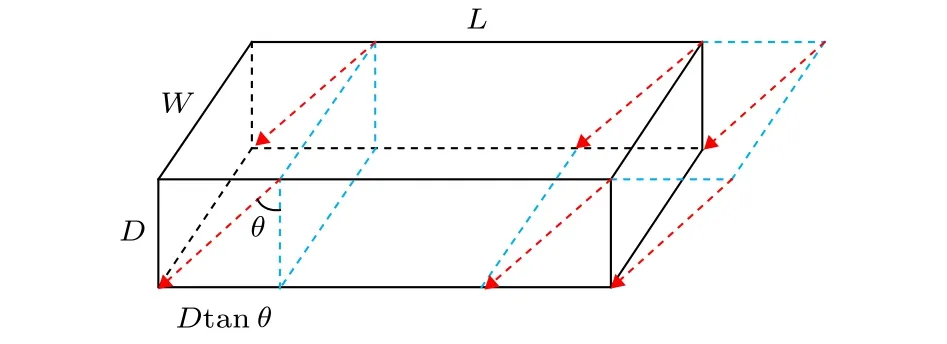
图12 边缘效应示意图 (未按实际比例绘图)[20,21]Fig.12.Schematic diagram of edge effect (not scaled)[20,21].
如图12所示,垂直入射条件下,器件的单粒子翻转截面为

其中W为灵敏区的宽度,L为灵敏区的长度.倾角入射条件下,若离子LET值足够大,路径长度变短并不影响入射离子在灵敏区中沉积足够的能量产生单粒子翻转,即沉积能量仍大于临界能量.则单粒子翻转截面为

其中D为灵敏区的厚度,q为入射粒子方向与器件法线之间的夹角.因此,边缘效应导致的单粒子翻转截面最大偏差为

计算可得该最大偏差为390%.对于本文的情况,由图8可知60°倾角入射条件下粒子数峰值处对应的沉积能量值为 49 keV,比 65 nm SRAM 的临界能量(22.5 keV)高超过两倍.当入射粒子沿图12模型中灵敏区的边缘入射时,粒子在灵敏区中的路径长度将减小,导致沉积能量降低,若该能量小于临界能量,将不能引起单粒子翻转.所以,边缘效应导致倾角入射条件下单粒子翻转截面的增大,但(6)式中的最大偏差为极限情况,故本文中单粒子翻转截面的增量小于该值.
4 结 论
本文基于Am-241放射源,搭建SRAM单粒子效应测试系统,结合a粒子辐照试验、反向分析和蒙特卡罗仿真开展a粒子在65和90 nm工艺SRAM器件中的软错误机理研究.研究结果表明,65 nm SRAM在Am-241放射源加速试验条件下的a 粒子单粒子翻转截面约为 2.89 × 10–10cm2/bit,远高于 90 nm SRAM,且未表现出明显的翻转极性.结合其塑封料的ULA级a粒子发射率,计算得到该器件的a粒子软错误率为303 FIT/Mb,对总体软错误率的贡献占比为70.63%(北京海平面).
基于反向分析结果构建器件三维仿真模型,65 nm SRAM器件使用六层金属布线,灵敏区大小为 0.2 µm(x) × 0.19 µm(y) × 0.45 µm(z),临界电荷约为 1 fC.蒙特卡罗仿真表明,65 nm SRAM器件的灵敏区沉积能量谱和单粒子翻转截面表现出明显的入射角度依赖性.随着入射角度从0°增大至60°,灵敏区中粒子数峰值处对应的沉积能量值减小了40%,原因为衰变a粒子的能量较低,入射角度增大导致a粒子穿过空气层和多层金属布线的厚度增大1/cos(q)倍,引起粒子能量减小,有效LET值随之减小.随着入射角度从0°增大至60°,单粒子翻转截面增大了 79%,原因为 65 nm器件灵敏区中明显的单粒子翻转边缘效应.
