极端电场环境激励下的VO2相变性能研究与应用*
2020-02-13何长安王庆国曲兆明孙肖宁杨鸿鸣娄华康
何长安,王庆国,曲兆明,孙肖宁,邹 俊,杨鸿鸣,娄华康
(1. 63601部队, 甘肃 酒泉 732750;2. 陆军工程大学 强电磁场环境模拟与防护技术重点实验室, 石家庄050003)
0 引 言
二氧化钒(VO2)薄膜材料可以在68℃时发生由低温绝缘体态向高温类金属态的可逆相变[1],相变过程中晶体结构发生由单斜结构到四方金红石结构的变化[2],并导致VO2薄膜在光学特性、电学特性、磁学特性等方面发生巨大变化[3]。正因如此,VO2在极端空间环境中的电学开关[4]、尤其是微小卫星电路控制系统[5]、太赫兹器件、智能窗[6]中具有广泛的应用前景,己成为功能材料领域研究的热点之一[7-8]。但VO2因制备条件苛刻、实验环境复杂等原因,为高重复性批量制备带来困难,严重制约了该材料的推广和应用。目前应用较多的VO2制备方法有磁控溅射法和无机溶胶-凝胶法等,磁控溅射法因实验工艺参数较多、精度要求较高,使实验成功率往往较低[9-10];无机溶胶-凝胶法因胶体本身的均匀性以及镀膜过程涂敷均匀性的不足[11],导致镀膜厚度的均匀性、结晶度等性能偏差,纯度不高,很难适用于高重复性批量制备。有研究表明[12],在溶胶凝胶法制备过程中,使用真空度在0.01 Pa至13.3 Pa区间内、退火温度为480 ℃、退火时间为10 min工艺条件可成功制备出相变前后表面电阻变化率为4个数量级的VO2薄膜,但此真空度对于管式炉来说还是较为苛刻[13]。为了进一步降低实验对真空度的要求,本文采用直流磁控溅射与真空退火相结合的方法制备高纯VO2,通过改变退火工艺,降低了实验条件对仪器的要求,提高了薄膜制备的重复率,并对VOx薄膜的场致相变特性进行了测试研究,总结不同组分对薄膜相变特性的影响规律。结果表明在场致相变过程中,焦耳热并非晶体相变的主导因素;不同退火条件生成的VXOY薄膜组分存在差异,进而导致薄膜场致相变规律改变,可据此研究相变电场可调的VXOY薄膜制备工艺;并对电场相变的氧化钒薄膜进行了研究,对将其应用于卫星智能控制系统中具有指导意义。
1 实验过程
1.1 薄膜的制备
实验采用磁控溅射直流靶材制备纯钒薄膜,使用管式炉在纯氧氛围内氧化纯钒薄膜得到表面均匀的V2O5薄膜,对V2O5薄膜进行真空退火,研究不同退火条件对薄膜组份的影响规律。具体实验细节如下。
考虑到基片在运输途中会沾有灰尘,且表面可能会依附油脂,影响实验结果,对基片进行清洗处理,将基片置于无水乙醇与丙酮的混合溶液中超声1 h,其溶液配制比例为4∶1,然后将其置入浓硫酸与过氧化氢的混合溶液中水浴加热1 h,控制其温度为363 K,溶液配制比例为2∶1。将水浴加热后的基片用去离子水冲洗干净备用。靶材表面会沾有灰尘且极易被氧化,一般擦拭清洗只能擦洗掉表面灰尘,需要使用预溅射来清洗靶材表面。将清洗过后的基片放入反应腔体,腔体抽至本底真空1×10-4Pa,充入高纯氩气对腔体进行清洗,调节反应气压至1 Pa,加热基片台至反应温度,预溅射10 min以达到清洗靶材表面氧化物的目的,使用直流纯钒靶材进行溅射,调节溅射功率180 W,溅射时间30 min,制得表面均匀的纯钒薄膜。使用管式炉在纯氧氛围内氧化纯钒薄膜,使用高纯氧对管式炉石英玻璃管洗气10 min,排气管接入去离子水进行水封闭,加热至773K关闭排气管,纯氧氛围下氧化纯钒薄膜300 min,氧化完成后的V2O5薄膜呈黄色,表面均匀。真空退火处理是调控实验产物最为关键的一步,采用真空度为60 Pa至100 Pa的管式炉进行退火,调节退火温度可制得不同组分的VXOY薄膜。
1.2 高电压测试系统的设计
为揭示VXOY电场相变规律,对不同实验条件获得的样品进行电场测试。设计恒温测试系统如图1所示,经建模计算,当样品为薄膜时,在恒温箱内,电极两端可构成均匀电场。

图1 测试系统结构示意图Fig 1 Schematic diagram of the test system structure
使用AgilentB1505A电压源,电压源限流50 mA,限压1 500 V,材料夹具采用单晶铜条,确保夹具电极与测试样品接触良好。
2 退火温度对VO2薄膜的影响规律
2.1 氧化时间对V2O5薄膜微观形貌的影响
高温氧化过程中的V2O5薄膜生长情况可以根据原子运动和扩散运输理论预测分析,根据能斯特—爱因斯坦方程ϑ=DF/RT(其中D为扩散系数,F为摩尔自由能梯度的一个量度)。该方程提出只要热能是激活能的来源,那么薄膜尺寸和晶粒生长规律就和温度T成正相关。由此可以预测晶粒生长趋势,在氧化温度T不变的情况下,且激活能的来源就是热能,在一定氧化时间范围内晶粒会持续生长,随着氧化时间的延长晶粒颗粒会变大。
由于V2O5薄膜为实验制备的中间产物,为保证每组生成的V2O5薄膜表面形貌、晶粒大小、薄膜厚度等因素不对后期实验产生影响,首先应该研究如何制备表面形貌平滑,晶粒大小均匀的V2O5薄膜。研究中改变退火时间并使用SEM扫描电镜对薄膜表面形貌进行了表征。
不同氧化时间下得到的V2O5薄膜微观形貌如图2所示,可以看出,薄膜晶粒随着氧化时间的延长而变大。氧化时间为200 min时,薄膜表面趋于平整,表面形貌变好,且晶粒大小趋于一致,但晶粒较小,约为200~300 nm;氧化时间延长至250min时,薄膜出现大颗粒晶粒,颗粒大小由800 nm至300 nm不等,但以小晶粒居多;氧化时间为300 min时,V2O5薄膜表面晶粒较大,薄膜晶粒平均尺寸在800 nm左右,晶粒长势良好,实验结果与理论预测符合较好。由于晶粒的大小对材料的相变临界温度和场强都有影响,因此可以利用氧化时间控制晶粒大小,进而可以调控V氧化物的临界性能。

图2 氧化时间对V2O5薄膜表面形貌的影响Fig 2 Effect of oxidation time on surface morphology of V2O5 film
2.2 不同氧化温度对V2O5薄膜组分的影响
为研究不同氧化温度对V2O5薄膜组分的影响,对薄膜进行了XRD扫描,旨在分析V2O5薄膜的组分与氧化温度的关系。图3给出了氧化温度400 ℃到500 ℃得到的V2O5薄膜XRD衍射图谱。通过对比PDF卡片41-1426,分析在不同氧化温度下V2O5薄膜的晶相构成,为观察方便,提取10°到50°的XRD衍射峰如图3,观察不同氧化温度表对薄膜晶体生长的影响。
由于实验设置在纯氧环境下对薄膜进行氧化,且氧化时间为300 min,V薄膜已完全被氧化,可以观察到3种氧化时间下薄膜均已由金属V转变成V2O5晶体。观察XRD衍射图可知在不同氧化温度下,20.26°均出现了V2O5(001)的强衍射峰,氧化温度为500℃时XRD衍射峰最强,说明此时V2O5晶体(001)相生长情况最好;3种不同退火温度下均可在42.05°观察到V2O5晶体(102)衍射峰,500 ℃时(102)取向的衍射峰最强。经过反复实验对比决定在V薄膜的氧化过程中,使用氧化时间为300 min,氧化温度500 ℃的实验工艺制备V2O5薄膜。
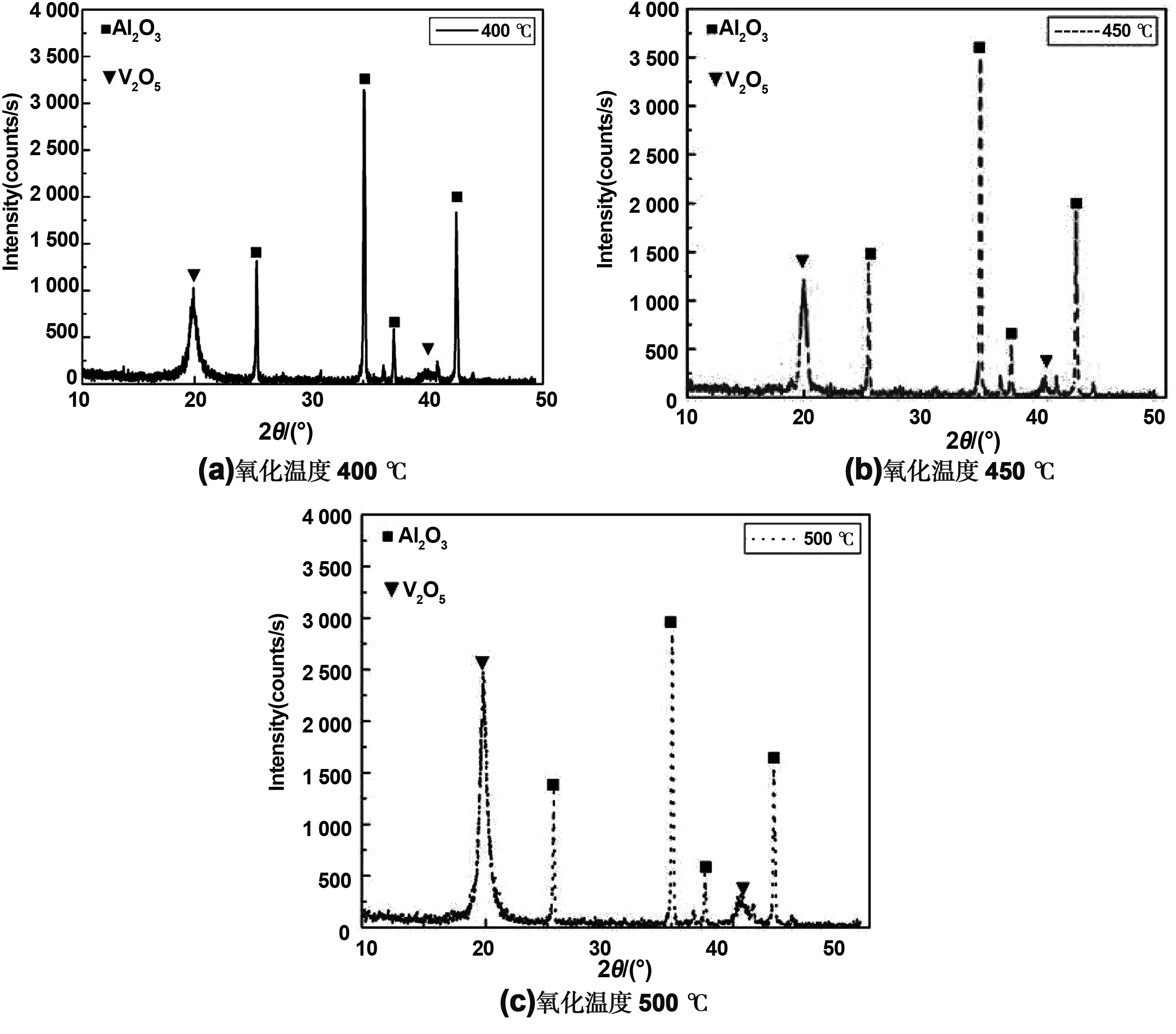
图3 不同氧化时间的V2O5薄膜XRD表征Fig 3 Characterization of V2O5 film XRD at different oxidation time
3 测试结果及分析
3.1 场致相变规律研究
根据前期文献资料总结,有学者认为场致相变中导致VO2薄膜相变的主要原因是电场对薄膜产生感应电流,电流产生焦耳热引起温度变化导致晶体膨胀,使晶格结构发生变化,材料发生相变。在实验中对这一假设进行了印证,由于薄膜相变具有可重复性,为总结相变电场对薄膜相变特性的影响规律,制备退火温度为515 ℃,退火时间为110 min的薄膜进行了多次场致相变测试,总结场致相变规律。实验验证了在场致相变条件下的相变现象与温致相变存在不同之处,结论表明场致相变中起主导作用的或许是外场导致薄膜晶格扭曲,这一现象可以部分验证主张电子-电子相互作用引起薄膜相变的Mott理论。
测试1为薄膜初始场致相变测试数据,测试2为薄膜场致相变后90 s进行的二次场致相变测试;静置10 min后等待薄膜晶格完全恢复对薄膜进行场致相变激励,实验测试3为薄膜场致相变测试后120 s进行的二次场致相变测试;静置10 min后等待薄膜晶格完全恢复对薄膜进行场致相变激励,实验测试4为薄膜场致相变测试后150 s进行的二次场致相变测试;总结实验数据如图4所示。
观察图4可知,测试1测得薄膜临界相变电场为0.71 MV/m;在90 s内对薄膜进行测试2,发现薄膜阻值维持相变后阻值并未发生改变,由于测试在298 K恒温箱中进行,测得此时薄膜温度为298.7 K,并未达到相变温度341 K,此时薄膜相变现象并非由于温度引起,且温致相变特性无法在温度条件消失后维持90 s,实验现象说明在场致相变过程中,薄膜晶体发生的相变现象,与温致相变特性不同,该实验现象佐证了场致相变规律中焦耳热并非主导作用。测试后间隔120s测得场致相变特性如图测试3所示,临界相变电场强度为0.48 MV/m;测试间隔150 s测得场致相变特性如图测试4所示,临界相变电场强度为0.57 MV/m。临界相变电场发生偏移,分析认为是薄膜晶粒在发生场致相变后的一段时间内,晶格并未完全从R相恢复至M相,存在缓慢恢复的阶段,在该阶段对薄膜进行场致相变测试即可观察到相变电场发生偏移的现象。
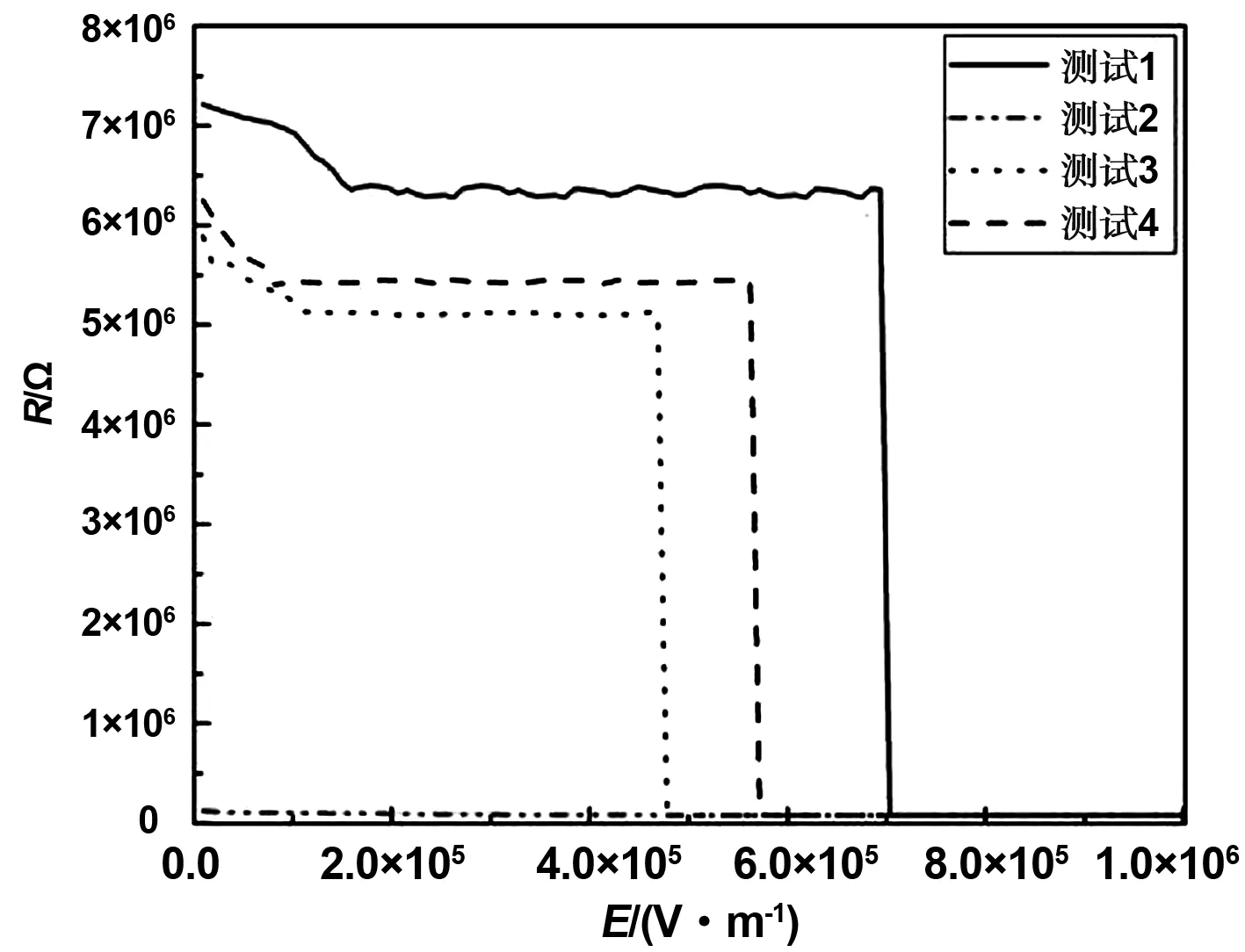
图4 相变点滞后现象Fig 4 Phase transition point hysteresis
3.2 相变电场调节技术研究
为对VO2薄膜进行多价态共存场致相变测试,需要制备仅含有VO2和V6O13的薄膜,由于含有V6O13的薄膜属于未完全退火薄膜,设定退火时间为65 min,调节退火温度为485 ℃至515 ℃,对不同退火条件下制备的薄膜进行了电场测试,实验表明薄膜中V6O13的含量可导致薄膜的临界相变电压发生改变。对薄膜进行了XRD表征如图5所示,为方便与PDF#44-0253卡片观察比较,提取了18°至31°的衍射图谱,可知,在退火温度为485℃时,薄膜出现了V6O13取向为(003)和VO2取向为(011)的衍射峰,提高退火温度至500 ℃,V6O13衍射峰开始变弱,表明含量开始降低,在退火温度升至515 ℃时薄膜已不出现V6O13衍射峰。
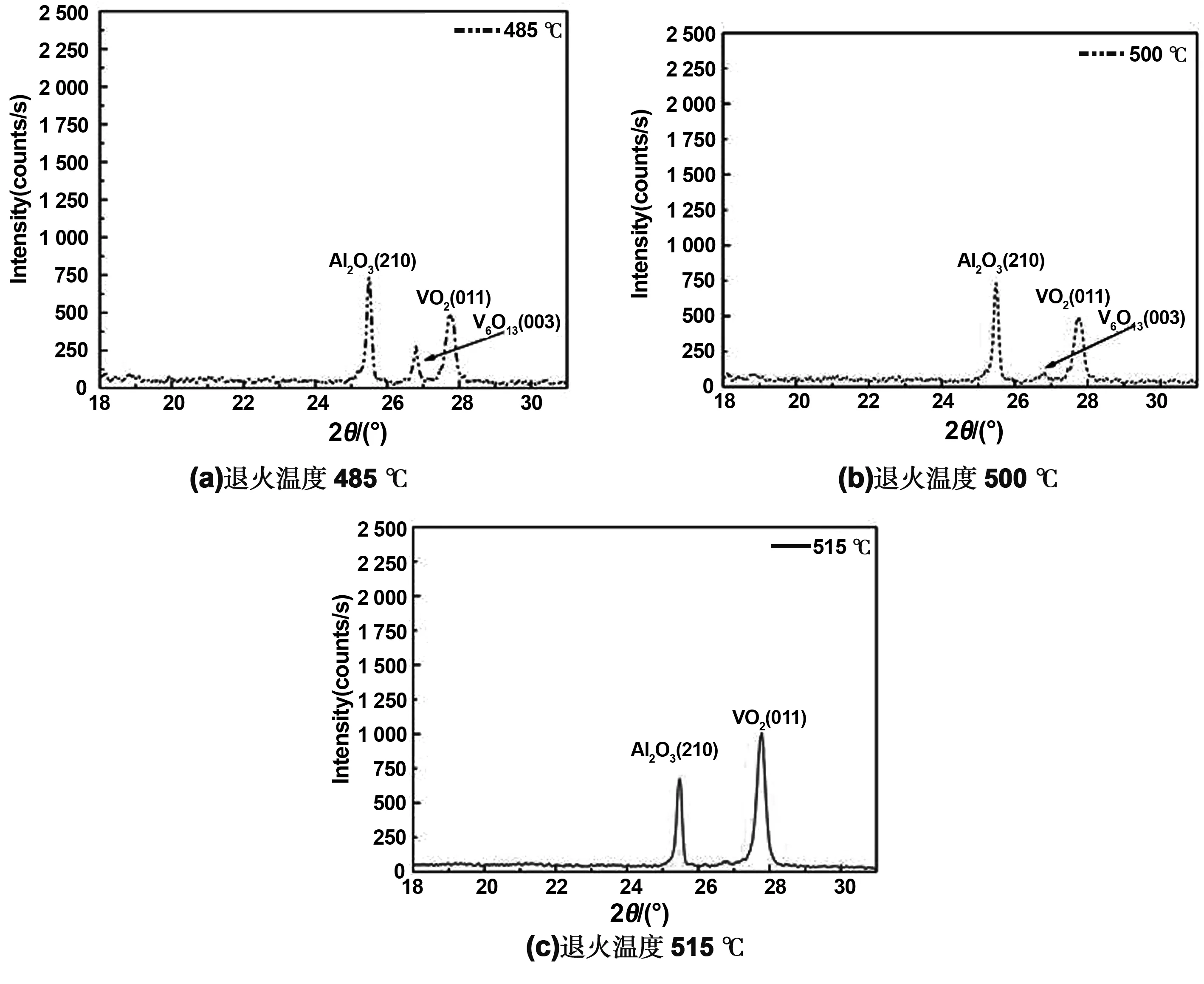
图5 不同退火温度下薄膜的XRD图谱Fig 5 XRD of films at different annealing temperatures
对制备出的三组薄膜进行温致及场致相变测试。图6为不同退火温度下的VO2场致相变测试规律,结合薄膜的XRD图谱分析可知:退火温度为515 ℃时,薄膜中只含有VO2不含V6O13,临界相变电场强度约为0.68 MV/m,可认为VO2的相变场强为0.68 MV/m;由于退火温度为500 ℃时薄膜含有取向为(003)的V6O13,薄膜临界相变电压骤变为0.22 MV/m;当退火温度为485 ℃时V6O13取向(003)衍射峰较强,说明此时的V6O13组分较多,此时的薄膜临界相变电场也降低为0.096MV/m。研究认为由于薄膜成分并不单一,钒的氧化物呈多样化形式存在,且测试距离为2 mm,相对于薄膜的纳米厚度测试距离较宽,VO2晶体在薄膜中呈现与V6O13晶体共存的情况,由于温致相变表,可知V6O13在常温下已经发生相变,可为VO2相变提供载流子,场致相变中VO2与V6O13共存的情况导致了VO2临界相变电场的降低。由此可见,利用退火温度的不同可以调控VO2及其他价态的含量,从而实现对相变临界电场的调控。
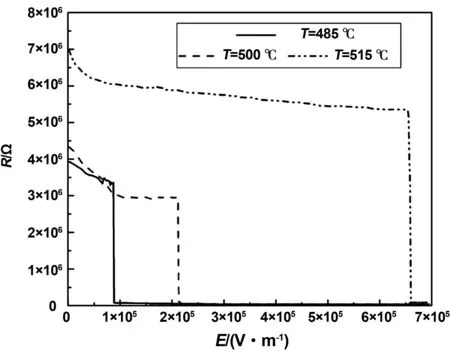
图6 不同退火温度下薄膜的场致相变测试Fig 6 Measurement of the electric field phase change of films under differentannealing temperatures
三组实验均存在薄膜在临界相变电压之前,阻值随电压升高缓慢下降的现象,分析认为这是场致相变与温致相变机制不同引起的,温致相变在温度到达相变点时所有晶体全部到达相变条件,引起自由电子跃迁,而在场致相变中可能会因为电场不均匀导致出现部分区域场强较高率先形成通路,引起阻值缓慢变低。
4 结 论
采用磁控溅射和真空退火工艺结合起来的方法制备了VXOY薄膜,对薄膜进行了电场相变特性研究,主要结论有:
(1)V2O5薄膜晶粒随着氧化时间的延长而变大,在500℃氧化温度下晶体取向最好。V2O5薄膜微观晶粒大小随着氧化时间的延长而变大,氧化时间为250 min时晶粒大小只有200~300 nm,氧化时间延长至300 min时薄膜晶粒平均尺寸在800 nm左右,晶粒长势良好;氧化温度为500 ℃时(001)取相的V2O5衍射峰最强,晶体取向最好。
(2)研究认为在场致相变过程中,引起相变的原因可能是电场的电子间强关联作用使得微观晶体结构发生变化,变形的晶格导致薄膜发生相变。场致相变过程中薄膜的温度仅上升了0.7 ℃,场致相变后90 s内未测得薄膜由R相恢复至M相的阻值变化情况。实验现象可以部分说明在场致相变过程中,薄膜晶体发生的相变现象与温致相变特性有不同之处。相变后120 s临界相变电场会降低至0.48 MV/m,150 s后临界相变电场强度降低至0.57 MV/m,研究认为是变形的晶格结构处于缓慢的恢复过程,故而出现不同的临界相变电场。
(3)测得了VO2的临界相变场强约为0.68 MV/m,当薄膜含有V6O13时,薄膜临界相变电压会降低。根据温致相变列表可知,V6O13在常温下已经发生相变,可为VO2相变提供载流子,在薄膜中由于VO2同V6O13共存,在电场激励下两种价态的薄膜互相作用,导致薄膜相变电压点会发生偏移,且发现V6O13含量越高,薄膜临界相变电压越低。
(4)在低于相变临界电场时,薄膜阻值出现随电场升高阻值缓慢减小的现象。由于VO2薄膜组成并不单一,且分布不均匀,在温致相变过程中,当薄膜达到临界相变温度时,薄膜内相变晶体均达到相变条件,电子发生跃迁,可同时发生相变;而与温致相变不同的是,场致相变中,由于薄膜组分分布不均匀,在电场激励作用下,一部分扭曲结构可提前发生相变,薄膜阻值会在未达到相变电场时一部分组分提前改变,出现随电场升高阻值缓慢减小的现象。
(5)卫星在空间工作温度环境可包络氧化钒薄膜相变温度68 ℃,可通过必要的隔热保温装置搭载氧化钒薄膜开关,设计以VO2相变特性为控制核心的智能开关应用于微纳卫星。
致谢:感谢智能电磁防护材料研究项目对本文的支持!
