X射线和重离子辐射对GaN基发光二极管的影响
2019-12-26张学文李彬鸿罗家俊刘新宇袁清习
王 磊,李 博,张学文,李彬鸿,罗家俊,3,刘新宇,3,袁清习
(1.中国科学院微电子研究所,北京100029;2.中国科学院硅器件技术重点实验室,北京100029;3.中国科学院大学,北京100049;4.中国科学院高能物理研究所,北京100049)
1 引 言
以电子-光子转换效应为原理的半导体光电子器件是光电子技术的关键和核心部件,相关研究已是现代光电子技术和微电子技术的前沿领域,也是信息技术的重要组成部分。半导体光电子器件主要包括自发发光器件、激光器、光电探测器件、传感器以及复合功能的异质集成器件等,它们基于多种材料和原理制备,波长可覆盖紫外至红外甚至太赫兹波段。此类器件具有光电转换效率高、光谱范围广、功率调谐范围大、抗电磁干扰能力强、调制频率高、带宽大、可多谱域成像、安全保密、方向性好及寿命长等优点,在商业、国防和航天领域广为应用,在未来技术革新中也将发挥越来越重要的作用。研究在X 射线和Si 重离子辐射效应影响下的发光二极管的各项性能的变化,具有很大的实用价值和必要性。
2 技术发展背景
GaN 材料及其三元和四元合金材料,作为一种典型的第三代半导体材料,其禁带宽度在0.6eV~6.2eV,覆盖了紫外到红外的整个波段,并具有耐高频高压、耐高温、耐腐蚀等优点,在光电子器件和电子器件领域有着巨大的应用前景。GaN 基光电子器件多以InGaN/GaN 多量子阱作为有源区,波长一般在蓝光和绿光波段。通过近20 年的快速发展,蓝光和绿光GaN 基发光二极管和激光二极管在商业化领域已经取得长足发展[1-6]。
InGaN/GaN 多量子阱发光二极管作为可见光通讯的主要光源,在保密会议网络系统、卫星内部、舰船内部无线通讯、火箭分离、太空舱外、深潜舱等军事航天领域的高速无线通讯方面具有巨大的应用前景[7-9]。GaN 基发光二极管在极端环境下的可靠性研究,尤其是在多种辐射环境下的辐照效应研究,对其在国防和航天领域的应用具有重要意义。
文献报道称,GaN 基半导体材料与器件因其稳定的物理化学特性,比GaAs 基和Si 基材料器件具有更高的抗辐射能力[10]。但目前针对高能射线的辐射电离效应、高能重离子位移效应和热峰效应对InGaN/GaN 多量子阱发光二极管的阈值电压、发光功率、峰值波长及色坐标所产生的影响的研究还缺乏系统性,仍处于初级阶段。发光二极管发光特性辐射效应的物理机制仍待深入研究[11-12]。
基于此背景,通过采用高能X 射线和高能Si 重离子对蓝光InGaN/GaN 多量子阱发光二极管芯片进行辐射特性研究,可揭示射线和粒子辐射对二极管阈值电压、发光功率、波长、色坐标等参数的影响,以评估发光二极管的抗辐射特性。
3 样品和实验
InGaN/GaN 多量子阱发光二极管采用金属有机化学气相外延生长法在蓝宝石衬底上生长。首先在C 面蓝宝石衬底上生长20nm 的低温GaN 成核层,接着生长2μm 的低温非掺GaN 缓冲层,再生长1μm 的Si 掺杂的N 型GaN 外延层(Si 元素掺杂浓度为1×1019/cm3)。接着生长50nm 厚的N 型AlGaN/GaN(Si 掺杂浓度为1×1019/cm3,Al 组分约为5%)用于调制后续GaN 的生长质量。再生长200nm 的N型GaN(Si 掺杂浓度为1×1018/cm3),此时有源区包括7 对InGaN/GaN 量子阱结构,其中InGaN 势阱宽度为3nm,GaN 势垒宽度为7nm。InGaN 量子阱中In元素组分约为20%。在量子阱形成之后紧接着生长20nm 厚的Mg 掺杂P 型AlGaN 电子阻挡层,用于提升电子空穴在量子阱中的发光复合效率(Mg 掺杂浓度为1×1020/cm3)。再生长100nm 厚的Mg 掺杂P 型GaN 用于形成PN 结(Mg 掺杂浓度为1×1020/cm3)。最后,在P 型GaN 上生长20nm 厚的非掺InGaN 盖帽层薄膜用于P 型欧姆接触制备。整个晶圆采用标准的紫外光刻和离子刻蚀等半导体标准工艺制备出发光二极管芯片,芯片面积为275μm×675μm。
高能X 射线辐射在中国科学院高能物理研究所同步辐射装置的4W1A 实验站完成。射线能量为0~50keV 的白光,剂量为0.1Mrad(Si)/s;发光二极管辐照剂量分别为1Mrad(Si)、10Mrad(Si)、33Mrad(Si)、67Mrad(Si)和100Mrad(Si)。
Si 重离子辐照在北京大学重离子加速器装置上完成。Si 重离子能量选择为30 MeV,注量率选择为1.32×108/cm2s,发光二极管注量辐照的注量分别为5×1010/cm2、5×1011/cm2、1×1012/cm2和5×1012/cm2。
发光二极管的电致发光谱采用杭州远方的白光LED 积分球(型号为ATA-1000,EVERFINE)进行测试。全部测试工作均在X 射线和Si 重离子辐照后4小时内完成。
4.结果与分析
4.1 阈值电压
InGaN/GaN 多量子阱发光二极管在电注入条件下的阈值电压(Vth)通常定义为:正向电流为20mA时的外加电压大小。Vth的大小代表着发光二极管的开启状态。一般来说,当外加正向电压小于Vth时,注入到二极管的电流非常小,二极管几乎不发光。但当外加正向电压大于Vth时,流过二极管的电流迅速增大,二极管的发光强度也迅速增大。
GaN 基发光二极管阈值电压受X 射线辐照和Si 重离子辐照后的变化情况如图1 所示。由图可以看到,Vth随X 射线剂量的增加始终维持在2.73V 左右,即使是X 射线总剂量达到了100Mrad(Si),Vth几乎没有发生变化。X 射线一般会在被辐照晶体内产生大量电子空穴对,但很少产生晶格位移效应和热峰效应,说明X 射线电离效应对InGaN/GaN 多量子阱发光二极管阈值电压等电学参数的影响很小。
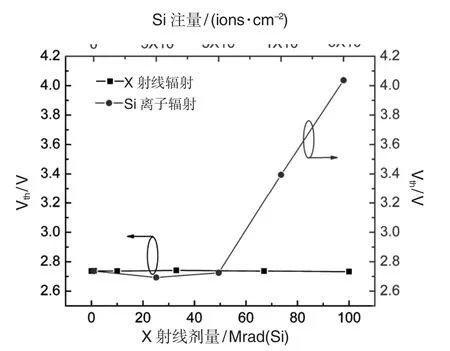
图1 X 射线和Si 重离子辐照对阈值电压的影响
图1 同样给出了GaN 基发光二极管受Si 重离子辐照前后阈值电压的变化。与X 射线辐照有很大不同,Si 重离子辐照不但可以在GaN 材料内产生电离效应,也可以产生位移效应和热峰效应。基于通过X 射线衍射、变温光致发光谱和正电子湮灭谱等方法对Si 重离子辐照的GaN 外延薄膜所做的系统化分析,发现Si 重离子辐照可以在InGaN/GaN 量子阱内因热峰效应产生In 组分局域态增强,也会因位移效应产生大量非发光复合点缺陷[13]。从图1 中阈值电压随Si 重离子注量变化可以看出,当Si 离子注量小于5×1011/cm2时,GaN 基发光二极管的阈值电压可保持在2.73V 左右;但当Si 离子注量达到1×1012/cm2和5×1012/cm2时,发光二极管的Vth分别增大到3.39V 和4.04V,二极管的伏安特性发生了明显的退化。发光二极管Vth的增加,说明当Si 离子注量达到1×1012/cm2时,组成PN 结的P 型GaN 和N型GaN 薄膜因位移损伤而发生了明显的载流子移除效应,导致了GaN 薄膜电学特性退化[14-17]。
4.2 发光功率
X 射线和Si 重离子辐照对InGaN/GaN 多量子阱发光二极管发光功率的影响如图2。二极管发光功率由积分球测得,发光功率测试为正向注入电流为200mA 时的功率。从图中可以看到,X 射线辐照下发光二极管的发光特性变化很小,说明GaN 基材料具有极高的抗高能射线电离辐射效应的能力。由其制备的光电子器件在抗电离辐射方面要明显优于Si 基和GaAs 基器件[10]。图2 同样给出了发光二极管发光功率同Si 重离子注量的关系曲线。可以看到,Si 重离子辐照后GaN 基发光二极管的发光功率明显减弱。当Si 粒子注量为5×1010/cm2时,发光功率由213mW 下降到101.8mW,相当于发光功率减半。而当Si 离子注量达到1×1012/cm2时,发光功率下降到了5mW 以下,光功率的衰减超过了97%。
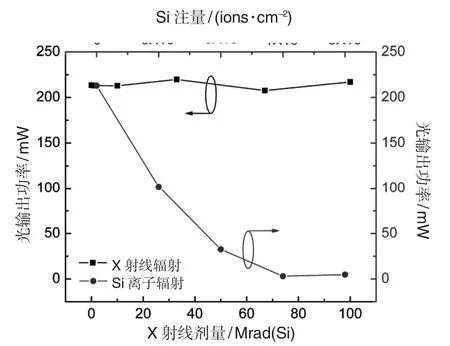
图2 X 射线和Si 重离子辐照对发光功率的影响
由分析可以看出,Si 重离子辐照对GaN 基发光二极管发光功率的影响明显强于X 射线辐照。而发光二极管发光功率的衰减一般是由于InGaN/GaN多量子阱层内非发光中心密度的增加引起的。通过与前面阈值电压的变化趋势分析可知,Si 重离子在注量为5×1010/cm2时就已经因位移效应而产生了点缺陷,并且对GaN 基发光二极管的发光功率造成了直接影响,但由于此时点缺陷密度较低,二极管的伏安特性并没有发生明显的变化。因此,通过发光功率和阈值电压变化的趋势发现Si 重离子辐照对二极管发光特性的影响要先于对电学特性的影响。
4.3 峰值波长
InGaN/GaN 多量子阱发光二极管发光峰值波长随辐照条件的变化对发光二极管在高速无线通讯系统中的信号传输有重要影响。例如,一旦发光波长因辐射效应发生了漂移,波长就有可能移动到耦合光纤的透射窗口之外,从而导致发光二极管和光纤之间耦合效率降低。另外,发光波长的变化也会对光电探测效率造成影响,引起光信息传输效率下降、传输带宽减小、信噪比恶化等问题。
图3 给出了200mA 正向电流下GaN 基发光二极管发光峰值波长随X 射线剂量和Si 重离子注量的变化曲线。对于X 射线辐照,从图中可以看出当X 射线剂量高于67Mrad(Si)时,二极管的发光波长出现了微小的红移现象(即发光波长变大,光子能量减小)。此现象可归因于X 射线电离效应在GaN 外延各层界面生成的界面态。界面态处携带的电荷可以增强InGaN/GaN 多量子阱层内的压电极化效应,从而使得量子阱内量子限制斯塔克效应更为明显,进而导致发光二极管发光波长的微小红移。
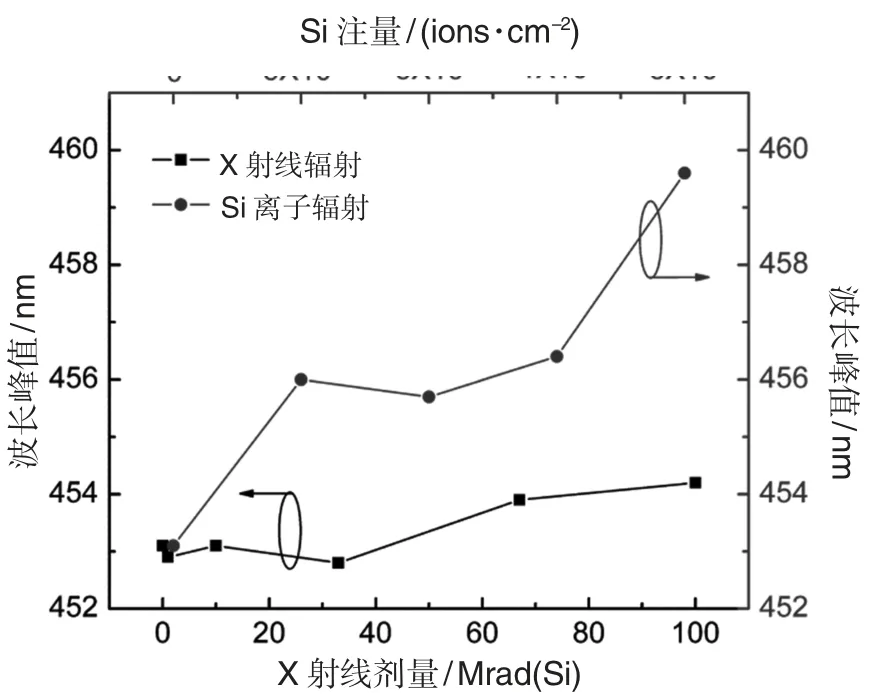
图3 X 射线和Si 重离子辐照对发光峰值波长的影响
相比于X 射线引起的波长变化,图3 中给出的Si 重离子引起的峰值波长变化峰位更为明显。通过早先研究和上述分析可知,Si 重离子辐照后的峰值波长红移主要有两方面因素引起。一个是由于Si 重离子辐照后引起了InGaN/GaN 多量子阱内In 组分局域态增强,局域态内In 组分的涨落减小了InGaN量子阱层内的带隙宽度,从而导致了发光波长的红移;另一方面,阈值电压随Si 离子注量的变化表明当Si 离子注量达到1×1012/cm2时,GaN 外延薄膜中产生了明显的载流子移除现象,N 型和P 型GaN 薄膜的电阻率变大,200mA 下PN 结发热特性变得十分明显。对于半导体材料,温度升高带隙减小,因此辐照后PN 结热效应同样导致了发光二极管发光波长的红移。综合以上因素。Si 重离子辐照引起的In组分局域态和载流子移除效应,导致了同一正向电流下比X 射线辐照更明显的发光波长红移现象。
4.4 色坐标
根据CIE 国际照明委员会的定义,发光二极管的色坐标就是指颜色在色品图中的坐标位置,以X轴和Y 轴的数值定义,其中X 代表红色在该颜色中的混合比例,Y 代表绿色在该颜色中的混合比例。色坐标对于评价一个发光二极管以及基于单色发光二极管和荧光粉制备的白光或混色发光二极管的颜色调制至关重要。二极管辐照后色坐标的偏差会导致太空舱内宇航员对颜色的判断和还原出现偏差,也会对基于GaN 基白光发光二极管的可见光通信系统造成一定影响。
图4 和图5 分别给出了GaN 基发光二极管色坐标X 分量和Y 分量随X 射线剂量和Si 重离子注量间的变化关系,正向注入电流同样取200mA。与发光波长变化趋势类似,Si 重离子引起的色坐标变化量明显大于X 射线引起的变化量。对比色坐标X分量和Y 分量的变化可以看到,当Si 重离子注量达到5×1012/cm2时,引起的X 分量变化量约为2.26%,而Y 分量的变化量约为38.49%。这说明,辐照后色坐标的Y 分量变化明显,而X 分量变化相对较小。
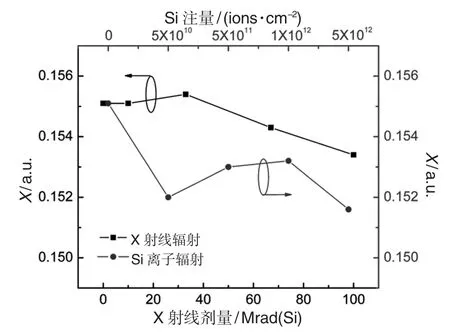
图4 X 射线和Si 重离子辐照对色坐标X 分量的影响

图5 X 射线和Si 重离子辐照对色坐标Y 分量的影响
5 结 束 语
对比研究了InGaN/GaN 多量子阱发光二极管发光和电学特性受白光光谱的X 射线和30MeV Si重离子辐照后的变化。通过对比发现,Si 重离子辐照的位移效应、热峰效应和载流子移除效应比X 射线的电离效应对发光二极管特性的影响要明显很多。在Si 重离子辐照下,发光二极管的发光特性变化明显早于电学特性的变化,说明位移效应引起的点缺陷先作为非发光中心影响发光,再作为载流子补偿中心影响GaN 外延薄膜的电阻率。宏观表现为发光二极管的发光功率先下降,然后才是阈值电压的升高。此外,Si 重离子辐照还引起了发光波长的明显红移和色坐标的偏移。波长红移机制主要是InGaN/GaN 多量子阱的In 组分局域态增强效应和大电流下PN 结的热效应。重离子辐照引起的色坐标偏移主要发生在Y 分量上。
