空间高速InGaAs-PIN光电二极管辐射损伤效应试验研究
2019-04-25冯展祖杨生胜黄新宁薛玉雄把得东
高 欣,王 俊,冯展祖,汪 伟,杨生胜,尹 飞,黄新宁,薛玉雄,把得东
(1. 真空技术与物理国家级重点实验室;2. 空间环境材料行为及评价技术国家级重点实验室;3. 兰州空间技术物理研究所:兰州 730000;4. 中国科学院 西安光学精密机械研究所 瞬态光学与光子技术国家重点实验室,西安 710119)
0 引言
高速光电探测器是空间激光通信系统的关键器件,被广泛应用在包括卫星内部以及卫星间通信的空间光通信领域。PIN光电二极管和雪崩光电二极管具有良好的灵敏度和响应特性,是目前最为常用的光电探测器,其中:雪崩光电二极管由于其内部的雪崩效应具有很高的灵敏度,但是噪声也较大;而PIN光电二极管没有内部增益,故噪声较小,信噪比很高,且由于其本征层很厚,导致耗尽区加宽,所以响应速度快;此外,随着集成电路技术的发展,PIN光电二极管探测器采用混合集成电路形式,器件之间连线短,缩小了连接线带来的信号延迟,也有利于进一步提高器件的响应速度[1]。
然而,空间高能带电粒子辐射可以使PIN光电二极管的电学和光学性能下降,影响激光通信系统的稳定性和可靠性。因此,在将光电二极管集成到光通信系统之前,评价分析其辐射损伤特征与抗辐射性能,对于保障卫星激光通信系统的稳定可靠运行是极其重要的。
空间辐射对半导体光电器件的辐射效应主要包括电离与位移损伤。电离是一种瞬时影响,会引起电子−空穴对增加与界面损伤,通常在辐射剂量低于1×105rad(Si)的情况下,不会造成光电器件的永久性损伤[2-3]。一般认为,在空间辐射环境中半导体光电二极管的性能衰退主要是由于辐射引起的位移损伤造成的[4-7]。位移损伤会使光电二极管的半导体材料晶格缺陷数量增加,缩短少数载流子的寿命。电离和位移损伤都会引起光电二极管量子效率下降,表面复合速率和复合电流增加,最终导致光电流减小与暗电流增大,影响光电二极管可探测的最小光功率。
针对可见光波段的硅基PIN光电二极管的辐射损伤效应,国内外开展了大量研究,得到了较为全面的辐射损伤数据[8-11]。但是,对于InGaAs等红外波段光电二极管,尤其是应用于空间激光通信的高性能PIN光电二极管的辐射损伤效应数据相对缺乏。本文利用质子、中子和伽马射线辐照源辐照激光通信系统拟选用的新型高速InGaAs-PIN光电二极管,并对其辐射损伤效应开展对比研究,分析电离与位移损伤对PIN光电探测器的光学和电学性能的影响。
1 试验样品
本项研究使用的近红外波段InGaAs-PIN半导体光电二极管,由中国科学院西安光学精密机械研究所研制。该光电二极管的光敏面直径100 μm,光谱响应范围800~1700 nm,工作速率5 Gbit/s。光电二极管的各项性能指标相对均衡,具有低暗电流、低电容、高量子效率以及较大的光敏面(更容易与光纤耦合),适合应用于空间激光通信系统的高速激光信号接收组件。PIN光电二极管属于平面型光电探测器,其横截面结构如图1所示:在厚350 μm的InP衬底上生长一层约1 μm厚的InP缓冲层,然后再沉积一层约2 μm厚的InGaAs本征层,其上是0.7 μm厚的InP帽层,最后是0.1 μm厚的InGaAs欧姆接触层和0.15 μm厚的SixN减反射膜。PIN器件采用TO封装结构,辐照试验前须去除金属帽与玻璃窗口,且由于试验样品性能参数存在个体差异,还要先筛选出性能参数基本一致的样品,在每一辐照条件下取3个样品进行测试,测试结果取其平均值。

图1 PIN光电二极管结构的横截面Fig. 1 Cross section of the structure of the PIN photodiode
2 试验方案
2.1 辐照方案
利用兰州空间技术物理研究所的双束加速器与60Co-γ射线源开展光电器件的质子和伽马射线辐照试验;利用中国原子能科学研究院的中子辐射源开展中子辐照试验。辐照试验时,样品放置在铝金属样品台上,并使器件各引脚处于短路状态,以防止辐照过程中的静电放电对器件造成损伤。所有器件在室温条件下进行辐照试验,以便最小化热退火效应。分别利用2 MeV质子、14 MeV中子和60Co-γ射线源开展PIN光电二极管辐照试验:质子辐照注量为 6.0×1011、1.2×1012和 2.2×1012p/cm2;中子辐照注量为 1.35×1012、2.92×1012、5.00×1012n/cm2;60Co-γ射线辐照剂量为 9.40×104、2.48×105和 7.20×105rad(Si)。质子辐照试验在真空条件下进行,真空度优于10-3Pa;中子和伽马射线辐照试验在大气环境下进行。
2.2 测试方案
当达到特定的辐照注量或剂量后,立即取出样品(除了中子辐照后需要放置24 h去活化)进行光电性能参数测试,以便比较辐照前后光电器件的性能参数变化情况。性能参数测试在室温条件下进行,使用Keithley 4200A-SCS半导体参数测试仪对光电器件的I−V和C−V特性参数进行测试,测试时样品放置于屏蔽箱中,以防止外部电磁和光的干扰。本研究设计了一套具备精密对准机构的特殊夹具平台,包含一套准直透镜系统,用于控制激光束斑在光电探测器上的尺寸和位置,以使激光器与外部连接光功率计的光电探测器之间能够保持精确对准,保证所有激光辐射都能够被探测器捕获。
3 辐射剂量分析
利用GEANT4辐射输运工具箱模拟分析质子、中子和伽马射线在InGaAS-PIN光电二极管各层材料中沉积的辐射剂量,模拟结果如图2和图3所示。由于2 MeV质子不能完全穿透PIN器件的InP衬底(350 μm厚),所以模拟给出的质子在衬底中的沉积剂量取其在衬底表面10 μm内的沉积剂量;而中子沉积剂量为其在整个衬底中的沉积剂量。比较图中不同辐射源在本征层(I层,吸收绝大部分光信号,并产生电子−空穴对)沉积的剂量,可以看出:注量为6.0×1011p/cm2的质子在I层沉积的电离总剂量约为7.09×105rad(Si),接近60Co-γ射线的辐照剂量(7.20×105rad(Si));并且其沉积的位移损伤剂量约为2.05×1010MeV/g,与注量为5.0×1012n/cm2的中子所沉积的位移损伤剂量(约1.89×1010MeV/g)也较接近。
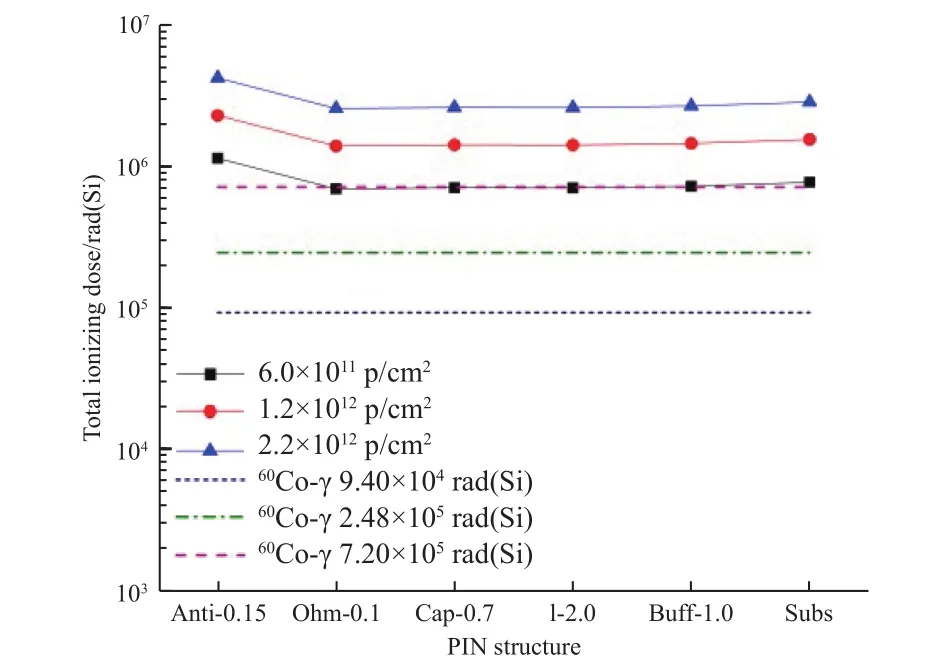
图2 质子和伽马射线在PIN光电二极管各层结构中沉积的电离总剂量Fig. 2 Total ionizing doses deposited by proton and γ ray in different layers of the PIN photodiodes

图3 质子和中子在PIN光电二极管各层结构中沉积的位移损伤剂量Fig. 3 The displacement damage doses deposited by proton and neutron in different layers of the PIN photodiodes
4 试验结果与分析
4.1 暗电流
InGaAs-PIN光电二极管在高速光通信系统中用作接收机的光探测器,其功能特点主要是宽带(覆盖高频段)和高灵敏度。为了获得高灵敏度的激光信号探测能力,PIN光电二极管必须有很小的暗电流和电容[11]。图4给出的是辐照前后PIN光电二极管的暗电流随反向偏压的变化情况。反偏状态下的PIN暗电流主要由3部分构成:1)体内由热激发产生的少数载流子扩散电流;2)耗尽区中热发射载流子的产生复合电流;3)表面漏电流,主要与表面缺陷、清洁度、偏置电压、表面面积等因素有关。图4结果显示,辐照后PIN光电二极管的暗电流显著增加,并且质子辐照后的暗电流比伽马射线辐照后的暗电流大3~4个数量级,中子辐照后的结果介于前两者之间。因此,质子和中子辐照后,PIN光电二极管可探测的最小光功率也会显著增大,影响器件性能。

图4 质子、中子和伽马射线辐照后PIN光电二极管的暗电流衰退特征曲线Fig. 4 Degradation characteristics of the PIN photodiodes'dark current under proton, neutron and gamma irradiations
分析认为质子和中子造成PIN光电二极管更严重的辐射损伤主要是位移损伤引起的:质子和中子与InGaAs本征层的晶格原子发生弹性碰撞,产生空位−间隙原子对,从而在禁带中产生各种缺陷能级;缺陷能级作为复合中心,使得本征层耗尽区中的少数载流子寿命缩短;而耗尽区势垒的产生复合电流与载流子寿命成反比,导致非辐射复合电流增大[12]。从图4还可以看出,随着反偏电压的增大,暗电流曲线逐渐变得平坦并趋于饱和。这主要是由于辐射引入的缺陷逐渐被电荷占据,产生复合电流趋向饱和状态。从暗电流随反偏电压增大至逐渐饱和的过程可以得出,在所加偏压范围内没有发生缺陷辅助的隧道效应(trap-assisted tunneling)——
该效应下随着辐照剂量的增加,缺陷密度进一步增大,缺陷辅助的隧道电流将成为暗电流的重要来源,暗电流将会急剧上升,饱和趋势被破坏[13-14]。图5和图6分别给出在不同反向偏压条件下
(5、12、15 V),暗电流随中子和质子在器件源区沉积的位移损伤剂量的变化。可以看出:暗电流随位移损伤剂量的增加而增大;暗电流与中子位移损伤剂量基本成线性关系;然而随着反向偏压增大,暗电流与质子位移损伤剂量逐渐偏离线性关系,且曲线斜率明显大于中子辐照下的情况,这可能是由于质子沉积的电离辐射在本征层界面处产生正电荷俘获和界面态,这种表面电荷会缩短少数载流子的寿命,也可以增加载流子表面复合速度,从而进一步增大漏电流,当电离总剂量足够高时甚至可在器件表面形成漏电通道。
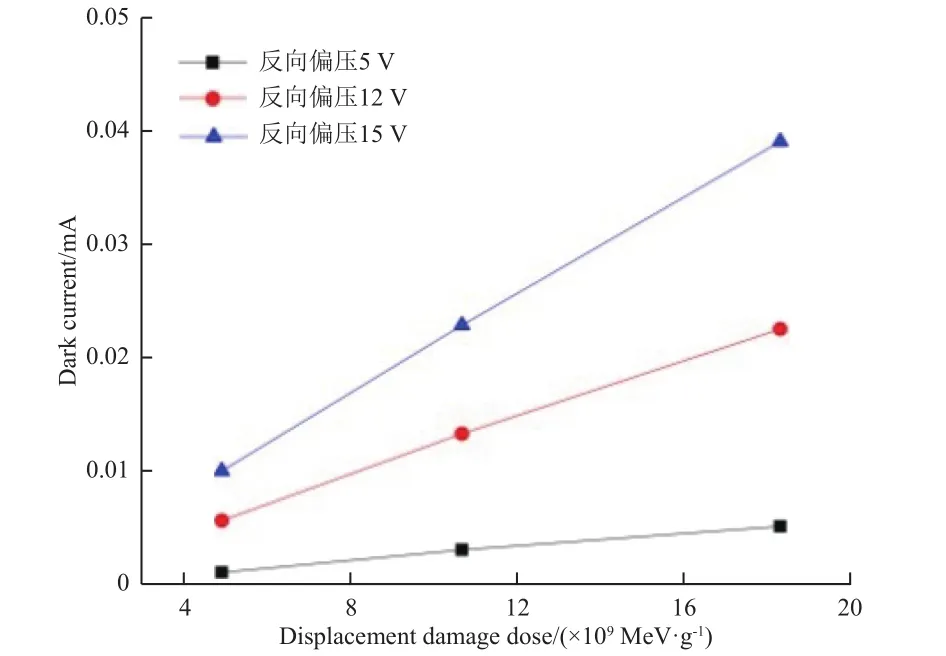
图5 不同反向偏压下PIN光电二极管暗电流随中子位移损伤剂量变化Fig. 5 Dark current of the PIN photodiodes vs. the displacement damage dose of neutrons at different reversed bias voltages

图6 不同反向偏压下PIN光电二极管暗电流随质子位移损伤剂量变化Fig. 6 Dark current of the PIN photodiodes vs. the displacement damage dose of protons at different reversed bias voltages
4.2 光电流
图7~图9给出在10 V反向偏压下,质子、中子和伽马射线辐照前后PIN光电二极管的输出光电流随波长为1550 nm的入射光功率的变化。其中的光电流数据为电流表实测数值,并未扣除器件的暗电流部分。可以看到:除了图7中能量为2 MeV、注量为2.2×1012p/cm2的质子辐照后光电流变化曲线,其余曲线基本呈现线性变化趋势,即光电流与入射光功率基本成正比关系(在探测器饱和前);并且,在同样的入射光功率条件下,质子辐照后的光电流最大,而伽马射线辐照后的光电流最小。这是由于PIN光电二极管在质子辐照后的暗电流远远大于伽马射线辐照后的暗电流,增加的光电流叠加在暗电流之上,造成质子辐照后的光电流变得非常大。

图7 质子(2 MeV)辐照前后PIN光电二极管的光电流随入射光(λ=1550 nm)功率的变化Fig. 7 The changes of the PIN photodiodes' photo current against the input light(λ=1550 nm) power before and after proton(2 MeV) irradiations

图8 中子(14 MeV)辐照前后PIN光电二极管的光电流随入射光(λ=1550 nm)功率的变化Fig. 8 The changes of the PIN photodiodes' photo current against the input light(λ=1550 nm) power before and after neutron(14 MeV) irradiations

图9 伽马射线辐照前后PIN光电二极管的光电流随入射光(λ=1550 nm)功率的变化Fig. 9 The changes of the PIN photodiodes' photo current against the light power(λ=1550 nm) before and after 60Co-γ irradiations
对3种辐射源辐照前后的光电流曲线进行线性拟合,获得光电流曲线的斜率(见表1),可以看出不同辐射源辐照前后的PIN光电二极管的光电流曲线斜率基本相同,表明单位入射光功率产生近似等量的光电流,也就是说辐照对于PIN光电二极管的光电流影响不大。
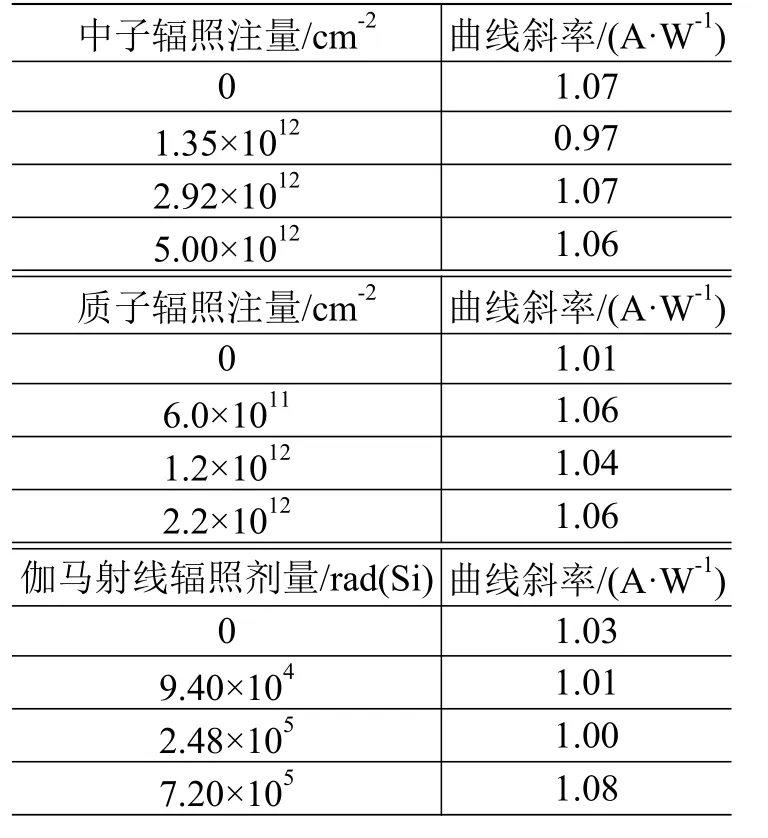
表1 PIN光电二极管在不同辐射源辐照前后光电流曲线斜率变化Table 1 The slopes of the PIN's photo current curve before and after irradiations by different radiation sources
4.3 光谱响应
图10~图12给出在10 V反向偏压下,质子、中子和伽马射线辐照前后,在850~1650 nm波段范围,PIN光电二极管的光谱响应。

图10 质子(2 MeV)辐照前后PIN光电二极管在 850~1650 nm波段光谱响应度Fig. 10 The responsivity of the PIN photodiodes to 800~1650 nm input light before and after proton(2 MeV)irradiations
光谱响应度是光电探测器的响应电流与光辐射通量的比值,一般利用单色光源入射到探测器上,然后测量探测器的响应电流而获得。图10~图12中不同波长入射光产生的光电流已经扣除了相应的暗电流部分,可以看出:在InGaAs-PIN光电二极管的光谱响应范围下限附近,二极管的光谱响应极微弱,质子和中子辐照后,在850 nm波长处,光电流非常微弱至无法与暗电流区分开来,因此图10和图11均未给出850 nm处的光谱响应数据;除质子辐照后光谱响应度有较明显的变化外,中子和伽马射线辐照对PIN光电二极管的光谱响应度影响很小,与辐照对光电流的影响结果基本一致。

图11 中子(14 MeV)辐照前后PIN光电二极管在850~1650 nm波段光谱响应度Fig. 11 The responsivity of the PIN photodiodes to 800~1650 nm input light before and after neutron(14 MeV) irradiations
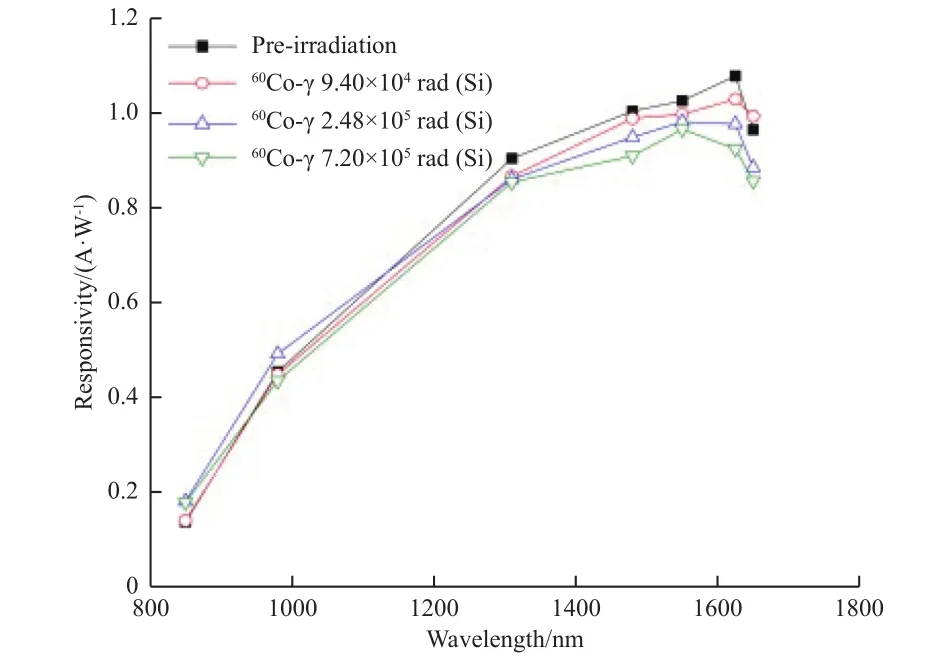
图12 伽马射线辐照前后PIN光电二极管在850~1650 nm波段光谱响应度Fig. 12 The responsivity of the PIN photodiodes to 800~1650 nm input light before and after 60Co-γ irradiations
4.4 C-V 特性
图13和图14给出不同辐射源辐照前后PIN光电二极管反向电容−电压(C−V)特征曲线,测量频率分别为1 MHz和10 MHz。曲线分为高电容区和低电容区,分别对应的是沟道累积态和耗尽态。
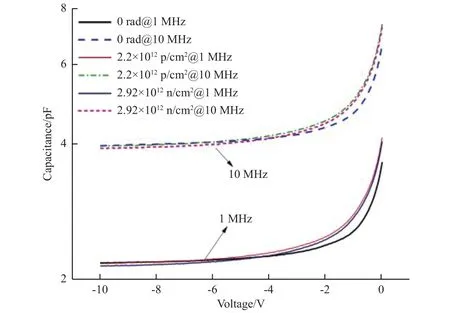
图13 PIN光电二极管在质子、中子辐照前后的C−V特征曲线Fig. 13 The C-V characteristics of the PIN photodiodes before and after proton and neutron irradiations
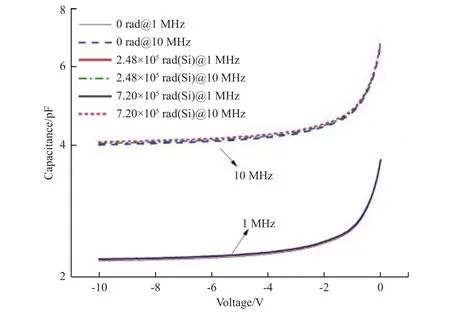
图14 PIN光电二极管在伽马射线辐照前后的C−V特征曲线Fig. 14 The C-V characteristics of the PIN photodiodes before and after 60Co-γ irradiation
由图13可以看出,测量频率为1 MHz时,质子和中子辐照后,在0 V偏压下沟道累积区的电容从3.63 pF增加到4.13 pF;当反偏电压增加到5 V以上,质子和中子辐照后的C−V特征曲线将会与辐照前的C−V曲线重叠成同一条曲线,并且电容基本不再发生变化,接近2.21 pF的恒定值。这是由于随着反偏电压的增大,辐照引入的缺陷基本被电荷占据,产生复合电流趋向饱和,耗尽区宽度接近最大值,从而PIN器件电容趋于最小值,这与随着反偏电压增大暗电流趋向饱和的机理是一致的。
由图14可以看出,伽马射线辐照后,InGaAs-PIN光电二极管的电容基本没有发生变化,这与Si-PIN光电二极管的伽马射线辐照结果一致[11]。
电容增大将会恶化PIN光电二极管的带宽特性和响应速度,导致在轨激光通信系统的光信号探测能力下降,因此,在空间辐射环境下保持PIN二极管相对较小的电容是非常重要的。
5 结束语
本文利用质子、中子和伽马射线对InGaAs-PIN光电二极管开展辐照试验,以评估器件在空间激光通信系统中使用的稳定性和可靠性。结果表明,辐照后,InGaAs-PIN光电二极管暗电流显著增大,质子辐照后的暗电流比伽马射线辐照后的大3~4个数量级。PIN光电二极管的辐射损伤主要决定于质子和中子辐射造成的位移损伤影响:暗电流随位移损伤剂量的增加而增大,与中子位移损伤剂量基本成线性关系,而随质子位移损伤剂量变化曲线的斜率明显大于随中子位移损伤剂量变化曲线的,这可能是由于质子沉积了较多的电离总剂量而进一步增大了器件的暗电流。其他测试结果表明:质子、中子和伽马射线辐照对PIN光电二极管的光电流、光谱响应度以及C−V特性的影响均较小。可见,辐照主要是对PIN光电二极管的暗电流产生严重影响,将会使PIN二极管可探测的最小光功率增大,从而降低卫星激光通信系统的灵敏度。
上述研究结果可为空间辐射环境中使用光电器件的结构设计与抗辐射加固设计提供参考数据,以提高卫星激光通信系统的稳定性与可靠性。
