锗(Ge)材料中砷(As)离子注入掺杂和退火激活的实验研究*
2019-02-27许金铃陈城钊詹镇业陈佳仪王久川曾锦城陈景乐
许金铃,陈城钊,詹镇业,陈佳仪,王久川,曾锦城,陈景乐
韩山师范学院 物理与电子工程学院,广东 潮州 521041
锗(Ge)材料由于具有高的电子和空穴迁移率,而且在通信波段有较高的吸收系数,近年来基于Ge 材料的高速微电子及光电器件受到了广泛关注[1-3].目前,体锗单晶材料的工业制备工艺臻于成熟,为锗相关器件的应用奠定了基础.此外,Ge材料的工艺与成熟的Si CMOS工艺基本兼容,因此锗器件在硅基光电集成方面的应用是非常有吸引力的.对于锗光电器件的制备,材料掺杂仍是一个关键问题,其中原位掺杂和离子注入是Ge材料常用的两种掺杂手段.原位掺杂虽然引入的位错比离子注入的低,但是原位掺杂对生长的条件要求比较苛刻,不易获得高掺杂浓度,且不易形成平整的表面;对于离子注入方法,如何在锗中形成高的n型杂质激活浓度及n型浅结,同时避免掺杂损耗仍是目前研究的重点及难点.
近年来,实验上也通过采取不同的退火激活条件来改善掺杂原子的扩散问题[4-6].目前对于n型掺杂原子的激活,主要有两种退火方式:快速热退火及激光退火.由于激光退火的退火时间很短,只有几个纳秒,因此掺杂杂质的扩散得到了有效的控制,能形成很浅的结深.新加坡的Jidong Huang等人[7]和韩国的Sungho Heo小组[8]都采用激光退火实现了n+/p-Ge浅结,其中Sungho Heo等人通过低能PH3等离子注入,结合KrF准分子激光退火,在Ge中实现了超浅的n+/p结,结深仅为15 nm.尽管扩散问题通过激光退火方式能够得到改善,但由于激光能量不均匀,使不同区域的激活效果存在差异性,因此激光退火比较适合小范围的掺杂激活.本文主要研究离子注入砷(As)在体锗(Ge)片中的掺杂扩散及快速热退火激活的情况.
1 试验部分
1.1 样品制备
注入样品为Ge (100)晶片,电阻率为1.1~1.3 Ω·cm.注入前先用PECVD在Ge表面生长一薄层SiO2,约15 nm,作为注入保护层.砷离子注入能量为17 keV,注入剂量为4×1015cm-2,注入时离子束偏离样品表面7 °,以减小沟道效应.已离子注入的Ge片在退火前,先将注入时表层的SiO2用稀释HF腐蚀掉,重新用PECVD在不同样品表面分别生长150 nm的SiO2,以防止退火过程中Ge表面被氧化以及掺杂离子从样品表面扩散出去,待退火完成后再去除.三组样品分别标记为样品组A,B和C,每组样品都进行RTA退火,退火温度分别为650,675和700 ℃,对应退火时间分别为8,5和3 s.
1.2 测试方法
采用JobinYvon Horiba HR800型微区Raman光谱仪对样品进行结构表征,激发光源为488 nm的Ar+激光.测试在室温下进行,拉曼散射峰位通过洛伦兹拟合获得.分别对样品A,B和C进行二次离子质谱(SIMS)分析,得到各自的As浓度分布.通过扩展电阻测试(SRP)和四探针测试,获得样品的载流子浓度和方块电阻.
2 试验结果与讨论
2.1 Raman分析
图 1为未注入、As注入和退火As注入Ge衬底的拉曼光谱.图1 (a)为各样品的Raman测试结果,从图1(a)可见,单晶Ge-Ge峰位于300 cm-1处.图1 (b)是注入前后Ge片的拉曼谱,从图1 (b)可以明显看出,刚注入的样品出现了非晶Ge的信号峰,约在270 cm-1处,说明砷注入对Ge晶格产生了严重的损伤,在表层注入区,Ge材料已变成了非晶体.图1(c)为三组样品测得的单晶Ge峰半高宽,从图1(c)可见:经过RTA退火后,单晶Ge峰重新出现,表明晶格损伤已基本完成修复;在经过650 ℃ 退火后,Ge峰半高宽仅为4.84 cm-1,说明注入引起的损伤已基本消除,晶体质量已恢复到注入前的状态.

图1 未注入、As注入和退火砷注入Ge衬底的拉曼光谱 (a)各样品的Raman光谱图;(b) As离子注入前后样品的Raman图;(c)单晶Ge峰的半高宽随退火的变化Fig.1 Raman spectra of unimplanted, as-implanted, and annealed arsenic-implanted Ge substrates(a) raman spectra of three kinds of samples;(b) raman spectra of unimplanted and as-implanted Ge substrates;(c) FWHM of the Ge peak of raman spectra of as-implanted and annealed arsenic-implanted Ge substrates VS annealing temperatures
2.2 SIMS和SRP分析
图2为Ge片注入As+未退火及经不同条件退火后的SIMS图(a)和SRP图(b),其中图2(a)为Ge片中注入As+离子后未退火及经过不同条件退火后的SIMS图,图2(b)为利用扩展电阻剖面分步法测到的退火后三个样品的载流子浓度纵向分布图.从图2(a)可以看到,刚注入样品的砷浓度峰值为6.93×1020cm-3.当退火温度从650 ℃增加到700 ℃时,在近表面处逐渐出现更高的扩散As浓度分布,说明此处As的扩散明显增强,同时扩散尾部的浓度值也变大了,扩散不断深入Ge内部,不过700 ℃退火的样品,其n-i结的界线更为陡峭.另外,根据SIMS测试曲线,得到退火后三个样品的结深Xj(一般指As浓度降低到1×1018cm-3的位置)分别为180,230和260 nm.在距表面300 nm之下砷浓度值均低于1×1017cm-3,已基本满足PIN器件n型掺杂的要求.从图2(b)可以看到,跟与SIMS的结果相对应,当退火温度从650 ℃增加到700 ℃时,在近表面200 nm处出现高达3.14×1019cm-3的扩散As浓度分布,说明温度升高,样品中As的扩散明显增强,同时扩散不断深入Ge内部,得到了很好的热激活.
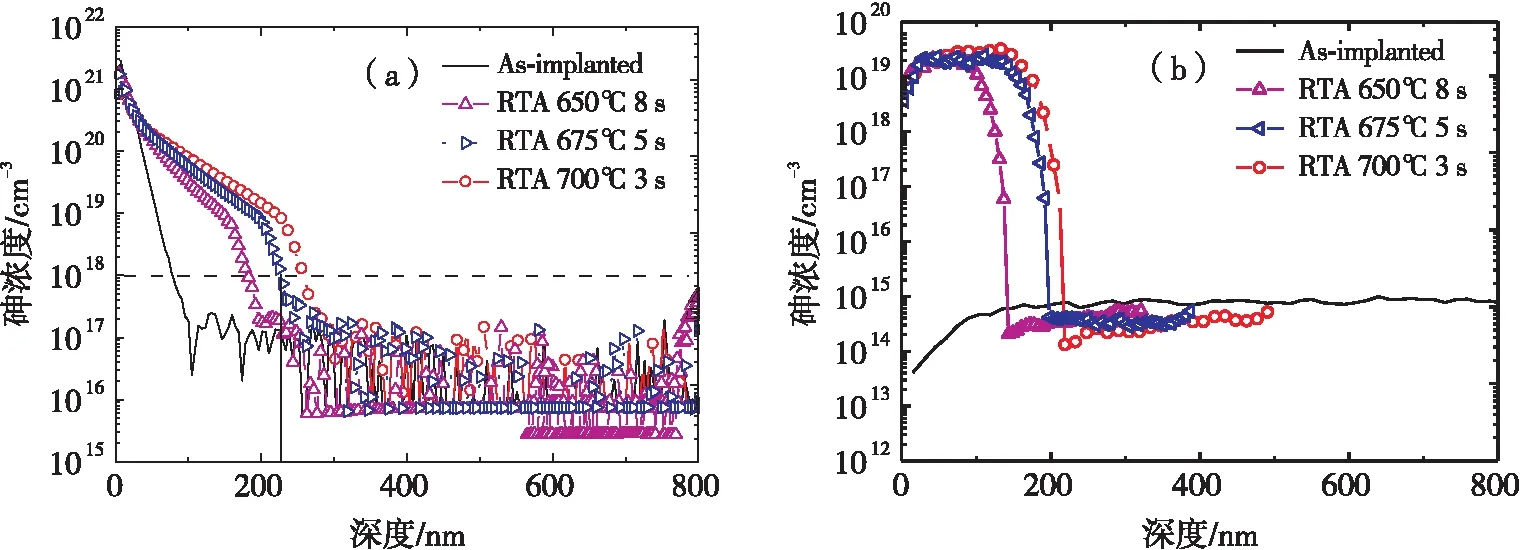
图2 Ge片注入As+未退火及经不同条件退火后的SIMS图(a)和SRP图(b)Fig.2 SIMS(a) and SRP(b) depth profiles of the as-implanted and annealed arsenic-implanted Ge substrates
2.3 方块电阻分析
图3为利用四探针测试得到的样品的方块电阻,其中0 ℃对应数据表示未注入和已注入未退火样品的方块电阻值.从图3可以看到,离子注入和退火对样品的方块电阻有明显的影响,说明注入及退火过程中样品的电学特性发生了变化.注入前Ge片方块电阻约为151.9 Ω/sq,注入后方块电阻增大到163.4 Ω/sq.这主要是由于离子注入对Ge晶格造成损伤,在内部形成大量缺陷,使材料迁移率减小,从而导致注入后的Ge片方块电阻变大.退火后,当退火温度从650 ℃增加到700 ℃时,Ge的方块电阻从108.8 Ω/sq逐渐降低到74.4 Ω/sq和63.1 Ω/sq.这是由于退火后砷离子被激活,使载流子浓度增加;另一方面,退火修复了注入的晶格损伤,这两个因素都促使电阻逐渐降低.

图3 Ge片注入As+离子后方块电阻随退火温度的变化情况Fig.3 The sheet resistance of unimplanted, as-implanted, and annealed arsenic-implanted Ge substrates
3 结 论
在Ge衬底中进行了砷离子注入后,采用快速退火工艺对其进行退火处理.主要研究了离子注入As在Ge衬底中的扩散和激活情况,实验结果表明,利用离子注入和快速热退火处理可以获得优质的n型锗材料,快速退火能修复离子注入损伤以及激活杂质离子,其中在700 ℃和3 s退火条件下,样品中电学载流子浓度约为3.14×1019cm-3,方块电阻为63.5 Ω/sq.
