铁电存储器中高能质子引发的单粒子功能中断效应实验研究∗
2018-12-14琚安安郭红霞张凤祁郭维新欧阳晓平魏佳男罗尹虹钟向丽李波秦丽
琚安安 郭红霞† 张凤祁 郭维新 欧阳晓平 魏佳男罗尹虹 钟向丽 李波 秦丽
1)(湘潭大学材料科学与工程学院,湘潭 411105)
2)(西北核技术研究所,西安 710024)
3)(西安交通大学核科学与技术学院,西安 710049)
(2018年6月24日收到;2018年8月29日收到修改稿)
1 引 言
1.1 铁电存储器的抗辐照背景
铁电存储器(ferroelectric random access memory,FRAM)作为新型半导体存储器中的一种,与传统的随机存储器(random access memory,RAM)不同之处在于断电后能继续保持数据.它与市场上的静态随机存储器(static random access memory,SRAM)可以实现替换,可以说是SRAM和FLASH存储器最好工艺的结合[1].相较于Flash,FRAM具有更高的读写次数,更快的读写速度以及超低的功耗[2].FRAM具有高达10万亿次的读写循环,是标准电可擦可编程只读存储器(electrically erasable programmable read-only memory,EEPROM)的100万倍,写入速度为EEPROM的76倍,而功耗却只有EEPROM的3%.FRAM的工艺由铁电薄膜技术与互补金属氧化物半导体(complementary metal oxide semiconductor,CMOS)工艺结合而成,采用具有自发极化特性的钙钛矿材料作为存储介质[3−6],使得存储单元不受辐射环境中产生电荷波动的影响,从而具有优良的抗辐照性能[7,8].所有的这些优点使得FRAM自诞生之日起就在航天航空应用领域成为热门.
在国内,FRAM重离子单粒子效应的相关研究已经开展.辜科等[9,10]对1 M的FRAM进行了不同种类重离子的实验研究,得到了该器件发生单粒子翻转(single event upset,SEU)的线性能量传递(linear energy transfer,LET)阈值和单粒子翻转截面以及发生单粒子闩锁的LET值并利用TCAD工具对存储单元的翻转进行了仿真;Zhang等[11]对一款4 M商用FRAM进行了重离子辐照,发现了至少六种单粒子效应,并确定是由外围电路的异常造成的.
在复杂的空间辐射环境中,质子分布广泛并占据很大的比例,如宇宙射线中80%为高能质子,太阳风中95%是质子,极光辐射和范·艾伦辐射带的内带中也存在着大量质子[12].因此,对质子源引发的单粒子效应进行实验研究具有重要的意义.由于之前国内并无中高能质子加速器,所以目前国内对于FRAM质子单粒子效应方面的研究仍处于空白.直到近年来中国原子能科学研究院的中高能质子加速器成功出束,这方面的工作才得以开展.
1.2 国外的工作
2008年NASA在印第安纳大学对型号同为FM22L16的商用FRAM进行了地面质子辐照测试,发现了两种单粒子效应:单粒子翻转(SEU)和单粒子功能中断(single event function interrupt,SEFI),并得到了图1所示的SEU翻转截面随质子能量变化的趋势[13],但是并未对SEFI现象进行深入分析.2010年2月,NASA在首颗快速、经济可承受科学技术卫星(fast and af f ordable science and technology satellite,FASTSAT)上搭载一款商用FRAM进行在轨测试(辐照环境主要是质子),在一年的在轨测试时间内并未发现有单个或多个字节的翻转[14].作为新型非易失性存储器,FRAM在质子辐照下发生的单粒子效应也与传统SRAM有所不同:SRAM在相同能量质子辐照下会产生SEU[15,16],而FRAM则会产生SEU和SEFI.对比NASA的地面质子辐照测试,发现实验现象一致,但NASA对于FRAM的SEFI的研究并未深入.在实验中我们发现,SEFI出现的频率较高(如图4所示),甚至器件的失效是由SEFI引起的.所以SEFI对FRAM在质子辐照环境下正常工作状态造成的影响不可忽视,本文使用100 MeV以下的质子束流对FRAM的SEFI进行了实验.

图1 不同质子能量下FRAM SEU翻转截面[13]Fig.1 .SEU cross section of FRAM verses dif f erent proton energy[13].
2 实 验
2.1 实验器件及设备
本实验选用两款产自Cypress公司的商用FRAM,型号为FM28V100和FM22L16,它们的特征尺寸分别为90 nm和130 nm,容量为1 M和4 M,后者的存储单元工艺结构为2T2C,前者未知.实验平台采用中国原子能科学研究院自主研发的100 MeV质子回旋加速器,如图2所示.它可以产生100 MeV以下的质子束流,利用降能片来实现能量的降低,通过法拉第筒进行注量率的测量,二次电子监督器对注量进行束流监督.通过束流诊断,确定中子质子比小于千分之一,束流的空间均匀性大于75%.这样的质子束流可以认为是稳定可靠的,并且能够满足本实验的要求.实验中选择90,70,50和30 MeV的质子能量,实际注量率为6.9×106p/(cm2·s).由于FRAM的累计失效剂量高达280 K·rad(Si)以上[17,18],辐照过程中每只器件所接受的质子总剂量远远小于失效累计剂量的80%,可以忽略总剂量效应对本实验的影响.

图2 中国原子能科学研究院100 MeV质子回旋加速器Fig.2 .100 MeV proton cyclotron of China institute of atomic energy.
2.2 测试系统
实验所用的测试系统如图3所示,测试板由ARM(advanced RISC machine)模块,FPGA(f i eld-programmable gate array)模块及电源模块组成.ARM模块接收上位机发送的配置信息及测试命令,并将这些命令解析后发送给FPGA模块,FPGA模块输出存储器的控制时序,通过I/O接口将操作命令及控制时序信息传递给器件,对器件进行存取操作.器件读出的信息通过I/O口反馈给FPGA模块,FPGA模块分析比较器件是否发生了效应并记录这些数据,依次传递给ARM模块和上位机,使其显示并存储这些信息.
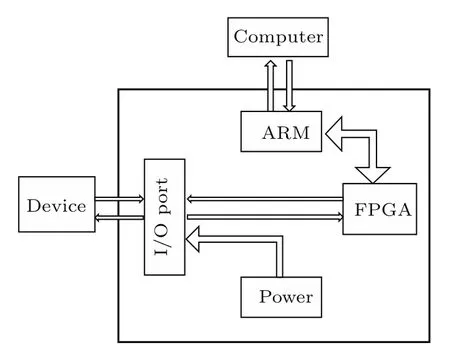
图3 FRAM测试系统示意图Fig.3 .Illustration of FRAM testing system.
在上述能量点下,根据器件的数据位数,分别向FRAM中填入棋盘式数据格式55或5555,然后在质子束流辐照的过程中对器件进行动态和静态的测试.动态测试通过测试系统在质子辐照过程中实时地从FRAM中读出数据,并和之前写入的棋盘式数据进行比较来判断是否发生了数据错误.静态测试在质子辐照过程中不进行读出操作,辐照结束后才开始读出数据判断是否发生了单粒子效应(single event ef f ect,SEE).
2.3 实验结果与分析
在上述参数的束流辐照下,FM28V100型FRAM未观察到任何单粒子效应,但是FM22L16型FRAM在辐照过程中发生了一些单粒子效应:当质子束流打开时,测试系统立刻监测到大量的瞬态错误,这些错误每隔几个周期会短暂消失,接着又重新出现(如图4所示),束流停止后器件中留下极少甚至是没有留下错误.将这个过程中发生的SEE详细地分为4种,如表1所列.
动态测试中当质子注量累计较低时,器件发生软SEFI,SEU和多位翻转 (multiple-bit-upset,MBU)效应,而随着注量累计增加,器件发生了硬SEFI效应,无法读出器件的SEU和MBU信息,此时断电操作不能使器件恢复正常,视为器件发生了失效.在静态测试过程中,累计注量低时未检测到SEE,累计注量高时,发现了硬SEFI效应.在两个月后对器件进行加电测试,所有发生硬SEFI的FRAM功能恢复正常,此时可以读出器件的SEU与MBU信息.

图4 FRAM在质子辐照过程中的SEFI现象Fig.4 .SEFI phenomenon of FRAM using proton irradiation.
功能中断截面计算公式为

其中δ为功能中断截面;n为功能中断发生时测试系统回读的错误个数;Φ为质子的注量.
根据上述公式计算出功能中断截面并进行比较,发现由SEFI造成的错误截面随着质子能量的增加而增加,如图5所示(由于多只器件的失效,未能准确给出30 MeV能量下的截面数据).

表1 FRAM在质子辐照过程出现中的SEETable 1 .SEE happened using proton irradiation for FRAM.

图5 FRAM的SEFI截面随质子能量的变化Fig.5 .FRAM SEFI cross section verses dif f erent proton energy.
2.4 SEFI效应机理探索
该实验中,器件SEFI效应在质子辐照环境下出现的频率较高,并且硬SEFI导致FRAM失效.SEFI对FRAM造成的影响不可忽视.为了更进一步地探索FRAM中的SEFI敏感区,使用西北核技术研究所的脉冲激光单粒子模拟装置对FM22L16存储器进行实验,使用波长为1064 nm的激光脉冲,对器件的版图从背部进行全面扫描[19].如图6所示,从版图左下角每隔25µm入射一个激光脉冲,每秒入射两个脉冲,激光的能量为5 nJ,一直到版图的右上角结束.在激光扫描的过程中对FRAM预先写入数据再进行动态的回读测试,并同时观察测试过程中是否会出现错误,一旦有SEFI效应发生,立刻停止激光扫描,并记录下该点坐标,然后继续测试.
结果发现激光脉冲在器件的整个外围电路中扫描(图6中A,B区域)均能够引起SEU效应,存储阵列C区内的激光脉冲不能引发任何单粒子效应,能够引发SEFI效应的区域只有在外围电路中的某一块区域,如图6中B区红点所示.需要指出的是,脉冲激光的直径远远小于图中红点的直径,红点表示SEFI敏感区所在的范围,并非单一点.另外当激光能量小于5 nJ时,可被监测的敏感点个数减少,而激光能量大于5 nJ时,可被监测的敏感点个数增加.在FRAM的电源输出端串联一个100 Ω的分压电阻,利用高频示波器监测波形,结果发现在使用激光微束造成器件SEE时,伴随着每次SEFI的发生,器件的电源输出端都能捕捉到一个微电流的产生(如图7所示),并且在该SEFI过程中的所有出错地址均是连续的.
显然FRAM的外围电路才是其SEE敏感区,而红点所在区域是器件SEFI敏感区.FRAM的外围电路基于传统的CMOS工艺加工而成,而集成电路中CMOS工艺易受辐射环境的影响[20−22],特别是缓存器和寄存器,受到辐射环境的影响会导致短暂的读写错误,甚至是功能中断[23].图8(a)所示是一个简化的可控硅电路原理图,Vdd和Vss通过寄生电阻分别与PNP和NPN双极管的基极相连,寄生电阻的存在使其通常保持在关闭的状态,但是当任何一个双极管基极的偏置增加时,电路中流动的电流会增大.一旦双极管的电流增益大于1,电路中的电流再生,直到两个双极管饱和,此时由于流过可控硅结构的电流过大,实际上改变了硅的有效掺杂状态,使其阻值变低[24].

图6 FM22L16 FRAM中的SEFI敏感区域Fig.6 .SEFI Sensitivity area of FM22L16 FRAM.

图7 伴随SEFI效应产生的电流波Fig.7 .Electric wave of FRAM accompanied with SEFI.
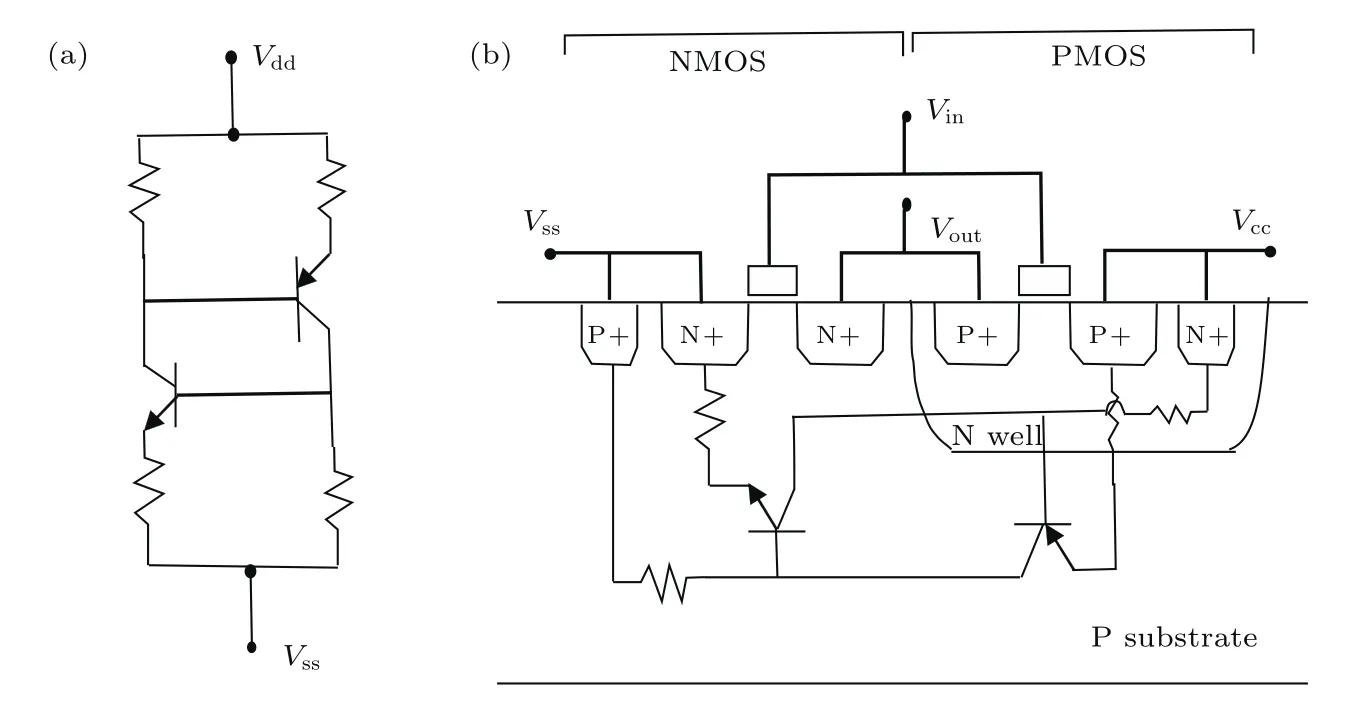
图8 (a)电子电路中寄生的可控硅结构;(b)简化的可控硅原理图Fig.8 .(a)Silicon controlled rectif i er parasitic in digital circuits;(b)simplif i ed silicon controlled rectif i er .
在本实验的辐射环境中,质子带一个单位的正电荷,由于其原子质量很轻,所以在物质中的穿透能力较强.当能量低于3 MeV的质子入射到电子器件中时,会通过直接电离的方式在硅中沉积出电子-空穴对,改变电子器件的逻辑或工作状态,这在纳米级尺寸的器件中表现较为突出[16].而本实验选择的中高能质子穿透器件时,库仑力对质子的阻碍能力减弱,此时质子主要与材料物质发生核反应生成重离子和其他次级粒子,重离子带有更多单位的正电荷,并且原子质量较重,穿透能力较弱,会在相对较短的路径中通过直接电离的方式,产生电子-空穴对.而对激光脉冲而言,激光入射器件时,光子被材料吸收,沿着其入射方向电离出电子-空穴对[25],这与低能质子及重离子的直接电离过程十分相似.
辐照环境产生的载流子的积累会使得CMOS工艺中的可控硅结构打开,图8(b)所示为电子电路中的可控硅结构示意图,电子空穴对在衬底中被Vss至Vcc的内部电场所收集,电流流过内部寄生衬底电阻时,基极的偏置增大,电路中流动的电流会增大.如果偏置足够高,可控硅结构被触发进入电流再生模式,器件发生单粒子锁定,测试系统对器件失去控制,直到给器件断电,并重新加电才能恢复正常[26,27].在本实验中SEFI发生时,测试系统并未对器件失去控制,因此可以认为可控硅结构中未达到电流增益状态,而是发生了微锁定现象,此时寄生可控硅结构中有电流流过,PMOS管和NMOS管的开关作用失效.
FRAM的数据读取和写入过程的顺利执行是有外围电路中的寄存器参与的,这些寄存器中有命令寄存器和地址寄存器,用来响应电路外部传入的命令代码和地址信号.在外围电路的寄存器发生微锁定时,产生了如图7所示的微小电流,其持续的时间为激光或质子在材料中产生的电子-空穴能够维持可控硅结构的寄生二极管中基极正向偏置的时间.在这个时间内,寄存器无法响应,FRAM的读出功能失效,测试系统回读出大量的错误,当这个时间结束后,电流消失,寄存器恢复正常,测试系统读出正确的数据,上一个周期中读出的错误消失,直到下一次微锁定发生时这种情况再次出现,如图4所示.随着质子能量的增高,通过核反应产生的次级重离子种类和能量也增加,在硅衬底中电离出的电子-空穴对随之增加,外围寄存器发生微锁定效应的时间越长,测试系统回读的错误数越多,导致FRAM的功能中断截面随着质子能量的增加而增加.在NASA对Intel生产的微处理器理器(microprocessor)、协处理器(coprocessor)、集成外围(integrated peripheral)的辐照效应研究中,发现其中某一个部分发生SEU均会导致其他两个部分随之发生SEE,推测这是由于各部分的总线连接造成的[28].因此认为,外围电路中发生的微锁定电流,通过总线的连接可以在器件的输出端被观测到,如图7所示.
3 结 论
本文对两款商用FRAM开展了质子单粒子实验研究,通过比较两款器件在质子辐照下的表现,发现特征尺寸对FRAM的SEE敏感性的影响与传统SRAM不同,虽然FM28V100的特征尺寸比FM22L16小,但FM28V100在90 MeV以下的质子能量辐照下未发生SEE,反而是特征尺寸较大的FM22L16出现了SEE.这是因为FM28V100的容量比FM22L16小,外围电路面积也比后者小,导致SEE敏感单元(如寄存器)在版图布局中的比例小,在相同的质子辐照环境下未发生SEE.利用不同能量的质子束流对FRAM进行辐照,FM22L16型FRAM在30—90 MeV的质子能量下均能检测到SEFI效应,并且器件SEFI截面随着质子能量的增加而增加.
通过激光微束的辅助实验,发现器件发生SEU效应的敏感区分布在整个外围电路中,而器件发生SEFI的敏感区只分布在外围电路中的某一块区域.本文认为外围电路中参与读写过程的寄存器在辐照环境下发生了微锁定,使其在读取数据的过程中失效,导致数据读取失败.与单粒子锁定现象不同,微锁定产生的电流未超过FRAM的正常工作电流(15 mA),可以自主恢复.这个电流持续的时间决定了FRAM的功能中断截面的大小.最后利用高频示波器在激光脉冲辐照器件时,对FRAM的输出电流进行同步采样,发现伴随着SEFI效应的发生,输出端会俘获到一段瞬态电流,为器件发生SEFI效应机理提供了支撑.
