批处理式离子注入机电荷交换效应的防控
2017-08-16郑刚
郑刚
(上海华虹宏力半导体制造有限公司,上海,201206)
批处理式离子注入机电荷交换效应的防控
郑刚
(上海华虹宏力半导体制造有限公司,上海,201206)
本文研究了批处理式离子注入机工艺过程中的电荷交换效应,该效应使得注入杂质浓度偏离设定值并且面内分布变差;为防控此种不良模式,可以通过收紧腔室端真空容限范围,但更为有效的方式是在注入中采用真空补偿,实验数据证明,采用优化的真空补偿系数可以在带光阻的硅片上获得更具良好重复性的掺杂浓度和更加均匀的面内分布。
离子注入;掺杂;电荷交换;半导体制造
0 引言
离子注入是现代超大规模集成电路制造中的关键工艺,批处理式注入机以其精确的掺杂工艺控制和高产出率获得广泛应用。通常离子注入系统可分成三部分:离子源,加速管,终端台【1】。含有注入物质的气体被传送至离子源并进行离化,然后工艺所需离子经过加速管并被分析磁石筛选出,最后在终端台目标离子在高真空环境下被注入硅片。
但实际中批处理式注入机高真空环境是不完美的,一种情况是总有极少量气体分子残留在腔室中,比如等离子喷淋装置需要使用小流量的AR或XE气体,或是当低温泵能力不足以及腔体有漏时;另一种情况是离子轰击到带光刻胶的硅片,打断了光刻胶的有机分子,留下非挥发性的碳【2】,同时导致少量H2气体的形成,从光刻胶表面逸出,从而导致终端台气压上升。以上两种情形造成离子束与气体分子碰撞,从而引起离子所带电荷价态发生改变,即电荷交换效应,导致严重的剂量误差【3】。
目标离子与气体分子间的电荷交换可能使离子外层增加或者减少电子,从而使其与recipe中所设定的电荷价态不一致。如图1所示,当电荷交换效应为中性化时,一定比例的入射离子与残余气体原子或热电子复合产生中性粒子【4】,注入在硅片上中性粒子不会产生电流,因而不会被法拉第计数,结果导致过注入;当电荷交换效应为剥离电子时,一定比例的入射离子失去电子继而变成更高价态,结果导致法拉第量测到的电荷增加了但实际注入的掺杂原子仍保持不变,造成欠注入。
批处理式注入机常应用在高能量,大剂量注入场合,带光刻胶的硅片被高功率离子束持续轰击,导致腔室实时真空压力的急剧变化;与此对应,由于电荷交换效应的影响,位于终端的法拉第检测到的束电流也会快速波动,因此在压力和束电流间建立一种关联就是真空补偿pressure compensation(PCOMP)。补偿量取决于通过真空计IG3实时量测到的真空度,当然PCOM同时也和注入机硬件设计有关,比如低温泵的数量和位置,IG3安装位置。就同一种设备来说,PCOMP主要取决于离子类型,电荷状态和能量大小,用公式描述如下。

图1 电荷交换效应Idisk=Idose×e−KP
其中Idisk是disk法拉第实时测到的束流,Idose是真空很好时忽略电荷交换效应下的束流,P是真空计IG3所测得的腔室真空度,K是表征离子束与残余气体发生电荷交换的强弱程度,其与PCOMP的转换关系如下:

当腔室压力为10-4torr时,于是有以下简化:

可见,PCOMP也就是假定真空在10-4torr时离子束流需要进行补偿的比例。
本文通过寻找恰当的真空补偿,在批处理式注入机上进行具体实验,通过分析具体测试结果找到防控电荷交换效应的方式。
1 实验方法及设定
为了获得电荷交换效应对剂量偏差和均匀性的影响的定量描述,我们需要通过实验获得恰当的真空补偿系数PCOMP,本文中采用交叉线测试法,这种方法理论依据是无论带有光刻胶的硅片是否有outgassing,在恰当的真空补偿作用下,其实际注入的剂量应该是相同的;在每轮实验中通过4轮注入,其中2轮不采用真空补偿分别对光片和带光刻胶片进行注入,另外2轮采用过补偿,也是分别对光片和带光刻胶片进行注入,如表1所示。

表1 交叉线法:4轮注入
在带光刻胶片的注入中,采用充填率模拟光阻占比,比如光阻coverage ratio是80%,则在满批次为13枚的机台上使用10枚涂光刻胶(10/13≈80%),其余3枚为光片来获得近似;每轮注入保证有一枚光片为控片,注入完成后,将四枚控片进行收集,然后一起经过1100℃ 30s(N2 ambient)的高温快速热退火,再使用四探针测量仪RS75进行方块电阻RS测定,条件是面内49点,距边缘5mm的。根据以上测量的方块电阻均值画出两条连线,其交叉点决定最佳的真空补偿值,如图2所示,同时也可根据面内49点测量结果计算每片面内均匀性,做出等值图线。

图2 交叉线法:交叉点决定最佳PCOMP值
本文中采用AXCELIS厂商的GSD型批处理式高电流和高能注入机,依照上述方法进行注入,可依次对不同注入recipe设定和不同光刻胶占比情况下的真空补偿进行测试,同时我们对这些注入中的终端腔室真空度,法拉第检测束流等参数进行实时收集,并依此评估这些情况下的电荷交换效应严重程度。
2 实验结果及分析
2.1 不同真空interlock下电荷交换情形的比较
在进行AS+ 110KEV 1E15的注入时,采用三种方式进行注入比较:模拟光刻胶占比80%的情形下分别关闭和开启真空interlock,并与全光片注入进行比较,当开启真空interlock时设定上限在1.5E-4Torr,分别记录这三种注入过程中终端腔室压力波动和faraday cup实时检测到的束流,如图3所示。
图中右段(901~1101*0.2s)为光片注入,可见此过程中由于没有光刻胶outgassing,基本没有电荷交换效应,无论是束流还是真空压力都很平稳。左端(1~201*0.2s)为interlock OFF时的带胶片注入,可见注入束流和真空压力呈现反向关联,这是因为硅片上的光刻胶被离子轰击时outgassing严重导致真空变差,导致一定比例的离子被中性化,法拉第检测到的束流变小;每次扫描至硅片中心时,光刻胶面积最大,outgassing更加严重,电荷交换效应更明显,从而检测到的束流最小,后续随着靶盘的周期性上下扫描,束流呈现周期性波动。中段(201~901*0.2s)为interlock ON时的带胶片注入,此时一旦outgassing导致真空变差到设定上限,注入被自动暂停,随后随着低温泵继续吸附掉腔内的残留气体,真空随之降低,注入工艺继续,因此体现在束流频繁间断,在这种方式下通过interlock防止了真空恶化,但造成工艺时间延长,牺牲了产出率。

图3 AS+ 110Kev 1E15注入终端腔室压力和束流实时采样

图4 三种情形下AS+ 110Kev 1E15注入束流采样值分布及对应方块电阻
从图4可以看到,带光刻胶80%占比的注入中离子的中性化最大导致了实时检测到的束流降低了30%,对应的方块电阻从正常时79.8ohm/sq降至71.6ohm/sq,面内均匀性从0.4%恶化到1.5%;当采用了interlock避免真空过于恶化,其水准对应的方块电阻也在77.2ohm/sq,与bare wafer注入差异不明显,但由于注入中频繁的中断,无法保证良好的工艺连续性,面内均匀性只有1.9%。本实验说明,在实际有outgassing的产品注入中,仅靠interlock来防止真空恶化并减少剂量偏差,效果是极其有限的。
2.2 能量下电荷交换情形的比较
分别在不同的离子种和注入能量下:利用高能注入机在300kev,500kev,
800kev,1000kev进行一价B+和P+注入,在800kev,1000kev, 1400kev,1700kev进行二价B++和P++注入,剂量设定2E13 ion/ cm2;利用高电流注入机在30kev,50kev,70kev,110kev进行一价B+,P+和AS+注入,剂量设定1E15 ion/cm2,以上全部选取光刻胶占比80%的涂胶硅片充填方式,利用上述交叉线法找出恰当的PCOMP系数,如图5(高能),图6(高电流)所示。
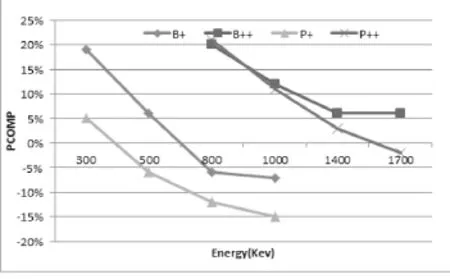
图5 高能注入机PCOMP随能量的变化

图6 高电流注入机PCOMP随能量的变化
由图中PCOMP可以视为为了弥补电荷交换效应所采取的补偿系数,其绝对值越大代表电荷交换效应越强。在低能量区段0~110Kev,如图6,也就是通常高电流注入机工作的能量范围,离子束与终端腔室中残气分子间主要发生的电荷交换过程会降低可侦测的beam current,如前述模型a,也就是以电中性为主,体现在PCOMP均为正值;但随着能量的提高,中性化的离子比例有所降低,对应PCOMP少许有降低趋势。随着能量的提高,在高能注入机工作的能量范围,如图5,情况会发生变化,前述模型b的情形,即电子剥离效应逐渐突出,并代替中性化占据主要地位,对应PCOMP逐渐降低,继而由正值转为负值;这个临界点发生在一价的B+700kev,P+400kev附近,以及二价的P++1700kev附近,因此仅从注入工艺条件来看,电荷交换效应主要受离子种和能量大小的决定。
2.3 不同光刻胶占比下真空补偿的改善比较
实验选取了部分注入条件,兼顾包含了不同离子种以及高电流,高能注入工作范围内的能量:B+50kev_1E15,P+70kev_1E15,AS+70kev_1E15,B+300kev_2E13,P+800kev_2E13,五组条件分别在其不采用(w/o)PCOMP补偿和采用(with)恰当的PCOMP补偿下进行注入,同时本实验中使用了不同数量比例的涂胶片充填近似模拟光刻胶占比30%,60%和90%的情形,按照前述的方法完成注入后,并对需量测方块电阻的控片进行高温退火,并进行面内49点RS测定。图7是采用PCOMP前后RS shift的对比,图8是采用PCOMP前后面内均匀性的对比

图7 不同注入条件采用PCOMP前后对RS shift的比较

图8 不同注入条件采用PCOMP前后对RS面内均匀性的比较
可见在不采用PCOMP进行真空补偿时,随着光刻胶占比的增加,RS shift趋向更加严重,最大的B+50kev条件在光刻胶占比90%时甚至达到12%左右,这在离子注入工艺上是不可接受的程度,同时面内均匀性也逐渐变差,在2%~4.5%;这是因为光刻胶占比越大,注入中outgassing现象愈加严重,电荷交换效应更加强烈,导致了明显恶化。对此对应的另一组数值,采用了恰当PCOMP补偿后的结果改善明显,无论光刻胶占比的高低,RS shift不超过1.5%,最大的差异是高能注入,也在1.3%;面内均匀性也有了明显改善,不超过1.5%,这是因为在PCOMP作用下,有效地克服了真空恶化所带来电荷交换效应,满足了注入工艺所要求的dose高精确度要求。
3 总结
批处理式高能高电流注入工艺中,由于光刻胶的outgassing造成真空恶化,导致电荷交换效应,使得注入杂质浓度偏离设定值并且面内分布变差;为防控此种模式对产品注入的不良影响,本文通过实验具体研究了真空补偿(PCOMP)方法,由数据可见实际注入中法拉第侦测电流随终端腔室真空压力瞬时而变,采用真空补偿比收紧腔室端真空interlock更为有效;它主要受离子种和注入能量所决定;优化的真空补偿(PCOMP)可以在带光刻胶硅片注入中明显减小RS shift,同时获得更加均匀的RS面内分布。
[1] J.W.Mayer,L.Erickson,and J.A.Davies,Ion Implantation in Semiconductors,Silicon and Germanium,AcademicPress,New York,1970.
[2] T.C.Smith, “Wafer Cooling and Photoresist Masking Problems in Ion Implantation,”in Ion Implantation Equipment and Techniques,H.Ryssel and H.Glawischni g,eds.,vol.11,Springer Series in Electrophysics,Springer-Verlag,New York,1983,p.196.
[3] P.Burggraaf,“Resist Implant Problems:Some Solved,Others Not,”Semiconductor Int.15:66(1992).
[4] H.Glawischnig and K.Noack,Ion Implantation System Concepts,”in Ion Implantation Science and Technology,J.F.Ziegler,ed.,Academic Press,Orlando,1984.
Prevention and control of charge exchange effect in batch ion implanter
Zheng Gang
(Shanghai Huahong grace Semiconductor Manufacturing Co., Ltd.,Shanghai,201206)
The charge exchange effect in batch mode implanter process was studied in this paper and it will cause dose shift and bad uniformity within wafer. In order to prevent this effect, we can tighten the end station chamber vacuum interlock and use the pressure compensation factors during implantation which is more effective method. Experiment data show that better dose repeatability and better uniformity on resist coating wafers can be achieved by using optimized pressure compensation factor.
Ion implantation;doping;charge exchange; semiconductor manufacture
