基于衍射光栅的干涉式精密位移测量系统
2017-03-11李文昊巴音贺希格刘兆武
吕 强,李文昊,巴音贺希格,柏 杨,刘兆武,王 玮
(1.中国科学院长春光学精密机械与物理研究所,吉林长春130033;2.中国科学院大学,北京101408;3.吉林大学生物与农业工程学院,吉林长春130022)
基于衍射光栅的干涉式精密位移测量系统
吕 强1,2,李文昊1*,巴音贺希格1,柏 杨3,刘兆武1,2,王 玮1,2
(1.中国科学院长春光学精密机械与物理研究所,吉林长春130033;
2.中国科学院大学,北京101408;
3.吉林大学生物与农业工程学院,吉林长春130022)
介绍了基于几何莫尔条纹原理和衍射干涉原理的两种光栅精密位移测量系统及各自的特点。综述了国内外对光栅干涉式精密位移测量系统的研究进展,总结了系统存在的关键问题及发展趋势。光栅干涉式精密位移测量系统的优点是对环境要求小,测量分辨率和精度较高,结构紧凑,成本低。该系统需要解决的问题包括提高光栅以及光学元器件制造和安装精度;寻求一种更高精度的检测手段对光栅位移测量系统进行标定等。光栅干涉式精密位移测量系统的发展方向为更高测量分辨率和精度,大量程、多维度测量以及尺寸小巧。该系统在现代工业加工精密制造领域将具有更广阔的应用前景。
位移测量;光栅;衍射干涉;高精度
1 引 言
21世纪以来,随着美国“先进制造伙伴计划”,德国“工业4.0”等创新战略计划的提出,世界主要国家都在依靠创新增强经济发展内生动力,抢占制造业高端,以智能制造为主导的第四次工业革命拉开了序幕。中国为了实现由制造大国向制造强国的转变,提出实施“中国制造2025”的战略。而更高水平的测量技术是“中国制造2025”的基石,是我国实现向制造强国转变的重要前提之一。计量与测试技术革命将对各个领域的测量精度产生深远影响。半导体制造、超精密光学加工、生物分子操纵以及纳米尺度诊断等领域[1-2]都需要高精度的扫描位移平台,寻找一种能够在宏观尺度范围内实现更高精度测量的方法显得尤为重要。
近年来人们对纳米位移测量技术的研究越来越多,各种精密位移测量仪器及测量方法层出不穷。STM、电容、电感测微仪、X射线干涉仪、光纤位移传感器、激光干涉仪以及光栅位移测量系统等[3-6]测量手段被广泛应用于各个领域的生产制造。其中,激光干涉仪和光栅位移测量系统是能够同时满足大量程和高分辨率的位移测量手段。
激光干涉仪以其特有的大量程、高分辨率和高精度等优点,在精密和超精密位移测量领域获得了广泛的应用[7]。激光干涉仪是以稳频激光的波长为工作基准,当测量环境的某些参数如温度、压力、相对湿度、CO2浓度等发生变化等都会导致波长的不稳定,加之外界振动和电子学噪声,这些都会给测量带来误差。因此,外界环境对激光干涉仪影响很大。用激光干涉仪实现高精度测量需要高级别的环境控制系统,比如米级尺度纳米级测量精度对环境的温度变化要求为0.01℃,这无疑加大了技术和成本上的投入。激光干涉仪的这一缺点限制了其应用范围,一般的生产制造环境很难使激光干涉仪实现高精度测量。所以,一种对环境要求小的测量方法对工业制造有十分重要的意义。
光栅位移测量系统很好的解决了环境对测量精度影响大的问题。该系统的核心元件是光栅,以光栅栅距为测量基准,系统结构紧凑,光路对称且光程短,外界环境对其影响微乎其微[8-9]。尤其是利用光的衍射干涉原理的光栅干涉式精密位移测量系统,相对于基于几何莫尔条纹原理的光栅位移测量系统,其分辨率和精度更高,结构更加灵活,更加适合高精度的加工制造领域中的位移测量和定位。
2 基本原理
光栅位移测量系统以光栅栅距为测量基准,当光栅栅距在10μm至200μm范围内,栅距远大于光源的波长,光入射到光栅上,衍射现象可以忽略。两块光栅—参考光栅和测量光栅相对移动会产生低频拍现象形成莫尔条纹[10-11],通过对莫尔条纹的计数和细分,可以计算出两块光栅的相对位移大小,实现位移测量。其原理图如图1所示。光源S发出的光经透镜L准直后入射到参考光栅G1,经过参考光栅G1和测量光栅G2后形成莫尔条纹,并且被光敏元件D接收,送到后续电路系统E处理。这一类测量系统为基于几何莫尔条纹原理的光栅位移测量系统。系统中的测量光栅通常位于参考光栅的第一菲涅尔焦面上,两个光栅之间的距离为l=d2/λ,d为光栅栅距,λ为入射波波长。两光栅之间的距离会随光栅间距的减小而减小,公差要求也会变严格。较高的公差要求,对制造安装无疑是不利的[12]。另外,随着光栅栅距的减小,光的衍射现象便不可忽略,衍射光会作为干扰光降低系统的信噪比。基于几何莫尔条纹原理的光栅位移测量系统的这一缺点限制了其精度和分辨率的提高,一般该系统通过后期高倍的电子细分来提高分辨率,但细分误差影响着系统的精度。因此,基于几何莫尔条纹原理的光栅位移测量系统很难应用在有着更高精度需求的加工制造领域。
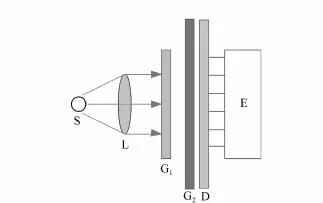
图1 基于几何莫尔条纹原理的光栅位移测量系统结构简图Fig.1 Schematic diagram of the grating displacement measurement system based on the principle of geometric Moire fringe
当光栅的栅距小于10μm时,栅距和光源波长比较接近,衍射现象越来越明显。衍射光栅干涉式位移测量系统就是利用衍射光的干涉产生明暗变化的条纹进行位移测量。其原理图如图2(a)和2(b)所示。

图2 基于衍射干涉原理的光栅位移测量系统结构简图Fig.2 Schematic diagram of the grating displacement measurement system based on the principle of diffraction and interference
图2 (a)中的系统采用两块光栅,光源发出的光线通过第一块光栅G1衍射分光,入射到第二块光栅G2,经过第二块光栅的衍射后,取相同方向的衍射光进行干涉,形成干涉条纹[13]。两块光栅相对运动使得条纹也发生明暗变化,实现位移测量。
图2(b)中的系统采用一块光栅,激光器发出的光经光栅衍射,取其对称级次±q级的衍射光进行干涉,用探测器接收干涉条纹。根据多普勒效应[14-15],光栅移动了距离s,±q级衍射光之间会有Δω=4πqv/d的角频率差,两束光差频干涉后会得到光强I随光栅位移s之间的关系:I~cos(4πqs/d)。如此便将位移s转化成了电信号。当衍射光取±1级时,系统具有光学二倍频。
由于光栅栅距是决定系统分辨率的重要因素,所以衍射光栅干涉式位移测量系统具有更高的分辨率,而且由于衍射光作为测量信号而不是干扰项,所以提高了系统的信噪比。衍射光栅干涉式位移测量系统结构灵活多变,国内外对其研究颇多。主要的研究和设计趋势包括缩小系统的体积,提高系统扫描速度、精度、分辨率以及稳定性,扩大系统的量程以及实现多维度测量等。
3 国内外研究进展
目前德国、日本等国在光栅位移测量领域有很大优势,德国Heidenhain公司光栅位移测量系统的设计理念,产品种类和产量都居于领先地位。
Heidenhain公司[16-18]的LIP、LIF、PP等系列产品是衍射光栅干涉式位移测量系统。该类产品一般采用栅距为8μm和4μm的光栅。图3为该系统的原理图。
如图3所示,参考光栅G1为透射光栅,测量光栅G2为反射光栅。LED光源S发射的光经透镜L准直后照射到参考光栅上并衍射为强度大致相等的0级和±1级衍射光。由于测量光栅被设计成没有零级衍射光出现,所以这3部分衍射光各自被测量光栅衍射为±1级衍射光。±1级衍射光又一次经过参考光栅衍射后发生干涉,形成了3路有一定相位差的干涉信号,分别被3个光电池D接收。系统采用了反射式测量光栅,光源和探测器在光栅的同侧,使得系统结构更加紧凑,便于安装。
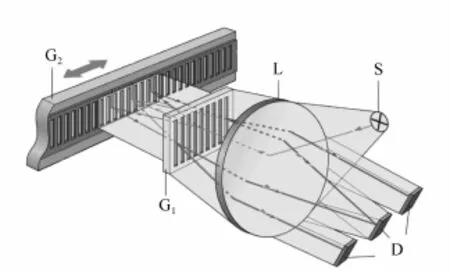
图3 Heidenhain公司衍射光栅干涉式位移测量系统原理图Fig.3 Schematic diagram of the diffraction grating interferometer displacement measurement system in Heidenhain
为了分析方便,可以将系统中的反射光栅等效成透射光栅构成三光栅系统[8,19]。如图4所示,G1和G3为参考光栅,G2为测量光栅。G1和G2之间的距离等于G2和G3之间的距离。光源发出的光经准直之后照射到G1,被G1衍射为0级和±1级。由于G1光栅的特殊设计,0级衍射光相对于±1级衍射光有φ的相位延迟。这三级衍射光照射到G2上并被其衍射。G2光栅能够抑制0级衍射光的产生,所以只有±1级衍射光会照射到G3光栅上,经过G3光栅的衍射后,相同方向的衍射光相互干涉形成干涉条纹。当G2光栅相对于G1(G3)光栅运动时,被G2衍射的+1级衍射光有+Ω的相位变化,-1级衍射光有-Ω的相位变化,由于G3就是G1光栅,所以0级衍射光还有φ的相位延迟。最终各个干涉波的相位来自于各单束光相移之和。3路信号光强和相位之间的关系为:I1~2[1+cos(2Ω+2φ)];I2~2(1+cos2Ω);I-1~2[1+cos(2Ω-2φ)]。3路有一定相位差的干涉信号被相应的光电池接收,并转换成电信号进行后续处理。
Heidenhain公司LIP571就采用这种结构,其标尺光栅栅距为8μm,经过光学二倍频,便可得到分辨率为4μm的原始信号,再通过电子学细分,系统的最终分辨率为50 nm。并且两光栅之间的距离为0.5 mm,平行度为±0.06 mm。该公司在20世纪80年代后期推出的LID351,采用几何莫尔条纹原理,光栅栅距为10μm(分辨率可达50 nm),它的间隙要求已经达到(0.1± 0.015)mm。相比之下,LIP571比它的公差要求宽松许多。LIP471采用栅距为4μm的标尺光栅,系统最终分辨率可达5 nm,精度等级达到±1μm,非常适合高精度的位移测量。
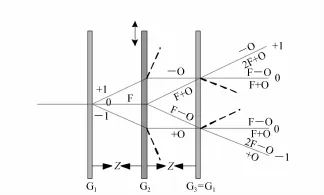
图4 三光栅系统原理图Fig.4 Schematic diagram of three-grating system
另外,为了进一步提高精度和分辨率,Heidenhain公司的LIP372和LIP382产品采用了栅距为0.512μm的标尺光栅,并且在结构上进行了调整[20]。图5为LIP382的系统原理图。
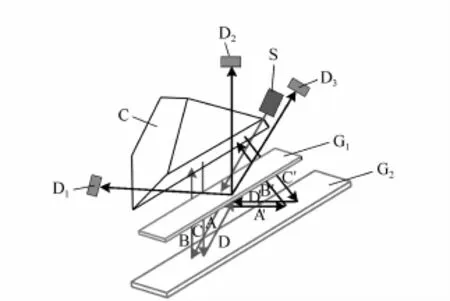
图5 LIP382系统原理图Fig.5 Schematic diagram of LIP382
如图5所示,光源S发出的光经过参考光栅G1衍射为0级和±1级,通过一定的结构抑制0级光,只让±1级光A和A′照射到标尺光栅,并且经标尺光栅衍射为1级衍射光B和B′。系统引入了一个角锥棱镜,而且角锥棱镜和标尺光栅以及A、A′衍射光采用Littrow自准直安装。通过这种结构设计,产生了分别与B、B′平行而且有一定平移的反射光C、C′并再次入射到标尺光栅。1级衍射光D、D′经参考光栅衍射为3路并相同方向的光发生干涉,3个探测器分别接收这3个干涉信号,进行后续处理。
该系统的最大特点就是加入了角锥棱镜,其优点主要有两个:第一,使经过标尺光栅的衍射光再次入射到标尺光栅,发生了二次衍射,形成了光学四倍频,分辨率得到了提升;第二,带来了较为宽松的安装公差。LIP382的分辨率达到1 nm,精度等级为±0.5μm,量程为70~270 mm,适合更高精度位移测量。另外,日本SONY公司研制的BS78系列激光尺[21]采用栅距为0.55μm的全息光栅,系统得到的全息光栅信号周期是0.137 9μm。值得一提的是,它通过4 000倍的电子细分后得到34 pm的最小步距。精度在±0.04μm以下,测量长度为10~420 mm。该测量系统达到皮米级分辨率,是21世纪精密检测的一个重大飞跃。
R.Sawada等人[22-25]对单光栅系统进行了相关研究,利用平板印刷术和特殊的半导体制造技术将激光二极管、聚酰亚胺波导以及一些光学薄膜集成在一起。如图6所示,激光二极管S发出的光经过透镜L1、L2后照射到光栅G上,相应的衍射光再通过透镜L3被光电二极管D接收。整个系统结构简单,而且尺寸缩小到了500μm2,微小化的光栅位移测量系统惯性小,具有很高的扫描速度,系统分辨率小于10 nm,可以将其应用在微型机器人手臂等微位移测量中。
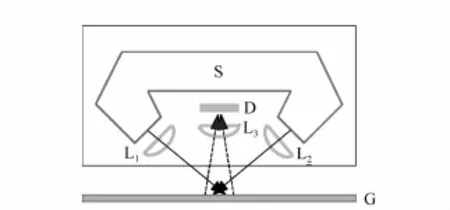
图6 微型光栅位移测量系统原理图Fig.6 Schematic diagram of m icro diffraction grating interferometer displacement measurement system
日本尼康公司[26-30]在半导体光刻机扫描平台上将激光干涉仪和光栅位移测量系统相结合构成BEC(Bird′s Eye Control)系统,如图7所示。由于读数头和光栅之间只有2 mm的距离,所以相对于激光干涉仪来说,环境对光栅位移测系统影响很小。光栅位移测量系统拥有很好的重复性,而激光干涉仪拥有高精度和长行程稳定性。二者的结合,提高了位移精度和稳定性,有利于提高硅片的产量和质量。另外,在光栅位移测量系统中该公司采用多读数头切换的方案扩大了光栅位移测量系统的量程。这种方法能够有效的解决采用高刻线密度光栅时量程很难扩大的问题。
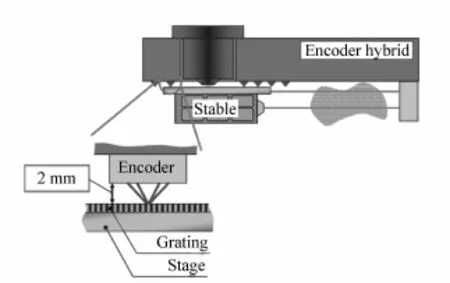
图7 Bird′s Eye Control系统原理图Fig.7 Schematic diagram of Bird′s Eye Control system

图8 6自由度测量系统原理图Fig.8 Conceptual design of the six-DOF surface encoder combined with a three-DOF displacement assembly and a three-DOF angle assembly
日本东北大学高伟等人[31-36]对半导体制造中所使用的二维运动平台进行了研究,并设计了能够实现三维位移测量以及三维角度测量的系统。其系统原理图如图8所示。XY方向位移测量采用衍射光栅干涉式系统单光栅测量原理,Z方向位移测量采用迈克尔逊干涉仪原理。值得一提的是系统把由测量光栅衍射得到的0级和-1级衍射光引入到2个四象限光电二极管QPD实现三维的角度测量。该系统采用的参考光栅和测量光栅的栅距都为0.57μm,测量光栅的大小为60 mm×60 mm,整个读数头的尺寸为95 mm× 90 mm×25 mm。该系统可以实现2 nm位移测量分辨率以及0.1和0.3角秒的角度测量分辨率。由于该系统采用了许多光学元件,系统的稳定性是个需要解决的重要问题。另外,该系统在θz方向上的角度分辨率以及X、Y、Z三个方向尤其是Z方向位移测量量程有待提高。
国防科技大学[37-42]对Post提出的非对称双级衍射系统[43]进行了研究,并将其中的参考光栅用分光镜代替,将光源L出射的光分成P、Q两束,经过平面镜反射之后对称入射到光栅上。选取高级次衍射光干涉实现了高倍的光学细分,配合相应细分电路实现1 nm分辨率。所采用的光路图如图9所示。该系统光学元件使用相对较少,在一定程度上减少了元件偏摆误差对系统精度的影响。另外,他们还采用了两种电子细分方法:采用任意相位差条纹信号细分方法的系统在100 mm测量范围内有100 nm的精度,并且有500 mm/s的测量速度。采用傅立叶变换条纹细分法的系统虽然测量速度相对较低,但是系统条纹信号噪声大大降低,测量精度达到10 nm。

图9 光栅干涉位移测量系统光路图Fig.9 Schematic diagram of optical setup
台湾地区一些高校及科研机构对光栅位移测量系统进行了多方面的研究,提出了许多新方案。2006年,范光照等人[44-45]采用1 200 l/mm的高刻线密度全息光栅,并设计了二次衍射的对称光路结构,提高了系统的分辨率,如图10所示。该系统在15 mm测量范围内与双频激光干涉仪之间的标准差为10~19 nm。他还采用Littrow结构提高了系统读数头和光栅的对准公差[46],如图11所示。并且,通过二维光栅实现分辨率为1 nm的二维位移测量[47],在常规的实验环境中,系统分别在两个坐标轴方向的25 mm测量范围内的测量标准差为15 nm。2007年,李世光等人[48-49]在光栅位移测量系统中加入了单倍望远镜结构,使光路沿原路返回,提高了系统的对位公差和信噪比,如图12所示。系统在20 mm测量范围内达到33.71 nm的测量精度。2014年,Hsieh等人[50-53]采用半透半反的二维光栅,结合外差、光栅剪切和迈克尔逊干涉等原理,设计了一个能够实现六维自由度测量的干涉系统,如图13所示。系统的位移分辨率为2 nm,角度分辨率为0.05μrad。这些系统中都应用了许多偏振以及分光、折光元件,这些元件的偏摆误差对于系统的稳定性会产生很大影响,如何精确固定这些元件也是一个需要解决的问题。
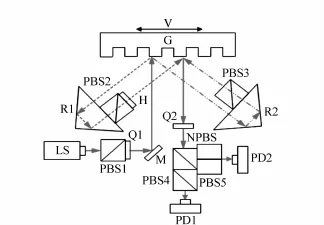
图10 二次衍射系统原理图Fig.10 Schematic diagram of double diffraction system
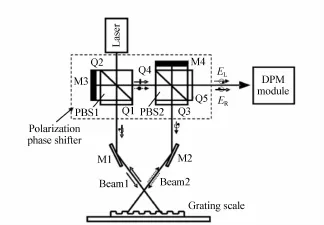
图11 采用Littrow结构的光栅位移测量系统原理图Fig.11 Schematic diagram of diffraction grating interferometer displacement measurement system with Littrow structure

图12 采用单倍望远镜结构的光栅位移测量系统原理图Fig.12 Schematic diagram of diffraction grating interferometer displacement measurement system with DiLENS configuration
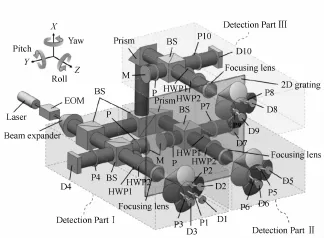
图13 6-DOF测量系统原理图Fig.13 Optical configuration for 6-DOF measurement system
2014年以来,清华大学[54-56]分别设计了能够实现一维、二维以及三维自由度位移测量的外差光栅位移测量系统,并申请了相关专利[57-59]。其所设计的二维位移测量原理图如图14。该系统在x方向9 mm测量范围内实现1.63 nm的分辨率,在z方向0.6 mm范围内实现0.6 nm的分辨率。该系统中的光学元件大大减少并且采用双频激光以及光纤耦合,有利于提高系统的稳定性。
此外,国内外还有许多机构对光栅位移测量系统进行研究并在结构上做出了一些改进,如哈尔滨工业大学[60-64]、合肥工业大学[12,65-67]以及日本的索尼[68-70]等。基于衍射干涉原理的光栅位移测量系统理论上可以达到纳米级分辨率及精度,再加上其对环境要求低的特点,非常适合于现代加工制造领域高精度位移测量,有着比较好的应用前景。
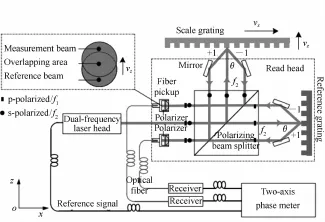
图14 外差光栅位移测量系统原理图Fig.14 Schematic diagram of the novel heterodynegrating interferometer system
4 存在的关键问题
人们对光栅干涉式精密位移测量系统的研究,无论在系统结构上还是在原理上都有了一定的创新和发展,相关产品和设备也应用在了不同测量需求中。但是,该位移测量系统还存在一些关键性问题需要我们去解决。
无论是利用何种原理和结构,光栅的制造精度影响着位移测量系统的精度,光栅的刻线密度影响着测量系统的分辨率,所以制造出高刻线密度、高精度的一维光栅以及二维光栅对位移测量系统非常重要。德国Heidenhain公司在地下15 m处建立了一处无尘、恒温(温度控制在0.01℃)的光栅刻蚀间,以保证光栅条纹的准确度和精度。并且该公司采用的DIADUR复制工艺,即在玻璃基板上蒸发镀铬的光刻复制工艺,可制造出高精度、价格低廉、抗污染能力强的刻度尺光栅。METALLUR生产工艺可以制造出高刻线密度的光栅,并应用在衍射干涉原理的光栅位移测量系统中。我国中科院长春光机所国家光栅制造与应用工程技术研究中心建有超洁净光栅实验室,温度精度±0.02℃。并且拥有光栅母板生产能力,光栅批量复制能力,为我国高精度光栅制造奠定了坚实的基础。
从上文对国内外的研究介绍可以看出当采用高刻线密度的光栅时,光栅位移测量系统的量程会大大缩小。原因就是目前的机械刻划光栅,全息光栅以及它们的复制光栅都无法做大做长,这严重制约了光栅位移测量系统向大量程方向发展。提高长光栅的生产能力是国内外面临的一个重要问题。为了解决制造长光栅的质量和时间问题,美国MIT利用扫描干涉场曝光(SBIL)技术制造出了高刻线密度,高精度长光栅[71]。我国中科院长春光机所国家光栅制造与应用工程技术研究中心也着力研究1.5m扫描干涉场曝光系统以及大面积光栅刻划机,为制作高刻线密度大光栅和长光栅提供了保障。除此之外,还可以通过改进系统结构扩大量程。例如,尼康公司多读数头测量方案,通过读数头的交替测量实现量程的扩大。还可以考虑通过多光栅排列的方法扩大量程。
另外,光栅位移测量系统各元器件之间的偏摆和位置误差等也是影响位移测量系统的精度重要因素。光学元件的固定方法采用粘合还是夹持,应当深入分析,寻找一种好的固定方案,尽量降低这些误差对提升整个系统的性能尤为关键;随着光栅位移测量系统精度的提高,采用更高精度的方法对其进行标定也是所面临的一个问题,在许多研究中都是用激光干涉仪与之比较,由于环境变化影响激光干涉仪的稳定性,这种方法得出的结果也只能作为参考。要使得结果更具准确性,一方面尽量保证环境要达到要求,另一方面可以增加测量的次数或者采用不同测量方案,从而将环境的影响减到最小;此外,进一步缩小光栅位移测量系统读数头的体积,尤其是多维度测量系统的体积,找到光学元件更好的集成方案,最终使其产品化,扩大其应用范围也是一个亟待解决的问题。
5 结束语
目前,衍射光栅干涉式一维位移测量系统已较为成熟,由于其测量维度低,结构相对简单,读数头尺寸可以做到很小,相应的产品已经广泛应用于测量领域;随着二维光栅在光栅精密位移测量系统中的应用,一方面系统测量维度可以扩展到二维,另一方面相对于使用两个一维光栅,二维光栅可以集成和简化系统结构,有利于系统小型化设计,其产品也相继出现;为了适应日益发展的精密加工技术,扩展光栅精密位移测量系统的应用范围,研究者正努力将其扩展到三维位移测量甚至包含角度测量的六维自由度测量,在测量维度的扩大的同时保证高精度是目前该系统的一个研究热点,上文对其有所提及,这些是基于衍射光栅干涉式精密位移测量系统在结构和功能上的发展。另外,在原理上系统由双频激光逐步取代单频激光,并且结合了多普勒频移、光栅剪切、迈克尔逊干涉等多原理于一体,有利于进一步提高了测量信号的质量。总之,基于衍射光栅的干涉式精密位移测量系统正在向高精度、大量程、多维度、小体积的方向发展。系统以其独有的优势,在精密位移测量中发挥着越来越重要的作用。相信随着光栅制造技术的发展以及新的测量方法的提出,上述关键问题会得到相应解决,具有更高分辨率和精度,大量程、多维度测量以及更紧凑的结构等优点的光栅位移测量系统将广泛应用于未来各种测量领域中。未来高精度测量会由于光栅位移测量系统的应用逐渐摆脱对环境的高要求,这将会是测量领域的一大进步。
[1] 陈宝刚,明名,吕天宇.大口径球面反射镜曲率半径的精确测量[J].中国光学,2014,7(1):163-168. CHEN B G,MINGM,LV TY.Precisemeasurementof curvature radius for sphericalmirror with large aperture[J].ChineseOptics,2014,7(1):163-168.(in Chinese)
[2] 刘淑杰,张元良,张洪潮.透明软质薄膜的表面形貌测量[J].中国光学,2014,7(2):326-331. LIU SH J,ZHANG Y L,ZHANG H CH.Profile measurement of thin transparentsoft film surface[J].Chinese Optics,2014,7(2):326-331.(in Chinese)
[3] BASILE G,BECKER P,BERGAMIN A,et al..Combined optical and X-ray interferometry for high-precision dimensional metrology[J].Proceedingsof the Royal Society A,2000,456(1995):701-729.
[4] ILEV I,KUMAGAIH,TOYODA K,et al..An alternative fiber-optic backreflectancemethod formeasurement of distances using a continuouswave laser[J].Review of Scientific Instruments,1996,67(3):662-665.
[5] 万德安.激光基准高精度测量技术[M].北京:国防工业出版社,1999. WAN D A.Laser Precision Measurement Technology[M].Beijing:National Defense Industry Press,1999.(in Chinese)
[6] 昌学年,姚毅,闫玲.位移传感器的发展及研究[J].计量与测试技术,2009,36(9):42-44. CHANG X N,YAO Y,YAN L.The development and investigation of displacement sensor[J].Metrology&Measurement Technique,2009,36(9):42-44.(in Chinese)
[7] 马爱民,马忠臣.超精密测量技术的应用进展[J].机械工程,2013,6:5. MA A M,MA ZH CH.Advances in application of precisionmeasurement technology[J].Mechanical Engineer,2013,6:5.(in Chinese)
[8] 周维来.光栅干涉仪在高精密测量中的技术和应用[J].工具技术,1994,1:37-42. ZHOUW L.The technology and application of grating interferometer in high precisionmeasurement[J].Tool Engineering,1994,1:37-42.(in Chinese)
[9] TEIMEL A.Technology and Application of Grating Interferometers in High-precision Measurement[M].Berlin:Springer Berlin Heidelberg,1991.
[10] 张善钟.计量光栅技术[M].北京:机械工业出版社,1985. ZHANG SH ZH.Metrology Grating Technology[M].Beijing:China Machine Press,1985.(in Chinese)
[11] 曹向群.光栅计量技术[M].杭州:浙江大学出版社,1992. CAO X Q.Grating Measuring Technique[M].Hangzhou:Zhejiang University Press,1992.(in Chinese)
[12] 尚平.高精度衍射光栅干涉位移传感器及关键技术研究[D].合肥:合肥工业大学,2012. SHANG P.Study on the key technology of high-resolution diffraction grating interferometric transducer of linear displacements[D].Hefei:Hefei University of Technology,2012.(in Chinese)
[13] 张金华,陈良洲,刘晓军.双光栅干涉位移传感器原理及其误差分析[J].光电技术应用,2012,3:41-45. ZHANG JH,SUN L ZH,LIU X J.Principle and error analysisof dual-grating interference displacement sensor[J].Electro-Optic Technology Application,2012,3:41-45.(in Chinese)
[14] 森山茂夫,郑建栋.用衍射光栅进行精密位移检测[J].国外计量,1984,6:11-13. SENSHAN M F,ZHENG JD.Precision displacementmeasurement with diffraction grating[J].Foreign Measurement,1984,6:11-13.(in Chinese)
[15] 吕海宝,曹聚亮,颜树华,等.光栅式大量程高分辨率位移测量研究[J].中国机械工程,2000,11(8):878-880. LU H B,CAO JL,YAN SH H,et al..Research forwide range and high resolution displacementmeasurementwith grating[J].China Mechanical Engineering,2000,11(8):878-880.(in Chinese)
[16] HOLZAPFELW.Advancements in displacementmetrology based on encoder systems[C].Proceedings of the 23rd Annual ASPEMeeting,Portland,USA,2008.
[17] THIEL J,SPANNER E.Interferential linear encoderwith 270 mm measurement length for nanometrology[C].Proceedings of the 1st International Conference and generalmeeting of the European Society for Precision Engineering and Nanotechnology,Bremen,Germany,1999:419-422.
[18] LOF J,DERKSEN A T A M,HOOGENDAM C A,et al..Lithographic Apparatus and Device Manufacturing Method:US,6819400B2[P].2005-10-21.
[19] 郑立.三光栅系统[J].光学仪器,1982,4(1):35-42 ZHENG L.Three grating system[J].Optical Instruments,1982,4(1):35-42.(in Chinese)
[20] 苏绍璟,刘辉,吕海宝,等.纳米级位移分辨率双光栅系统的多普勒分析[J].光学精密工程,2003,11(1):17-21. SU SH J,LIU H,LU H B,et al..Doppler analysis for double-grating displacementmeasurement system with nanometer resolution[J].Opt.Precision Eng.,2003,11(1):17-21.(in Chinese)
[21] 卢国刚.SONY跨入皮米级检测和加工时代[J].世界制造技术与装备市场,2008,1:92. LU GG.SONY jumping to picometer world[J].Key Components for CNCMachine Tool,2008,1:92.
[22] SAWADA R,HIGURASHIE,OHGUCHIO,et al..Long-lifemicro-laser encoder[C].Proceedingsof the IEEE International Conference on Micro Electro Mechanical Systems,2000:491-495.
[23] SAWADA R,HIGURASHI E,ITO T,et al..Monolithic-integrated microlaser encoder[J].Applied Optics,1999,38(33):6866-6873.
[24] SAWADA R,OHGUCHIO,MISEK,etal..Fabrication of advanced integrated opticalmicro-encoder chip[C].Proceedings of the Micro Electro Mechanical Systems,1994,MEMS′94,IEEE,1994:337-342.
[25] SAWADA R,TANAKA H,OHGUCHIO,et al..Fabrication of active integrated opticalmicro-encoder[C].Proceedings of the Micro Electro Mechanical Systems,1991,MEMS′91,IEEE,1991:233-238.
[26] WAKAMOTO S,KANAYA Y,KOSUGIJ,et al..Actual performance data analysis of overlay,focus,and dose control of an immersion scanner for double patterning[J].SPIE,2010,7640:79-86.
[27] MAST F V D.Towards ultimate optical lithography with NXT:1950i dual stage immersion platform[J].SPIE,2010:7640:511-519.
[28] SHIBAZAKIY,KOHNO H,HAMATANIM.An innovative platform for high-throughput high-accuracy lithography using a single wafer stage[J].SPIE,2009,7274:72741-10.
[29] PASCH B V D,MAST F V D.Enabling the lithography roadmap:an immersion tool based on a novel stage positioning system[J].SPIE,2009,7274:72741S-8.
[30] WAKAMOTO S,KIKUCHIT,SHIRATA Y,etal..Stability and calibration of overlay and focus control for a double patterning immersion scanner[J].SPIE,2008,7973(6):3620-3625.
[31] LIX,GAO W,MUTO H,et al..A six-degree-of-freedom surface encoder for precision positioning of a p lanar motion stage[J].Precision Engineering Journal of the International Societies for Precision Engineering&Nanotechnology,2013,37(3):771-781.
[32] KIMURA A,GAOW,KIM W J,et al..A sub-nanometric three-axis surface encoderwith short-period planar gratings for stagemotionmeasurement[J].Precision Engineering,2012,36(4):576-585.
[33] GAOW,KIMURA A.A fastevaluationmethod for pitch deviation and out-of-flatness of a planar scale grating[J].CIRP Annals-Manufacturing Technology,2010,59(1):505-508.
[34] GAO W,KIMURA A.A Three-axis displacement sensor with nanometric resolution[J].CIRP Annals-Manufacturing Technology,2007,56(1):529-532.
[35] GAOW,DEJIMA S,KIYONO S.A dual-mode surface encoder for position measurement[J].Sensors&Actuators A Physical,2005,117(1):95-102.
[36] DEJIMA S,GAO W,SHIMIZU H,et al..Precision positioning of a five degree-of-freedom planar motion stage[J]. Mechatronics,2005,15(8):969-987.
[37] XU D M,WENGC F,LEIM R.Research on the high accuracy displacementmeasuring and display system[C].7th International Symposium on Testand Measurement,Chinese Society ofModern Technology Equipment,Beijing:International Academ ic Publishers,2007:3515-3518.(in Chinese)
[38] CHU X CH,LU H B,ZHAOSH H.Wide ranggrating interferometerwith nanometer resolution[J].Optp-electronic Engineering,2008,35(1):56-59.(in Chinese)
[39] CHU X CH,LU H B,CHEN T ZH,et al..Investigation on long-range nanometer resolution gratingmoire interferometer[J].SPIE,2004,5635:333-341.
[40] 杜列波.纳米级光栅位移测量中关键技术的研究[D].长沙:国防科学技术大学,2004. DU L B.Research on key technology of nano scale grating displacement[D].Changsha:National University of Defense Technology,2004.(in Chinese)
[41] SU SH J,LU H B.High-speed great-capacity storing and processing technique of video sensor signal[J].SPIE,2000,4077:396-399.
[42] PU J,ZHANG H,NEMOTO S.Spectral shifts and spectral switches of partially coherent light passing through an aperture[J].Optics Communications,1999,162(1-3):57-63.
[43] POST D.Moire fringemultiplication with a nonsymmetrical doubly blazed reference grating[J].Applied Optics,1971,10(4):901-907.
[44] FAN K C,ZHANG Y L,MIAO JW,et al..Error compensation of grating interferometer due to angular error of linear stage[C].Proceedings of the Advanced Intelligent Mechatronics(AIM),IEEE,2012:428-431.
[45] FAN K C,LIU Y S,CHEN Y J,et al..A linear diffraction grating interferometer with high accuracy[J].SPIE,2006,6280:628008-6.
[46] KAO C F,LU SH,SHEN H M,et al..Diffractive laser encoder with a grating in littrow configuration[J].Japanese J.Applied Physics,2008,47(3):1833-1837.
[47] CHUNG Y C,FAN K C,LEEBC.Developmentof a novel planar encoder for2D displacementmeasurement in nanometer resolution and accuracy[C].Proceedings of the 9th World Congress on Intelligent Control and Automation(WCICA),Taiwan,China,2011:PID1723643.
[48] WU CC,WUW J,PAN ZS,etal..Laser linear encoderwith both high fabrication and head-to-scale tolerances[J].Applied Optics,2007,46(16):3169-3176.
[49] LEE CK,WU CC,CHEN SJ,etal..Design and construction of linear laser encoders that possess high tolerance ofmechanical runout[J].Applied Optics,2004,43(31):5754-5762.
[50] HSIEH H L,PAN SW.Development of a grating-based interferometer for six-degree-of-freedom displacement and angle measurements[J].Optics Express,2015,23(3):2451-2465.
[51] HSIEH H L,PAN SW.Three-degree-of-freedom displacementmeasurementusing grating-based heterodyne interferometry[J].Applied Optics,2013,52(27):6840-6848.
[52] HSIEH H L,CHEN JC,LERONDEL G,et al..Two-dimensional displacementmeasurement by quasi-common-opticalpath heterodyne grating interferometer[J].Optics Express,2011,19(10):9770-9782.
[53] HSIEH H L,LEE J Y,WU W T,et al..Quasi-common-optical-path heterodyne grating interferometer for displacement measurement[J].Measurement Science&Technology,2010,21(11):280-284.
[54] WANG L J,ZHANGM,ZHU Y,etal..American society for precision engineering a novel heterodyne grating interferometer system for in-plane and out-of-plane displacementmeasurementwith nanometer resolution[C].Proceedings of the Meeting of the American Society for Precision Engineering,ASPE,2014.
[55] LIN D,JIANG H,YIN C.Analysis of nonlinearity in a high-resolution grating interferometer[J].Optics&Laser Technology,2000,32(2):95-99.
[56] WANG L J,ZHANGM,ZHU Y,et al..Construction and accuracy testof a novel heterodyne grating interferomter system for two-dimensional displacementmeasurement[J].Laser,2013,89(3):69.
[57] 朱煜,张鸣,王磊杰,等.一种双频光栅干涉仪位移测量系统:中国,WO2014/071816A1[P].2013-02-20. ZHU Y,ZHANGM,WANG L J,et al..Dual-frequency grating interferometer displacementmeasurement system:China,WO2014/071816A1[P].2013-02-20.(in Chinese)
[58] 张鸣,朱煜,王磊杰,等.一种二自由度外差光栅干涉仪位移测量系统:中国,WO2014/201950A1[P].2013-09-18. ZHANGM,ZHU Y,WANG L J,et al..Displacementmeasurement system for two-degree-of-freedom heterodyne grating interferometer:China,WO2014/201950A1[P].2013-09-18.(in Chinese)
[59] 张鸣,朱煜,王磊杰,等.一种外差光栅干涉仪位移测量系统:中国,WO2014/071807A1[P].2013-02-27. ZHANGM,ZHU Y,WANG L J,et al..Heterodyne grating interferometer displacementmeasurement system:China,WO2014/201950A1[P].2013-02-27.(in Chinese)
[60] WEIP,LU Z,LIU L.Double-grating diffraction interferometric stylus probing system for surface profiling and roughness measurement[C].International Symposium on Precision Engineering Measurement and Instrumentation.International Society for Optics and Photonics,2015:94461N.
[61] 王雪英.基于衍射干涉原理的高精度光栅位移测量系统研究[D].哈尔滨:哈尔滨工业大学,2014.WANG X Y.Research of high-precision displacementmeasurementsystem based on the principle of diffraction and interference[D].Harbin:Harbin Institute of Technology,2014.(in Chinese)
[62] LIN J,GUAN J,MA L,etal..Effects of parameters of Bessel-Gaussian on the achievementof optical needlewith longitudinal polarization[J].SPIE,2013,8759:875937.
[63] 徐敏儿.基于衍射光栅的高分辨力位移测量系统研究[D].哈尔滨:哈尔滨工业大学,2013. XU M E.Research on and high-resolution displacementmeasurement system based on diffractive grating[D].Harbin:Harbin Institute of Technology,2013.(in Chinese)
[64] 邸晶晶.基于衍射光栅的高精度位移测量系统的设计[D].哈尔滨:哈尔滨工业大学,2012. DIJJ.Design of high-precision displacementmeasurementsystem based on diffractive grating[D].Harbin:Harbin Institute of Technology,2012.(in Chinese)
[65] CHENG F,FAN K C.An improved design of the linear diffraction grating interferometer[C].Proceedings of ASPEN20009,Kitakyushu,Japan,2009.
[66] XIA H J,FEIY T,WANG Z Y.Basic theoretical research about the 2-D diffraction grating in nano-scalemeasurement[R],ISIST2004,1226-1231.
[67] 刘玉圣,范光照,陈叶金.高精度线性衍射光栅干涉仪的研制[J].工业计量,2006,16(2):1-3. LIU Y SH,FAN G ZH,CHEN Y J.A research on diffraction grating interferometer with high accuracy[J].Industrial Measurement,2006,16(2):1-3.(in Chinese)
[68] AKIHIRO K.Optical displacementmeasurement system:US,6407815B2[P].2002-06-18.
[69] KURODA A.Optical disp lacement measurement system for detecting the relative movement of a machine part:US,6166817[P].2000-12-26.
[70] TANIGUCHIK,TSUCHIYA H,TOYAMA M.Optical instrument formeasuring displacement:US,4676645[P].1987-06-30.
[71] SCHATTENBURG M L,SMITH H I.The critical role ofmetrology in nanotechnology[J].SPIE,2002,4608:116-124.
Interferometric precision displacementmeasurement system based on diffraction grating
LV Qiang1,2,LIWen-hao1*,Bayanheshig1,BAIYang3,LIU Zhao-wu1,2,WANGWei1,2
(1.Changchun Institute of Optics,Fine Mechanics and Physics,Chinese Academy of Sciences,Changchun 130033,China;
2.University of Chinese Academy of Sciences,Beijing 101408,China;
3.College of Biological and Agricultural Engineering,Jilin University,Changchun 130022,China)*Corresponding author,E-mail:leewenho@163.com
This paper introduces the principlesand the characteristics of the grating displacementmeasurement system based on geometric moire fringe and the principle of diffraction and interference.It summarizes the research progress of the diffraction grating interferometer displacementmeasurement system at home and abroad and its key problems and development trend.The advantages of the diffraction grating interferometer displacementmeasurement system are that low the effect of environment requirement,high resolution and precision,compact structure and low cost.The problems of this system needed to be solved include how to improve the fabrication and installation accuracy of grating and optical components,and seek a higher accuracy of detectionmeans to calibrate the grating displacementmeasurement system and so on.The development trend of the system is higher resolution and accuracy,larger range,multi-dimensionalmeasurement and more compact structure.The diffraction grating interferometer displacement measurement system will have a wider application prospect in the field ofmodern industrial processing and manufacturing.
displacementmeasurement;grating;diffraction interference;high precision
TN247;TH744.3
:A
10.3788/CO.20171001.0039

吕 强(1992—),男,山东德州人,硕士研究生,2014年于山东师范大学获得学士学位,主要从事光栅精密位移测量等方面的研究。E-mail:lq_0119@126.com

李文昊(1980—),男,内蒙古赤峰人,博士,研究员,2002年于陕西科技大学获学士学位,2008年于中国科学院长春光学精密机械与物理研究所获博士学位,主要从事平面、凹面全息光栅的理论设计及制作工艺等方面的研究。E-mail:leewenho@163.com
2095-1531(2017)01-0039-12
2016-08-22;
2016-09-16
国家重大科研仪器设备研制专项(No.61227901)
Supported by the National Science and Technology Major Project of the Ministry of Science and Technology of China(No.61227901)
