基于等离子体光谱的反应磁控溅射镀膜控制系统*
2017-02-02曹一鸣陈霞蔡俊涛
曹一鸣 陈霞 蔡俊涛
基于等离子体光谱的反应磁控溅射镀膜控制系统*
曹一鸣 陈霞 蔡俊涛
(广州市光机电技术研究院)
为实现精确、稳定、快速的反应溅射镀膜工艺,降低成本,提高品质,设计基于等离子体光谱的反应溅射镀膜控制系统。通过监控反应溅射镀膜过程中等离子体的发射光谱,采用PID算法控制,实时闭环调节反应气体流量。
等离子体光谱;反应磁控溅射
0 引言
从20世纪80年代开始,现代薄膜技术得到迅速发展,其中反应溅射技术在薄膜涂层领域中占有举足轻重的地位,在工业生产和科研领域发挥了巨大的作用[1]。
目前,在反应磁控溅射镀膜工艺的反应溅射过程中,反应气体的基本质量平衡难以监控,限制了溅射效率,导致蒸发速率低和精度低等技术难题[2]。
本文通过监控反应溅射镀膜过程中等离子体的发射光谱,采用PID算法控制,实时闭环调节反应气体流量,设计基于等离子体光谱的反应溅射镀膜控制系统。
1 设计思路
在反应磁控溅射控制中,反应气体充入真空室内的等离子体环境中,会发生迟滞效应。反应溅射迟滞曲线如图1所示,理想反应气体流量控制点应在位置A附近,此时反应充分,溅射速率高。当反应气体过量时,对应的溅射速率是较高的金属模式A'-A,此时反应不充分,得到的反应化合物含量低;当反应气体不够时,对应的溅射速率是较低的反应模式B'-B。反应溅射过程无法稳定维持在A点的主要原因是:反应气体供应无法及时快速地响应A点所需的精准反应气体流量[3]。
基于等离子体发射光谱的监控系统是解决上述问题的一种方式[4]。在反应磁控溅射镀膜工艺的反应溅射过程中,使用惰性气体氩气高压电离后轰击靶材产生溅射,而后靶离子与反应气体反应形成中性粒子沉积在基片上得到薄膜。在沉积过程中靶材与基片中间的区域内离子体密度非常高,形成等离子体。在此等离子体中,靶材粒子由受激状态退化时,会发出一定的特征光谱,并且特征光谱的强度与反应气体流量线性相关,特征光谱强度与反应气体流量关系曲线如图2所示。无反应气体时,靶材粒子为金属溅射状态,特征谱线强度最大;随着反应气体的增加,特征谱线强度也逐渐降低,当溅射反应完全时,靶材粒子为化合物溅射状态,特征谱线强度达到最低。因此,通过监控等离子体中靶材金属粒子特征光谱,根据特征谱线强度变化,判断靶材溅射状态的变化,即可实时调整反应气体流量,从而准确迅速地调整靶材金属的溅射状态。

图1 反应溅射迟滞曲线

图2 特征光谱强度与反应气体流量关系曲线
2 总体设计
基于等离子体光谱的反应磁控溅射镀膜控制系统总体设计如图3所示。在反应磁控溅射镀膜过程中,通过上位机设定图1中A点溅射状态对应的光强值为目标值,并设定PID参数;利用光纤和光电转换装置不断地采集特征谱线光强值,作为PID闭环控制器的输入信号;经过PID计算后得到输出信号,输出的电压信号通过气体流量控制装置使反应气体流量发生变化,从而影响等离子体特征谱线光强值的变化。经过这样的闭环反馈控制,使反应气体流量能快速稳定地调节到图1中A点溅射状态对应的反应气体流量,达到图1中A点溅射状态对应的光强值,即可得到稳定的反应溅射等离子体和高速的沉积速率。
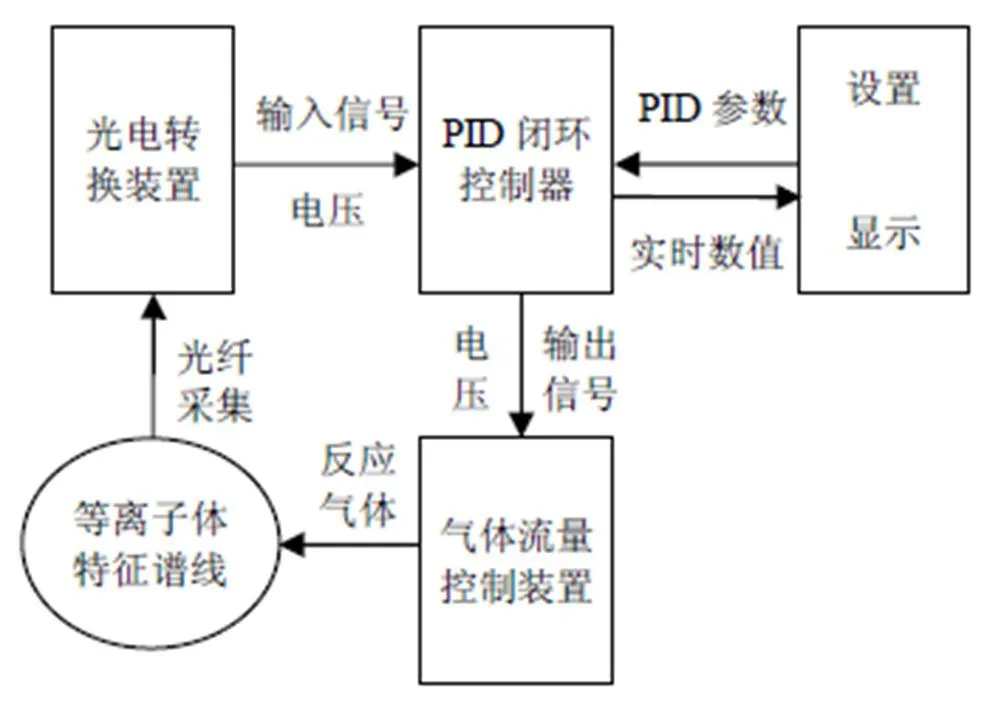
图3 基于等离子体光谱的反应磁控溅射镀膜控制系统总体设计图
3 硬件设计
系统的硬件连接原理如图4所示。

图4 系统硬件连接原理图
3.1 光电转换装置
光电转换装置硬件采用光电倍增管。光电倍增管将通过光纤探头采集到的等离子体特征谱线光强信号转变为电信号,并将电信号进行放大,作为控制系统的输入信号。
在反应磁控溅射镀膜过程中形成的等离子体发射光谱中,不同的金属靶材对应不同的特征光谱谱线,如金属Ti对应的特征谱线在500 nm处,因此在等离子体光强信号进入光电倍增管前,还需经过窄带滤光片滤光,以得到相应的特征谱线的光强信号。
本系统采用PMTH-S1-CR131型光电倍增管,波长响应范围185 nm~900 nm,放大倍数达到1.0×107。
3.2 气体流量控制装置
反应气体流量控制作为系统的输出信号,要求其反应速度快,以实现实时控制。本系统反应气体流量控制采用PEV-1压电阀,流量控制范围0 sccm ~ 500 sccm,响应时间为2 ms。
3.3 PID闭环控制器
控制器采用STM32为主控制芯片。STM32芯片上写有PID控制算法,通过不断地对比光电倍增管光强的设定值与读取值,可实时地对反应气体流量进行调节,实现闭环控制。
3.4 上位机
上位机通过COM口与PID闭环控制器进行通信,主要实现对控制器的参数设置与实时光强曲线的显示。
4 软件设计
PID闭环控制器的STM32芯片程序采用C语言编写,上位机程序采用C#语言编写。控制器程序流程图如图5所示。

图5 控制器程序流程图
首先读取设定参数,并对光强进行采样;然后进行PID计算;最后根据计算结果输出信号控制压电阀。如果单片机受到干扰10 s没有响应,报警。
靶材金属溅射状态60%~80%连续可调,靶材溅射速率变化<2%。
5 结语
基于等离子体光谱的反应溅射镀膜控制系统以等离子体特征光谱为监控对象,通过含有PID算法的控制器对反应溅射镀膜过程进行控制,可用于溅射镀膜工艺高速率镀制具有光学特性的光学薄膜产品。
[1] 佟洪波,柳青,巴德纯.反应磁控溅射研究进展[J].真空,2008, 45(3):51-54.
[2] 姜燮昌.大面积反应溅射技术的最新进展及应用[J].真空, 2002(3):1-9.
[3] 焦红岩.真空镀膜系统中反应溅射控制的分析与研究[D].兰州:兰州交通大学,2013,6-7.
[4] 肖劲宇,和军平.反应溅射镀膜的等离子体发射控制系统设计[J].计算机测量与控制,2011,19(7):1608-1610,1618.
Control System of Reactive Magnetron Sputtering Coating Based on Plasma Spectrum
Cao Yiming Chen Xia Cai Juntao
(Guangzhou Research Institute of Optics-Mechanics-Electricity Technology)
In order to realize the accurate, stable and fast reaction sputtering process, reduce the cost, and improve the quality, the system can maintain a high sputtering rate for plating compound film by monitoring the plasma emission spectra in the reactive sputtering process, using PID control algorithm, real-time closed-loop regulation of gas flow rate.
Plasma Spectrum; Reactive Magnetron Sputtering
曹一鸣,男,1976年生,硕士研究生,高工,主要研究方向:光学镀膜及自动控制。E-mail: cao_yiming@163.com
广东省科技计划项目(2016B030303001);广州市科技计划项目(2014SY000018)。
