Ar/SiCl4大气压等离子体射流沉积SiO2薄膜
2016-09-07袁强华常小伟李娇娇殷桂琴
袁强华,常小伟,李娇娇,殷桂琴
(西北师范大学物理与电子工程学院,甘肃省原子分子物理与功能材料重点实验室,甘肃兰州 730070)
Ar/SiCl4大气压等离子体射流沉积SiO2薄膜
袁强华,常小伟,李娇娇,殷桂琴
(西北师范大学物理与电子工程学院,甘肃省原子分子物理与功能材料重点实验室,甘肃兰州730070)
以氩气为携带气体,SiCl4为源材料,使用双频(50 kHz/33 MHz)组合功率源大气压等离子体射流(APPJ)装置,以空气中的氧气作为氧化物质沉积SiO2薄膜.用发射光谱检测等离子体组成物种,并研究了随源材料(SiCl4)含量的不同,体系内各主要物种的变化情况并以此得到较优的沉积条件.分别用扫描电子显微镜(SEM)、X射线光电子能谱(XPS)以及傅里叶红外光谱(FT-IR)对所沉积薄膜的形貌、化学成分和化学结构进行检测.XPS表明薄膜主要组成元素为Si、O以及少量的Cl.FT-IR显示薄膜化学结构主要为Si-O-Si和Si-OH键.
大气压等离子体射流;双频激发;SiO2薄膜
氧化硅(SiO2)薄膜由于其独特的结构性能已经被广泛用于微机电系统和集成电路中,比如其热稳定性好、电绝缘性强、耐腐蚀等优点被作为防护层、绝缘层及化学防腐层等[1-5].对于工业生产来说关键在于以低成本生产优良的氧化硅薄膜.通常都是使用溶胶-凝胶方法制备氧化硅薄膜[6-7].然而,溶胶-凝胶法是湿法化学过程,之后的高温处理过程在所难免.相比之下,大气压等离子体增强化学气相沉积法(PECVD)是一种在低温环境下拥有高沉积速率的新颖方法.特别的,PECVD法是干式制法,可以有效地避免溶胶-凝胶法的劣势(热处理)[8].所以,PECVD方法很适合在低温环境下制备高品质的薄膜[9-10].Kim等使用HMDS/O2/He/Ar在25 kHz频率下成功地沉积出了氧化硅薄膜[11].Alonso等使用SiCl4/O2/Ar在13.56 MHz频率下沉积出了氧化硅薄膜[12].研究发现,双频系统比单一频率系统有更多优势[13-14].例如,双频激发的等离子体射流长度比单频激发的要长,这使其应用更为方便.因此,本实验中采用双频(50 kHz/33 MHz)系统,使用SiCl4/Ar等离子体并以空气中的氧作为氧化物质沉积氧化硅薄膜.
1 实验及理论
1.1实验装置及仪器
本实验所使用的大气压等离子体薄膜沉积系统如图1所示,该装置在文献[14]中已详细介绍.与普通的射流发生装置最大的不同在于,该装置同时具有两个驱动电极.一个是用低频(LF)功率源(50 kHz,CORONA Lab CTP-2000K)驱动的针电极,直径为2 mm,材质为纯铜.它安置在内径为8 mm、外径为10 mm以及长度为5 cm的石英玻璃管中.石英玻璃管的前端是一个内径为2 mm、外径为4 mm、长度为2 cm的喷嘴.另一个电极是缠绕在石英玻璃管前端的环形电极,由宽度为1 cm的铜片缠绕而成,它使用一个射频(RF)功率源(33 MHz,rishige RSGK100)驱动.其中,两个电极之间的距离为2 mm,环形电极距离玻璃管管口的距离为5 mm,沉积薄膜时基底距离管口3 mm.
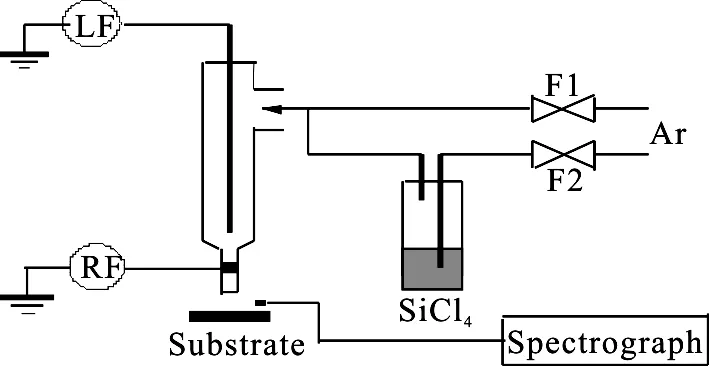
图1 实验装置
实验的工作气体为Ar(纯度为99.99%),它经过石英玻璃管的较粗端侧端开口通入放电管内.为了将原料气体引入到等离子体放电区域,实验装置中加入了一个鼓泡器,当一路氩气通入装有源材料(SiCl4)的鼓泡器时,将会携带一定量的原料气体一并进入到等离子体发生区域.气体流量由两台气体质量流量控制计(Sevenstar CS200)控制,F1 控制维持放电进行的大流量氩气的量(1.5 L·min-1),F2 控制携带原料气体氩气的流量.实验中射频功率维持在50 W,低频功率维持在10 W,分别在KBr和Si基底上沉积薄膜,沉积薄膜之前使用Ar等离子体射流清洗基底表面5 min以减少表面污染.
在光学诊断方面,采用的是荷兰Avantes公司的八通道高精度光谱仪(AvaSpec-2048-8).所用的扫描电镜为FESEM,Hitachi S-4800型.红外光谱仪为Alpha Centauri傅立叶红外光谱仪,测量范围为400~4 000 cm-1.
1.2Antoine 公式
Antoine公式可以用来计算带入等离子体发生区域的先驱体的含量,其表达式为

(1)
其中,P/kPa为饱和蒸汽压;t/K为绝对温度;A,B,C为Antoine常数.实验在室温下进行,经过鼓泡系统之后被带出的先驱体的流量用F表示,可由下式计算得到:
(2)
则混合气体中的先驱体气体的分压为
(3)
其中F1和F2分别为两支氩气的流量.可以通过以上公式计算出带入等离子体发生器中的先驱体的含量.
2 结果与讨论
2.1等离子体发射光谱
图2给出了大气压Ar+5 570×10-6SiCl4的光学发射光谱(200~1 000 nm).实验中,光谱的积分时间为200 ms.可以看出,随着SiCl4的加入,等离子体发射光谱中出现了一些新的物种,主要为大量的含硅物种Si(250.6~252.8 nm,288.1 nm)和SiO(221 nm,A1Π→X1Σ)[15-16],同时也可以观察到Cl(725.6 nm)的谱线.可见,源材料SiCl4分子在等离子体中已经裂解为小的活性自由基,观察到的含硅物种来自于SiCl4分子的裂解和碎片的再复合.由于放电是在大气压下开放环境中产生,SiO自由基则是由周围空气中的O2分子与SiCl4分子裂解产生的自由基反应而成,Cl则是由源材料的裂解产生.还可以看出,随着源材料的加入,对Ar 谱线的强度也产生了很大的影响,使得Ar 谱线的强度显著降低.表1列出了在Ar 与SiCl4等离子体中,一些主要的激发态物种的跃迁谱线.

图2 Ar+5 570×10-6 SiCl4光学发射光谱

表1 Ar 与SiCl4等离子体中一些主要的激发态物种的参数
为了使在沉积薄膜时体系中含硅物种的相对比例最大,图3给出了Si(251.6 nm)与Cl(725.6 nm)和Ar(696.5 nm)的相对强度比随SiCl4含量变化的关系曲线.可以看出,随着源材料SiCl4含量的增加,Si/Cl的相对强度逐步变大.而Si/Ar的相对强度先增加再减小,这是因为源材料含量的增多使得猝灭效应显著,从而使等离子体的放电逐渐减弱引起.当SiCl4含量为6 113 ×10-6时,Si在体系中的相对强度达到最大,文中薄膜的沉积就是在SiCl4含量为6 113×10-6时进行的.
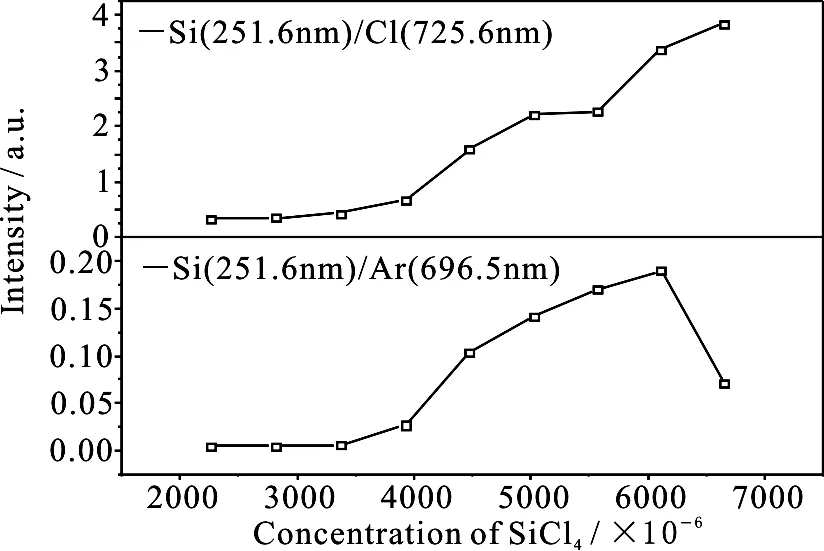
图3 Si(251.6nm)与Cl(725.6nm)和Ar(696.5nm)的相对强度比随SiCl4含量变化的特性曲线
2.2薄膜的表征
在优化条件下(维持放电的Ar流量为1.5L·min-1,SiCl4含量为6113×10-6)在KBr和Si基底上分别沉积薄膜.实验所使用双频功率源为50 kHz/33 MHz,沉积时间为3 min和5 min.所沉积薄膜面积约为25 mm2.分别使用扫描电子显微镜(SEM)、X射线光电子能谱(XPS)以及傅里叶红外光谱(FT-IR)对所沉积薄膜的形貌、化学成分和化学结构进行了表征.
SEM结果显示所沉积薄膜的生长方式为典型的复合生长(Stranski-Krastanov型)模式[17],即在成膜初期,按二维层状生长(Frank-Van der Merwe型)模式生长,形成层之后,生长模式转化为岛状生长(Volmer-Weber型),如图4a所示.图4b为沉积5 min所得薄膜的断面形貌,可以看出整体呈竹笋状生长.由图4c和图4d可以看出薄膜是由粒径为400 nm左右的球形颗粒团簇而成,并且薄膜整体较为均匀.
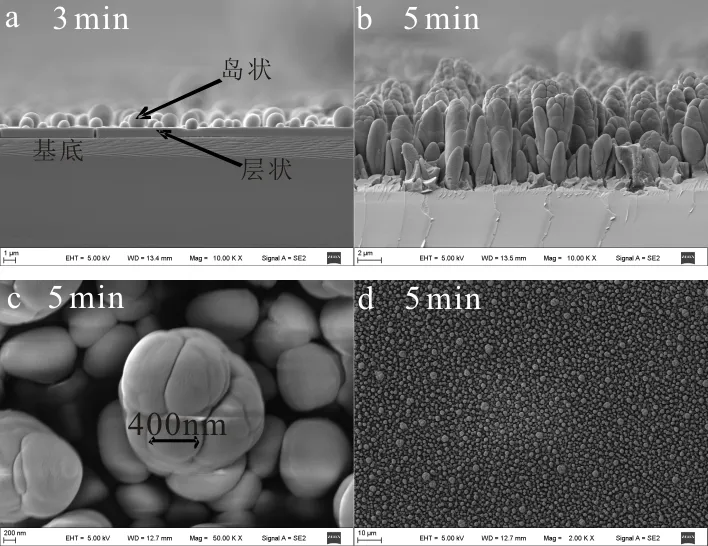
图4 不同放大倍数下薄膜的SEM形貌

Relativeatomicconcentration(at.%)C1sO1sSi2pCl2p19.5658.3621.860.22
表2为X射线光电子能谱(XPS)测得沉积5 min所得薄膜的化学成分.其中Si2p和O1s明显可见,同时也可以看到有少量的Cl2p出现,除此之外,所测结果显示有一定量的C1s.各元素相对原子浓度(at.%)分别为C1s(19.56),O1s(58.36),Si2p(21.86),Cl2p(0.22).其中,C1s来源于XPS检测过程中的污染碳(以C1s作为标准进行校准)以及薄膜制备之后放置时会吸附一定量空气中的CO2,尤其氧化类薄膜吸附能力较强,因此,部分O1s也应由薄膜吸附而来.图5给出了薄膜中Si2p和O1s的XPS谱图.Si2p和O1s的峰分别位于103.35 eV和532.65 eV.结合能为103.35 eV的Si2p和532.65 eV的O1s归属于Si-O-Si 基团.这表明Si和O在薄膜中以SiO2的形式存在[18].参杂有Cl的SiO2薄膜既保持了纯SiO2薄膜的很多结构和性质,又提供了一些潜在的微电子应用方面的优势,比如闸极绝缘层里的Cl物种能够钝化钠离子杂质,从而减少界面态[12].

图5 薄膜中Si2p和O1s的XPS谱图
采用傅里叶红外光谱(FT-IR)分析技术可以分析所沉积薄膜的化学结构.图6为所沉积薄膜的FT-IR图.可以看出三个主要的吸收波段,分别位于波数为1 060~1 070 cm-1,805~810 cm-1和480~490 cm-1[18,19],它们分别代表Si-O-Si中氧原子的伸展、弯曲和振动.此外,在波段为3 380~3 620 cm-1和 930~945 cm-1处出现两个Si-OH的特征吸收峰[18-20].沉积过程主要伴随着的化学反应过程有SiCl4+O2→SiO2+Cl2和H2O+Si-Cl→Si-OH+HCl[12].因此在沉积过程中随着SiCl4的分解会产生一定量的自由Cl、Cl2以及Si-Cl自由基.在FT-IR图中位于500~700 cm-1之间的一些较微弱的峰应该归属于SiCl(470~550 cm-1),SiCl2(460~540 cm-1,535~595 cm-1),或者SiCl3(450~535 cm-1,570~625 cm-1)基团[19].
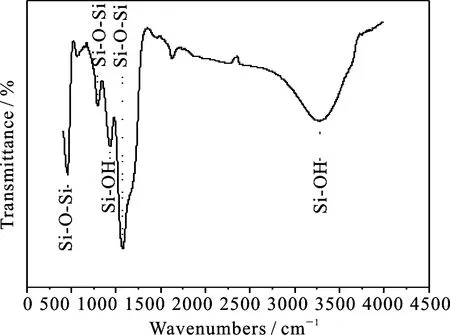
图6 薄膜的FT-IR光谱
3 结论
采用双频(50 kHz/33 MHz)驱动的大气压冷等离子体射流装置,以Ar作为携带气体,SiCl4作为源材料,并借助空气中的氧气作为氧化剂成功制备了SiO2薄膜.SEM显示薄膜是由大小为400 nm左右的球形颗粒团簇生长而成,并且较为均匀.XPS表明组成薄膜的化学成分主要为Si、O以及少量的Cl,并且Si和O是以SiO2的形式存在.FT-IR显示薄膜中的化学结构主要为Si-O-Si和Si-OH键.
[1]WANG C A,HUANG R K,SHIAU D A,et al.Monolithically series-interconnected GaInAsSb/AlGaAsSb/GaSb thermophotovoltaic devices with an internal backsurface reflector formed by wafer bonding[J].Appl Phys Lett,2003,83(7):1286.
[2]SHIBAYAMA H,HASUO S,YAMAOKA T,Formation of low defect density SiOxfilms for Josephson integrated circuits[J].Appl Phys Lett,1985,47(4):429.
[3]MAGERLEIN J H,BAKER J M,PROTO G R,et al.Low defect density insulating films deposited on room temperature substrates[J].J Vac Sci Technol B,1984,2(4):636.
[4]HASS G,SALZBERG C D.Optical properties of silicon monoxide in the wavelength region from 0.24 to 14.0 microns[J].Vacuum,1954,4(3):222.
[5]HEDENQVIST M S,JOHANSSON K S.Barrier properties of SiOx-coated polymers:multi-layer modelling and effects of mechanical folding[J].Surf Coat Technol,2003,172(1):7.
[6]JAIN A,ROGOJEVIC S,PONOTH S,et al.Porous silica materials as low-k dielectrics for electronic and optical interconnects[J].Thin solid Films,2001,398(2):513.
[7]KITAZAWA N,NAMBA H,AONO M,et al.Sol-gel derived mesoporous silica films using amphiphilic triblock copolymers[J].J Non Cryst Solids,2003,332(1):199.
[8]YANG P Z,LIU L M,MO J H,et al.Characterization of PECVD grown porous SiO2thin films with potential application in an uncooled infrared detector[J].Semicond Sci Technol,2010,25(4):45017.
[11]KIM Y S,LEE J H,LIM J T,et al.Generation of size and structure controlled Si nanoparticles using pulse plasma for energy devices[J].Thin Solid Films,2009,517(14):4184.
[12]ALONSO J C,VAZQUEZ R,ORTIZ A,et al.Effect of hydrogen dilution on the remote plasma enhanced chemical vapor deposition of chlorinated SiO2films[J].J Vac Sci Technol,1998,16(6):3211.
[13]ZHOU Y J,YUAN Q H,LI F,et al.Nonequilibrium atmospheric pressure plasma jet using a combination of 50 kHz/2 MHz dual-frequency power sources[J].Phys Plamsa,2013,20:113502.
[14]WANG X M,YUAN Q H,ZHOU Y J,et al.Deposition of carbonaceous thin-film using atmospheric pressure microplasma driven with 2 MHz/50 kHz dual-frequency excitations[J].Plasma Sci Technol,2014,16(1):68.
[15]BENISSAD N,BOISSE-LAPORTE C,VALLEE C,et al.Silicon dioxide deposition in a microwave plasma reactor[J].Surf Coat Technol,1999,116-119:868.
[16]GRANIER A,VERVLOET M,AUMAILLE K,et al.Optical emission spectra of TEOS and HMDSO derived plasmas used for thin film deposition[J].Plasma Sources Sci Technol,2003,12:89.
[17]田民波.薄膜技术与薄膜材料[M].北京:清华大学出版社,2006.
[18]PLISKIN W A,VAC J.Comparison of properties of dielectric films deposited by various methods[J]. J Vac Sci Technol,1977,28(5):1064.
[19]SOCRATES G.Infrared Characteristics Group Frequencies Tables and Charts[M].New York:Wiley,1994.
[20]THEIL J A,TSU D V,WATKINGS M W,et al.Local bonding environments of Si-OH groups in SiO2deposited by remote plasma-enhanced chemical vapor deposition and incorporated by postdeposition exposure to water vapor[J].J Vac Sci Technol,1990,8(3):1374.
(责任编辑孙对兄)
Deposition of SiO2film by using Ar/SiCl4atmospheric pressure plasma jet
YUAN Qiang-hua,CHANG Xiao-wei,LI Jiao-jiao,YIN Gui-qin
(Key Laboratory of Atomic and Molecular Physics and Functional Materials of Gansu Province, College of Physics and Electronic Engineering,Northwest Normal University,Lanzhou 730070,Gansu,China)
SiO2thin film has been deposited using an atmospheric pressure plasma jet(APPJ) driven by dual-frequency excitations(50 kHz/33 MHz) with Ar as the carrying gas,SiCl4as the source material and oxygen in the air as oxidizing substances.Plasma composition is characterized by optical emission spectroscopy(OES).The content of SiCl4and the change of species in the plasma is studied by OES technique.According to the results,the deposition condition is optimized.Morphology and structure of the thin films are characterized by scanning electron microscopy(SEM),X-ray photoelectron spectroscopy(XPS) and Fourier transform infra-red(FT-IR) spectroscopy.XPS shows that chemical composition of the thin film is Si,O and a small amount of Cl.FT-IR points out that the chemical structure of the thin film is mainly Si-O-Si and Si-OH bonds.
atmospheric pressure plasma jet;dual-frequency excitation;SiO2thin film
10.16783/j.cnki.nwnuz.2016.02.009
2015-10-05;修改稿收到日期:2015-12-20
国家自然科学基金资助项目(11165012);甘肃省自然科学基金资助项目(145RJZA159)
袁强华(1974—),男,江苏南通人,副教授,博士,硕士研究生导师.主要研究方向为低温等离子体物理.
E-mail:yqh0669@126.com
O 539
A
1001-988Ⅹ(2016)02-0038-05
