AlGaN/GaN HEMT电容及充电时间的研究*
2016-08-18侯斌武赵红东夏士超宋晓敏席瑞媛李梦宇
侯斌武,赵红东,夏士超,宋晓敏,卢 俏,席瑞媛,李梦宇
(河北工业大学信息工程学院电子材料与器件天津市重点实验室,天津300401)
AlGaN/GaN HEMT电容及充电时间的研究*
侯斌武,赵红东*,夏士超,宋晓敏,卢俏,席瑞媛,李梦宇
(河北工业大学信息工程学院电子材料与器件天津市重点实验室,天津300401)
通过计算AlGaN/GaN HEMT二维电子气中的电势、载流子以及调制掺杂载流子寿命,得到AlGaN/GaN HEMT电容和充电时间,研究了AlGaN掺杂层浓度和厚度对器件的时间响应,并分析了AlGaN/GaN HEMT器件的高频特性。结果表明,栅电容随着AlGaN掺杂层浓度和厚度的增加逐渐减小。随着AlGaN层掺杂浓度的增大,电容充电时间先减后增,当掺杂浓度达到1.24×1019cm-3时,电容充电时间达到极小值,在AlGaN掺杂层厚度等于7 nm时电容充电时间最短。
AlGaN/GaN HEMT;频率;电容充电时间;掺杂浓度;厚度
AlGaN/GaN作为第三代半导体异质结材料,其宽禁带和高电子迁移率等优良特性使得AlGaN/GaN HEMT器件具有高击穿电场、低噪声、宽带宽以及较高工作温度诸多优点[]1-6,广泛地应用于雷达、航空航天、无线通信、汽车电子、电力传输等领域[7-11]。在近十年来,科研人员对于高频大功率HEMT器件的研究尤为重点。2008年,Wong等[12]制造的N极性AlGaN/GaN HEMT器件,栅长为0.7 μm时,输出功率为7.1 W/mm,频率4 GHz,分别达到17 GHz和37 GHz的电流和功率增益截止频率。2010年,Feng等采用氟离子注入技术制造了阈值电压为0.2 V的增强性HEMT,最大输出功率3.65 W/mm,频率18 GHz,增益11.6 dB[]13。2012年,国外报道的GaN HEMT功率放大器,工作频带2.6 GHz~3.0 GHz,输出功率45 W,增益12.5 dB[14]。
对于AlGaN/GaN HEMT器件的研究,虽然实验开展了高频特性的研究,但是在理论设计方面大多是以直流特性为主,本文对器件频率从充电时间入手进行分析与优化。实验通过减小电容值和增大电子迁移率提高器件频率。
1 器件结构和物理模型
1.1器件结构
器件的接触电极为N型掺杂,掺杂浓度为5× 1018cm-3。AlGaN层的厚度为25 nm,GaN层的厚度为3 μm。AlGaN与GaN接触部分,AlGaN层为P型掺杂,厚度为5 nm,上缓冲层厚度为1 nm。GaN层为N型掺杂,厚度为5 nm,下缓冲层厚度为5 nm。AlN层厚度为20 nm。.蓝宝石衬底厚度为2 μm。本文通过改变AlGaN层的掺杂浓度与厚度来影响电容及其充电时间的大小,找出变化规律,提高器件频率。结构模型如图1所示。
项目来源:河北省自然科学基金项目(F2013202256)
收稿日期:2015-07-24修改日期:2015-08-27
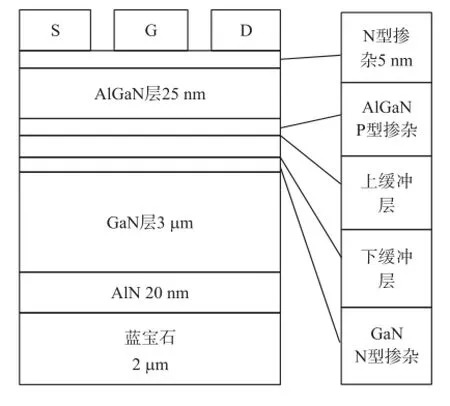
图1 GaN HEMT器件结构
1.2物理模型
半导体中电子满足有效质量方程[15]:

式中,ℏ为普朗克常量,m*(z)为与z方向有关的电子有效质量,ψk()z为二维电子气的波函数,EC(z)为导带底能量,Ek为二维电子气的本征能级。式(1)描述了异质结界面的导带底势阱对电子限制作用。
半导体中电势满足泊松方程的牛顿法模型[]

式中,ε为静态介电常数,ε0为真空介电常数,V为电势,N+D(V)为电离杂质浓度,n3D(V)为体电子密度。
异质结界面的调制掺杂散射[]

式中,τMD为调制掺杂载流子的寿命,ND为调制掺杂浓度,kF为费米波矢,d1和d2分别为势垒层调制掺杂部分的边界与异质界面的距离。
电流密度:

式中,μp和 μn分别为空穴和电子的迁移率,Dp和Dn分别为空穴和电子的扩散系数。
二维电子气面电子密度方程:

式中,σpol(x)为界面的极化面电荷,ε(x)为相对介电常数,ΔEF为GaN导带底与费米能级的能极差,ΔEC(x)为界面带阶,d为AlGaN的势垒层厚度,di为掺杂层厚度。
电容充电时间的长短主要取决于电子迁移率和电容值的大小。电容值小,电子迁移率大,则电容充电时间短。因此,要缩短电容充电时间需要增大电子迁移率和减小电容。
最大振荡频率计算公式[15]:

式中,fT为截止频率,RG为栅串联电阻,RS为源电阻,RD为漏电阻,CGD为栅漏极电容。由式(7)关系可知,要提高 fmax需要提高 fT,减小栅串联电阻RG和源电阻RS。
截止频率计算公式:

式中,g*m为本征跨导,CG为栅极电容。由式(8)可知,要提高 fT需要减小栅电容CG。综上可知,本实验通过改变AlGaN层掺杂浓度和掺杂层厚度来增大电子迁移率和减小栅电容从而缩短电容充电时间提高响应时间和提高截止频率来提高器件最大振荡频率。
2 结果与讨论
2.1掺杂浓度对电容及其充电时间的影响
模型AlGaN层掺入P型杂质,GaN层掺入N型杂质,N型掺杂浓度大于P型掺杂浓度,因此二维电子气沟道仍为N型。GaN层N型掺杂使得导带电子浓度更大,电势更高,有效防止沟道电子溢出,而AlGaN层P型掺杂加强对沟道的限制作用。此种掺杂对三角形势阱的作用如图2所示。

图2 P型掺杂对三角形势阱的作用
由图2可知,AlGaN层P型掺杂质掺杂浓度的增大可加深三角形势阱的深度,加强导带底势阱对电子的限制作用。
选取AlGaN层P型掺杂浓度为1.22×1019cm-3,1.23×1019cm-3,1.24×1019cm-3,1.25×1019cm-3进行仿真。结果如图3和图4所示。

图3 电子迁移率分布图
图3中,以颜色紫、蓝、黄、红层次有序的显示出了电子迁移率由小到大的分布。纵坐标单位长度为5 nm。从图3中可以看出,0至5 nm层紫色偏深,电子迁移率较大,加入的N型掺杂层降低电阻率。由于AlGaN/GaN异质结反型层形成三角形势阱,在栅极电压控制下,载流子集中于三角形势阱形成的二维电子气沟道中,图3中横线所在纵坐标25 nm处可见,栅极下方电子迁移率明显较高。对此部分仿真如图4所示。

图4 掺杂浓度与电子迁移率的关系
图4中,图中央竖线为二维电子气沟道所在,纵坐标为沟道电子迁移率。由图4可知,当AlGaN层的掺杂浓度小于1.24×1019cm-3时,随着掺杂浓度的增大,电离杂质散射增强,电子迁移率逐渐增大;当AlGaN层的掺杂浓度大于1.24×1019cm-3时,随着掺杂浓度增大,沟道内散射增强,电子迁移率逐渐减小。因此,掺杂浓度为1.24×1019cm-3时,电子迁移率达到最大值。
图5中,横坐标为栅极电压,纵坐标为栅电容,不同曲线代表不同掺杂浓度器件的栅电容。由图5可知,随着AlGaN层掺杂浓度的增大,电容值逐渐减小。掺杂浓度为1.24×1019cm-3时,电容值最小。

图5 掺杂浓度与电容的关系
图6中,横坐标为时间,纵坐标为输出电流,不同曲线代表不同掺杂浓度器件的响应。图中每条电流曲线上升下降过程为电容充电时间。由图6可知,当AlGaN层的掺杂浓度小于1.24×1019cm-3时,随着掺杂浓度的增大,电容充电时间变短;当AlGaN层的掺杂浓度大于1.24×1019cm-3时,随着掺杂浓度增大,电容充电时间变长。当掺杂浓度为1.24×1019cm-3时,电容充电时间最短。

图6 掺杂浓度与电容充电时间的关系
2.2掺杂层厚度对电容及其充电时间的影响
图7中,横坐标为栅极电压,纵坐标为栅电容,不同曲线代表不同掺杂层厚度器件的栅电容。由图7可知,电容值随着AlGaN层掺杂厚度的增大而减小。当掺杂厚度为7 nm时电容值最小。

图7 掺杂层厚度与电容的关系
图8中横坐标为时间,纵坐标为输出电流,不同曲线代表不同掺杂层厚度器件的响应。由图7可知,在AlGaN层掺杂厚度小于7 nm时电容充电时间基本保持不变,随着厚度继续变厚充电时间会逐渐变长。掺杂层厚度为7 nm时电容充电时间最短。

图8 掺杂层厚度与电容充电时间的关系
3 结论
本文仿真分析了AlGaN层掺杂浓度和掺杂层厚度对电容值大小和电容充电时间的影响,通过增大电子迁移率和减小栅电容来缩短电容充电时间提高响应、减小电容值来提高截止频率从而提高器件最大振荡频率。最后得出结论,当AlGaN层的掺杂浓度为1.24×1019cm-3时,电容充电时间最短,电容值最小;当AlGaN层的厚度为7 nm时,保证电容充电时间最短的同时,电容值最小。由此可见,当AlGaN层的掺杂浓度为1.24×1019cm-3、掺杂层厚度为7 nm时,可有效提高器件最大振荡频率。
[1] Lee S,Vetury R,Brown J D,et al.Reliability Assess-Ment of AlGaN/GaN HEMT Technology on SiC for 48 V Applications[C]// IEEE International Reliability Physics Symposium,2007:446-449.
[2] 陈雪成,周爱民,高建军.用改进的差分进化算法提取HEMT小信号模型的参数[J].电子器件,2013,36(3):363-366.
[3] 孙世滔,蔡摇斐,李摇川,等.GaN HEMT非线性输出电容寄生参数研究[J].电子器件,2013,36(6):760-764.
[4] 刘果果,魏珂,郑英奎,等.AlGaN/GaN HEMTs器件布局对器件性能影响分析[J].电子器件,2008,31(6):67-69.
[5] Wang J,Sun L,Liu J.A Surface-Potential-Based Compact Core Modelfor GaN HEMTs[J].Journal ofMicrowaves,2012,6(1):1.
[6] Saito W,Nitta T,Kakiuchi Y,et al.A120W Boost Converter Operation Using a High-Voltage GaN-HEMT[J].IEEEE DL,2008,29 (1):8-9.
[7] Cathy Lee,Paul Saunier,Jinwei Yang,et al.AlGaN-GaN HEMTs on SiC With CW Power Performance of 4 W/m mand 23%PAE at 35 GHz[J].IEEE Electron Device Letters,2003,24(10):616.
[8] Jimenez J L,Chowdhury U.X-band GaN FET Relia-Bility[C]// IEEE InTernational Reliability Physics Symp-Osium,2007:429-435.
[9] 郝跃,薛军帅,张进成.III族氮化物InAlN半导体异质结研究进展[J].中国科学(信息科学),2012,42(12):1577-1587.
[10]贾晓娟,张斌珍,刘俊.GaAs基PHEMT加速度传感器的研究[J].传感技术学报,2010,23(2):188-191.
[11]Meiners J.Sulationand Designofa Submicron Gate Length AIGaN/ GaN HEMT[D].Cineinnati:UniversityofCineinnati,2007:88-93.
[12]Wong M H,Chu R M,Rajan S,et al.N-Face Metal-Insulator-Semiconductor High-Electron-Mobility Transistors with AlN Back Barrier[J].IEEE Electron Dev Lett,2008,29:1101-1103.
[13]Feng Z H,Zhou R,Xie S Y,et al.18-GHz 3.65 W/mm Enhancement-ModeAlGaN/GaN HFET Using Fuorine Plasmaion Implantation[J].IEEE ElectronDev Lett,2010,31:1386-1388.
[14]Chéron J,Michel C,Denis B.Design of A55 Wpackaged GaN HEMT with 60%PAE Byinternal Matching in S-Band[C]//IntegratedNonlinearMicrowaveandMillimetre-WaveCircuits (INMMIC2012).Dublin:IEEE,2012:1-3.
[15]郝跃,张金凤,张进成.氮化物宽禁带半导体材料与电子器件[M].北京:科学出版社,2013:66-86.

侯斌武(1989-),男,河北保定人,硕士研究生,主要研究方向为半导体器件结构与物理;houbinwu@163.com;

赵红东(1968-),男,河北省,博士,教授,博士生导师,主要从事半导体器件方向研究,zhaohd@hebut.edu.cn。
Research on Capacitance and Charging Time of AlGaN/GaN HEMT*
HOU Binwu,ZHAO Hongdong*,XIA Shichao,SONG Xiaomin,LU Qiao,XI Ruiyuan,LI Mengyu
(Tianjin Key Laboratory of Electronic Materials and Device,College of Information Engineering,Hebei University of Technology,Tianjin 300401,China)
The AlGaN/GaN HEMT two-dimensional electron gas of the electric potential,carrier life and modulation doped carrier life were calculated.The AlGaN/GaN HEMT capacitance and charging time were got,device time response for the AlGaN layer doping concentration and its thickness were studied and the AlGaN/GaN HEMT devices of high frequency characteristics was analysised.Results show that gate capacitance decreases gradually with the increase of doping concentration and thickness of the AlGaN layer.The capacitance charging time reduction first then increases with the increase of doping concentration of AlGaN layer,when doping concentrations reach a minimum at 1.24×1019cm-3;when the AlGaN doping layer thickness is equalto 7 nm,the capacitance charging time is the shortest。Key words:AlGaN/GaN HEMT;frequency;capacitance charging time;doping concentration;thickness;
TN325.3
A
1005-9490(2016)03-0531-04
EEACC:256010.3969/j.issn.1005-9490.2016.03.007
