纳米薄膜厚度标准物质的均匀性及稳定性监测*
2015-12-10
纳米薄膜厚度标准物质的均匀性及稳定性监测*
徐建郝萍周莹 / 上海市计量测试技术研究院
摘要通过选用X射线光电子能谱(XPS)测量方法,对上海市计量测试技术研究院所研制的纳米薄膜厚度标准物质的组成及化合态进行了分析,并考察了薄膜厚度的均匀性和稳定性。实验结果表明,所研制的标准物质的薄膜组成为氧化钽,薄膜的均匀性以及在监测期内的稳定性良好。该标准物质可以作为产品质量控制、设备校准以及测试方法验证的国家计量器具使用,完全满足标准物质使用要求。
关键词纳米厚度薄膜;标准物质;均匀性;稳定性
0 引言
纳米薄膜指厚度处在纳米数量级(1~100 nm)的薄膜。这类薄膜具有显著的晶界效应、尺寸效应和量子效应,在电学、光学等多方面表现出奇异特性,并在太阳能电池、存储器、气体传感器以及功能薄膜涂层、镀层等领域得到广泛应用[1]。
纳米薄膜具有如此广泛的应用,然而纳米薄膜的厚度往往又决定了其最终产品性能的高低,因此如何有效控制薄膜的厚度以及对薄膜厚度的准确测量成为当前高新技术和先进制造领域迫切需要解决的问题[2]。
随着微电子、光电子技术及纳米科技的飞速发展,所制备的薄膜材料厚度越来越薄,大规模集成电路以及光电子器件等领域所使用的薄膜厚度都小于100 nm,其中集成电路的栅极材料以及磁性隧道结中的绝缘层等更是薄到1~3 nm。为了对所用薄膜的结构和特性有更精确的控制,对薄膜的有效分析也随之变得越来越重要。同时,为确保薄膜测量结果的准确,需要为测量仪器提供可供量值溯源的薄膜厚度标准物质。对于标准物质而言,其均匀性和稳定性是非常重要的评定依据。
本文采用XPS膜厚测量方法,对纳米薄膜厚度标准物质GBW(E)130419的均匀性和稳定性进行有效监测,考察了其均匀与稳定性能。
1 样品制备及分析方法
本文所用的样品为上海市计量测试技术研究院研制的纳米薄膜厚度标准物质GBW(E) 130419。该标准物质是在金属钽片上通过阳极氧化获得的氧化钽薄膜,标称厚度为30 nm。
本文选用X射线光电子能谱仪(XPS)结合惰性离子溅射深度剖析方法测量纳米薄膜的厚度,并考察纳米薄膜的均匀性及稳定性,样品溅射及采谱分析示意图见图1。本实验以溅射剖析中氧化钽中氧的质量分数下降到上平台值的50%时所对应的溅射时间标尺的位置来确定氧化膜的厚度,如图2所示。

图1 在XPS深度剖析实验过程中离子溅射和采谱区域
2 纳米薄膜组成和化合态表征
为了确定纳米薄膜的化学组成,选用XPS技术对纳米薄膜进行分析,测量结果如图3所示。由图3 (a)可知,纳米薄膜由Ta、O和C元素组成,其中C元素为污染碳。从图3(b)可知,Ta 4f7/2和Ta 4f5/2峰分别在26.4 eV和28.4 eV,对应Ta2O5中Ta的化合态。图3(c)中O元素也可以通过分峰拟合为2种化合态,O 1 s的峰位为530.8 eV和532.1 eV,分别对应Ta2O5中O的化合态和表面羟基O的化合态。测量结果表明,所制备的纳米薄膜的成分为Ta2O5,完全符合薄膜标准物质所标明的组成。
3 纳米薄膜厚度标准物质均匀性检测
均匀性是标准物质最基本的属性,良好的均匀性是标准物质必须具备的基本条件,它是保证标准物质全部分析结果一致性的前提。均匀性检验方法很多,有方差法、极差法、区间法和三分之一法等,其中方差法和极差法经多年的实践证明是可靠的,已得到广泛应用。本文在薄膜厚度标准物质的均匀性检验中使用方差法[3-5]。
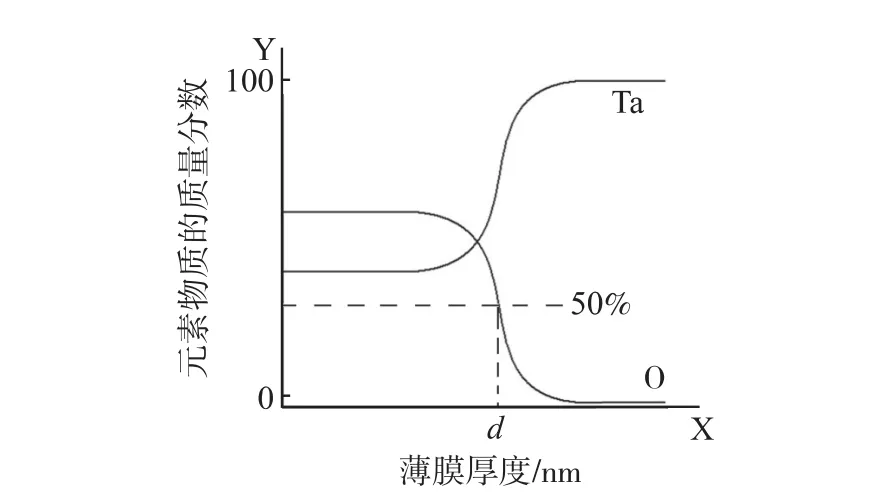
图2 纳米薄膜深度剖析及厚度测量

图3 GBW(E) 130419纳米薄膜的XPS谱图
根据《标准物质管理办法》和JJF 1006-1994 《一级标准物质技术规范》中的相关规定,对纳米薄膜厚度标准物质的均匀性进行检验。从100片标准物质样品中随机抽取15片,每片进行3次测量。均匀性监测数据汇总见表1。
方差分析法是通过组间方差和组内方差的比较来判断各组测量值之间有无系统性差异,如果两者的比小于统计检验的临界值,则认为样品是均匀的。
具体做法为:在抽取的15片样品中,每片样品做3次测量,得到15片样品的总平均值。


表1 GBW(E) 130419纳米薄膜厚度均匀性监测数据

4 纳米薄膜厚度标准物质稳定性检验
为了评价该纳米薄膜厚度标准物质的稳定性,需在样品贮存期间进行定期抽样测试。为了定量说明样品放置一段时间后与初始值的一致性,主要考察了常规贮存条件对纳米级薄膜标准物质的稳定性影响。样品存储条件为室温(20±5)℃,湿度(60 ±20)%。稳定性监测持续时间为360 d,先密后疏,分别为0 d、15 d、30 d、60 d、90 d、120 d、150 d、180 d、270 d和360 d。
长期稳定性的研究是在不同的时间(例如,以d为单位)积累特性值的测量数据。GBW(E)130419纳米薄膜厚度稳定性监测数据见表2。

表2 GBW(E)130419纳米薄膜厚度稳定性监测数据
将表2中数据,以x代表时间,以y代表纳米薄膜厚度标准物质的特性值,拟合成一条直线,则有斜率b1

斜率的不确定度s(b1)用下式表示

自由度为n-2和p = 0.95(95%置信水平)的分布,t0.95,8因子通过查表为2.31。
满足│b1│ < t0.95, n-2·s(b1)
故斜率是不显著的,即表明未观测到样品的不稳定性,即纳米薄膜厚度标准物质样品在监测期内是稳定的。
5 结语
通过对上海市计量测试技术研究院研制的纳米薄膜厚度标准物质进行薄膜组成、均匀性以及常温贮存条件下的稳定性分析和监测,结果表明,所研制的标准物质的材质组成为氧化钽,薄膜的均匀性以及在监测期内的稳定性良好,可以作为产品质量控制、设备校准以及测试方法验证的国家计量器具使用,完全满足使用要求。
参考文献:
[1] 蓝闽波.纳米材料测试技术[M].上海:华东理工大学出版社,2009.
[2] 徐勇军,李秀平,罗列,等.XPS对多层膜中单层膜厚的测定[J].分析测试学报,2008,27(9),1005-1007.
[3] 国家标准物质研究中心.JJF 1006-1994[S].北京:中国计量出版社,1994.
[4] 全浩,韩永志.标准物质及其应用技术[M].北京:中国标准出版社,2003.
[5] 韩永志.标准物质定值原则和统计学原理[M].北京:中国质检出版社,2011.
Uniformity and stability test of nano-film thickness reference material
Xu Jian, Hao Ping, Zhou Ying
(Shanghai Institute of Measurement and Testing Technology)
Abstract:In this paper, the composition and chemical state of the nanofilm thickness reference material which developed by Shanghai Institute of Measurement and Testing Technology are analyzed by using X-ray photoelectron spectroscopy (XPS) method, and the uniformity and stability of film thickness are also investigated. The results show that the nano-film of the reference material is composed of tantalum pentoxide. The uniformity of the nano-film and the stability of the film during the monitoring period are good. The reference material can be used as the national measurement apparatus for the product quality control, instrument calibration and measurement method validation, which fully meet the requirements of the use of the reference material.
Key words:nano-film thickness; reference material; uniformity; stability
* 基金项目:上海市质量技术监督局科研项目(2013-49),上海市科委标准化专项(13dz0502400)
