碳化硅材料及技术研究进展
2015-04-23刘义鹤江洪
刘义鹤 江洪
一、引言
在半导体材料的发展历史上,通常将硅(Si)、锗(Ge)称作第1代半导体。将砷化镓(GaAs)、磷化铟(InP)、磷化镓(GaP)等为代表的合金半导体称作第2代半导体。在其之后发展起来的宽带隙半导体,碳化硅(SiC)、氮化镓(GaN)、氮化铝(AlN)及金刚石等称为第3代半导体。SiC作为第3代半导体的杰出代表之一,相比前2代半導体材料,具有宽带隙、高热导率高、较大的电子饱和漂移速率、高化学稳定性、高击穿电场高等诸多优点,在高温、高频、大功率器件[1-3]的制作上获得广泛应用。SiC晶体有着很多不同的多型体,不同多型体的禁带宽度在2.3~3.3eV之间,因而,SiC也被用于制作蓝、绿和紫外光的发光[4]、光探测器件[5],太阳能电池[6],以及智能传感器件[7]等。另外,SiC能够氧化形成自然绝缘的二氧化硅(SiO2)层,同时也具有制造各种以金属-氧化物-半导体(MOS)为基础的器件的巨大潜能[8]。表1给出了不同多型体SiC和其他半导体材料相比的主要物理性质。
二、SiC的生长方式进展
近10年,SiC及其纳米材料的制备方式通常有碳纳米管模板辅助法、电弧放电法、激光法、溶胶凝胶和碳热还原法、化学气相沉积法,以及高频电感加热法制备。表2给出了不同生长方式的比较结果。
三、SiC应用进展
1.SiC功率器件
传统的硅基功率器件由于本身物理性质的限制——例如目前商用Si基绝缘栅双极晶体管(IGBT) 的最大击穿电压为6.5kV,目前所有的硅基器件都无法在200℃以上正常工作——很大程度上降低了功率器件的工作效率。而新一代基于宽禁带半导体的功率器件能够很好地解决这些问题。虽然GaN在高频与高压下表现更好,但SiC更易于制出高质量晶体,并且具有更高的热导率,因而SiC获得了更广的应用。
2.SiC功率整流器
相比Si,SiC的击穿电压高出一个量级。并且由于高导热性,SiC器件所需的冷却系统更小。SiC功率整流器通常有3种:①肖特基势垒管(SBD)具有高开关速度和低开启状态功耗。但是击穿电压较低,漏电流相对较大。②p-i-n管,能在高压下工作,漏电流小,但在开关状态转换时会出现反向恢复电荷。③结型势垒肖特基管(JBS),开启状态表现出肖特基管性质,而关闭状态表现出p-i-n管性质。
SiC肖特基管自2001年实现商用,其击穿电压和传导电流有着持续改进。由300V/10A发展1.2~1.7kV,以及50A的额定电流。目前,商用3.3kV击穿电压的肖特基管已经发布。SiC整流管并且已经被认为在600~3 000V范围内将取代Si基整流管。
高温场合的大面积3.3kV,正向电流范围为10~20A的肖特基管已经制备出来,例如在BepiColombo ESA任务中用于太空中恶劣环境的300V,5A肖特基势垒二极管[9]。另外,SiC SBD非常适用于高速开关应用,和Si基器件比起来,SiC SBD的反向恢复电荷更低。因此,SiC SBD非常适合作为续流二极管和Si基IGBT配合使用。图1给出了SiC三种整流器在25℃和300℃下的关断电流波形。
混合了p-i-n和肖特基结构的混合整流器由于同时具备p-i-n的高击穿电压和SBD的低反向恢复电荷而有着特殊吸引力。如今1.2kV的混合整流器已经实现商用,并且Infineon公司推出了第5代thinQ!TM系列650-V JBS二极管,该二极管基于一种薄晶片工艺,能以正温度系数容纳大电流和雪崩效应。另外,科锐(Cree)公司已经推出了在IGBT模块里作为反平行二极管使用的高电流(50A)JBS二极管,以及75~100A/1.2kV到20 A/10kV的JBS二极管。
由于可靠性问题(主要是正向电流漂移),市面上目前还没有SiC双极性晶体管。目前已报道的最高技术水平的SiC p-i-n二极管在180A(100A/cm2)电流下正向压降为3.2V,击穿电压为4.5kV,反向电流1μA[10]。事实上,击穿电压20kV的结构已经实现[11],但仍需解决半导体晶体质量问题才能获得商用。
3.SiC单极功率开关
在600V电压范围以内Si基金氧半场效晶体管(MOSFET)以及IGBT性能还能优于SiC基器件,但在1.2~1.7kV,Si基MOSFET由于有较大的传导性降低,而IGBT则在快速开关上表现出较高的动态损失。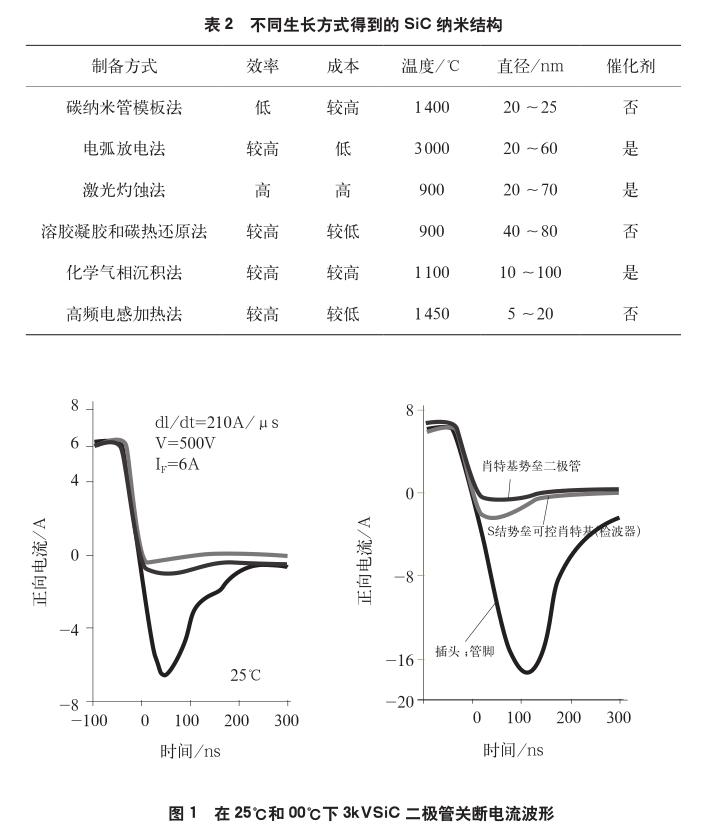
SiC基功率开关由于具有极低的开启态电阻,并且能应用于高压、高温、高频场合。因此是Si基器件的理想替代者。英飞凌(Infineon)公司推出了1.5kV、0.5Ω开启态电压的混合开关,应用于谐振变换器和电源。它包括1.5kV垂直SiC常开的JFET(如图2所示),和一个60Vn型导电沟道的Si基MOSFET共发射极共基极放大器[12];并且,Infineon公司还推出了一个1.2kV、70mΩ开启态电阻SiC基JFET开关[14]。这种解决方案能够让器件坚固性更强。
虽然这种SiC基JFET技术能够让器件耐压值达到4.5kV,但由于有低压的Si基 MOSFET集成,这种混合开关不能应用于高温场合。为了克服这种局限,新的SiC常关态沟道JFET被制备出来。这种新器件基于SiC p-n结自身的高电压,但同时,沟道电阻高,阈值电压低。因此为了获得高性能的常关SiC JFET仍需进一步研究。
由于目前能够制得的反型沟道迁移率非常低,推迟了低阻载流子的迁移率功率MOSFET器件的研制。近年来很多研究工作都集中于金属-氧化物-半导体(MOS)界面改善和MOSFET集成。Si基MOS器件最大的进展在于降低界面的捕获态密度(Dit)和改善器件表面形貌。行之有效的2项技术分别是将氮气或者三氯氧磷(POCl3)应用于退火、后氧化过程,以及在晶体其他晶面形成MOS沟道。


4.SiC双极功率开关
由于具有导电调制效应,SiC IGBT被认为是最具有高压应用潜力的功率器件。SiC基IGBT今年来获得很大研究热情,击穿电压超过10kV的结构也已经有报道[17]。并且,在不久预计能够将击穿电压提高到20~30kV[17]。MOS界面晶体质量和沟道内载流子迁移率是制备高性能IGBT的关键因素。另外,外延层的生长工艺也值得进一步研究改进。最近,科瑞公司推出了极高压4H-SiC基IGBT[18]。具体来说,4H-SiC基p型沟道IGBT,其面积6.7mm×6.7mm,有源区0.16cm2,具有15kV击穿电压,栅偏压-20V时室温差分特异性开启导通电阻24m?·cm2。而具有相同面积的4H-SiC基n沟道IGBT具有12.5kV击穿电压,栅偏压20V时,室温差分特异性开启导通电阻为5.3m?·cm2。
SiC基BJT虽然和p-i-n结型整流器一样有可靠性问题,但仍然具有广阔应用前景。这些器件近年来制备工艺技术已经发展得相当成熟了。例如,Cree公司推出了4kV,10ABJT,其有源区放大增益为34。芯片面积为4.24mm×4.24mm,能够在50μA漏电流下耐受4.7kV电压。室温下其开启和关闭时间分别为168和106ns。然而,由于基极区域不可避免地存在位错缺陷[21],SiC基BJT在正向压力下仍然表现出电流增益和正向电压的降低。
最后,一些SiC基GTO结构由于能够从传导调制性以及正向压降下的负温度系数获益而被研究出来。目前报道具有最高性能的结构是SiC换流关断晶闸管(SiC Commutated Gate turn-off Thyristor,SiC GT),其截面图如图3所示。
该结构击穿电压4.5kV,电流120A,芯片面积8mm×8mm,表面包裹一种新型耐400℃高温的环氧树脂。在120A电流下正向压降为5V,250℃,4.5kV偏压下漏电流小于5×10-6A/cm2,开启和关闭时间分别为0.2μs和1.7μs。另外,使用back-to-back系统12V直流总线,功率为120kW的3相转换器也利用的SiC GT和SiC基p-i-n晶体管集成制备出来。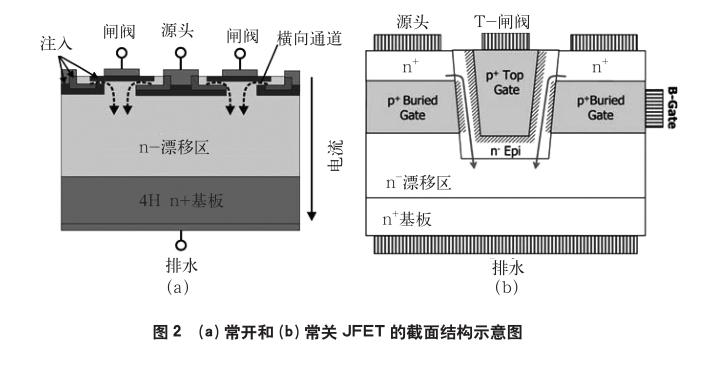
5.光电探测器领域领域
4H-SiC材料除了上述优越性能外,作制备为紫外光点探测器的材料,还具有一下优势:①可见光盲。4H-SiC在室温下的禁带宽度为3.26 eV,截止波长约为380.3nm,因此晶体质量好的4H-SiC制成的探测器几乎不会对可见光有响应。②在太阳盲光谱区域具有高量子效率。270~280nm范围的紫外光对ZnO和GaN等材料穿透深度小于0.1μm,而對4H-SiC穿深能达到1~5μm,因而更多光子能够到达器件有源区,从而提高量子效率。③漏电流小。由于4H-SiC本征载流子浓度只有10-8/cm3量级,因而4H-SiC器件漏电流比Si材料要小2个量级以上。④抗辐射,耐高温。⑤材料生长工艺成熟。表现在4H-SiC具有晶格匹配的生长衬底,2~4英寸的晶片以实现商用。
Sciuto等[19]制备出一种垂直结构4H-SiC基MSM结构探测器。该器件正面使用Ni2Si微结构肖特基接触叉指电极,背面为Ni做欧姆接触电极。1V偏压下暗电流为1pA左右。偏压50V下,暗电流仍小于200pA。在256nm光照下,光电流比暗电流增大2个数量级。效应度160mA/W,内量子效率78%。
传统Si基光电探测器工不能在超过125℃的温度下工作,高温下暗电流增大严重,且光学特性也发生改变,导致灵敏度和响应严重下降。SiC基器件却能解决该问题。Lien等人[20]制备出在450℃下具有高灵敏度的MSM探测器。其探测器在环境温度由25℃增加到400℃时,其光响应上升、下降时间分别由594μs和699μs分别增加到684μs和786μs,上升幅度很小。这时目前光电探测器正常工作能达到的最高温度。
波长范围为10~100nm的远紫外线(EUV)由于在半导体内穿透深度只有2nm~0.2μm,因此大部分紫外光在材料表面就被吸收,光生载流子多数在表面缺陷复合,无法到达耗尽区形成光电流,因此量子效率非常低。Xin等人[21]首次制备出一种大面积的4H-SiC EUV光电探测器。其截面示意图如图4所示。器件背面采用镍(Ni)电极,正面采用半透明肖特基势垒电极,材料为10nm镍和7.5nm铂层。其对260~280nm波长紫外光探测效率最高,为40%~45%,紫外可见抑制比>1×103。在120~200nm范围,量子效率随波长增加而增加,镍和铂金肖特基器件对120nm紫外光量子效率分别为4%和9%,对200nm则为15%~18%和20%。在21.5nm和77.5nm范围内量子效率则随波长减小而增加,分别为176%、147%。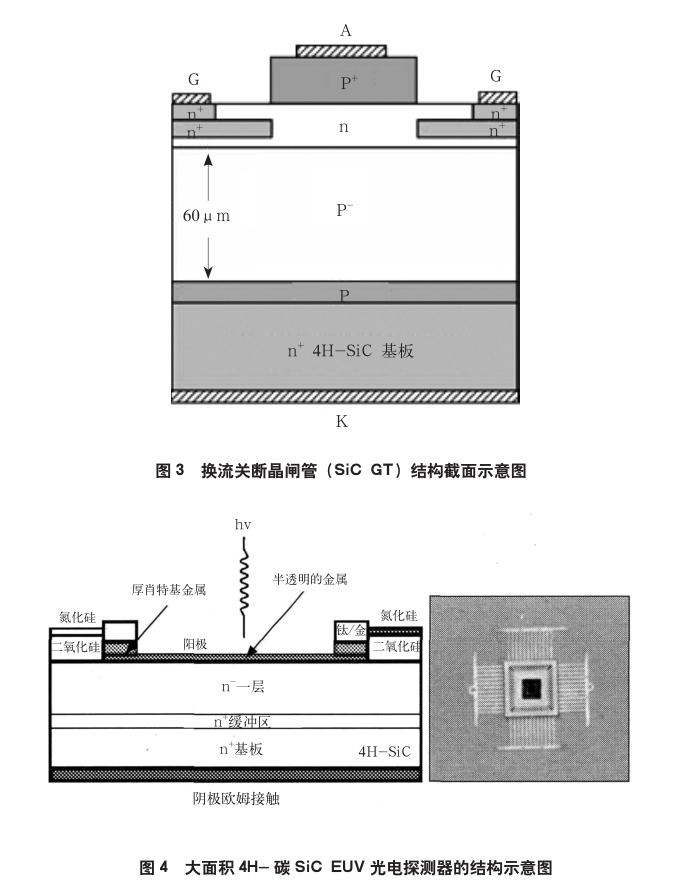
在探测器老化方面,据Siuto等人报道[22],他们分别用强度为1mW/cm2、中心波长256nm紫外光和256nm光强101mW/cm2的汞灯未分光,在60℃,10V偏压下连续照射探测器200h,这2种条件下器件的所有性能几乎保持不变。表明SiC基探测器能很好的经受高强紫外辐射。而Prasai等人[23]用强度4.2mW/cm2,中心波长254nm的低压汞灯对4H-SiC基pn结型光电探测器分别照射1.6h和93h。结果表明,探测器光电流在照射42h和72h后,光电流分别只下降了5%和4%,之后光电流稳定,进一步证实了4H-SiC基材料具备超强的抗紫外辐射性质。
雪崩倍增光电探测器方面,美国德克萨斯大学的坎贝尔课题组在4H-SiC基光电探测器作了一系列工作,降低器件暗电流,提高器件性能。他们首先对化学气相沉积法(PECVD)和热生长SiO2介质层对器件性能影响进行比较[24],结果表明热生长代替PECVD生长的SiO2层能将暗电流减小80%。他们总结为热生长的SiO2层具有更好的致密性,因而能对器件具有更好的钝化保护作用。他们随后比较了侧壁在垂直和具有10°倾角的情况下的I-V特性[25]。发现在低偏压时2种结构暗电流均较小,约1pA。但垂直侧壁结构器件在29V偏压下暗电流开始增加,达到雪崩电压时,暗电流增加2个量级。而具有倾斜侧壁的器件在雪崩击穿前基本不随电压变化。垂直侧壁器件当增益为50时会发生明显边缘击穿,而倾斜侧壁器件增益达到1 000时才会出现边缘击穿。表明针对雪崩光电管的侧壁进行结构改进能显著提高器件性能。
之后,該课题组进行了一系列结构创新,如双台面侧壁结构[26],凹槽光窗结构[27],质子注入隔离结构[28]等,使得器件按电流在增益1 000时小于5pA,增益达到与光电倍增管相当的水平,使雪崩光电二极管工作温度达到200℃,大幅提升器件击穿电压和光响应度。其最新雪崩光电管能够探测到fW量级(10~15W)的微弱紫外光,单光子计数模式的4H-SiC基雪崩管单光子监测率达到30%。
除了在功率器件以及光电器件方面取得的巨大进展,SiC复合材料,陶瓷材料,也由于所具有的优良性质获得极大发展。在传感器等方面也有广阔的应用的前景。
四、结语
近十几年来,为满足极端条件下半导体器件的应用需求,人们对SiC材料与器件进行了大量的研究工作,取得了非常多的成果。但SiC要充分发挥其应用潜力还有很多工作需要进一步进行与完善。其中继续改善SiC晶体生长工艺,降低生产成本,提高晶体质量,提高掺杂浓度等基础方面显得尤为重要。SiC材料在未来仍然具有极大的研究价值。相信不久,一系列性能更好,价格更低的SiC产品将出现于市场,造福人类社会。
参考文献
[1] Jia Hujun,Xing Ding,Zhang Hang,et al.RF characteristics for 4H-SiC MESFET with a clival gate[J].Materials Science in Semiconductor Processing,2015,40:777-780.
[2] Abdelwahed N,Troudi M,Sghaier N,et al.Impact of defect on I(V)instabilities observed on Ti/4H–SiC high voltage Schottky diodes[J].Microelectronics Reliability,2015,55(8):1169-1173.
[3] Zhao F,Du W, Huang C F.High-temperature mechanical properties of thermal barrier coated SiC/SiC composites by PIP process with a new precursor polymer[J].Surface and Coatings Technology,2014,258:146-153.
[4] Kamiyama S,Iwaya M,Takeuchi T,et al.White light-emitting diode based on fluorescent SiC[J].Thin Solid Films, 2012,522:23-25.
[5] Biondo S,Lazar M,Ottaviani L, et al.4H-silicon carbide thin junction based ultraviolet photodetectors[J].Thin Solid Films,2012,522:17-19.
[6] Heidarzadeh H,Baghban H,Rasooli H,et al.A new proposal for Si tandem solar cell:Significant efficiency enhancement in 3C–SiC/Si[J].Optik-International Journal for Light and Electron Optics,2014,125(3):1292-1296.
[7] Kumar R,Kushwaha A S,Srivastava S K.One-dimensional nano layered SiC/TiO2 based photonic band gap materials as temperature sensor[J].Optik - International Journal for Light and Electron Optics,2015,126(14):1324-1330.
[8] Soo M T,Cheong K Y,Noor A F M.Advances of SiC-based MOS capacitor hydrogen sensors for harsh environment applications[J].Sensors and Actuators B:Chemical,2010,151(1):39-55.
[9] Godignon P,Jorda X.SiC Schottky diodes for harsh environment space applications[J].IEEE Trans.Ind.Electron.,2011,58(7):2582-2590.
[10] Scarpa V,Kirchner U,Kern R.New SiC thin-wafer technology paving theway of Schottky diodeswith improved performance and reliability[J].Power Electron.Eur.,2012,3:30-32.
[11] Niwa H,Feng G,Suda J.Breakdown characteristics of 12-20 kV-class 4H-SiC PiN diodes with improved junction termination structures[M].in Proc.Int.Symp.Power Semicond.Devices ICs,2012:381-384.
[12] Stephani D,Todays and tomorrows industrial utilization of silicon carbide power devices[M].presented at the 10th Eur.Conf.Power Electron.Appl.,Toulouse,France,2003,1199.
[13] Okamoto D, Yano H, Hirata K, et al.Improved inversion channel mobility in 4H-SiC MOSFETs on Si face utilizing phosphorus-doped gate oxide[J].IEEE Electron Devices Lett.,2010,31(7):710-712.
[14] Wright N G,Poolami N,Vassilevski K V,et al.Benefits of high-k dielectrics in 4H-SiC trench MOSFETs[J].Mater. Sci.Forum,2004,457-460:1433-1436.
[15] Blanc C,Tournier D,Godignon P,et al.Process optimisation for <11-20>4H-SiC MOSFET applications[J].Mater. Sci.Forum,527-529:1051-1054.
[16] Das M K.Recent advances in(0001)4H-SiC MOS device technology[J],Mater.Sci.Forum,2004,457-460:1275-1280.
[17] Ryu S H,Capell C,Jonas C,et al.Ultra high voltage(>12kV),high performance 4H-SiC IGBTs[M].Semiconductor Science and Technology,2012:257-260.
[18] Buono B,Ghandi R,Domeij M.Current gain degradation in 4H-SiC power BJTs[J].Mater.Sci.Forum,2011,679–680:702-705.
[19] Sciuto A,Roccafore F,Franco S D,et al.High responsivity 4H-SiC Shottky UV photodiodes for UV-light detection[J].IEEE Photonics Technology Letters, 2009,21(23):1782-1784.
[20] Lien W C,Tsai D S,Lien D H,et al.4H-SiC metal-semiconductor-metal ultraviolet photodetectors in operation of 450°C[J].IEEE Photonics Technology Letters,2012,33(11):1586-1588.
[21] Xin X,Yan F,Koeth T W,et al.Demonstration of 4H-SiC visible-blind EUV and UV detector with large detection area[J].Electronics Letters,2005,41:21.
[22] Sciuto A,Mazzillo M, Raineri V,et al.On the aging effects of 4H-SiC Schottky phtodiodes under high intensity mercury lamp irradiation[J].IEEE Photonics Technology Letters,2010,22(11):775-777.
[23] Prasai D,John W,Weixelbaum L,et al.Highly reliable silicon carbide photodiodes for visible-blind ultraviolet detector applications[J].J.Mater.Res.,2013,28(1):33-38.
[24] Guo X,Beck A,Yang B,et al.Low dark current 4H-SiC avalanche photodiodes[J].Electronics Letters,2003,39:1673-1674.
[25] Beck A L,Yang B,Guo X,et al.Edge breakdown in 4H-SiC avalanche photodiodes[J].IEEE journal of Quantum Electronics,2004,40(3):321-324.
[26] Bai X,Guo X,Msintosh D C,et al. High detection sensitivity of ultraviolet 4H-SiC avalanche photodiodes[J].IEEE journal of quantum electronics,2007,43(12):1159-1162.
[27] Liu H,Zheng X,Zhou Q,et al.Double mesa side wall silicon carbide avalanche photodiode[J].IEEE Journal of quantum electronics,2009,45(12):1524-1528.
[28] Bai X,Liu H,Mcintosh D C,et al.High-detectivity and high-single-photon-detection efficiency 4H-SiC avalanche photodiodes[J].IEEE Journal of quantum electronics,2009,45(3):300-303.
