氧化镓薄膜的制备及其日盲紫外探测性能研究
2015-01-06于永斌陈文宇
刘 浩,邓 宏*,韦 敏,于永斌,陈文宇
(1.电子科技大学电子薄膜与集成器件国家重点实验室,四川成都 610054;
2.电子科技大学信息与软件工程学院,四川成都 610054;
3.电子科技大学计算机科学与工程学院,四川成都 610054)
氧化镓薄膜的制备及其日盲紫外探测性能研究
刘 浩1,邓 宏1*,韦 敏1,于永斌2,陈文宇3
(1.电子科技大学电子薄膜与集成器件国家重点实验室,四川成都 610054;
2.电子科技大学信息与软件工程学院,四川成都 610054;
3.电子科技大学计算机科学与工程学院,四川成都 610054)
采用射频磁控溅射方法在蓝宝石单晶衬底上沉积氧化镓(Ga2O3)薄膜,并通过光刻剥离工艺(Lift-off)制备了金属-半导体-金属结构的Ga2O3日盲紫外探测器。对不同温度下沉积的Ga2O3薄膜分析表明,在800℃下获得的薄膜结晶质量最好,薄膜的导电性则随着沉积温度的上升先增大后减小。在800℃制备的β-Ga2O3薄膜的可见光透光率大于90%,光学吸收边在255 nm附近。在10 V偏压下,探测器的暗电流约为1 nA,光电流达800 nA,对紫外光响应迅速。器件的响应度达到0.3 A/W,260 nm波长处的响应度是290 nm波长对应响应度的40倍,可实现日盲紫外波段的探测。
β-Ga2O3;射频磁控溅射;紫外探测
1 引 言
β-Ga2O3作为一种直接带隙氧化物半导体材料,室温下禁带宽度约为4.9 eV,对应波长为250 nm,恰好处在日盲(200~280 nm)紫外波段[1],在宇宙探索、导弹追踪、火焰预警等领域都有广泛的应用价值。目前,主要用于日盲探测的材料有Al-GaN、ZnMgO、金刚石、β-Ga2O3等。AlGaN要实现日盲探测,需要较高的Al组分,但是很难制备高Al且质量很高的薄膜[2]。纤锌矿结构的ZnMgO也面临同样的问题,掺Mg含量过高时无法保证晶格完好[3]。金刚石由于禁带宽度过大(~5.45 eV),不能实现对整个日盲波段的探测且价格昂贵。Ga2O3作为一种二元氧化物材料,完美的单晶较容易获得,制备方法简单,物理化学性质稳定,禁带宽度为4.7~4.9 eV,被认为是制备日盲光电探测器最为理想的材料之一。近年来,无论是Ga2O3单晶,还是Ga2O3薄膜和纳米线,都有用于日盲紫外探测器的报道[4-5]。目前而言,利用β-Ga2O3薄膜制备探测器在实际应用方面更具潜力和价值。
β-Ga2O3薄膜的制备方法有很多,如分子束外延(MBE)[1]、溶胶-凝胶法(Sol-gel)[6]、磁控溅射[7-8]、脉冲激光沉积(PLD)[9]、金属有机物化学气相沉积(MOCVD)[10]等。由于射频磁控溅射具有生长速度快、工艺重复性好、可大面积生长等优点,故本文采用射频磁控溅射方法沉积薄膜。为了获得高结晶质量的β-Ga2O3薄膜,实验以蓝宝石(0001)单晶为衬底,在不同温度下沉积Ga2O3薄膜,研究沉积温度对薄膜结晶质量和光电性能的影响,并在此基础上制备了MSM结构的日盲紫外光电器件。
2 实 验
2.1 仪器与方法
实验用(0001)蓝宝石作为制备Ga2O3薄膜的基片,将封装于1000级包装内的5 mm×5 mm× 0.5 mm基片取出,依次用丙酮、无水乙醇和去离子水超声清洗10 min后,氮气吹干。采用纯度为99.999%的氧化镓陶瓷靶,在不同衬底温度下,通过射频磁控溅射沉积厚度约为200 nm的Ga2O3薄膜。沉积过程中,工作压强为0.6 Pa,溅射沉积时间为2 h。沉积结束后,样品在腔体中原位退火30 min。采用Lift-off工艺和电子束蒸发,在薄膜上蒸镀Ti/Au叉指电极,厚度为250 nm,叉指宽度为0.05 mm,长度为3 mm,间距为0.1 mm,器件有效感光面积为12.5 mm2。为了减少界面接触电阻,形成良好的欧姆接触,将样品在500℃保温10 min。
2.2 材料表征
采用英国Bede公司生产的D1型XRD(Cu Kα射线,λ=0.154 06 nm)对薄膜结构进行表征;采用美国 Perkin-Elmer公司的 Lambda 750UV/ VIS/NIR紫外-可见分光光度计对薄膜的光学特性进行测量;采用光强13×10-6W/cm2的汞灯(波长254 nm)和安捷伦4155B半导体参数分析仪对薄膜紫外光电性能进行测试;采用DSR-100紫外光响应测试系统对器件紫外光响应度进行测试。
3 结果与讨论
3.1 XRD结果分析
图1为不同衬底温度下制备的Ga2O3薄膜的XRD图。衬底温度为500℃的样品没有出现与氧化镓对应的衍射峰,表明低温沉积时,被Ar离子轰击的靶材原子在到达基片后,没有得到足够的表面迁移能量,岛状生长形成非晶相。温度增加到700℃后,样品的XRD谱中分别在18.95°、38.40°、59.19°处出现衍射峰,对应于β-Ga2O3的晶面,同属一个晶面组,与Ga2O3的标准卡片JCPDS No.43-1012基本符合,表现出明显的择优取向。随着衬底温度的上升,这一晶面组的衍射峰强度逐渐增大,这与Oshima等的研究结果一致[1]。针对衍射峰研究发现,其半高宽(FHWM)先由700℃时的0.165°减小到800℃时的0.095°,又逐渐增大到1 000℃时的0.110°。晶粒尺寸可根据公式(1)计算得到:

式中D、λ、β、θ分别为晶粒尺寸、X射线入射波长(λ=0.154 06 nm)、FHWM和布拉格衍射角,计算结果见表1。当衬底温度增加到1 000℃时,在衍射峰 FHWM增大的同时,在30.05°、 57.64°和60.54°分别出现晶面衍射峰。这说明温度过高时,晶体的择优取向减弱,晶格的有序性降低,Ga2O3开始沿着不同的取向生长。

图1 不同衬底温度下沉积的Ga2O3薄膜的XRD图Fig.1 XRD patterns of Ga2O3thin films deposited at various temperatures
表1 不同衬底温度下制备的Ga2O3的β(402)衍射峰半高宽和晶粒尺寸Table 1FHWMand grain size of Ga2O3thin filmsdeposited at various temperatures

表1 不同衬底温度下制备的Ga2O3的β(402)衍射峰半高宽和晶粒尺寸Table 1FHWMand grain size of Ga2O3thin filmsdeposited at various temperatures
Temperature/℃ FHWM/(°) Grain size/nm 500 - -700 0.165 53.9 800 0.095 88.6 900 0.102 82.5 1 000 0.110 74.5
3.2 透射光谱分析
图2为不同衬底温度下制备的Ga2O3薄膜的紫外-可见透射光谱。500~900℃下沉积的薄膜在可见光部分的光透过率均大于80%,且在240~300 nm之间出现了陡峭的光学吸收边,与Ga2O3晶体的禁带宽度相对应。500℃下制备的样品的光学吸收边出现在280 nm,透射光谱在330 nm出现的吸收峰对应于氧空位能级,表明薄膜内部空位缺陷较多,结晶质量差[11]。当温度升高到700℃后,薄膜的光谱曲线则比较平滑,可见光透过率在90%以上,光学吸收边向短波长方向移动,薄膜结晶质量变好,这与XRD的分析结果是一致的。衬底温度达到1 000℃时,薄膜吸收边出现在235 nm,发生非常明显的蓝移。许多研究者认为这是由于高温沉积,蓝宝石基片与Ga2O3薄膜发生反应,半径更小的Al离子在Ga2O3内部产生扩散,与Ga原子发生替位,使晶格常数减小,导致禁带宽度展宽[4,12]。图3是Ga2O3薄膜的(αhv)2随光子能量hv变化的曲线。Ga2O3作为直接带隙半导体材料[13-15],满足以下方程
(αhv)2=B(hv-Eg), (2)其中,α是吸收系数,hv是光子能量,Eg是光学带隙。以hv为横坐标,(αhv)2为纵坐标,作(αhv)2随hv变化的曲线,曲线的切线与横轴的交点即薄膜材料的禁带宽度Eg。可以看出,随着衬底温度的升高,Ga2O3的光学禁带宽度变宽。
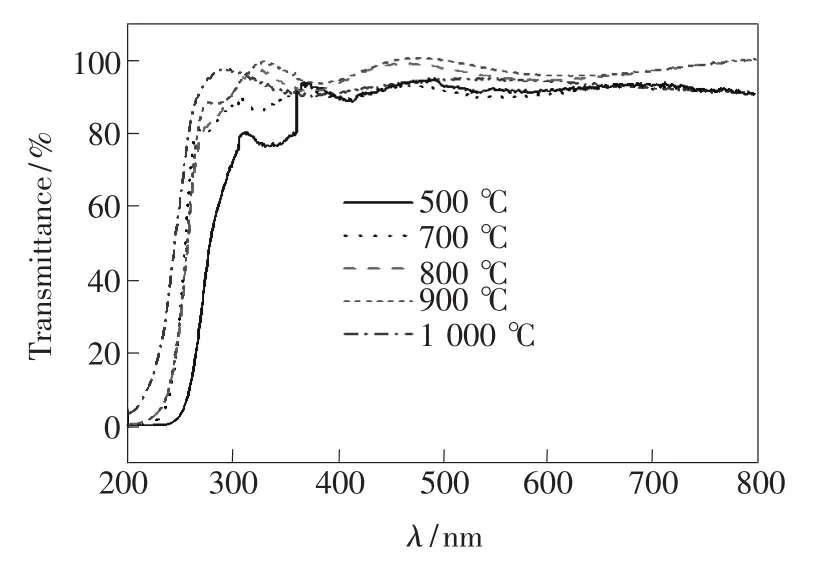
图2 不同衬底温度下制备的Ga2O3薄膜的紫外-可见透射光谱Fig.2 Transmittance spectra of Ga2O3thin films deposited at various temperatures

图3 Ga2O3薄膜的(αhv)2随光子能量hv变化的曲线Fig.3 (αhv)2vs.photon energy hv of Ga2O3thin films deposited at various temperatures
3.3 电性能分析
利用四探针法测量薄膜的电阻率,得到电阻率随衬底温度变化的曲线,如图4所示。当衬底温度为500℃时,薄膜的电阻率太大,无法测量。衬底温度高于700℃后,电阻率迅速下降。800℃沉积的薄膜电阻率最低,约为347Ω·cm。电阻率的变化与薄膜的结晶状况密不可分。当衬底温度较低时,被氩离子轰击的靶原子到达基片后不能得到足够高的能量做表面迁移,致使薄膜以岛状生长为主,内部存在大量缺陷,阻碍载流子的迁移,所以电阻率很大。温度高于700℃后,靶原子在自身能量和基片对应的能量作用下,有足够的能量在基片表面扩散迁移,晶粒合并长大,由岛状生长转变成层状生长,Ga2O3由非晶相转变为β相。故衬底温度升高后,结晶质量提高,内部缺陷减少,晶粒逐渐变大,晶界散射作用减少。这是导致电阻率明显下降的主要原因[16-18],与XRD的分析结果一致。

图4 Ga2O3薄膜电阻率随沉积温度变化的曲线Fig.4 Resistivity as a function of deposition temperature
3.4 紫外光电响应性能研究
采用Lift-off工艺和电子束蒸发在薄膜表面制作Ti/Au叉指电极,制备基于Ga2O3薄膜的MSM结构紫外光电探测器(图5插图)。在无光照、405 nm和254 nm波长光照下分别测得薄膜探测器的I-V特性曲线,如图5所示。可以明显地发现,电流随电压呈线性变化,说明Ga2O3薄膜与Ti/Au电极之间形成了良好的欧姆接触。黑暗条件下和405 nm光照下的I-V曲线基本重合,10 V偏压下的电流约为1 nA,薄膜对可见光基本没有表现出敏感特性。而在254 nm紫外光照射下,同样偏压下的光电流达到了800 nA,光暗电流比接近3个数量级。图6为Ga2O3薄膜MSM结构探测器的紫外响应度曲线。探测器的响应波长处在日盲紫外区域,10 V偏压下的探测器的最大响应度为0.3 A/W,出现在260 nm,是290 nm波长处响应度的40倍。可见探测器对波长大于290 nm的波段基本没有响应,具有良好的紫外选择性,有效地避免了非日盲紫外波段对探测器性能的干扰。这应当归因于β-Ga2O3的宽禁带特性,结果与图2中的透射光谱相吻合。
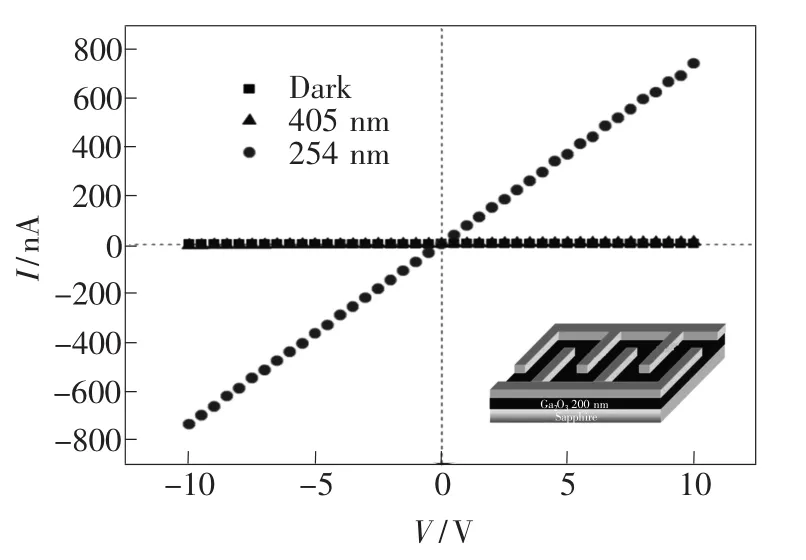
图5 薄膜探测器在无光、405 nm和254 nm光照下的I-V特性曲线。Fig.5 I-V characteristics ofβ-Ga2O3thin film MSM photodetectors in dark,under 405 nm and 254 nm light, respectively.The inset is the structure of MSM photodetectors.

图6 β-Ga2O3薄膜MSM器件的紫外响应度曲线Fig.6 Photo responsivity ofβ-Ga2O3thin film MSM photodetectors

图7 254 nm光照开关响应时间曲线。(a)5次光开关的响应时间曲线;(b)1次光开关的响应时间曲线放大图。Fig.7 Time-dependent photoresponse of MSM photodetectors under 254 nm illumination.(a)Response curve for five times light on/off switch.(b)Enlarge view of the rise/decay edge for one time light on/off switch.
图7(a)是Ga2O3薄膜探测器在254 nm汞灯照射下的10 V偏压下的响应时间曲线。汞灯每隔10 s开/关一次,经过多个循环开关之后,依然表现出稳定的光电特性。暗电流保持在1 nA左右,饱和光电流约为800 nA。图7(b)为图7(a)的局部放大图,可以看出,汞灯开启,薄膜电流的上升时间约为1 s;汞灯关闭,电流迅速降到1 nA左右,时间仅为0.08 s。这是由于800℃衬底温度下沉积的薄膜内部的载流子陷阱较少,光生载流子主要来源于价带与导带之间的电子跃迁,而陷阱中心“捕获”和“释放”载流子的这个缓慢过程作用较小[15],所以器件的响应速度较快,并且抑制了持续光电导现象。从图7可见,光电流上升达到饱和的时间较长,下降时间明显小于上升时间(汞灯光源开启时间约为0.15 ms)。
4 结 论
采用射频磁控溅射方法在蓝宝石基片上沉积Ga2O3薄膜,在衬底温度达到700℃后,薄膜由非晶相转化为以 β-Ga2O3为主的多晶结构,沿晶面组择优生长。随着衬底温度的升高,晶粒变大,从而晶界数量减少,电阻率下降。同时,光学禁带随着衬底温度的上升而增大,光学吸收边发生蓝移,800℃时在255 nm处出现陡峭的光学吸收边,可见光透过率在90%以上。基于以上薄膜制备的紫外探测器在10 V偏压下,暗电流约为1 nA,光电流达800 nA。最大响应度为0.3 A/W(260 nm),是290 nm波长对应响应度的40倍。对254 nm紫外汞灯开关的响应时间分别为1 s(上升)和0.08 s(下降),可实现日盲紫外波段的探测。
[1]Oshima T,Okuno T,Fujita S.Ga2O3thin film growth on c-plane sapphire substrates bymolecular beam epitaxy for deepultraviolet photodetectors[J].Jpn.J.Appl.Phys.,2007,46(11)∶7217-7220.
[2]RazeghiM.Short-wavelength solar-blind detectors-status,prospects,andmarkets[J].Proc.IEEE,2002,90(6)∶1006-1014.
[3]Yang W,Hullavarad SS,Nagaraj B,etal.Compositionally-tuned epitaxial cubic MgxZn1-xO on Si(100)for deep ultraviolet photodetectors[J].Appl.Phys.Lett.,2003,82(20)∶3424-3426.
[4]Kokubun Y,Miura K,Endo F,et al.Sol-gel preparedβ-Ga2O3thin film for ultraviolet photodetectors[J].Appl.Phys. Lett.,2007,90(3)∶031912-1-3.
[5]Kang H C.Heteroepitaxial growth ofmultidomain Ga2O3/sapphire(0001)thin films deposited using radio frequencymagnetron sputtering[J].Mater.Lett.,2014,119∶123-126.
[6]Feng P,Zhang JY,LiQ H,et al.Individualβ-Ga2O3nanowires as solar-blind photodetectors[J].Appl.Phys.Lett., 2006,88(15)∶153107-1-3.
[7]Li Y B,Tokizono T,Liao M Y,et al.Efficient assembly of bridgedβ-Ga2O3nanowires for solar-blind photodetection [J].Adv.Funct.Mater.,2010,20(22)∶3972-3978.
[8]Ramana C V,Rubio E J,Barraza CD,et al.Chemical boding,optical constants,and electrical resistivity of sputter-deposited gallium oxide thin films[J].J.Appl.Phys.,2014,115(4)∶043508-1-7.
[9]Ou S L,Wu D S,Fu Y C,etal.Growth and etching characteristics of gallium oxide thin films by pulsed laser deposition [J].Mater.Chem.Phys.,2012,133∶700-705.
[10]Du X J,MiW,Luan CN,etal.Characterization of homoepitaxialβ-Ga2O3films prepared bymetal organic chemical vapor deposition[J].J.Cryst.Growth,2014,404∶75-79.
[11]Zhang J,Jiang F H.Catalytic growth of Ga2O3nanowires by physical evaporation and their photoluminescence properties [J].Chem.Phys.,2003,289∶243-249.
[12]Goyal A,Yadav B S,Thakur O P,et al.Effect of annealing onβ-Ga2O3film grown by pulsed laser deposition technique [J].J.Alloys Compd.,2014,583∶214-219.
[13]Rebien M,Henrion W,Hong M,et al.Optical properties of gallium oxide thin films[J].Appl.Phys.Lett.,2002,81(1)∶250-252.
[14]Sinha G,Adhikary K,ChaudhuriS.Sol-gel derived phase pureα-Ga2O3nanocrystalline thin film and its optical properties [J].J.Cryst.Growth,2005,276(1)∶204-207.
[15]Guo D Y,Wu ZP,Li PG,etal.Fabrication ofβ-Ga2O3thin films and solar-blind photodetectors by laser MBE technology[J].Opt.Mater.Express,2014,4(5)∶1067-1076.
[16]Orita M,Hiramatsu H,Ohta H,et al.Preparation of high conductive,deep ultraviolet transparentβ-Ga2O3thin film at low deposition temperatures[J].Thin Solid Films,2002,411(1)∶134-139.
[17]Kumar SS,Rubio E J,Martinez G,etal.Structure,morphology,and optical properties of amorphous and nanocrystalline gallium oxide thin films[J].J.Phys.Chem.C,2013,117(8)∶4194-4200.
[18]Vemuri R S,BharathiK K,Gullapalli SK,etal.Effectof structure and size on the electrical properties ofnanocrystalline WO3films[J].ACSAppl.Mater.Interf.,2010,2(9)∶2623-2628.

刘浩(1990-),男,河北保定人,硕士研究生,2013年于河北工业大学获得学士学位,主要从事Ga2O3薄膜材料的研究。
E-mail:haoliu929@163.com

邓宏(1963-),男,四川江油人,教授,博士生导师,1986年于电子科技大学获得硕士学位,主要从事ZnO材料及器件的研究。
E-mail:hdeng@uestc.edu.cn
Preparation and Ultraviolet Detection Performance of Ga2O3Thin Film s
LIU Hao1,DENG Hong1*,WEIMin1,YU Yong-bin2,CHENWen-yu3
(1.State Key Laboratory ofElectronic Thin Films and Integrated Devices, University ofElectronic Science and Technology ofChina,Chengdu 610054,China; 2.School of Information and Software Engineering,University ofElectronic Science and Technology ofChina,Chengdu 610054,China; 3.School ofComputer Science and Engineering,University of Electronic Science and Technology ofChina,Chengdu 610054,China)
*Corresponding Author,E-mail:hdeng@uestc.edu.cn
Gallium oxide(Ga2O3)thin filmswere depsited by radio frequencymagnetron sputtering on sapphire(0001)substrateswith a range of substrate temperatures from 500 to 1 000℃.The norphological characteristics,optical bandgaps,electrical properties and photoresponsivity of the grown thin filmswere researched.With the increasing of the growth temperature,the crystallinity and conductivity of the films increase at first and then decrease slightly.Ultraviolet-visible spectra indicate that the transmittance ofβ-Ga2O3film depsited on 800℃ is over than 90%,and it's absorption edge is located at about255 nm,meaning that the optical bandgap was about 4.8 eV.Themetalsemiconductor-metal photodetector based onβ-Ga2O3film shows dark current of~1 nA and photocurrent of~800 nA under 254 nm light illumination at10 bias voltage.Themaximum responsivity of the photodetector is 0.3 A/W at260 nm,40 times asmuch as the responsivity at290 nm.
β-Ga2O3;RFmagnetron sputtering;UV detector
O484.4
:A
10.3788/fgxb20153608.0906
1000-7032(2015)08-0906-06
2015-05-28;
:2015-07-29
中央高校基金(ZYGX2013J041);电子薄膜与集成器件国家重点实验室创新基金(KFJJ201303)资助项目
