Mylar膜衬底上的镀膜技术
2014-08-07樊启文杜英辉
张 榕,樊启文,杜英辉
(中国原子能科学研究院 核物理研究所,北京 102413)
物理实验要求在厚度为12.5 μm、尺寸为7.5 cm×7.5 cm的Mylar膜上镀1 μg/cm2和20 μg/cm2的Sc、Ti、V、Cr、Mn、Fe、Co、Ni、Cu、Pb、Y、As、Se、Al、ZnS、CdS、NaBr、RbCl、NaCl、KCl、CaF2、SrF2、MgCl2和LiF薄膜,要求不均匀性小于10%。Mylar膜的耐热温度低,镀膜必须考虑蒸发源的辐射热和蒸发物质的冷凝热造成的衬底温度的升高,须研究并采取防止Mylar膜软化和变形的必要措施,如增大蒸发距离、降低沉积速率、减小蒸发源尺寸、采用挡板、间断蒸发和基衬转动等。对于厚度为1 μg/cm2的超薄膜,应研究精确控制薄膜厚度的方法。本工作将系统研究在12.5 μm的Mylar膜上通过真空蒸发沉积上述24种材料薄膜的技术,并对一些关键问题进行讨论。
1 薄膜沉积过程中输入衬底的热量
用真空蒸发沉积薄膜时,造成衬底温度上升的热量包括蒸发源的辐射热WR、沉积时的冷凝热WC和蒸发原子的动能WK[1]。其中,WK与WR、WC相比,可忽略不计。将蒸发源看成面源,假设其温度为T时,单位时间内,传给距离面源为h的单位面积衬底上的WR为:
WR=CAσεT4/2πh2
(1)
单位时间内,由沉积原子和分子传给单位面积衬底的冷凝热量WC为:
WC=10-8Qρυ
(2)
式中:C为常数,取1~2;A为蒸发源面积;σ为Stefan-Boltzmann常数;ε为发射率;T为蒸发源温度;h为蒸发距离;Q为蒸发物质单位质量的冷凝热;ρ为蒸发物质的密度;υ为沉积速率。
为得到WR与参变量υ的定性关系,以蒸发Ag为例,使蒸发距离h保持不变,改变T可测出υ-T关系,如图1所示。由式(1)、(2)和图1可知,蒸发距离h越大,辐射热WR越小;蒸发源面积A越大,辐射热WR越大;沉积速率υ越大,冷凝热WC越大,辐射热WR也越大。因此,为避免因辐射热和冷凝热过高而导致有机膜软化,应尽量增大蒸发距离、降低蒸发冷凝的沉积速率和减小蒸发舟的尺寸。

图1 沉积速率与蒸发源温度关系的测量值与理论值
2 厚度的精确控制
采用IL-100型石英晶体膜厚速率监控仪在线监控薄膜的沉积速率和厚度。对于厚度为1 μg/cm2的超薄膜,必须考虑蒸发源的热辐射对监测仪器的影响[2]。为对超薄膜层进行精细监控,测量蒸发源热辐射对仪器显示厚度的影响。实验时,先打开晶体探头的水冷系统,然后将6 mm×25 mm×0.1 mm的Ta舟加热。通过控制电流,使蒸发源温度先升高后降低。膜厚监控仪的显示值随温度的变化列于表1。
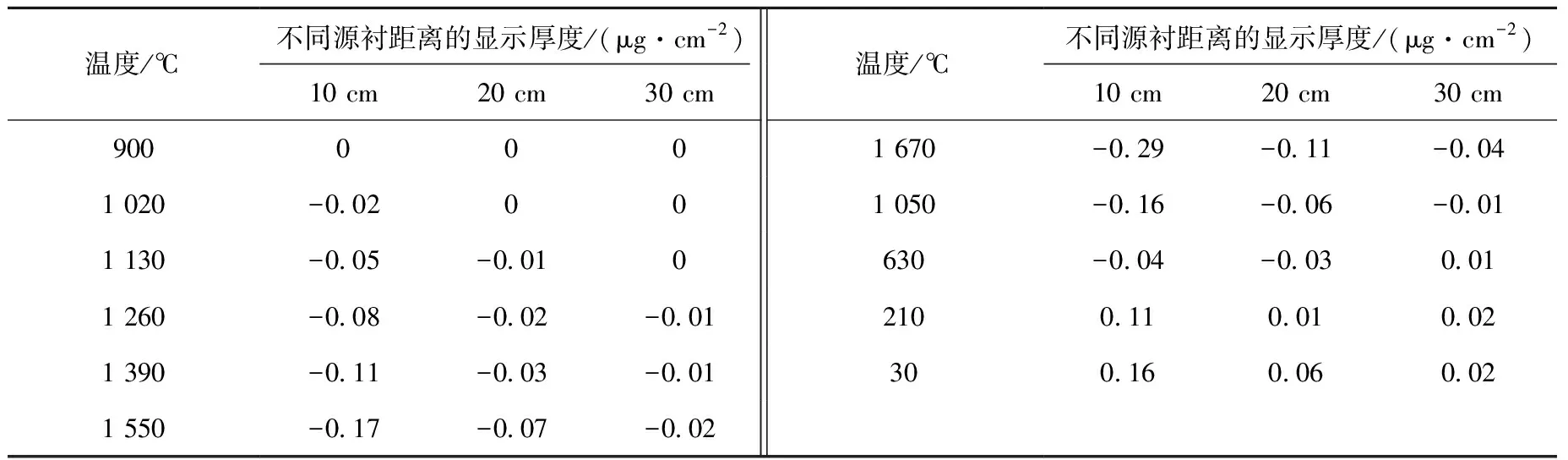
表1 石英晶体膜厚监控仪的显示厚度与蒸发源温度的关系
由表1可见,显示厚度随蒸发源温度的变化而变化,温度越高,显示厚度变化越大;同时,源衬距离越大,显示厚度受蒸发源温度的影响越小。在预熔阶段,因为温度对晶体探头的影响,显示厚度出现负值;蒸发源关闭后,因为残余蒸发的作用,显示厚度仍继续增加。这两部分的影响需扣除,其显示厚度不能计算在总厚度内。为减少蒸发源热辐射对膜厚的影响,在蒸镀薄膜时,除增大蒸发距离外,还需采取如下措施:1) 预熔时,安装一个挡板,使其只挡住基衬而不挡住晶体探头,让晶体有足够时间完成热平衡;2) 预熔结束后,在打开挡板的同时将监控仪显示值清零;3) 厚度达预定值后,立即用挡板挡住蒸发源并切断电流停止蒸发,此后监控仪继续增加的显示值不计算在总厚度内。通过上述手段,膜厚可精确控制在0.1 μg/cm2以内。
3 Mylar膜衬底上的镀膜
3.1 小面源-静止衬底蒸发沉积
小面源在静止衬底上蒸发沉积的示意图如图2所示。

图2 小面源-静止衬底蒸发沉积示意图
根据图2中的几何安排,基衬上的任意一点的沉积厚度[3]有:
d=1 000h2/π(h2+r2)2
(3)
其中:h为源到基衬的垂直距离,cm;r为基衬上任意一点到中心点的距离,cm;d为基衬上任意点的质量归一厚度,μg·cm-2·mg-1。

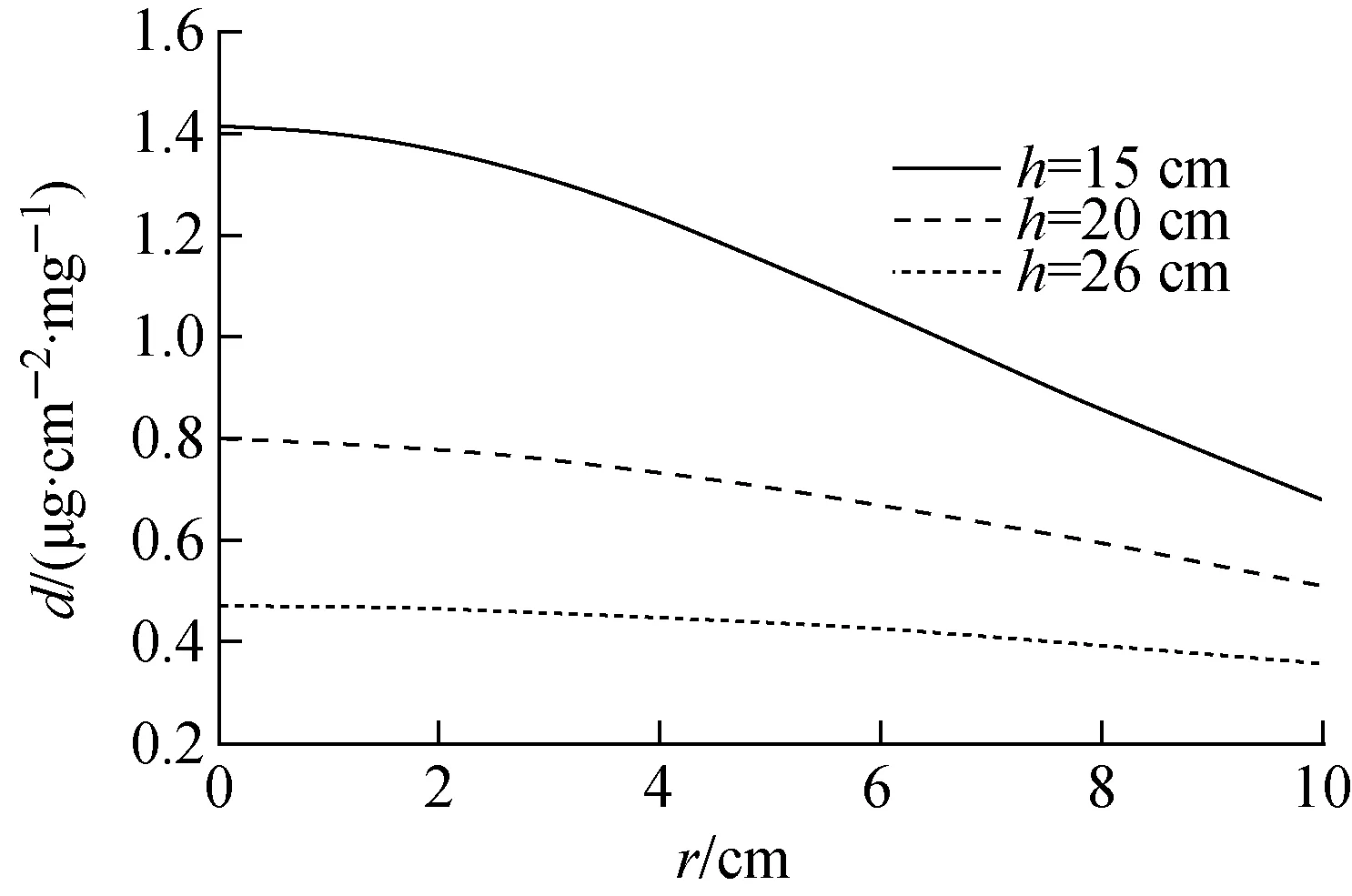
图3 小面源-静止衬底蒸发沉积的厚度分布曲线
表2小面源-静止衬底蒸发沉积的均匀性计算和测量结果
Table2Calculatedandmeasureduniformityforlittleplanesource-staticsubstrate

h/cm最大不均匀性/%计算值测量值1514.5207.838.76265.456.02
实验时,根据蒸发温度的不同,选择不同的蒸发距离:1) 对于蒸发温度小于800 ℃的As、Pb、Se、CdS、RbCl、MgCl2、KCl和NaBr(其蒸发温度分别为310、715、245、680、600、570、635、620 ℃),蒸发距离选20 cm;2) 对于蒸发温度大于800 ℃的Ag、Mn、ZnS和LiF(其蒸发温度分别为1 030、970、960、820 ℃),蒸发距离选26 cm。沉积的膜厚为1 μg/cm2和20 μg/cm2,对应的蒸发速率分别为0.01~0.02 μg·cm-2·s-1和小于0.1 μg·cm-2·s-1。在所有镀膜中,均在预熔时和沉积刚完时加挡板。对于蒸镀20 μg/cm2的膜,均采用4次间断蒸发,即每沉积5 μg/cm2停5 min。镀膜选用的坩埚为6 mm×25 mm×0.1 mm的小Ta舟。
实验结果表明:对于静止衬底,蒸发温度小于750 ℃时,h为20 cm是安全的;蒸发温度大于800 ℃小于1 200 ℃时,h为26 cm是安全的。此外,对于Al、Cu和蒸发温度大于1 200 ℃的材料,即使同时采取前述的所有防护措施,在蒸发沉积过程中也会将Mylar膜软化。对于这些材料,应采用小面源-转动衬底蒸发沉积法。
3.2 小面源-转动衬底蒸发沉积
小面源-转动衬底蒸发沉积如图4所示,一次可安装4片Mylar膜。转动基衬上任意点的蒸发厚度[3]有:
d=1 000h2(h2+r2+s2)/
π[(h2+r2+s2)2-4s2r2]3/2
(4)
式中:r为源到转动轴的水平距离;s为基衬上任意一点到转动轴的水平距离。


图4 小面源-转动基衬蒸发沉积示意图
实验时,根据蒸发温度的不同,选择不同的蒸发条件:1) 对蒸发温度为1 200~1 400 ℃的Al、Cu、Sc、Cr、CaF2和SrF2(其蒸发温度分别为1 220、1 260、1 390、1 395、1 400、1 280 ℃,坩埚分别选用*W、Ta、W、W、Ta、Ta(*W和W分别是用直径0.7 mm和1.2 mm的W丝做成“V”型和“—”型的W丝蒸发源,Ta是用6 mm×25 mm×0.1 mm的Ta片做成的小Ta舟)),选择h=20 cm,r=15.4 cm;2) 对于蒸发温度大于1 400 ℃的Y、Ti、Fe、Co和V(其蒸发温度分别为1 630、1 730、1 470、1 540、1 850 ℃,坩埚分别选用Ta、W、W、Mo、Mo(Mo是用6 mm×25 mm×0.1 mm的Mo片做成的小Mo舟)),选择h=26 cm,r=20.5 cm。沉积的膜厚为1 μg/cm2和20 μg/cm2,对应的蒸发速率分别为0.01~0.02 μg·cm-2·s-1和<0.1 μg·cm-2·s-1。蒸镀方法与静止底衬的蒸镀方法基本相同。
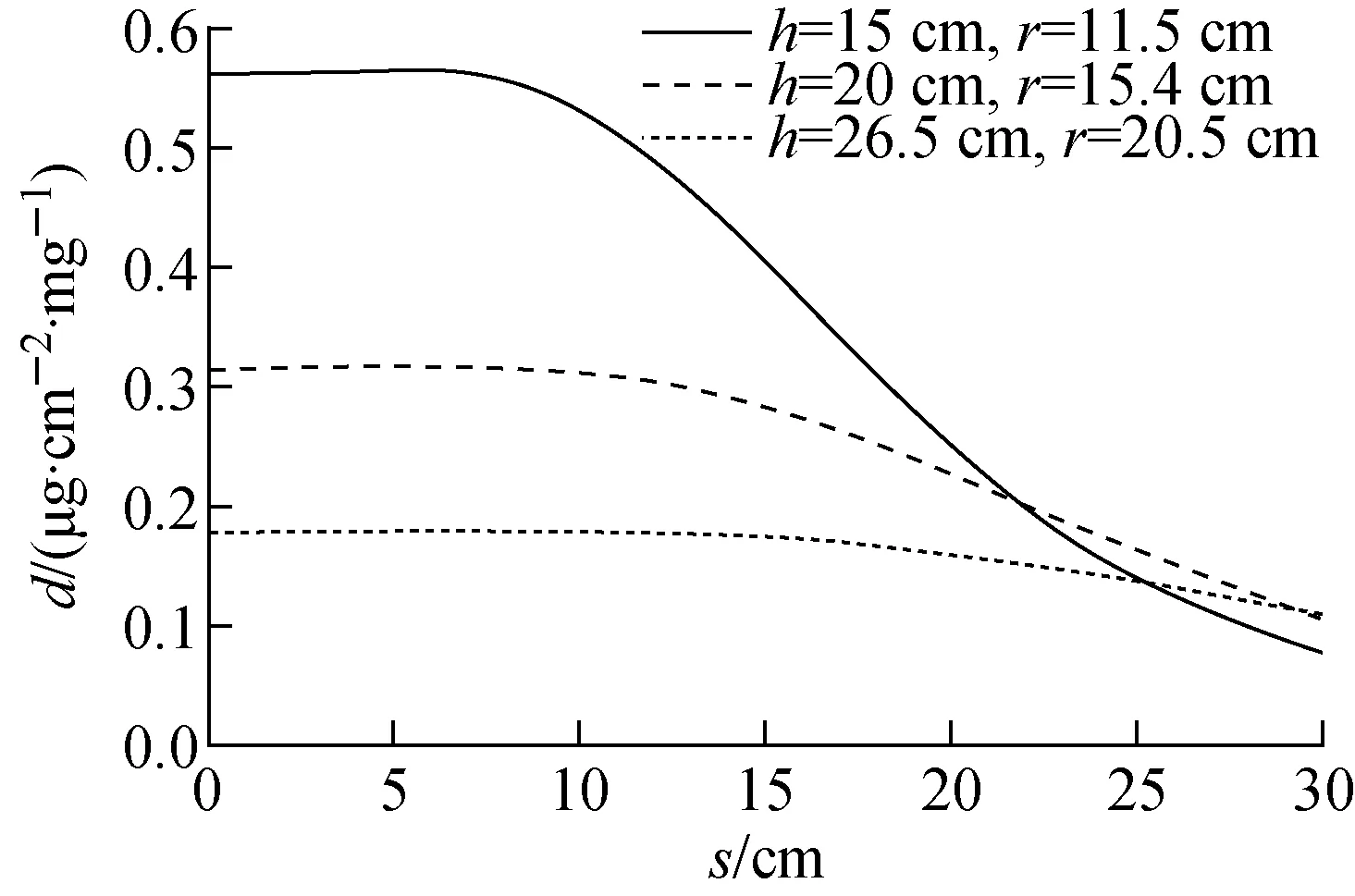
图5 小面源-转动衬底蒸发沉积的厚度分布曲线
表3小面源-转动衬底蒸发沉积的均匀性计算和测量结果
Table3Calculatedandmeasureduniformityforlittleplanesource-rotatingsubstrate
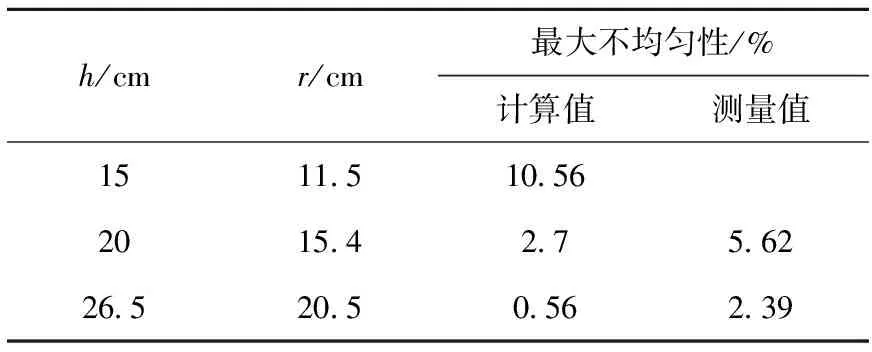
h/cmr/cm最大不均匀性/%计算值测量值1511.510.562015.42.75.6226.520.50.562.39
实验结果表明,对于转动衬底,蒸发温度<1 400 ℃时,选择h=20 cm、r=15.4 cm对Mylar膜是安全的;蒸发温度>1 450 ℃时,选择h=26.5 cm、r=20.5 cm对Mylar膜是安全的。
4 X射线荧光分析单元素膜的均匀性
通过测试膜上不同区域元素的浓度分布来测试镀在12.5 μm的Mylar膜上的单元素膜的均匀性。测试实验在上海同步辐射光源上进行,光斑直径为1 mm左右。选择Cu/Mylar和Cr/Mylar两种膜进行测试,膜的面积为75 mm×75 mm。Cr膜和Cu膜的区域均匀性测试结果分别为4.19%和4.43%,均达到物理实验上提出的要求。图6为Cr和Cu的分布图。
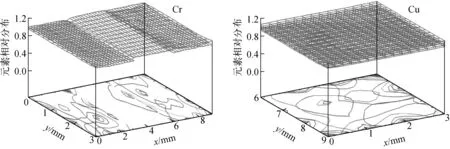
图6 Cr和Cu的分布
5 小结
1) 石英晶体膜厚监控仪具有控制精度高、显示直观等优点,其测量精度可达0.01 μg/cm2,但对极薄的薄膜厚度控制,蒸发源的辐射热对测量结果有影响(尤其是蒸发高熔点材料时),应采取必要措施进一步减小误差,如加挡板、提高蒸发距离和减小蒸发速率等。
2) 降低沉积速率不仅能减少单位时间传给基衬的冷凝热,还能减少蒸发源的辐射热,是防止有机膜软化和变形的有效措施。
3) 对于在Mylar膜上沉积蒸发温度超过1 200 ℃的材料薄膜时,更适合采用转动衬底法来蒸发。
参考文献:
[1] 田民波,刘德令. 薄膜科学技术手册:上[M]. 北京:机械工业出版社,1991:149.
[2] 许国基. 石英晶体测厚仪监控核靶厚度[J]. 原子能科学技术,1990,24(5):78-81.
XU Guoji. Determination and control of target thickness with quartz crystal thickness monitor[J]. Atomic Energy Science and Technology, 1990, 24(5): 78-81(in Chinese).
[3] HAOLAN L. 真空镀膜技术[M]. 林树嘉,译. 北京:国防工业出版社,1962:80-88.
