MOCVD的原理与故障分析
2014-07-04李彦丽
李彦丽
(中国电子科技集团公司第十三研究所,河北石家庄,050051)
薄膜工艺是半导体工艺中的一个重要工艺,按薄膜的制备方法可以分为物理气相淀积(Physical Vapor Deposition,简称PVD)和化学气相沉积(Chemical Vapor Deposition,简称CVD)。CVD 是一种通过气体化学反应在衬底表面形成固体薄膜的工艺,金属有机化学气相沉积(MOCVD)是在CVD 的基础上发展起来的。MOCVD 技术最大的优点在于它的通用性,只要选取合适的金属有机源就可以进行外延生长,而且只要保证气流和温度的均匀分布就可以获得大面积的均匀材料,适合进行大规模工业化生产。
1 MOCVD 法的基本原理[1-3]
1.1 MOCVD 法的基本原理和步骤
金属有机化学气相沉积法 (MOCVD) 是由Manasevit 等于1968年提出用于制备化合物半导体薄片单晶的一项技术。MOCVD 法经过几十年的发展,现在已经成为半导体外延生长的一种主要技术,非常适合于规模化生产,成为应用最广泛的外延技术之一。该方法采用Ⅱ、Ⅲ族元素的有机化合物和Ⅵ、Ⅴ族元素的氢化物作为源材料,通过热分解反应,在衬底上进行气相外延,生长Ⅲ-Ⅴ族、Ⅱ-Ⅵ族化合物半导体和多元化合物半导体薄层。MOCVD 的基本原理如图1 所示。

图1 MOCVD 的基本原理图
对于MOCVD 法生长半导体的动力学模型大多认为是复相化学反应机制,由于在衬底上面存在边界层,所以认为其生长过程是按下列步骤进行:
(1)反应物从反应室的入口到衬底的输运;
(2)反应物通过扩散,穿过边界层到达衬底表面;
(3)反应物分子吸附在高温衬底表面上;
(4)吸附分子之间或吸附分子与气体分子之间发生化学反应生成生长晶体的原子(或分子)和气体副产物;
(5)生长晶体的原子(或分子)沿着衬底表面扩散,到达表面上晶格的某些折角或台阶处结合进入晶体点阵中;
(6)副产物从表面解析扩散穿过边界层进入主气流中被排出系统。
以上步骤按顺序进行。由于每一步的速率是不同的,因此总体的生长速率是由其中最慢的一步决定的,这最慢的一步叫做速度控制步骤。一般低温时为表面反应控制过程或者动力学控制过程,高温时为质量控制过程。
1.2 MOCVD 法的优点
MOCVD 法之所以被广泛应用是因为其具有以下优点:
(1)用于生长半导体材料的各组分和掺杂剂都是以气态的方式通入反应室,因此可以通过精确控制气态源的流量和通断时间来控制外延层的组分、掺杂浓度、厚度等,可以用于生长薄层和超薄层材料;
(2)反应室中气体流速较快,因此,在需要改变多元化合物的组分和掺杂浓度时,可以迅速进行改变,减小记忆效应发生的可能性。这有利于获得陡峭的界面,适于进行异质结构和超晶格、量子阱材料的生长;
(3)晶体生长是以热解化学反应的方式进行,是单温区外延生长。只要控制好反应源气流和温度分布的均匀性,就可以保证外延材料的均匀性。因此,适于多片和大片的外延生长,便于工业化大批量生产;
(4)通常情况下,外延层的生长速率与金属有机源的流量成正比,因此,生长速率调节范围较广;
(5)生长过程中无需液体容器(如坩埚等),生长外延层的源材料和载气的纯度可以达到99.9995%以上,因此,MOCVD 方法制备的材料纯度比其他生长技术高一个数量级;
(6)源材料和反应产物中不含有卤化物,避免了卤素的污染和腐蚀性带来的危害。
1.3 MOCVD 法的缺点
MOCVD 的主要缺点有:
(1)许多金属有机化合物有毒和易燃,给有机化合物的制备、储存、运输和使用带来困难,必须采取严格的防护措施。反应产物需要进行处理,避免污染环境;
(2)有些金属有机化合物在气相中就发生反应,生成固态微粒沉积到衬底表面,破坏了薄膜的完整性;
(3)金属有机化合物中包含其他元素(如C、H等),需要对反应过程进行仔细控制避免引入非故意掺杂的杂质。
2 MOCVD 的结构
一台MOCVD生长设备可以简要地分为4 部分,如图2 所示。
2.1 气体处理系统
气体处理系统的功能是向反应室输送各种反应剂,通过质量流量控制器(MFC)和压力控制器(PC)精确控制流量、流速等,便于生长特定成分与结构的外延层。气体处理系统由气体输送管道、控制单元、有机金属化合物源(MO 源)供应系统和氢化物供应系统等组成。
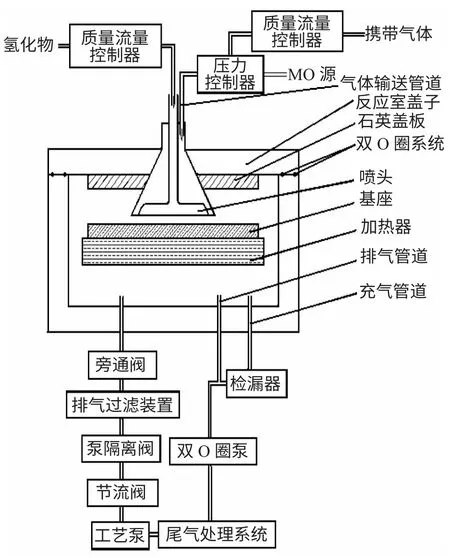
图2 MOCVD 结构图
2.1.1 气体输送管道
气体的输运管道包括生长和排空线,工艺气体经由生长线从源到达反应室,经由排空线从反应室进入真空系统。为了避免工艺过程中生长和排空线之间的压力补偿,生长排空线和反应室必须保持在同一压力。
2.1.2 控制单元
控制单元包括阀门、对气体流量进行控制的质量流量控制器,对源压力进行控制的压力控制器。
2.1.3 有机金属化合物源(MO 源)供应系统
在有机金属化合物源(MO 源)供应系统中,无论是液态还是固态的金属有机化合物,都储存在特制的不锈钢鼓泡器中,由通入的高纯H2(或N2)携带输送到反应室。鼓泡器装配了能实现温度控制的水浴恒温槽来确保金属有机化合物有恒定的蒸汽压。
2.1.4 氢化物供应系统
在氢化物供应系统中,氢化物气体储存在气瓶中,由定量供应单元输送到反应室。
2.2 反应室
反应室是MOCVD 生长系统的核心组成部分,它对外延层的厚度、均匀性、杂质浓度和外延层的质量都有很大的影响。反应室的设计应满足气体呈层流状态,不会形成湍流,从而实现在反应室内的气流和温度的均匀分布,有利于源材料在衬底上大面积的均匀生长。反应室的组成主要有:基座、石英盖板、RF 感应加热系统、双O 圈系统。
2.2.1 基座
基座用来存放衬底,因而基座温度的分布决定了衬底温度的一致性。为了使整个工艺过程中的温度保持一致,基座配备了一套特殊的旋转系统,由一个行星盘和一组卫星盘组成。行星盘是旋转主体,由电机驱动;卫星盘以共中心的形式排列在行星盘上,通入一定气体流量推动卫星盘各自旋转,同时也随行星盘公转,从而形成行星式旋转。可通过调节气体流量,改变自转的速度,获得均匀的生长速率。
2.2.2 石英盖板
石英盖板与反应室内部的盖子是分离的,由中心的螺钉固定在一起,其间距随着工艺不同而改变。反应室盖子由水冷控制。N2/H2的混合物用来净化石英盖板和反应室盖子的间隙并在两者之间进行热传递,并可通过控制N2/H2混合物的成分调节盖板表面的温度,改善温度场的均衡性,降低产生寄生反应的几率。
2.2.3 RF 感应加热系统
反应室采用的是RF 感应加热方式,射频发生器独立于设备外,射频信号经过振荡器后到达加热线圈,加热线圈配备有高度可调节的陶瓷外壳,位于反应室内石英盖板的下方。反应室的温度由温度控制器进行监测和控制。
2.2.4 双O 圈系统
双O 圈系统包括两个O 圈:内部O 圈和外部O 圈。O 圈中间部分被不断地抽真空来确保密封的可靠性和可控性。当反应室打开时,手套箱内的惰性气体自动充满双O 圈系统,当反应室再次关闭,又自动被排出。双O 圈系统配有量程为1×10-3到100 kPa 的压力控制装置来监控压力,如果压力值超出上限,“反应室泄露监控”报警会被触发。
2.3 真空系统
真空系统包括3 个真空泵,分别用于手套箱、双O 圈系统和反应室;各种手动、气动、螺线管式以及电磁- 气动阀,执行操作系统发出的指令;带有止回阀的旁路,其功能是保护系统。
2.4 尾气处理系统
由于MOCVD 系统中所采用的大多数源均易燃易爆,而且其中的氢化物源又有剧毒,因此,必须对反应过后的尾气进行处理。本设备尾气处理的原理是在逆流装置里用解毒溶液来与尾气发生化学反应进行解毒,快速化学反应是有效地将气体净化的本质。
3 影响MOCVD 工艺的因素分析[4-5]
3.1 温度
温度对生长速度有着重要影响。以生长GaAs为例,当温度在550 ℃以下时,生长速度随着温度的升高而增高,同时衬底的晶向对生长速度和活化能都有一定影响。温度在550~750 ℃时,生长速度只与MO 源到达衬底表面的输送速度有关,在该阶段不改变其他条件,只增加气体流速,加快MO 源进入反应室的速度,即可提高外延生长的速度。从而在此温度范围内进行外延生长具有速度高、外延层生长可控、外延层质量高、生长速率不受温度影响等优点。温度在750 ℃以上时,随着温度的不断升高,生长速度却逐渐下降,并且此时衬底的晶向对生长速度有影响。
3.2 反应室压力
反应室的压力对沉积速度有一定影响。另外,较低的压力值可以减少在反应室内形成热动力所形成的对流,也减少形成寄生反应的概率,从而获得均匀性较好的厚度和组分等。
3.3 气体流速
气体流速相对较低时,进入反应室的气流有充足的时间与衬底表面进行均匀生长。当气体流速过大时,有一部分反应剂未来得及反应就随气体流走,极大的降低生长的效率。因此,气体的流速对生长速率有着显著的影响,在生长的过程中应选择适宜的气体流速,有益于生长出高质量的外延层。
3.4 Ⅴ/Ⅲ比
Ⅴ/Ⅲ比对材料的生长速度,晶格匹配度和光学特性有影响。因此,当外延生长厚度需精确控制的量子阱薄层材料以及失配度需精确控制的厚层材料时,必须充分考虑Ⅴ/Ⅲ比对材料外延的影响,选取合适的Ⅴ/Ⅲ比。
4 常见故障现象与解决方法
通过以上对MOCVD 原理与设备结构的介绍以及对影响MOCVD 工艺因素的分析,结合维修经验总结了MOCVD 设备的常见故障与解决方法,如表1 所示。
5 结束语
MOCVD 工艺是一门复杂的工艺,要保证工艺的质量、稳定性和重复性,首先要保证设备的稳定性,因此必须要掌握并精通MOCVD 设备的原理与结构,其次要掌握影响工艺质量的各个因素,在出现故障时,能迅速分析导致故障的原因。最后要保证设备和工艺的稳定性,降低设备的故障率,日常的维护保养是非常必要的。
[1] 杨邦朝,王文生. 薄膜物理与技术[M]. 成都:电子科技大学出版社,1994.
[2] 唐伟忠. 薄膜材料制备原理、技术及应用[M]. 北京:冶金工业出版社,2003.
[3] 杨树人,丁墨元. 外延生长技术[M]. 北京:国防工业出版社,1992.
[4] 田宇. 利用行星式MOCVD 反应室生长AlGaInP 红光外延片的研究[C].长春:理工大学硕士学位论文,2011.
[5] 林委之,李建军,于晓东,等. Ⅴ/Ⅲ族气体源流量比对AlGaInP 材料MOCVD 外延生长的影响[J].SEMICONDUCTOR OPTOELECTRONICS,2007,28(2):202-204.
