SiGeC薄膜表征对于光刻对准性能的影响研究
2013-12-05王霞珑
王霞珑
(上海交通大学微电子学院,上海 200240)
1 引言
Si1-x-yGexCy技术被广泛应用,除民用无线、有线通信外,也广泛应用于军用通信、GPS定位导航系统、卫星通信、汽车雷达等领域,特别是高速/高频的各个领域。
Si1-x-yGexCy/Si异质结材料的Si1-x-yGexCy薄膜的厚度、Ge含量、C含量、晶体质量和缺陷等是Si1-x-yGexCy材料生长重要的控制参数,它们决定着Si1-x-yGexCy器件的性能。因此,Si1-x-yGexCy材料的表征技术是研究Si1-x-yGexCy材料的一个重要组成部分。目前,Si1-x-yGexCy材料的表征方法主要有X射线、原子力显微镜、霍尔测量、二次开发离子质谱、透射电子显微镜等。这些研究方法对实验研究作用很大,但在规模化量产中具有相当的局限性,特别是在Si1-x-yGexCy器件的制造过程,图形化过程对Si1-x-yGexCy薄膜的特性和表面状态要求很高,上述方法都还不能实现对Si1-x-yGexCy薄膜特性和表面状态的快速监控,本文通过大量实验研究,总结出了Si1-x-yGexCy薄膜的特性及表面状态与光学反射率之间的关系,对Si1-x-yGexCy薄膜的光学表征的实现具有一定的借鉴意义。
此外,本文所述Si1-x-yGexCy薄膜的生长采用的是低温选择性外延工艺,外延生长温度对Si1-x-yGexCy薄膜的特性有明显影响。选择性外延的特性,决定了Si1-x-yGexCy薄膜在Si单晶表面生长的是单晶Si,在非单晶薄膜表面生长的是多晶,在不同衬底表面Si1-x-yGexCy薄膜的生长速率及表面形貌有明显的差异。不同的Si1-x-yGexCy成分、厚度对Si1-x-yGexCy薄膜的特性也有明显影响。
本文还系统研究了Si1-x-yGexCy薄膜在不同衬底的表面状态,并研究了不同外延生长工艺、成分、薄膜厚度对光刻对准标记的影响。
2 原料及设备
2.1 实验设备及用途
(1)美国应用材料公司生产的C e n t u r a Epi5200,用于Si1-x-yGexCy薄膜外延生长;
(2)Nikon 207 Scanner 光刻机,用于曝光及对准信号采集;
(3)MAC-110MV1 套刻设备,用于对准测量及光学信号采集;
(4)KLA-tencor F5X 厚度测试仪,用于测定薄膜表面的反射率。
2.2 实验工艺
首先,外延生长Si1-x-yGexCy薄膜;其次采集外延晶片的反射信号;再次,采集光刻机的对准信号;最后,套刻数据的测试及套刻信号的采集。
相关工艺技术和基本原理简单介绍:光刻(Lithography)是集成电路生产中一项关键的工艺技术,是利用掩模版(MASK)上的几何图形,通过光化学反应,将图案转移到半导体硅片上的感光薄膜层上(光刻胶,Resist)的一种工艺步骤。
典型的光刻工艺流程包括:
表面处理→涂胶→前烘→曝光→显影→后烘→刻蚀→去胶。
光刻机是实现图形转移的重要设备,而套准精度是判断光刻机性能的一个重要参数。套准精度指后续掩模版与先前掩模版刻在硅片上的图形互相对准的程度。而Si1-x-yGexCy薄膜的表面粗糙度对于套准精度的影响则是本文所要研究的主要内容。
3 实验结果及分析
3.1 Si1-x-yGexCy薄膜生长对衬底材料的依赖性
由于Si1-x-yGexCy薄膜采用的是低温外延工艺,薄膜的生长速率随温度的变化非常明显。并且由于外延工艺的特点,薄膜生长对硅片衬底也有很强的依赖性。当衬底是单晶硅时,原子会沿着硅单晶原来的晶向排列向外生长,形成的也是单晶薄膜;当衬底是氧化硅/氮化硅或多晶硅等非单晶薄膜时,生长出的则是多晶薄膜,这就导致Si1-x-yGexCy薄膜在不同薄膜表面和不同Pattern density的情况下生长速率也不尽相同,进而对工艺和产品产生不同的影响。
图1~图4是Si1-x-yGexCy薄膜生长于单晶硅、SiO2、Si3N4和α-Si表面的SEM照片,从图中我们可以看出,因为单晶硅表面的Si1-x-yGexCy薄膜也是单晶,所以表面非常光滑均匀。而在SiO2、Si3N4和α-Si表面均为多晶硅,并且不同薄膜表面的Si1-x-yGexCy多晶硅粗糙程度也不一样,其中氧化硅表面的多晶硅最为粗糙,而氮化硅和α-Si表面的多晶硅膜则相对平滑均匀很多。

图1 单晶体硅表面的SiGeC

图2 SiO2表面的SiGeC
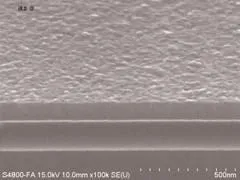
图3 Si3N4表面的SiGeC

图4 α-Si表面的SiGeC
3.2 Si1-x-yGexCy薄膜表面的反射率研究
3.2.1 反射率测试系统稳定性评估
GRR(Gauge Repeatability and Reproducibility)测试是对量测系统的稳定性和再现性的标准的评定方法,目前业内通用的评定标准为GRR<30%,即认为量测结果是稳定可靠的,GRR<10%,结果是精准的。图5为不同衬底上生长的Si1-x-yGexCy薄膜反射率的GRR测定结果,在不同的衬底上Si1-x-yGexCy薄膜反射率的GRR值都在30%以下,测试系统的结果是可信的,在SiO2、Si3N4、α-Si衬底反射率的GRR值甚至在10%以下,结果十分精确,这为Si1-x-yGexCy薄膜反射率表征打下基础。从实验数据还可以看出,较粗糙的Si1-x-yGexCy薄膜反射率GRR较低,其原因可能在于:较粗糙表面反射率的变化范围较大。

图5 不同衬底SiGeC薄膜反射率的GRR测试结果
3.2.2 不同膜层表面反射率的测试结果比较
图6为不同衬底Si1-x-yGexCy薄膜反射率的实验结果,结果表明:在不同的衬底上沉积的Si1-x-yGexCy薄膜其反射率有明显差异,由于不同衬底的Si1-x-yGexCy薄膜的表面状态有明显差异,反射率可以作为监控Si1-x-yGexCy薄膜表面状态的有效方法。

图6 不同衬底SiGeC薄膜反射率的实验结果
3.2.3 不同Ge含量膜层表面反射率的实验结果
图7为相同衬底上生长的Si1-x-yGexCy薄膜反射率的实验结果,结果表明:不同Ge含量的Si1-x-yGexCy薄膜,其反射率有明显差异,反射率可以明显地区分不同Ge含量的Si1-x-yGexCy薄膜。

图7 相同衬底SiGeC薄膜反射率的实验结果
3.3 不同Ge含量对光刻对准性能的影响
图8为不同Ge含量Si1-x-yGexCy薄膜光刻对准信号(LSA)的实验结果,Ge含量对光刻对准信号有明显影响,随着Si1-x-yGexCy薄膜Ge含量的增加,光刻对准信号明显变弱,当Ge含量大于28%之后,光刻对准信号就变得非常弱了。

图8 不同Ge%含量SiGeC薄膜光刻对准信号的实验结果
3.4 不同外延膜厚度对光刻对准性能的影响
图9为不同厚度的Si1-x-yGexCy薄膜光刻对准信号(FIA)的实验结果,Si1-x-yGexCy薄膜的厚度对光刻对准信号的影响较小,也没有明显的规律可寻。
3.5 衬底对对准套刻精度的影响
由于Si1-x-yGexCy薄膜生长的衬底不同,表面粗糙度有明显差异,单晶硅上生长比较均匀,在SiO2、Si3N4和α-Si表面生长较为粗糙。图10为不同衬底的光刻套刻精度(3-Sigma)的实验结果,Si1-x-yGexCy薄膜的表面状态对套刻精度影响较大,平滑表面套刻量测精度较高。
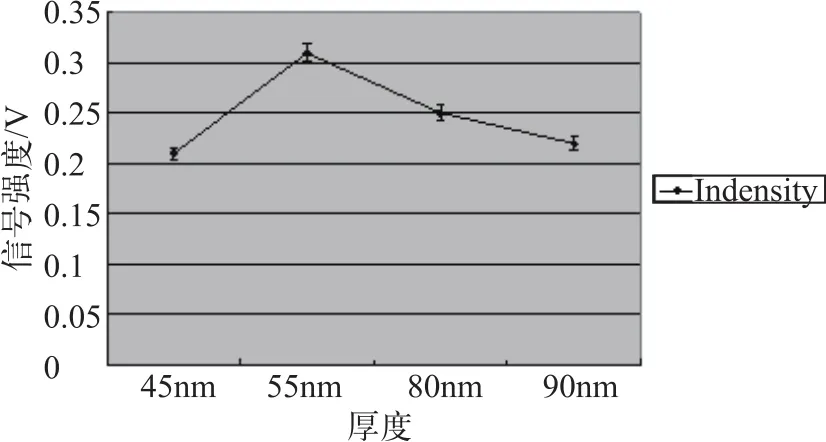
图9 不同厚度光刻对准信号的实验结果

图10 不同衬底的光刻套刻精度(3-Sigma)的实验结果
4 结论
(1)Si1-x-yGexCy薄膜的反射率可以稳定地测量,反射率对薄膜的粗糙度、成分有较强的区分度(10% 以上),证明了反射率表征Si1-x-yGexCy薄膜的可行性;
(2)Si1-x-yGexCy薄膜Ge含量对光刻对准性能影响较大,Ge含量越高,对准信号越弱,而Si1-x-yGexCy薄膜的厚度对光刻对准信号影响较小;
(3)Si1-x-yGexCy薄膜表面的粗糙度对光刻套刻精度影响很大,粗糙表面的套刻无法精确测量,3-Sigma接近70 nm,而平滑表面仅20 nm。
[1] 徐世六,等. SiGe微电子技术[M]. 北京:国防工业出版社,2007.
[2] 谢孟贤,刘诺. 化合物半导体材料与器件[M]. 成都:电子科技大学出版社,2000.
[3] Paul D. The Physics, Material and Devices of Silicon Germanium Technology [J]. Physics Word.
[4] Buschhbeck M. UVH/CVD for Low Temperature Epitaxy of Silicon Germanium(High speed Silicon)[A]. Unaxis Semiconductors Switzerlan.
[5] Kiyoa Y, et al. HCl-free Selective Epitaxial Si-Ge Growth by LPCVD for high-Frequency HBTs [J]. IEEE transaction on electron devices, 2002(49)∶ 5.
