In含量对InGaN/GaN LED光电性能的影响
2013-12-04李国斌陈长水刘颂豪
李国斌,陈长水,刘颂豪
(华南师范大学信息光电子科技学院广东省微纳光子功能材料与器件重点实验室,广东广州 510631)
1 引 言
近年来,随着InGaN基LED技术的不断发展和成熟,大注入条件下高量子效率的高亮度LED有望逐步取代传统照明用的白炽灯和日光灯[1-2]。然而,在大注入条件下(>100 A/cm2),LED的量子效率大幅下降,只有在电流密度较小(~10 mA/cm2)时才会出现峰值效率。这就是所说的Efficiency Droop现象。量子效率下降效应严重阻碍了LED在大功率器件和普通照明方面的发展和应用。科研工作者对量子效率下降现象进行了大量的研究,并针对不同的影响机制提出了不同的理论解释和理论模型,如俄歇复合[3-5]、载流子泄漏[6-9]、空穴注入效应[10-11]、极化效应[12-13]、载流子离域[14-15]、热效应[16]等。但这些理论和模型并没有得到一致的认可和接受,因此有必要对效率下降现象做进一步的研究和探索。
InGaN/GaN量子阱材料以其相对较高的发光效率[17]被广泛用做高功率蓝绿LED和半导体激光的活性层,然而对于其高功率的发光机制目前还不是特别清楚,不同的研究者提出了不同的观点,各个观点之间也存在着很多争论。其中最主要的有两种观点:一种观点认为,当In含量较大时,由于InGaN/GaN之间存在着晶格常数失配,在界面存在着界面缺陷,发生应变,应力导致电荷分离,产生较大的极化效应。由于极化效应而产生了很大的极化电场,使得量子阱发生量子阱束缚斯塔克效应QCSE(Quantum-confined Stark effects),从而导致能带弯曲,光谱红移,而红移的程度则取决于极化电场的大小与量子阱的厚度[20-23]。另一种观点则认为,很多光学性能并不是由QCSE引起的,而是因为掺杂的In分布不均匀,使得在InGaN/GaN中形成了很多像量子点(Quantum Dots)那样的结构,正是因为这种结构的存在使得量子阱中产生了激子。当量子阱宽较窄(≤2 nm)时,激子发生局域化效应,相互作用增强,成为很多复合发光中心,使得InGaN/GaN量子阱有较高的发光功率[18-19]。除了上面两种观点以外,还有研究者认为空穴局域化效应是其发光的主要机制等[24]。而Humphreys的研究发现,在InGaN材料中并不存在In团簇的结构[25]。
本文对不同In含量的InGaN量子阱LED的模拟实验进行了分析,发现InGaN/GaN的很多光学功能和量子阱束缚态分裂能级与电子泄漏有很大关系。结果显示,随着电流密度的增大,功率光谱密度不断增大,光谱发生蓝移,辐射速率不断增加,相对辐射速率不断下降。In含量较小时,光谱发生蓝移程度相对较小,但势垒较低,在电流密度较大(>8 kA/cm2)时,电子容易发生泄漏,导致发光功率降低,因此应该选择较小的工作电流。In含量较大时,光谱发生蓝移程度较大,然而势垒较高,电子不易发生泄漏,在大电流密度时具有较高的发光功率,因此应该选择较大的工作电流。而电流密度的大小则以8 kA/cm2为分界点。这些结论将对InGaN/GaN LED量子阱结构优化与In含量的掺杂,提高内量子效率与发光效率起到一定的指导作用。
2 实 验
2.1 模拟实验条件
本文运用SILVACO软件模拟In含量的变化对InGaN/GaN单量子阱LED性能的影响,结合了自洽模型、载流子泄漏模型、漂移扩散模型等。模拟的部分参数采用系统默认值(见SILVACO使用手册)。
2.2 器件结构
器件的工作温度为300 K,选用的器件尺寸为0.35 mm ×0.35 mm,器件结构(如图 1 所示)从下到上依次为:c面蓝宝石衬底;30 nm厚的非掺杂GaN缓冲层;4 μm厚的n-GaN(n型掺杂浓度为1×1018cm-3);3 nm厚的活性层(InGaN);100 nm厚的p-电子阻挡层(p型掺杂浓度为7×1017cm-3);0.5 μm厚的p-GaN层(p型掺杂浓度为1 ×1019cm-3)。p 电极为金属Ni,n 电极为 Ti。
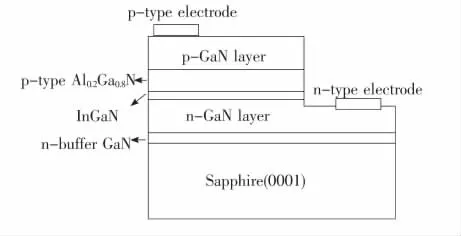
图1 器件结构示意图Fig.1 Schematic diagrams of LED structures
3 结果与讨论
3.1 开启电压
不同 In含量的 InxGa1-xN/GaN LED的 I-V特性如图2所示。当0 V<V<3.8 V时,电流随着x的增大而增大;而当3.9 V<V<5 V时,电流随着x的增大而越来越小。这是因为在低电压时,随着In含量的增大,势垒高度不断增大,导致了空穴注入的减少,电子发生辐射的几率减少;另外,还导致了内建电场的增大,电子漂移增大,因此电流偏大。而随着电压的继续增大,In含量较少的势垒高度较低,电子逃脱量子阱的束缚变得相对容易,电子开始发生泄漏,从而导致电流的增大。另外极化效应与应力作用也会使I-V特性发生变化。

图2 不同In含量的LED器件的I-V特性Fig.2 I-V characteristic of InGaN/GaN LEDs with various In content
3.2 量子阱中电子和空穴的浓度
从图3中可以看出,对于不同的In含量,量子阱内的电子浓度随电流密度的变化是不一样的。对于不同的电流密度,In含量较低(x=0.16)时的电子浓度增量要比In含量较高(x=0.22)时的增量小,而量子阱里总的电子浓度也随着In含量的增加而增大。这主要归因于不同的In含量会使量子阱有不同的禁带宽度,从而具有不同的势垒高度。In含量越小,禁带宽度越大,导致势垒高度越低;In含量越大,则禁带宽度越小,势垒高度相对就越高。对于不同的势垒高度,量子阱中的束缚态分裂能级的数量与能级高度不尽相同。势垒越高,能级数量越多,电子所能占据的能态就越多;势垒越低,能级数量越少,电子所能占据的能态就越少。因此,随着In含量的增加,量子阱里电子浓度越来越大。
而图3中增量的大小则与电流密度有很大关系。在低电流密度时,电子大部分都被量子阱束缚。随着电流密度的增大,由于In含量较低的量子阱中电子能级数量较少,电子所能占据的能态较少,所以电子很容易发生泄漏,挣脱量子阱的束缚,从量子阱中逃逸出来。因此,其电子浓度的增量要小于In含量较高的量子阱。
图4为In含量不同的量子阱中空穴浓度随电流密度的变化关系。与量子阱中的电子浓度一样,随着电流密度的增大,空穴的注入也不断增加。不同的是,在低电流密度时,空穴浓度增加量大致一样;而随着电流密度的不断增大,In含量(x=0.16)较少量子阱中的空穴浓度的增量要小于In含量(x=0.22)较大的量子阱。这与电子浓度的增加刚好是反过来的。这主要归因于电流密度较大时,空穴的注入增大。
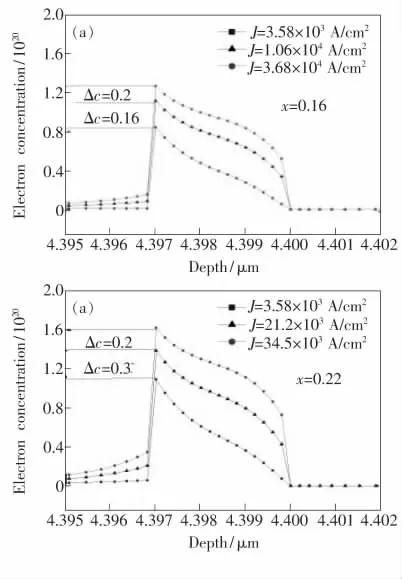
图3 同In含量的量子阱中的电子浓度随电流的变化关系。(a)x=0.16;(b)x=0.22。Fig.3 The electron concentration of InGaN/GaN quantum wells with various In content vs.injection currents.(a)x=0.16.(b)x=0.22.
从图3和图4中还可以看出空穴浓度要大于电子浓度。除了上面分析的原因外,极化效应也是一个很重要的原因。极化效应会导致能级弯曲,加剧电子的泄漏与空穴的注入。而In含量的增加又加剧了量子阱的极化效应,增加了电子与空穴的浓度差。图3中,x=0.16,电子、空穴浓度差约为0.35 ×1020;而图4 中,x=0.22,电子空穴浓度差约为1.6×1020。由此可知,In含量的大小决定了量子阱中电子、空穴浓度的多少。
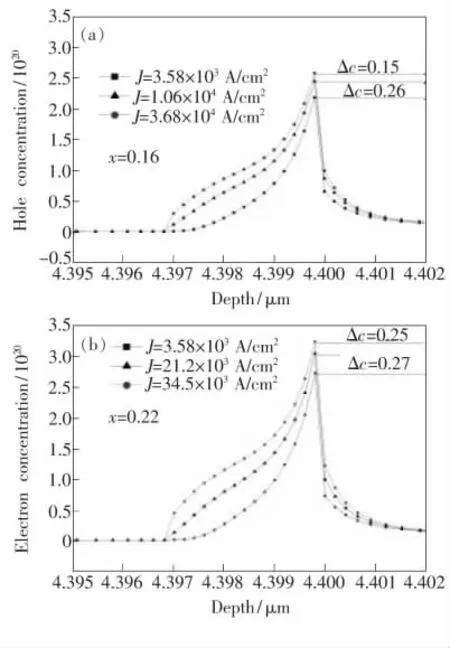
图4 不同In含量的量子阱中空穴浓度随电流变化关系。(a)x=0.16;(b)x=0.22。Fig.4 The hole concentration of InGaN/GaN quantum wells with various In content vs.injection currents.(a)x=0.16.(b)x=0.22.
3.3 器件光谱分析
图5为量子阱中电子能级跃迁示意图。图6为不同注入电流下的功率光谱密度随In含量的变化关系。可以看出,In含量不同的器件,其光谱密度峰值不一样。随着In含量的增加,密度峰值逐渐减小,光谱宽度不断增大。随着电流密度的增大,蓝移程度也不断增大,从Δλ=40 nm增大到Δλ=55 nm。在低电流密度时,与x=0.16,0.18,0.20,0.22 相对应的峰值波长分别为445,455,465,478 nm,这与我们理论计算的数值是一样的(如表1所示)。而随着电流密度的增加,光谱开始出现蓝移现象,这主要归因于电子的能级填充效应。

图5 量子阱中电子能级跃迁示意图Fig.5 The diagram of the electronic transition in the quantum well with various In concentration
在量子阱中,In含量的不同将导致量子阱中束缚态能级的分布完全不同。通过理论计算,我们得到量子阱导带中电子束缚态分裂能级差随着In含量的增大而增大,如表1所示。而价带中的空穴能态也会发生能级分裂,通过前面量子阱中的空穴浓度分析可知,空穴能级差也会随着In含量的增加而增大,如图5所示。
当In含量较低时,束缚态分裂能级差较小;随着In含量的增大,分裂能级差不断增大。因此,当电流密度增大时,电子将填充高能级束缚态分裂能级,从而发生光谱蓝移,而光谱密度增加量也不断减小。由此可知光谱蓝移会随着In含量的增大而增加。
图7为不同电流下In含量不同的功率光谱密度。从图6、图7中不难发现(图中圆圈所示),有一些小的密度峰值。这些密度峰值为何会出现?且只有在In含量较低、电流密度较大时才出现?正如前面所作的分析,在In含量较低时,量子阱导带中的电子能级距离阱口较近,容易挣脱量子阱的束缚,逃离出来,在GaN中发生跃迁(图5)。从图7中可知,圆圈中的峰值波长约为380 nm,其所对应的禁带宽度则为3.26 eV,与GaN的禁带宽度3.42 eV非常接近。再考虑到GaN极化效应所导致的能带弯曲引发的红移,那么结果就更加正确了。由此可以发现,电子泄漏确实发生了,而且会随着势垒高度的减少而增大。也进一步说明了能级填充的正确性。
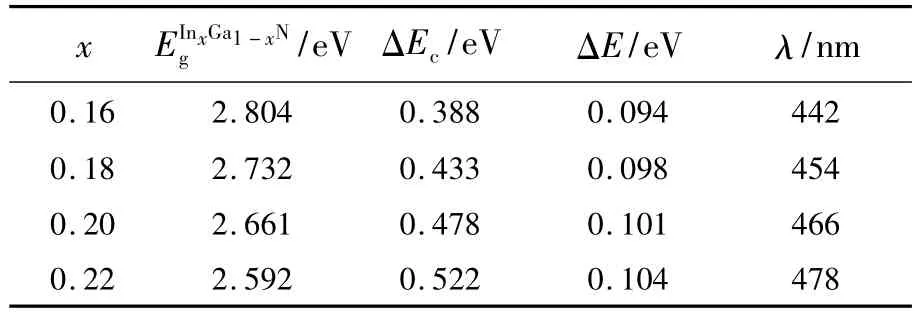
表1 与In含量相关的器件参数Table 1 The parameters related to the different In content

图6 不同注入电流下功率光谱密度随In含量的变化关系。(a)x=0.16;(b)x=0.18;(c)x=0.20;(d)x=0.22。Fig.6 The power spectral density of InGaN/GaN LEDs with various In content vs.injection currents.(a)x=0.16.(b)x=0.18.(c)x=0.20.(d)x=0.22.
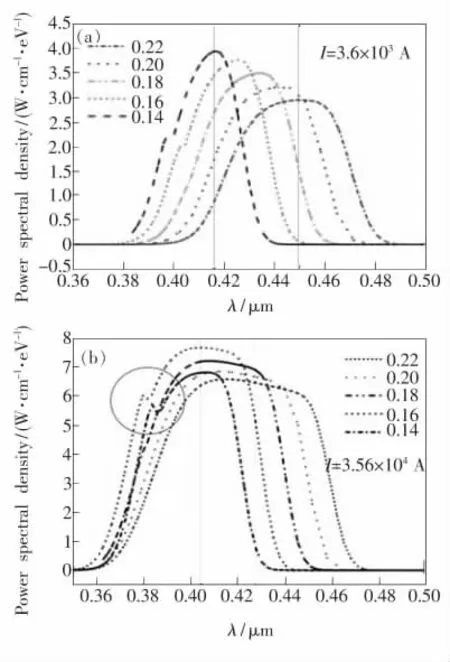
图7 不同电流下In含量不同的功率光谱密度。(a)I=3.6 ×103A;(b)I=3.56 ×104A。Fig.7 The power spectral density of the InGaN/GaN LEDs with various In content.(a)I=3.6 × 103A.(b)I=3.56 ×104A.
3.4 器件的发光效率
图8、图9是量子阱中的辐射速率、相对辐射速率与电流密度的关系。随着电流密度的增大,辐射速率不断增大,In含量较小的器件的辐射速率增长幅度要小于In含量较大的器件。这是因为随着电流密度的不断增大,In含量较小的器件由于分裂能级距离阱口较低,电子容易发生泄漏,使得电子注入相对减少,辐射速率增幅不大;而随着In含量的增大,势垒高度增加,电子不易发生泄漏,使得辐射速率相对较高。
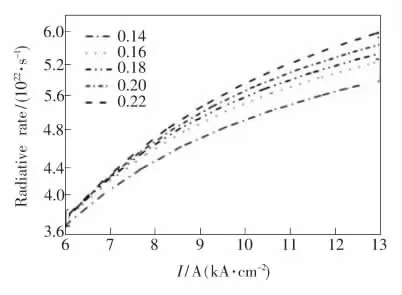
图8 In含量不同的辐射速率Fig.8 The radiative rate of the InGaN/GaN LEDs with various In content

图9 In含量不同的相对辐射速率Fig.9 The relative radiative rate of the InGaN/GaN LEDs with various In content
从图9中可看出,随着电流密度的增大,相对辐射速率下降。这说明非辐射复合在不断地增加,导致了内量子效率的下降。In含量越小则下降越快,这主要是由于In含量较小时电子容易泄漏;另外一个原因就是In含量小时所形成的辐射发光中心少[26],也会导致辐射相对较少,而相对辐射速率下降更快。
从图10中可以看出,当电流密度较小(<8 kA/cm2)时,In含量越小,输出功率越大;当电流密度较大(>8 kA/cm2)时,In含量越小,输出功率越小。这是因为在低电流密度时,In含量越高则势垒高度越大,空穴能级升高,空穴注入越难,电子-空穴对的复合较少,使得输出功率减少。从图2中也能看出由于空穴注入很少,导致电子漂移运动增加,电流增大。而当电流密度增大到8 kA/cm2左右时,In含量较小的器件由于电子的泄漏而导致电流开始增大。因此,可以知道In含量较小的器件更加容易发生电子泄漏,导致相对复合速率下降更快(如图9),输出功率上升较慢(如图10)。相对于In含量较高的器件,其输出功率要偏小。
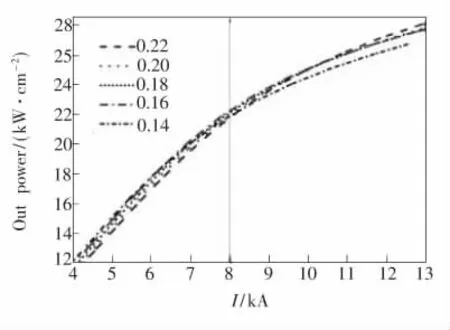
图10 不同In含量的InGaN/GaN LEDs的输出功率Fig.10 The out power of the InGaN/GaN LEDs with various In content
4 结 论
对比分析了不同In含量的InGaN/GaN LEDs的功率光谱密度、量子阱中电子空穴浓度、发光功率以及复合率等参数,发现电子泄漏和能级填充是影响光电性能的主要原因。随着电流密度的增大,功率光谱密度也不断增大,光谱发生蓝移,辐射速率不断增大,相对辐射速率不断下降。In含量较小时,光谱发生蓝移程度相对较小,但势垒较低,在电流密度较大(>8 kA/cm2)时,电子容易发生泄漏,导致发光功率下降,因此应该选择较小的工作电流;In含量较大时,光谱发生蓝移程度较大,然而势垒较高,电子不易发生泄漏,在大电流密度时具有较高的发光功率,因此应该选择较大的工作电流。这些结论将对InGaN/GaN LED量子阱结构优化、提高内量子效率与发光效率起到一定的指导作用。
[1]Li X,Okur S,Zhang F,et al.Improved quantum efficiency in InGaN light emitting diodes with multi-double-heterostructure active regions[J].Appl.Phys.Lett.,2012,101(4):1115-1119.
[2]Chen G C,Fan G H.Study on long-wavelength optical phonons in hexagonal InAlGaN crystals[J].Chin.J.Lumin.(发光学报),2012,33(8):808-811(in English).
[3]Kioupakis E,Rinke P,Delaney K T,et al.Indirect Auger recombination as a cause of efficiency droop in nitride lightemitting diodes[J].Appl.Phys.Lett.,2011,98(16):161107-1-3.
[4]Shen Y C,Mueller G O,Watanabe S,et al.Auger recombination in InGaN measured by photoluminescence[J].Appl.Phys.Lett.,2007,91(14):141101-1-3.
[5]Delaney K T,Rinke P,Van de Wall C G.Auger recombination rates in nitrides from first principles[J].Appl.Phys.Lett.,2009,94(19):191109-1-3.
[6]Joachim P,Li S.Electron leakage effects on GaN-based light-emitting diodes[J].Opt.Quant.Elect.,2011,42(2):89-95.
[7]Pope I A,Smowton P M.Carrier leakage in InGaN quantum well light-emitting diodes emitting at 480 nm[J].Appl.Phys.Lett.,2003,82(17):2755-2757.
[8]Mao A,Jaehee C.Reduction of efficiency droop in GaInN/GaN light-emitting diodes with thick AlGaN cladding layers[J].Electron.Mater.Lett.,2012,8(1):1-4.
[9]Meyaard D S,Shan Q,Dai Q,et al.On the temperature dependence of electron leakage from the active region of GaInN/GaN light-emitting diodes[J].Appl.Phys.Lett.,2011,99(4):041112-1-3.
[10]Bulashevich K A,Karpov S Y.Is Auger recombination responsible for the efficiency rollover inⅢ-nitride light-emitting diodes[J].Phys.Status Solidi(c),2008,5(6):2066-2069.
[11]Xie J Q,Xian F N,Qian F,et al.On the efficiency droop in InGaN multiple quantum well blue light emitting diodes and its reduction with p-doped quantum well barriers[J].Appl.Phys.Lett.,2008,93(12):121107-1-3.
[12]Kunzer M,Leancu C C,Maier M,et al.Well width dependent luminescence characteristics of UV-violet emitting GaInN QW LED structures[J].Phys.Status Solidi(c),2008,5(6):2170-2172.
[13]Reed M L,Readinger E D,Moe C G,et al.Benefits of negative polarization charge in n-InGaN on p-GaN single heterostructure light emitting diode with p-side down[J].Phys.Status Solidi(c),2009,6(2):585-588.
[14]Jaehee C,Euijoon Y,Wo J H,et al.Characteristics of blue and ultraviolet light-emitting diodes with current density and temperature[J].Electron.Mater.Lett.,2010,6(2):51-53.
[15]Kim A Y,Steigerwald D A,Wierer J J,et al.Performance of high-power AlInGaN light emitting diodes[J].Phys.Status Solidi(a),2001,188(1):15-21.
[16]Efremov A A,Bochkareva N I,Gorbunov R I,et al.Effect of the joule heating on the quantum efficiency and choice of thermal conditions for high-power blue InGaN/GaN LEDs[J].Semiconductors,2006,40(5):605-610.
[17]Nakamura S,Senoh M,Iwasa N,et al.Super bright green InGaN single quantum well structure light-emitting diodes[J].Jpn.J.Appl.Phys.B,1994,34(10):L1332-L1335.
[18]Zheng D Y.Characterization and analysis on optics character of semiconductor luminescence material[D].Yantai:Yantai University,2005.
[19]Son J H,Lee J L.Strain engineering for the solution of efficiency droop in InGaN/GaN light-emitting diodes[J].Opt.Exp.,2010,18(6):5466-5469.
[20]Im J S,Kollmer H,Off J,et al.Reduction of oscillator strength due to piezoelectric fields in GaN/AlGaN quantum wells[J].Phys.Rev.B,1997,57(16):9435-9438.
[21]Cheong M G,Liu C,Choi H W,et al.Study of the origin of luminescence in high indium composition InGaN/GaN quantum wells[J].J.Appl.Phys.,2003,93(8):4691-4695.
[22]Chichibu S,Azuhata T,Sota T,et al.Spontaneous emission of localized exactions in InGaN single and multi quantum well structures[J].Appl.Phys.Lett.,1996,69(27):4187-4189.
[23]Qin X L,He Z Y,He N.Efficiency characteristic analysis and driving scheme design of power LEDs[J].Chin.J.Liq.Crys.& Disp.(液晶与显示),2012,(3):371-377(in Chinese).
[24]Morel A,Lefebvre P,Kalliakos S,et al.Donor acceptor like behavior of electron-hole pair recombinations in low-densional GaInN/GaN systems[J].Phys.Rev.B,2003,68(4):045331-1-7.
[25]Humphreys C J.Does In form In-rich clusters In InGaN quantum wells[J].Philosophical Magazine,2007,87(13):1971-1982.
[26]Narukawa Y,Kawakami Y,Fujita S,et al.Dimensionality of exactions in laser-diode structures composed of InxGa1-xN multiple quantum wells[J].Phys.Rev.B,1999,59(15):10283-10288.
