封装SiCp/Cu复合材料组织性能研究
2013-11-05杜建全王开坤田丽倩
杜建全,王开坤,周 璐,田丽倩
(1.北京科技大学材料科学与工程学院,北京,100083;2.中航三林集团钛业有限公司,山东 淄博,255086)
随着航空航天和国防微波电路、微电子器件、半导体集成电路向大功率、小型化、轻量化、高密度组装化以及高性能、高可靠性方向的发展,对电子封装材料提出了更高要求[1]。传统的封装材料往往在某个性能上存在不足,如因瓦合金、可伐合金虽然具有较低的热膨胀系数,但导热性能很差;某些金属如Cu、Al具有很好的导热性,但热膨胀系数过大;Mo和W的热物理性能较好,但难于焊接,不易加工,且密度大、价格高。因此,开发新型高性能电子封装材料成为必然趋势[2-4]。
碳化硅颗粒增强铜基复合材料就是在此背景下新近出现的一种新型封装材料,SiCp/Cu材料结合了碳化硅低热膨胀系数、高强度以及铜的高导热性、韧性,是一种颇为理想的封装材料[5]。为此,本文采用粉末冶金法制备不同体积分数SiC的SiCp/Cu复合材料,并对其显微组织、热物理性能和力学性能进行研究,以期为封装SiCp/Cu复合材料的制备工艺提供依据。
1 实验
1.1 材料
本实验所用基体材料为锡青铜粉末,颗粒尺寸约为74μm,其中Sn含量约为10%,其熔化起始温度为862℃,熔化结束温度为1011℃,流动性为30~35s/50g,密度为2.6~3.5g/cm3。增强体材料为不规则形状的SiC颗粒,平均颗粒尺寸为10μm。高温下SiC颗粒与Cu基体易发生界面反应生成Cu3Si等中间合金,而且青铜与SiC颗粒的润湿性很差,所以在复合材料中需添加少量的Al粉末。
1.2 实验方法
1.2.1 SiCp/Cu复合材料制备
按照预先设定比例配制SiC、铜合金粉和Al粉末,并将其放入球磨机中通过机械湿混法进行均匀混合,混粉时间为1h。将混粉均匀的粉末在YT32-200C型四柱液压机上进行冷压致密化,对压制后的复合材料进行排蜡处理以去除压坯中的黏结剂,然后对压坯进行无压烧结,烧结温度为800℃,保温时间为1h,分别制备出SiC体积分数为20%、35%、50%的SiCp/Cu复合材料试样。
1.2.2 试样表征
采用NEOPHOTO21型金相显微镜、LEO-1450型扫描电镜对制备不同体积分数SiC的SiC/Cu复合材料试样进行组织观察;采用 WCP型热膨胀仪、DZL402C型热分析仪对试样热物理性能进行测定;采用TH320型洛氏硬度计对试样进行硬度分析。
2 结果与分析
2.1 SiCp/Cu复合材料的组织结构
图1为不同体积分数SiC制备SiCp/Cu复合材料的金相组织照片。由图1可看出,SiC体积分数为20%时复合材料SiC颗粒分布均匀,未观察到气孔。但随着SiC体积分数的增大,复合材料中的气孔、孔洞增多,增强相出现偏聚,且SiC体积分数越大,增强相的偏聚现象越加严重。
图2为SiC体积分数为20%时SiCp/Cu复合材料的SEM照片。由图2(a)可看出,SiCp/Cu复合材料的组织致密,无裂纹、气孔;基体晶界明显,晶粒细小;SiC颗粒与基体结合良好,个别区域出现堆砌、偏聚现象,偏聚区有少量空洞。这是由于SiC形状不规则且硬度极大,因此在压制过程中,相邻颗粒之间有时出现滑动、移位,甚至出现孔洞。由图2(b)可看出,SiC与青铜合金之间的界面结合主要依靠机械咬合,增强体与基体之间主要依靠粗糙面相互嵌入互锁来进行连接,复合材料界面干净且紧密。
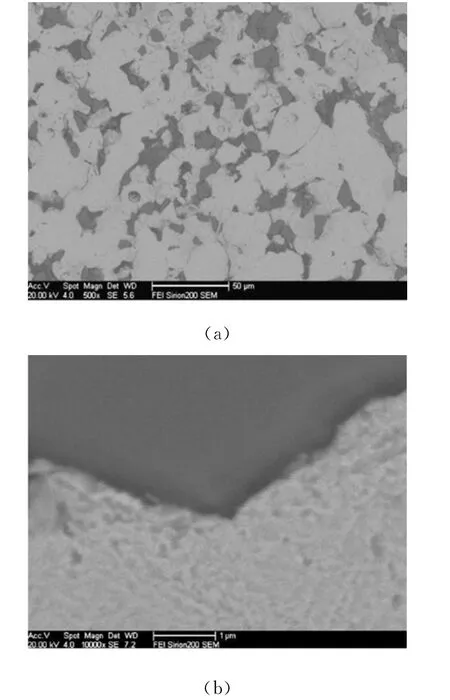
图2 SiCp/Cu复合材料的SEM照片Fig.2 SEM micrographs of SiCp/Cu composite
2.2 SiCp/Cu复合材料热导率分析
青铜基体与SiC增强相的热导率分别为245、120W/m·K,采用几何模型、Maxwell模型和Bruggement模型[6]对不同体积分数SiC的SiCp/Cu复合材料热导率进行理论计算,其热导率理论值变化曲线如图3所示。由图3可看出,不同体积分数SiC的SiCp/Cu复合材料热导率曲线相差不大,也就是说,在相同的增强相体积分数下,按照不同模型计算的复合材料热导率值相差不大,其理论计算模型均以假设增强相的圆球形为基础。
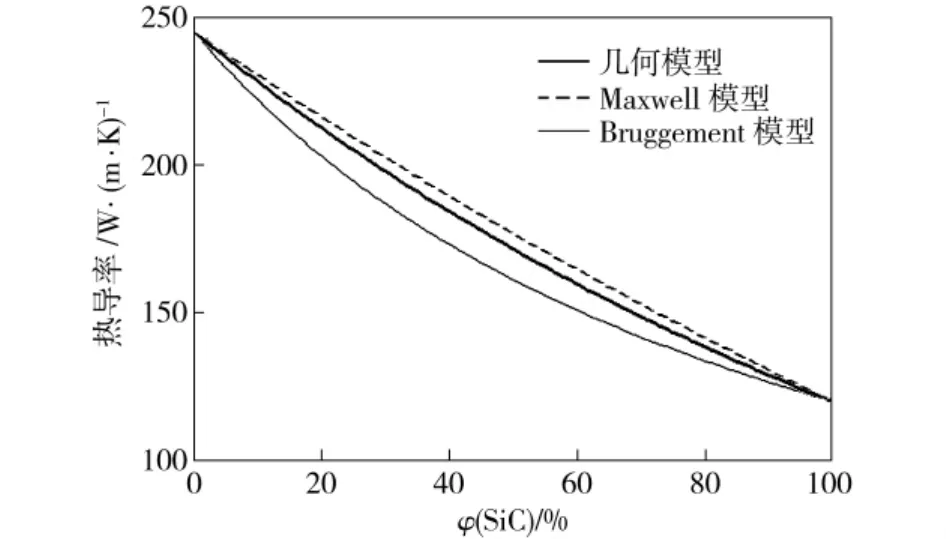
图3 SiCp/Cu复合材料热导率理论值与SiC体积分数的关系Fig.3 Relationship between theoretical value of thermal conductivity of SiCp/Cu composites and volume fraction of SiC
通过对不同体积分数SiC的SiCp/Cu复合材料进行热导率测量,SiC体积分数为20%、35%、50%的复合材料热导率分别为167、145、130W/m·K。由此可看出,复合材料热导率的实际值小于理论值,这在很大程度上表明粉末冶金法制备复合材料具有一定的孔隙率。SiCp/Cu复合材料的热导率随着SiC含量的增多而减小,这与理论计算值相符合。事实上,颗粒增强复合材料的热导率不仅是增强体含量的函数,而且还受到其颗粒尺寸及分布情况的影响。
2.3 SiCp/Cu复合材料热膨胀系数分析
取SiC颗粒与铜基体热膨胀系数分别为5.12×10-6、16.15×10-6K-1,杨氏模量分别为450、110GPa,泊松比分别为0.142、0.3,采用ROM模型、Turner’s模型和Kerner模型对不同体积分数SiC的SiCp/Cu复合材料进行计算,其热膨胀系数理论值如图4所示。由图4可看出,SiCp/Cu复合材料的热膨胀系数理论值随着SiC含量的增多而减小。

图4 SiCp/Cu复合材料热膨胀系数与SiC体积分数的关系Fig.4 Relationship between thermal expansion coefficient of SiCp/Cu composites and volume fraction of SiC
本研究所测SiC体积分数分别为20%、35%、50%的SiCp/Cu复合材料热膨胀系数实际值分别为10.2×10-6、8.6×10-6、9.6×10-6K-1。由图4对比可知,当SiC体积分数分别为20%、35%时,复合材料热膨胀系数实际值小于上述3种模型的理论值,而当SiC体积分数为50%时,复合材料热膨胀系数较Turner’s模型理论值小。各种模型计算的热膨胀系数虽随着增强相的增多而减小,但当SiC体积分数为50%时,复合材料热膨胀系数反而比SiC体积分数为35%时的大,这是因为其致密度低,复合材料中含有大量气孔而严重影响热膨胀系数。
图5为SiC增强相体积分数为20%时复合材料热膨胀系数随着温度的变化。由图5可看出,复合材料热膨胀系数在温度为50~500℃范围内有升高趋势,且在100℃温区时升高速率较快,复合材料热膨胀系数控制在(10.2~12.7)×10-6K-1范围内,这与理论值具有匹配性,表明此复合材料热稳定性良好,可满足电子封装材料的要求。

图5 SiC体积分数为20%时SiCp/Cu复合材料的热膨胀系数曲线Fig.5 Thermal expansion coefficient curve of SiCp/Cu composites with 20%volume fraction of SiC
2.4 SiCp/Cu复合材料硬度分析
本研究测定了SiC体积分数分别为20%、35%、50%时SiCp/Cu复合材料的硬度,其结果如图6所示。由图6可看出,复合材料的硬度值随着SiC体积分数的上升先提高,随后有所降低。这是由于当SiC含量增加时,复合材料中受到外界压力时有效载体增多,因此材料的承载能力增强,复合材料硬度值提高。但随着SiC含量继续上升时,SiCp/Cu复合材料致密度减小,孔隙率增大,从而导致SiCp/Cu复合材料的硬度值降低。由此可看出,在SiCp/Cu复合材料中,当SiC体积分数小于35%时,复合材料的硬度值变化取决于SiC含量;当SiC体积分数大于35%时,复合材料的硬度值取决于致密度。

图6 不同体积分数SiC时SiCp/Cu复合材料硬度值Fig.6 Hardness of SiCp/Cu composites with different volume fractions of SiC
3 结论
(1)随着SiC体积分数的上升,SiCp/Cu复合材料的气孔、孔洞增多,其增强相偏聚,且SiC体积分数越大,增强相的偏聚现象越严重。
(2)随着SiC含量的升高,SiCp/Cu复合材料的热导率减小,其热膨胀系数先减小后增大,硬度值先提高后降低。在SiCp/Cu复合材料中,当SiC体积分数小于35%时,复合材料的硬度值变化取决于SiC含量;当SiC体积分数大于35%时,复合材料的硬度值取决于致密度。
[1]方明,王爱琴,谢敬佩,等.电子封装材料的研究现状及发展[J].材料热处理技术,2011,40(4):84-87.
[2]王常春,朱世忠,孟令江.铜基电子封装材料研究进展[J].临沂师范学院学报,2008,30(6):43-47.
[3]蔡辉,王亚平,宋晓平,等.铜基封装材料的研究进展[J].材料导报,2009,23(8):24-28.
[4]Z Jianhua,L Lei,H Guohua,et al.Study on composite electroforming of Cu/SiCpcomposites[J].Materials Letters,2004,58:1634-1637.
[5]陈栋.粉末冶金法制备SiCp/Cu复合材料工艺研究[D].西安:西安科技大学,2009.
[6]G F Celebi Efe,I Altinsoy,M Ipek,et al.Some properties of Cu-SiC composites produced by powder metallurgy method[J].Kovove Mater,2011,49:131-136.
