超高浓度钛掺杂硅薄膜的制备及光电特性研究
2013-03-10中国科学院研究生院周玉荣刘勇刘丰珍
中国科学院研究生院 ■ 周玉荣 刘勇 刘丰珍
一 引言
中间带太阳电池作为低成本、高效率的新概念光伏器件[1~4],目前得到了广泛关注。在硅中形成中间带的主要途径之一,是引入浓度超过Mott极限(>1019cm−3)的深能级杂质(如钛)[4]。由于掺杂浓度远高于掺杂元素在硅中的固溶度,因此不能通过常规的扩散方法来掺杂。目前有关文献报道的主要方法是采用离子注入在晶体硅中实现高浓度掺杂,并通过非平衡的后处理过程,如脉冲激光退火来恢复晶格并激活掺杂元素[3,4],以避免掺杂元素的析出。离子注入的主要缺点是掺杂元素随深度呈高斯分布。掺杂浓度低于Mott极限的区域中的杂质将起到复合中心的作用,降低材料和器件的电学性能。因此,实现深能级杂质的均匀掺杂对中间带电池的研究具有重要意义。此外,离子注入形成的高浓度掺杂层厚度通常小于100nm[3],这在一定程度上限制了中间带材料作用的发挥。而且,目前报道的钛在硅中的超高浓度掺杂的研究工作都是基于晶体硅衬底,未见对薄膜硅的相关报道。基于以上问题,本文将磁控溅射和热丝化学气相沉积相结合,制备出超高浓度掺钛的氢化非晶硅薄膜,实现杂质的均匀分布和掺杂层厚度的控制,并初步研究薄膜的光电特性。该研究工作对要求高浓度均匀掺杂的新概念中间带太阳电池、稀磁半导体[5,6]等具有重要意义。
二 实验
掺钛非晶硅薄膜采用热丝化学气相沉积和直流磁控溅射相结合的技术制备。热丝化学气相沉积的气源方向与直流磁控溅射靶材表面法线位于相互垂直的两个方向。衬底表面法线与热丝气源方向的夹角为8¡,与直流磁控溅射靶材表面法线夹角为82¡,以尽量减少溅射损伤。非晶硅薄膜通过热丝化学气相沉积制备,直流磁控溅射用来在硅薄膜的生长过程中实现钛掺杂。衬底为玻璃,衬底温度120℃,热丝温度1800℃,钛靶纯度99.999%。
如果实验中工作气体只有硅烷和氢气,或硅烷和氩气的流量比过高,不仅靶材不能被有效溅射出来,而且硅薄膜会在靶上沉积。通过实验确定了氢气、氩气和硅烷的混合气体作为工作气体,流量分别为12、6和6sccm,气压为1.9Pa。实验发现在上述沉积气氛下如果溅射功率密度低于1.2W/cm2,靶材也不能被溅出,因此实验中溅射功率密度>1.2W/cm2。
为了研究钛掺杂浓度对薄膜光电性能的影响,在不同的溅射功率下(1.32、1.54、1.72、2.04W/cm2),制备4个样品(样品1#、2#、3#、4#),沉积时间1h。为了研究薄膜退火特性,采用脉冲激光对5#样品(制备条件与3#相同,沉积时间为40min)进行了熔融退火处理。激光器输出波长532nm,脉冲宽度15ns,退火时采用0.1J/cm2和0.2J/cm2两种单脉冲能量,对应样品为6#和7#。采用光发射谱(OES,Horiba Micro HR)研究热丝对溅射过程的影响。
通过俄歇电子能谱(型号PHI-700)分析钛浓度随着薄膜深度的变化关系。掺钛薄膜的透射和反射谱采用日立UV4100测试得到。在300~50K温度范围,测量掺钛硅基薄膜的电输运温度特性。薄膜的拉曼谱采用HORIBA JobinYvon HR800测量。
三 实验结果
1等离子体光谱特性
为了研究热丝对溅射过程的影响,测量了热丝加热前后溅射辉光区的光发射谱,结果如图1所示。图中(HW)表示只有热丝加热,溅射功率为0;(MS)表示只有磁控溅射,热丝不加热;(HW+MS)表示磁控溅射起辉和热丝加热共同作用。这里磁控溅射功率密度为1.64W/cm2。对比以上3种情况可知,除了Hα发射峰(656nm)的强度在有热丝加热时略有增强(这与热丝有效分解硅烷,产生较多的原子氢有关),热丝和溅射都开启时的光发射强度约等于只开热丝和只开溅射时的发光强度之和。这表明热丝是否加热对溅射过程影响不大。即可通过分别控制HWCVD和溅射的工艺条件来控制硅薄膜的生长速率和钛的掺杂浓度。

图1 热丝加热前后的磁控溅射辉光区光发射谱
2掺钛非晶硅薄膜的杂质分布与光电特性
在直流溅射和热丝化学气相沉积工艺实现有效结合的基础上,采用不同的溅射功率密度,制备了1#、2#、3#和4# 4个样品。采用俄歇电子能谱分析了不同溅射功率密度下薄膜中钛的浓度随样品深度的变化关系,如图2所示。从图中可看出,钛的浓度为2%~8%。

图2 不同溅射功率下,硅薄膜中钛浓度随薄膜深度的变化
实现高浓度的掺杂,而且钛在薄膜中近似均匀分布,这是离子注入法不能实现的。图3为薄膜中钛的平均浓度随溅射功率密度的变化,可见在研究的功率范围内(1.32~2.04W/cm2),钛的平均浓度随溅射功率近似呈线性增加,实现了对掺杂浓度的有效控制。
图4为1#~4#样品的透射谱和反射谱。从图中可看出随着薄膜中钛含量的增加,薄膜在可见-红外波段的透过率和反射率均逐渐降低。综合透射和反射数据表明,随着钛浓度的增加,可见和红外波段的薄膜光吸收逐渐增加。
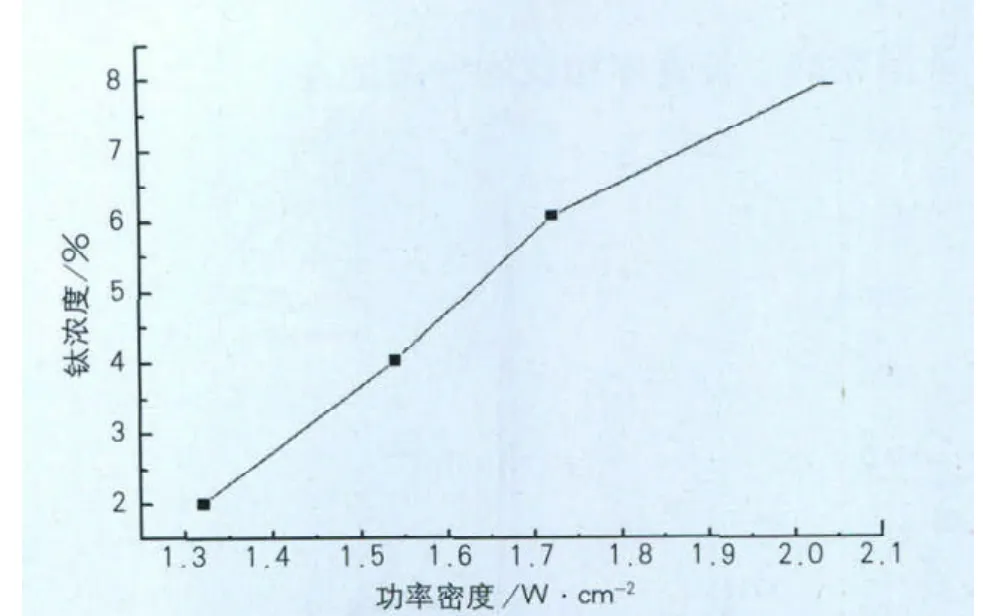
图3 薄膜中钛的平均浓度随溅射功率密度的变化
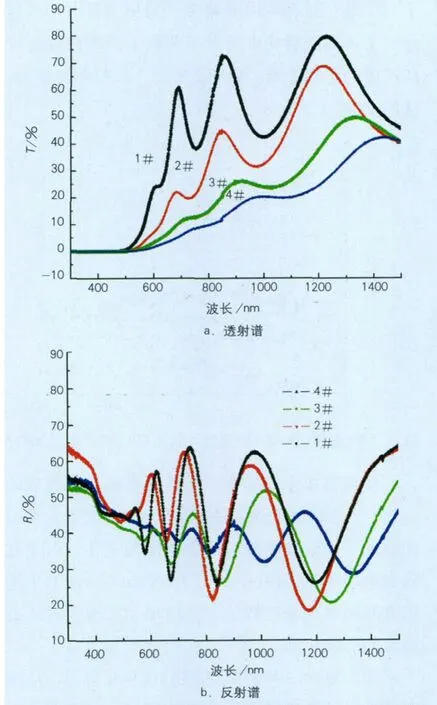
图4 不同掺杂浓度的掺钛非晶硅薄膜的光透射、反射谱
通过研究1#、2#、4#样品的电学特性,发现掺钛非晶硅膜常温下的电导率高出本征非晶硅膜(<10−10S/cm)7个数量级以上。为了研究掺钛硅薄膜的输运特性,测量了电导率σ随温度的变化。通常掺杂半导体电导率随温度的变化可用关系式[8,9]σ(T)=σ0exp[−(T0/T)s]拟合。s=1时,为扩展态电子传导;s=1/4为Mott变程跳跃电导。图5为1#、2#、4#样品电导率随温度的变化关系。可见对于3个掺杂浓度,基本满足s=1/4。
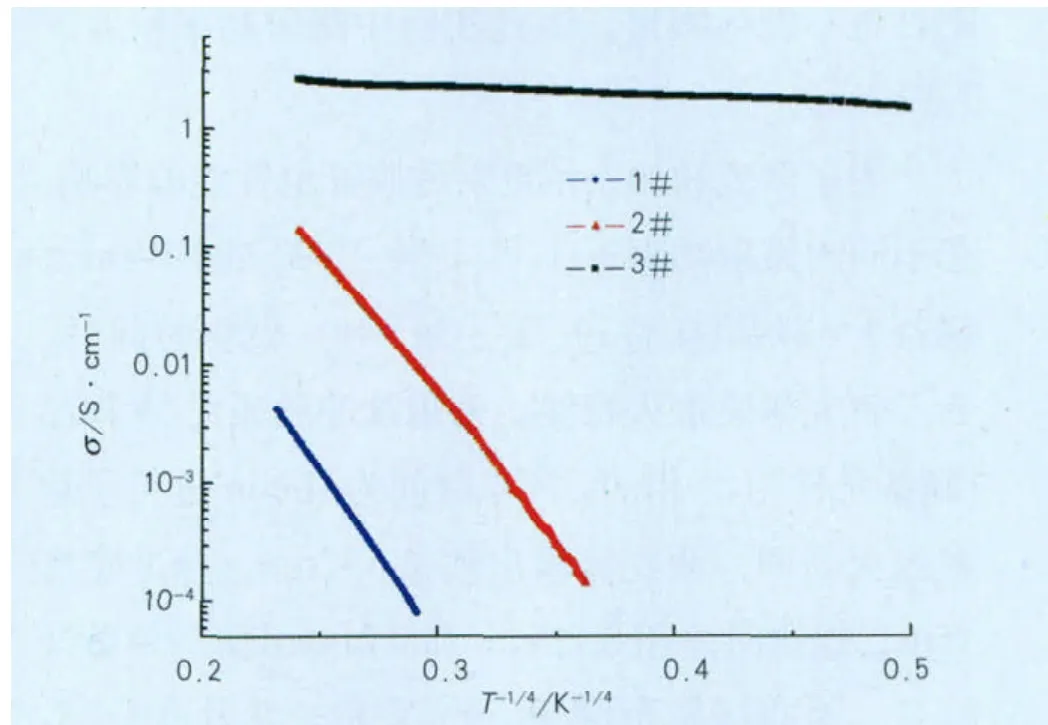
图5 1#、2#、4#样品的电导率随温度的变化关系曲线
以上电学性质表明:(1) 钛掺杂在薄膜中引入了载流子,起到了掺杂的作用;(2) 掺钛的氢化非晶硅薄膜整体上还是呈现半导体特性,电导率随着温度的降低而下降;(3)薄膜中载流子的输运方式主要是Mott变程跳跃导电。
3掺钛非晶硅薄膜的晶化
目前报道的在硅中实现中间带的理论计算都是基于晶体硅的情况。掺钛非晶硅薄膜的电学性质仍具有半导体材料的特征,没有表现出中间带材料的电输运特性。为了使薄膜晶化,并激活掺杂元素,对样品进行了退火处理。将5#样品先在480℃退火1h出氢气,再通过脉冲激光退火使样品晶化。图6为退火前后薄膜的拉曼光谱。其中5#为未退火,6#、7#样品分别对应激光熔融单脉冲能量为0.1J/cm2和0.2J/cm2的情况。从图6中可见未退火的样品为非晶,脉冲激光退火使样品有效的晶化,出现了520cm−1的晶化峰;6#和7#样品的拉曼谱几乎重合。通过三峰拟合得到6#、7#样品的晶化率都为51%。这表明当脉冲能量达到0.1J/cm2,再增加脉冲能量并不能提高样品的晶化率。

图6 掺钛非晶硅膜在经过脉冲熔融退火前后的拉曼谱
图7为样品退火前后的透射谱。结果显示退火后的样品和未退火的样品相比透过率提高了约7%,这可能是由于样品晶化后吸收系数降低造成的。但是退火后的样品并未看到明显的晶体硅的吸收边。一方面可能是因为样品的晶化率只有51%,而微晶硅的吸收系数远高于晶硅,所以样品的透射谱主要显示微晶硅的特征;另一方面,与未退火的低浓度掺钛(如1#样品)或未掺杂的硅薄膜相比,退火后的高浓度钛掺杂硅薄膜的透射率在500~1200nm范围内仍然要低得多,这与高浓度钛的存在有关。但薄膜材料中是否形成了中间带,还需要进一步的验证。今后将进一步研究激光熔融退火后薄膜的输运特性,以验证是否有中间带的形成。
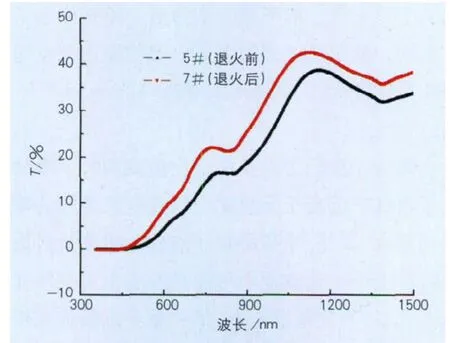
图7 样品退火前后的吸收谱
四 结语
本文将磁控溅射和热丝化学气相沉积结合,制备了超高浓度钛掺杂的非晶硅薄膜。俄歇电子能谱测试表明钛在薄膜中均匀分布,随着溅射功率从1.32W/cm2增加到2.04W/cm2,钛平均浓度近似线性地从2%增加到8%。透射反射谱测试表明,掺钛非晶硅薄膜在可见到红外区(600~1500nm)的光吸收明显增加。电导率温度特性测试表明,钛掺杂有效提高了非晶硅薄膜的电导率,但薄膜主要显现半导体导电特性,为Mott变程跳跃导电。脉冲激光熔融退火使薄膜晶化率达到50%以上。退火后,薄膜的透射率与未退火相比增加了约7%,但与未掺杂的硅薄膜相比,仍表现出增强的可见-红外吸收特性。
[1] Luque A, Mart’ A. Increasing the efficiency of ideal solar cells by photon induced transitions at intermediate levels[J]. Physical Review Letters, 1997, 78(26): 5014-5017.
[2] Luque A, Mart’ A, Stanley C. Understanding intermediate-band solar cells[J]. nature photonics, 2012, 6:146-152.
[3] Olea J, Toledano-Luque M, Pastor D, et al. High quality Tiimplanted Si layers above the Mott limit [J]. Journal of Applied Physics, 2010, 107(10):103524.
[4] Olea J, Gonz‡lez-D’az G, Pastor D, et al. Two-layer Hall effect model for intermediate band Ti-implanted silicon[J]. Journal of Applied Physics, 2011, 109(6): 063718.
[5] Wolf S A, Awschalom D D, Buhrman R A, et al. Spintronics: A spin-based electronics vision for the future[J]. Science, 2001, 294(5546):1488-4195.
[7] Ray P P, Chaudhuri Czechoslovak P. Study of radio frequency plasma of silane — Argon mixture by optical emission spectroscopy [J]. Czechoslovak Journal of Physics, 2000, 50(3):349-355.
[8] Zabrodskii A G. The coulomb gap: The view of an experimenter [J]. Philosophical Magazine Part B, 2001, 81(9):1131-1151.
[9] Shklovskii B L, Efros A L. Electronic properties of doped semiconductors[M]. Berlin: Springer-Verlag, 1984.
[10] Ray P P, Gupta N D, Chaudhuri P,et al. Properties of Si:H thin films deposited by rf-PECVD of silane-argon mixtures with variation of the plasma condition[J]. Journal of Non-Crystalline Solids, 2002, (299-302):123-127.
