多晶发射极结构三极管抗总剂量能力研究
2012-12-05郑若成顾爱军
郑若成,顾爱军
(无锡中微晶园电子有限公司,江苏 无锡 214035)
1 概述
多晶发射极三极管结构和传统三极管结构相比,具有很多优势,包括极大的放大倍数、更高的响应频率和更小的尺寸结构,这些优势使得该结构在亚微米和深亚微米BiCMOS工艺中完全取代传统三极管结构而被广泛采用。实际上,在和传统三极管结构比较中,我们比较容易忽略多晶发射极结构三极管的另外一个优势,那就是多晶发射极结构具有更强的抗总剂量辐照能力。
2 三极管总剂量机理分析
总剂量辐照效应是由于伽马射线入射到SiO2介质中,产生能量沉积,形成电子空穴对。由于电子在SiO2中迁移率大,容易逃逸,而空穴则容易被SiO2介质中的陷阱俘获,在SiO2中形成固定的正电荷或者在界面产生界面态。这种固定的正电荷或者界面态会造成硅衬底中杂质浓度的再分布或对载流子寿命产生影响,因此总剂量辐照会对器件性能产生影响。
氧化层越厚,因辐照产生的空穴就越多,被陷阱俘获的几率也越大。SiO2介质中固定正电荷分布除了和SiO2介质中的陷阱分布有关外,还和外加电场相关。因为在电场的作用下,正电荷会发生移动,当正的陷阱电荷移动到SiO2-Si界面边缘时,对器件性能影响最大。因此SiO2介质是总剂量辐照的敏感介质,并且辐照的影响程度和SiO2介质的厚度以及外加电场强烈相关。
对于MOS管器件,抗总剂量辐照加固就是针对氧化层介质的加固,包括场氧的加固和鸟嘴的加固,对于亚微米和深亚微米工艺,栅氧一般不需要加固;对三极管器件,抗总剂量加固也是针对氧化层介质加固,主要是基区上氧化层介质和EC之间的氧化层介质。基区上氧化层介质在总剂量辐照下会对基区产生影响,EC之间氧化层介质总剂量辐照可能会引起EC之间的漏电。图1是普通梳状VNPN管的结构。
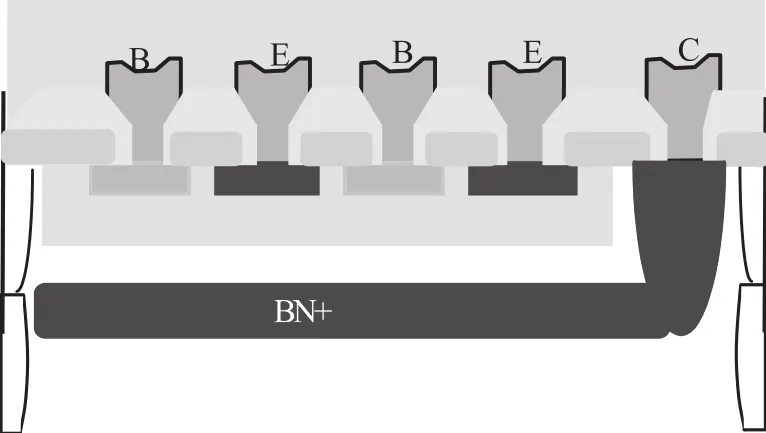
图1 普通梳状VNPN管剖面结构
从普通VNPN管结构可以看出,在EB极间的基区上存在场氧、PMD和钝化等SiO2介质,尽管PMD和钝化层氧化层的抗辐照能力要强,但是对器件辐照性能起主要影响的是场氧介质,厚度一般在500nm以上。该氧化层中的正陷阱电荷和界面态会对VNPN管的基区产生影响,包括产生较大的复合电流,降低少子寿命等,这些都会增加基区的复合电流,降低管子HFE。一个三极管中,这样的位置越多(如梳状结构),则抗辐照能力越弱。所以,梳状结构(或者周长面积比大)比单面积结构三极管的抗辐照能力差[1]。另外,在EC间的氧化层也会受到辐照的影响,该氧化层中的陷阱正电荷可能会造成基区反型,从而在EC之间形成N型通路,造成EC之间的漏电。
因此,对于传统NPN管,辐照引起的主要影响是降低NPN管HFE和造成EC之间的漏电,而HFE的降低是主要的,一般造成EC之间的漏电需要有足够的正陷阱电荷,需要较大的总剂量辐照才会出现。
从上面的讨论可以看出,增强三极管抗总剂量辐照能力需要对关键区域进行加固,这种加固包括工艺上的加固,如SiO2介质的改性或者更换其他抗辐照的介质;也可以是结构上的加固,如采用多晶发射极结构等,多晶发射极结构三极管如图2所示。
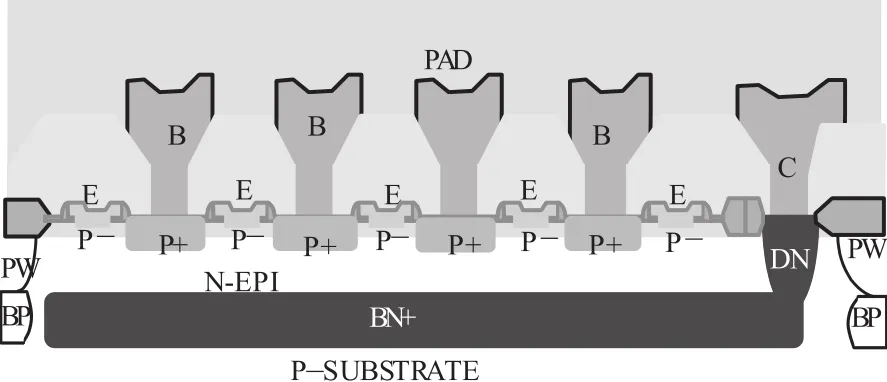
图2 梳状多晶发射极结构三极管剖面图
多晶发射极结构也是采用EB交叠方式,这样可以增大三极管的电流能力,但和传统三极管结构不同的是,传统三极管结构发射极是通过金属引出,而多晶发射极结构的发射极是通过多晶引出,然后再通过金属将多晶引出。
下面分析多晶发射极结构三极管的辐照瓶颈。和传统三极管结构类似,第一个瓶颈在EC之间的基区,如图3(a)所示(图中多晶边缘的SPACER应该和场氧交叠在一起,这里放大了它们之间的距离),该区域存在场氧化层,如果没有P+注入,则场氧化层中的正陷阱电荷可能会造成EC之间漏电。为解决该问题,可以适当拉大SPACER和场氧之间的距离。因为在该结构中,P+SD是自对准注入的,如果SPACER距离场氧有一定的距离,如图3(b),则该区域会被P+SD注入,更加不会出现EC之间的反型漏电问题。
由于P+SD是自对准注入,因此真正能对器件产生影响的氧化层区域只有SPACER宽度区域和多晶包底部氧化层的区域。由于多晶屏蔽的作用(接固定的低电位),多晶上的氧化层的辐照效应不会对底部的器件产生影响。
多晶包底部氧化层区域的氧化层很薄,电子和空穴都能逃逸,因此辐照不会在该氧化层中产生正陷阱电荷等辐照效应。因此,对于多晶发射极结构,真正能对器件辐照性能产生影响的只有SPACER区域,对于亚微米工艺,该区域的宽度不超过0.15μm,并且P+SD注入后会有横向扩散,因此对基区复合电流影响的区域就更小了。
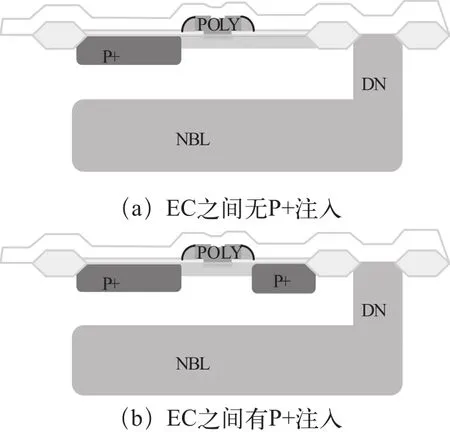
图3 多晶发射极结构辐照能力分析图
除了上面的分析外,对于多晶发射极三极管结构,还存在如图4的区域,该区域是多晶从有源区爬到场区。由于多晶的屏蔽,P+SD无法注入到有源区,因此不能通过P+SD注入来阻止EC之间的漏电,一种设计方法是拉长发射极EW窗口到场氧的距离,这样即使场氧由于辐照影响产生正陷阱电荷,但由于基区距离较长,不会造成整个基区的反型引起EC之间的漏电。
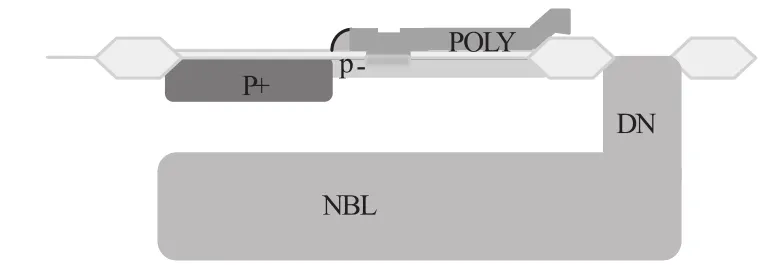
图4 多晶爬场区结构抗总剂量辐照分析图
3 多晶发射极三极管辐照结果和分析
对梳状多晶发射极结构进行了抗辐照实验,三极管发射极面积为3×16μm×0.5μm,为三指结构,每指长度为16μm,宽度0.5μm。主要考察辐照前后三极管的放大倍数和漏电流,辐照实验结果如图5所示。
辐照条件:辐照源Co60γ射线,辐照偏置:EB反偏2.5V。
从图5(a)可以看出,三极管VNPN管在总剂量150krad(Si)辐照下,HFE曲线无明显变化,当超过400krad(Si)时,HFE出现明显减小,但900krad(Si)相对于400krad(Si)剂量减小并不明显。HFE显著减小区域是在小注入下,如果设计有足够的容宽,或者选择大注入边缘工作区域(一般情况下都是在这种工作区域),则在900krad(Si)的总剂量辐照下,电路也能正常工作。

图5 多晶发射极三极管辐照结果
从图5(a)的HFE曲线看,辐照对器件的影响首先是小注入下的HFE,随着剂量增大,大注入下的HFE也会出现明显的降低,这和辐照引起的基区复合电流大小有关。当辐照引起的基区复合电流较小时,影响的是小注入的放大倍数,当辐照引起的基区复合电流较大时,大注入下的放大倍数也会出现明显的降低。从IC的具体数值看,IC电流几乎没有变化,说明从发射极注入的电流达到集电极没有受到辐照的影响,因此可以说辐照没有对基区体内复合产生影响。HFE的降低是由于基区表面复合电流IB的增加造成的,而不是集电极电流IC的减小造成的。
从图5(b)漏电曲线可以看到,辐照前后三极管的漏电也没有出现异常。
4 结论
相比普通三极管,多晶发射极结构三极管具有很强的抗总剂量辐照能力,这和该结构的特征相关。对多晶发射极结构总剂量辐照瓶颈结构进行适当的优化设计,可以使这种器件的抗总剂量辐照能力达到1Mrad(Si)以上。
[1] 郑玉展,陆妩,任迪远,等.不同发射极面积NPN晶体管高低剂量率辐射损伤特性[J].物理学报,2009, 58(8):55-76.
