苯并三唑对铜/磷酸体系电化学腐蚀抑制作用
2012-09-04翟文杰杨阳展王景贺闫茂振王金虎
翟文杰,杨阳展,王景贺,闫茂振,王金虎
(哈尔滨工业大学机电工程学院,150001哈尔滨)
由于Cu互连芯片化学机械抛光(CMP)中磨粒所导致的机械去除难以控制,以及下压力较大会引起表面划痕或芯片中低k介质层的机械损伤,开始研究无磨粒CMP技术以及电解抛光、电化学机械抛光(ECMP)[1]等.ECMP结合了无磨粒CMP和电解抛光的优势,工件阳极电势是ECMP过程中铜氧化成铜离子的直接驱动力,铜离子则与电解液中的络合物质反应形成易于机械去除的反应层.该反应层只需抛光垫以极低的压力接触即可摩擦去除(而不会造成表面损伤).因此,ECMP的去除量与工件上施加的阳极电势直接相关,并且要获得较好的表面质量需使阳极电势处于抛光区.另一方面,ECMP为减小铜表面轮廓低凹处的溶解去除速度,通常在抛光液中添加腐蚀抑制剂.抑制剂是ECMP电解液的关键成分,能显著影响材料去除速率、表面平整度和表面光洁度[1].许多学者采用电化学测试和表面分析技术针对抛光液中不同的氧化剂、络合剂和腐蚀抑制剂,研究铜材料去除的化学作用机理[2-4].
磷酸溶液是典型的铜电抛光液,而苯并三氮唑(BTA)广泛用作铜的腐蚀抑制剂[5-7].本文针对铜的磷酸基抛光液,应用电化学测试以及表面原子力显微镜(Atomic force microscope,AFM)测量技术,研究BTA添加剂对铜的腐蚀抑制作用和ECMP工艺参数的影响.
1 实验
1.1 试件及其静态电化学试验
铜片的静态电化学试验在自制的聚四氟乙烯电化学池(如图1(a))所示)中以三电极体系进行,即以铜试件为研究电极,Ag/AgCl电极为参比电极,铂丝为辅助电极,电位由CHI604B电化学分析仪控制.试件为T2拉制铜棒加工的直径12mm、厚2mm的铜片.为获得光整的初始表面,首先应用精密车床车削铜表面,然后用1μm的金刚石研磨膏在抛光布上抛光,结果如图1(b)所示,表面粗糙度的算术平均偏差值 (Ra)为10nm左右.

图1 电解池照片及铜试件初始表面形貌
试件用无水乙醇超声清洗并自然干燥后,分别在30%(质量分数)H3PO4和30%(质量分数)H3PO4+0.01 mol/L BTA中对铜进行不同静态阳极极化电势下的电化学腐蚀试验.为确定合适的阳极电势,先针对不同抛光电解质,应用线性扫描的方法,获得铜片的阳极极化曲线(扫描速率为0.005V/s).
试件静态腐蚀后的材料去除量RMR可根据腐蚀前后材料的去除质量m按下式计算:

式中:H为材料去除厚度,m;t为腐蚀时间,s;V为材料去除体积,m3;S为铜片横截面积,m2;m为材料去除质量,kg;ρ为铜的密度,8.9×103kg/m3;d为铜片直径,m.
腐蚀10min后的试件先进行AFM表面形貌观测,之后在无水酒精溶液中超声清洗10min并自然干燥后称重.试件的质量采用Sartorius CP225D型精密电子天平测量,其量程为220g,分辨率可达10-5g.
1.2 铜片AFM表面形貌分析
采用原子力显微镜Nanoscope IIIa(Digital Instruments),在标准接触模式下对静态电化学腐蚀后的铜片表面进行观测,扫描速率为2 Hz.AFM微悬臂梁材料为氮化硅(Si3N4),其弹簧常数k=0.06 N/m,长约 120 μm,针尖为金字塔形.使用Digital Nanoscope软件控制显微镜并记录数据,可生成二维或三维图像,获得表面粗糙度参数.
2 结果与讨论
2.1 铜在H3PO4中的线性扫描伏安(LSV)曲线
铜在30%H3PO4中的LSV曲线如图2所示.所有曲线都表现出典型的阳极极化曲线的特点,由活化区、过渡区、钝化区和过钝化区组成,但电流的水平有很大差别.加入BTA后在0~1 V段电流较小,BTA对铜的腐蚀抑制作用明显.

图2 铜在30%H3PO4中含与不含BTA的极化曲线
2.2 铜的静态腐蚀
根据图2选用外加极化电位范围0~0.7V进行铜的静态腐蚀试验.30%H3PO4中铜在不同极化电势下静态腐蚀10min的I-t曲线如图3(a)所示.在开始时电流快速降低,然后逐渐趋于稳定;稳定电流都在几十毫安,铜溶解率很大;电流随阳极极化电势增加而增大,说明铜溶解率也随之增大.在加入0.01mol/L BTA的H3PO4介质中的铜在不同阳极电势下的I-t曲线如图3(b)所示,除0.7V时腐蚀电流较大外,其他电势下的腐蚀电流比不加BTA的小一个量级以上,说明BTA对铜的腐蚀有明显的抑制作用.

图3 铜在含与不含BTA的30%H3PO4中不同电压下的I-t曲线
图4给出了铜在加入0.01mol/LBTA和不加BTA的30%H3PO4中的静态腐蚀去除量对比.不加入BTA的溶液中静态腐蚀去除量明显大于加入BTA的,并且腐蚀量随电势增加而增大.在0.5V以下电压时的含BTA的静态腐蚀去除量小于100nm/min.

图4 铜在不同阳极电势下的静态腐蚀去除量
2.3 腐蚀铜片的AFM测量
图5(a)~(e)为铜在30%H3PO4+0.01 mol/L BTA中不同阳极电势静态处理10 min后的表面AFM图像.由图5(a)和未处理表面相比(图1(b))可见,不加电时铜静置10 min后的表面划痕清晰且略有加深,粗糙度为 Ra14 nm.施加0.2 V阳极电势后的表面(图5(b))机械划痕基本消失,粗糙度为Ra32 nm.此时铜的溶解速率较慢,BTA分子在表面局部被Cu离子吸附,形成节状Cu-BTA斑岛.
图5(c)为0.3 V阳极电势处理后的表面.阳极电势增大致使表面凸峰局部对BTA分子的吸附能力增强,形成环岛状Cu-BTA连接,表面粗糙度增大至Ra76 nm.静态施加0.5 V阳极电势处理后的铜表面,则形成了较为完整均一的Cu-BTA覆盖膜(图5(d)),其表面粗糙度为Ra69 nm.
更大的阳极电势(0.7V)处理后的表面如图5(e)所示,表面膜不再完整,表面粗糙度增大至Ra82 nm.说明在0.7V下局部的Cu-BTA膜不能形成或者形成后分解脱落,致使该区域的铜溶解速度加快(参见图3(b)),即在较高阳极电势下BTA对铜的腐蚀抑制效果不佳,铜表面的质量(粗糙度和平整性)很难控制.
从图5(a)~(e)可以看出,0.5 V阳极电势下铜表面能够形成较好的Cu-BTA覆盖膜,对铜基体起到抑制其进一步腐蚀的作用.为了说明该表面Cu-BTA膜的形成过程,图6给出了对铜在30%H3PO4+0.01mol/LBTA介质中施加0.5V阳极电势1min后及5min后的表面AFM图像.可以看出,施加0.5 V阳极电势1min时铜表面处于腐蚀溶解阶段,表面粗糙度较大(Ra96nm);随着溶解的进行,BTA分子和表面Cu离子形成吸附膜,5min时形成的膜层还较薄,局部有团絮状聚集,表面粗糙度已有较大降低(Ra70nm);对比图5(d)可以看出,此后Cu-BTA膜随着时间逐渐增厚形成多层膜,抑制铜的进一步溶解,表面粗糙度收敛于70nm左右.
作为对比,图7给出了铜在不含BTA的30%H3PO4中0.5 V电势静态腐蚀10min后的表面AFM图像,可见表面腐蚀形成了很深的沟壑,其表面粗糙度为Ra152nm,比含BTA时的显著增大,这表明了BTA的腐蚀抑制和平整化作用.
2.4 CuBTA膜静态吸附和动态去除机理
BTA是一种含有苯环和三唑环的有机化合物,可以和铜离子形成不溶性Cu(Ⅰ)BTA膜来阻隔铜离子的扩散,从而抑制铜的阳极溶解速度.
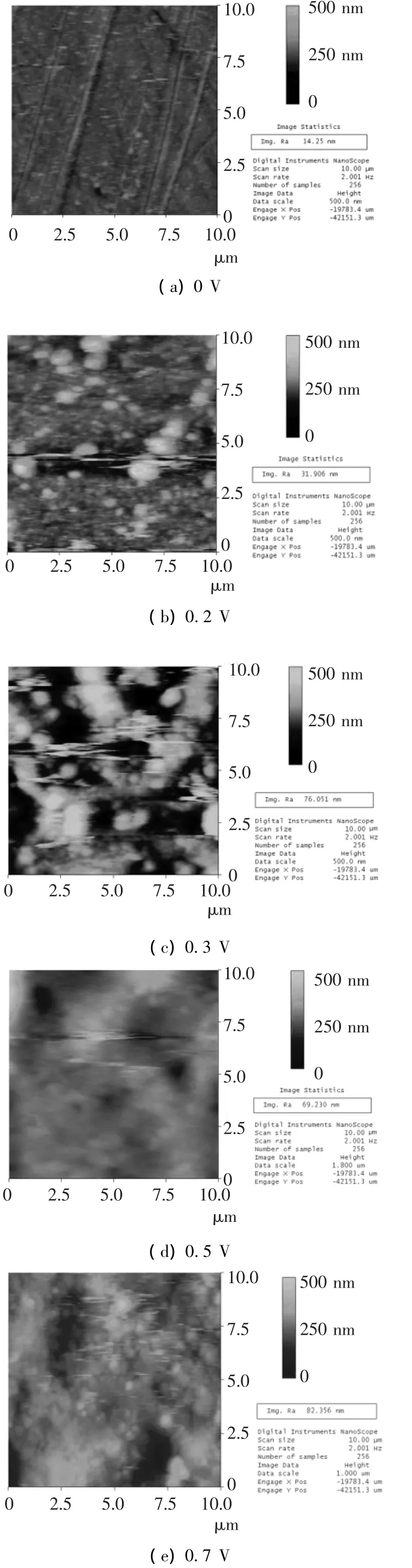
图5 铜在30%H3PO4+0.01 mol/L BTA中不同阳极电势静态腐蚀后的表面

图6 30%H3PO4+0.01 mol/L BTA中铜在0.5 V静态腐蚀不同时间后的表面

图7 30%H3PO4中铜0.5V静态腐蚀10min后的表面
图8为含0.01mol/LBTA水基溶液铜的电势-pH图[8],可以看出,阳极电势在0.5V以上时,铜在含BTA的酸性溶液中难以形成Cu(Ⅰ)BTA膜,表面将发生持续的阳极溶解生成Cu2+.0.5V以下阳极电势条件下,随着铜的溶解,铜离子可与BTA结合形成Cu(Ⅰ)BTA膜,铜的腐蚀抑制效果与该层膜的覆盖率及厚度有关.
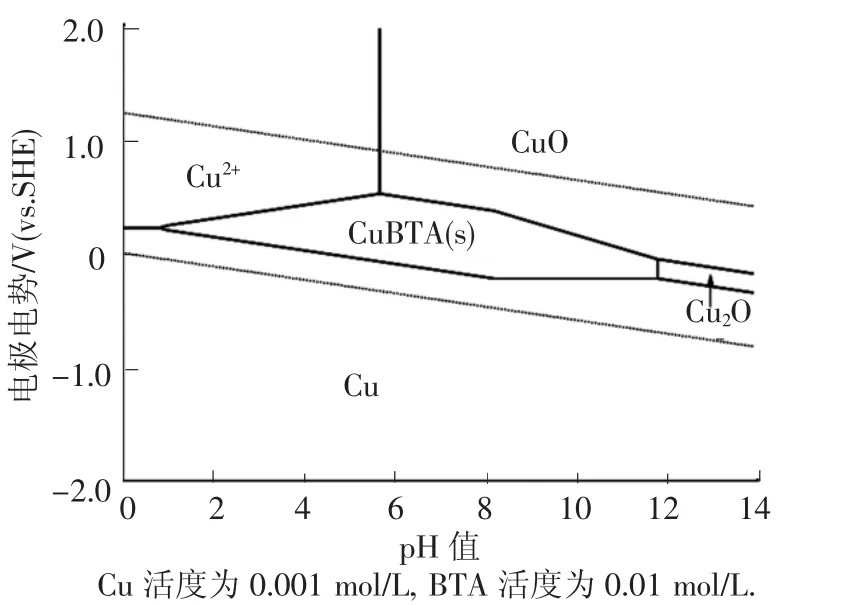
图8 水基溶液中铜的电势-pH图[8]
0.5V阳极电势下,铜溶解(1 min)后表面粗糙度加大(图6(a)),溶解的铜离子先和BTA形成节状的不溶颗粒覆盖在铜的表面;铜离子浓度增大到一定程度后,吸附更多BTA分子在表面逐渐形成Cu(Ⅰ)BTA单覆盖层,表面粗糙度稳定于一较低值(图6(b)).之后Cu(Ⅰ)BTA单覆盖层可由进一步的物理吸附形成较厚的多层Cu-BTA膜,而表面粗糙度基本不再改变(图5(d)).表明本实验条件下铜从溶解到成膜需要1 min以上的时间,稳定的CuBTA多层膜是铜的溶解和BTA分子再吸附进一步对其抑制达到平衡的结果.
为表明铜表面Cu-BTA覆盖膜的存在,对0.5V电压下铜试件溶液中静态腐蚀1 h后的表面进行XPS能谱分析[9],结果见图9.可以看出,在表面 XPS 谱中主要检测到了Cls、P2p、O1s、Cu2p、N1s 5种元素,各元素质量分数分别为C31.5%、O52.23%、P8.89%、Cu3.36%和N4.02%.其中,Cls的特征峰很强,主要来源于BTA及其他表面吸附物;O1s峰来源于表面膜中的Cu2O等氧化物以及络合剂;而N1s则是Cu-BTA膜形成的主要标志,N1s的分峰结果表明表面钝化膜中存在Cu-BTA,其结合能比BTA中的略大;Cu2p特征峰也具有明显的Cu-BTA的特征,而且峰的强度较大,这说明电化学作用过程产生的亚铜离子与BTA结合构成了钝化层的主要成分.

图9 铜静腐蚀表面主要元素XPS谱图
据此,认为苯并三氮唑类有机物在金属铜表面上的成膜机理主要分两个过程进行:第一步为快速吸附过程,苯并三氮唑类有机物分子直接吸附在金属铜原子的表面上,反应过程可表示为

另一步为少量的一价铜离子(Cu+)和溶液中的苯并三氮唑类有机物分子形成配合物的过程,即

无论是直接吸附还是形成配合物,都是苯并三氮唑类有机物分子中的离域π电子迅速进入金属铜离子或离子中的d空轨道,所以,配位作用是第一步的主要驱动力.当苯并三氮唑类有机物分子(BTA)在金属铜表面上达到饱和吸附之后,为了达到能量和结构上的最优化,吸附在金属铜表面上的苯并三氮唑类有机物分子还进行慢速结构重排过程.这一过程中,苯并三氮唑类有机物分子之间的π-π芳香作用为形成致密有序而又稳定的钝化膜起了关键的作用.
为进一步验证该结论并指导ECMP工艺,进行了图10所示的CuBTA膜刻划和恢复实验(模拟ECMP[10]),机械刻划由聚氨酯抛光垫在10 kPa压力下完成.可以看出,动态刻划时,电流急速增大,说明铜表面静态腐蚀形成的CuBTA膜被迅速去除,这也反映出CuBTA膜的机械性能很差.动态刻划过程中,电流维持在高值,说明刮擦过程中CuBTA膜不能形成.刻划停止后的十几秒,电流快速降低,之后逐渐减小,说明CuBTA膜正逐渐生成;近2 min后电流趋向平稳,说明在铜表面上形成了稳定的CuBTA膜.

图10 0.5V下CuBTA膜去除和恢复过程电流曲线[10]
3 结论
1)H3PO4介质中加入BTA后,铜的腐蚀率明显降低,这是因铜溶解的离子和BTA形成的吸附膜(CuBTA膜)具有较好的腐蚀抑制作用.
2)形成稳定的CuBTA膜需要近2 min.为保证CuBTA膜的形成,铜片所加的静态阳极电势应在0.5 V以下.
3)形成的CuBTA膜容易被抛光垫的机械摩擦作用去除,为保证铜表面的加工平坦性,须保证抛光垫的表面平整性及其运动精度和稳定性.
[1]SUNI I I,DU Bing.Cu Planarization for ULSI processing by electrochemical methods:a review[J].IEEE Transactions on Semiconductor Manufacturing,2005,18(3):341-345.
[2]TSAI T H,WU Y F,YEN S C.A study of copper chemical mechanical polishing in urea-hydrogen peroxide slurry by electrochemical impedance spectroscopy[J].Applied Surface Science,2003,214:120 -135.
[3]DU Tianbao,LUO Ying,DESAI V.The combinatorial effect of complexing agent and inhibitor on chemical-mechanical planarization of copper[J].Microelectronic Engineering,2004,71:90 -97.
[4]EIN-ELI Y,ABELEV E,STAROSVETSKY D.Electrochemical aspects of copper chemical mechanical planarization(CMP)in peroxide based slurries containing BTA and glycine[J].Electrochimica Acta,2004,49:1499-1503.
[5]CARTER M K,SMALL R.Electrochemical measurements of passivation bilayers on copper in a CMP system[J].Journal of the Eletrochemical Society,2004,151(10):B563-B571.
[6]PADHI D,YAHALOM J,GANDIKOTA S,et al.Planarization o copper thin films by electropolishing in phosphoric acid for ULSI applications[J].Journal of the Eletrochemical Society,2003,150(1):G10-G14.
[7]GILS S V,PEN C,HUBIN A,et al.Electropolishing of copper:in Ex situ and in situ optical characterization[J].Journal of the Eletrochemical Society,2007,154(3):C175-C180.
[8]MUTHKUMARAN A K.Chemical systems for electrochemical mechanical planarization of copper and tantalum films[D].Arizona:The University of Arizona,2008:142.
[9]闫茂振.缓蚀剂对铜摩擦电化学性能影响的研究[D].哈尔滨:哈尔滨工业大学机电学院,2011.
[10]杨阳展.铜的电化学机械平整工艺优化及机理研究[D].哈尔滨:哈尔滨工业大学机电学院,2010.
