HDI多层板走过二十年(1)——对二十年来HDI多层板及其基板材料技术创新的评析
2011-07-30祝大同
祝大同
(中国电子材料行业协会经济技术管理部,北京 100028)
若以SLC成果发表时间作为HDI多层板发展的起始点,那么到今年为止世界HDI多层已经走过了整整二十年的发展历程。HDI多层板的出现及发展,不仅给世界PCB技术带来了革命性的变化,也推动了PCB及其基板材料技术创新的巨大进步。在纪念它之过了二十周年历程之际,笔者撰写此文对HDI多层板及其基板材料的发展过程、特点、创新规律、发展趋势等作以回顾与探讨。
1 二十年前HDI多层板技术的创立与启示
1991年,以日本人塚田裕属名的、以“表层加层电路板(Surface Laminar Circuit ,SLC)”为内容的研究论文,在日本《表面安装技术》(1991年第一期)和《电子材料》(1991年第四期)发表。[1][2]这是在日本首次发表的积层法多层板(此后世界PCB业界将这类PCB称为HDI多层板)的技术成果,它揭开了日本乃至全世界的积层法制造技术一个崭新篇章。塚田裕创造出的SLC,对世界印制电路板具有划时代性意义。在现今许多编撰世界PCB发展历程的文献中,一般将SLC成果发表的1991年,称为HDI多层板发展的元年。
SLC技术创新的核心,是创造了一种新型的多层板薄型绝缘层及由它构成PCB的微孔制作法。正是由于作为日本IBM公司(IBM野洲工厂)课题负责人的塚田裕先生在SLC和倒芯片贴装(FCA)的技术开发上有突出的贡献,在1996年5月,他荣获美国IBM集团授予的“IBM研究员”的技术职衔。在整个IBM集团发展史上,获得IBM内最高级技术职衔者共有143名(至1996年止)。几十年来,在整个亚太地区的IBM公司中获此殊荣者唯有塚田裕先生一人[3]。
在SLC成果确立之前,世界半导体业与PCB业已出现了类似SLC工艺的先期技术探索的成果[4]。例如1967年,Beadles.R.L(美)提出了“Integrated Silicon Device Technology ”的发明文献。他提出了在绝缘树脂层上逐次、交替地叠加成导体层(铜电镀层)的多层板制造工艺。为采用积层法工艺生产多层板的一个雏型;1984年,NTT公司提出的含有薄膜电路的Copper Polyimide工艺法,其绝缘层就是由感光性树脂所构成、导通孔是通过对感光树脂的曝光、显影加工而获得;在20世纪80年代,在世界半导体业的厚膜电路制造技术上,创新出以导电膏与绝缘树脂涂层为原材料,通过丝网印刷交替制作、重叠积层导电层和绝缘层的工艺法;1984年,Finstrate最早尝试在多层板上采用了盲孔结构加工,即在聚四氟乙烯树脂基材上采用CO2激光机进行微孔加工而成盲孔等。上述所列的研究成果,尽管大多数成果并未转化为工业化大生产,但都给塚田裕等的SLC发明打下了基础,创造了条件。
一个换代的新产品开发思想的确立,首先需要准确地确定它的研试方向问题。这关系到所要开发新产品,它的生命力和真正的经济价值。塚田裕等最初在确立此课题的开发方向时,打破一般技术人员的思维方法,首先潜心研究要开发的PCB未来应用领域的变化。这种研究方法,塚田裕在SLC问世数年后曾在一篇他总结此发明的文章[5]中,称其为“准模块(组)”(Quasi Module,简称QM)概念的建立。他在开发前所建立的QM概念,至今都对于一个搞PCB、电子安装的工程技术人员来讲是难得可贵的。二十多年过后的今天,我们再“回放”一下塚田裕在上世纪80年代中期在实际开发SLC之前所建立的QM概念,可以加深对他的创造思维有更深。当时,他的QM概念主要内容是:(1)预测今后的个人电脑,“担当功能的半导体元器件,应不需要再次安装”(即将一二级的两次电子安装,合为一次完成的倒装裸芯片的安装——笔者注)。(2)“电脑的总共有1 cm左右厚度(当时绘的构想图见图1)”(在2011年问世的“苹果iPad二代”的平板电脑达到了0.8 mm厚。这对于处在当时笔记本电脑还未完全市场化背景下的塚田裕来讲,能预测出与现今如此正所接近于这样的厚度,真为他的预测准确所惊叹——笔者注)。(3)“承载元器件的PCB,应像纸一样的薄”(这种大胆的想象,现在前沿的PCB技术已经成为现实——笔者注)。(4)半导体及组件是采用多个裸芯片贴装在基板上(预测出了当时还未完全开发成功的“倒芯片安装技术” ——笔者注)。(5)多个裸芯片的“点状”相接(约十年后,这种构想已在日本出现的MCM、BGA、CSP、COF等技术成果中得到实现——笔者注)。由以上基本内容构成的QM概念,使得塚田裕等课题组人员更加丰富了其创造思维,更加明确其开发的方向。他们更坚定的认识到:未来笔记本电脑向“薄、轻、小”方向发展,对PCB的布线密度提出更高的要求。而沿用传统的FR-4半固化片材料及内芯板,制造多层板的技术途径,已是无法实现。

图1 二十几年前塚田裕预测的未来笔记本电脑情况
打破传统的思维,利用已经获得应用的材料,将其原有功能进行“转移”,恰倒好处的另图其它所用——这是创新的一种手法。塚田裕等在研发SLC技术中,借鉴前人的有关此方面的探索经验,巧妙的运用了此种方法。塚田裕及其课题组人员在考虑到新型PCB制造成本降低和实现布线密度的大幅度提高的前提下,大胆构想出用无玻纤布增强的环氧树脂去充当多层板的绝缘“纯”树脂层。这种树脂是原用做PCB阻焊层的、Giba-G e i g y公司生产的、牌号为プロビマ-52”感光性树脂(牌号为プロビマ-52)。所构成的这种“纯”树脂层厚度可减薄到40μm。在层间通孔加工方面,他们创新出用感光性树脂(来自半导体的树脂光致蚀孔加工的启发),去实现多层板绝缘层间贯通的微细孔的加工。使通孔直径可减小到100μm ~ 150μm(此成果问世几年后,SLC孔径制作的工程能力可达90μm)。电路层的通孔连接,不全部采用全通孔,而是创造了层间通孔的结构。从而在这种多层板制造中,采用了逐层积层的方式。这种设计创新,对在SLC问世之后出现各类积层法多层板的导通孔结构创造,起到了开拓新思路的重要作用,从而大大减少了原全通孔在多层板层间所占居过多的空间,以此提高了布线密度。导电层制造及各类层间通孔互连,他们采用了在绝缘层上镀铜的形成方法,其镀层最薄达到了10μm,为微细线路的制作创造了有利的条件。通过几年的努力,他们先后攻克了剥离强度、通孔可靠性和耐金属离子迁移性三大难题,取得此课题研发的成功。这一整套的对新型PCB结构、工艺的创造,打破了自1964年美国IBM在“360系列”计算机中首创采用FR-4基板材料的四层多层板以来,二十几年的传统多层板的技术束缚。
在SLC研发成果初见成效的数年后,塚田裕曾发表一篇带有对此发明成果“经验总结”内容的论文。[6]其中提及他们在开发SLC产品之前,曾对它今后在应用的“定位”上,确定了两个“立足”。其一,立足于“在世界上任何地方,都可以生产”(塚田裕语)。此意是指:该产品技术应在使用原材料、加工设备上,已具备其有普遍性。所用的原材料,在市场上可以购到,一般多层板加工用的设备也可以制作SLC。以后的试验中,塚田裕等人始终坚持遵循这一“立足”原则。例如:在绝缘材料选择上,所确定用的环氧树脂,不但成本低(低于聚酰亚胺树脂材料数倍)、可靠性好,而且在市场中易于获得。其二,在SLC上“可进行任何形式的安装”(塚田裕语)。这是由于在SLC开发期间,日本正处于表面安装技术向裸芯片安装技术的转变过程中,为了使SLC技术能保持旺盛的生命力,追求其高附加值,他们确定应使它溶入新一代的安装技术之中。
两个“立足”,是塚田裕等人创新发明S L C新工艺技术,特别是发明的新型PCB基板材料,之所以成功的关键。遵循两个“立足”的指导思想,找到了发明的从创新思想建立到创新成果产生的一条“捷径”。
SLC问世对HDI多层板各种结构形式、工艺路线的创新具有十分强烈的驱动性。这里摘录一些20世纪90年代初、中期日本PCB业人士对SLC发明的评价就可见一斑:[7]“近年,日本IBM的SLC工艺技术的成功,使它再一次令人瞩目。SLC技术,是采用液态感光性树脂材料制成绝缘层。由于各方面工艺控制得很严密,从而成功地达到实用化。对这一伟绩,应给予高度的评价”(日立化成的PCB制造专家山寺隆语)。“在众多积层法的开发报告中,最为闪烁者应属日本IBM在1991年发表的那篇。在这一成果发表之后,PCB的微细图形、间距的制造工艺更加被看重。从而许多企业也着手于对积层法多层板进行研究、开发。因此可以这样讲: SLC的出现,具有划时代的意义”(原从业于富士通P C B事业部的著名专家高木清语)。“伴随着表面安装技术的发展新型的印制电路基板被一一不断地开发出来。这里,典型的代表例是积层法多层板。日本IBM公司的SLC是此类PCB技术开发的先导。在此之后,各公司才在此方面加速了开发的竞争”(富士通研究所的资深专家桥本薰语)。
90年代初、中期,世界HDI多层板的主要策源地为日本。就是在SLC技术出现的带动、启发下,HDI多层板各种工艺法的创新像雨后春笋似地迅速在日本兴起,并还开始很快地蔓延到欧美、韩国、台湾等地区。正如在90年代末,东芝化学公司的青木正光所言:“自日本IBM的野洲派开始带头,于是又涌现出了大仓山派、大垣派、小向派、门真派、群马派、长野派、富山派、下馆派(以上均以日本一些大型PCB生产厂所在地址为代名,所指各技术流派——笔者注)等各种各样积层法多层板制造技术”。
SLC发明的二十年后今天,尽管这种SCL法制造HDI多层板由于它的某些工艺局限性所在而在目前世界PCB中已只在极少企业继续采用,但它当时顺应了PCB市场需求,开创了一类全新的PCB工艺法——积层法,起到了打开HDI多层板工艺技术创造思想潮流之闸门的重要作用。
2 对HDI多层板技术精髓的分析与探讨
2.1 HDI多层板定义及技术特点
高密度互连(High Density Interconnecting,HDI)是指在常规PCB(如双面板或四层板等作为芯板)的一面或双面上,利用重叠方式交替地积层上绝缘介质层和导电层等而形成更高密度的印制板(这是在PCB业界中目前最权威的对HDI板的解释,但是近年来由于全层HDI多层板的出现,这一解释又不确切——笔者注)。HDI多层板的导通上下导线层电路的微细导通孔(或者导电胶等形式)的分布密度,远远高于传统多层板,所以它能有效地提高了印制板的导线密度和组装密度。
如何给HDI多层板下更确切的定义?
一位国内著名PCB专家对HDI多层板曾做过这样的描述:[8]“美国IPC协会对HDl的定义是:非机械钻孔;孔径≤0.15 mm;多为盲孔,孔环径≤0.25 mm;微孔或微导通孔;接点密度≥130点/in2。布线密度为117 in/in2(1 in=2.54 mm,相当于:46 cm/cm2);线宽/间距≤0.075 mm。日本命名这类印制板为“Build up PWB”,译为积层印制线路板。HDI和Build up(高密度互连和积层)在PCB行业里所表达的含义相同(引自梁志立语)。”
另一位国内著名PCB专家对HDI多层板的基本特征归纳为以下几点:[8]“综合有关资料,积层多层板为(1)微孔(包括盲孔、埋孔)的孔径≤φ0.l mm;孔环直径≤φ0.25 mm。(2)微孔的孔密度≥93孔/cm2(600孔/in2)。(3)接点(Connection)密度≥20点/cm2(130点/in2)。(4)导线宽/间距≤75μm。(5)布线密度[布线通道(Channel)宽1.27 mm]超过46 cm/cm2(117 in/in2)。(6)介质厚度 <0.l mm。(7)非机械钻孔(引自李乙翘语)。”
“微孔、薄层、细线”是HDI多层板在产品结构上区别于传统多层板的三大特点。走过二十年发展历程的HDI多层板,总是主要围绕着这三大特点不断将其自身制造技术向更深层次的延伸,不断地提升这三大特点的更高水平。在这三大特点中,“微孔”是HDI多层板的技术发展轴心与灵魂。正因如此,又将HDI多层板称作为“微孔板”(此称谓起源于台湾,现在台湾PCB中广为使用)。一般机械钻孔是无法实现HDI多层板的微孔加工,因此自HDI多层板诞生起,也伴随着出现了“非机械钻孔”(注意,上文引用的两位专家对HDI多层板下的定义中,都提及到“非机械钻孔”)——即激光钻孔等的微孔加工新方式。
在国内一位PCB布局设计工程师近期发表的文献[9]中,对携带型电子产品所用HDI多层板技术实践与进展进行了讨论。在积累多年的PCB布局设计经验的基础上,他诠释了“微孔”是HDI多层板结构的“核心”这一特点。他讲:“当我们了解了激光钻孔特点的同时,也就了解了HDI技术的特点,进而也知道了HDI技术的优势所在。激光钻孔的PCB主要有三个特点:(1)HDI技术可以使PCB的面积变得更小。因为钻孔Pad直径的缩小,钻孔所占面积只相当于原来的四分之一,节约了大量表面空间用于布局布线。(2)HDI技术可以使PCB 变得更薄。因为激光钻孔只在相邻层间做互联,不妨碍内在讯号层的布线,节约了内在讯号层的空间,从而大大提高了内在讯号层的布线密度。台湾工研院的统计数据是利用率提高了30%。这使得减少多层板的层数成为一种可能,PCB板也可以做得更薄。(3)因为HDI 技术中的激光钻孔只是导通相邻的两层,所以这些钻孔不会破坏多层板内在电源层的完整性,也不会破坏内在地层的完整性。再配合HDI 介质层薄的特点,在高速信号处理越来越普遍的今天,对PI(电源完整性)和SI(信号完整性)都有很大的帮助(引自沈浩语)。”
2.2 HDI多层板在整个PCB技术发展进程中的地位分析
在半个多世纪的PCB发展过程中,HDI多层板处于什么地位?扮演一个什么样的角色?
日本电子信息技术产业协会(JEITA)于2009年编制的《电子安装路线图》中,将PCB技术从20世纪50年代中期到21世纪30年代末期间的发展划分为七代[10]。其中第四代是HDI多层板(见图2)。在它的之前是传统的多层板(第三代),在它的之后是埋置元器件PCB(第五代)及系统内埋式PCB(第六代)。

图2 PCB发展中的七代技术
PCB发展中第三代是以表面全层贯通孔为特点的常规多层PCB。作为PCB发展中第四代的HDI多层板技术,是在第三代PCB制造技术的继承与发展。它还保留着含有内芯板(在HDI发展的初、中期)、孔的电镀贯通(大部分HDI多层板工艺法采取)、图形显影-曝光-蚀刻形成工艺等了原有第三代PCB(常规多层PCB)的一些技术。另一方面它的下一代PCB(第五代的埋嵌元器件多层板)也是在HDI多层板技术上发展起来的,离不开它的主要技术的支撑。例如,作为第五代的埋嵌元器件多层板,它采用了HDI多层板的激光钻孔技术与电镀填充孔技术在所形成微孔上,实现与埋嵌的元器件电极凸块的连接。第四代HDI多层板与第五代、第六代的埋嵌元器件PCB和系统埋嵌PCB,它们都是为达到一个目标而推动其技术发展的。这个一致的目标就是在PCB上(或者PCB整个体)实现元器件的高密度安装。从这一点也可看出:HDI多层板与未来的第五、六代PCB,在技术上将是相辅相成、交叉并进、继承发展的。
由于HDI多层板无论是在市场上,还是在技术上未来还会有很大的发展空间,因此它占居PCB产品形式的主流地位的时间将会很长。全球著名PCB市场分析机构Prismark公司曾对世界HDI多层板销售额的统计、预测:2000年世界HDI多层板的销售额为54亿美元(因封装基板几乎全部都采用HDI板工艺,此数据引用含封装基板数据下同),占当年世界整个PCB总产值的13.7%。到2010年世界HDI多层板的这比例增加到28.4%,销售额达到144.8亿美元;预测到2015年,HDI多层板的销售额还将增加到217.0亿美元,占整个PCB总销售的28.4%。HDI多层板的世界销售额在未来几年中所占比例的不断增加,充分说明它的发展前景仍是一片光明。
2.3 HDI多层板在各发展阶段中的技术演变
HDI多层板的主要工艺路线,在二十年发展中不断发生演变。可以把HDI多层板技术发展划分三个阶段:
(1)初期阶段(90年代初期至90年代末)
在这个初期阶段主要有三大技术支流:①感光性树脂形成绝缘层、感光制孔形成微孔的HDI多层板制造工艺法(以SLC为典型代表);②非感光、热固性树脂形成绝缘层、通过激光、等离子体、机械钻孔等方法形成微孔的HDI多层板制造工艺法(以热固性树脂涂布法形成绝缘层、附树脂铜箔即RCC法等为典型代表);③在激光钻孔加工的微孔中,填入(或者印刷上)导电胶(或导电膏),而形成电气互连的方式。它以松下电子公司的任意层内导通孔(ALIVH)和东芝公司的埋嵌凸块互连技术(B2it)工艺法等为典型代表 。
(2)成熟期阶段(2000年至2009年)
自2000年左右起,进入到了HDI多层板技术发展的“成熟期阶段”。在此阶段,尽管它的工艺法的流派有许多种,但从市场占有的份额统计,其市场占有率名列前三的有:① 激光加工形成微孔的有玻纤布补强作树脂绝缘层的HDI多层板制造工艺法(即“LDP法”——激光直接图形法);②RCC法(涂树脂铜箔法);③ ALIVH法(任意层内导通孔)。
随着HDI多层板的“微孔、细线、薄层”三大特点更加深层化,一些不再适合这一发展的工艺法生产的HDI多层板被逐渐退出(或为挤出)这个PCB的市场,而上述成熟期阶段的三类工艺法的HDI多层板,在工艺技术上有了很大的进步、改进:
LDP法在基板材料性能及激光加工设备技术上有了很大的进步(此方面内容在本文下部分将有所详述)。
RCC法由它在初期阶段的绝缘层由“纯”树脂组成,转变为在成熟期阶段的以有填料型的树脂层形式做为RCC工艺法的主流。“纯”树脂构成绝缘层的RCC具有介电常数低(相对环氧-玻纤布基基板材料)为特点之一,但演变成有填料树脂层RCC,就丧失了其特性。而它的树脂膜厚精度、机械强度都抑制了RCC继续向更加绝缘层薄形化的发展。
ALIVH法在这近二十年间发生两大方面的重要转变:即其一,它的工艺主流路线,由芳酰胺纤维无纺布做增强材料型ALIVH 多层板逐渐演变为以环氧-玻纤布做增强材料型ALIVH多层板;由有内芯层ALIVH 多层板逐渐演变为全层(无内芯层)ALIVH多层板。这两大转变,不仅使得它在HDI多层板发展的成熟期阶段仍然“站得住脚”,并且现在在日本、中国台湾、韩国等PCB工厂中采用此工艺法还大量生产高阶的HDI多层板产品。ALIVH工艺法的HDI多层板,大多数用于移动电话用PCB(主要板)。
(3)全层HDI多层板阶段(自2010年起)
自2010年起,以“薄、轻、小型”为鲜明特点的智能手机及平板电脑为典型代表的携带型电子产品的问世及迅速发展,促进了全层(Anylayer)HDI多层板制造技术有很大的提高,并且在智能手机及平板电脑的PCB中开始得到了广泛的使用。这也使HDI多层板进入了新的发展阶段。
图3所示了全层HDI多层板的性能特点,及与带内芯层HDI多层板在结构上的对比。其中图中右侧的所示全层HDI多层板(即全层积层法多层板)的资料,是日本PCB厂家于2010年最新公布的。
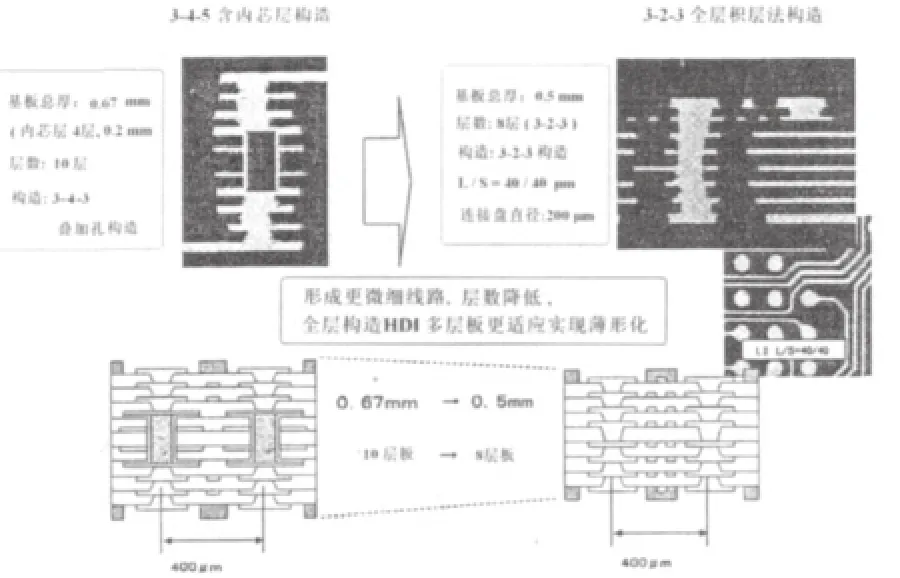
图3 全层HDI多层板的性能特点及结构对比
尽管目前全层HDI多层板占整个HDI多层板市场比例还不如有内芯层HDI多层板大,但无论是从技术飞跃角度看,还是从迅速普及、替代传统HDI多层板的趋势角度看,都可把它看作HDI多层板迈入一个发展新阶段的重要标志。
2.4 从HDI多层板主流工艺法演变所得到的启示
国内一位从事多年HDI多层板技术、生产研究的著名PCB专家,曾对各种HDI多层板工艺技术法的地位变化,做过这样的分析[11]:“在积层技术发展初期,由于生产时间不长,各种工艺方法的优劣尚未表现。当时约有十几不同的工艺方法,各种方法材料及设备差异巨大,业界无所适从。经过多年的竞争,目前激光钻孔成为最主流的成孔技术。积层材料中,两大主角仍是RCC及LDP,其中LDP由于具有制造成本低,尺寸稳定性好,刚度强,易于制作盲孔等优势,从2006年以来,LDP市场占有率已经超过RCC,这种工艺法成为HDI多层板中使用最多一类…… 总之,在HDI多层板工艺技术发展方面,它的总趋势是更小、更薄、密度更高(引自黄同东语)。”
LDP法在HDI多层板发展的“初期阶段”几乎没有任何的HDI多层板市场占有率,直到2000年它的只有4%的HDI多层板市场份额(据Prismark公司的市场调查数据),但在2005年时它的市场占有率增至41%,几乎与RCC法并驾齐驱。到2008年LDP法已明显地成为HDI多层板的主流工艺路线,到2010年它的市场占有率已达到了76%。未来多年LDP法HDI多层板在市场上竞争的主要不同工艺法多层板的“对手”将是挑战传统的电镀通孔工艺方式的、采用导电胶形成电气互连的方式——ALIVH工艺法HDI多层板。
表1所示了在2000年~2015年间各类工艺法的HDI多层板市场占有率变化(表1中的数据主要参考了Prismark公司提供的2000年~2005年统计数据[12],其它年份数据是由笔者估计、推测的)。
表1中所显示出的LDP法HDI多层板在市场所占比例的近十几年的巨大变化,是一个很值得深入探究的问题。微孔加工技术在众多PCB技术所构成的HDI多层板技术中,是发展演变最活跃、最能带动整体技术向前推进的一项技术。各种工艺法的HDI多层板开发在选择所用各种基板材料时,都大有“顺微孔者昌,逆微孔者亡”的劲头。例如,HDI多层板创立初期,采用传统环氧-玻纤布基的基板材料,进行机械钻孔的工艺法,是典型的“逆微孔者”(它所用的基材是不适宜于CO2激光微孔钻孔加工),它在HDI多层板发展初期的多年中,被拒之HDI多层板用基板材料的“门外”。

表1 2000年-2015年间各类工艺法的HDI多层板市场占有率变化
环氧-玻纤布基基板材料从它成为HDI多层板用基板材料的“门外汉” (在HDI多层板发展初期,约在1991年~2000年),到“入门”(约在2001年左右),到成为采用它的工艺法(LDP法)的HDI多层板占整个此类PCB市场近80% 份额——在二十年中,其这一大的地位变化,它揭示了这样一个道理:作为传统的环氧-玻纤布基的基板材料只有对其进行创新、改造去顺应HDI多层板的“微孔、细线、薄层”特点,并有其它应用条件成熟下(如激光加工设备技术取得突破性的进步),才能被HDI多层板所使用。而当它被HDI多层板技术发展大潮所容纳后,就表现出不断的市场壮大、地位提升的特点。它之所以不再被落伍、淘汰反而逐渐变成基板材料的主角,就是因为它在制造HDI多层板中具有制造成本低、生产工艺性好、性能均衡性好、它改性自由度大等优点,而且越来越凸显出来。
环氧-玻纤布基的基板材料及LDP工艺法在HDI多层板中的采用,及其变化,表明了一个深刻的对事物发展的哲学观点:事物从简单到复杂、从低级到高级的发展不是直线式的,而是近似于一串圆圈,近似于螺旋的曲线。即由自身出发,仿佛又回到自身,并得到丰富和提高的辩证过程。它是高层次重复,是扬弃,是否定之否定。人的认识是对客观事物的反映,也是螺旋式发展的。正如列宁说:“人的认识不是直线(也就是说,不是沿着直线进行的),而是无限地近似于一串圆圈、近似于螺旋式的曲线”[13]。 在科学的创新道路上,我们所需要是,具有对认识事物发展的认识“统一完整地再现和把握发展着的具体概念的各种规定(G.W.F.黑格尔语)”的重要思想。
[1]塚田裕(日) .“SLC”与倒装芯片安装技术[J]. 表面安装技术, 1991, 第一期.
[2]塚田裕 (日) .表层布线印制电路板(SLC)的特征与应用[J]. 电子材料, 1991, 第四期.
[3]祝大同. SLC的开发与发展——SLC的开发思想与研究过程综述[J]. 印制电路信息, 1998, 第10期.
[4]祝大同. 积层法多层板发展历程.电子与封装[J].2003, 3期(总11期).
[5]塚田裕(日) . SLC/FCA安装技术的应用进展[J]. 表面安装技术, 1993, 第1期.
[6]塚田裕(日). 积层法印制电路板[J]. サーキットテクノロジ, 1994, 第5期.
[7]塚田裕(日). 采用光固化树脂表层加层多层印制电路技术. 电路安装学会志, 1998, 第1期.
[8]祝大同. 积层法多层印制板技术讲座——第一讲日本积层法多层板发展现状[J]. 印制电路信息,1998,1.
[9]李乙翘, 陈长生主编. 印制电路[M]. 化学工业工出版社, 2007, 1.
[10]沈浩. HDI技术在手持式产品中的设计应用.百度文库. http://wenku.baidu.com.
[11]“配線板の展望”.エレクトロニクス实装学会誌.Vol.12, No.1 (2009).
[12]黄志东等.HDI印制板对CCL机遇和挑战第八届覆铜板市场[C]. 技术研讨会文集, 2008.
[13]祝大同. 高性能覆铜板发展趋势及对环氧树脂性能的新需求[J]. 覆铜板资讯. 2006, 5.
[14]列宁全集[M]. 第38卷, 第 411页, 人民出版社.
