图形反转方法制备MEMS器件电极的研究*
2010-12-21彭自求蒋亚东
彭自求,王 军,袁 凯,蒋亚东
(电子科技大学光电信息学院, 电子薄膜与集成器件国家重点实验室,成都 610054)
微电子机械系统(MEMS)技术具有体积小、价格低廉、精度高、性能稳定、可靠性高、耗能低、多功能和智能化等优点,因而在众多领域中有着广泛的应用[1]。在MEMS器件的制备过程中,制作均匀性好、性能优越的金属电极,对器件性能的影响极大。
对于离子轰击难以刻蚀的金属材料,传统的电极图形的制备一般采用湿法腐蚀,即蒸镀、溅射金属薄膜,然后在金属上覆盖掩膜图形,再通过腐蚀液对金属进行腐蚀。但该方法不易控制,难以制备细线条且均匀性较好的金属电极,而且容易产生残留。而采用剥离技术来制作金属电极则不存在以上问题,有利于制备性能优异的器件。
目前,剥离技术主要有图形反转法、氯苯浸泡法、负性光刻胶法、多层掩膜剥离法等方法。但由于氯苯有毒,对人体有害,对设备要求极高[2];负性光刻胶存在分辨率不高和溶胀问题[3];多层掩模剥离法在常规的工艺和设备条件下难以应用[4],所以图形反转法成为研究和应用的热点[5-8]。
正性光刻胶经紫外线照射后发生光化学反应,化学键断裂重组,曝光的区域会溶于显影液,未曝光的区域不溶,形成的图形与掩模版上图形相同。负性胶性质则相反,其得到的图形与掩模版上图形相反。而图形反转是利用光刻胶的特殊化学性质,用正性光刻胶来实现用负性光刻胶得到的光刻图形[9]。
利用AZ5214胶的图像反转性质,对形成倒台面图形的机理进行了分析和讨论,通过改变前曝光时间,反转烘温度和时间得到最佳的金属层剥离的倒台面光刻胶图案,最终得到了符合要求的电极线条。
1 实验
实验采用的衬底为6 inch单晶硅硅片,光刻胶为AZ-5214,显影液为RZX-3038。匀胶、显影机为DǜNA700,光刻机为Nikon的NSR2005i9C。
首先让硅衬底在120 ℃环境中烘烤,去除水分。然后HMDS气相成底膜,以增加表面的粘附性。采用静态滴胶涂胶,然后涂胶台高速运动将胶涂均匀。涂胶后在热板上进行前烘,去除光刻胶中的溶剂成分。待硅片冷却后进行首次曝光,光经过掩膜版后照射到硅片表面的光刻胶,使其发生化学变化。曝光后用热板对已曝光硅片进行反转烘,烘烤过程中被曝光区域再次发生化学反应而失去光敏特性。待硅片冷却后再进行泛曝光,此次曝光下光源和硅片之间没有掩膜版。曝光完成后进行显影、清洗,并最终在120 ℃氛围中固化坚膜。
光刻胶形成“倒台面”图形后,将基片置于磁控溅射仪器内制备NiCr金属。溅射完成后,将硅片置于丙酮内,辅以超声清洗对其进行剥离。剥离完成后清洗,即完成了NiCr金属电极的制备。图一分别是光刻反转后的图案、溅射金属后的图案和剥离完成后的图案。

图1 电极制备各阶段金像显微图
2 结果与讨论
2.1 图像反转机理分析及仿真
AZ5214光刻胶主要由3部分组成:光敏成分、树脂、溶剂。经光照后的区域光敏成分转变成羧酸,亲水,可溶于碱性显影液中。在反转烘步骤中,高温使得光刻胶中的咪唑与以上产生的酸发生交联反应,产生不溶于碱液的酰胺类化合物。反转烘温度相对较高,曝光的区域发生的交联反应比未曝光的区域中多得多,结果在泛曝光后掩模曝光区域比未掩模曝光区域溶解性低,从而实现了曝光区域的图像反转[10-11]。
光刻胶因各种辐射源的辐照所引起的的化学反应基本上可分为光化学反应和辐射化学反应两种。紫外光对AZ5214光刻胶引发的是光化学反应。光的吸收可按 Beer定律和Lambert定律进行。 Beer定律指出,被吸收的光的数量和吸收物质的浓度成正比。Lambert定律指出,入射光所能被吸收的百分比和光的强度无关。凡是厚度相等的连续介质层都吸收同样百分率的入射光。根据 Lambert-Beer定律, Dill等人对正胶的光化学反应机理进行了定量的研究[12],根据Dill理论,当光无反射透过光刻胶时,可将光强的变化用下式描述:

其中I为光强(单位mJ), X为该点到光刻胶与空气接触面的距离(单位μm), ai为第i种成分的摩尔浓度(单位mol/L), mi为第i种成分的每摩尔光吸收系数。
对于AZ5214正胶来说,需要考虑三种吸收成分:光敏成分(PAC)、树脂、反应生成物。其中光敏成分在光学曝光过程中生成反应生成物,这一过程将减少胶膜对光的吸收,由式(1)可得I(x, t)光强随深度x和曝光时间t的分布:

其中a1、a2、a3分别为光敏成分、树脂、反应生成物的摩尔吸收常数。 m1(x, t)、m2(x, t)、m3(x, t)分别为光敏成分、树脂、反应生成物的摩尔浓度。
光敏成分浓度m1(x, t)随深度x和时间t的变化由下式描述:

其中C为光敏成分的分解系数。在光化学反应中,一摩尔光敏成分分解可得到一摩尔反应生成物,而树脂不会发生分解,因此可将此光化学反应的初态设为:

式(4)表示初始光强;式(5)为光敏成分的初始浓度;式(6)表明反应过程中树脂浓度保持不变;式(7)表明一摩尔光敏成分分解可得到一摩尔反应生成物。
将(4)、(5)、(6)式代入(2)式得:

定义:

由以上变换, (2)、(3)两式可化为:

根据曝光条件,在曝光以前,初始条件为:

相应的边界条件为:

当A、B、C及I0的值确定后,结合边界条件和初始条件可求出光强随深度和时间的变化I(x, t)及光敏成分随深度和时间的变化M(x, t)。
在以上分析的基础上对AZ5214光刻胶的曝光机理进行了模拟仿真,假设光刻胶厚度为3 μm,初始光强为6 000 m J,经过t0=200 ms的曝光后在显影得到光刻胶侧壁的形状。代入边界条件和初始条件后算得光强随深度和时间的变化I(x, t)及光敏成分浓度随深度和时间的变化M(x, t)。光强随时间位置的变化关系如图2(a)所示。光敏成分随时间位置的变化关系如图2(b)所示。
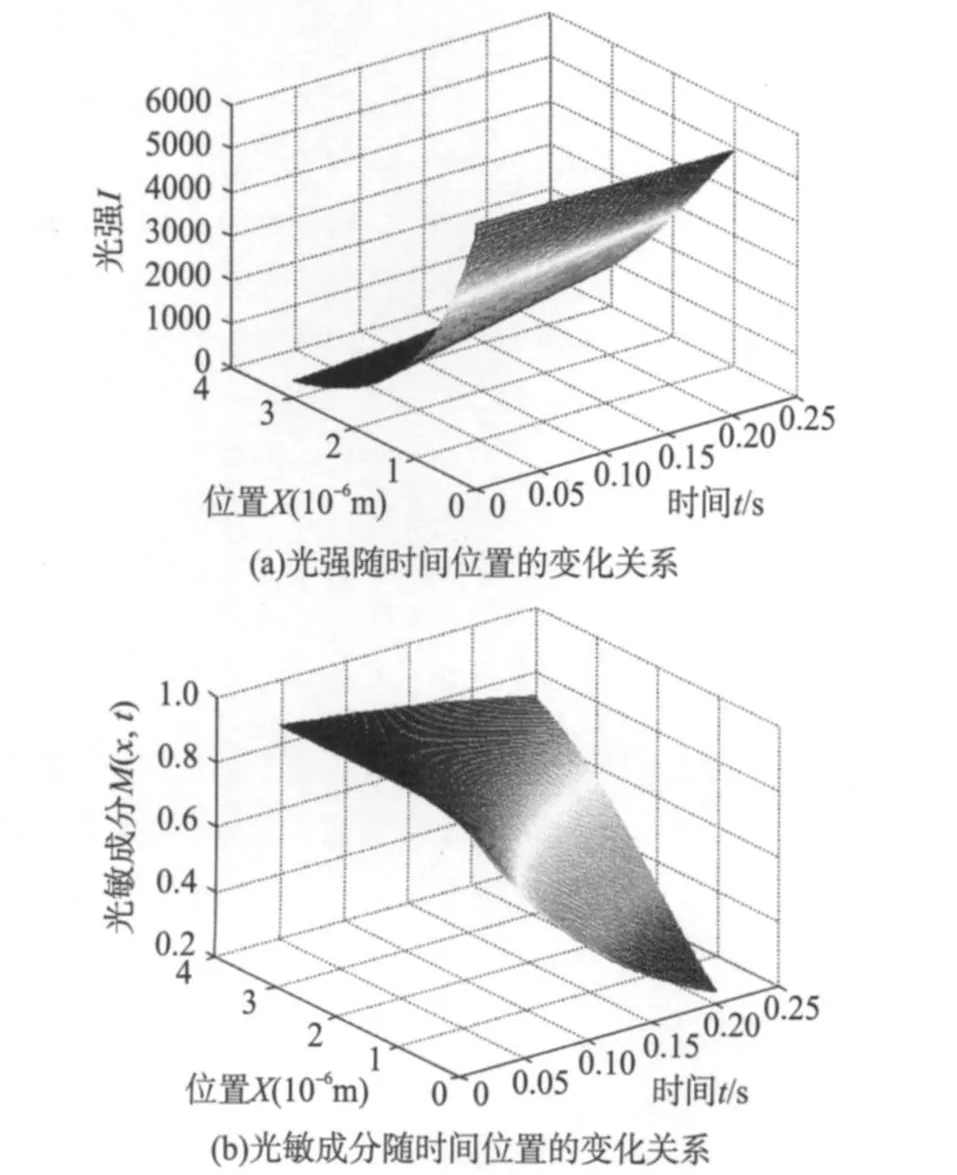
图2 光强和光敏成分随时间位置变化关系
同时,可以得出前曝光后光敏成分浓度M(x, t)与位置的关系,如图3(a)所示。由Dill等人提出的光敏成分浓度对应显影速率的关系[12],可得出显影速率D(x, t)和位置的关系曲线,如图3(b)。在反转烘过程中,原本可以在显影中溶解的羧酸与咪唑发生交联反应而生成了难溶的酰胺类聚合物,在假设生成的羧酸完全反应的情况下(即反转烘温度和时间充足),泛曝光后的光敏成分浓度可以用M′(x,t)=1-M(x, t)表示,其对应的显影速率D′(x, t)和位置的关系曲线如图3(c)。因此,显影后的光刻胶截面将形成“上宽下窄”的倒“八”字倒台面图形。

图3 光敏成分浓度M(x, t)和显影速率D(x, t)对应位置关系
2.2 前曝光时间和泛曝光时间对倒台面影响
实验证明,不同的前曝光时间和泛曝光时间组合,将影响反转效果。为了达到良好的倒台面效果,前曝光时间和泛曝光时间需要合理的分配。由实验可得出,在一定曝光强度,反转烘温度相同条件下,若前曝光与泛曝光时间之比太小,则容易产生浮胶,留膜率低;若二者比值太大,会导致线条底部变宽,侧壁的内倾角度很小,断面的倒梯形形状不明显,溅射金属时断面处容易粘连,最终不能有效的分离开。由实验确定二者比值为0.1左右,内倾角度在60 ℃时,剥离出的电极较好。选取胶厚所对应的前曝光时间,则泛曝光时间也可确定。实验中采取的转速为4 000 转/m in,胶厚为1.1 μm,选取前曝光时间和泛曝光时间为200 ms和2 s。
2.3 反转烘对倒台面影响
反转烘的作用是使前曝光区域产生的羧酸发生交联反应,改变在显影液中的溶解能力。交联反应须在一定的温度下进行,所以,若温度过低,则曝光部分交联反应不充分,溶解性能改变不多,从而在泛曝光后,掩膜曝光区域也会部分溶于显影液中,导致留膜率降低,图形反差不大。若温度过高,类似于前烘温度过高,导致未曝光区域的光敏感特性下降,无法完全溶于显影液中,从而图形无法实现反转。图4在前曝光与泛曝光时间相同条件下改变反转烘温度得到的倒台面。
由图4中可知,反转烘温度为105 ℃时内倾严重,容易在显影或剥离时脱落。而反转烘温度为115 ℃时倒台面倾角约为60°,制作完成的电极线条均匀、无脱落。

图4 AZ5214胶光刻图形的扫描电镜图
3 结论
根据理论推导和仿真结果,得出了光刻胶的显影模型。利用AZ5214 光刻胶的特殊性质, 可知剥离方法可以有效地解决金属电极的制备问题。从实验结果得出,当前曝光与泛曝光时间之比为0.1,反转烘温度为115 ℃时,可以得到倾角约为60°的光刻胶倒台面,并最终制备精度达到1 μm宽的MEMS器件中的金属NiCr电极。
[ 1] 李旭辉.MEMS发展应用现状[ J] .传感器与微系统, 2006, 5:7-9.
[ 2] Hatzakis M, Canavello B J, Shaw JM.Single-Step Optical Lift-Off process[ J].IBM Journal of Research and Development,1980, 24:452-460.
[ 3] 田民波,刘德民.薄膜科学与技术手册[ M] .北京:机械工业出版社, 1991:85-91.
[ 4]LIC, Richards J.A high Resolution Double Layerphotoresist Structure for Lift-Off technology[ C] //Wash D C:International Electron DevicesMeeting, 1980:412-414.
[ 5] 陈德鹅,吴志明,李伟,等.图形反转工艺用于金属层剥离的研究[ J] .半导体技术, 2009, 6:535-538.
[ 6] 史锡婷,陈四海,何少伟,等.剥离技术制作金属互连柱及其在MEMS中的应用[ J].半导体技术, 2005, 12:15-18.
[ 7] 何熙.红外微测辐射热计结构优化设计与制备[ D] .厦门大学, 2008:40-45.
[ 8] 陈光红,于映,罗仲梓,等.AZ5214E反转光刻胶的性能研究及其在剥离工艺中的应用[J] .功能材料, 2005, 36(3):431-433.
[ 9] 韩阶平,侯豪情,邵逸凯.适用于剥离工艺的光刻胶图形的制作技术及其机理讨论[ J].真空科学与技术, 1994, 5:215-219.
[ 10] 王军,杨刚,蒋亚东,等.图形反转工艺制作OLED器件的阴极分离器[ J] .发光学报, 2007, 2:198-202.
[ 11] Spak M, Mammato D, Jain S, et al.Mechanism and Lithographic Evaluation of Image Reversal in AZ5214 Photoresist[ C] //Ellenville:Seventh International Technlcal Conference on Photopolymers, 1985:15-23.
[ 12] Frederick H Dill, William P Hornberger, Peter SHauge, et al.Characterization of Positive Photoresist[ J] .IEEE Trans on Electron Devices, 1975, 22:445-452.
