快速凝固Sn2.5Ag0.7Cu钎料中金属间化合物的形态及对焊点性能的影响
2010-11-24赵国际张柯柯
赵国际,张柯柯,罗 键
(1. 重庆大学 材料科学与工程学院,重庆 400044;2. 重庆大学 机械传动国家重点实验室,重庆 400044;3. 河南科技大学 材料科学与工程学院,洛阳 471003)
快速凝固Sn2.5Ag0.7Cu钎料中金属间化合物的形态及对焊点性能的影响
赵国际1,2,张柯柯3,罗 键2
(1. 重庆大学 材料科学与工程学院,重庆 400044;2. 重庆大学 机械传动国家重点实验室,重庆 400044;3. 河南科技大学 材料科学与工程学院,洛阳 471003)
利用SP009A型半自动非金属系制造器,通过铜制单辊快淬工艺制得快速凝固态Sn2.5Ag0.7Cu钎料合金薄带,采用JSM−5610LV 扫描电镜及能谱仪,研究快速凝固态钎料合金的微观形貌及金属间化合物(IMC)特征;通过钎焊接头组织与剪切断口分析,研究 IMC对钎焊接头韧性的影响机制。结果表明:快速凝固态钎料合金焊点界面处形成的排列紧密的小尺寸β-Sn能有效抑制界面处IMC Cu6Sn5的长大;在钎焊过程中,钎料中过饱和固溶体析出大量尺寸细小、弥散分布的金属间化合物Cu6Sn5和Ag3Sn,凝固时可作为第二相粒子与初生相混杂在一起,形成细小共晶组织分布于钎缝中,改善了焊点韧性。
Sn2.5Ag0.7Cu;钎料;金属间化合物;快速凝固;钎焊
近几年来,利用快速凝固方法制备急冷态甚至非晶态钎料合金在材料加工领域得到了广泛的研究与应用[1−3]。与常态钎料相比,经快速凝固技术制备的钎料具有合金化程度高、化学成分均匀、熔点较低、熔化区间窄、流动性好、铺展润湿性好等优点,可以缩短钎焊时间,提高钎焊质量[3−5]。
在现有的无铅钎料中,SnAgCu系钎料合金以其较好的综合性能得到了广泛应用[6−7]。然而,与 SnPb合金相比,SnAgCu系钎料熔点较高、且存在 Ag3Sn等粗大 IMC颗粒,会导致低流动性和焊点的非均匀性[8−9],不利于工业应用。
利用快速凝固技术可以改变SnAgCu系钎料合金特性。DUTKIEWICZ等[10]研究表明,SnAgCu合金在高冷速条件下,β-Sn相含量显著增加;KIM等[11]研究了冷却速度对 SnAgCu钎料组织及金属间化合物Ag3Sn形貌与分布的影响;SHEN等[12]关于Sn3.5Ag钎料的研究表明,快速凝固可以使晶粒细化,同时,可以使钎料中作为强化相的金属间化合物Ag3Sn的分布更加均匀,有利于提高连接性能。
界面IMC的形成与特性决定了焊点的可靠性[13]。本文作者在对 SnAgCu系无铅钎料早期研究基础上[14−15],选取Sn2.5Ag0.7Cu常态钎料合金为参照系,研究单辊法制备快速凝固钎料中金属间化合物(IMC)的形态及对其钎焊的影响,对于新型环保型、高可靠性、无铅钎料的开发与应用具有一定的理论和实用价值。
1 实验
1.1 钎料的制备
采用纯度为99.9%(质量分数)的Sn、Ag、Cu为原料,在真空度为5×10−3Pa的非自耗电炉ZHW−600A中进行真空熔炼,制备常态Sn2.5Ag0.7Cu钎料合金。
取常态 Sn2.5Ag0.7Cu钎料合金约 20 g,利用SP009A型半自动非金属系制造器,通过铜制单辊快淬工艺制得快速凝固态钎料合金薄带(宽 6 mm,厚50~80 µm)。快凝单辊直径为350 mm,铜辊面线速度为44 m/s。快速凝固钎料薄带制备后立即置于液氮中保存备用以防止氧化与再结晶。
1.2 仪器分析
利用JSM−5610LV扫描电镜对快速凝固态钎料薄带进行微观形貌分析,利用EDAX能谱分析仪进行成分分析,其中腐蚀试样用4%硝酸酒精浸蚀60 s后在纯酒精中进行超声波清洗。
1.3 钎焊试验与接头分析
钎焊焊点为搭接,焊点试样的结构示意图如图 1所示。
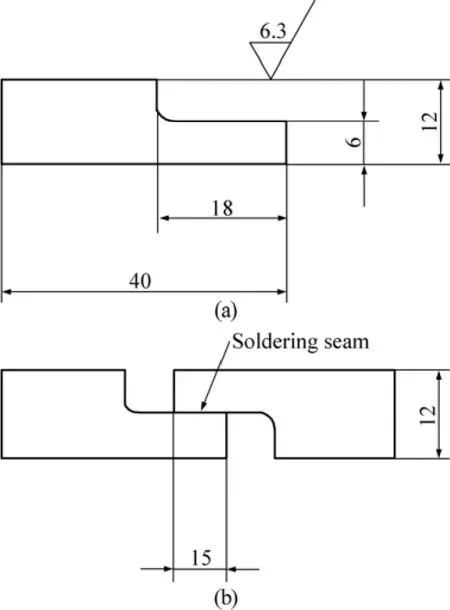
图1 钎焊焊点试样结构示意图(mm)Fig.1 Schematic diagram of test specimen for soldering joint(mm): (a) Soldering base metal; (b) Soldering joint sample
将常态钎料合金在轧辊机上轧制成0.2 mm厚的薄片,并用砂纸打磨以除去其氧化皮及污垢,然后,置于丙酮中清洗并吹干;快速凝固态钎料薄带折叠 4层使用;钎剂采用22%(体积分数)ZnCl2+2%NH4Cl水溶液。在焊前清理的试样的待钎焊面上滴上2~3滴钎剂,将钎料薄片(薄带)剪成15 mm×4 mm的矩形,置于焊点之间,放入 4−13型箱式电阻炉中进行钎焊试验,钎焊温度为265 ℃,时间为3 min(钎焊时间是指将常温下装配好的接头自放入加热炉至取出的时间),制备常态与快速凝固态 Sn2.5Ag0.7Cu钎料合金钎焊接头试样。
分别将使用快速凝固态和常态 Sn2.5Ag0.7Cu钎料合金钎焊后的接头试样用线切割的方法横向切开,制备金相试样,用1%的盐酸甲醇浸蚀8 s,经超声波清洗后,在JSM−5610LV扫描电镜(SEM)下观察分析接头组织特征,利用EDAX能谱仪进行特征位置成分分析。
分别将使用快速凝固态和常态 Sn2.5Ag0.7Cu钎料合金钎焊后的接头试样室温下在AG−I 250KN万能材料试验机上进行剪切拉断后,经超声波清洗,采用JSM−5610LV扫描电镜(SEM)对钎料/铜钎焊焊点的剪切断口进行观察。
2 结果与讨论
2.1 钎料的微观形貌
常态Sn2.5Ag0.7Cu钎料组织如图2所示。由图2可知,钎料组织由初生相β-Sn与共晶组织组成。钎料合金中共晶组织包括颗粒状 β-Sn+Cu6Sn5与针状β-Sn+Ag3Sn 2种二元共晶以及β-Sn+Cu6Sn5+Ag3Sn三元共晶[16]。

图2 常态Sn2.5Ag0.7Cu钎料组织Fig.2 Microstructure of normal state Sn2.5Ag0.7Cu solder alloy
研究表明[10,16]:Sn2.5Ag0.7Cu快速凝固薄带与常态钎料均由 β-Sn、Ag3Sn、Cu6Sn5相组成;与常态钎料相比,快速凝固钎料中 IMC(Ag3Sn,Cu6Sn5)含量减少,而β-Sn相明显增加,共晶组织由层片状转变为团状。
图3所示为Sn2.5Ag0.7Cu快速凝固态钎料合金薄带自由面的SEM像及能谱分析结果。由图3可以看出,Sn2.5Ag0.7Cu快速凝固态钎料合金薄带表面凹凸不平,由黑色基体和白色的颗粒状物质组成。能谱分析结果表明,白色的颗粒状物质(A处)成分为Sn;黑色基体的区域(B处)主要成分为 Sn,含有少量的Ag(w(Ag)<1%);未检测到Cu。
图4所示为腐蚀后的Sn2.5Ag0.7Cu快速凝固态钎料合金薄带微观形貌及能谱分析结果。由图4可以看出,由于薄带表面凹凸不平造成了腐蚀的不均匀,在腐蚀较轻处,形成了团块(A′处),EDS分析表明,这些团块中含有一定量的Ag和Cu,且Cu含量略高于Ag,表明该团块为三元共晶产物;在腐蚀较深的区域,出现了大量极细的弥散分布的颗粒(B′处),EDS分析表明,这些颗粒中含有远大于平均值的 Ag(19%,质量分数)和Cu(4.4%,质量分数),尤其是Ag含量急剧增大,且远高于Cu的含量。

图3 Sn2.5Ag0.7Cu快速凝固态钎料合金薄带的SEM像与EDS分析Fig.3 SEM image (a) and spectrum analysis ((b), (c)) of Sn2.5Ag0.7Cu rapidly solidified solder alloy ribbon
结合文献[16−17]的分析结果可知,在急冷快速凝固条件下,IMC(Ag3Sn,Cu6Sn5)作为形核质点和β-Sn共同竞争生长,初生相β-Sn枝晶生长速率大并快速分枝,形成网络状枝晶骨架;Ag3Sn生长被抑制,散布于β-Sn中,凝固形成细小的Ag3Sn颗粒;Cu在基体中含量很少,极易形成IMC Cu6Sn5[18],且绝大部分与细小的β-Sn枝晶和 Ag3Sn小颗粒共同组成三元共晶团;以IMC(Ag3Sn,Cu6Sn5)作为形核质点形成的三元共晶团在快速凝固过程中发生了明显的显微偏析,心部Ag、Cu含量高,而在颗粒外部则基本是Sn,经硝酸酒精腐蚀并清洗腐蚀产物后,组成白色颗粒的大量Ag、Cu含量高的细小颗粒显露出来。

图4 Sn2.5Ag0.7Cu快速凝固态钎料合金带浸蚀 60 s的SEM像与能谱分析Fig.4 SEM image (a) and spectrum analysis ((b), (c)) of Sn2.5Ag0.7Cu rapid solidification solder alloy ribbon in erode for 60 s
2.2 焊点界面分析
2.2.1 焊点组织分析
Sn2.5Ag0.7Cu钎料合金/Cu钎焊接头钎缝由初生相β-Sn和β-Sn与金属间化合物 Ag3Sn、Cu6Sn5之间形成的共晶组织组成;焊点界面化合物包括靠近钎料一侧厚度不均匀的脆硬扇贝状 Cu6Sn5相和靠近基体铜一侧的Cu3Sn相,大部分研究认为,Ag原子并不参与IMC的形成[18]。
常态钎料合金钎焊接头组织如图 5(a)所示,钎缝中β-Sn与共晶组织轮廓清晰且尺寸较大,钎料合金与Cu基体形成界面层边缘高低不平的波浪形,Cu6Sn5向钎缝中心长大形成粗大棒状。
快速凝固态钎料合金钎焊接头组织如图 5(b)所示。与常态钎料钎焊接头组织相比,界面处扇贝状Cu6Sn5层的边缘比较平滑,没有出现伸向钎料的棒状Cu6Sn5;界面靠近铜基体侧初生相β-Sn尺寸较小且紧密排列,共晶组织明显减少;在钎缝中心区,快速凝固态钎料合金钎焊接头中初生相 β-Sn与共晶组织细化且其间界限变得模糊,富铜相生长为各个方向伸长的细棒状,而富银相为小方块状[8]。

图5 Sn2.5Ag0.7Cu常规熔铸态与快速凝固态钎料钎焊接头的显微组织Fig.5 Microstructures of Sn2.5Ag0.7Cu/Cu soldering joints:(a) Normal state Sn2.5Ag0.7Cu soldering joints; (b) Rapid solidification Sn2.5Ag0.7Cu/Cu soldering joints
2.2.2 界面IMC生长动力学特点
熔融焊料和 Cu基板接触,就会瞬间形成金属间化合物 Cu6Sn5(η相),并形成连续层,这是由母材和钎料直接化学反应形成的;其后续生长需要反应组元(Sn和/或者 Cu)通过金属间化合物层的扩散来进行。界面η相的生长受沿着它的扇贝状边缘或者晶界的扩散所控制。
关于一定时间和温度范围内 IMC的生长动力学研究认为IMC层厚度X可表达为[19−21]

式中:X0为刚焊接完成时的IMC厚度(在t=0时刻);k0为常数; Q为激活能,t为有效时间;R为摩尔气体常数;T为反应温度;n为时间常数,与IMC生长机制有关,对 Sn系合金和铜的界面固相反应,大多数取0.4~0.5[6]。
常态 Sn2.5Ag0.7Cu钎料合金钎焊接头界面区Cu6Sn5厚度区别较大,由于Cu6Sn5与钎料合金和铜基板间热膨胀系数差别较大,在服役过程中,易造成焊点界面区 Cu6Sn5金属间化合物内沿铜基板方向易萌生裂纹[18];钎料合金经快速凝固制备工艺后,焊点界面区 Cu6Sn5厚度区别明显减小,且没有出现棒状Cu6Sn5金属间化合物,表明焊点界面区裂纹倾向减小,利于提高焊点的韧性与连接的有效性。
2.2.3 钎缝结晶动力学特点
在常态钎料焊点凝固过程中,由界面向钎料中心形核长大的层片状初生相汇聚生长为粗大的β-Sn(10~15 µm),在 β-Sn内留下了明显的条纹(见图5(a)),同时由于铜在锡中的扩散速度非常快[18,22],Cu6Sn5向钎缝的生长迅速,甚至在β-Sn组织间隙生长为粗大棒状;快速凝固态钎料β-Sn中由于过饱和固溶了大量Ag3Sn、Cu6Sn5等(见图4)金属间化合物细小粒子[16],在钎焊熔化过程中快速大量析出,形成大量形核质点。冷却凝固过程中形核率μ计算公式[23]为

式中:α为原子间距;η(T)为动力学黏度;Nn为形核点的数量;ΔW为形核功;k为玻尔兹曼常数。
焊接过程中晶粒的尺寸主要取决于形核密度。由于快速凝固态钎料中形核点数量 Nn明显大于常态钎料的,促进了凝固过程中形核,最终钎料在界面处形成了大量小尺寸(3~5 µm)的初生相β-Sn,且在界面处排列紧密,抑制了基体中铜元素向钎料中的扩散,防止了Cu6Sn5在钎料中的过度生长,有利于焊点界面韧性的提高。
2.3 钎焊接头断口分析
图6所示为Sn2.5Ag0.7Cu常态与快速凝固态钎料钎焊接头剪切断口照片。
剪切试验结果表明,钎焊试样均断在接头的钎缝上,表明钎料合金与母材结合良好,钎焊接头的界面层强度高于钎料合金的强度,快速凝固态钎料钎焊接头剪切强度高于常态钎料钎焊接头。
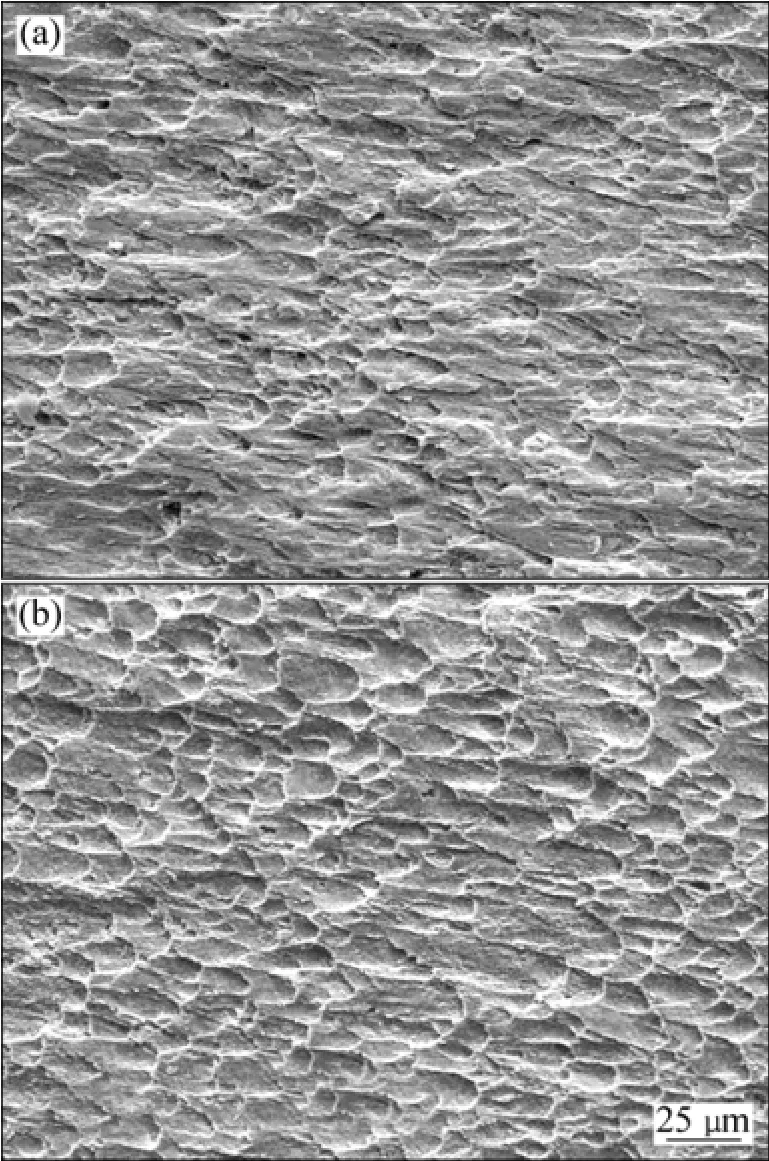
图6 Sn2.5Ag0.7Cu常规熔铸态与快速凝固态钎料钎焊接头剪切断口照片Fig.6 SEM image of shear fracture of normal state and rapidly solidified Sn2.5Ag0.7Cu solder alloy joints: (a) Shear fracture of normal state solder soldering joint (τ=38 MPa); (b)Shear fracture of rapid solidification solder soldering joints(τ=42 MPa)
对剪切断口观察发现,接头剪切断口有明显塑性变形痕迹,由韧窝和撕裂面组成,呈韧性断裂。其中,常态钎料钎焊接头剪切断口中韧窝数量较少(见图6(a)),大多表现为撕裂面形貌;而快速凝固态钎料钎焊接头剪切断口中,韧窝尺寸较小,分布均匀,数量明显较多(见图6(b))。
韧窝断裂包含了微孔的形成和长大、汇合并最终断裂的过程,而显微孔洞一般是在第二相粒子上形核的[24],所以韧窝的形貌也可以间接反映出钎缝中第二相的分布状态。常态钎料钎缝中存在大量大尺寸β-Sn(见图 5(a)),在剪切力作用下主要以撕裂方式断裂;快速凝固 Sn2.5Ag0.7Cu钎料过饱和固溶体中细小、分布弥散的金属间化合物Ag3Sn与Cu6Sn5,在钎焊过程中大量析出,凝固时作为第二相粒子与初生相混杂在一起形成细小共晶组织分布于钎缝中,在剪切力作用下形成大量微孔增加了韧窝数量,改善了焊点的韧性。
3 结论
1) 经快速凝固后,Sn2.5Ag0.7Cu钎料合金中金属间化合物Ag3Sn、Cu6Sn5以弥散的细小粒子形态过饱和固溶于β-Sn中;在钎焊时,其大量析出促进了钎缝凝固时初生相形核,形成小尺寸β-Sn密布于界面区,抑制了界面金属间化合物Cu6Sn5的生长,提高了结合性能。
2) 在钎焊过程中,快速凝固 Sn2.5Ag0.7Cu钎料过饱和固溶体中尺寸细小、分布弥散的金属间化合物Ag3Sn与Cu6Sn5大量析出,凝固时与初生相混杂形成细小的共晶组织分布于钎缝中,在剪切力作用下形成大量微孔,增加了韧窝数量,改善了焊点韧性。
REFERENCES
[1] SHEN J, CHAN Y C. Research advances in nano-composite solders[J]. Microelectronics Reliability, 2009, 49(3): 223−234.
[2] 蒋志国, 邹家生. Ti-Zr-Ni-Cu非晶钎料钎焊Si3N4陶瓷的连接强度[J]. 中国有色金属学报, 2006, 16(11): 1955−1959.JIANG Zhi-guo, ZOU Jia-sheng. Joint strength of Si3N4brazed with Ti-Zr-Ni-Cu amorphous brazing alloy[J]. The Chinese Journal of Nonferrous Metals, 2006, 16(11): 1955−1959.
[3] 俞伟元, 陈学定, 路文江, 王艳红. 快速凝固钎焊薄带[J].焊接技术, 2006, 35(3): 2−4.YU Wei-yuan, CHEN Xue-ding, LU Wen-jiang, WANG Yan-hong. Rapidly solidified brazing foils[J]. Welding Technology, 2006, 35(3): 2−4.
[4] 邹家生, 许志荣, 初雅杰, 陈 光. 非晶态焊接材料的特性及其应用[J]. 材料导报, 2004, 18(4): 17−19.ZOU Jia-sheng, XU Zhi-rong, CHU Ya-jie, CHEN Guang.Characteristics and application of amorphous welding materials[J]. Materials Review, 2004, 18(4): 17−19.
[5] AMAGAI M. A study of nanoparticles in Sn-Ag based lead free solders[J]. Microelectronics Reliability, 2008, 48(1): 1−16.
[6] SUGANUMA K. Advances in lead-free electronics soldering[J].Current Opinion in Solid State and Materials Science, 2001, 5(1):55−64.
[7] 张富文, 刘 静, 杨福宝, 胡 强, 贺会军, 徐 骏.Sn-Ag-Cu无铅焊料的发展现状与展望[J]. 稀有金属, 2005,29(5): 619−624.ZHANG Fu-wen, LIU Jing, YANG Fu-bao, HU Qiang, HE Hui-jun, XU Jun. Developing tendency and current situation of Sn-Ag-Cu lead-free solder[J]. Chinese Journal of Rare Metals,2005, 29(5): 619−624.
[8] SHEN J, CHAN Y C, LIU S Y. Growth mechanism of bulk Ag3Sn intermetallic compounds in Sn-Ag solder during solidification[J]. Intermetallics, 2008, 16(9): 1142−1148.
[9] 王小京, 祝清省, 王中光, 尚建库. Ag3Sn粗化模型及其对Sn-Ag-Cu焊料蠕变的影响[J]. 金属学报, 2009, 45(8):912−918.WANG Xiao-jing, ZHU Qing-sheng, WANG Zhong-guang,SHANG Jian-ku. Modeling of Ag3Sn coarsening and its effect on creep in Sn-Ag-Cu solder[J]. Acta Metallurgica Sinica, 2009,45(8): 912−918.
[10] DUTKIEWICZ J, LITYNSKA L, SWIATEK R. Rapid quenching and mechanical alloying of eutectic Ag-Cu-Sn alloys[J]. Journal of Materials Processing Technology, 1995,53(1/2): 131−138.
[11] KIM K S, HUH S H, SUGANUMA K. Effects of cooling speed on microstructure and tensile properties of Sn-Ag-Cu alloys[J].Materials Science and Engineering A, 2002, 333(1/2): 106−114.
[12] SHEN J, LIU Y C, GAO H X. In situ nanoparticulate -reinforced lead-free Sn-Ag composite prepared by rapid solidification[J].Journal of Materials Science: Materials in Electronics, 2007,18(4): 463−468.
[13] WANG Feng-jiang, YU Zhi-shui, QI Kai. Intermetallic compound formation at Sn-3.0Ag-0.5Cu-1.0Zn lead-free solder alloy/Cu interface during as-soldered and as-aged conditions[J].Journal of Alloys and Compounds, 2007, 438(1/2): 110−115.
[14] 王要利, 张柯柯, 程光辉, 樊艳丽. 微量稀土及工艺参数对SnAgCu钎料合金润湿特性的影响[J]. 中国机械工程, 2006,17(18): 1963−1966.WANG Yao-li, ZHANG Ke-ke, CHENG Guang-hui, FAN Yan-li.Effect of tiny rare earth and soldering parameters on wetting properties of SnAgCu solder alloy[J]. China Mechanical Engineering, 2006, 17(18):1963−1966.
[15] 樊艳丽, 张柯柯, 王双其, 程光辉, 王要利, 余阳春. 水洗钎剂下 SnAgCu系钎料对不同基板的润湿特性[J]. 特种铸造及有色合金, 2006, 26(9): 604−606.FAN Yan-li, ZHANG Ke-ke, WANG Shuang-qi, CHENG Guang-hui, WANG Yao-li, YU Yang-chun. Wettability of SnAgCu lead-free solder containing low Ag for different substrate with water-soluble flux[J]. Special Casting &Nonferrous Alloys, 2006, 26(9): 604−606.
[16] 赵国际, 张柯柯, 王要利, 祝要民. 快速凝固 Sn2.5Ag0.7Cu钎料合金凝固组织特征[J]. 金属热处理, 2009, 34(6): 55−58.ZHAO Guo-ji, ZHANG Ke-ke, WANG Yao-li, ZHU Yao-min.Solidified structural characteristics of rapid solidified Sn2.5Ag0.7Cu solder alloy[J]. Heat Treatment of Metals, 2009,34(6): 55−58.
[17] BALI R, FLEURY E, HAN S H, AHN J P. Interfacial intermetallic phases and nanoeutectic in rapidly quenched Sn-Ag-Cu on Au under bump metallization[J]. Journal of Alloys and Compounds, 2008, 457(1/2):113−117.
[18] 王要利, 张柯柯, 韩丽娟, 温洪洪. Sn-2.5Ag-0.7Cu(0.1RE)/Cu焊点界面区微观组织与 Cu6Sn5 的生长动力学[J]. 中国有色金属学报, 2009, 19(4): 708−713.WANG Yao-li, ZHANG Ke-ke, HAN Li-juan, WEN Hong-hong.Microstructure and growth behavior of Cu6Sn5 for Sn-2.5Ag-0.7Cu(0.1RE)/Cu solder joint interface[J]. The Chinese Journal of Nonferrous Metals, 2009, 19(4): 708−713.
[19] VIANCO P T, ERICKSON K L, HOPKINS P L. Solid state intermetallic compound growth between copper and high temperature, tin-rich solders. Part I. Experimental analysis[J].Journal of Electronic Materials, 1994, 23(8): 721−727.
[20] VIANCO P T, KILGO A C, GRANT R. Solid state intermetallic compound layer growth between copper and hot dipped indium coatings[J]. Journal of Materials Science, 1995, 30(19):4871−4878.
[21] VIANCO P T, KILGO A C, GRANT R. Intermetallic compound layer growth by solid state reactions between 58Bi-42Sn solder and copper[J]. Journal of Electronic Materials, 1995, 24(10):1493−1505.
[22] TSUKAMOTO H, NISHIMURA T, NOGITA K. Epitaxial growth of Cu6Sn5formed at Sn-based lead-free solder/non-textured polycrystalline Cu plate interface[J]. Materials Letters,2009, 63(30): 2687−2690.
[23] 陈 光, 傅恒志. 非平衡凝固新型金属材料[M]. 北京: 机械工业出版社, 2004: 26−34.CHEN Guang, FU Heng-zhi. New metal materials by non-equilibrium solidification[M]. Beijing: China Machine Press,2004: 26−34.
[24] 田 燕. 焊接区断口金相分析[M]. 北京:机械工业出版社,1991: 22−36.TIAN Yan. Fractograph investigation on welding zone[M].Beijing: China Machine Press, 1991: 22−36.
Micro-morphology of intermetallic compounds in rapid solidification Sn2.5Ag0.7Cu solder alloy and its effects on performance of solder joint
ZHAO Guo-ji1,2, ZHANG Ke-ke3, LUO Jian2
(1. School of Materials Science and Engineering, Chongqing University, Chongqing 400044, China;2. The State Key Laboratory of Mechanical Transmission, Chongqing University, Chongqing 400044, China;3. School of Materials Science and Engineering, Henan University of Science and Technology, Luoyang 471003, China)
Rapid solidification Sn2.5Ag0.7Cu solder alloy ribbons were produced by single copper roller process with SP009A semi-automatic nonmetal series fabricate machine, and the micro-morphology and properties of intermetallic compound (IMC) were studied by JSM−5610LV scanning electronic microscope and energy spectrum analyzer. Through the analysis on the microstructure and shear fracture of the soldering joint, the influence mechanism of IMC on the toughness of soldering joint was studied. The results show that,in solder joint by using rapid solidification solder alloy,small size β-Sn tight arrangement at the interface can effectively inhibit the growth of IMC Cu6Sn5, and the IMC Cu6Sn5and Ag3Sn in the supersaturated solid solution with small size and dispersive distribution massively precipitate as the second phase particle confounding with the primary phase during the solidification process to form fine eutectic structure in the soldering beam, and the toughness of soldering joint is improved.
Sn2.5Ag0.7Cu; solder; intermetallic compound (IMC); rapid solidification; soldering
TG454
A
1004-0609(2010)10-2025-07
河南省高校创新人才基金资助项目(教高 2004-294);河南省高校杰出科研人才创新工程资助项目(2004KYCX020);重庆大学研究生科技创新基金项目(201005A1B0010334)
2009-11-11;
2010-06-29
罗 键,教授,博士;电话:13036328161;E-mail:luojian@cqu.edu.cn
(编辑 龙怀中)
