硅晶片上超薄氧化硅层厚度纳米尺寸效应的XPS研究
2010-10-14赵志娟赵良仲
赵志娟 刘 芬 赵良仲
(中国科学院化学研究所,北京 100190)
硅晶片上超薄氧化硅层厚度纳米尺寸效应的XPS研究
赵志娟 刘 芬*赵良仲
(中国科学院化学研究所,北京 100190)
用X射线光电子能谱(XPS)测定了一系列厚度经过国际比对准确已知的硅晶片上的超薄(1.45 nm<d<7.2 nm)氧化硅膜的Si 2p电子能谱和价带谱.结果表明:SiO2膜厚d<2 nm时,Si 2p结合能最低,其原因可归结于此时光电离空穴既有来自SiO2中的原子极化对空穴的原子外弛豫,也有来自衬底Si的电荷移动对空穴的屏蔽(有效屏蔽距离大约是(2.5±0.6)nm);当d>3 nm时Si 2p结合能增大,此时只有来自SiO2的原子外弛豫,d较小者的Si 2p结合能较高.SiO2的价带电子结构也与其厚度纳米尺寸效应有关:当d<2 nm时价带中SiO2的O 2p非成键电子峰的相对强度较强,O 2p—Si 3p和O 2p—Si 3s成键电子峰较弱.
硅晶片;SiO2膜; 纳米厚度; 尺寸效应;X射线光电子能谱; 电子结合能; 价带谱; 原子外弛豫
Abstract:X-ray photoelectron spectroscopy(XPS)was used to record the Si 2p and valence band spectra for a series of ultrathin SiO2on Si substrate with the oxide thickness(d)ranging from 1.45 to 7.2 nm.The thicknesses of these samples were measured precisely in the international key comparison.The results show that the samples with the oxide thickness of d<2 nm have a lower Si 2p binding energy(EB).This has been attributed to the extra-atomic relaxation provided by both the polarization of the neighboring atoms of SiO2and charge transfer from atoms of the Si substrate to the core holes created by photoionization(the screening distance was about(2.5±0.6)nm).The EBof Si 2p increased when d>3 nm and in this case extra-atomic screening was provided by the polarization of the neighboring atoms of SiO2.The sample with a smaller d showed a higher EBfor Si 2p.The valence band structure is also related to the thickness nanosize effect.The samples with d<2 nm show a higher relative peak intensity of the O 2p non-bonding electrons and lower peak intensities for the O 2p—Si 3p and O 2p—Si 3s bonding electrons from SiO2.
Key Words: Si substrate;Silicon oxide film;Nanosize thickness;Size effect;X-ray photoelectron spectroscopy; Electron binding energy; Valence band spectrum; Extra-atomic relaxation
硅晶片上纳米量级厚度的氧化硅层作为一种超薄栅极氧化物,在金属-氧化物-半导体技术特别是亚微米硅基超大规模集成电路中有着极其重要的应用.在现代工艺中,随着器件尺寸的日益缩小,栅氧化层变得越来越薄,目前它已降至2 nm以下,国际半导体技术发展路线图(ITRS)指出:到2016年它将达到0.5 nm[1].显然,研究硅晶片上超薄氧化硅的内层和价带电子结构与其厚度的关系,考察这种纳米薄膜材料是否也存在纳米尺寸效应,对于硅基微电子工业和纳米薄膜材料有重要意义.事实上鉴于硅晶片在半导体工业中的重要性,人们很早就开始用X射线光电子能谱(XPS)来研究硅晶片上表面氧化物及其SiO2-Si界面,并观察到SiO2的Si 2p结合能与其膜厚有关[2-4].但是,在这些研究中膜厚的精确测量尚未解决,例如文献中有的用湿法化学蚀刻技术估算膜厚[2],有的用早期的XPS测量法[3],有的则通过沉积单层或多层膜来估算[4].对于SiO2的Si 2p结合能随膜厚而位移的解释也存有争议,有的归因于在界面存在结构不同的过渡区[2],有的归因于表面荷电[3],有的认为是终态效应所致[4].因此对于硅晶片上超薄氧化硅层及其界面需要在微观水平上进行更准确和深入的了解.最近10年Seah等[5-6]完善了精确测量硅晶片上超薄氧化硅层厚度的XPS方法,并已组织了两次国际比对[7],使得超薄氧化硅厚度测量技术日趋成熟.在本研究中用XPS方法测定了一系列经过国际比对的、氧化硅厚度准确已知的SiO2/Si样品的内层和价带电子能谱,并对超薄氧化硅层的厚度纳米尺寸效应进行了考察,得到了纳米厚度尺寸效应引起内层电子结合能位移,SiO2/Si界面原子外弛豫效应的影响距离(屏蔽距离)以及价带结构与纳米尺寸的关联等新的实验结果.
1 实验部分
测试样品是经过国际比对(CCQM-K32/P84和APMPQM-P08)的硅晶片上的超薄氧化硅(SiO2/Si)样品,其厚度(d)范围为 1.45 nm<d<7.2 nm.它们分别由英国国家物理实验室和日本国家计量研究院提供.硅晶片表面通过热生长方法在特别设计的氧化炉内制备了厚度范围为1.5-8 nm的均匀的氧化硅层.样品已经过清洗处理,表面光滑洁净,含碳污染层厚度仅为0.15-0.3 nm[6].样品的O 1s峰很对称,表面无羟基化迹象.样品在密封包装后专供国际比对测试用.
XPS测试在英国VG Scientific公司生产的ESCALab 220i-XL型光电子能谱仪上进行.该谱仪的能量标尺已经校准,其标准样品的电子结合能测量值为Au 4f7/284.03 eV,Ag 3d5/2368.31 eV,Cu 2p3/2932.73 eV.它们与国际标准化组织提供的标准值(分别为83.96、368.21和932.62 eV)符合.XPS测试时选用Mg KαX射线源,功率为18 mA×14 kV,分析室真空度为3×10-7Pa.测量Si(100)样品时的方位角和光电子发射角分别为22.5°和34°;Si(111)样品的方位角为25.5°,发射角为0°.Seah等[5]的研究表明,选用这些角度可以提高超薄氧化硅层厚度测量的准确度,因而我们在国际比对中也采用了这些角度.它并不影响Si 2p结合能的比较测定.记录每条Si 2p谱线时重复扫描6次,扫描步长为0.05 eV.处理每条Si 2p谱线时先扣除X射线伴线(Kα3,4)产生的光电子伴峰,再进行平滑处理,扣除shirley本底.Si 2p峰拟合采用2峰(元素Si和SiO2的Si 2p峰)拟合和5峰(元素 Si、Si2O、SiO、Si2O3和 SiO2)拟合两种方法,其中元素Si的Si 2p峰已扣除Si 2p1/2成份.元素Si的Si 2p3/2峰位指定为99.10 eV.3个中间氧化物的峰位分别指定为 100.05、100.85、101.58 eV.图 1为不同氧化硅厚度的SiO2/Si(100)样品测得的Si 2p电子能谱.由图1可知,当d>7 nm时元素Si的Si 2p电子峰仍清晰可见.图2为氧化硅层厚度为4 nm的SiO2/Si(100)样品的Si 2p谱线拟合图.价带谱的记录范围为-2-40 eV,每条谱线重复扫描15次,先扣除O 2s的X射线伴峰成份,再进行平滑处理.由于本谱仪无紫外光源,所以采用XPS而不是紫外光电子能谱记录价带谱.
2 结果与讨论
2.1 硅晶片上超薄氧化硅层厚度纳米尺寸效应引起的Si 2p电子结合能位移

表1给出了从硅晶片表面不同氧化硅层厚度的样品测得的SiO2的Si 2p电子结合能.表中第2列的氧化硅层厚度数据为我们实验室参加CCQMK32国际比对的测量值.这些数据与国际比对参照值[7]符合得很好,其平均不确定度为2.5%.CCQM-K32国际比对有包括中国在内的美、英、德、日等9个国家参加,所用测量技术包括XPS,椭圆光度,X射线反射和中子反射等.我们在参加国际比对时采用了Seah等[5-6]提出的硅晶片上超薄氧化硅层厚度测量的XPS方法.该方法首先记录二氧化硅和元素硅的Si 2p电子能谱,测量其Si 2p峰强度,并用谱峰拟合的方法得到中间氧化物(Si2O、SiO、Si2O3)的Si 2p峰强度,然后根据一系列改进的计算公式,计算超薄氧化硅层的厚度.表1中的每一个氧化硅厚度数据和Si 2p电子结合能数据都是6次重复测量的平均值,以保证数据准确可靠.采用了2峰拟合和5峰拟合两种方法所得到的Si 2p结合能数据一致.在分析Si(100)样品的数据时发现,在表1所列的厚度范围内,SiO2的结合能并非简单地随厚度增加而升高,当氧化硅厚度d<2 nm时(样品1-3)Si 2p结合能较低,其平均值为103.30 eV;当3 nm<d≤4 nm时(样品4-6)Si 2p结合能最高,其平均值为103.64 eV;当d>5 nm时(样品7至9)Si 2p结合能介于两者之间,其平均值为103.46 eV.每次测量都可得到重复的结果.Si(111)样品的Si 2p结合能与d的关系也符合此规律.例如,当d<2 nm时(样品10)Si 2p结合能最低(103.27 eV);当3 nm<d≤4 nm时(样品11)Si 2p结合能最高(103.60 eV);当d>5 nm时(样品12和13)Si 2p结合能介于两者之间(分别为103.47和103.45 eV).这说明硅晶片上超薄氧化硅膜的厚度纳米尺寸效应影响其Si 2p电子结合能.我们的实验结果不支持Si 2p结合能位移是由于界面存在结构不同的过渡区的解释[2],因为在界面的中间氧化硅层厚度仅为0.124-0.128 nm[8].我们的结果也不支持表面荷电解释[3],因为它不能解释d>5 nm时SiO2的Si 2p结合能比3 nm<d≤4 nm的低这一现象.样品存在功函数差异的解释也难以成立.首先,在超薄(d<8 nm)范围内厚度不同的氧化硅样品是否存在可测量的功函数差异,特别是差异是多少,这尚不清楚.其次,即使存在功函数差异,它主要是对表面上价电子轨道有影响,而价电子轨道会以同样的方式影响氧化硅和元素硅的内层能级.在我们的测试中是以元素硅的Si 2p结合能为标准,测定同一条谱线中的氧化硅的Si 2p结合能,所以功函数的影响也可以忽略.我们将其原因归结为不同纳米尺寸的氧化硅层光电离时具有不同的原子外弛豫效应.Koopman理论假设当一原子被光电离时其它轨道不发生弛豫,因此电子结合能等于用Hartree-Fock自洽场方法计算得到的轨道电子能量的负值.但实际上即使是孤立自由原子被光电离后,其内层空穴也将被较外围的轨道弛豫所屏蔽,即产生原子内弛豫.固体中的原子内层电子被光电离后,除发生原子内弛豫外还有额外的终态弛豫,即原子外弛豫,它来自相邻原子的极化作用或电荷转移,其结果是使实测结合能值降低.原子内弛豫效应较少受该原子环境的影响,但原子外弛豫能的大小与原子环境紧密相关.金属和半导体的原子光电离后周围原子的电荷或导带电子很容易向带正电的空穴移动,所以弛豫能强.氧化物是绝缘体,没有可以自由移动的电子态,其原子外弛豫通过相邻原子上的电荷极化来完成.纳米颗粒只有较少的相邻原子贡献于弛豫,所以原子外弛豫能比相应的体材料小,测得的结合能较高,这在文献中已有报道[9-10].本文的研究结果则进一步表明,除纳米颗粒外,硅晶片上一维调制的超薄氧化硅膜中的原子被光电离后同样存在膜厚纳米尺寸效应引起的结合能位移,对于氧化硅厚度d<2 nm的SiO2/Si样品而言,与SiO2光电离同时发生的原子外弛豫既来自周围SiO2的原子极化,也来自SiO2-Si界面处衬底元素Si的电荷转移,即总的原子外弛豫能()为两部分之和:

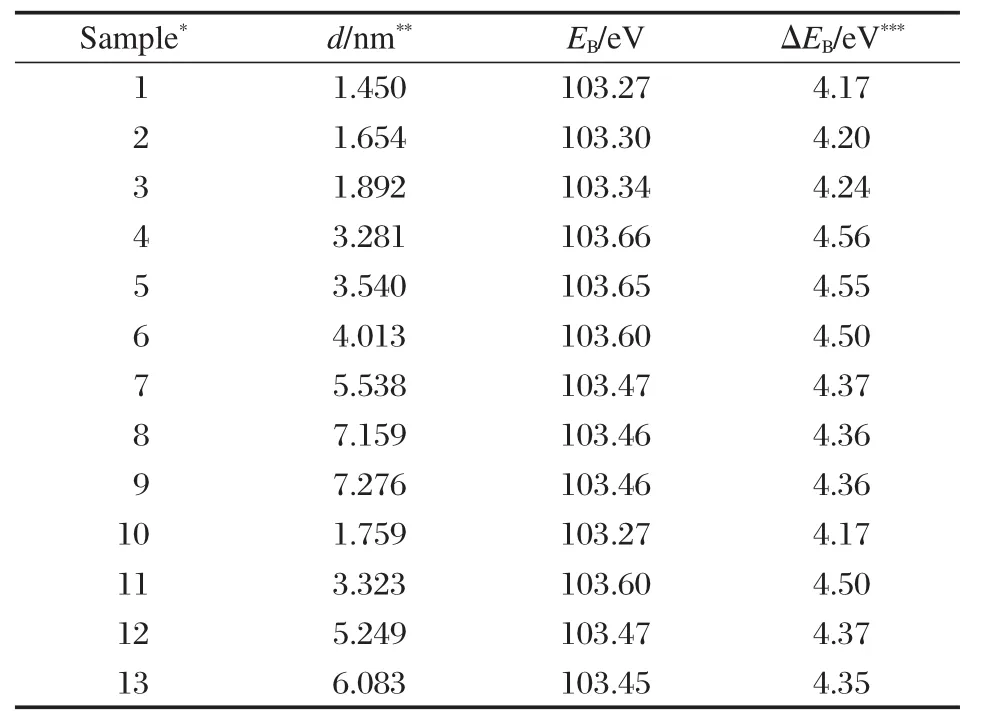
表1 硅晶片上超薄SiO2层的Si 2p电子结合能(EB)Table 1 Si 2p binding energy(EB)of ultrathin SiO2on Si substrate

但是,对于d>3 nm的SiO2/Si样品,光电离后的原子外弛豫效应只来自相邻原子的极化效应:(SiO2).前面已提及,半导体Si的弛豫能要比绝缘体SiO2的大得多,对后者而言,SiO2膜较厚的SiO2/Si样品有较多的相邻原子贡献于极化,所以弛豫能比膜较薄时要大,为此对于表1中的样品,原子外弛豫能的大小次序为:

由于原子外弛豫能越大则测得的结合能越低,所以正如表1中所显示,测得的Si 2p电子结合能高低顺序为

另一有意义的结果是,根据表1的结合能测量值,还可以估算出SiO2-Si界面处SiO2被光电离时来自衬底Si的弛豫有效影响距离(即屏蔽距离).从样品1至样品3,SiO2厚度从1.450 nm增至1.892 nm,Si 2p结合能增加0.07 eV,这一方面反映了随着膜厚增加所受到的Si的屏蔽效应在减弱,另一方面也表明此厚度范围仍在Si的屏蔽距离之内.但是当d=3.281 nm时,Si 2p结合能迅速上升至103.66 eV,此后d增大结合能不再增加,反而略有减小.这说明此时已超出衬底硅的屏蔽距离,所以当SiO2被光电离时,来自衬底Si的电荷移动对空穴进行屏蔽的有效距离应介于3.281 nm和1.892 nm之间,即(2.5±0.6)nm.这虽然是近似值,但它是建立在对一系列SiO2层厚度准确已知的SiO2/Si样品的Si 2p结合能进行精确测量的基础之上的,是来自实验结果的合理推算.鉴于SiO2-Si界面在硅基电子技术中的重要作用,在界面处屏蔽距离的估算对于更深入地理解界面处发生的光电相互作用等是有意义的.

2.2 硅晶片上超薄氧化硅层厚度纳米尺寸效应对价带谱的影响
图3显示了Si(100)晶片上超薄氧化硅样品的价带谱.位于2.5 eV处的谱峰来自衬底Si的3p电子;位于5-10 eV处的峰对应于SiO2的O 2p非成键电子;10-17.5 eV处的两个峰分别对应于O 2p—Si 3p和O 2p—Si 3s的成键电子价带.从图3可以清楚地看出,样品1的衬底Si 3p价带峰最强,随着氧化硅层增厚,该峰逐渐减弱,至样品8时该峰已基本消失.SiO2价带谱中O 2p—Si 3p和O 2p—Si 3s成键电子峰的强度则随氧化硅厚度增加而增强.更重要的结果是,当氧化硅层厚度d<2 nm时,SiO2价带谱中O 2p非成键电子峰的相对强度(与其成键电子峰比较)要强得多,SiO2的成键电子对价带强度的贡献较弱.这些实验结果是超薄SiO2存在纳米尺寸效应的新的例证.d<2 nm时SiO2成键电子峰较弱和O 2p非成键电子峰相对较强的原因可归结于此时SiO2薄膜中处于表面的原子比例大大增加,这些表面原子的配位数较少,配位不饱和导致大量表面悬键,从而导致SiO2成键电子价带较弱和O 2p非成键电子峰的相对强度较强.
3 结 论
硅晶片上超薄SiO2膜的Si 2p电子结合能存在膜厚纳米尺寸效应引起的结合能位移,位移值并非简单地随膜厚增加而增大.对于膜厚d<2 nm的SiO2/Si样品,这种位移归因于衬底Si的电荷移动对光电离空穴的屏蔽和SiO2中的原子极化对空穴的原子外弛豫,因而Si 2p结合能最低,其中衬底Si的屏蔽距离约为(2.5±0.6)nm;对于d>3 nm的样品,这种位移的原因只来自SiO2中的原子外弛豫,SiO2厚度较小者的Si 2p结合能较高.SiO2膜的价带电子结构也与其膜厚纳米尺寸有关,来自Si衬底的Si 3p电子峰强度随SiO2厚度增加而减弱,O 2p—Si 3p和O 2p—Si 3s成键电子峰的强度则随SiO2厚度增加而增强.当d<2 nm时价带中SiO2的O 2p非成键电子峰的相对强度较强,成键电子峰较弱.
1 International Technology Roadmap for Semiconductors(2001 edtion).http://public.itrs.net/
2 Grunthaner,F.J.;Grunthaner,P.J.;Vasquez,R.P.;Lewis,B.F.;Maserjian,S.Phys.Rev.Lett.,1979,43(22):1683
3 Tao,Y.;Lu,Z.H.;Graham,M.J.;Tay,S.P.J.Vac.Sci.Technol.B,1994,12(4):2500
4 Zhang,K.Z.;Greeley,J.N.;Banaszak,H.;Mark,M.;McFeely,F.R.J.Appl.Phys.,1997,82(5):2298
5 Seah,M.P.;Spencer,S.J.Surf.Interface Anal.,2002,33(8):640
6 Seah,M.P.;Spencer,S.J.Surf.Interface Anal.,2003,35(6):515
7 Seah,M.P.CCQM-K32 key comparison and P84 pilot study amount of silicon oxide as a thickness of SiO2on Si.NPL Report AS 27,NPL,Teddington,UK,2008
8 Seah,M.P.;Spencer,S.J.;Bensebaa,F.;Vickridge,I.;Danzebrink,H.;Krumrey,M.;Gross,T.;Oesterle,W.;Wendler,E.;Rheinlander,B.;Azuma,Y.;Kojima,I.;Suzuki,N.;Suzuki,M.;Tanuma,S.;Moon,D.W.;Lee,H.J.;Cho,H.M.;Chen,H.Y.;Wee,A.T.S.;Osipowicz,T.;Pan,J.S.;Jordaan,W.A.;Hauert,R.;Klotz,U.;van der Marel,C.;Verheijen,M.;Tarnminga,Y.;Jeynes,C.;Bailey,P.;Biswas,S.;Falke,U.;Nguyen,N.V.;Chandler-Horowitz,D.;Ehrstein,J.R.;Muller,D.;Dura,J.A.Surf.Interface Anal.,2004,36(9):1269
9 Fu,X.Y.;Wang,Y.;Wu,N.Z.;Gui,L.L.;Tang,Y.Q.J.Colloid Interface Sci.,2001,243(2):326
10 Zhao,Z.J.;Liu,F.;Qiu,L.M.;Zhao,L.Z.;Yan,S.K.Acta Phys.-Chim.Sin.,2008,24(9):1685 [赵志娟,刘 芬,邱丽美,赵良仲,闫寿科.物理化学学报,2008,24(9):1685]
XPS Study of the Thickness Nanosize Effect for Ultrathin SiO2on Si Substrate
ZHAO Zhi-Juan LIU Fen*ZHAO Liang-Zhong
(Institute of Chemistry,Chinese Academy of Sciences,Beijing 100190,P.R.China)
O647
Received:April 27,2010;Revised:August 2,2010;Published on Web:September 17,2010.
*Corresponding author.Email:fenliu@iccas.ac.cn;Tel:+86-10-62553516.
The project was supported by the Special Research Foundation of Commonweal Profession for Quality Inspection,China(200710199).
质检公益性行业科研专项项目(200710199)资助
