基于MCU主控芯片的热学可靠性与失效分析研究*
2021-10-09闫辰侃张凯虹
王 敦 闫辰侃 张凯虹
(中国电子科技集团公司第58研究所 无锡 214035)
1 引言
近年来,集成电路技术的发展迅速,随着多功能、高频和高功耗的芯片需求不断增加,芯片可靠性要求也越来越高,芯片主要失效形式之一是热失效,随着环境温度增加,芯片内部热量不能及时传递出去,这就会造成热量在芯片Die附近积累,温度升高,结点温度的升高会使晶体管的电流放大倍数迅速增加,导致集电极电流增加,最终导致元件失效[1~3]。据统计,温度过高引起微电子器件失效的几率高达50%以上[4]。不断增大的功率密度使得封装设计中的热设计工作越来越受到重视。其中热学物理模型计算以及测定芯片热场分布成为了半导体器件可靠性设计和失效分析的重要环节[5]。
本文基于国产和进口MCU芯片,通过建立热阻网路模型仿真,并利用电学法进行验证,系统分析了MCU芯片内部温度场分布及热阻变化,并基于红外摄像仪和SAM超声设备分析了热阻仿真与测试偏差的主要原因,为MCU芯片热学可靠性分析奠定理论与测试基础。为MCU热学设计和测试,提高可靠性和失效分析水平提供了理论基础。
2 物理模型建立与分析
2.1 MCU芯片有限元模型建立
对于MCU芯片,散热设计主要考虑两个热性能参数氧化物结点区的工作温度(简称结温)TJ和热阻Rth。热阻代表了物体散热的能力,芯片上的散热方式主要是热传导,如图1所示MCU芯片热传输模型(上图),热量通过芯片烧结材料传递到外壳或者芯片基底,并进一步传递到周围的环境。可根据MCU芯片的结构建立热阻网络模型,如图1所示MCU芯片热阻网路模型(下图)。MCU芯片的总热阻为Rth=R1+R2+R3+R4。
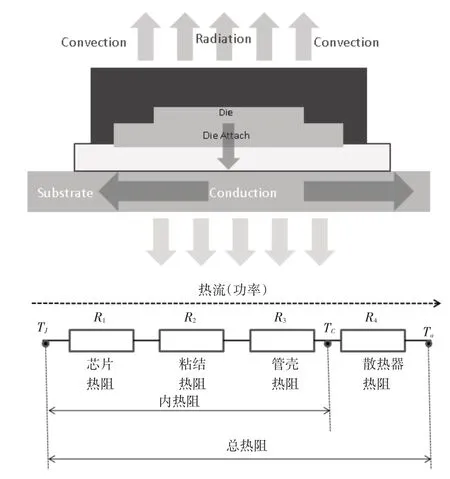
图1 MCU芯片热传输模型(上)及热阻网路计算图(下)
采用ANSYS有限元分析软件进行有限元实体模型计算,主要仿真模拟流程包括物理模型建立、参数设置、网格划分、模拟计算以及结果优化。最重要的是网格划分方法的选择,本文采用六面体主体法网格划分[6]。本方法用于控制几何体表面生成六面体网格,几何体内部生成四面体或锥形网格。对各部分采用不同的网格大小以控制合适的网格密度。网格划分结果如图2所示,国产和进口MCU芯片采用相同的网格划分方法,利用单元质量、单元纵横比、雅可比比率和倾斜度等参数评估网格质量[7]。

图2 网格划分图
2.2 MCU芯片热学仿真结果与分析
图3温度场分布模拟图可以得出芯片内部具体温度,结果如表1,在环温35℃下,可以看出国产和进口MCU芯片的2D梯度热场分布区别,国产芯片结温最大值TJ为58.2℃,进口芯片结温最大值TJ为52.0℃,国产和进口芯片结温和热阻值接近,两种芯片内部结构基本相同,主要区别在于芯片功耗和封装的不同。由于曲线为典型的反S型曲线,固采用Logistic函数非线性回归,进行定量分析。经回归分析得到的函数为[8]

图3 2D热场梯度分布图

表1 国产和进口MCU温度场模拟结果
MCU芯片的温度t-距离x曲线回归结果:

同时,由于仿真模型以及参数设置不同,一般仿真结果会存在10%左右公差[9]。
3 测试与验证
热阻是反映器件散热能力的重要参数,热阻大则表明该器件散热不佳;热阻小,则表明该器件散热效果良好[10]。热阻测试主要参照的标准有国军标GJB548B、国标GBT14862、美军标MIL-STD 883J,主要测试方法有两种,分别是直接测试法和间接测试法:1)直接测量结温以确定Rth(J-R)。采用红外热辐射仪直接测量半导体芯片内部芯片的结温,应去掉封闭壳体的帽或顶盖,以暴露有源芯片或器件;2)间接测量结温以确定Rth(J-R),给出了典型的测试结温的电路,包括有源器件的P-N结电压测试方法和集成电路的衬底体二极管测试结温方法[11]。本文主要采用间接测量电学法,测试结果见表2,测试热阻最重要的是测试K值,可以建立结温与电压之间的关系。K=(THi-TLo)/(VHi-VLo),THi和TLo分别是测试温度最大和最小值,VHi和VLo分别是测试最大电压和最小电压值[12],P-N结电压受结温和正向电流两个因素影响。K系数热阻测量值如图4,可以根据K系数测试拟合曲线得出,在输入测试电流1mA下,正向压降与结温呈线性关系[13],其中国产K值为-2.1028,进口K值为-1.3431。

表2 结-壳热阻(θJC)测试结果比较

图4 国产与进口MCU芯片热阻测试及K系数测试拟合曲线
结壳热阻Rth=(TJ-TC)/P。其中TJ为结温,TC为壳温,P为输入功率。TJ可以通过电学法测试得到[14]。在对芯片热阻测试的过程中,可以得到器件的温度随时间变化的关系曲线,通过对该曲线进行一系列数学推理可以得出结构函数,见图5,国产样件结壳热阻值基本与仿真相似,均值在5.12℃/W。进口样件结壳热阻值偏大,均值在12.57℃/W,大约是模拟值的两倍。影响热阻的因素很多,主要是芯片内部结构加工工艺存在公差所致。同时,可以将国产样件与进口样件结构函数进行比较,结构函数曲线是反映半导体器件热容与热阻关系的曲线,正常器件与失效器件的结构函数曲线会在失效部位发生分离,因而通过分析结构函数曲线的走向及分离点,可以确认器件的失效位置,提前对芯片内部结构失效或不良做出判断,进而可以筛选出失效或不良器件,这也是这项工作的主要目的[15]。下面通过超声扫描和连续稳态显微红外测温技术,进一步对芯片内部进行分析。

图5 国产和进口MCU芯片热阻与结构函数测试结果
4 失效分析
结合国产和进口MCU芯片热阻设计与测试验证,可以确定芯片失效模式,为了进一步确认进口芯片样件热阻偏大的原因,了解芯片内部具体热分布情况,结合超声扫描和连续稳态显微红外测温技术,对进口芯片热阻值偏差进行分析。由图6超声SAM扫描测试结果所示,进口芯片内部基板发生分层,导致热传输受到阻碍,导致接触电阻过大和散热性能差,引起器件电学参数的漂移,使得热阻值增大。这将会严重影响着器件的质量,降低器件的可靠性[16]。同时,我们采用连续稳态显微红外测温技术对器件在连续加电压的过程中,对DIE表面温度场分布进行采集,由图7可以看出,在环境温度35℃下,DIE表面边缘出现红色高温区域,最高温度65℃左右。综合分析,热阻失效要归因于芯片基板分层,导致热传输途径受阻碍,降低了器件的热可靠性。
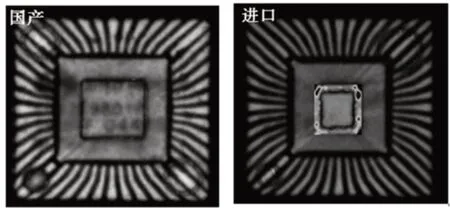
图6 国产和进口MCU芯片SAM超声扫描测试结果

图7 进口MCU芯片红外摄像仪测试结果
5 结语
本文基于国产和进口MCU芯片进行研究,探讨了热学可靠性设计与测试的方法。系统地研究了MCU芯片的热学特性及热学参数的原理。并基于红外摄像仪Infra-scope和SAM超声设备分析了热阻仿真与测试偏差的主要原因,为MCU芯片热学可靠性设计及测试提供了一定的参考依据。
