先进封装关键工艺设备面临的机遇和挑战
2012-06-28王志越高尚通
王志越,易 辉,高尚通
(北京中电科电子装备有限公司,北京100176)
集成电路先进封装主要指以BGA、CSP和WLP为代表的面阵列封装、以及MCM、3D封装和SiP。先进封装源自常规封装,先进封装是常规封装发展的必然。常规封装主要是用引线框架承载芯片的封装形式,而先进封装引脚以面阵列引出,承载芯片大都采用高性能多层基板。常规封装有四大功能,即芯片机械支撑和环境保护、接通电源、引出信号线和接地线、以及芯片热通路。先进封装在这四大功能的基础上,更肩负了提高芯片规模、扩展芯片功能和提高可靠性的作用,做硅集成电路完全做不到的各种电路集成。可以说,先进封装和组装的作用正在向系统集成方向迅速发展与扩张,在传统的摩尔定律实施越来越困难时,封装与组装的创新可以缓解和解决这个难题,先进封装可以解决超越摩尔的问题。
国际上,在20世纪末和21世纪初集成电路封装测试领域已经完成常规封装向先进封装的转变,我国封装测试行业最近4年才开始向先进封装发展,如 WLP/CSP、FC、BGA、aQFN、MCM 和3D封装/SiP等。“十一五”国家重大科技Θ项推动我国先进封装迅速发展。这一转变激发了我国计算机、无线通讯、互联网和手机为代表的消费类产品的爆炸性增长,从而带动了集成电路的一路上扬。这给集成电路封装乃至封装设备带来极好的市场机遇,同时封装设备也遇到了前所未有的严峻挑战。
先进封装是前道芯片工艺不断发展和扩展的产物。先进封装把芯片物化成可以使用的集成电路,而封装设备是实现各种封装的必不可少的手段。先进封装的发展对封装工艺设备不断提出越来越高的要求。有的先进封装工艺需要全新的封装设备,必须尽快研发;有的先进封装工艺需要在原有的设备上进行改进和优化,增加新的功能;有的先进封装工艺需要几种原有的设备功能集成为一个整体设备。可以说,先进封装工艺设备面临的机遇是空前的,挑战也是空前的。
1 先进封装工艺设备
因为先进封装的种类繁多,每种先进封装的工艺流程都不尽相同,所采用的设备也各种各样。我们不妨把各种先进封装工艺分成三段:第一段:晶圆级工艺;第二段:芯片级封装工艺;第三段:塑料封装工艺及以后。然后,把每一段分解出主要的共性工艺技术,再理出每种共性技术所需要的设备。最后,我们对最关键的几种设备进行分析,来论述先进封装设备的挑战问题。
1.1 晶圆级工艺及其封装设备
第一段:晶圆级工艺。在这一工艺段,所有的工艺加工都是在晶圆上进行的,无论是150 mm、200 mm还是300 mm的晶圆。目前发展最为迅速的是WLP。WLP的关键技术包括:重新布线技术、凸点制造技术、硅通孔互连技术、扇出技术、以及晶圆减薄技术和晶圆划片技术。其它先进封装形式如BGA、CSP、3D封装和SiP所涉及的晶圆工艺主要是晶圆减薄技术和晶圆划片技术。这段工艺所需要的设备如表1所述。

表1 先进封装晶圆级工艺所需设备
1.2 芯片级封装工艺及其封装设备
第二段:芯片级封装工艺。在这一工艺段,主要在芯片级进行加工。首先,把芯片从晶圆上取下,安装到引线框架、多层基板或载体上,这是装片工艺,使用装片机(DB)。然后用引线键合或倒装芯片方法完成芯片上焊盘和引线框架、多层基板或载体上引脚的连接。这是键合工艺,使用引线键合机或倒装芯片键合机。第二段工艺所需的主要设备如表2。
1.3 塑封工艺及其封装设备
第三段:塑封工艺技术(含塑封及后序工艺)。这段工艺主要把安装好和键合好的芯片用塑封料进行包封,然后再固化、打印、切割、测试、编带包装等工艺过程。这段工艺的设备示于表3。
2 关键封装工艺设备的机遇与挑战
通过表1可见,对于WLP/CSP的封装设备,除了倒装芯片键合机、回流焊炉、印刷机、电镀线、植球机以及晶圆减薄机、晶圆划片机以外,其余的设备基本上都是半导体薄膜工艺设备,在本文中不作叙述。在表1至表3中,我们选择通用性好、技术性强、用途广和权重高的封装设备作为我们的重点分析对象。这些封装设备包括:晶圆减薄机、晶圆划片机、倒装芯片键合机、引线键合机、装片机、切割机和aQFN(先进QFN或多圈QFN)塑封设备等。

表2 先进封装芯片级封装工艺所需要的主要设备

表3 塑封工艺及后序所需要的主要设备
2.1 晶圆减薄机面临的挑战
其实,晶圆减薄工艺一直存在,只不过随着先进封装尤其3D封装的要求越来越苛刻,所以才变得越来越重要。国际上,把芯片和晶圆的厚度分为3个等级:常规的厚芯片和晶圆:300~1000 μm;薄芯片和晶圆:100~300 μm;超薄芯片和晶圆:50~100 μm及以下。超薄芯片和晶圆又分为三级,即 50~100 μm;10~50 μm 和小于 10 μm。晶圆减薄目前应用需减薄到大约50 μm,而在将来需减薄到约25 μm以下。
为什么需要薄芯片和晶圆,主要目的在于减小形状因子、提高封装密度、减小热阻、提高柔性和可靠性,以及提高成品率。然而,厚度越小,对晶圆减薄机提出的要求越高。如薄晶圆的传输、对准、夹持问题、晶圆的内应力问题、晶圆的粗糙度问题,以及晶圆的测试问题。薄晶圆的传输、对准、夹持问题涉及设备的机械手,晶圆的内应力问题涉及去除应力加工,晶圆的粗糙度问题涉及到晶圆的精抛精磨等等。晶圆减薄机的挑战示于表4。国际国内晶圆减薄机的生产水平已达到300 mm晶圆,厚度 50 μm。

表4 晶圆减薄机的指标与挑战
2.2 晶圆划片机面临的挑战
晶圆划片机的目的是基本无损地把整个晶圆划切成单个的集成电路芯片,然后才能进行装片和引线键合等工艺。由于划片的对象是成本昂贵的晶圆,设备必须具有高精度和高可靠性。晶圆划片机的挑战主要有以下几方面:
(1)晶圆直径已经从150 mm、200 mm增加到300 mm,而集成度越来越高,芯片尺寸越来越小,切割道宽度也不断缩小,从 75 μm、65 μm、50 μm到目前的30 μm。这已经到了机械式砂轮划片的极限领域。
(2)先进3D叠层封装要求晶圆及芯片的厚度越来越薄,甚至到了50 μm以下。超薄晶圆对机械应力和热应力都非常敏感,要求划片过程应力残留越小越好。
(3)低K介质层、铜互联材料的多孔网状结构容易碎裂,金属材料对金刚石砂轮刃具具有极强的黏粘性,必须寻找新的划切方法。
(4)化合物半导体材料(GaAs、InP)和第三代半导体材料(SiC、GaN和金刚石)的应用越来越广泛,这些高硬度材料的划切无论是对设备还是刃具都提出了新的要求。
尽管基本的机械划片方式至今并没有发生根本性的变化,但是,以上这些挑战不得不让设备厂家探索新的划切方法。瑞士Synova公司研制了微水柱导引激光划片设备,微水导激光划片工艺技术应运而生。另外纯粹的激光划切技术也已有应用。
先进封装给晶圆划片机带来的挑战性技术指标示于表5。

表5 晶圆划片机的指标与挑战
2.3 倒装芯片键合机面临的挑战
倒装芯片键合工艺旨在完成封装内部芯片与基板之间的面阵列凸点互连,是先进封装工艺的核心组成部分。与传统的引线键合相比,倒装芯片键合形成的电气连接路径更短、横截面积更大,因而电阻和电感更小并且导热性更好,同时倒装芯片面阵列凸点能够提供更多的输入输出管脚。这些特性使倒装芯片尤其适合具有高频输入输出信号和大管脚数的高功率集成电路封装。倒装芯片是芯片上所有焊盘同时完成互连的并行工艺,相对于逐一形成焊盘键合的引线键合,效率更高,且形状因子更小。高密度倒装芯片键合机已经成为CPU等高端多管脚封装工艺的核心设备。正因为这些高的性能和优势,使倒装芯片键合机得到不可替代的越来越广泛的应用,从晶圆级封装(WLP扇出技术、再造晶圆、C2W和W2W等)、芯片级封装 (FCIP:FCBGA、C2C等)到MCM、3D和SiP(FCOB)都有它的重要位置和作用。过去,主要是成本的原因,限制了FC的发展。最近几年,当FCOB不断增长数量之时,FCIP也迅速的膨胀。FCIP主要用于消费类产品、通信装备(基站和网络系统)、计算机系统和无线通信如手机。FC在两个领域膨胀,一个驱动来自微处理器、ASIC和高端DSP的高性能需要,另一个驱动来自形状因子。目前,已经形成倒装芯片键合机应用的兴旺时期。现在,国际上封装产业界,倒装芯片键合机的应用水平为300 mm晶圆,倒装节距150 μm,倒装凸点数25 000(芯片尺寸20 mm×20 mm,有25 000只凸点,使用FCBGA封装)。
倒装芯片键合机面临的挑战主要有如下几个方面:
(1)多自由度精密对准技术。位置精度±10 μm,旋转精度±0.5,具备自动完成芯片与基板调平的能力。
(2)倒装芯片—基板凸点对准技术。放大倍率2倍到10倍,分辨率小于3 μm。
(3)芯片缺陷识别视觉算法。能够快速(识别时间<10 ms)、准确地识别芯片的崩边、裂纹、桥连、墨点等缺陷。
(4)键合头加热技术。室温到350℃快速加热,加热面积0.25 mm×0.25 mm~25.4 mm×25.4 mm,温度均匀性±2℃。
(5)精密助焊剂涂敷技术。助焊剂厚度误差±3 μm,助焊剂涂敷准确率98%,助焊剂涂敷速度每芯片100 ms。
高密度倒装芯片键合机面临的挑战示于表6。

表6 高密度倒装芯片键合机的指标与挑战
2.4 装片机(Die Bonder)面临的挑战
装片机(Die Bonder)是集成电路(IC)、功率IC、晶体管等产品的后道封装设备,用于将芯片从晶圆蓝膜上取出连接到框架(LEADFRAM)或基板上。装片机主流机器都采用全自动上下料,将自动识别、自动点胶、工作平台自动到位、自动装载芯片集成在一起,形成高度自动化设备。
装片机涉及到精密机械、自动控制、精密光学、计算机应用、气动技术、系统工程学等诸多学科领域。实现从上料、点胶、装片到下料的全自动化,便可以保证产品质量和生产效率。而自动化、智能化、系统化、光机电气等多学科技术集成是装片机的主要特点及发展趋势。装片机主要面临的挑战有以下几个方面:
(1)框架的自动上、下料与精密进给和定位、基板厚度检测功能及基板次品检测功能。
(2)高速运动下多模式涂胶过程中点胶量的精确定量控制,实现点胶量一致性达到99%以上。
(3)间歇式高速运动下大尺寸晶圆盘的可靠夹持以及微进给伺服运动控制;高加速运动下大惯量承载平台的精密定位。
(4)抑制高速运动下贴装头的振动保持平稳,以及高速运动过程中芯片和引线框架之间X-Y-Z-θ四个姿态的高精度对准。
(5)高速运动(≥13K UPH)工况下的精密定位,对视觉定位系统硬件和光路系统提出了挑战。同时,高速运动产生的振动带来的图像模糊以及复杂工况下图像信息缺失亦对图像高速图像处理提出了挑战。装片机的技术参数与挑战见表7。

表7 装片机的指标与挑战
2.5 引线键合机面临的挑战
引线键合机是连接半导体芯片与外部器件的一道工艺,在超声波和热压的同时作用下完成该过程。现在铜线键合的应用也越来越广泛。目前尽管也有一些其他的连接方法,如倒装芯片键合技术(FC)和载带自动焊技术(TAB)等,引线键合由于适应性强,成本低和可靠性高仍然是现在最流行的封装方法,占整个封装形式的70%左右,在先进封装中仍有广泛的应用。而全自动引线键合机在整个后道封装工艺中,所占的设备数量比例,以及投资比例基本上都是最高的。
引线键合机面临的挑战主要表现在以下几方面:
(1)一些关键单元和技术市场上买不到,必须自行开发和生产,包括直线电机、音圈电机和螺旋管,高精密、高加速xy平台,高精密、高加速键合头,工作夹持台,高精度、高抗振图像识别系统,控制器,断线检测系统,实时运动控制,键合力控制和系统软件等。
(2)三维空间中的复杂高速运动是设备的基本特征。xy方向,15 ms内完成2.54 mm点到点运动并且趋稳至±1.5 μm范围内,跟随误差±5 μm以内;z方向,7 ms内完成8 mm点到点运动,过调小于3 μm,运动结束时跟随误差小于8 μm,运动结束之后4 ms内趋稳至±2 μm范围内,等等。技术参数具有很大的挑战性。
(3)高效精密机器视觉系统参数十分严格,模板匹配时间小于18 ms;位置精度小于1/20像素;旋转精度小于2,等。准确高效的机器视觉定位和对准是设备的基础和精度效率的重要保证。
(4)在各项技术指标全部合格的前提下,必须实现低成本,才能适应产业化的使用要求。
(5)既要满足各种规格金线的要求,还要满足各种规格铜线的要求,以求进一步降低封装的成本。
引线键合机面临的挑战示于表8。
2.6 QFN和aQFN切割机面临的挑战
QFN(无引脚方形扁平封装)是一种体积小、性能高和低成本的小型封装。aQFN与传统QFN的不同处在于过去QFN的排数约1~2排,脚数在100支以下,而aQFN是在3排以上,脚数可以增加到100~400支脚。此外,aQFN的封装面积较小、厚度也较薄,同时可以配合客户设计,随意布置引脚;aQFN电和热性能很好,成本也较低,是一种高密度、高性能和低成本的先进封装,可以取代低端的BGA如FBGA等。目前消费类和通讯类是主要采用aQFN的领域,在通讯方面,基频、电源管理IC、RF、无线网络、WiFi和开关控制芯片等都有客户采用多排QFN;至于消费性领域的数字电视芯片、译码器、DVD控制芯片、数据储存控制芯片、STB译码器、数字相机控制IC等皆有产品采用多排QFN。最近几年,aQFN的市场需求迅速增长。这个市场的发展促进了QFN切割机和非对称塑封自动压机(见下第2.7小节)的需求增长。

表8 引线键合机的指标与挑战
QFN和aQFN切割机主要用于把封装好的多列QFN和aQFN分成合格的成品,是QFN类产品的专用设备,也可用于多层印制板等材料的切割。
QFN和aQFN切割机面临的挑战主要有以下几方面。
(1)自动传输定位技术,其定位精度、传输速度和可靠性直接影响到切割效率和质量。
(2)自动识别对准技术,由于QFN和aQFN的特殊性,设备需要在XY方向的切割道上和角度上频繁调整,对识别和对准精度要求很高。
(3)切割材料不是单一材料,而是塑封料和黏粘的铜材料,而且切割整体翘曲的程度也有区别,也给切割带来一定的难度。
QFN切割机主要技术参数和挑战示于表9。
2.7 aQFN非对称塑封全自动压机面临的挑战
上一节提到,QFN和aQFN的市场迅速增长,促进了非对称全自动压机的迅速发展。这种压机是专门用于QFN和aQFN的塑料封装的。与常规封装不同的是,一方面引线框架不是位于塑封料的中间,而是位于塑封料的底部,即所谓的非对称;另一方面塑封料型腔底部不是模具,而是高温膜和引线框架贴合在一起组成。因此,这种设备面临的挑战是显而易见的。
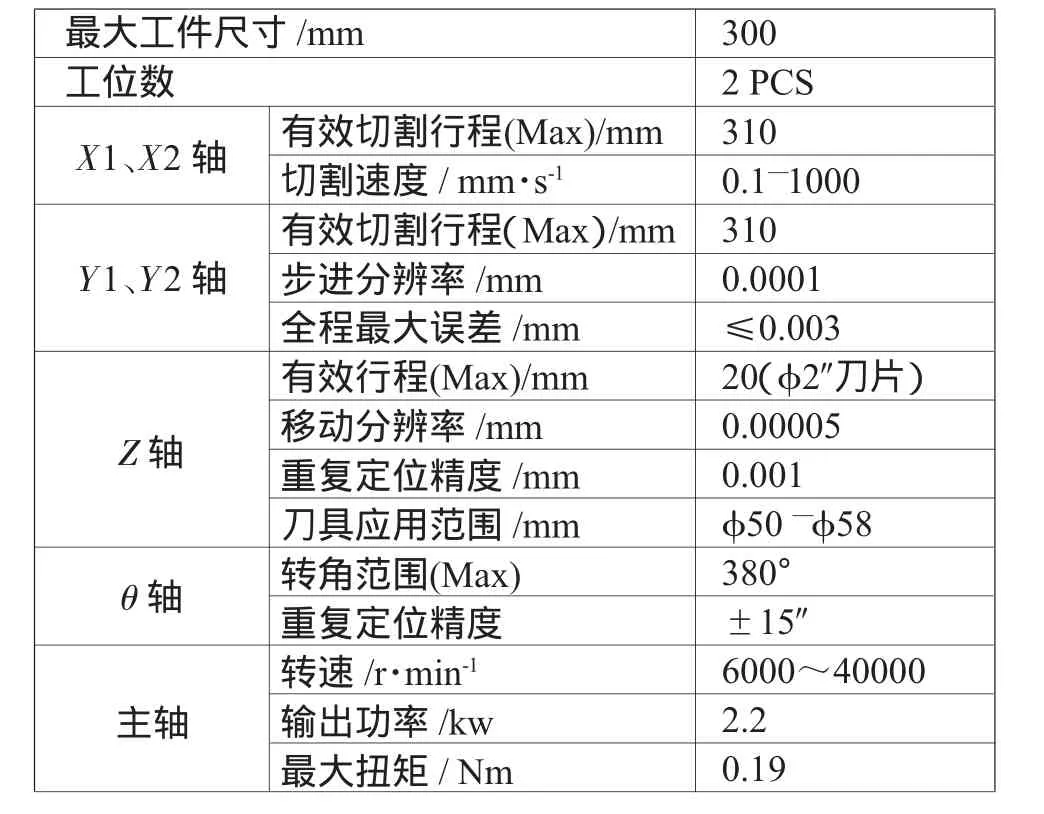
表9 QFN和aQFN切割机主要技术参数和挑战
(1)在高温膜和引线框架之间,很容易出溢料而变成废品,大大影响成品率,提高成本。
(2)塑封完成后,需要撕去高温膜,然后电镀,但由于引线框架上存有残胶,去残胶是件很麻烦的工作,搞不好影响电镀质量。尽管采用镀钯框架后得到缓和,但仍存在残胶问题。
(3)由于是非对称式塑封,因此塑封后很容易翘曲,这给后序工艺带来困难。
(4)这类设备至今还垄断在外国公司手中,如果我国希望开发自己的设备,应该早作准备,下力气尽快解决,因为市场是变化的。
aQFN非对称塑封全自动压机的技术参数和挑战示于表10和表11。
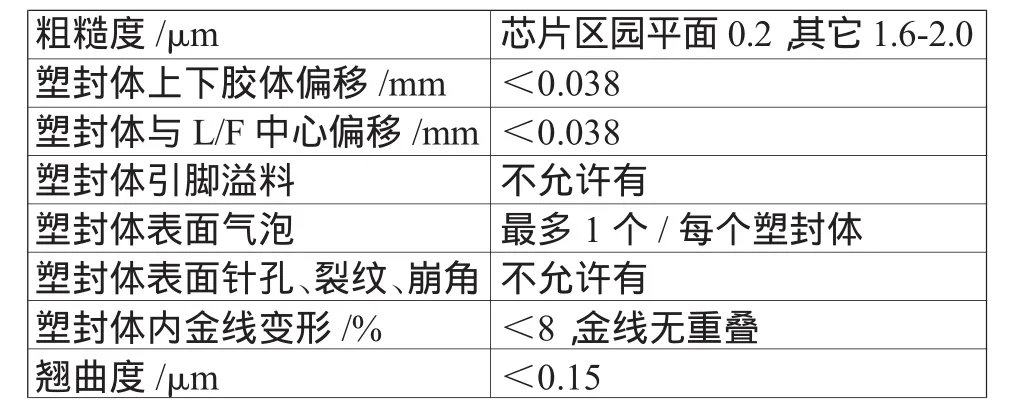
表10 、aQFN非对称塑封全自动压机的塑封产品技术指标和挑战

表11 、aQFN非对称塑封全自动压机的技术指标和挑战
3 小 结
综上所述,先进封装所使用的工艺设备具有一定的共性特点:即集光、机、电、软件为一体的高精度、高速度、自动化程度高的精密设备,同时也在向模块化、智能化、一体化发展。目前,正是发展先进封装关键工艺设备的大好时机,设备企业应加大研发和产业化力度,以适应先进封装新的市场要求,迎接我国封装测试产业新的机遇和挑战。
[1]高尚通.先进封装技术的发展与机遇[J].中国集成电路,2006(10):47-52.
