芯片制造过程中的电化学侵蚀控制
2010-05-31聂圆燕郭晶磊陈海峰
聂圆燕,郭晶磊,陈海峰
(中国电子科技集团公司第58研究所,无锡 214035)
1 引言
后端布线工艺镜检经常发现一些双金属电路圆片的PAD孔(Bond pad,键合孔)上有圆圈状的异常物(如图1),且圈状异常物只在PAD孔上有,金属条上从未出现过。在线圆片跟踪调查发现该圈状物是在通孔腐蚀工艺后才出现的。另外还发现对于同一种电路,有些批次有圈状异常有些没有,说明该圈状异常是随机出现的,和电路种类没有特定的关系。初步怀疑圈状异物是因金属被侵蚀而产生的侵蚀坑。由于侵蚀坑会影响键合孔的质量,导致键合孔键合时粘附性不好等问题。因此在芯片制造过程中消除金属侵蚀坑非常重要。为了消除侵蚀坑,首先要知道引起圈状物异常的根本原因,从而找到彻底消除该问题的方法。
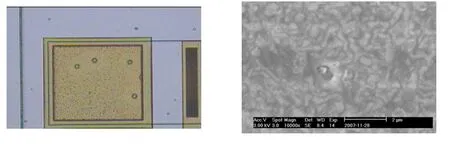
图1 芯片PAD孔上圈状物显微镜和SEM分析照片
2 实验及结果分析
分析流程后端工序在金属淀积工艺后,有三种工艺过程会对金属表面造成侵蚀从而形成侵蚀斑:通孔腐蚀后的过腐蚀工艺、EKC清洗工艺以及去离子水清洗工艺[1]。为了找到引起PAD孔上圈状异常的根本原因,设计了以下实验。
实验一:改变通孔腐蚀时过腐蚀工艺的时间。如果是过腐蚀工艺引起的侵蚀,增加过腐蚀工艺时间侵蚀应该更明显。
实验表明通孔腐蚀过腐蚀工艺不会引起侵蚀。

表1 改变过腐蚀工艺时间
实验二:EKC清洗工艺。取在线通孔报废的圆片做EKC清洗,EKC清洗后镜检没有发现圈状物,说明EKC清洗工艺也不会引起侵蚀。
实验三:去离子水清洗工艺。假设圆片在水中放置引起了电化学侵蚀,圆片在水中放置时间越长,反应产物应越明显。取金属淀积后的圆片快冲8次后在水中放置一段时间后再甩干,然后显微镜检查看圈状物情况并进行SEM分析。

实验结果说明金属淀积后的圆片在去离子水中放置时会产生侵蚀坑,且圆片在水中放置时间越长,电化学侵蚀越严重,侵蚀坑也越大。实验过程中还发现采用高温淀积的铝由于晶粒很大在水中长时间放置也不容易产生侵蚀。

图3 水中放置30min后侵蚀坑SEM分析照片(最长跨度达8 μm)
由以上实验说明,通孔腐蚀工艺后电路PAD孔上的侵蚀坑是由去离子水清洗工艺引起的。由于后端工艺设备中只有湿法清洗工艺是全手动操作的,不同操作人员的操作习惯不一样,这就解释了圈状物出现的随机性。研究资料表明去离子水清洗工艺时产生的金属侵蚀坑是由电化学腐蚀反应[4]引起的。
3 电化学腐蚀反应机理及理论模型[1-4]
电化学腐蚀也叫双金属腐蚀,即当两种不同的金属在水中或潮湿的环境下进行电接触时,就会发生电化学腐蚀。由定义可以看出电化学反应发生的两个必要条件:第一,两种不同的金属即金属间存在势差;第二,存在势差的两种金属有电接触,即两种金属放置在电解液中,只有当两个条件都满足,电化学腐蚀才会发生。当电化学反应对形成时,一种金属作为阳极被侵蚀得较快,另一种金属作为阴极被侵蚀得较慢。
在芯片制造过程中,金属铝常被用来作为金属互联。而为减小电迁移效应和控制金属的晶粒,通常在铝中加入铜,形成铝-铜合金(本室用来作为互连的金属为Al-1%Si-0.5%Cu)。然而在芯片加工过程中的去离子水清洗工艺时,PAD孔上的铝-铜晶胞可能会导致电化学腐蚀反应的发生。首先,由于铝-铜之间存在势差,满足条件一;其次,去离子水本身不是电解液,但是由于水(H2O)和溶解在水中的氧气(O2)之间会发生反应,产生具有侵蚀性的氢氧离子(OH-),使去离子水变成弱的电解液(满足条件二)。两个条件都成立,说明电化学腐蚀反应可能发生。
H2O和O2之间的反应如下:

PAD孔上的铝-铜晶胞间发生电化学腐蚀反应时,铝(Al)作为阳极被腐蚀得快而铜(Cu)作为阴极被腐蚀得慢。铝-铜晶胞发生电化学反应的理论模型如下:

在带负电荷的铝-铜晶核周围的铝离子将被侵蚀而产生氢氧化铝,化学反应式如下:

从以上理论模型中我们可以看出,发生电化学侵蚀后,铝被侵蚀而形成氢氧化铝Al(OH)3,当用去离子水对圆片进行冲水时,电化学侵蚀的反应产物氢氧化铝将被水冲走并在PAD孔上留下侵蚀斑。同时铝合金中的铜将会聚集在侵蚀坑的中间形成铝-铜晶核。电化学腐蚀反应的最初铝-铜晶核和周围的铝是连在一起的,当电化学反应继续发生时,铝-铜晶核最终将和周围的铝完全隔离。去离子水清洗快冲时铝-铜也有可能被水冲走。
由电化学腐蚀反应模型可得,要消除电化学腐蚀反应的发生可以从两个方面入手。首先由化学反应式(4),可以通过采用二氧化碳(CO2)鼓泡的方法抑制电化学反应生成物的产生[1];其次,将圆片放置在干燥的环境中即脱离电解液放置。
很多芯片加工厂因金属后湿法清洗设备带有二氧化碳(CO2)自动鼓泡装置,没有出现过类似问题。由于本室金属后清洗设备无法实现CO2自动鼓泡功能,只有通过采用严格控制操作的方式来消除电化学侵蚀。即在金属淀积后的湿法清洗操作时要求圆片冲水后立即甩干,通过减少圆片在水中的放置时间来控制电化学腐蚀反应的发生。采取该措施8个月内PAD孔上没有再出现侵蚀斑,至此由于湿法清洗工艺造成的电化学腐蚀问题已得到彻底的解决。
4 结论
芯片PAD孔上的圈状异常是由金属淀积后去离子清洗工艺时的电化学腐蚀引起的侵蚀斑,金属淀积后圆片在水中放置的时间越长侵蚀越严重。金属后湿法清洗设备带有二氧化碳(CO2)自动鼓泡装置时,可以从硬件上彻底消除由去离子清洗工艺引起的电化学侵蚀。在硬件条件无法满足的情况下,也可以通过严格控制湿法操作解决去离子水清洗的电化学侵蚀问题。
[1] Hua Younan, E. C. Low, L. H. An,et al.Failure Analysis and Elimination of Galvanic Corrosion on Bondpads during Wafer Sawing[C]. The proceedings from the 26h International Symposiumfor Testing and Failure Analysis,Nov 12-16 2000,Meydenbauer Convention Center, Bellevue(Seattle), Washington,USA, 2000.369-372.
[2]Hua Younan. Studies on Elimination Solutions of Galvanic Corrosion on Microchip Al Bondpads in Wafer Fabrication and Assembly Processes[C]. The proceedings from the International Conference on Semiconductor Electronics 7-9 Dec, Kuala Lumpur, Malaysia ,2004.
[3]Hua Younan. A Study on Discolored Bondpads & Galvanic Corrosion[C]. The Proceedings from the 24th International Symposiumfor Testing andFailure Analysis, 15-19 Nov,Hyatt Regency, DFW-East Tower, Dallas, Texas, USA,1998, 269-272.
[4]Hua Younan. A Study on Al Bondpad Grain Boundaries and Galvanic Corrosion in Wafer Fabrication[C]. The proceedings from the International Conference on Semiconductor Electronics 7-9 Dec, Kuala Lumpur, Malaysia ,2004.
