3D MCM组件产品热分析技术研究
2010-05-31徐英伟
徐英伟
(中国电子科技集团公司第四十七研究所,沈阳 110032)
1 引言
3D MCM是指将多个裸芯片或二维多芯片组件(2D MCM)沿z轴方向层叠起来的封装技术,相对于单芯片封装和2D MCM具有很多优点,如体积小、重量轻,硅片的封装效率大大提高,延迟进一步缩短,噪声降低,速度更快等。随着3D MCM组装密度的进一步加大,单位体积容纳的热量就越来越高,器件的工作温度将会大大增加。器件的失效往往与其工作温度密切相关。资料表明,器件的工作温度每升高10℃,其失效率增加一倍。不合理的热设计将会诱发一系列的问题,如出现局部过热,温度分布不均。因此热设计和热分析技术的研究在三维电子封装中显得越来越重要。
要对3D MCM进行合理的热设计,首先必须了解整个封装实体的温度场分布情况,再根据热分析的结果来确定热设计方法。热分析主要是进行热场分析以及热应力分析。热应力场是结构场和温度场的耦合。而热场的分布可通过模拟仿真和实验来获得,对于三维封装来说,通过实验方法一般只能获得封装实体外部的温度场,而内部温度场只能通过计算机仿真技术来得到。国内外已经对三维封装的热场分析进行了很多研究工作,文献[1]中S.Moghaddam etc利用热阻网络拓朴关系对MCM进行了热仿真分析;文献[2]中K.W.Morton比较详细地阐述了利用有限差分法进行二维和三维热分析的基本理论;文献[3]、[4]利用有限元法对三维多芯片组件进行了热场仿真分析。近些年来,随着有限元理论的逐渐成熟,伴随着出现了一些商用软件,如Ansys以及Flotherm等,使得利用有限元法进行热场仿真分析得到了广泛的应用,尤其对于三维场分析更加有效。
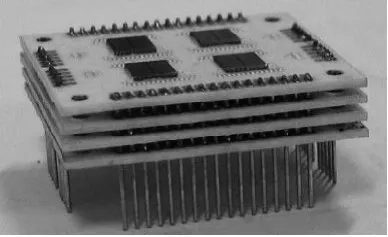
图1 三维叠层式组件产品结构图
本论文利用Ansys有限元分析工具对某叠层式三维静态存储器模块进行热分析,模块如图1所示,并与实验结果进行了对比分析,大大提高了三维存储器组件设计的可靠性。
2 Ansys软件分析原理
Ansys是一个大型通用有限元分析软件,可在微机或工作站上运行,能够进行应力分析、热分析、电磁场分析等多种物理场分析,并且具有强大的前、后处理功能。在温度场分析方面包括稳态温度场分析和瞬态温度场分析。
2.1 稳态传热
如果系统的净热流率为0,即流入系统的热量加上系统自身产生的热量等于流出系统的热量:Q流入+ Q生成- Q流出= 0,则系统处于热稳态。在稳态热分析中任一节点的温度不随时间变化。稳态热分析的能量平衡方程为[5]:

(1)式中:
[K]为传导矩阵,包含导热系数、对流系数及辐射率和形状系数;
{T}为节点温度向量;
{Q}为节点热流率向量,包含热生成。
ANSYS利用模型几何参数、材料热性能参数以及所施加的边界条件,生成[K]、{T}以及{Q}。
2.2 瞬态传热
瞬态传热过程是指一个系统的加热或冷却过程。在这个过程中系统的温度、热流率、热边界条件以及系统内能随时间都有明显变化。根据能量守恒原理,瞬态热平衡可以表达为:

式(2)中:
[K]为传导矩阵,包含导热系数、对流系数及辐射率和形状系数;
[C]为比热矩阵,考虑系统内能的增加;{T}为节点温度向量;
{T′}为温度对时间的导数;
{Q}为节点热流率向量,包含热生成。
3 模型的建立与加载
Ansys软件分析过程一般包括:模型建立→材料属性定义→网格划分→加载→求解→结果分析。
3.1 模型建立与网格划分
在进行热分析前,首先要根据实体结构建立热分析模型。如图1所示,该模块为四层多芯片组件结构,每层包含4个SRAM芯片(128k×8bit),共有16个SRAM芯片,芯片尺寸为5.4mm×4.6mm×0.45mm,功耗为0.1W;基板的材料为低温共烧陶瓷(LTCC),尺寸为32mm×28mm×0.9mm;各层基板之间采用通孔-导柱的方式进行互连,导柱材料为铜;基板通孔内侧电镀金属,通孔和导柱间通过PbSn焊料连接。各材料的属性如表1所示。图2为进行了网格剖分后的实体简化模型,为了与研制的样品模型相一致,暂时没有考虑叠层间的填料以及外部管壳的问题;同时为了简化模型(有利于计算分析),在温度场分析时,导柱与基板通孔间的PbSn焊料被忽略不计。网格划分选用的是8节点的三维实体热单元Thermal Solid 70,划分后形成了199182个单元,49112个节点。


图2 模型网格剖分图
3.2 加载方式
首先要确定模块的热通路,以确定边界条件和加载方式,该模块的热通路为:芯片→基板→导柱→外部环境,边界条件为自然对流。对于该模块的分析可以有两种加载方法,一种是功耗加载(Heat Flow),另一种加载方式是生热率(Heat Generat),即单位体积的功耗。这两种方式中值得注意的是第一种为节点载荷,而第二种方式为体载荷,考虑到芯片发热的整体效应,最好采用体载荷加载方式。对于功耗为0.1W的单个芯片,根据芯片的体积可以计算出生热率为0.805 15×107W·m-3,体载荷的加载需要根据实际工作情况进行加载,该模块单个芯片为8位SRAM,整体互连后可以形成8位SRAM和16位SRAM(由片选控制线来控制)。当模块作为8位SRAM使用时,每个时刻只有一个芯片在工作;当作为16位SRAM使用时,每个时刻共有两个芯片在同时工作,这样就确定了载荷的加载方式和工作方式。
4 模块瞬态温度场仿真分析
模块工作初期载荷随时间而变换,热场分布也随时间变化而变化,应进行瞬态热分析。
对模块进行瞬态温度场仿真分析时,最主要的是时间载荷步的加载问题,在模块实际工作中为交变载荷,即随时间的变化工作芯片发生变化。16位存储器模块每一时刻有两个芯片同时工作,全模块仿真时需要加载交变载荷。因为第二层基板属内层基板,散热性能比第一层和第四层基板要差,温升最高,第三层基板的散热性能与第二层基板的散热性能相当(不考虑底层基板与外界的热传导现象,均以自然对流条件考虑)。为得到模块工作时的极限温度,仿真时对模块中第二层基板上的四个芯片加载了交变载荷,图3为载荷-时间的变化关系。图3(a)代表1、2两个芯片载荷与时间的关系,图3(b)代表3、4两芯片载荷与时间的关系。
图4为模块瞬态温度场分布仿真图(由于篇幅因素,这里只给出了3600s时的温度场变化),仿真条件为:边界条件为室温25℃,载荷步设置为600s,子步为60s。为表示清晰,温度场图形中隐含了第一层基板。模块工作时,被加载芯片的温度最高,为得到芯片温度与时间变化关系,分别选择了芯片1和芯片3上温度最高的两个节点14834和15358,图5为两个节点的温度值随时间变化的关系,从图中可以看出,当模块在交变载荷工作1h后,基本形成了稳定的温度长,芯片工作温度的最高值为42.424℃(当t=4800s时)。在交变载荷发生变化时,刚被卸掉载荷的芯片工作温度下降,而被加载的芯片工作温度开始升高,当模块内部温度到达42.4℃附近时,系统内部温度场变化基本达到一个稳定状态。
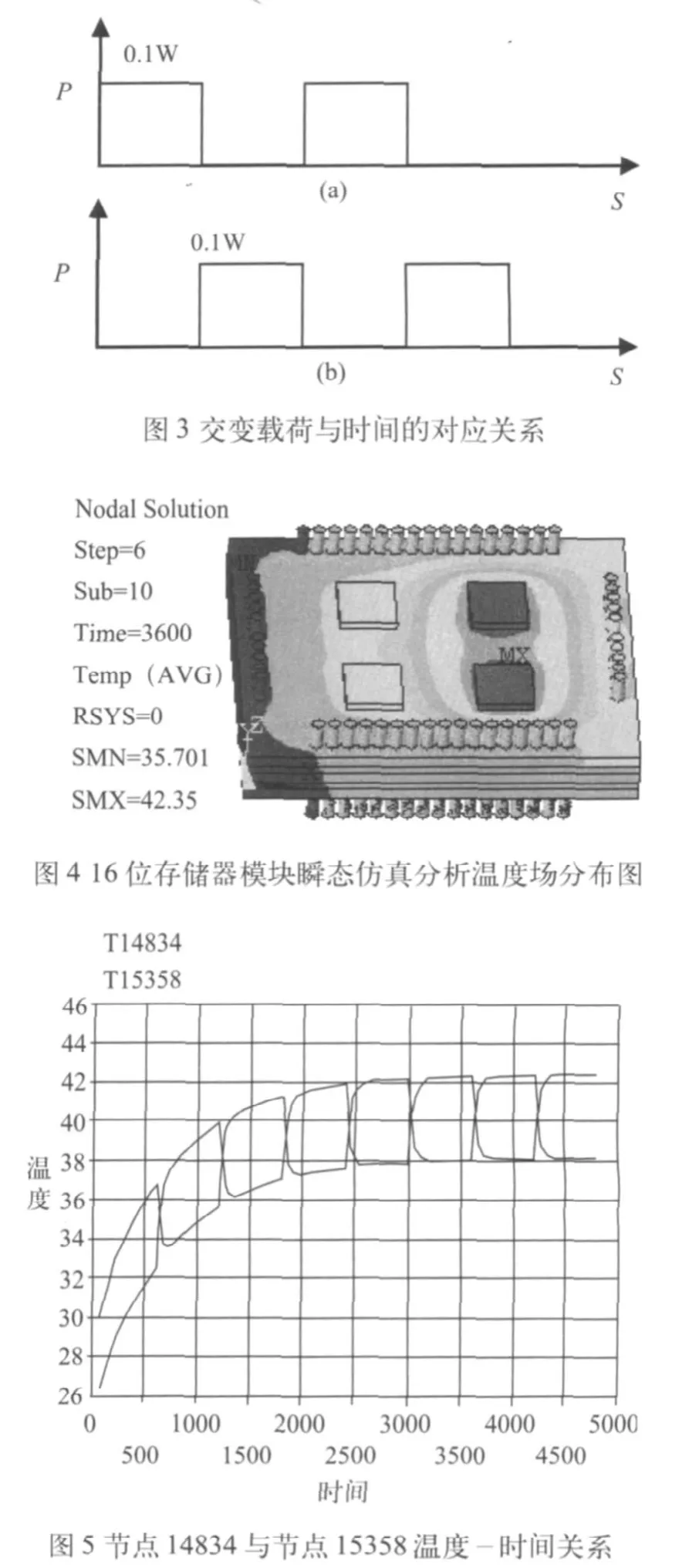
5 实验对比

将被测模块置于测试电路中工作,并通过热像仪来测试电路的温度场,加载条件为3、4号芯片长时间加载,载荷为0.1W。目前只考虑模块封装内部的热场分布情况,由于热像仪只能测试外部温度场分布情况,为了与模拟温度场进行对比,需要在温度场分析中取上表面的几个特定点与热像仪测试结果进行对比(上面最终得到的稳态情况下)。模拟结果与实测结果见表2。从表中可以看出实测值与模拟值很好地吻合。
6 结论
目前集成电路的组装密度越来越高,正由单芯片封装向2D MCM及3D MCM技术方向发展。在3D封装技术中由于集成度高,其模块的热分析与热设计技术变得越来越重要。在热分析和热设计过程中,利用有限元方法能够比较准确地模拟三维器件内部热场分布以及热应力分布,通过3D MCM热分析技术以及相应的优化设计,可以大大提高3D MCM的可靠性。
[1]S.Moghaddam,etc. Evaluation of analytical models for thermal analysis and design of electronic packages[J].Microelectronics Journal 2003,34: 223-230.
[2]K.W.Morton, D.F.Mayers. Numerical Solution of Partial Differential Equations[M]. Cambridge University Press.2005.
[3]Larry D.Carwford, James R. Leith. Develop-ment of A Thermal Management Technique for Cooling 3 Dimensional Multi-Chip Modules[C]. 7th AIAA/ASME Joint Thermophysics and Heat Transfer Conference,Albuquerque.1998,6: 15-18.
[4]Xiaowu Zhang, etc. Thermo-mechanical finite element analysis in a multichip build up substrate based package design[J]. Microelectronics Reliability, 2004,44:611-619.
[5]唐兴伦,等. ANSYS工程应用教程——热与电磁学篇[M]. 北京:中国铁道出版社. 2003. 1.
