InAs/GaSb II类超晶格长波焦平面阵列台面ICP刻蚀技术研究
2022-10-26王海澎木迎春彭秋思黄佑文李俊斌龚晓丹周旭昌李东升孔金丞
王海澎,木迎春,彭秋思,黄佑文,李俊斌,龚晓丹,刘 玥,敖 雨,周旭昌,李东升,孔金丞
〈材料与器件〉
InAs/GaSb II类超晶格长波焦平面阵列台面ICP刻蚀技术研究
王海澎,木迎春,彭秋思,黄佑文,李俊斌,龚晓丹,刘 玥,敖 雨,周旭昌,李东升,孔金丞
(昆明物理研究所,云南 昆明 650223)
本文采用SiO2/SiN作为掩膜对InAs/GaSbⅡ类超晶格红外材料进行感应耦合等离子体(ICP)刻蚀条件研究,得到InAs/GaSbⅡ类超晶格较好的刻蚀条件以提升红外探测器性能。对ICP刻蚀过程中容易出现台面侧向钻蚀以及台面底部钻蚀两种现象进行了详细研究,通过增加SiO2膜层厚度以及减小Ar气流量,可有效减少台面侧向钻蚀;通过减小下电极射频功率(RF),可有效消除台面底部钻蚀。采用适当厚度的SiO2/SiN掩膜以及优化后的ICP刻蚀参数可获得光亮平整的刻蚀表面,表面粗糙度达到0.193nm;刻蚀台面角度大于80°,刻蚀选择比大于8.5:1;采用优化后的ICP刻蚀条件制备的长波640×512焦平面器件暗电流密度降低约1个数量级,达到3×10-4A/cm2,响应非均匀性、信噪比以及有效像元率等相关指标均有所提高,并获得了清晰的焦平面成像图。
InAs/GaSbⅡ类超晶格;SiO2/SiN掩膜;ICP刻蚀
0 引言
基于GaSb材料,包括InAs,GaSb,AlSb等材料可以灵活地设计成各种新型材料和器件,尤其是InAs/GaSb超晶格具有独特的Ⅱ型能带结构,可以在器件结构中很方便地加入势垒层,提高器件工作温度和减小暗电流,在制作高性能红外探测器方面具有很大的潜力[1-3]。对于Ⅱ类超晶格红外探测器,在器件制备过程中台面侧壁角度和表面粗糙度对器件的表面漏电流和噪声等有较大的影响,严重制约着器件的性能。随着InAs/GaSbⅡ类超晶格红外焦平面阵列规模的增大,光敏元的尺寸和间距越来越小,所要求的线宽越来越小,精细度越来越高,对台面侧壁角度和表面粗糙度提出了更高的要求[4-5]。然而,传统的光刻胶掩膜已经无法满足工艺要求,取而代之的是二氧化硅(SiO2)等掩膜材料,相对于光刻胶掩膜层,复合掩膜层与超晶格材料具有较高的选择比,采用复合掩膜层能够获得更好的台面角度以及更光滑的侧壁形貌[6]。同时,对干法刻蚀工艺提出了更高的要求,良好的干法刻蚀工艺可以降低台面的侧向及底部钻蚀,从而提高阵列芯片上的占空比和器件的量子效率,降低光敏元间的串扰[7]。
本文采用SiO2/SiN复合掩膜,利用感应耦合等离子体刻蚀设备(Inductively coupled plasma)在不同工艺条件下刻蚀台面,并对ICP刻蚀台面出现的不同形貌特征进行了分析研究,通过调节ICP刻蚀工艺参数,获得了表面光滑的台面,刻蚀台面角度大于80°,刻蚀选择比大于8.5:1。同时对比不同台面刻蚀条件制备的长波640×512焦平面器件测试结果,侧壁平整光滑的焦平面器件暗电流密度降低1个数量级,达到10-4A/cm2,焦平面器件综合性能有较大提高。
1 实验方法
通过分子束外延(molecular beam epitaxy)生长得到InAs/GaSbⅡ类超晶格材料。材料结构为PπMN结构,整体结构见表1。
在上述材料衬底上首先通过ICP-chemical vapor deposition(ICP-CVD)依次制备一定厚度的SiO2/SiN复合掩膜层,如图1(a)、(b)、(c)所示。随后在复合膜层上通过光刻工艺获得台面隔离沟槽3mm,中心距15mm的光刻图形,如图1(d)所示;通过反应离子刻蚀(Reactive Ion Etching),使得光刻图形转移至复合掩膜层上,即在复合掩膜层上获得间距3mm,中心距15mm的图形,如图1(e)所示;随即通过ICP以Cl基气体刻蚀超晶格材料并获得间距约3mm,深度约为3.1mm的台面结构,如图1(f)所示;最后去除剩余SiO2掩膜层,如图1(g)所示。

表1 InAs /GaSbⅡ类超晶格材料结构

图1 长波640×512红外焦平面器件制备流程
InAs/GaSbⅡ类超晶格材料的刻蚀设备为Sentech SI500,刻蚀气体为SiCl4/Ar/H2,实验分别采用4种ICP刻蚀工艺条件,如表2所示。通过扫描电镜表征掩膜与超晶格材料选择比和侧壁形貌,原子力显微镜表征刻蚀表面粗糙度,焦平面测试系统表征长波640×512红外焦平面器件暗电流及相关性能参数。

表2 InAs /GaSbⅡ类超晶格材料ICP刻蚀条件
2 结果与讨论
2.1 SiO2/SiN复合掩膜层刻蚀
以CHF3/O2为刻蚀气体通过RIE设备对二氧化硅及氮化硅掩膜进行刻蚀,结果如图2所示。掩膜刻蚀后刻蚀区域表面光滑,与超晶格材料表层形貌一致,刻蚀区域的均一性较好,刻蚀后掩膜侧壁较为陡峭,这得益于CHF3基刻蚀气体对二氧化硅和光刻胶有较好的刻蚀选择性。
2.2 InAs/GaSbⅡ类超晶格材料刻蚀
基于2.1制备的掩膜图形,采用条件1对InAs / GaSbⅡ类超晶格材料刻蚀后的角度大于80°,刻蚀深度为3.15mm,台面隔离槽顶部宽为3.05mm,底部宽为2.87mm,剩余的SiO2约为3300Å,同时侧壁及底部较为光滑、无刻蚀产物残留,如图3(a)所示,InAs/GaSb刻蚀速率为~3940Å/min,掩膜刻蚀速率为~460Å/min,超晶格材料与掩膜的选择比大于8.5:1。同时,利用原子力显微镜(atomic force microscope,AFM)对刻蚀台面底部进行粗糙度测量,在2mm×2mm面积内其均方根平均粗糙度达到0.193nm,如图3(b)所示。

图2 RIE刻蚀SiO2+SiN掩膜SEM图

图3 ICP刻蚀条件1样品SEM及刻蚀区域AFM图
以上结果表明采用复合掩膜刻蚀能够获得理想的台面阵列,但在台面顶部出现倒角,即侧向钻蚀,如图3(a)黑框所示。采用刻蚀条件2制备台面,对比条件1将SiO2掩膜厚度由6000Å增加到8000Å,台面刻蚀结果如图4(a)所示,掩膜厚度增加后,台面顶部侧向钻蚀有所缓解。
采用ICP刻蚀条件3制备台面,对比条件2,将Ar气流量减小5sccm,台面顶部侧向钻蚀现象完全消失,如图4(b)黑框内所示。因此,结合实验结果及刻蚀参数分析台面顶部侧向钻蚀现象消失的原因主要有两个,原因①:由于沉积SiN/SiO2掩膜厚度较薄,等离子体的物理轰击作用较多地作用在超晶格材料侧壁上[8],如图5(a),同时由于Cl基刻蚀气体的化学作用,使得超晶格材料的刻蚀速率快于SiN/SiO2掩膜,从而在顶部出现侧向钻蚀现象;因此通过增加SiN/SiO2掩膜厚度使得等离子体的物理轰击作用较多的作用在SiN/SiO2掩膜上,如图5(b),达到改善侧向钻蚀目的;原因②:超晶格材料各向异性刻蚀主要来自于SiCl4/H2与InAs/GaSb反应形成的聚合物附着在侧壁上形成阻挡层,阻止刻蚀气体进一步对侧壁的化学作用。但由于刻蚀过程中Ar气的比例过高,物理刻蚀作用过强使得侧壁聚合物分解,侧壁上的化学作用持续进行,从而出现侧向钻蚀。

图4 ICP刻蚀条件2和条件3样品SEM图

图5 掩膜图形影响台面顶部侧向钻蚀示意图
增加SiN/SiO2掩膜厚度和降低Ar气流量,虽然解决了顶部侧向钻蚀问题,但在台面底部出现了钻蚀。为了解决底部钻蚀,将RF功率增加到150W,即ICP刻蚀条件4,结果如图6(a)所示,台面底部钻蚀现象消失。分析其主要原因为在射频源等离子体中,偏压是由附着在衬底上的电子产生,但由于SiO2薄膜的绝缘性,电子聚集在SiO2膜层上,尤其是在SiO2膜层角落,使得膜层表面带负电[9],从而影响Ar+离子的运动轨迹,导致底部钻蚀的形成,如图6(b)所示。因此,在增加RF功率后,提高Ar+离子的动能以保证Ar+离子刻蚀方向性,降低膜层表面电荷对Ar+离子的运动轨迹的影响。在该条件下,台面侧壁陡直且光滑,刻蚀角度约为88°,选择比大于8.5:1。同时,采用刻蚀条件4制备的台面底部在2mm×2mm面积内其均方根平均粗糙度约为0.2nm,如图6(c)所示,说明ICP刻蚀条件1和4对平面刻蚀效果基本一致。
2.3 长波640×512焦平面器件测试结果
由于采用条件1、2、3制备台面均出现侧向钻蚀或底部钻蚀现象,不是理想的台面制备条件,因此仅选取条件1和条件4进行器件结果对比。采用ICP刻蚀条件1和条件4制备长波640×512焦平面器件,77K下器件光谱测试结果表明50%截止波长为9.26mm,如图7(a)所示。77K下暗电流对比结果如图7(b)所示,在台面刻蚀工艺改善后,即采用条件4制备的长波640×512焦平面器件暗电流密度降低约1个数量级,达到3×10-4A/cm2,反向偏压曲线平坦区更长,说明侧壁形貌以及光滑程度对器件暗电流存在较大影响。台面侧壁粗糙一是由于刻蚀沉积物附着在侧壁,二是由于刻蚀过程中物理轰击作用过大,而沉积物在侧壁容易形成漏电通道,过强的物理轰击作用会带来额外的刻蚀损伤,同时,台面顶部侧向钻蚀以及底部钻蚀位置的钝化膜覆盖度会减小,当器件在降温过程中,钝化膜容易开裂甚至脱落,降低钝化膜对侧壁漏电的抑制作用,上述原因均会增大器件暗电流。
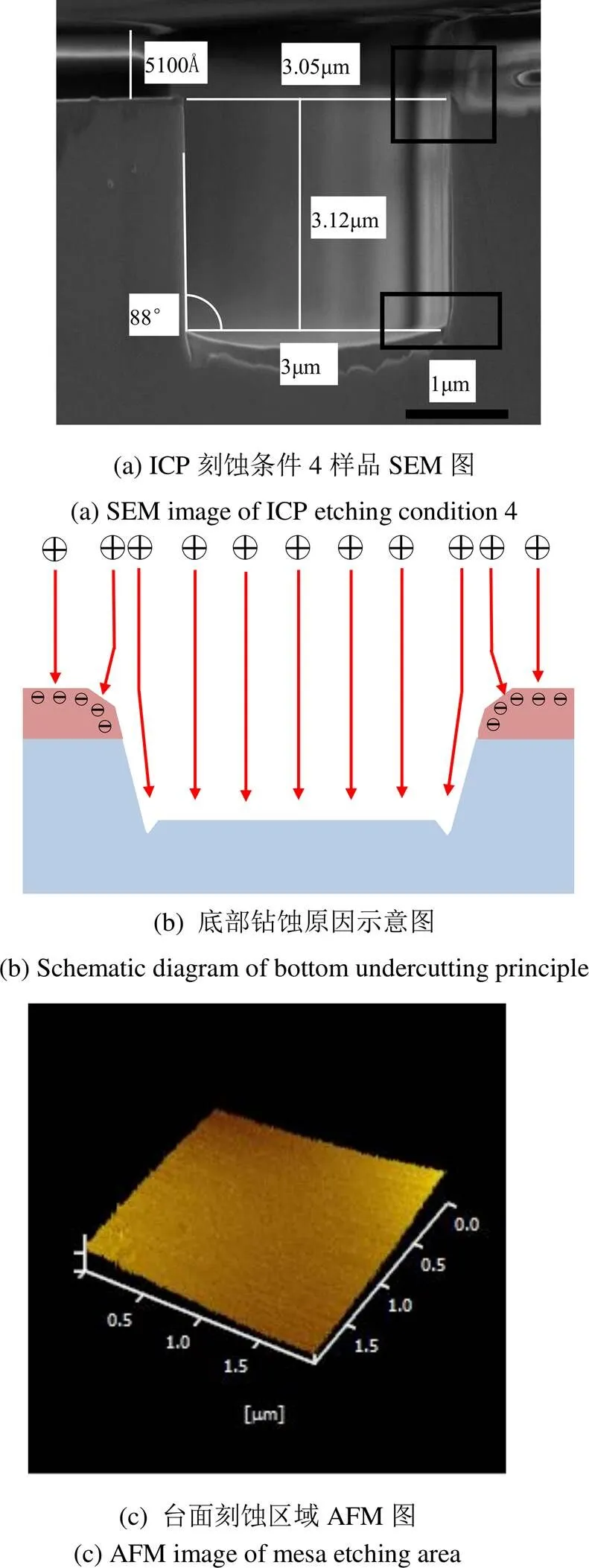
图6 采用ICP刻蚀条件4制备样品相关结果
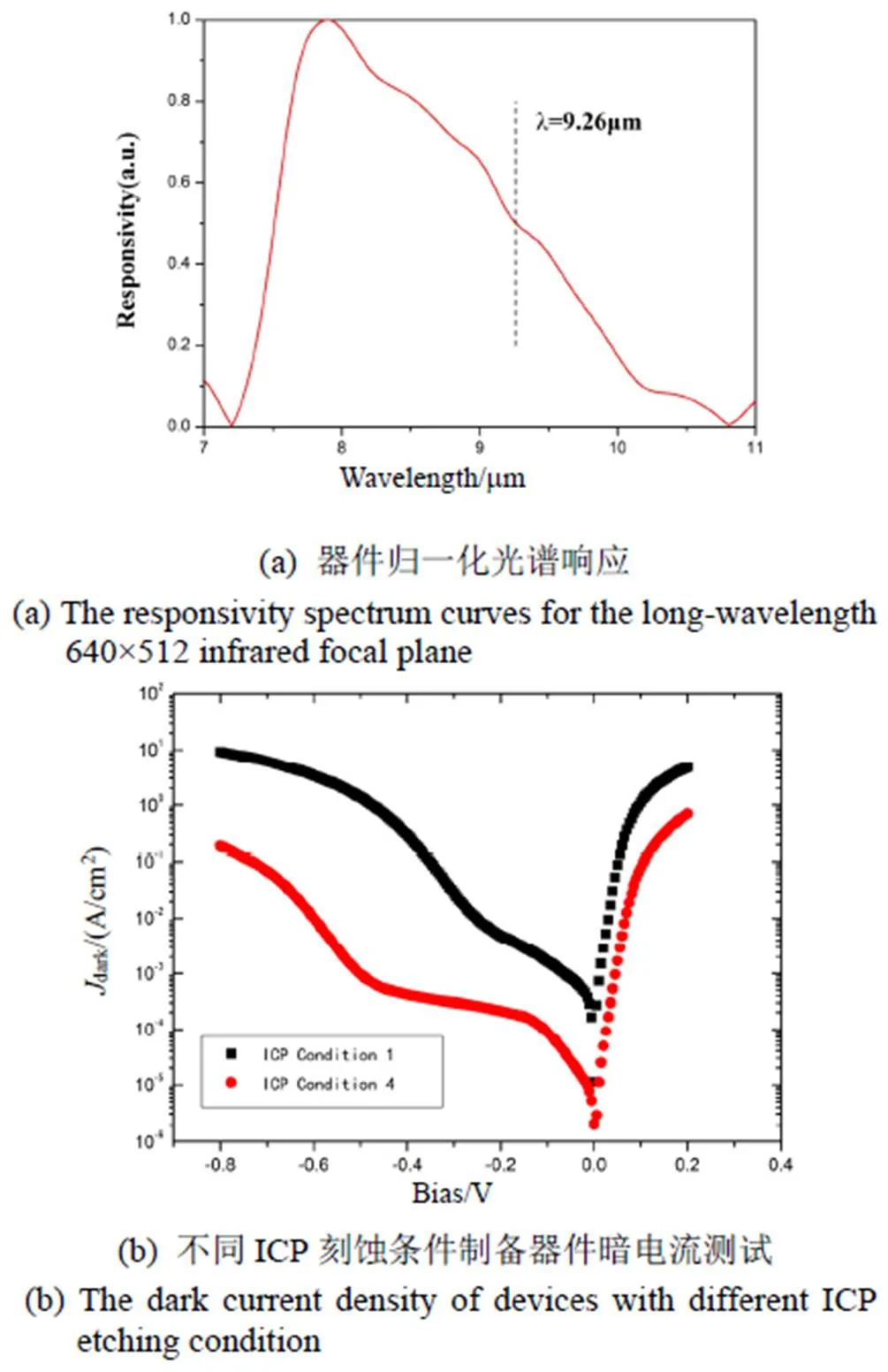
图7 器件光谱响应及暗电流测试结果
采用ICP刻蚀条件4制备的焦平面器件,其黑体响应非均匀性较低,信噪比高,盲元率低,具有较好的器件性能,如图8及表3所示,同时该器件获得了清晰的焦平面成像图,如图9所示。
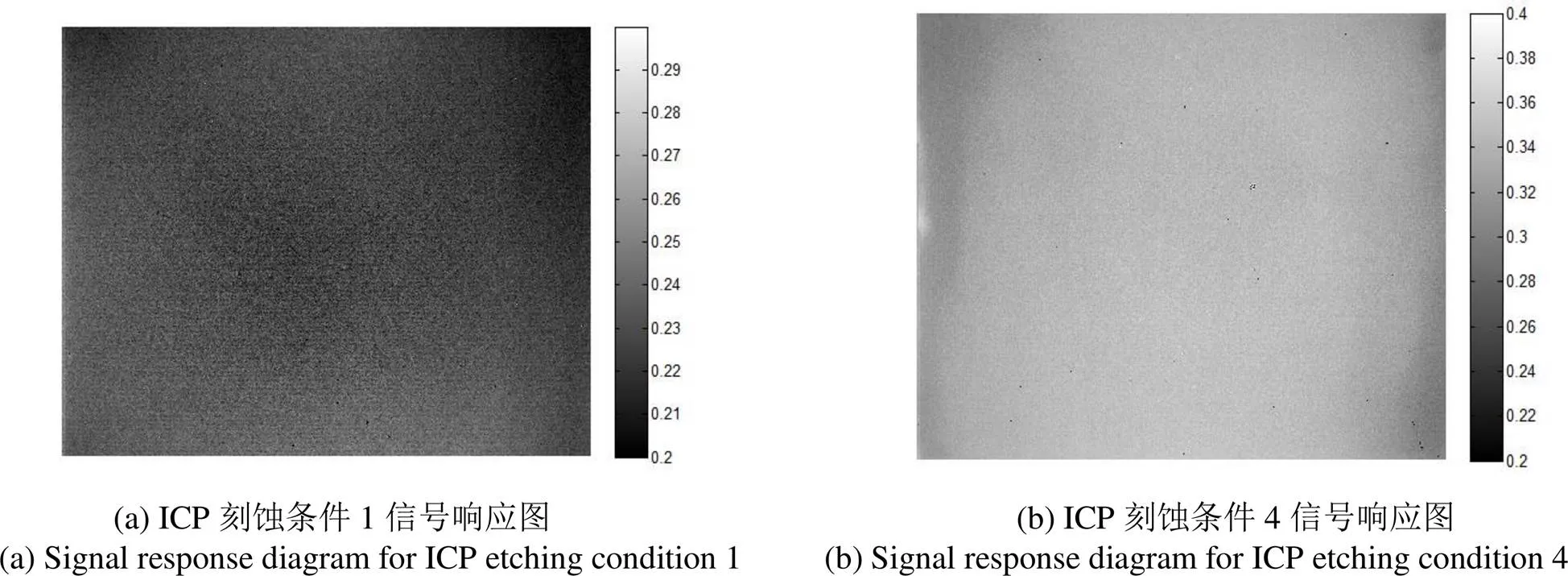
图8 长波640×512红外焦平面信号响应图

表3 长波640×512红外焦平面相关参数对比

图9 长波640×512红外焦平面成像图
3 结论
利用一定厚度的SiO2/SiN复合掩膜层以及优化后的ICP干法刻蚀工艺,获得了光滑的刻蚀表面以及接近垂直的台面角度,台面刻蚀角度大于80°,InAs/GaSb超晶格材料与掩膜刻蚀选择比大于8.5:1。同时由分析结果可知,SiO2/SiN复合掩膜层的厚度以及Ar气流量的大小对台面顶部的侧向钻蚀程度有一定影响,而下电极射频功率(RF)会影响到台面底部的钻蚀程度,通过增加掩膜层厚度、减小Ar气流量可有效减缓侧向钻蚀程度,而减小下电极射频功率(RF)可有效减缓底部的钻蚀程度。同时对比长波640×512焦平面器件测试结果发现,采用ICP刻蚀条件4制备的器件暗电流密度较小,约3×10-4A/cm2,响应非均匀性、信噪比以及有效像元率等相关指标均有所提高。
[1] Smith D L, Mailhiot C. Proposal for strained type II superlattice infrared detectors[J]., 1987, 62(6): 2545-2548.
[2] Haddadi A, Dehzangi A, Chevallier R, et al. Type-II InAs/GaSb/AlSb superlattice-based heterojunction phototransistors: back to the future[C] //, 2018, 10540: 1054004-1054004-12.
[3] Jenkins J, Terterian S, Tu.B, et al. Fabrication of small pitch, high definition (HD) 1k´2k/5μm MWIR focal-plane-arrays operating at high temperature (HOT)[C]//, 2017, 10177: 101771J-101771J-7.
[4] 陈永远, 邓军, 史衍丽, 等. InAs/GaSb二类超晶格红外探测材料的ICP刻蚀[J].红外与激光工程, 2013, 42(2): 433-437.
CHEN Yongyuan, DENG Jun, SHI Yanli, et al. ICP etching in InAs/GaSb type Ⅱ superlattice infrared detector material[J]., 2013, 42(2): 433-437.
[5] 张国栋, 司俊杰, 王理文. 利用CH4/H2/Ar及Cl2高密度等离子体对InSb的高速率刻蚀研究[J]. 红外与激光工程, 2012, 41(4): 843-846.
ZHANG Guodong, SI Junjie, WANG Liuen. High rate etching of InSb in high density plasma of CH4/H2/Ar and Cl2[J]., 2012, 41(4): 843-846.
[6] HAO Hongyue, WEI Xiang, WANG Guowei, et al. Etching mask optimization of InAs/GaSb superlattice mid-wavelength infrared 640×512 focal plane array[J]., 2017, 26(4): 047303.
[7] HUANG M , CHEN J, XU J , et al. ICP etching for InAs-based InAs/GaAsSb superlattice long wavelength infrared detectors[J]., 2018, 90: 110-114.
[8] YE Z H, HU W D, LI Y, et al. Studies on a novel mask technique with high selectivity and aspect-ratio patterns for HgCdTe trenches ICP etching[C]//, 2012, 8353(2): 83532T- 83532T-7.
[9] CHEN Y Y, YE Z H, SUN C H, et al. Dry etched SiO2mask for HgCdTe etching process[J]., 2016, 45(9): 1-6.
ICP Dry Etching of Type II InAs/GaSb Superlattice Long-wavelength Focal Plane Arrays
WANG Haipeng,MU Yingchun,PENG Qiusi,HUANG Youwen,LI Junbing,GONG Xiaodan,LIU Yue,AO Yu,ZHOU Xuchang,LI Dongsheng,Kong Jincheng
(,650223,)
Dielectrical layer SiO2/SiN is used as a mask in studying inductively coupled plasma (ICP) etching conditions of InAs/GaSbⅡsuperlattice infrared materialsfor improving the electrical performance of the device. In this article, ICP etching parameters of InAs/GaSb type-II superlattice with SiO2/SiN were investigated. Two common phenomena observed in the ICP etching process, mesa lateral undercutting and under mesa undercutting, were analyzed in detail. The mesa lateral undercutting was efficiently improved by increasing the thickness of the SiO2film and reducing the Ar gas flow rate. The table undercut was effectively eradicated by reducing the radio frequency (RF) power of the bottom electrode. A bright and flat etching surface with a surface roughness of 0.193nm was obtained by using an appropriate thickness of SiO2/SiN mask and optimized ICP etching parameters. The etching mesa angle was greater than 80°, and the etching selection ratio was greater than 8.5:1. The dark current density of a long-wavelength 640×512 focal plane array manufactured using improved ICP etching conditions was lower by an order of magnitude, reaching 3×10-4A/cm2. Other parameters, such as response non-uniformity, signal-to-noise ratio, and effective pixel rate were also improved, and a clear image was obtained.
InAs/GaSb type II superlattice, SiO2/SiN mask, ICP etching
TN215
A
1001-8891(2022)10-1027-06
2022-02-08;
2022-03-22.
王海澎(1988-),男,工程师,主要从事红外探测器芯片技术研究。E-mail:W_hpeng@163.com。
孔金丞(1979-),男,研究员级高级工程师,主要从事红外探测器材料及器件技术方面研究。E-mail:kongjincheng@163.com。
