稀释气体流量对外延生长3C-SiC薄膜的影响
2022-10-20朱佩佩熊梦杨
朱佩佩,熊梦杨,涂 溶
应用研究
稀释气体流量对外延生长3C-SiC薄膜的影响
朱佩佩1,熊梦杨1,涂 溶2
(1. 武汉船用电力推进装置研究所,2. 武汉理工大学,武汉 430064)
3C-SiC具有带隙宽、临界击穿电场高、导热率高、载流子饱和漂移速率高等优异的物理特性,被广泛应用于大功率电子器件。3C-SiC(001)单晶薄膜具有最高的电子迁移率,能显著提高大功率场效应晶体管(MOSFET)器件的性能。本论文采用激光化学气相沉积技术在Si(001)衬底异质外延3C-SiC薄膜,研究了稀释气体流量对3C-SiC(001)薄膜的影响。当氢气流量为0.5 slm时,薄膜具有最大的电子迁移率590 cm2V-1S-1。
3C-SiC 大功率电子器件 激光化学气相沉积
0 引言
半导体产业的发展先后经历了以Si为代表的第一代半导体材料,以GaAs为代表的第二代半导体材料,Si材料无法满足在高温、高压、抗辐射等方面的应用。GaAs材料虽然能制备在较高温度下工作的器件,但其热导率低,不利于电子电力器件的制备。SiC材料是继Si、GaAs之后发展最为成熟的第三代半导体材料,可广泛应用于电子电力器件、射频器件、光电子器件等领域,其优越的半导体性能远超Si材料[1-5]。
根据Si-C双原子层的排列顺序差异可形成不同晶型的SiC,目前备受关注的为3C-SiC、4H-SiC和6H-SiC,3C-SiC具有较高的电子迁移率与空穴迁移率,使得大功率场效应晶体管(MOSFET)有较高的工作电流。
Si(001)面的界面态密度最低,表面电子迁移率最高,在单晶Si(001)基板上外延生长3C-SiC(001)薄膜,可实现3C-SiC异质外延薄膜与硅微电子器件的整合[6]。本研究采用激光化学气相沉积法在Si(001)基板上外延生长3C-SiC(001)薄膜,重点研究稀释气体流量对薄膜的影响。
1 实验方案
1.1 薄膜的制备
采用激光化学气相沉积技术制备薄膜,以Si(001)为基板,六甲基二硅烷(HMDS)为前驱体原料,氩气为载流气,氢气为稀释气体,具体的薄膜生长工艺参数如表1所示。

表1 薄膜生长工艺参数
1.2 薄膜的表征
1.2.1 薄膜的物相与孪晶含量分析
使用X射线衍射仪(XRD)对薄膜进行物相与孪晶含量分析,其型号为RigukaUltimaIII。
1.2.2 薄膜的杂质及缺陷分析
利用拉曼光谱分析薄膜中的杂质相以及缺陷,其型号为Invia,激光波长为633 nm。
1.2.3 薄膜的形貌分析
使用场发射扫描电子显微镜(Field Emission Scanning Electron Microscope,简称FESEM)分析薄膜的形貌,其型号为FEI-Quanta-250。
1.2.4薄膜的电性能分析
采用范德堡法对薄膜的电性能进行表征,薄膜的厚度通过断面的SEM图片测量,将测量薄膜的厚度输入霍尔效应测试系统软件后可直接获得所测薄膜的电学性能,霍尔效应的生产厂商为英国的Accent Optical公司,其型号为HL5500PC。
2 结果和讨论

图1 不同氢气流量下制备的3C-SiC薄膜的XRD图谱:(a)0.5 slm,(b)1 slm,(c)1.5 slm,(d)2 slm
图1是在不同氢气流量下制备的3C-SiC薄膜的XRD图谱,从图中可以看出,氢气流量对3C-SiC薄膜的生长取向影响较小,所有的薄膜均为<001>取向,与Si基板的取向一致,无其它物相。

图2 不同氢气流量下制备的3C-SiC薄膜的拉曼图谱:(a)0.5 slm,(b)1 slm,(c)1.5 slm,(d)2 slm
图2为不同氢气流量下的拉曼谱图,所有的TO和LO峰均位于792和967 cm-1处,3C-SiC的横向光学分支(TO)和纵向光学分支(LO)分别位于796和972 cm-1处[7],本研究所制备的薄膜均向左发生偏移,这种现象叫做红移,研究表明,红移现象与3C-SiC薄膜中应力相关[8]。随着氢气流量的增加,在1360、1590 cm-1处的石墨的D和G峰强度增高[9],表明所制备的薄膜为3C-SiC与石墨的混合相;当氢气流量为2 slm时,3C-SiC薄膜的LO峰与Si基板的2TO峰有重合,这是因为薄膜比较薄,拉曼能探测到Si基板,因此氢气流量为0.5 slm时为最佳流量,此时的薄膜为单一3C-SiC(001)。

图3 不同氢气流量下制备的3C-SiC薄膜的表面形貌图:(a)0.5 slm,(b)1 slm,(c)1.5 slm,(d)2 slm
图3为不同氢气流量下的3C-SiC薄膜的表面形貌图。从图中可以看出,随着氢气流量的增加,薄膜表面的晶粒减小,当氢气的流量为1.5 slm时,薄膜表面出现少量的团聚现象,当氢气流量为2.0 slm时,薄膜的团聚现象减弱。图4为不同氢气流量下的3C-SiC薄膜沉积速率曲线,随着氢气流量的升高,沉积速率逐渐降低。

图4 不同氢气流量下的3C-SiC薄膜沉积速率
图5为一级孪晶含量与氢气流量的关系,采用XRD的极图扫描模式测试孪晶含量,可以根据j扫描图中衍射峰的强度估算孪晶的含量,根据文献报道,将一级孪晶的含量记为z(z=15.8o/54.7o)[10],其中15.8o为一级孪晶4个衍射峰的强度总和,54.7o为外延衍射峰的强度总和。随着H2流量由0.5slm增加到2 slm时,一级孪晶含量急剧下降,由30.06减小到1.56。图6为孪晶形成示意图,Si原子在{111}面上有两种结合方式,正常位置I与错误的位置II(图6(a)),在错误的位置II上成核的概率更大,因为该过程受热力学与表面动力学控制,在位置II上成核系统的能量比在位置I上成核的能量低,因此大量的Si原子将在位置II处成核,如图6(b)所示,此处成核导致了位置III处的孪晶结构,并且该孪晶结构会随着薄膜的生长而延伸,如图6(c)所示。随着H2流量的增加,HMDS的浓度减小,二次成核密度减少,因此孪晶缺陷含量降低,此外,H原子的通量大,能显著刻蚀位置II处的成核,所以孪晶密度随着H2流量的增加急剧下降[10]。
表2为不同氢气流量下制备的3C-SiC薄膜的霍尔效应测试结果,所有的薄膜均为n型导电。薄膜的电子迁移率与随氢气流量减少而上升无明。当氢气流量为2 slm时,薄膜的电阻率为0.00304 Ω·cm,一般文献中3C-SiC薄膜的电阻率在10-2~10-1Ω·cm之间[11],Zhuang等人认为3C-SiC薄膜中的杂相如石墨烯会显著降低薄膜的电阻率[12]。氢气流量为0.5 slm时,薄膜样品的电子迁移率可达570 cm2V-1S-1,比室温下理论的电子迁移率(1000 cm2V-1S-1)低,高于文献CVD技术报道的最大电子迁移率550 cm2V-1S-1[13]。卫等人认为霍尔迁移率受晶格振动散射、电离杂质散射、载流子散射、中性杂质散射和谷间散射机制的影响,在室温下主要受杂质散射的影响[14]。在杂质浓度一定的情况下,半导体的电子迁移率与薄膜的结晶质量密切相关,薄膜的结晶质量越高,载流子的散射效应降低,使得霍尔迁移率提高[15]。

图5 一级孪晶含量与H2流量的关系

图6 孪晶形成简图:(a)Si原子在{111}面上的错误堆积,(b)Si原子在{111}面上的错误堆积的延伸,(c)孪晶形成
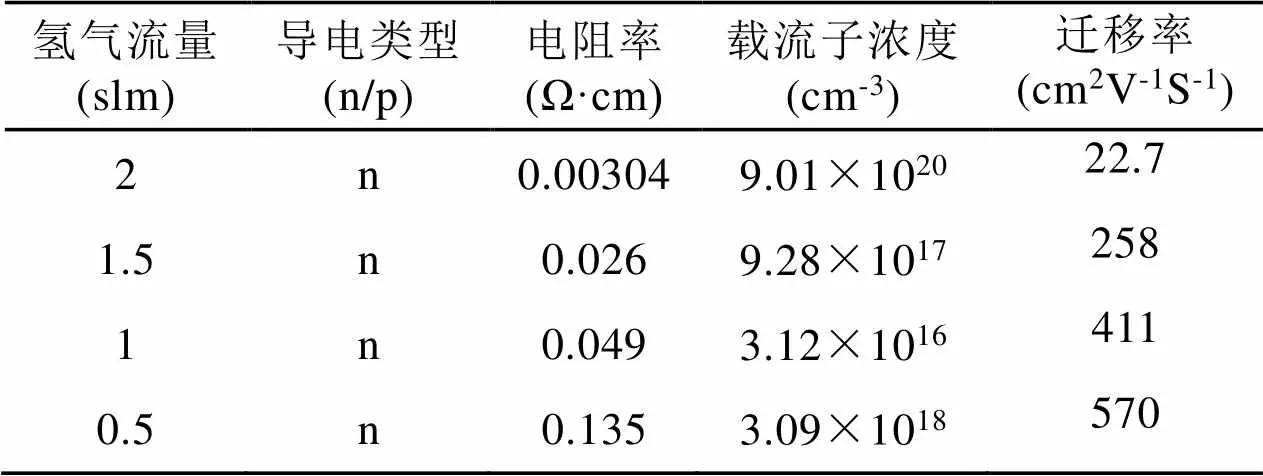
表2 不同氢气流量下制备的3C-SiC薄膜的霍尔效应测试结果
3 结论
本文采用激光化学气相沉积制备了<001>-3C-SiC薄膜,薄膜的沉积速率、孪晶含量随氢气流量的增加呈下降趋势,薄膜的粗糙度随氢气流量的增加呈上升趋势,当氢气流量为0.5 slm时,薄膜具有最大的电子迁移率590 cm2V-1S-1。
[1] Wang Y, Li S, Han J. Enhanced photoelectroctatlytic performance of etched 3C–SiC thin film for water splitting under visible light[J]. RSC Adv., Royal Society of Chemistry, 2014, 4(97): 54441–54446.
[2] Shariatmadar Tehrani F, Rahman S A. Influence of filament-to-substrate distance on the spectroscopic, structural and optical properties of silicon carbide thin films deposited by HWCVD technique[J]. Journal of Materials Science: Materials in Electronics, 2014, 25(5): 2366–2373.
[3] Syväjärvi M, Ma Q, Jokubavicius V. Cubic silicon carbide as a potential photovoltaic material[J]. Solar Energy Materials and Solar Cells, Elsevier, 2015: 1–5.
[4] Nagasawa H, Yagi K, Kawahara T. Hetero- and homo-epitaxial growth of 3C-SiC for MOS-FETs[J]. Microelectronic Engineering, 2006, 83(1): 185–188.
[5] Michaud J F, Portail M, Chassagne T. 3C-SiC: New Interest for MEMS Devices[J]. Materials Science Forum, 2014, 806: 3–9.
[6] Technology E, Arci P D, Allegra B T. 3C-SiC epitaxial growth on large area silicon : Thin films[J]. Research Signpost, 2012, 661(2): 145–191
[7] Harima H. Raman scattering characterization on SiC[J]. Microelectronic Engineering, 2006, 83(1): 126–129.
[8] Bosi M, Watts B E, Attolini G. Growth and characterization of 3C-SiC films for Micro Electro Mechanical Systems (MEMS) applications[J]. Crystal Growth and Design, 2009, 9(11): 4852–4859.
[9] Lefebvre D, Chenot S, Roudon E. Growth mode and electric properties of graphene and graphitic phase grown by argon – propane assisted CVD on 3C – SiC / Si and 6H – SiC[J]. Journal of Crystal Growth, 2012, 349: 27–35.
[10] Yun J, Takahashi T, Mitani T. Dependence of stacking fault and twin densities on deposition conditions during 3C-SiC heteroepitaxial growth on on-axis Si(001) substrates[J]. Journal of Crystal Growth, 2006, 291(1): 148–153.
[11] 石彪. 单晶硅衬底异质外延3C-SiC薄膜研究进展[J]. 2011, 30(05): 1083-1088.
[12] Zhuang H, Yang B, Heuser S. Graphene/3C-SiC Hybrid Nanolaminate[J]. ACS Applied Materials and Interfaces, 2015, 7(51): 28508–28517.
[13] Yamanaka M, Daimon H, Sakuma E. Temperature dependence of electrical properties of Nitrogen-doped 3C-SiC[J]. Japanese Journal of Applied Physics, 1987, 26(5A): L533–L535
[14] 卫静婷,陈利伟. 半导体载流子迁移率及电阻率的计算模型[J]. 内江师范学院学报, 2016, 31: 43–47.
[15] 杜学舰. 同质外延氧化镓薄膜和铝铟氧薄膜的制备及性质研究[D].山东:山东大学,2017.
Effect of diluting gas flow rate on epitaxial grown 3C-SiC thin film
Zhu Peipei1, Xiong Mengyang1, Tu Rong2
(1. Wuhan Institute of Marine Electic Propulsion, 2. Wuhan University of Technology,Wuhan 430064, China)
It is found that the maximum mobility of 590 cmVSoccurs at the hydrogen flow rate of 0.5 slm.
O484
A
1003-4862(2022)10-0028-04
2022-07-30
朱佩佩(1988-)女,博士,研究方向:功能材料。E-mail:523192486@qq.com
