InSb(111)衬底上外延生长二维拓扑绝缘体锡烯/铋烯的差异性研究*
2022-09-30郑晓虎张建峰杜瑞瑞
郑晓虎 张建峰 杜瑞瑞†
1) (北京大学物理学院,量子材料科学中心,北京 100871)
2) (北京量子信息科学研究院,北京 100193)
近些年,人们对拓扑材料体系的认知得到了飞速发展.随着量子信息科学与技术成为当下科学研究的热点,具有大能隙高稳定性的低维拓扑材料有从基础研究向应用探索的趋势发展.如何实现高质量、大面积的单晶生长是影响拓扑材料走向实用化的重要一步.本文报道了在具有Sb 原子终止面的InSb(111)衬底上利用分子束外延技术生长低维拓扑绝缘体锡烯与铋烯的实验结果.实验中发现,无论是锡烯还是铋烯,起始外延阶段都会在衬底上形成单层的浸润层.由于锡原子之间的相互作用远强于其与衬底的表面结合力,因此浸润层呈岛状生长,晶畴岛与岛合并的过程中边界效应明显,导致薄膜实际上由大量小晶畴拼接而成,畴壁处的缺陷难以避免.而浸润层的晶体学质量又限制了后续锡烯薄膜的外延行为,因此实验发现难以实现高质量且层数准确可控的单晶锡烯薄膜生长.而铋原子与衬底表面的结合能强于原子之间的相互作用,能够在较高温度下实现浸润层的单层层状生长,高质量的浸润层为后续铋烯的生长提供了良好的外延过渡层,因此发现实验中更容易得到大面积的铋烯薄膜.本文实验结果及相关理解对于利用半导体衬底生长低维拓扑晶体薄膜具有指导意义.
1 引言
经过近二十年的发展,拓扑材料学已经成为凝聚态领域一个重要的分支.拓扑材料不仅能帮助我们更深入地了解物质的奇异结构和性质,也为微电子学和超导领域带来了新的探索空间,更有可能助力未来量子信息技术的发展.尤其是具有拓扑边界态的低维拓扑绝缘体,由于其能够实现无耗散的导电通道,不仅有利于量子器件的开发及电学性质的测量,而且与超导材料制备异质结后,更有望实现拓扑量子比特的构筑及操控[1-4].高质量的拓扑绝缘体已然成为了材料学家及物理学家追求的重要目标.早期基于量子阱结构的HgTe 及InAs/GaSb二维电子气已经通过低温输运实验观测到了量子化的边缘态输运信号[5-7],证实为二维拓扑绝缘体.这两类体系具有复杂的异质结构、生长难度较大,且带隙相对较小,需要在极低的环境温度下才能观测到拓扑性质,不利于性质研究以及未来潜在应用开发.因此,新型结构简单且稳定的二维拓扑绝缘体仍然是该领域研究探索的重点与难点[8].随着机器学习及新的计算方法在材料设计上的应用,大量具有强自旋耦合的二维宽带隙材料被预言具有拓扑性质[9,10].通过实验研究者不懈地努力,诸如锡烯(stanene)[11-14]、铋烯(bismuthene)[15-17]以及具有磁性的二维拓扑绝缘体材料[18-21]已经在实验室持续被合成,其拓扑性质也得到越来越广泛地研究,为量子技术的发展储备了大量的材料与理论支撑.然而,目前在高质量材料合成中仍然存在诸多挑战,如大部分大能隙的低维拓扑材料只能在金属衬底上通过金属的催化效应才能获得高质量的大单晶.如果将合成的薄膜通过严苛的方法转移到绝缘衬底上再进行电子输运测量和微纳器件制备,就需要材料具有较高的稳定性,并且需要严苛的转移技术相辅助,这也成为拓扑器件制备中面临的重大挑战.此外,目前整个微电子领域是基于半导体材料建立起来的,已经拥有了强大而完善的工艺体系,能够满足各种半导体器件的规模化集成.因此能够在生长环节直接以半导体为基底实现高质量拓扑材料的合成,就有可能在未来的应用中充分利用现有的半导体工艺开发适用于拓扑材料的量子器件,对拓扑材料在未来量子信息科技中得到广泛应用产生开拓性的影响.
过往的研究显示,锡烯与铋烯两种宽带隙二维拓扑绝缘体的带隙宽度均为几百毫电子伏特,有望在室温下保持拓扑态,且实验证实两者均能够在大气环境下稳定存在[22,23].实现两者的高质量生长,尤其是基于半导体衬底实现外延生长意义重大.因此我们在实验中重点关注了这两种二维拓扑材料的分子束外延(molecular beam epitaxy,MBE)生长情况.本文对比研究了利用B 面(Sb 原子面)InSb (111)衬底外延生长锡烯与铋烯薄膜的实验结果.希望通过对具体生长参数及生长动力学的分析,能够探究出半导体衬底外延二维拓扑绝缘体薄膜的一般规律.在生长过程中,发现第一层锡(Sn)及铋(Bi)原子被沉积到衬底表面后,都很难直接形成锡烯与铋烯的晶格结构,而是首先形成浸润层(wetting layer),为后续外延提供过渡.在生长第二层时,锡烯与铋烯的晶格能够在扫描隧道显微镜(scanning tunneling microscopy,STM) 下被清晰地观测,但由于Sn 与Bi 两者的浸润层生长模式不同,Sn 浸润层的岛状生长导致薄膜存在晶畴拼接现象及畴壁缺陷,因此后续外延出的锡烯薄膜质量较差,很难实现大单晶成膜.而对于Bi 的浸润层层状模式生长更显著,能够均匀成膜,为后续铋烯外延生长提供可靠支撑,因此经过生长参数优化以及退火工艺能够在浸润层上形成高质量的铋烯单晶,通过扫描隧道谱(scanning tunneling spectroscopy,STS)的测量能够在体态中观测到明显的带隙以及无能隙的边缘态.
2 InSb(111)上锡烯的生长
图1 总结了InSb(111)外延衬底、锡烯以及铋烯的晶格结构特点.锡烯和铋烯晶格与InSb(111)表面晶格排列相似,均为蜂窝状结构.且作为二维拓扑绝缘体,锡烯与铋烯均具有翘曲结构.从已经发表的计算文章中可知,在不受衬底因素影响时锡烯与铋烯的晶格常数十分接近,分别约为4.67 Å(锡烯)[24,25]与4.58—4.64 Å (铋烯)[15,26],两者的晶格常数均与InSb(111)晶格常数4.58 Å[27]相匹配,满足在InSb(111)衬底表面外延生长的基本条件.从数据上看,InSb(111)衬底上外延的锡烯与铋烯晶格会存在少许的压缩应力,其中锡烯的应力会略大于铋烯.如果采用其他外延衬底,由于两种拓扑绝缘体均具有翘曲结构,在不同衬底上晶格常数受晶格失配影响会有较大幅度的变化.因此,在以往的实验中锡烯的晶格常数从4.3 Å到5.1 Å都有报道[11,14,25,28,29],而铋烯的晶格也能够从4.42 Å延展到5.35 Å[15-17,30].从图1(a)可以看到,锡烯的翘曲高度(上下两层锡原子的距离)约为0.84 Å[28];而铋烯的翘曲高度接近锡烯的两倍(约1.6 Å)[15].因此理论上,如果两者与衬底之间具备足够的结合能,翘曲结构足以使其克服晶格失配带来的晶格应力.而铋烯的晶格常数有更大的拓展空间,能够承受更大的与外延衬底的晶格失配度.
为了实际对比两种拓扑绝缘体的生长差异,我们选用了相同的以Sb 原子为终结面(B 面)的InSb(111)单晶作为外延衬底(如图1(a)中所示).依据相关报道以及我们以往的生长经验,利用IIIV 族半导体原子极性较大的B 面作为衬底外延二维拓扑绝缘体更有利于拓扑绝缘体获得更大的带隙宽度[23,31,32].在生长锡烯或铋烯之前,半导体衬底需要在超高真空中用氩离子以500 eV 的能量溅射清洁表面的氧化层,然后在超高真空(优于5×10—10Torr (1 Torr=1.33322×102Pa))的环境中以380 ℃退火30 min.此程序一般循环两至三次才能够获得具有原子平整度的外延面.如图2(a)STM照片所示,衬底表面的原子台面及台阶清晰可见,且从低能电子衍射(low energy electron diffraction,LEED)结果中可以看到,InSb(111)蜂窝状排列的原子所对应的六个衍射点.但同时,LEED 结果也显示在InSb(111)表面存在 3×3 原子重构.这种表面重构在原子分辨的STM 成像中能够更清晰地被观测,如图2(b)所示.接下来利用STM 对锡烯的生长过程进行了监测,当少量Sn 原子在衬底保持室温(约25 ℃)条件下被沉积到InSb(111)表面时,Sn 原子会形成无序分布的三维核,这些成核点获得更多的沉积物后形成如图2(c)所观察到的岛.岛的大小受Sn 原子在表面的扩散能力及成核点继续俘获Sn 原子的能力影响.从图2(c)中岛的分布密度可以看出,Sn 原子间相互结合的能力相比Sn 原子与InSb(111)衬底之间的结合能更强,因此沉积的原子并没有均匀分散在衬底表面实现单层的层状生长,而是趋向于岛状模式生长.如图2(d)中的上图,我们着重测量了单个岛的形貌,直观上看已经初具单晶形态,具有明显的边缘,且形状接近六边形,其大小约为4 nm,高度为650 pm,略高于单层Sn 膜的高度.但从晶格结构也很难看到清晰的蜂窝状原子排列,因此不能确定岛状结构为锡烯单晶.当更多的Sn 原子沉积到衬底表面后,发现所形成的岛对Sn 原子的吸附能力降低,并没有像理想中岛状生长过程: 小岛逐渐变大并合并生长更大的岛.而是Sn 原子在基底表面扩散能力降低,弥散在整个基底表面,如图2(e)所示.从较大尺寸STM 形貌图上已经很难看到清晰的薄膜的晶体形态.为了增加Sn 原子在表面的扩散能力,对图2(e)中的样品进行退火处理.经过逐渐提高退火温度,发现在约为230 ℃的温度下退火能够获得最佳的成膜质量;温度继续升高,Sn 原子会脱离衬底表面被二次蒸发.这也与之前报道的在InSb(111)衬底上外延锡烯的退火温度相一致[14,30].图2(f)展示了样品在230 ℃条件下退火40 min 的表面形貌,可以看出大量的岛状结构已经联通,实现了表面的完整覆盖,且表面平整度有了显著的提升.但从高分辨STM 图中仍然可以看到,薄膜存在大量的孔洞缺陷,而且薄膜整体由大量三角或类三角的单晶晶畴岛拼接构成,意味着岛状晶畴在合并过程中存在应力释放的过程,如图2(g)左图所示.实验中,也尝试通过改变生长参数来进一步提升薄膜质量,如在Sn 原子沉积同时给衬底加热,但发现对改善Sn 膜的质量收效甚微,很难有效地避免孔洞缺陷的形成,尤其在单层薄膜生长的最后阶段所沉积的Sn 原子很难填充这些孔洞.在具有整齐原子排列的晶畴上测量了原子间距,显示晶格常数超过9 Å,接近锡烯晶格的2 倍,预示着第一层Sn 膜并不具有锡烯的晶格结构,而是存在 2×2 原子重构.但从退火前后以及InSb(111)衬底的LEED 衍射结果看,当Sn 原子沉积到衬底上后原来InSb(111)表面 3×3 原子重构消失(图2(a)、图2(e)和图2(g)).因此可以推断出,Sn 原子与InSb(111)衬底表面悬挂键存在较强相互作用以使悬挂键得到饱和.据此,推断首层Sn 膜以浸润层(wetting layer)的形式存在.由于该浸润层又将作为后续锡烯的外延衬底,因此其质量会对后续外延层的质量产生重要的影响.

图2 (a) 经过500 eV Ar 离子轰击及380 ℃退火处理的InSb(111)表面的STM 形貌图及LEED 测量结果,在LEED 结果中绿色圆圈标识了InSb(111)晶格所对应的衍射斑点,红色圈出的衍射点证实了表面存在的 3×3 原子重构;(b) 原子分辨的InSb(111)衬底表面晶格成像,直观清晰地呈现了表面重构的原子结构;(c) 少量Sn 原子(930 ℃,5 min)在室温下沉积到衬底上的STM 形貌图,成核点逐渐形成岛状结构;(d) 上: 放大显示的Sn 原子构成的岛状结构,下: 岛状结构的高度为单原子层;(e) 当接近一层的Sn 原子(930 ℃,15 min)沉积到InSb(111)衬底后的表面形貌,显示原子排列较为杂乱,并未形成晶体学薄膜;LEED 衍射斑点显示衬底的晶格特征,其中衬底重构消失;(f) 对图(e)中的样品进行230 ℃真空退火后的薄膜相貌,显示平整度显著提升;(g) 左图: 高分辨测量显示三角形晶畴形成,但并不连续,存在明显的缺陷,晶格常数约为9 Å;右图: 退火后样品的LEED 衍射结构没有显著变化.STM 测试条件: 测量温度为77 K;样品偏压为600 mV;阈值电流为200 pAFig.2.(a) STM morphology of InSb(111) substrate that has been processed with 500 eV Ar ion bombardment following with annealing at 380 ℃;the inset shows the LEED pattern acquired at 56.4 eV,which presents the diffraction points (red circles) of the 3×3surface reconstruction,green circles reveal the lattice of InSb(111) surface;(b) atomic-resolved STM image of the InSb(111)where the surface reconstruction can be directly observed;(c) STM image of the InSb(111) surface after Sn atoms being deposited(930 ℃,5 min),Sn islands can be observed;(d) up panel: STM image of a single Sn island;down panel: height profile of the island;(e) STM morphology of the surface with monolayer Sn atoms deposited,there is no clear atom structure,and the LEED pattern inset shows the surface reconstruction disappears;(f) STM morphology presents the surface evolution after 230 ℃ annealing in the vacuum;(g) left: high-resolution STM image shows the noncontinuous domains and defects in the Sn-wetting layer;right: LEED patterns of the annealed sample.STM parameters: T=77 K,sample bias=600 mV,setpoint current=200 pA.
我们又通过STM 监测了第二层的Sn 膜的生长情况.如图3(a)所示,当第二层90%的Sn 原子被沉积到衬底表面后,经过与第一层相同的退火处理,发现第二层Sn 膜逐渐形成.但仔细观察薄膜形态发现第二层Sn 膜受第一层Sn 膜浸润层影响严重,也明显由大小形态类似的岛状晶畴拼接构成.当接近100%的第二层Sn 原子量被沉积后,我们可以看到较为连续的第二层Sn 膜,如图3(b)所示.在STM 形貌图上,由于原子沉积不足导致的缺陷清晰可见,而且从缺陷的形态可以看出,大量三角形或类三角形的缺陷具有基本相同的取向,证明第二层Sn 膜仍以外延模式生长.但通过原子分辨的STM 测量可以发现,相对连续的Sn 膜仍然很难避免由大量小晶畴拼接的现象,如图3(b)所示.情况与浸润层类似,在生长过程中尝试通过延长样品退火时间,改变样品沉积过程中衬底的温度,但对改善薄膜质量都收效甚微,再次证明浸润层的形态直接决定后续薄膜的生长.图3(c)展示了当Sn 原子量沉积到约为第三层时所获得的薄膜的形态,受第一及第二层Sn 膜晶体质量的影响,第三层薄膜仍由大量小晶畴拼接而成,其Sn 原子也并非严格局限在第三层,而是出现了多层薄膜同时生长的情况,导致很难再控制薄膜的层厚.但从原子分辨的STM 结果看,多层锡膜晶畴的原子结构与理想的锡烯晶格能够完全匹配,证明这些小晶畴就是锡烯.在我们之前的文章中[23],对所生长的锡烯薄膜的性质也进行了较为系统的研究,虽然薄膜质量有待提高,但其稳定性,拓扑性质以及低温磁输运结果都证实其具有广泛的研究价值[23].从目前已经被报道的实验结果看,高质量的锡烯薄膜一般都生长在金属衬底上,比如Ag(111)上高质量大尺寸的锡烯[33],Cu(111)衬底上外延获得超平整的锡烯单晶[11],低翘曲的Bi 衬底锡烯等[24].而在半导体衬底上如Bi2Te3(111)[14],InSb(111)[23,31],PbTe[34]所生长的锡烯质量均有待提高,且普遍具有如上述的晶畴拼接现象.我们认为半导体衬底虽然与锡烯的晶格具有较高的匹配度,但由于半导体很难像金属衬底提供丰富的自由电子,因此生长过程不具备催化性,且与外延层的相互作用不如金属高;如果所沉积的原子之间相互作用较强,当晶畴生长到一定尺寸后,层间应力容易使外延层原子相对衬底发生移动,因此在应力释放过程中形成晶畴拼接及筹壁缺陷.
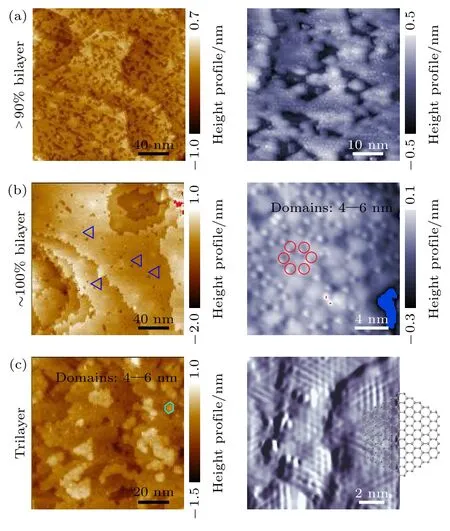
图3 (a) 浸润层上第一层Sn 沉积约为90%时退火后样品的STM 形貌图,不同尺寸的视野显示薄膜具有岛状生长的特征,并且除了存在大量空隧道外表面还存在大量原子吸附;(b) 当Sn 原子沉积接近100%时,STM 图像显示薄膜变得连续但仍然存在由于晶畴拼接导致的三角形缺陷,且三角形具有相同的取向;放大的STM 图像显示薄膜由大量4—6 nm 小晶畴构成,畴壁处的缺陷导致原子吸附;(c) 当第3 层Sn 原子沉积并退火后,大量小晶畴拼接薄膜的行为越发明显,从小晶畴的晶格形貌与理想锡烯对比,发现这些小晶畴为锡烯单晶.STM 测试条件: 测量温度为4.2 K;样品偏压为1.5 V;阈值电流为1.5 nAFig.3.(a) STM images of the annealed sample after about 90% Sn atoms being deposited on the Sn wetting layer,the high-resolution STM image in the right panel shows the adatoms and defects;(b) STM images of the sample with 100% Sn atoms deposited on the wetting layer shows the continuous film with some triangle defects,the high-resolution image in the right panel shows the film is composed by many small domains (4—6 nm) with defects on the domain walls;(c) STM images shows the third layer Sn-film is formed when the sample is annealed with enough Sn atoms being deposited;the film is obviously formed by many small domains,and the lattice structure of the domains fit the lattice of stanene very well.STM parameters: Temperature=4.2 K,sample bias=1.5 V,setpoint current=1.5 nA.
3 InSb(111)上铋烯的生长
接下来利用同样的外延衬底以相似的生长条件: 即在同样的B 面InSb(111)衬底上,在室温下进行Bi 原子沉积,尝试铋烯的外延生长.第一层Bi 原子量沉积到衬底表面后,对样品进行了LEED与STM 形貌的表征,可以看到LEED 衍射图案已经从InSb(111)衬底的 3×3 重构图样变成了1×1的衍射图样,与沉积Sn 原子的情形一致.说明Bi 原子同样能够消除InSb(111)表面的原子重构,表面Sb 原子的悬挂键转而与Bi 原子相互成键(图4(a)),同样意味着Bi 原子与衬底之间存在较强的相互作用.观察STM 图像可以发现,类似于生长锡烯,在室温下所沉积的Bi 原子在InSb(111)表面同样动能较低,无法完全克服Bi 原子之间的吸引力,均匀分布于衬底表面.但相比于Sn 原子的岛状生长,Bi 原子之间的相互吸引力相对较弱,岛状模式生长并不明显,如图4(b)所示.当给样品施加一定的退火温度后,Bi 原子会获得更高的表面迁移能.对比退火前后的LEED 衍射结果,发现表面原子结构从宏观上并没有显著差异,但能够观测到 2×2 的原子重构,说明退火后Bi 原子出现了重构现象,这与Sn 的生长也十分类似,如图4(c)所示.从原子形貌上看,退火过程中Bi 原子在衬底表面动能增加,原子之间的结合能明显弱于Bi 原子与衬底之间的结合力,Bi 原子实现了在衬底表面的平铺,薄膜以单层模式生长为主,实现了整个衬底表面的全覆盖.逐步提高退火温度并通过观察表面原子形貌变化,最终在退火温度350 ℃时,观察到Bi 原子排列相对规则且连续,如图4(d)所示.当继续提高退火温度后,衬底表面会变的不稳定,因此已经不能通过继续升高退火温度的方式提高Bi 膜的质量.从STM 形貌图可以发现,在退火后形成的薄膜中的某些区域内Bi 原子形成了四方结构(图4(d)虚线框内),并不是预期的蜂窝状结构.这与Bi 室温下生长在Si(111)表面初期的准立方相类似,可解释为由于这种四方结构在生长初期阶段结合能更低,更容易稳定形成[35,36].为了进一步增加Bi 原子在表面的迁移能,在后退火的基础上又在生长过程中对衬底加热,经过详细的条件摸索,发现生长时衬底温度设定为300 ℃沉积Bi 原子,然后对样品再进行350 ℃,30 min 的退火能够达到最优的薄膜质量.如图4(e)所示,第一层Bi 膜能够具有较高的匀质性,实现了单层全覆盖,且四方结构得到了有效抑制.图4(f) 上图中展示了高分辨单层Bi 膜的晶格形态,但从晶格形貌看,首层Bi 膜不具有铋烯蜂窝状晶格结构且晶格常数超过9 Å,约为铋烯晶格常数的两倍,证实存在Bi 的 2×2 重构,结果与LEED 结果所观测到的衍射斑点相一致.考虑衬底表面重构在沉积Bi 原子过程中发生变化,首层Bi 原子与衬底悬挂键存在较强的键合作用,能够判定首层Bi 膜依然为浸润层.但相比Sn 膜形成的浸润层,Bi 膜浸润层具有较高的质量,原子排列更为规则(如图4(f)所示),为后续实现铋烯薄膜的外延生长提供希望.
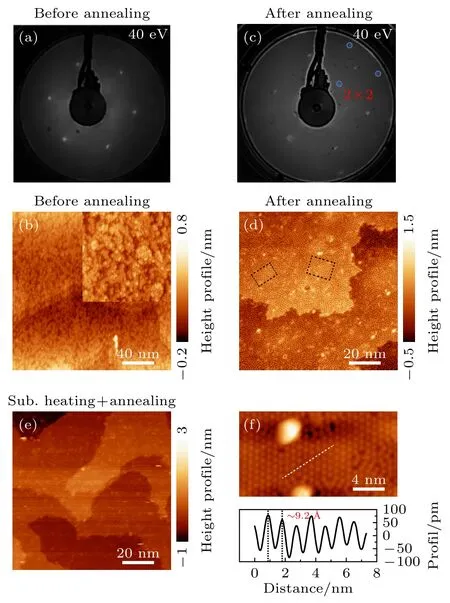
图4 (a),(b) 单层铋原子沉积到InSb(111)衬底后,LEED以及STM 结果,其中LEED 衍射斑点显示InSb(111)衬底的原子重构消失;(c),(d) 同一样品逐渐升温至350 ℃退火30 min 后的LEED 及STM 测量结果,其中在图(c)中隐约能够观测到Bi 膜 2×2 重构所导致的衍射斑点;(d) 图中用虚线框出了出现四方结构的区域;(e) 当衬底温度为300 ℃时,沉积单层铋原子并退火后形成连续且匀质的浸润层STM 形貌图;(f) 原子分辨的STM 形貌显示浸润层存在 2×2 原子重构,沿着图中白线获得的浸润层轮廓线显示浸润层的晶格常数约为9.2 Å.STM 测试条件: 测量温度为77 K;样品偏压为1 V;阈值电流为500 pAFig.4.(a),(b) LEED and STM image of sample with monolayer Bi atoms are deposited on InSb(111) substrate;LEED pattern shows the 3×3 surface reconstruction disappears after deposition of Bi atoms;(c),(d) the same sample as that in panel (a) and (b) but after being annealed at 350 ℃for 30 min; 2×2 surface reconstruction can be distinguished in the LEED pattern;and the region with black dashed squares show the tetragonal lattice;(e) STM morphology of the sample with both post-annealing and heating of substrate at 300 ℃ during deposition of Bi atoms,which shows uniform Bi film;(f) up panel: high-resolution STM image of the first Bi layer on InSb(111);down panel:the profile along the white dashed line in the up panel show the lattice constant is about 9.2 Å.STM parameters: Temperature=77 K,sample bias=1 V,setpoint current=500 pA.
在以上摸索出的最优生长条件下,延长了沉积Bi 原子的时长.根据大尺寸STM 形貌表征结果可以判断,Bi 在浸润层以上为岛状生长,但与锡烯对比所形成的岛对后续Bi 原子的吸附能力更强,能够形成更大尺寸的单晶结构.如图5(a)所示,能够在同一STM 视野内同时观测到浸润层以及另外两层的Bi 膜存在(2-Bi,3-Bi),通过厚度测量,发现单层薄膜的厚度约为550 pm (图5(b)),且边界整齐,符合外延单晶的形态,且单晶上存在层间的台阶.图5(c)中,对浸润层上第二层Bi 膜(记作3-Bi/InSb)的形态进行了高分辨的STM 成像,发现薄膜中存在少许的空位缺陷.把原子结构与理想铋烯的进行了对比,可以看到其晶格周期与理想铋烯的晶格完美匹配.这个结果证实利用InSb(111)衬底在浸润层以上能够实现高质量的铋烯生长.此外,还观察到生长得到的铋烯边缘具有规则结构,为zig-zag 形.规则的几何形状有利于观测拓扑边缘态.在台面远离边缘处,我们对样品的表面态进行了表征,通过多点平均化的STS 隧穿谱显示体态具有稳定的隧穿谱线,且能隙约为0.15 eV,和浸润层的能隙约0.3 eV 相比有所下降(如图5(f)所示),但作为拓扑绝缘体的体态能隙其已经能够实现室温下保持相关拓扑性质.根据已有报道,衬底表面原子极性会影响外延层的能隙大小,由于浸润层与InSb(111)表面存在较强相互作用,因此能带隙会较大,但随着Bi 或者Sn 原子层数增加,带隙会更趋近于铋烯与锡烯的本征能隙,实验中Bi 膜沉积过程中观测到的能隙随层数变化趋势与理论预测相符[37],也与我们沉积Sn 膜的结果相一致[23].而在台阶边缘处,可以看到清晰稳定的“V”字型金属态,如图5(f)所示,预示着其边缘可能存在受拓扑保护的边缘态,但其详细可靠的拓扑性质还需要更进一步的实验验证.

图5 (a) STM 形貌图显示浸润层上生长出具有规则边缘的1 层(2-Bi)及2 层(3-Bi)锡烯单晶;(b) 1 层锡烯膜的厚度约为550 pm;(c) 第二层(3-Bi)的铋烯的原子形貌图,其中薄膜中普遍存在原子空位缺陷;对比可以看出单晶薄膜完好匹配理想锡烯的晶格结构;(d) 3-Bi 锡烯层的晶格常数约为4.5 Å;(e) 液氮温度下浸润层dI/dV 谱,通过对浸润层上多点谱线进行平均显示浸润层具有稳定的带隙,约为0.3 eV;(f) 在3-Bi 上((c)中右图星形及圆形标示位置)获取的dI/dV 谱线,显示其体态具有约为0.15 eV 的能带隙而边缘处为无能隙状态,符合拓扑绝缘体边缘态的特征.STM 测试条件: 测量温度为77 K;样品偏压为1 V;阈值电流为500 pA.STS: 锁相频率为707 Hz,调制电压为8 mVFig.5.(a) STM image captured on a region containing wetting layer,the first bismuthene layer (2-Bi) and the second bismuthene layer (3-Bi);the bismuthene domain has very sharp edges;(b) line profile across 2-Bi and the wetting layer shows the thickness of bismuthene monolayer is about 550 pm;(c) left: atomic-resolved STM image on 3-Bi film shows the vacancies,and in the right panel comparison between the lattice of 3-Bi and the lattice model of bismuthene shows good consistency;(d) profile along the white dashed line in panel (c) shows the lattice constant of bismuthene is about 4.5 Å;(e),(f) the tunneling spectra which reveal the surface density of states acquired on the wetting layer and the 3-Bi layer;it shows the gapless edge state at the edge of the 3-Bi layer compared with that on the bulk.STM parameters: Temperature=77 K,sample bias=1 V,setpoint current=500 pA.STS: lockin frequency=707 Hz,modulation voltage=8 mV.
4 结论
用同样的Sb 面的InSb(111) 外延衬底,通过分子束外延的方式尝试了锡烯与铋烯薄膜的生长.从实验结果看,由于衬底表面在经过氩离子轰击及退火程序后,悬挂键为降低表面能量产生了3×3表面重构,当沉积Sn 或者Bi 原子后,整个表面的化学环境会产生新的调整,结果便是在外延的开始阶段都会产生一层浸润层,浸润层中均观测到了2×2原子重构.浸润层由于与衬底较强的相互作用,STM 测量结果发现其一般具有较大的能隙.从浸润层的成膜过程看,Sn 膜以岛状模式生长,在约为230 ℃的退火条件下能够达到最佳的成膜条件,但成膜质量较差,普遍存在晶畴拼接及筹壁缺陷;而Bi 膜层状模式生长更为显著,在衬底300 ℃加热条件下蒸发Bi 原子并结合350 ℃后退火能达到最佳的成膜质量,薄膜连续均匀.从能够承受更高的退火温度看,Bi 原子与衬底InSb(111)的结合能力远超Sn 与衬底的结合能,而Sn 原子之间的结合能又高于Bi 原子,这也是导致两种浸润层生长差别的主要原因.浸润层作为后续薄膜生长的外延层,其质量直接影响后续薄膜的生长.其结果是后续生长的锡烯连续膜也出现了大量单晶晶畴拼接的情况,且在薄膜超过三层后即很难实现层数可控生长.而Bi 原子能够在浸润层上形成高质量的铋烯单晶结构,而且更容易通过沉积时间控制薄膜的厚度.
