质子辐照作用下浮栅单元的数据翻转及错误退火
2022-06-18刘晔郭红霞琚安安张凤祁潘霄宇张鸿顾朝桥柳奕天冯亚辉
刘晔 郭红霞 琚安安 张凤祁 潘霄宇 张鸿 顾朝桥 柳奕天 冯亚辉
1) (湘潭大学材料科学与学院,湘潭 411105)
2) (西北核技术研究所,西安 710024)
1 引言
Flash 存储器自诞生以来发展十分迅速,在半导体存储市场占据主导地位.NAND (not and)flash 存储器在较低的电压下即可实现擦除与重新编程[1-3],存储容量大且价格低,在航空航天领域中得到了广泛的应用[4,5].太空辐射环境会严重影响flash 存储器的工作状态和使用寿命[6],这会极大限制商用flash 器件在航天系统中的应用.
近几十年来,国内外对flash 存储器的重离子和质子辐射效应开展了诸多的研究[7-19].Bagatin 等[13]利用29.4—200.0 MeV 质子开展了25 nm NAND flash 的单粒子效应实验,结果表明25 nm 多层存储单元(multi level cell,MLC)的单粒子翻转(single event upset,SEU)截面随质子能量的降低而增大.该结果不符合当前存储器高能质子SEU的实验规律,这是因为实验中质子注量未保持一致.Chen 等[14]研究了NAND Flash 存储器在不同重离子注量下的SEU 效应,发现SEU 截面随重离子注量的升高而减小.卫星运行轨道上的质子注量远高于重离子注量,而关于质子SEU 效应与注量的相关性鲜有研究.因此,开展地面辐照实验来评估质子能量和注量对SEU 效应的影响是十分有必要的.
经质子辐照后,flash 存储器发生SEU,产生浮栅单元错误,该错误会随着退火时间的推移而发生改变.彭聪[15]在高能质子辐照25 nm Flash 存储器后研究了浮栅单元错误的退火特性,认为多陷阱辅助导电通道[16,17]使得浮栅单元错误增多,微剂量效应[18,19]使得浮栅单元错误减少,浮栅单元错误的增减是这两种机制竞争的结果.彭聪[15]虽然阐述了浮栅单元错误的变化过程,并对该过程进行了机制分析,但仍然有许多可深入研究的地方.例如,浮栅单元错误的增减与退火时间和质子能量的相关性,两种机制对浮栅单元数据保存能力的影响等.因此,本文开展了25 nm flash 存储器的质子辐照实验,主要研究了SEU 截面与质子能量和注量的相关性,浮栅单元错误的退火规律以及浮栅单元的数据保存能力.
2 实 验
2.1 实验样品
本次实验选用的器件是镁光公司生产的商用2D NAND flash 存储器,器件均采用环氧树脂进行48-pin TSOP 塑料封装,具体信息见表1.图1给出了25 nm 单层存储(sing level cell,SLC)浮栅单元的透射电子显微镜(transmission electron microscope,TEM)横截面.Flash 存储器的单个存储单元为浮栅晶体管,结构与普通的金属氧化物半导体(metal oxide semiconductor,MOS)晶体管类似,但在栅极与沟道之间加了一层可存储电子的浮栅结构[17].根据单个浮栅单元的存储信息位数,可将NAND flash 分为SLC 和MLC.SLC 器件单个浮栅单元只能存储一位信息,阈值电压状态为“0”或“1”.MLC 器件单个浮栅单元可存储两位信息,可能的阈值电压状态有四个,分别为“00”,“01”,“10”和“11”.

表1 实验所用flash 存储器信息Table 1.Flash memory information used in the experiment.

图1 25 nm SLC 阵列浮栅单元的TEM 横截面Fig.1.TEM cross-section of 25 nm SLC floating cells array.
2.2 实验设置
利用西安200 MeV 质子装置开展flash 存储器的质子辐照实验,该装置可以引出60 MeV 的准单能质子束流,并通过选择不同厚度的铝箔降能片将质子能量调节到20,40 MeV.测试前,器件写入的测试图形为“55”,被固定在样品架的辐照板上.测试时,质子束流垂直入射flash 存储器,执行不加偏压的静态测试.辐照结束后,统计浮栅单元错误数量,并计算浮栅单元SEU 截面.SEU 截面由(1)式计算

式中,σ表示浮栅单元SEU 截面,单位为cm2/bit;Φ为质子总注量,单位为p/cm2;N为错误总数,M为存储单元存储容量,单位为bit.MLC flash存储器本身存在一定量的固有错误,在计算浮栅单元SEU 截面时会扣除MLC 器件中原有的固有错误[15].
3 实验结果分析
3.1 Flash 存储器质子单粒子翻转特性
通常认为存储器的SEU 截面会随着高能质子能量的升高而增大,直至达到饱和.文献[13]中的辐照实验由于未采用相同的质子注量,得出“25 nm MLC 的SEU 截面随质子能量的升高而减少”的结论,同注量而不同能量下的SEU 截面数据有待补充.此外,SEU 截面随重离子注量的升高而减小[14],这也应该引起学者们对不同注量下的质子单粒子测试标准的思考.因此,本文研究了不同能量和注量的质子SEU 特性.
3.1.1 质子能量对单粒子截面的影响
图2 显示了不同能量的质子辐照下MLC 和SLC 两款flash 器件的浮栅单元SEU 截面,质子能量分别为20,40 和60 MeV,注量为5×109p/cm2.从图中可以看出,25 nm flash 浮栅单元SEU 截面随质子能量的升高而增大.同为25 nm 工艺下,MLC 器件的质子SEU 截面更大.

图2 不同能量的质子辐照下浮栅单元SEU 截面Fig.2.Single event upset cross section of floating gate cells irradiated by protons at different energy levels.
对于MLC 器件的质子SEU 截面大于SLC 器件,国内外已有很多研究[15].MLC 器件一个浮栅单元存储2 bit 信息,有4 个阈值电压状态,对浮栅单元中电子的得失更为敏感.相比于SLC 器件,MLC 器件在质子辐照下失去更少的电子即可发生SEU[15].
高能区质子的直接电离线性传输值(linear energy transfer,LET)很低,只能通过反冲核的电离引起SEU.ENDF/B-VII.0 库有150 MeV 以下的p+28Si 反应全套核反应数据,这组数据是目前国际上质子单粒子效应研究主要的核数据来源.图3 显示了ENDF/B-VII.0 库中20—60 MeV 质子与Si 发生核反应产生反冲核的部分评价数据[20].随着高能区质子能量的升高,核反应道逐渐开放,能够引起SEU 的反冲核反应截面逐渐增大,浮栅单元SEU 截面增大.当质子能量大于50 MeV 时,核反应截面趋于稳定,SEU 截面趋于饱和[15].

图3 不同能量质子与Si 的核反应截面[20]Fig.3.Cross section of nuclear reaction between protons at different energy levels and silicon.[20].
3.1.2 质子注量对SEU 截面的影响
图4 显示了不同注量的质子辐照下MLC 和SLC 两款flash 器件的浮栅单元SEU 截面,质子能量为60 MeV,质子注量分别为109,2.5 × 109,5 × 109和1010p/cm2.可以看出,25 nm flash 浮栅单元SEU 截面随质子注量的增大而减少.

图4 不同注量的质子辐照下浮栅单元SEU 截面Fig.4.Single event upset cross section of floating gate cells irradiated by protons at different fluence levels.
高能质子引发的SEU 受到广大学者的关注,大量的质子截面测试数据被获取.根据质子SEU实验规律,Stapor 等[21]提出了双参数Bendel模型.双参数Bendel 模型与质子SEU 截面测试数据符合得很好,用于拟合SEU 截面曲线和预测质子极限截面,表达式为

式中,σp表示质子SEU 截面,单位为cm2/bit;E表示质子的能量,单位为MeV;A表示质子SEU截面的能量阈值,单位为MeV,对于特定电路来说,A是一个固定值;B为SEU 截面曲线的拟合参数.根据(2)式,特定电路的质子SEU 截面似乎只与能量相关,与注量无关.文献[12,13]在开展flash 的质子辐照实验中,也并未统一注量,这表明学者们普遍认为质子SEU 截面无注量相关性.
由于生产工艺上的误差,在同一个flash 存储器的浮栅单元存储相同数据时,其阈值电压也不完全相同,而是服从泊松分布规律,如图5(a)所示.当浮栅单元的阈值电压不相同时,其质子单粒子敏感性也会存在差异.Flash 存储器经质子辐照后,浮栅单元的阈值电压会降低,阈值电压低的浮栅单元更易跨过判读电压线而发生数据翻转,如图5(b)所示.

图5 浮栅单元阈值电压的分布示意图 (a) 辐照前;(b) 辐照后Fig.5.Schematic illustrations of floating gate cell distribution vs.threshold voltage:(a) Before the irradiation;(b) after the irradiation.
假设质子入射一个浮栅单元时,该存储单元的阈值电压足够低,它才有概率p发生SEU.假设flash 存储器中总存储单元个数有M个,阈值电压低的浮栅单元总数有N个.那么在质子每次都只能入射一个浮栅单元的前提下,第n个浮栅单元发生SEU 的概率P(n)为

由(3)式可知,随着n的增加,第n个浮栅单元发生SEU 的概率P(n)逐渐减少.对于flash 存储器,阈值电压低的浮栅单元占比(N/M)很小.在质子注量低时,样本总数中阈值电压低的部分浮栅单元会发生SEU.随着质子注量的增加,阈值电压低的部分浮栅单元已发生SEU.较之于辐照前期,后续辐照的浮栅单元样本总数未变,而可发生SEU 的浮栅单元阈值电压相对更高,使得后续辐照的SEU 概率更低.因此,较之其他非易失类存储器,由于浮栅单元单粒子敏感性的差异,flash 存储器的质子SEU 截面会随着注量的升高而减少.
这一现象将会引发flash 存储器质子SEU 测试可能存在的问题,过低注量的质子SEU 测试方法会高估flash 存储器的实际在轨SEU 概率.目前flash 存储器的SEU 测试中,质子注量普遍取5 × 109p/cm2,该注量远远低于航天器件在太空环境中接受的总注量[22].通过较高注量的质子SEU测试,可以更准确地预测实际在轨翻转概率.另一方面,在航天任务过程中,如果没有对flash 存储器重新写入正确数据,则错误将累积,使得在航天任务开始时的在轨翻转率将高于任务结束时的在轨翻转率.因此,对于flash 存储器的空间应用,研究不同注量质子辐照下的SEU 概率具有重要意义.
3.2 缺陷诱导浮栅电子的泄露
关于浮栅单元错误产生的机制,国内外已有一些解释.
(I) 瞬态导电路径[23,24]、瞬态载流子电流及浮栅电子的发射,导致浮栅中的电荷瞬间永久性丢失,浮栅单元阈值电压出现了负向漂移,负漂值为ΔVth,SEE.
(II) 浮栅电子被浮栅周围氧化物陷阱电荷所俘获[18,19],该机制导致的阈值电压负漂值为 ΔVth,TID.
(III) 高能粒子辐照在隧穿氧化层产生的缺陷形成多陷阱辅助导电通道[16,17],浮栅电子通过该通道缓慢泄漏,阈值电压负漂值为 ΔVth,DD.
如图6 所示,机制(I)、(II)和(III)均会引起浮栅单元阈值电压的负漂,当阈值电压跨过判读电压线时,浮栅单元存储的数据出现错误.在辐照结束后,机制(I)导致的浮栅单元错误占据主导地位,该类错误只能通过重新擦写才可以消除.在辐照后的退火过程中,机制(II)中俘获的电子可能随时间缓慢回到浮栅中,使得 ΔVth,TID减少.若浮栅单元阈值电压恢复到判读电压线之右,浮栅单元错误便会减少.这也是之前相关报道中重离子辐照下浮栅单元错误随辐照后时间不断减少的原因[18,19].在辐照后的退火过程中,浮栅电子因机制(III)随时间不断泄漏,使得 ΔVth,DD持续增大.部分未出现错误的浮栅单元阈值电压跨过判读电压线,浮栅单元错误增多.

图6 不同机制影响下的浮栅单元阈值电压变化示意图Fig.6.Schematic illustrations of threshold voltage changes of floating gate cells under the influence of different mechanisms.
综上所述,在退火过程中,机制(II)使浮栅单元错误减少,机制(III)使浮栅单元错误增多.为了探究浮栅单元错误的增减与退火时间和质子能量的相关性,将不同能量质子辐照后的SLC 器件保持无偏状态,在45 天内多次进行数据回读并记录浮栅单元错误数.此外,为了研究机制(II)和机制(III)分别对浮栅单元保存数据“1”和“0”能力的影响,将质子辐照后的SLC 器件进行重新擦写读操作,重新写入的数据模式有“FF”和“00”,并记录45 天内的浮栅单元错误数.
3.2.1 浮栅单元错误的退火特性
图7 显示了三种能量的质子辐照后45 天内SLC 器件的浮栅单元错误变化,质子能量分别为20,40 和60 MeV,注量均为5 × 109p/cm2.可以看出,在质子辐照后的退火过程中,浮栅单元错误比例不断增大;20 MeV 质子辐照下浮栅单元错误增加的比例最大.
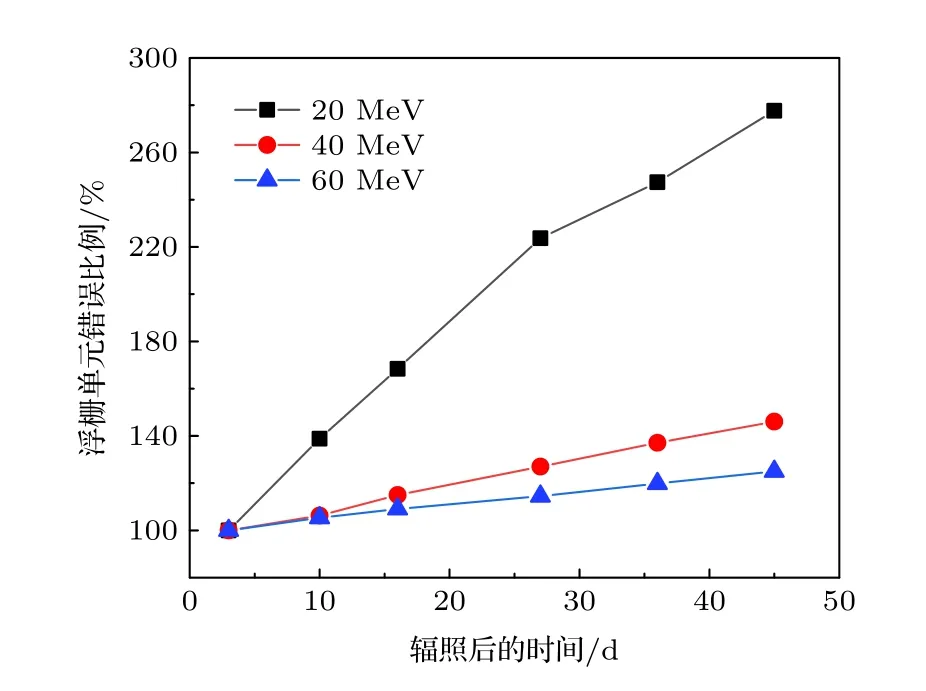
图7 不同能量质子辐照后45 天内浮栅单元错误变化Fig.7.Annealing of floating gate errors within 45 days after proton irradiation at different energy levels.
该现象说明,在质子辐照后的退火过程中,机制(III)中的多辅助陷阱导电通道占据主导地位,导致浮栅单元错误比例不断增大.相关研究[16,17]表明,对于65 nm MLC NOR(not or) Flash 器件,隧穿氧化层中只需两个缺陷足以产生辅助导电通道.一般来说,非电离能量损失的产生对应着间隙原子-空位缺陷的形成.为此,非常有必要研究质子在隧穿氧化层中的非电离能量损失.
Flash 存储器中的隧穿氧化物材料成分为SiO2,利用计算机仿真软件可得到SiO2中单位深度的非电离能量损失随质子能量的变化,仿真结果如图8所示.随着质子能量的降低,单位深度的非电离能损增大,隧穿氧化层中产生的缺陷越多,形成的多陷阱辅助导电通道更多,电子被泄漏的浮栅单元更多,浮栅单元错误数更多.
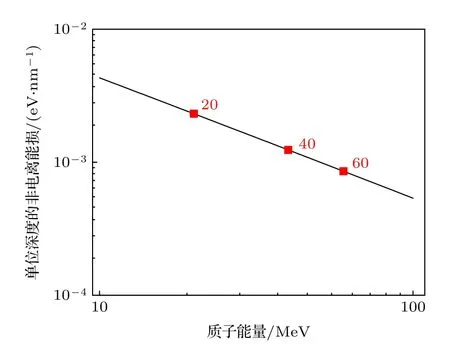
图8 单位深度的非电离能量损失随质子能量的变化Fig.8.The non-ionizing energy loss per unit depth varies with the proton energy.
由于质子在器件材料内的非电离损伤,隧穿氧化层形成可泄漏浮栅电子的多陷阱辅助导电通道,使得浮栅单元错误不断增多.这将是一个创新性的发现,在此之前,并未有研究证实质子导致的非电离损伤和多陷阱辅助导电通道的产生存在直接的联系.
3.2.2 浮栅单元数据保存能力的退化
图9 显示了重新写入不同数据后45 天内SLC器件的浮栅单元错误变化,质子能量为60 MeV,注量为5 × 109p/cm2.可以看出,重新写入“00”的浮栅单元错误数随时间的增加不断增加,而重新写入“FF”的器件未出现浮栅单元错误.

图9 重新写入不同数据后45 天内浮栅单元错误变化Fig.9.Annealing of floating gate errors within 45 days after rewriting different data.
在质子辐照结束后,受机制(II)影响的浮栅单元中,浮栅周围氧化物存在俘获电子的陷阱.在对Flash 器件进行重新写入“FF”后,陷阱可能会随时间释放电子给浮栅,引起浮栅单元阈值电压的正漂.当数据为“1”的浮栅单元阈值电压升高至判读电压线之右,则数据翻转为“0”,浮栅单元出现错误.然而,本文实验中并未发现此类错误,可能是因为随时间正漂的阈值电压不足以跨过判读电压线,如图10 所示.

图10 重新写入不同数据后浮栅单元阈值电压变化示意图Fig.10.Schematic illustration of threshold voltage changes of floating gate cells after rewriting different data.
在质子辐照结束后,受机制(III)影响的浮栅单元中,隧穿氧化层中存在可泄露浮栅电子的多辅助导电通道.在对Flash 器件进行重新写入“00”后,该通道会随时间不断泄漏浮栅中的电子,引起浮栅单元阈值电压的负漂.当数据为“0”的浮栅单元阈值电压降低至判读电压线之左,则数据翻转为“1”,浮栅单元出现错误.这也是本次实验中重新写入“00”的浮栅单元错误数随时间不断增多(图9中的实验结果)的原因.正常情况下,Flash 存储器的数据保存能力可长达数年.经质子辐照后,隧穿氧化层会形成泄漏电子的多辅助陷阱通道,浮栅单元保存数据“0”的能力存在明显的退化.
4 结论
本文实验工作针对25 nm Flash 存储器开展了质子辐射效应研究,获取了不同能量和注量质子辐照后的浮栅单元翻转截面,研究了浮栅单元错误的退火特性和数据保存能力的退化规律,分析了质子单粒子翻转特性及缺陷对浮栅内电子的影响.高能质子与靶原子发生相关的核反应产生反冲核,反冲核的电离作用引发了Flash 存储器的单粒子翻转.随着质子能量的升高,能够引发单粒子翻转的反冲核反应截面逐渐增大直至趋于稳定,单粒子翻转截面持续增大直至饱和.此外,单粒子翻转截面会随着质子注量的增大而减少,这是由于浮栅单元单粒子敏感性的不同.反冲核引起的非电离损伤会在隧穿氧化层形成部分永久性的缺陷损伤,产生可以泄漏浮栅电子的多辅助陷阱通道,导致浮栅单元错误的增多及数据保存能力的退化.错误数随时间增多的效应在低能量质子入射时更为明显,这是因为低能量质子在隧穿氧化层中的非电离损伤更加严重.
