新型Ti3C2 MXene的化学制备及基于MXene忆阻器特性与机理
2022-03-31王钰琪张缪城徐威沈心怡高斐朱家乐万相连晓娟许剑光童祎
王钰琪,张缪城,徐威,沈心怡,高斐,朱家乐,万相,连晓娟,许剑光,童祎 ,3,*
1南京邮电大学电子与光学工程学院,南京 210023
2盐城工学院材料科学与工程学院,江苏盐城 224051
3新加坡科技设计大学,工程产品开发系,新加坡 487372
1 引言
有关阻变器件应用的研究近年来主要集中在新兴存储器1,2以及神经形态系统领域1,3-5。当前的存储器多数是基于金属氧化物半导体存储单元,随着器件特征尺寸的缩小受到越来越多的物理瓶颈的限制6,在大量数据存储的需求下,采取新器件和新结构的新兴存储器逐渐成为研究的热点1,7。对于四种新兴存储器而言,铁电存储器(FRAMs)以及磁存储器(MRAMs)存储单元面积过大,相变存储器(PCRAMs)状态改变过程中功耗过高都限制了进一步发展2,8,9。但对于阻变存储器(RRAMs)而言,作为存储单元的阻变器件忆阻器在具备纳米级尺寸10,高速开关速度的同时11,12,功耗能够达到小于0.1 pJ的量级13,14,在新型存储领域极具竞争力。然而在实现忆阻器应用的过程中仍存在着如电学特性不稳定,可靠性较差等问题。针对提高忆阻器电学性能和稳定性,目前主要是采用在阻变层中引入纳米点诱导导电细丝生长的方式,如Zhang等15通过在TiO2氧化层中引入Pt纳米颗粒实现性能改善,Zhao等16,17通过引入石墨烯量子点用作离子储存,实现可重复电阻状态并降低了器件开关电压。
此外,近期一些工作也证明二维材料在优化忆阻器性能方面具备良好的应用潜力。如Liu等18以氧化石墨烯作为离子阻挡层,利用其层状结构控制Cu2+的移动从而控制内部导电通道的形态,经测试该结构忆阻器具备良好的电阻切换性。2011年,Naguib等19利用氢氟酸选择性刻蚀Ti3AlC2中的Al原子层得到具有类石墨烯结构的二维材料Ti3C2Tx;随后,利用类似的方法刻蚀结构相似的MAX相(M为早期过渡金属、A主要为IIIA或者IVA族元素,X为C和/或N元素),成功制备出对应的二维金属碳/氮化物,并命名为MXene20,21。MXene具备与石墨烯相似的二维层状结构、较大的比表面积,显现出独特的物理化学特性22,23,不仅在储能、电子领域具有重要应用价值24-26,而且有望应用于忆阻器以提高器件的电学性能17。Yan等27将二维材料Ti3C2TxMXene引入阻变器件,制备Al/Ti3C2Tx/Pt结构忆阻器,实现以10 ns脉宽的脉冲有效调制,远远短于目前已报道的基于部分其他二维材料以及部分传统氧化物结构的忆阻器。例如基于二维材料MoS2的W/MoS2/SiO2/p-Si结构忆阻器需要5 ms的脉宽实现短时、长时可塑性实验28;基于氧化物TaOx的TiN/TaOx/Pt结构忆阻器需要100 ns脉冲持续时间实现有效调制29。但目前对于引入二维材料阻变器件研究尚不全面。Liu等18已经报道在Cu/SiO2/Pt结构忆阻器中引入二维层状氧化石墨烯能够通过控制离子移动通道提升器件稳定性。因此,我们通过在器件中引入同样具有层状结构的Ti3C2作为阻挡层以控制Cu2+以及Cu的移动和生长,并进一步探究引入Ti3C2二维材料忆阻器的电学特性。
本文系统地研究了新型二维材料Ti3C2粉末及薄膜的化学制备方法,在现有工艺的基础上将二维Ti3C2薄膜引入到忆阻器中,制备得到Cu/Ti3C2/SiO2/W结构的忆阻器,并且对其相关电学特性以及导电机理进行了研究。其中二维材料Ti3C2作为阻挡层有望能够通过约束阻变层中离子的运动控制导电通道的生长与退化行为18,28,29,从而优化器件性能。通过实验我们发现引入二维材料Ti3C2的新型忆阻器在直流以及脉冲测试实验中能够表现出良好的稳定性及双脉冲易化特性30,31,有望在未来应用于新兴存储器以及人工神经形态系统的构建。
2 实验部分
2.1 Ti3C2纳米片层的制备
实验所用Ti3C2粉末通过盐酸(HCl)以及氢氟酸(HF)的混合溶液选择性刻蚀三维层状化合物Ti3AlC2来制备。刻蚀Ti3AlC2过程示意图如图1a所示,首先将1.98 g的LiF粉末溶解在20 mL HCl含量为6 mol·L-1的盐酸溶液中得到盐酸(HCl)和氢氟酸(HF)的混合溶液。随后向混合溶液中加入2 g Ti3AlC2化合物,并将得到的混合物在35 °C下反应24 h。最后使用去离子水将所得沉淀离心洗涤,重复数次直到上清液pH值接近6。将所得沉淀通过烘干收集Ti3C2粉末。图1b为分别对Ti3AlC2及刻蚀得到的Ti3C2粉末进行X射线衍射(XRD)的结果。对比两条曲线可以发现在约39°处Ti3AlC2曲线上的主峰消失,表明Ti3AlC2中的Al原子被成功刻蚀,得到Ti3C2粉末。图1c为在扫描电子显微镜(SEM)下观察到的Ti3C2粉末图像,从图中可以看出刻蚀得到的Ti3C2粉末具有明显的层状结构。进一步,取1 g干燥的Ti3C2粉末与100 mL蒸馏水混合得到两者的悬浮液,并使用超声处理4 h,然后以3500 r·min-1离心60 min。最后通过真空过滤、干燥获得的Ti3C2纳米片层,图1d为观察到的Ti3C2纳米片层的SEM图像,从图中可观察到明显的片状结构。
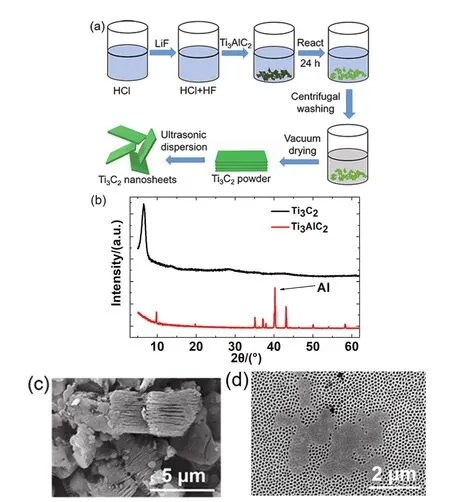
图1 (a)刻蚀Ti3AlC2过程示意图;(b)利用X射线衍射(XRD)分别对Ti3AlC2以及Ti3C2成分分析结果;(c)在扫描电子显微镜(SEM)下观察到的Ti3C2粉末图像;(d)在扫描电子显微镜(SEM)下观察到的Ti3C2纳米片层图像Fig. 1 (a)The diagram of the process of etching Ti3AlC2; (b)the component analysis of Ti3AlC2 and Ti3C2 by X-ray diffraction (XRD), respectively; (c)the morphology of fabricated Ti3C2 power characterized by scanning electron microscope (SEM); (d)the morphology of fabricated Ti3C2 nanosheet characterized by scanning electron microscope (SEM).
2.2 引入Ti3C2薄膜忆阻器的制备
为了研究引入Ti3C2薄膜的忆阻器性能,我们制备了Cu/Ti3C2/SiO2/W结构的分立忆阻器,制备流程示意图如图2a所示。首先,使用氢氟酸和去离子水的混合溶液清洗硅片,去除硅衬底表面的SiO2和杂质。随后通过磁控溅射镀膜法,在充氩气的真空条件下在硅衬底表面淀积一层厚度为90 nm的金属钨(W)作为底电极,溅射功率以及溅射时长分别设置为30 W和45 min;接下来同样在充氩气的真空条件下采用磁控溅射法淀积厚度为80 nm的SiO2,溅射功率以及溅射时长分别设为150 W和41 min;随后,为了在SiO2表面制备均匀的Ti3C2薄膜,首先将0.3 g的Ti3C2纳米片层与10 mL去离子水在试管中混合,取上层悬浮液放入甩胶机,设置甩胶机转速3500 r·min-1旋涂到SiO2表面,通过退火烘干得到Ti3C2薄膜。图2b为经过旋涂并烘干后得到的Ti3C2薄膜在扫描电子显微镜下观察到的形态图像。由图2b可以看出通过旋涂工艺得到均匀的Ti3C2薄膜。最后,利用磁控溅射在Ti3C2层上通过掩膜版沉积一层厚度100 nm的金属Cu作为顶电极,溅射功率以及溅射时间分别设置为100 W和8 min。在金相显微镜下观察器件如图2c,从图中可以清晰地看到忆阻器表面分立的顶电极,电极大小约为469 μm × 456 μm。

图2 (a)Cu/Ti3C2/SiO2/W忆阻器制备流程示意;(b)在扫描电子显微镜(SEM)下观察到的Ti3C2薄膜形态图像;(c)金相显微镜下观察到的器件分立电极以及表面形态Fig. 2 (a)The diagram of fabrication process of Cu/Ti3C2/SiO2/W memristor; (b)The SEM morphology of fabricated Ti3C2 film; (c)The separate electrodes and surface morphology of Cu/Ti3C2/SiO2/W memristor observed by metalloscope.
3 结果与分析
实验通过探针系统Cascade S300和半导体参数分析仪Keithley 4200-SCS进行。如图3a中插图所示,测试过程中W电极接地,Cu电极接正电压。对于未测试过的忆阻器,在测试之前通常需要通过电铸使忆阻器表现出阻变特性。对于Cu/Ti3C2/SiO2/W忆阻器,我们在电铸过程中设置扫描电压6 V,限流10 μA。电铸完成后,当连续100次对Cu/Ti3C2/SiO2/W忆阻器两端施加双向直流扫描电压(-4到+4 V)时,流经忆阻器的电流曲线如图3a所示。为了防止器件击穿,在正向扫描过程中人为设置限流值为10 μA。在第一阶段,施加正向扫描电压过程中,电阻从原始的高阻态(HRS)逐渐转变到低阻态(LRS),称之为set过程。在第三阶段,当施加反向直流扫描电压时,电阻由set过程结束时的低阻态(LRS)逐渐转变为高阻态(HRS),称之为reset过程。一个连续的set过程和reset过程为一个循环32。图3a分别绘制了100个循环下忆阻器的I-V曲线。在set过程中,当扫描电压到达0.1 V时,我们分别选取高、低阻态下对应的电流值计算出电阻Roff、Ron。图3b分别统计了100个循环过程中Roff、Ron的分布情况;图3c分别统计了100个循环下Roff以及Ron的均值以及标准偏差。从图3b以及3c中,我们可以看出当用-4到+4 V的双向直流扫描电压测试100个循环的情况下,在0.1 V读取高阻态阻值Roff在26.89 MΩ左右,标准偏差为2.61 MΩ,而低阻态阻值Ron较小,从插图中可以看出Ron基本保持在0.16 MΩ左右,标准偏差仅为0.22 MΩ。由实验数据可以看出在0.1 V读电压下高阻态阻值Roff的离散程度大于低阻态阻值Ron的离散程度。表明虽然器件在经历过图3a中3、4阶段的reset过程后到达高阻态的阻值偏差较大,但在相同的正向扫描下,如图3a中1、2阶段的set过程之后仍然能够到达相对稳定的低阻态。表明Cu/Ti3C2/SiO2/W忆阻器受同样大小的正向电压刺激后的电导状态受初始电导状态影响较小,具备较强的稳定性。图3d分别绘制了3 × 104s以内高、低阻态电阻随时间的变化趋势。从图中可以看出,在104s以内,Roff、Ron基本保持在稳定值。当时间超过104s之后,高阻态阻值Roff基本保持稳定,但是由于低阻态下产生的导电细丝不稳定,低阻态阻值Ron随时间逐渐增大33-35。

图3 (a)100次双向直流电压扫描下Cu/Ti3C2/SiO2/W忆阻器I-V曲线;(b)连续100个循环过程中Roff、Ron的分布;(c)连续100个循环过程中Roff以及Ron的平均值以及标准偏差;(d)3 × 104 s以内高、低阻态电阻值随时间的变化Fig. 3 (a)I-V curves of Cu/Ti3C2/SiO2/W memristor under 100 dual DC voltage sweepings; (b)The distribution of Roff andRon under continuous 100 cycles; (c)The mean and standard deviation ofRoff andRon under continuous 100 cycles; (d)The trends ofRoff andRon within 3 × 104 s.
由忆阻器导通机理分析,当对Cu/Ti3C2/SiO2/W忆阻器进行电压扫描,如图4a所示,顶电极的Cu电极接正电压,Cu发生氧化反应:Cu → Cu2++2e-。由于外加电压的存在,器件内部存在由顶电极指向底电极的电场,电子向正电压源移动,而Cu2+在电场力的作用下向底电极移动。当Cu2+移动到底电极W的附近时,由于底电极接负电压,Cu2+在底电极附近发生化学还原反应:Cu2++ 2e-→Cu。随着反应的进行,Cu逐渐在底电极附近堆积并向顶电极延伸,当堆积的Cu原子完全连接顶电极和底电极时,器件由高阻态转变为低阻态36,37。此时形成Cu原子形成的导电通道也称之为导电细丝34,38。随着两端化学反应的进行,器件内部导电细丝的数量不断发生增加,导致器件的阻值逐渐减小。类似地,当正向扫描结束后,器件内部存在大量的导电细丝。此时,对顶电极施加负向电压,对底电极施加正向电压,则发生与上述过程相反的化学反应。堆积在底电极附近以及器件内部连接两个电极的Cu原子逐渐被氧化成为Cu2+,并在反向电场的作用下逐渐移动到顶电极,并在顶电极附近被还原成为Cu原子,此时内部Cu原子构成的导电细丝逐渐消失,器件的电阻值逐渐增加,器件恢复到原始的高阻态。从器件内部工作原理可以看出忆阻器在工作过程中阻值的变化依赖于内部离子在电场作用下的移动以及化学反应34,39。如果将忆阻器的阻值视为权重,即忆阻器权重的大小受到不同电压下内部离子迁移的影响。这与图4b所示突触连接强度受Na+等在突触前膜以及突触后膜之间迁移的调节极为相似40,41。

图4 (a)正向扫描时,Cu/Ti3C2/SiO2/W忆阻器阻态受内部离子移动调节示意图;(b)突触间的连接强度受Na+等的移动调节示意图Fig. 4 (a)The diagram of the regulating function of ion migration on the resistance of Cu/Ti3C2/SiO2/W memristor under positive sweeping; (b)The diagram of the regulating function of ions such as Na+ on the connection strength between synapses.
从忆阻器和突触权重都由内部离子迁移影响可以看出忆阻器有望作为人工突触单元应用到神经形态电路。同样地,类似于生物突触连接强度受突触前尖峰与突触后尖峰的时间间隔调节42,在实验中,Cu/Ti3C2/SiO2/W结构忆阻器的阻态类似地也能够受到两个脉冲电压时间间隔来调节。如图5a中电压折线所示,对Cu/Ti3C2/SiO2/W忆阻器施加两个相同幅值5 V,持续时间10 ms的电压脉冲信号。尽管两个电压脉冲的幅值相同,但由于前一个信号对忆阻器的阻态产生影响,在忆阻器内部产生一定数量的导电细丝,当第二个同样的电压脉冲信号施加到忆阻器上时,实际产生的电流大于第一个脉冲产生的电流,如图5a中电流折线所示。两者之比称为双脉冲易化指数(paired-pulses facilitation index,PPF index)31,32,图5a所示PPF指数达到2.0。进一步减小或增加脉冲之间的间隔时,可以发现,双脉冲易化指数随着脉冲间隔的减小或增加分别呈增大或衰减趋势,图5b中虚线绘制出了PPF指数与脉冲间隔的关系。这与突触权重受突触前尖峰与突触后尖峰的时间间隔而改变一致。通常,突触权重随时间推移的改变通常使用指数衰退来表现41,42,从图5b中拟合曲线中可以看出Cu/Ti3C2/SiO2/W忆阻器PPF指数同样遵循随脉冲间隔的增大指数衰减的趋势。拟合曲线形式采用函数y=A1× exp(-t/t1)+y0,(A1、t1及y0为常数,t为时间间隔变量),与Riepe等43在鼠脑海马体切片上拟合函数一致,拟合参数表如表1所示。证明了引入Ti3C2MXene的忆阻器与生物脑神经突触的相似性,有望模仿人脑并应用到未来人工神经形态电路的开发与构建中。

图5 (a)当对Cu/Ti3C2/SiO2/W施加两个幅值5 V,持续时间10 ms的电压脉冲信号,流经忆阻器的电流随时间的变化关系;(b)双脉冲易化指数与脉冲间隔关系及拟合图Fig. 5 (a)Relationship between current flowing through the Cu/Ti3C2/SiO2/W memristor and time, when applied two voltage pulses with 5 V amplitude and 10 ms pulse duration; (b)Relationship and corresponding fitting curve between PPF index and pulses intervals.

表1 PPF指数与脉冲时间间隔关系拟合参数表Table 1 Fitting parameters of the functional relationship between PPF index and pulses intervals.
4 结论
在本文中我们首先通过刻蚀Ti3AlC2层状化合物得到Ti3C2粉末并利用XRD、SEM对其进行物理表征。随后通过超声分散得到Ti3C2纳米片层并通过旋涂法将Ti3C2薄膜引入忆阻器中,制备了Cu/Ti3C2/SiO2/W结构的忆阻器。通过实验发现引入Ti3C2MXene层的忆阻器能够同时被直流和脉冲电压有效调制。在-4到+4 V的双向直流电压扫描下,不仅能够观察到忆阻器典型的I-V特性曲线,而且在循环100次(0.1 V读电压)下,虽然高阻态阻值Roff在26.89 MΩ左右存在一定的波动现象,但是低阻态阻值Ron基本保持在0.16 MΩ,表明set过程后Cu/Ti3C2/SiO2/W忆阻器状态受初始状态影响较小,具备较强的稳定性。同时,Roff以及Ron能够在104s以内基本保持稳定;此外,当利用脉冲电压调制时,可以观察到典型的双脉冲易化现象,并且观察到PPF指数与脉冲间隔的关系呈指数变化关系,与突触权重受突触前、后尖峰时间间隔的影响一致。以上结果表明基于Ti3C2MXene的忆阻器在稳定性以及模拟生物突触方面表现良好,在将来构建新型非易失性存储设备以及大规模神经形态系统中具有巨大的发展潜力。
