磷化铟高电子迁移率晶体管外延结构材料抗电子辐照加固设计*
2022-02-17周书星方仁凤魏彦锋陈传亮曹文彧张欣艾立鹍李豫东郭旗
周书星 方仁凤 魏彦锋 陈传亮 曹文彧 张欣 艾立鹍 李豫东 郭旗
1)(湖北文理学院物理与电子工程学院,低维光电材料与器件湖北省重点实验室,襄阳 441053)
2)(中国科学院上海微系统与信息技术研究所,信息功能材料国家重点实验室,上海 200050)
3)(中国科学院新疆理化技术研究所,中国科学院特殊环境功能材料与器件重点实验室,乌鲁木齐 830011)
为研究磷化铟高电子迁移率晶体管(InP HEMT)外延结构材料的抗电子辐照加固设计的效果,本文采用气态源分子束外延法制备了系列InP HEMT 外延结构材料.针对不同外延结构材料开展了1.5 MeV 电子束辐照试验,在辐照注量为2 × 1015 cm—2 条件下,并测试了InP HEMT 外延结构材料二维电子气辐照前后的电学特性,获得了辐照前后不同外延结构InP HEMT 材料二维电子气归一化浓度和电子迁移率随外延参数的变化规律,分析了InP HEMT 二维电子气辐射损伤与Si-δ 掺杂浓度、InGaAs 沟道厚度和沟道In 组分以及隔离层厚度等结构参数的关系.结果表明:Si-δ 掺杂浓度越大,隔离层厚度较薄,InGaAs 沟道厚度较大,沟道In 组分低的InP HEMT 外延结构二维电子气辐射损伤相对较低,具有更强的抗电子辐照能力.经分析原因如下:1)电子束与材料晶格发生能量传递,破坏晶格完整性,且在沟道异质界面引入辐射诱导缺陷,增加复合中心密度,散射增强导致二维电子气迁移率和浓度降低;2)高浓度Si-δ 掺杂和薄隔离层有利于提高量子阱二维电子气浓度,降低二维电子气受辐射损伤的影响;3)高In 组分应变沟道有利于提高二维电子气迁移率,但辐照后更容易应变弛豫产生位错缺陷,导致二维电子气迁移率显著下降.
1 引言
随着载人航天嫦娥探月工程和火星探测任务的开启,航天探测工程步入到深空阶段.深空探测系统需要传输的探测数据量越来越多,但目前面临通信信号越来越弱、通信时延增加的问题,急需信噪比高、灵敏度高、工作频率高的深空通信收发系统.磷化铟基高电子迁移率晶体管(InP based high electron mobility transistor,InP HEMT)利用InGaAs 沟道具有的高迁移率的二维电子气(two-dimensional electron gas,2DEG)来工作,具有高速高频、高功率增益、低噪声及低功耗等特点,成为毫米波和太赫兹波领域最具竞争力的三端固态电子器件之一,非常适合制作毫米波太赫兹波低噪声放大器,可应用于深空通信收发系统[1-3].
但是,随着HEMT 射频器件在空间环境中应用,面临着包括地球辐射带、太阳耀斑和银河宇宙射线等强辐射环境,将不可避免受到各种高能粒子和射线等辐射影响,其中电子是空间辐照环境中含量极为丰富的粒子,具有较大的电子能损,会在材料中引入微观缺陷,并可在异质界面引起原子混合,这都会造成HEMT 量子阱中2DEG 迁移率和密度发生变化[4-6],易于诱发空间通信系统中HEMT射频器件的最小噪声系数Fmin、截止频率ft、最大振荡频率fmax等关键参数退化[7-9],甚至引起器件失效,影响空间通信的稳定性和准确性,严重威胁航天器的安全可靠运行.因此对于空间环境中应用的HEMT 器件,研究其电子辐照效应显得尤为重要.
近年来,国外众多研究团队纷纷报道了辐照对各种HEMT 器件的影响,其中辐照源包括质子、电子、中子、γ射线、α 粒子等,HEMT 器件主要包括GaAs HEMT[10],GaN HEMT[11],InP HEMT[12],InAs/AlSb HEMT[13].Pearton 等[14]发现电子辐照会导致GaN HEMT 二维电子气面密度和电子迁移率减小,阈值电压正向漂移,同时漏电流和跨导退化.Fleetwood[8]发现沟道内缺陷及异质界面散射会诱导载流子数量变化,引起HEMT 器件1/f噪声增大.Lin 等[15,16]分析了电子质子辐照对AlGaAs/GaAs HEMT 二维电子气密度和电子迁移率的辐射影响规律和材料中引入的深能级缺陷,发现外延结构和生长条件会影响HEMT 二维电子气的抗辐照能力.Tang 等[5,17]通过模拟仿真发现GaN HE MT 异质结附近GaN 层中的Ga 空位会影响费米能级,并且俘获势阱中二维电子气,其中采用背部势垒层可以提高器件性能,但会导致抗辐射性能降低.Zang 等[18]质子辐照实验发现:辐照诱导阈值电压漂移与隔离层厚度正相关,隔离层厚度较薄会提高 GaN HEMT 抗辐射能力.Smith 等[19]实验发现:通过材料外延设计和钝化技术可控制和提高GaN HEMT 抗伽马辐照能力.Zhong 等[20]通过模拟仿真质子辐照InP HEMT 辐照前后直流和射频特性变化发现:沟道下面插入一层Si-δ 掺杂层可以增强质子辐射耐受性.研究以上文献发现:通过材料生长、外延结构设计和工艺钝化技术都可提高HEMT 抗辐射性能,但大部分主要集中在GaN HEMT 器件抗辐射效应研究上,而InP HEMT 器件抗辐射效应的研究报道较少,在辐照损伤机理和抗辐射加固措施上有待进一步研究.
二维电子气(2DEG)的电子迁移率(u)和面密度(n)是影响 HEMT 器件频率、功率、噪声系数等性能的2 个重要参数,研究辐射诱导缺陷对二维电子气的影响对分析 HEMT 器件空间辐照退化机理和加固方法具有十分重要的意义.目前国内在InP HEMT 外延结构材料电子辐射效应方面的研究尚不够全面和深入,无法为InP HEMT 器件与电路抗辐照加固设计提供理论指导.因此本文拟对系列InP HEMT 外延结构材料开展1.5 MeV电子束辐照试验,获得辐照前后二维电子气浓度和电子迁移率辐射损伤特性,研究InP HEMT 外延结构材料二维电子气辐射与外延结构参数的相关性,分析结构参数变化对InP HEMT 外延结构材料的抗辐照性能影响,为InP HEMT 器件与电路抗辐照加固设计提供数据支撑.
2 材料制备与辐照试验
2.1 材料制备
本实验所用InP HEMT 外延结构材料样品是中国科学院上海微系统与信息技术研究所提供的,采用V90型气态源分子束外延生长系统(GSMBE)制备,该生长系统设备如图1 所示.样品基本结构如表1 所列,外延结构从下至上的组成为:300 nm非掺杂In0.52Al0.48As 缓冲层(Buffer layer)、twnm非掺杂InxGa1—xAs 沟道层(Channel)、hwnm In0.52Al0.48As 隔离层(Spacer layer)、Si-δ 平面掺杂层(δdoping)、8 nm 非掺杂In0.52Al0.48As 势垒层(Barrier layer)、4 nm 非掺杂InP 停止刻蚀层(Etch-stopper)、15 nm 的n+掺杂的In0.52Al0.48As 帽层(Cap layer 3)、15 nm 的n+掺杂的In0.53Ga0.47As 帽层(Cap layer 2)和10 nm 的n+掺杂的In0.65Ga0.35As帽层(Cap layer 1).为了研究 InP HEMT 二维电子气辐射损伤与外延结构参数依赖的关系,进行抗辐射外延加固优化设计,实验制备了4 组不同结构参数的外延结构样品.A 组样品的隔离层厚度为3 nm,沟道厚度为15 nm,沟道In 组分为0.53,Si-δ平面掺杂层浓度分别为3×1012,4×1012,5×1012,6×1012cm—2,分别标记为样品A1,A2,A3,A4.B 组样品的Si-δ 平面掺杂层浓度为5×1012cm—2,沟道厚度为15 nm,沟道In 组分为0.53,隔离层厚度分别为2,3,4,5 nm,分别标记为样品B1,B2,B3,B4.C 组样品的Si-δ 平面掺杂层浓度为5×1012cm—2,隔离层厚度为3 nm,沟道厚度为10 nm,沟道In 组分分别为0.6,0.65,0.7,0.75,分别标记为样品C1,C2,C3,C4.D 组样品的Si-δ 平面掺杂层浓度为5×1012cm—2,隔离层厚度为3 nm,沟道In 组分分别为0.53,沟道厚度分别为5,15,25,35 nm,分别标记为样品D1,D2,D3,D4.4 组样品辐照前常温(RT)和低温77 K 霍尔测试结果如表2 所列.图2 给出了沟道In 组分为0.7 且沟道厚度为12 nm 的InP HEMT 结构材料TEM 分析图[21].

图1 V90型气态源分子束外延生长系统Fig.1.V90 gas source molecular beam epitaxy growth system.

表1 InP HEMT 外延结构表(S.I.InP sub,半绝缘InP 衬底)Table 1. Structure parameters of the InP HEMT(S.I.InP sub,semi-insulating InP substrate).

表2 InP HEMT 外延结构样品辐照前霍尔测试数据Table 2. Hall data of the InP HEMT structures before irradiation.

图2 InP HEMT 结构材料TEM 分析图Fig.2.TEM analysis diagram of InP HEMT structural material.
2.2 辐照试验
电子辐照试验是在中国科学院新疆理化技术研究所完成的.试验采用的电子加速器型号为俄罗斯ELV-8 II 高频高压电子加速器,能量范围为1.0—2.0 MeV.试验选取入射电子能量为1.5 MeV,注量率为1.0×1011cm2·s—1,采用垂直入射方式.当累积辐照注量达到2×1015cm—2时,将样品取出进行常温和低温77 K 霍尔测试,获取InP HEMT二维电子气浓度和迁移率.
3 试验结果
在辐照前后分别进行常温和低温77 K 霍尔测试,获取InP HEMT 二维电子气浓度和迁移率,并进行数据的归一化(Normalized)处理,即采用辐照后的二维电子气浓度或电子迁移率除以辐照前对应外延结构材料的二维电子气浓度或电子迁移率;分析InP HEMT 外延结构材料二维电子气辐射损伤随外延结构参数的变化规律,以便进行外延结构加固设计优化.
图3 为电子辐照对不同δ 掺杂浓度InP HEMT二维电子气浓度和电子迁移率的归一化影响.由图3(a)和图3(b)可知:室温和77 K 二维电子气浓度和电子迁移率辐射损伤趋势一致,即在相同辐照条件下,随着δ 掺杂浓度增大,InP HEMT 外延结构二维电子气浓度和电子迁移率辐照损伤减小,这说明δ 掺杂浓度高的InP HEMT 外延结构二维电子气浓度和电子迁移率辐照损伤相对较小,具有较强的抗辐照能力.对比图3(a)和图3(b)可发现:同一样品在相同辐照条件下,77 K 条件下的二维电子气浓度和电子迁移率比常温退化严重,说明样品辐照后二维电子气辐射损伤性能随着温度的降低会发生显著退化,这主要是由于随着温度降低,载流子热运动的平均速度变小,不能较快地掠过辐射诱导缺陷,偏转较大,受到缺陷散射增强,且更容易受到辐射诱导缺陷俘获[22].图4 为电子辐照对不同隔离层厚度InP HEMT 二维电子气浓度和电子迁移率的归一化影响.从图4(a)和图4(b)可以看到:室温和77 K 二维电子气浓度和电子迁移率辐射损伤趋势基本一致,即在相同辐照条件下,随着隔离层厚度减小,InP HEMT 外延结构二维电子气浓度和电子迁移率辐照损伤快速减小,这说明隔离层较薄的InP HEMT 外延材料二维电子气浓度和电子迁移率辐照损伤相对较小,具有较强的抗辐照能力,在GaN HEMT 中也观察到缩减隔离层厚度减小辐射退化的类似现象[18].图5 为电子辐照对不同沟道In 组分InP HEMT 二维电子气浓度和电子迁移率的归一化影响.从图5(a)和图5(b)可以看到:室温和77 K 二维电子气浓度和电子迁移率辐射损伤趋势基本一致,即在相同辐照条件下,随着沟道In 组分减小,InP HEMT 外延结构二维电子气电子迁移率辐照损伤快速减小,二维电子气浓度辐射损伤缓慢增大,影响较小,这说明沟道In 组分较小的InP HEMT 外延材料二维电子气电子迁移率辐照损伤相对较小,具有较强的抗辐照能力.图6 为电子辐照对不同沟道厚度InP HEMT 二维电子气浓度和电子迁移率的归一化影响.从图6(a)和图6(b)可以看到:室温和77 K 二维电子气浓度和电子迁移率辐射损伤趋势基本一致,即在相同辐照条件下,随着沟道厚度增大,InP HEMT 外延结构二维电子气电子迁移率辐照损伤缓慢减小,二维电子气浓度辐射损伤变化不明显,这说明沟道厚度大的InP HEMT 外延材料二维电子气电子迁移率辐照损伤相对较小,具有较强的抗辐照能力.在图4、图5 和图6 中同样也可以发现:同一样品在相同辐照条件下,77 K 条件下的二维电子气浓度和电子迁移率比常温退化严重,这说明无论样品的结构参数如何,其低温条件下的辐射损伤均较室温下严重.

图3 电子辐照对不同δ 掺杂浓度InP HEMT 二维电子气浓度和电子迁移率的归一化影响 (a)室温;(b)77 KFig.3.Normalized 2DEG density (n)and electron mobility (u)versus δ-doping density measured at (a)room-temperature and(b)77 K irradiated by electron beam.
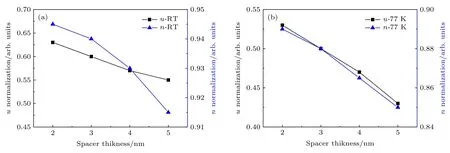
图4 电子辐照对不同隔离层厚度InP HEMT 二维电子气浓度和电子迁移率的归一化影响 (a)室温;(b)77 KFig.4.Normalized 2DEG density (n)and electron mobility (u)versus spacer layer thickness measured at (a)room-temperature and(b)77 K irradiated by electron beam.

图5 电子辐照对不同InGaAs 沟道In 组分InP HEMT 二维电子气浓度和电子迁移率的归一化影响 (a)室温;(b)77 KFig.5.Normalized 2DEG density (n)and electron mobility (u)versus channel In content measured at (a)room-temperature and(b)77 K irradiated by electron beam.

图6 电子辐照对不同沟道厚度InP HEMT 二维电子气浓度和电子迁移率的归一化影响 (a)室温;(b)77 KFig.6.Normalized 2DEG density (n)and electron mobility (u)versus channel thickness measured at (a)room-temperature and(b)77 K irradiated by electron beam.
4 讨论
InP HEMT 外延材料的2DEG 来自InGaAs/InAlAs 量子阱,其输运特性主要受InGaAs/InAl As 异质结构能带结构和远程电离杂质散射、库仑散射、合金散射等各种散射过程的影响.二维电子气受到的散射越强,电子迁移率越低.当用高能电子束辐照InP HEMT 外延材料时,电子会和材料中的晶格原子相互作用,发生弹性碰撞或非弹性碰撞,将部分能量传给晶格原子,导致晶格原子获得足够能量,克服周围原子束缚,挤入晶格间隙,同时原来的晶格位置成为空位,形成辐射诱导点缺陷[23].且在注量不太高的情况下,辐射诱导点缺陷浓度与电子注量的大小成正比.另外高能电子辐照也会导致沟道InGaAs/InAlAs 异质结附近区域合金无序和远程离化杂质等辐射诱导缺陷增多.这些在InP HEMT 沟道InGaAs/InAlAs 异质结附近区域产生的辐射诱导缺陷(包括点缺陷、合金无序、远程离化杂质等缺陷)和材料中的其他杂质会破坏晶格周期性,在量子阱区域晶格禁带中产生局部分立缺陷能级,使载流子散射增强,导致InP HEMT 外延材料二维电子气电子迁移率减小,其中部分缺陷能级成为载流子俘获中心,俘获载流子后出现附加电荷,削弱沟道InGaAs/InAlAs 量子阱异质界面内建电场,降低能带弯曲程度,使异质结界面处三角势变浅,导致二维电子气浓度减小[23].
从图3 和图4 可以观察到δ 掺杂浓度较高和隔离层较薄的InP HEMT 外延材料二维电子气浓度和电子迁移率辐照损伤相对较小.这主要是由于InP HEMT 外延结构材料二维电子气浓度随着δ 掺杂浓度增加和隔离层厚度减少而迅速提高,同时二维电子气电子迁移率略微降低,如表2 中A 组和B 组数据所列.同时在辐照剂量相等且不是很高的条件下,在材料中引入的辐照诱导缺陷数量基本相等,导致辐射诱导缺陷引起的二维电子浓度减小数目基本相同,因此辐照后会导致较高δ 掺杂浓度和较薄隔离层厚度的InP HEMT 二维电子气浓度损伤相对较低.此外,低δ 掺杂浓度和较厚隔离层的InP HEMT 外延结构材料中由于引入的远程电离杂质Si 较少,远程杂质散射较弱,导致低δ 掺杂浓度和较厚隔离层的InP HEMT 二维电子气迁移率较高,如表2 中A 组和B 组数据所列.由于辐照后会在InP HEMT 沟道InGaAs/InAlAs异质结附近区域产生辐射诱导缺陷,此时二维电子气的电子迁移率主要由辐射诱导缺陷散射决定,其他非辐照诱导散射如远程电离杂质散射、合金散射、晶格散射等可忽略不计.在相同辐照条件下,样品中引入的辐照诱导缺陷数量基本相同,从而引入的辐射诱导缺陷散射大致相同,但是辐射诱导缺陷散射会造成较低δ 掺杂浓度和较厚隔离层厚度的InP HEMT 二维电子气电子迁移率减小的更多,因此辐照后会导致较高δ 掺杂浓度和较薄隔离层厚度的InP HEMT 二维电子气迁移率损伤相对较低.
从图5 可以观察到沟道In 组分较低的InP HEMT 外延材料二维电子气辐照损伤相对较小.原因如下所述,在晶格失配的沟道InxGa1—xAs/InAlAs量子阱中,晶格的对称性由于应变层的引入发生变化,外延层横向发生压缩应变使晶格常数与衬底匹配,即晶格常数在平行于异质结平面的两个方向相对原来缩小,受到双轴压应力,同时纵向伸长发生张应变,如图7(a)和图7(b)InGaAs/InAlAs 应变异质结的外延生长示意图所示.在双轴压应变层中,净的带隙移动为[24]

式中:α为形变势,α>0,与材料的弹性常数等有关;ε是压应变,ε≤0 .从(1)式可以看出随着压应变增大异质结净的带隙也会随着增大,压应变如果消失,净的带隙移动也会跟着消失.随着In 组分的增大,压应变增大,沟道异质结界面势阱变深,量子阱二维电子气受到的散射减小,电子迁移率快速增大,同时电离施主杂质电子也更容易转移到量子阱中,导致二维电子气浓度也略微增大,如表2中C 组样品数据所列.在经过同等条件辐照后,通过辐照诱导缺陷的引入,部分失配应变弛豫,导致沟道InxGa1—xAs 应变层的晶格常数与衬底InP 晶格常数不再相等,应变能量将通过在异质结界面附近产生位错缺陷而释放出来,如图7(c)所示.因此辐射诱导缺陷会造成沟道In 组分高的InP HEMT外延结构高应变量子阱晶格严重弛豫,导致量子阱势垒降低,应变量子阱弛豫引起的位错散射和远程离化杂质散射将会增强,导致沟道In 组分高的InP HEMT 外延结构材料二维电子气迁移率辐射损伤更大,所以辐照后会导致沟道In 组分低、应变较小的InP HEMT 二维电子气电子迁移率损伤相对较低.同时,沟道异质结界面辐射诱导缺陷俘获载流子后会出现附加电荷,削弱异质界面内建电场,使界面能带弯曲程度降低,三角势阱变浅,造成二维电子气的载流子浓度降低[23].同时应变弛豫后会导致量子阱势垒进一步降低,造成二维电子气的载流子浓度再次降低.因此,随着In组分增大虽然可以略微增大二维电子气浓度,但是随着辐照后应力弛豫同样会导致二维电子气浓度损伤更大.所以沟道In 组分较低对InP HEMT 二维电子气的辐射损伤变化较小,具有更好的抗辐照能力.

图7 InGaAs/InAlAs 应变异质结的外延生长及弛豫示意图 (a)两种不同晶格常数外延层;(b)应变异质结;(c)弛豫异质结Fig.7.Schematic diagram of epitaxial growth and relaxation of InGaAs/InAlAs strained heterojunction:(a)Epitaxial layers with different lattice constants;(b)strained heterojunction;(c)relaxation heterojunction.
从图6 可以观察到沟道厚度较厚的InP HEMT外延材料二维电子气辐照损伤变化相对较小.由于InP HEMT 外延结构材料二维电子气浓度和电子迁移率随沟道厚度变化不明显,如表2 所列.在相同辐照剂量条件下,在外延结构材料中引入的辐照损伤缺陷数量基本一致,导致辐射诱导缺陷复合的二维电子浓度减小数目基本相同,沟道厚度对InP HEMT 二维电子气浓度辐射损伤影响较小,可以忽略不计.但是,辐照在量子阱材料异质界面引入的辐照损伤较大,造成辐射诱导缺陷集聚在异质界面,量子阱沟道厚度越小,辐照后量子阱内的缺陷浓度越高,量子阱内的二维电子气受到的缺陷散射越强,导致沟道厚度窄的InP HEMT 二维电子气迁移率损伤相对较大.因此辐照后会导致沟道厚度较厚的InP HEMT 二维电子气电子迁移率损伤相对变化较小.
5 结论
本文利用电子加速器试验装置,开展了不同外延结构参数的InP HEMT 外延结构材料的电子辐射效应试验研究.通过研究 InP HEMT 外延结构材料二维电子气辐射损伤与外延结构参数(例如Si-δ 掺杂浓度、InGaAs 沟道厚度和沟道In 组分以及隔离层厚度等结构参数)的依赖关系,获得了不同外延结构InP HEMT 材料二维电子气归一化浓度和电子迁移率随外延参数的变化规律.值得注意的是,研究发现通过增大δ 掺杂浓度和InGaAs 沟道厚度,减小隔离层厚度和沟道应力等措施都可以增强InP HEMT 外延结构材料的抗辐照能力,这说明通过调节外延结构设计增强InP HEMT 材料的抗辐照性能是一种可行的外延加固方法.未来仍需要进一步验证外延结构加固设计对InP HEMT器件的抗辐照性能影响.
