InSb芯片碎裂与迸溅金点的关系*
2022-02-17张江风田笑含张晓玲孟庆端
张江风 田笑含 张晓玲 孟庆端†
1) (河南科技大学电气工程学院,洛阳 471023)
2) (河南科技大学软件学院,洛阳 471023)
批量生产中经常发生的锑化铟(InSb)芯片碎裂问题制约着InSb红外焦平面探测器(IRFPAs)成品率的提升.经分析认为:低周期液氮冲击下发生在器件边沿区域的InSb芯片破碎与该区域中迸溅金点的存在有关.为从理论上明晰迸溅金点对InSb芯片局部碎裂的影响,本文建立了包含迸溅金点的InSb IRFPAs结构模型,分析了迸溅金点的存在对应力分布的影响.在此基础上,在应力集中处预置不同长度的初始裂纹用以描述InSb晶片中的位错,以能量释放率为判据,探究InSb芯片碎裂与迸溅金点和位错线长短的关系.结论如下:1) 迸溅金点的存在对InSb芯片碎裂的影响是局部的,在迸溅金点与InSb芯片接触区域的两侧会形成两个应力集中点;2) 环绕预置裂纹的能量释放率会随着预置裂纹长度的增加而加速增大,当预置裂纹长度接近InSb芯片上表面时,能量释放率近乎指数增加,并在预置裂纹贯穿InSb芯片时达到最大值;3) 迸溅金点引起的InSb芯片破碎属于I型断裂失效模式,在多周期液氮冲击中,位错线在应力集中效应的驱使下逐步扩展,直至贯穿InSb芯片,最终形成宏观碎裂失效现象.
1 引言
红外焦平面探测器广泛应用于航空航天、红外遥感、导弹制导、气象、医疗及科学仪器等领域.在现有红外面阵探测器产品序列中,工作在3—5 µm波段的锑化铟(InSb)面阵探测器具有均匀性好、暗电流小、量子效率高等优点,从而在红外探测领域占据重要地位[1−4].为抑制背景噪声,提高信噪比,InSb面阵探测器通常工作于液氮温度(77 K),但器件封装是在室温(300 K)下完成的.当器件温度从300 K快速降至77 K时,相邻材料间因线膨胀系数的不同将诱生热失配,产生热应力,过大的热失配应力将会导致InSb芯片断裂失效.在InSb面阵探测器的生产中,需要采用蒸发工艺制备较厚的金层和铟层,分别用于形成引线电极和制备用于互连的铟柱阵列.在蒸发工艺中,通常会发生金属液滴迸溅现象,滴落在InSb芯片上的金液滴冷却后会形成迸溅金点,这一现象在蒸发工艺中不受控制,无法避免.蒸发工艺中产生的迸溅金点分布没有规律性,如果迸溅金点出现在有效光敏元阵列区域,则可借助光学显微镜筛选出来.如果迸溅金点不出现在有效光敏元阵列区域,则可能存在漏检现象,使得包含迸溅金点的InSb芯片进入后续工艺.待器件封装完成后,器件初期能够经受一定次数的液氮冲击而不发生InSb芯片碎裂,但随着液氮冲击次数的增多,出现了InSb芯片碎裂的现象.经InSb芯片局部碎裂区域的选区腐蚀,材料成分分析,判定面阵探测器周边区域的随机迸溅金点是引起InSb芯片碎裂的主因.为从理论上剖析迸溅金点的存在与InSb芯片碎裂失效之间的关系,本文建立了包含迸溅金点的InSb面阵探测器结构模型,用以定量分析迸溅金点对器件失效的影响.
针对InSb IRFPAs生产中出现的InSb芯片破碎问题,罗宏[5]认为InSb 芯片的破碎源于网状底充胶和电极金属层的形变;孟庆端等[6]认为铟柱阵列的存在会引起应力局部集中,可导致InSb芯片发生张开型碎裂失效和InSb芯片与下层结构之间的局部分层.上述研究能够从宏观层面揭示InSb IRFPAs发生局部失效的原因,缺乏对InSb芯片碎裂失效微观层面的解读,不能直接用来解释因迸溅金点的存在造成InSb芯片的破碎现象.为此,本文建立了包含迸溅金点的InSb IRFPAs结构模型,用于分析迸溅金点的存在对InSb面阵探测器结构可靠性的影响,以应力分量为标准,探讨InSb芯片的局部碎裂失效模式,以能量释放率为依据,引入虚拟裂纹替代位错线,剖析破碎起源地,以期从宏观与微观两个层面剖析InSb芯片在迸溅金点作用下的破碎机理.
2 InSb面阵探测器制备工艺及晶体缺陷
InSb面阵探测器的主要制备工艺包括InSb芯片制备、硅读出电路(readout integrated circuits,ROIC)制备、倒焊互连、底充胶填充及其固化、InSb芯片背减薄工艺、增透膜淀积以及后续探测器与杜瓦组件的封装和测试等[7,8],具体流程如图1所示.需要指出的是,在InSb芯片和硅ROIC制备中,为实现光生电信号的输出,需要采用热蒸发的方式蒸镀较厚的金属电极和互连铟层,分别形成传输信号的电极和用于倒焊互连的铟柱阵列.热蒸发期间难免会发生熔融金属的迸溅现象,迸溅金属液滴一旦和InSb芯片或者硅 ROIC接触,冷却后就会形成局部增厚的现象,形成一定形状的金点或者铟点.离散迸溅金点如果位于光敏元阵列区域,则会被筛选出来,离散迸溅金点如果位于光敏元阵列区域外边,这些区域不是成像器件的核心区域,可能会被忽略,从而进入后续封装工艺.当液氮冲击次数累积到一定程度时,就会发生InSb芯片始于器件边缘的碎裂现象.

图1 InSb面阵探测器制备工艺具体流程Fig.1.Specific fabricating processes of InSb IRFPAs.
InSb晶体生长过程中常常会形成一定数量的位错线缺陷,包括刃位错、螺位错和混合型位错.位错的存在会对材料的力学性能产生较大影响,致使InSb晶片发生低应力破碎.InSb生长过程引起位错的主要因素[9]有:1) 籽晶因素,单晶生长时,籽晶中的位错延伸至生长面,伴随着晶体生长进入新生晶体中,直到与晶体表面相交为止[10];2) 热应力因素,晶体生长过程中需采用大的温度梯度,过大的温度梯度会产生较大的应力,当应力超过材料自身的屈服强度时,就会使晶体出现滑移引入位错[11];3) 杂质因素,晶体在拉制过程中,杂质的存在也会伴随着晶体生长进入晶体内部,这样也会产生滑移位错.上述这些位错线缺陷深埋于InSb晶体中,当外界条件(如温度)变化时,这些位错线缺陷会沿解理面(110)产生不同程度的滑移,在晶体中引发裂纹的衍生与扩展,最终导致晶体发生破碎失效.
3 虚拟裂纹闭合技术
虚拟裂纹闭合技术(virtual crack closure technique,VCCT)最早由Rybicki和Kanninen[12]于1977年提出,能够相对精确地计算断裂模型的能量释放率.相对于扩展有限元法、奇异性单元法、内聚力模型等断裂模型分析方法,VCCT具有精度高、计算简单、不需要考虑裂纹尖端的奇异性等优点.VCCT是基于这样一个假设,即分开一个表面所需的能量与闭合同一表面所需的能量相同,该方法假设虚拟裂纹尖端后面的张开位移和实际裂纹尖端后面的张开位移近似相等,通过虚拟裂纹扩展分析技术可获得应力或应变的精确解,可以有效分析复合材料的结构断裂和分层问题.这里描述的线性虚拟裂纹闭合原理如图2所示.

图2 线性虚拟裂纹闭合技术原理Fig.2.Principle of virtual crack closure technique for linear crack.
首先假定主裂纹长度为a,进一步假定裂纹尖端周围的应力状态在裂纹小幅增长Δa时不会发生显著变化.根据Irwin[13]提出的应变能释放率的概念,线性裂纹的闭合积分公式表示为

式中σy和τxy为实际裂纹(当裂纹长度是a时)在裂尖前沿的应力分量,并且当r→ 0时,裂纹尖端的应力分量趋近于无穷大,Δu和Δv分别为虚拟裂纹(当裂纹长度是a+Δa时)面上的张开位移及相对滑动位移,GI和GII则分别为I型和Ⅱ型的应变能释放率分量.也就是说,虚拟裂纹闭合法的原理就是将实际裂纹a扩展成虚拟裂纹a+Δa所要做的功与将虚拟裂纹a+Δa闭合成实际裂纹a所要做的功是相同的.
4 模型建立及材料参数选取
InSb IRFPAs通常由3层材料堆叠而成,采用倒焊技术将最上面的InSb光敏元芯片与最下面的硅 ROIC通过铟柱阵列进行互连,随后填入底充胶以提升铟柱阵列的结构可靠性.本文采用有限元软件ANSYS进行结构性建模,考虑到InSb IRFPAs结构的对称性,选取整个探测器的1/2结构.建立的InSb IRFPAs二维结构模型如图3所示.在建立的模型[14,15]中,InSb芯片、Underfill、铟柱和硅ROIC的厚度分别为10,10,10和300 µm,铟柱宽度为30 µm,中心距为50 µm,具体材料参数见表1.迸溅金点大小为30 µm × 5 µm,位于InSb IRFPAs的边沿区域.为了精确计算多层材料结构中累积的热应力,模型中所有材料的线膨胀系数都采用温度相关模型[16],所有材料均视为线弹性材料.

表1 InSb IRFPAs模型的相关材料参数Table 1.Material parameters of InSb IRFPAs model.
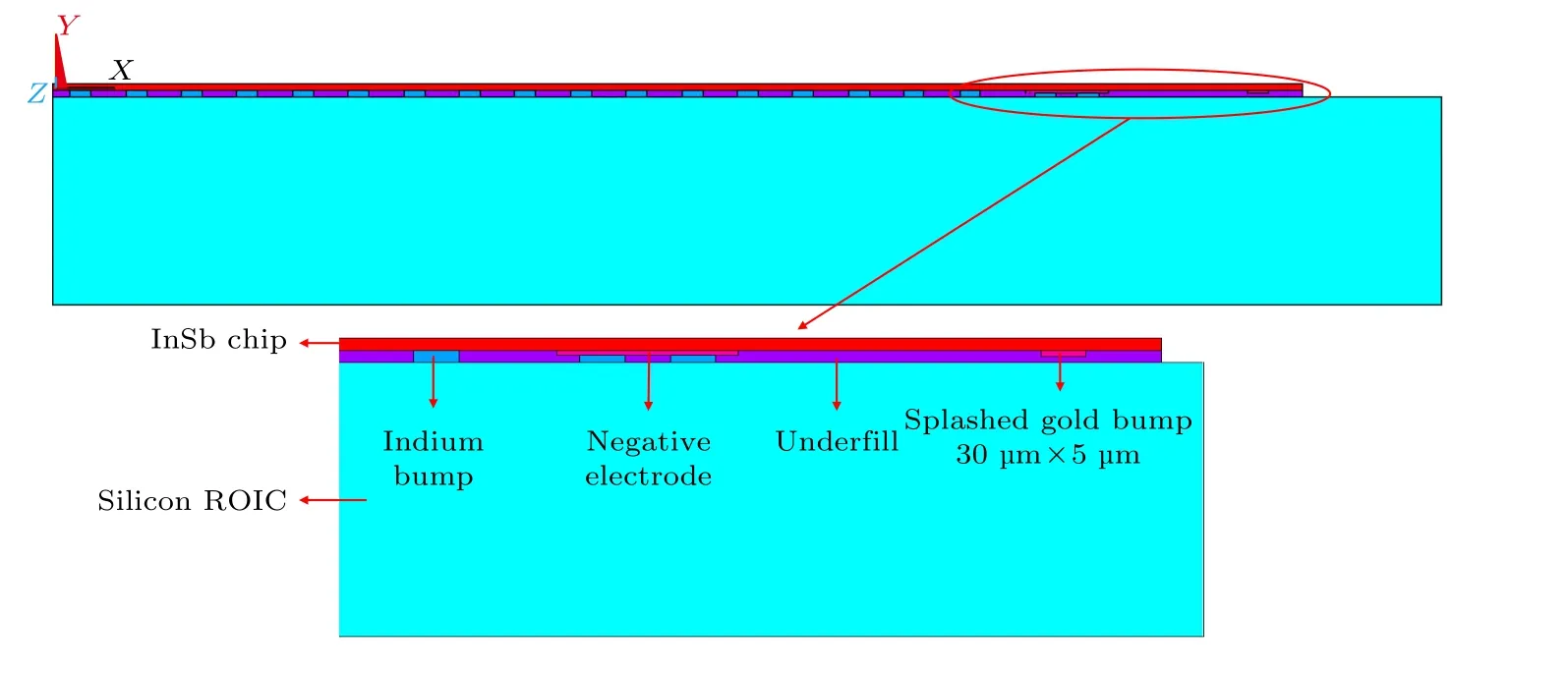
图3 InSb面阵探测器的二维有限元模型Fig.3.Two-dimensional finite element model for InSb IRFPAs.
5 模拟结果分析与讨论
在InSb IRFPAs的制备过程中,通常需要蒸发较厚的金层,用于电极制备.在热蒸发工艺中,通常会发生金属随机迸溅现象,从而在InSb芯片下表面形成局部迸溅金点.由于蒸发工艺中迸溅金点在分布上没有规律性,如果分布在器件中心区域,则可借助光学显微镜筛选出该器件,如果分布在边沿区域,该区域不属于重点监测范围,可能通过检验流程,进入后续工序,制备出包含迸溅金点的InSb IRFPAs.在InSb IRFPAs的例行测试中,发现原先通过检测流程的InSb IRFPAs中出现了InSb芯片碎裂的现象,碎裂起源于InSb IRFPAs边沿区域,经过选区腐蚀,材料成分分析,在碎裂起源处发现了离散金点.为了明晰迸溅金点对InSb芯片碎裂的影响,结合碎裂实际,在InSb IRFPAs结构模型的周边区域添加离散金点,并提取迸溅金点附近InSb芯片下表面面内正应力分布,如图4所示,便于比对,这里一同给出没有离散金点时InSb芯片下表面面内正应力分布.这里的X轴坐标已进行归一化处理.

图4 迸溅金点存在与否情况下InSb芯片下表面的面内正应力分布Fig.4.Distributions of the in-plane normal stress in bottom surface of InSb chip with splashed gold bump or not.
从图4可知,迸溅金点的存在对InSb芯片中的面内正应力分布影响甚大.在归一化坐标低于X=0.864和高于X=0.925的区间内,InSb芯片中面内正应力分布与迸溅金点的存在与否没有关系.由此可知,迸溅金点对InSb芯片中面内正应力分布的影响是局部的,即在迸溅金点附近有影响,远离迸溅金点的位置,应力分布不受迸溅金点的影响.具体来说,迸溅金点不存在时,当归一化横坐标从X=0.847移动到X=0.864的过程中,InSb芯片下表面面内正应力由593.09 MPa降低到517.39 MPa;当归一化坐标从X=0.925移动到X=1时,对应的面内正应力则由404.30 MPa降低到–136.09 MPa.引入迸溅金点后,迸溅金点位于X=0.886至X=0.908的坐标范围内,在归一化坐标X=0.864至X=0.886区间内,界面内正应力由529.80 MPa逐渐升高到670.38 MPa,当归一化坐标由X=0.886移动到X=0.900时,界面内正应力先是快速降到15.80 MPa,紧接着缓慢降到–17.844 MPa,当归一化坐标由X=0.900移动到X=0.925时,界面内正应力先是由–17.844 MPa快速升高到583.95 MPa,紧接着缓慢降至421.48 MPa.而对于没有迸溅金点的情况,界面内正应力则直接由517.39 MPa逐渐降到404.30 MPa.显然,迸溅金点的存在对InSb芯片的影响是局部的,即在归一化坐标X=0.864到X=0.925区间范围内,这一范围略宽于迸溅金点所涵盖的位置坐标.
存在迸溅金点时,液氮冲击下,在InSb芯片下表面会形成两个应力集中点,分别位于归一化坐标X=0.886和X=0.908处,如图4所示.为了解迸溅金点存在时应力集中对InSb芯片造成的影响,在应力集中点上方的InSb芯片中预置不同长度的裂纹来研究预置裂纹在应力集中下对InSb芯片破碎的影响,这里的预置裂纹基于InSb晶体中存在位错缺陷的事实.通过预置不同长度的初始裂纹用以描述InSb晶片中的位错,得到与裂纹长度对应的能量释放率.能量释放率由InSb芯片中的面内正应力和垂直于芯片的虚拟裂纹决定,面内正应力取决于热失配.借助能量释放率作为InSb芯片中出现裂纹衍生与扩展的判据,绘制了InSb芯片中能量释放率随预置裂纹长度的依赖关系,如图5所示.
如图5所示,在进行InSb芯片内能量释放率提取时,发现II型能量释放率仅是I型能量释放率的千分之一,因此在总能量释放率计算时,II型能量释放率忽略不计,即总能量释放率G=GI.从用于描述裂纹衍生与扩展的能量释放率来看,InSb芯片断裂失效模式为I型断裂失效模式.

图5 不同裂纹扩展长度下InSb芯片中能量释放率的演化过程Fig.5.Evolution process of energy release rate in InSb chip under different crack propagation lengths.
不论应力集中点是位于X=0.886,还是位于X=0.908,InSb芯片内部的能量释放率均伴随着裂纹扩展而呈现线性增长趋势.对于X=0.886处的应力集中点而言,当预置裂纹长度从1 µm扩展到8 µm时,能量释放率从0.898 J/m2逐渐升高到6.311 J/m2,在这个预置裂纹长度区间内,能量释放率的增长率相对较低,但当预置裂纹长度从8 µm扩展到10 µm的过程中,InSb芯片中的能量释放率从6.311 J/m2指数增长到114.11 J/m2,在这一预置裂纹长度区间内,能量释放率的增长率处于非常大的值.需要指出的是,当预置裂纹长度为10 µm时,预置裂纹已贯穿InSb芯片,到达其上表面,此时的能量释放率达到最大值114.11 J/m2.模拟得到的能量释放率与预置裂纹长度的演化关系与Liu等[17]得到的结论基本一致,这进一步证明了本文模拟结果的正确性.当InSb芯片内的裂纹延伸到表面时,能量释放率从理论上讲是无限的,在理论计算中对应于能量释放率增加了两个数量级.
InSb 晶体制备中,通常会引入不同数量的位错线.在不受外界影响时,这些位错线深埋于InSb芯片中,一旦进行周期性液氮冲击,这些位错线会在应力集中的驱动下逐步扩展、长大,直至延伸到InSb晶片表面,形成贯穿位错线,导致InSb芯片发生局部微观碎裂,随后在多周期液氮冲击中,这些贯穿位错线在应力集中效应的驱动下继续扩展,直至形成宏观的碎裂失效,这一推断符合实验历程,能够解释InSb芯片的低周期碎裂失效模式.因此我们认为:多周期液氮冲击中,迸溅金点的存在会在InSb芯片下表面形成应力集中点,在一定程度上会加快位错线的扩展,表现为InSb芯片内的能量释放率不断增加,从而增加InSb芯片出现破碎失效的概率.
6 结论
低周期液氮冲击中起源于InSb面阵探测器边沿区域的InSb芯片破碎失效与该区域中迸溅金点有关.为了从理论上剖析迸溅金点的存在对InSb芯片碎裂失效的影响,建立了包含迸溅金点的InSb面阵探测器结构分析模型,以应力分量为依据,认为迸溅金点的存在对InSb IRFPAs造成的影响是局部的,在迸溅金点与InSb芯片接触区域的两端附近会形成两个应力集中点;以能量释放率为判据,在应力集中处预置不同长度的初始裂纹用以替代InSb晶片中的位错线,发现环绕预置裂纹的能量释放率会随着预置裂纹长度的增加而加速增大;综合应力和能量释放率分量值的大小,认为迸溅金点引起的InSb芯片破碎属于I型断裂失效模式.在多周期液氮冲击中,位错线在应力集中的驱使下逐步长大,贯穿InSb芯片,形成微观局部破碎,局部破碎在应力集中效应的驱动下继续扩展,形成宏观的碎裂失效模式,这一推断符合实验历程,能够解释InSb芯片的低周期碎裂失效模式.
