MEMS陀螺芯片的晶圆级真空封装
2022-01-21刘福民张乐民张树伟王学锋
刘福民, 张乐民, 张树伟, 刘 宇, 王学锋
(北京航天控制仪器研究所,北京 100039)
0 引 言
微机电系统(micro-electro-mechanical system,MEMS)陀螺[1,2]的微结构需要工作在真空环境下以实现高谐振Q值并确保其检测灵敏度[3,4]。当前,采用晶圆级真空封装是国外发展MEMS陀螺的主流工艺方案[4,5],它通过采用晶圆级封装,可以避免MEMS微结构在后续芯片划切中的粘连、颗粒污染,还可以降低真空封装成本、提高芯片的加工成品率。此外,晶圆级真空封装可实现器件的小型化、集成化,是实现惯性微系统的必由之路,对于进一步提高MEMS陀螺性能和可靠性,满足工程应用需求具有重要的意义。
目前开展MEMS惯性器件晶圆级真空封装的代表性研究机构有德国Bosch、加拿大DALSA、美国Inversense[6]和瑞典Silex[7,8]等公司,他们的技术方案各具特色,并已经实现了工程化应用产品。MEMS惯性器件的晶圆级真空封装在实现微可动敏感结构真空密封的同时也要实现可动结构与封装结构外的电气互联[4]。整个晶圆级封装的工艺设计需要兼顾这两方面的要求。
本文围绕MEMS陀螺的工程化需求,进行晶圆级真空封装的工艺技术研究,采取全硅(Si)基的芯片结构设计,开展了相关关键工艺技术研究,实现了晶圆级真空封装的MEMS陀螺仪芯片,实现了约为2 Pa的真空度,晶圆级真空封装达到MEMS陀螺工程化研制需求。
1 MEMS陀螺晶圆级封装结构与工艺流程
本文设计的芯片整体结构如图1所示,芯片由三层结构组成,包括衬底层、器件层和封帽层。其中,在器件层的MEMS陀螺微结构是整个芯片的核心部分,其周边是键合环,用于与衬底层和封帽层进行键合,形成密封空腔结构;封帽层与器件层之间有一层图形化的二氧化硅(SiO2),通过硅—二氧化硅(Si-SiO2)直接键合将器件层与封帽层键合在一起,SiO2确保了器件层与封帽层的绝缘;衬底层上布有电极图形,与器件层之间通过金—硅(Au-Si)共晶键合[5]使两层结合在一起,形成一个可供器件层的梳齿微结构自由活动的空腔,并采用侧面电极引出的方式实现空腔结构内的器件层结构与空腔外电极焊盘的互联。

图1 晶圆级封装MEMS陀螺结构示意
上述结构的工艺加工流程如图2所示。其中,图2(a)所示完成陀螺芯片封帽以及微结构芯片加工的各工序。首先,在封帽层上通过干法刻蚀形成表面带有SiO2的锚区结构及凹腔结构;然后,封帽层通过Si-SiO2直接键合实现与器件层的键合;最后,器件层经减薄抛光后,在其上用干法刻蚀工艺刻蚀出陀螺的微可动结构。
陀螺衬底层的加工如图2(b)所示。首先,通过湿法腐蚀在衬底层上形成凹腔结构,并通过热氧化形成绝缘层;然后,在绝缘层上制作电极层,并生长第二层SiO2绝缘层;接下来,在第二层SiO2绝缘层上刻蚀出接触孔,以便于电极与后续的金层相连接;最后,在衬底层上形成吸气剂薄膜[9]和Au电极,后者用于电气互联并作为后续Au-Si键合的介质。

图2 MEMS陀螺芯片各层工艺流程
MEMS陀螺芯片的晶圆级真空封装通过Au-Si共晶键合实现,在真空条件下,衬底层上的Au与器件层的硅发生共晶反应,形成芯片的真空封装。在Au-Si共晶键合过程中的加温过程可以实现吸气剂的激活,从而提高真空密封的真空度。最后,芯片经过划切即可得到如图1所示的MEMS陀螺芯片。
2 晶圆级真空封装关键工艺研究
2.1 Si-SiO2直接键合工艺
在图2(a)所示的器件层与封帽层的加工流程中,器件层与封帽层的Si-SiO2直接键合是其核心工艺,实现器件层微结构与封帽层上锚区的机械连接。
Si-SiO2直接键合的原理[10]是,裸Si片和带有氧化层的Si片,经清洗后会形成羟基(-OH)密度较高的亲水表面,将具有亲水表面的两片晶圆贴合到一起,分子间作用力(范德华力和氢键)会使两片晶片键合在一起。晶片经退火后,互相结合的活性氢氧基团开始进行脱水,会转化为稳定的Si-O-Si共价键,形成Si-SiO2永久性键合界面。其反应式为
Si-OH + HO-Si → Si-O-Si + H2O
(1)
在上述过程中,晶片表面的羟基是晶片实现键合的重要媒介,因此在Si片的清洗过程中,经标准清洗的Si片不再用氢氟(HF)酸去除自然氧化层,以确保晶片表面的亲水状态。为了提高键合强度,对待键合裸Si片和带氧化层的Si片表面分别进行了氧等离子和氮等离子激活处理。通过等离子体激活处理后,会增加待键合晶片表面的活性氢氧基团悬挂键,有利于提高键合强度。
为确保陀螺稳定可靠工作,需要陀螺微结构上所有锚点均具有高的键合强度。为评估芯片结构上各个锚点(面积为50 μm×50 μm~200 μm×200 μm)的键合强度,本文通过对芯片上所有锚点进行破坏性剪切测试的方法进行键合强度统计评估。界定一个锚区键合强度合格的判据为破坏性测试时,键合面断裂时应有50 %面积的SiO2留在器件层Si上。对采用400 ℃低温退火的样品进行测试,结果如表1所示,结果表明,大约有一半的芯片上至少有一个锚区键合强度不合格,而存在缺陷的芯片中,平均有5~7个锚区键合强度不合格。

表1 采用400 ℃退火的锚区键合强度破坏性测试结果
基于以上结果,对键合的退火温度进行了优化,由原来的400 ℃低温退火,调整为高温退火。经退火工艺优化后,晶片的键合强度得到了显著的提高。图3(a)中显示的是经400 ℃低温退火的晶圆封帽层上锚区结构,其上只有部分面积的SiO2被撕裂;图3(b)图中显示的是经高温退火的器件层的结构,键合面断裂后将封帽层上的全部面积的SiO2撕裂并留在器件层上,表明经高温退火能够有效提高键合强度,而且Si-SiO2的键合强度已经超过了热氧化法生长的SiO2的强度。多个晶圆测试表明,晶圆内Si-SiO2直接键合强度合格的芯片比例达到97 %上,并且不合格芯片平均不合格锚区数控制在2个以内。由于在本文的工艺流程设计中,Si-SiO2直接键合不存在其他金属,因而高温对结构本身无影响,因此经高温退火的Si-SiO2直接键合工艺可以满足MEMS陀螺芯片的加工需求。本文利用Dage4000剪切力测试仪对Si-SiO2晶圆键合的样品进行剪切测试,结果表明键合强度可以达到56.5 MPa。
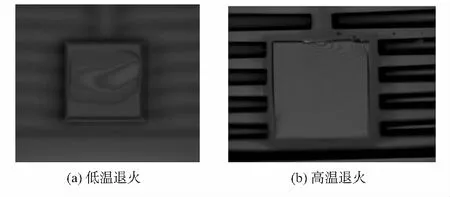
图3 不同退火温度下锚区的典型破坏性测试结果
2.2 吸气剂工艺研究
在晶圆级封装MEMS陀螺中,吸气剂薄膜[9,11]制备是高真空度获得进而确保陀螺谐振高Q值的必要方法。吸气剂材料需要在真空的条件下对其进行加热激活恢复其吸气能力。吸气剂的激活通常需要与芯片最终的真空封装过程同时进行,因此在本文所设计的工艺流程中,吸气剂的激活需要与Au-Si共晶键合过程相兼容,吸气剂的激活温度要低于Au-Si键合的共晶温度(363 ℃)。
本文选择Ti基的非蒸散型吸气剂[11]材料,非蒸散型吸气剂薄膜的制备可以通过磁控溅射工艺来实现。磁控溅射生长Ti薄膜的微观结构与生长过程中的衬底温度、射频功率、溅射气压等工艺参数紧密相关,通过工艺参数优化,最终生长出具有柱状晶粒结构的多孔Ti薄膜吸气剂薄膜,形成的薄膜表面及断面微观形貌如图4所示。
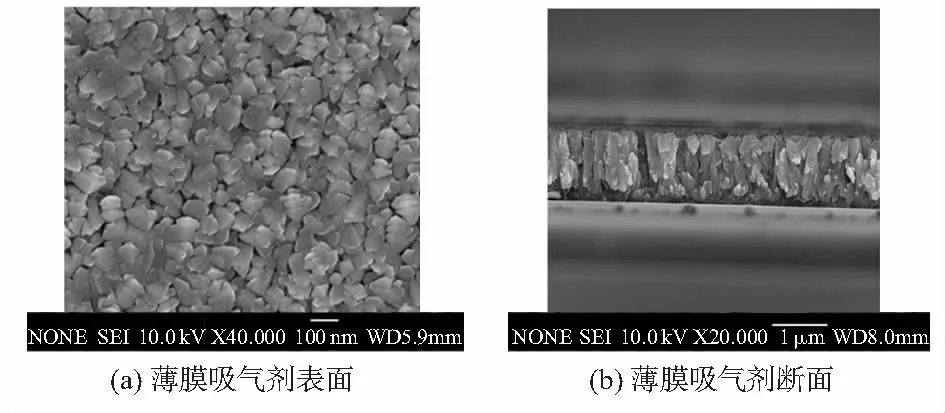
图4 扫描电镜下薄膜吸气剂的微观形貌
在确定溅射生长参数的基础上,在Si片上生长了两片吸气剂薄膜样品,一种是单Ti薄膜,另一种是以Cr为黏附层的Ti薄膜。在真空条件下对两片样品在300,340,380 ℃下进行加热30 min激活处理,并用定压法[12]测试了两片样品的吸氢性能曲线。测试结果如图5所示。测试结果表明,在两种薄膜吸气剂在300 ℃下已经具备吸气能力,随着激活温度升高,吸气能力逐渐增大,其最大初始吸气速率在380 ℃激活条件下达到130 cm3/(s·cm2);在300 ℃激活的条件下,Cr/Ti薄膜具有比单层Ti膜更高的吸气能力,而随着激活温度的提高,两者的吸气能力趋于一致,表明Cr/Ti薄膜具有比Ti更低的激活温度,这可以解释Cr层的存在会在一定程度上增加Ti膜的孔隙率。因此对于较低的晶圆级键合封装温度,Cr/Ti薄膜更有利于获得较高的这空度。在Au-Si键合晶圆级真空封装中,实际键合温度最高可以到400 ℃,此时Ti和Cr/Ti的吸气性能已趋于一致,因此两者均可用于Au-Si共晶晶圆级真空封装,其吸气能力足以能够满足晶圆级真空封装的要求。
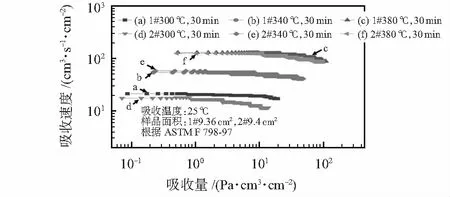
图5 两种薄膜吸气剂样品在不同激活温度下的吸氢性能曲线(1#:Ti;2#:Cr/Ti)
2.3 Au-Si共晶键合真空封装工艺
MEMS陀螺的晶圆级真空封装通过Au-Si共晶键合实现,Au-Si键合是晶圆级真空封装中的关键环节,在实现MEMS结构晶圆级真空封装的同时,也实现了MEMS结构与电路引线间的电学连接。将图2(a)和图2(b)所示加工好的衬底片与器件层和封帽层在键合对准机下进行对准,然后放入键合机中进行Au-Si键合。键合过程中经高温除气后,两组晶圆开始接触并加以5 000 N的压力,温度升至363 ℃共晶点后,保持15 min,然后继续升至400 ℃并保持15 min,以确保Au-Si共晶反应充分。
Au-Si共晶键合对Si表面存在的氧化层十分敏感,Au在SiO2表面的浸润性非常差,而Si片的自然氧化层会阻止Au-Si接触,使共晶共熔无法实现。因此,为确保Au-Si键合具有足够的键合强度,键合前需要用稀氢氟酸将Si表面的自然氧化层去掉。然而在稀氢氟酸湿法清洗过程中,水分子的表面张力易造成梳齿或梁结构的粘连。为避免微结构的粘连,采用气态氢氟酸干法腐蚀工艺,将表面的自然氧化层腐蚀掉。由于该工艺梳齿结构无需浸泡在液体中,因此不会造成结构粘连。
在Au-Si共晶键合过程中,Au-Si生成的液相共晶合金在压力作用下,容易出现外溢的现象。Au-Si共晶外溢容易造成微结构间短路,影响芯片成品率。为了保证良好的键合质量,防止共晶液的溢出,本文在陀螺四周的密封键合环上设计了防溢出浅槽结构,如图6所示。在键合过程中,液态Au-Si共晶体在压力的作用下首先填充到浅槽中,从而避免了Au-Si共晶液的外溢,避免了结构的短路。

图6 键合环上的防Au-Si共晶溢出浅槽结构
对于完成Au-Si共晶键合的芯片样品,本文对芯片键合环部位进行了破坏性剪切强度测试,测试仍采用Dage4000剪切力测试仪,相关测试数据如表2所示,测试后的样品如图7所示。结果表明,Au-Si共晶键合晶圆的剪切强度可以达到35 MPa以上,并且键合面断裂时衬底层将芯片层的一部分Si撕裂了下来,表明Au-Si共晶键合的强度超过了Si材料的强度,进一步表明了本文的Au-Si共晶键合强度可以满足晶圆级真空封装的要求。

表2 Au-Si键合剪切强度测试数据

图7 Au-Si共晶键合面破坏性测试结果
3 晶圆级真空封装MEMS陀螺芯片的测试
按照上述工艺进行MEMS陀螺芯片晶圆级真空封装进行制备,晶圆经常规切割,形成MEMS陀螺芯片。将实现的MEMS陀螺芯片置于探针台上,施以驱动信号,对其进行扫频测试,从而得到其品质因数。经测试,芯片实现的最高Q值为103 879。而不使用吸气剂的晶圆级真空封装的芯片Q值最高仅为1 500,表明吸气剂已经在封装过程中被激活并发挥了作用。
为便于标定Q值与真空度之间的对应关系,本文在真空探针台下测试了非晶圆级真空封装的相同结构陀螺芯片的Q值与气体压强,其关系曲线如图8所示。

图8 MEMS陀螺芯片品质因数Q与气压关系曲线
对比上述测试结果可知,本文晶圆级真空封装的实际真空度可以达到2 Pa左右。为进一步提高真空封装的真空度,需要进一步优化吸气剂的制备及激活工艺,提高吸气能力,同时还需要优化衬底层上其他金属层的溅射工艺,减少氩气等惰性气体在薄膜内的吸附和扩散,减小惰性气体在真空封装后的微腔内的残留[13,14]。
4 结 论
本文提出了一种MEMS晶圆级真空封装结构方案,并对Si-SiO2直接键合、吸气剂制备、Au-Si键合等关键工艺技术进行了研究,Si-SiO2直接键合剪切强度达到56.5 MPa;薄膜吸气剂经380 ℃高温激活,其初始吸气速率可达到130 cm3/(s·cm2);Au-Si共晶键合成功解决了液态Au-Si共晶体的外溢的问题,实现了大于35 MPa的键合剪切强度,最终实现了MEMS芯片的晶圆级真空封装。测试结果表明:晶圆级封装中各层晶圆之间形成了足够强度的键合,吸气剂在键合过程中被成功激活,实现最低可达2 Pa的晶圆级真空封装的真空压力,并实现最高为103 879的陀螺结构谐振Q值。本文研制的晶圆级真空封装MEMS陀螺芯片可以满足MEMS陀螺工程化的需要。
