探讨LED封装工艺的优化及管控
2022-01-07林连城
林连城
(厦门华联电子股份有限公司,福建 厦门 361008)
0 引言
LED产品生产的重中之重就是封装工艺,它对产品性能、可靠性和成本具有决定影响。本文针对LED封装工艺进行优化,主要从以下几个方面进行改进,从而保障产品质量和性能。在LED封装环节中做好准备工作十分关键,需严格控制原材料品质,最终促进LED封装工艺细节质量的提升。
1 LED 封装工艺流程

图1 LED 封装工艺流程
1.1 固晶
在正式开展LED封装工作之前,需实施固晶操作,固晶主要指借助胶在支架上固定LED晶片,固晶的稳定性受到固晶处理操作的决定性影响。需要控制固晶胶温度,使其小于零下40摄氏度,对胶进行使用时,需借助针筒吸入绝缘胶,静置于常温环境中半个小时,在胶达到适合温度条件下,将其安放在固定胶盘内,开展处理搅拌工作,使扩晶得以实现[1]。
开展扩晶工作时,在母环中安放晶片膜,开启崩片机台温度设定为(50±5)℃,在离子风扇下缓慢撕膜,待温度到达设定温度时,掀起绷片机上盖,先后将绷片环内环、芯片蓝膜放置在绷片台上,合上上盖并锁紧,扩片后,开启上盖,取下绷好的芯片环,目检芯片排列整齐,间距一致,将四周多余蓝膜用刀片割掉,送自动固晶工序待用。
为了使LED支架表面光亮清洁,无发黄、发黑或者其他沾污现象,增强固晶效果,需在固晶前对支架进行清洗,预烘烤的产品须在半小时内进行等离子清洗,若超过半小时后,必须重新进行预烘烤后才能清洗,产品清洗完成后必须在4小时内流入下一道工序,超过4小时后需要重新进行等离子清洗。
将清洗完成的支架放在固晶机台上,并做好手的防静电指套,先在LED支架上点上银胶(绝缘胶),然后用真空吸嘴将LED芯片吸起移动位置,再安置在相应的支架位置上。(对于GaAs、SiC导电衬底,具有背面电极的红光、黄光、黄绿芯片,采用银胶。对于蓝宝石绝缘衬底的蓝光、绿光LED芯片,采用绝缘胶来固定芯片。)工艺难点在于控制点胶量,在胶体高度、点胶位置均有详细的工艺要求,胶量符合工艺要求(银胶高度为芯片高度的1/4~1/3,绝缘胶高度为芯片高度的1/3~1/2)。
完成固晶工作后,烘烤固晶胶,设置烘烤温度,使其达到(175±10)℃/(60~70)分钟,中间不得随意打开,烧结烘箱不得再其他用途,防止污染。
固晶胶烧结之后,还需测试其推力,根据芯片大小设置芯片推力大小,判断固晶效果,为固晶稳定性提供保障。

图2 测试芯片推力
1.2 焊线
LED封装过程中的重点内容是焊线,需应用热压和力超声波开展此环节工作处理LED支架,从而实现对接支架上键合与芯片电极的目的。
LED的压焊工艺有金丝球焊和铝焊,金丝球焊过程先在压第一点前烧个球,在LED芯片电极上压上第一点,再将金丝拉到相应的支架上方,压上第二点后扯断金丝。完成第一个焊点球工作后,对接电极焊和金线,给进线施加压力,促进线弧产生。
1.3 荧光粉涂覆和烘烤
借助荧光粉开展涂覆与烘烤工作时,点胶涂覆法是最常用方法,在具体实践过程中,此种方法具有明显优势,即特别适合应用于规模化生产中,具有简单生产操作流程,缺点是实际生产过程中具有较低精确度,无法对LED封装要求进行满足。实际运用中点胶涂覆法具有较差重复性,会促进沉淀产生,进而会影响到涂覆质量。
比如,涂覆荧光粉过程中,可能会在温度、压力等因素影响下,导致大量气泡产生,受热后的LED灯珠中会有膨胀气体产生。空气与硅胶膨胀系数不相同,在此条件下,就会撕裂硅胶弹性体。
1.4 储存于静电管理
密封是存储LED封装环节的直接目标,能够防止氧化LED支架,降低其银层灵敏度。存储优点是可以保障LED具有可靠的质量。如果不能科学合理封装存储,会导致一种化学元素进入LED支架中,造成化学反应发生于银层与元素S之间,最后使Ag2S产生于LED支架,此化学产物会使支架的银层反射能力大幅度下降,导致有光衰现象出现。由此看来,需将真空封装方法应用于LED封装存储环节中,并且将其存放于小于30摄氏度的环境中[2]。
静电管理对于LED要求也是比较高,因此在LED制作整个过程,对于LED静电防护措施需要充分做到位。
(1)进入车间需要穿防静电净化服,防静电净化鞋帽,人体需戴有线防静电手环。
(2)车间操作机台、地板、桌椅、包装材料、周转盒等需设置防静电防护。
(3)配胶过程以及检验过程需配置离子风扇。
2 LED 封装工艺优化
2.1 焊线工艺优化
具体应用LED过程中,通常会发生不良焊接造成功能失效情况,由此看来,必须促进焊线质量的提升。对于焊线环节的施工工作而言,需对工艺实验参数进行严格控制,只有这样,才能为实验参数在可控质量范围内提供保障。
在焊线前,需对支架、芯片清洁度进行清洗并进行检测,根据不同材质选择清洗水滴角标准,一般选择水滴角(润湿角)≤40°,确认在焊线前电极上无污染,保证焊接效果,等离子清洗后,需在8小时内完成焊接,防止过程再次被污染,保证焊接效果。
焊线时确定参数,寻找符合标准要求的高度、速度、球径、打火间隙、打火时间、送线量、打火功率分别是150µm、12µm/s、60µm、1300µm、1200µs、520µm、40m/s有很多因素都会造成LED封装焊接键合不良,包括劈刀寿命管控、不良存储,人体净化、污染空气等。
在焊线后需对焊线效果进行检测,焊点位置:第一焊点的焊球不偏出电极,第二焊点不得超出键合区范围,焊点形状:金球形变好,丝与球同心。金球推力:≥40gf,有残金。第一焊点金球大小A为(60±15)um(约为芯片电极的90%),金球厚度B约为(10~23)μm,第二焊点金球大小A为(80±15)μm,芯片无裂片、碎片、掉电极等不良,基板无变形、发黄等不良,无多余金丝杂质,BSOB/BBOS线型,高度超出芯片表面(0~250)um,形状良好,无塌丝、倒丝等不良。
金丝测拉力时,拉勾对准拱丝中间位置,垂直向上拉,键合拉力及断点位置如图,断点位置A,球与电极相连处,不论拉力为何值,都不合格;断点位置B,金球根部,断点位置C,BD点之间,一般拉力要求≥7g;断点位置D(契形与金线转接处),断点位置E(支架与第二点契形断开),不论拉力为何值,都不合格.

图3 测金丝拉力
测金球的推力时,首先选择剪切工具的型号,一般剪切工具应该是扁平,宽度为1.5倍到2倍键合直径或者键合长度的剪切面,将剪切工具置于键合点位置,垂直于器件表面且距其小于键合点高度的一半,剪切工具的底部应保持在键合点中心线下方,芯片键合区金属化层的上方,测试机参数设定推刀高度为(3~5)μm处测试推力,根据实际金球大小,设定推力大小,一般要求≥30g。
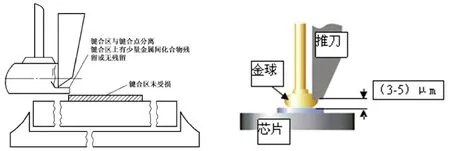
图4 测金球推力
除此之外,如果不能适当保管LED金丝,就会导致使老化情况的出现,大大改变金丝延展度和硬度。为了有效保障LED金线键合稳定性,在开展封装工作之前,技术人员可以开展等离子清洁工作,通过比较之后发现,清洁芯片之后,可以大大提高焊线和支架拉伸韧性,至少增加20%。
2.2 荧光粉涂覆工艺优化
在提高LED封装质量方面可以应用荧光粉涂覆工艺优化方式,点胶涂覆法是传统荧光粉涂覆方式,此方法具有简单作业程序,缺点是无法均匀分布LED的光强[3-4]。例如,有比较弱的蓝光产生于支架边缘上,在蓝光穿透荧光粉过程中,大量荧光粉会将蓝光吸收,使黄光显示出来。涂覆此种荧光之后,会加重LED颜色不均匀情况。为了改进此种情况,需采用自由点胶涂覆法,这是反沉淀荧光粉涂覆工艺的一种,支架结构出光概率比较大,防止有散射损失出现在荧光粉中。
首先在荧光粉涂覆前需进行配胶,配胶顺序:先加胶后加粉。加胶时,如果A部:B部=1:1,则先加A部,如果A部:B部=10:1,则先加B部,配制好荧光胶之后需及时将剩余的胶和粉密封并放入电子干燥箱贮存,将配制好的荧光胶放入真空搅拌机依真空搅拌机搅拌,取出搅拌好的胶,荧光胶颜色均匀,胶中无气泡,杯壁无荧光粉残留,点胶时针头应高于碗杯顶部并小于1.5mm,配置好的胶需要在0.5小时内点完胶,防止荧光粉沉淀,在配置点胶机台采用螺杆推进式,避免采用气压式。
为了达到点胶效果达到要求,在烘烤前将产品固定在测试夹具上,最后将顶杆放置到积分球内,调整测试积分时间、光度量程档位设置使测试Ip值约在60%~80%之间,在显微镜下镜检产品荧光胶均匀一致,无黑点、气泡等异常[5-7]。为了减少在温度、压力等因素影响下,导致大量气泡产生,受热后的LED灯珠中会有膨胀气体产生,导致撕裂硅胶弹性体,因此在烘烤前设置好温度与时间,进行循环烘烤,避免同个温度,一直存在烘烤,一般温度与时间设置分别如下:

表1 烘烤前温度与时间的设置
通过以上配胶、点胶以及烘烤方案的优化,可以有效的降低荧光粉反沉淀以及硅胶体膨胀带来的问题。
3 结语
总而言之,为了使封装质量得以提高,开展LED封装工作前需将基础准备工作做好。确保LED能够顺利封装的原材料包括:荧光粉、蓝光芯片、支架。想要保证封装质量,需将抽样检查方式用于这些材料中,只有质检合格的原材料才可以进入具体封装工艺中。
