low-k介质的机械可靠性的研究进展
2021-06-30北方工业大学王雪松王艳蓉魏淑华
北方工业大学 王雪松 闫 江 王艳蓉 张 静 魏淑华
随着集成电路尺寸的不断微缩,后段制程(back-end-ofline,BEOL)中低介电常数(low-k)材料的选择制备与集成逐渐成为制约超大规模集成电路发展的重要因素之一。将具有低介电常数的多孔材料集成到微电子器件中对图形化和沉积技术提出了许多挑战,对材料在性能和可靠性方面提出严格的要求。在集成过程中,多层结构中应力驱动的机械失效影响了微电子器件的可靠性。本文通过概述孔隙率、有机桥联末端基团(-CH3、-OH等)、超链接网络和沉积技术对low-k薄膜的不同影响,从力学性能(杨氏模量、硬度)方面讨论了low-k材料的机械可靠性,证明了多孔超低介电常数材料的力学性能与孔隙率、网络结构和沉积技术密切相关,为研究多孔超低介电常数材料提供一定的支撑。
随着微电子器件特征尺寸的不断微缩,晶体管密度不断增加,功耗问题逐渐成为制约集成电路发展的瓶颈之一,互连层电阻和电容所产生的延迟效应越来越明显,而减少RC延迟的途径之一是用低介质常数材料代替传统材料。深亚微米范围内尺寸的缩小意味着图形化和沉积技术面临着巨大的挑战,从而对薄膜可靠性造成了一定影响。
在半导体行业中,杨氏模量经常被用来评估层间介质材料的力学性能和工艺相容性。当杨氏模量不能满足最低标准时,则该材料不能用于双镶嵌集成。本文对low-k材料的机械可靠性进行了调研,研究表明多孔超低介电常数材料的力学性能与孔隙率、网络结构和沉积技术密切相关。
1 孔隙率
多孔材料的整体力学性能,取决于基体的性能和孔结构。由于难以单独控制孔隙率和基体性能,使纳米多孔low-k介质中对孔隙率的研究变得复杂。
为了调节有机硅玻璃(OSG)薄膜的孔隙率,需要改变薄膜沉积过程中的孔原负载量。利用二乙氧甲基硅烷(DEMS)作为前驱体,采用PECVD技术在不同的孔源负载下沉积了OSG薄膜(图1)。Si-O-Si峰相对于SiC-H3峰的相对强度随膜孔隙率的增加而减小,表明与基体中的网络键相比,端基的相对量发生了变化。
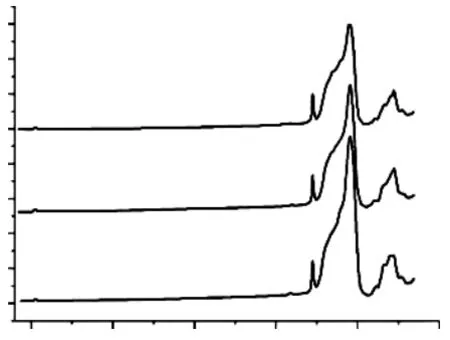
图1 不同孔隙率(P)的OSG薄膜的FTIR吸收光谱
2 混合介质
通过在二氧化硅网络中引入有机端基来实现低介电常数是大多数传统的有机硅电介质的共同之处。Seregin等人发现,过高的甲基浓度会降低OSG薄膜的机械性能,杨氏模量随SiO2网络物的浓度而增加(图2)。当采用CH3=Si比大于0.2的溶胶进行沉积时,薄膜变得疏水。孔径随甲基浓度的增加而增大,分子力学模拟表明Si-O-Si键中dπ-pπ杂化的改变,而这种杂化受CH3基团的影响,甲基基团降低了基质中Si原子的交联度,进一步表明其力学性能较低。

图2 杨氏模量与网络峰的峰面积的关系
末端基团(如末端甲基基团)破坏了共价分子网络,降低了材料的机械完整性。Dubois等人提出在薄膜沉积过程中强化薄膜的新策略。通过加强前驱体单体结构,烃类分子可以作为网络形成单元而不是作为终端基团结合到材料基体中,从而形成一个破坏较少并且强度较高的网络。在PMO材料中,与由末端甲基基团组成的结构相比,桥连的聚倍半硅氧烷(≡Si-O-Si≡)中的桥连有机基团交联(-CH2--CH2-CH2-,芳族基团等)增加了整体连接性,使机械强度提高。
桥连碳基取代末端甲基的组合物的优点是可以保持提高材料可靠性。烷基桥联的low-k薄膜比带有甲基端基的薄膜具有更好的力学性能(图3)。随着桥连烷基基团的浓度升高和末端甲基浓度的降低,膜中具有桥连烷基的OSG膜具有更高的杨氏模量。这一事实与利用力场势和基于密度泛函理论的理论分析结果相一致。证明纯二氧化硅的体积模量从(约39.5GPa)逐渐增加到59.3GPa,是由于一半的氧原子被亚甲基(-CH2-)桥连基团取代。所以基于碳的桥接基团比氧桥更有利于于杨氏模量的提升。

图3 (a)杨氏模量对桥连和终止烷基基团浓度的依赖性
当两个以上的硅原子通过芳环连接而而转变为超连接结构时,对分子网络力学性能的影响是惊人的。如图4所示,即使在低得多的密度下超连接柔性硅烷的性能优于乙烯桥接模型。

图4 1,3,5-苯桥连的材料的体模量与其他有机体桥连材料的关系
Chunhui等人研究证明了其机械强度高于完全致密的二氧化硅。图5(a)是由EP和NI测得的不同含量1,3,5苯前体薄膜的杨氏模量,杨氏模量值比实际应用的系统化数据要大,这种差异在无孔膜中更为明显。较高浓度的1,3,5-苯在“无孔”薄膜中显示出明显的优势,其介电性能如图5(b)所示。k值随孔隙率的增加而减小,最小可以降低至2.5以下。但是对比不同1,3,5-苯占比薄膜的介电常数可以看出具有较高浓度的1,3,5-苯基的薄膜的较大k值。这意味着苯桥的存在明显改善材料的机械性能的同时也使得介电常数在一定程度上增加。因此如何兼顾该制备沉积的low-k薄膜的力学性能和介电常数是该材料研究的重点问题。
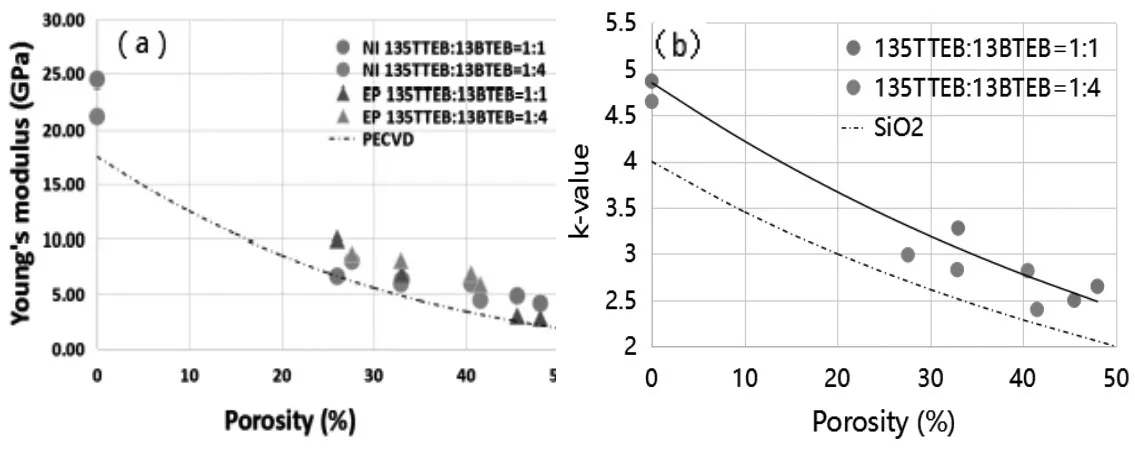
图5 (a) 在原始和改性实验中沉积的所有薄膜的杨氏模量,虚线曲线对应于PECVD薄膜杨氏模量的变化 (b)不同薄膜的介电性能
力学性能上的差异也显示了潜在分子结构的重要性:超连接柔性硅烷的弹性特性与密度呈超线性关系,而乙烯桥接模型则呈线性关系。随着柔性硅烷侧链长度的减小,形成网状端部的前驱体数量减少,极大地提高了机械性能。
3 沉积和固化
3.1 沉积技术
Low-k薄膜的研究中常用的沉积工艺有等离子体增强化学气相沉积(PECVD)和旋凃沉积(Spin-on)。同时薄膜沉积后需要使用温度≥400°C的退火处理,以去除有机相并产生孔隙率。该工艺也会引起骨架结构的一些化学变化,并伴随着薄膜收缩。然而,无论是纯热处理还是辅助通过紫外辐射,都不能形成较好的多孔材料。因此,通过PECVD方法将有机硅酸盐基质前体(如烷基硅烷)与有机致孔剂(如环状烃)共沉积较为困难。
Spin-on沉积技术可以持续提供可控厚度的高质量涂层。由于PECVD沉积技术不能均匀地“填充”金属布线结构,当工艺需要良好的平坦化和间隙填充特性时,旋涂沉积较为合适。
通过比较PECVD沉积和Spin-on沉积后的有机硅玻璃(OSG)薄膜的消光系数(图6),无致孔剂旋凃沉积的OSG薄膜和PECVD OSG薄膜的消光系数更接近SiO2。采用PECVD技术,用有机二氧化硅基质和致孔剂共沉积制备的OSG薄膜,在UV固化后,比其他薄膜具有更高的消光率。消光系数最大为4.5eV,反映了sp2杂化碳的存在,表明致孔剂残留物的存在增加了OSG薄膜的消光系数。

图6 不同沉积技术下SiO2的消光系数
3.2 UV固化
PECVD沉积OSG薄膜后需要进行温度≥400℃的退火处理,以去除有机相并产生孔隙率。固化过程不再是一个独立过程,力学性能的提高,在多孔薄膜工艺中应考虑耦合(沉积和固化)。由于UV常被用作low-k材料固化,许多研究致力UV曝光转化的机制。
Hisamoto等人分析了Si-O-Si与UV的交联,获得了UV光子效应的统一解释,为了改善薄膜的力学性能。有两个至关重要的因素:紫外光子波长和Si-OH含量。
紫外线光子被其化合物吸收,通过选择性光解离,紫外线光子具有足够的能量使薄膜结构变(图7)。CH3中的C-H的键能(270-285nm)与发射的UV光很好地匹配。因此,紫外线能量可以有效地将破坏致孔剂及骨架中的C-H基团,产生所需的孔隙率。

图7 SiOCH材料中不同结构的键解离能
总结:在有机硅酸盐玻璃薄膜中引入孔隙率对其力学性能造成了一定影响,通过在PECVD过程中氧化烷基硅烷将有机二氧化硅基体与有机致孔剂共沉积来引入孔隙率,薄膜进行UV固化后,多孔分子发生光解离,通过SiCOH材料的键合结构(交联)中的热诱导和光诱导重排形成增强的Si-O-Si网络。然而,并非所有的孔原在紫外线固化过程中被去除,孔原残留物的存在会对薄膜基本性能及其工业工艺相容性产生负面影响。
本文从三方面总结了几种有效提高力学性能的方法。通过概述孔隙率、有机桥联末端基团(-CH3、-OH等)、超链接网络和沉积技术对low-k薄膜的不同影响。讨论了有机硅酸盐玻璃的力学性能。证明了多孔超low-k介质的力学性能与孔隙率、网络结构和沉积技术密切相关。因此,集成后的low-k材料的发展不仅取决于力学性能(杨氏模量、硬度)的一个简单因素,而是所有这些性能的组合及相对较高的机械或热机械载荷和环境影响,将共同决定其命运。
