偏置条件对国产SiGe BiCMOS 器件总电离辐射效应的影响
2020-10-30王利斌李小龙刘默寒
王利斌 王 信 吴 雪 李小龙 刘默寒 陆 妩
1(新疆大学物理科学与技术学院 乌鲁木齐830046)
2(中国科学院新疆理化技术研究所 中国科学院特殊环境功能材料与器件重点实验室 乌鲁木齐830011)
3(新疆电子信息材料与器件重点实验室 乌鲁木齐830011)
4(模拟集成电路重点实验室 重庆400060)
自20世纪70年代以来,微电子器件和集成电路仍沿着摩尔定律和国际半导体技术路线图的发展趋势进步。但从应用角度讲,硅基器件速度已经接近物理极限,在保持线性特性的基础上进一步提升其速度和改善其频率特性愈发困难。为了满足射频通信等应用对高性能器件的需求,该领域的研究重点逐渐转向新型半导体材料和结构的器件,如锗硅异质结(SiGe HBTs)工艺器件。SiGe HBTs 是最早在硅上实现能带工程的实用器件。带隙渐变使其具有卓越的耐低温特性,去除了庞大的保温装置,极大地降低了飞行器发射成本[1-2]。SiGe BiCMOS工艺技术将SiGe HBTs高频、低噪、高速、耐低温特性的优点,同工艺成熟、价格低廉、集成高、功耗低的Si CMOS 优势集合到一起,成为近年来深空探测不断发展的推动力,是空间微电子应用领域关注的热点[3]。
应用在航天器中的电子器件长期暴露在空间辐射环境中,必然遭受到各种宇宙射线辐射,会产生辐射效应和常规可靠性两方面的问题。其中电离总剂量效应问题凸显,电离总剂量效应是空间质子和电子经电离作用对器件产生的永久性损伤,是航天电子系统辐射效应研究的主要问题之一。SiGe HBTs由于禁带宽、本征基区薄等特殊器件结构,一般认为它具有很强的抗电离总剂量能力,国内外相关研究也证实了这点[4]。有国外课题组[5-6]对IBM公司的各代SiGe HBTs器件进行了详细的研究,国内中科院新疆理化技术研究所、清华大学、西安电子科技大学等单位也较早地对国产SiGe HBTs 器件进行了相关研究[7-10],发现其均具有非常优异的抗总剂量辐射效应和位移损伤效应的性能,但在国产SiGe HBTs器件上有很明显的低剂量率增强效应(ELDRS),而IBM公司器件上不存在[11-13]。
但是随着制备工艺的优化和结构的完善,比SiGe HBTs 应用前景更加广阔的SiGe BiCMOS 工艺器件在辐射环境中的长期可靠性出现新的表现形式,CMOS 工艺对电离总剂量(Total ionizing dose, TID)损伤更为敏感,严重制约了SiGe BiCMOS工艺器件的应用和国产化进程。因此,研究SiGe BiCMOS 工艺器件的TID 响应限制至关重要。对此,国外Fleetwood等[14-16]对IBM第一代到第四代SiGe BiCMOS 工艺器件进行了详细而系统的电离总剂量辐射研究,发现其同样具有非常好的抗电离总剂量辐射效应和位移损伤效应的性能,而且没有发现ELDRS 的存在。由于设备条件限制等原因,国内SiGe BiCMOS工艺的研究起步较晚,大部分还处于研发阶段,没有工程实用化,所以国内对国产SiGe BiCMOS 工艺器件相关报道极少[17-19]。为促进国产SiGe BiCMOS 技术的发展及其在航天领域的应用,对国产SiGe BiCMOS 工艺器件抗电离总剂量辐射响应的研究是十分必要且迫切的。为了全面评估国产新型0.35 μm SiGe BiCMOS工艺器件的抗电离总剂量辐射响应,本文对该器件进行了不同偏置条件下的高剂量率实验,发现其具有非常好的抗总电离剂量辐射效应性能,且偏置条件对0.35 μm SiGe BiCMOS器件的抗电离总剂量性能影响非常大。
1 样品及试验条件
本文选取了国内自主研发的新型0.35 μm SiGe BiCMOS工艺器件,在中国科学院新疆理化技术研究所的60Co γ辐射环境下进行了三种不同偏置(基射结正偏、基射结反偏和基射结零偏)状态的高剂量率辐照实验。本文辐照实验选取1 Gy(Si)/s 的高剂量率,总剂量累积到12 kGy(Si)。器件每累积吸收剂量2 kGy(Si),将其取出并用美国4200-SCS半导体参数分析仪在室温下对其参数进行测量,测试过程均保持在15 min 以内。对不同偏置条件下电参数随总剂量辐照响应结果进行了分析,得到基极电流Ib和集电极电流Ic随辐照累积剂量的变化关系,并对其进行了Gummel 特性曲线的测试,得到Ib和Ic随基极-发射极电压VBE的变化关系。
2 实验结果
随剂量而增大,从而导致了图2中电流增益以及峰值电流增益随剂量的不断退化。表明Ib是SiGe BiCMOS器件的主要敏感参数,Ic基本不受电离辐射效应的影响。当辐照总剂量累积到12 kGy(Si)时,3种偏置条件下器件峰值hEF仍高于170,说明其在高剂量率辐照下有着良好的抗电离总剂量辐照性能。在不同偏置条件下正偏Ib和hEF退化程度最小,零偏次之,反偏时的退化最大,说明反偏为其最劣偏置。
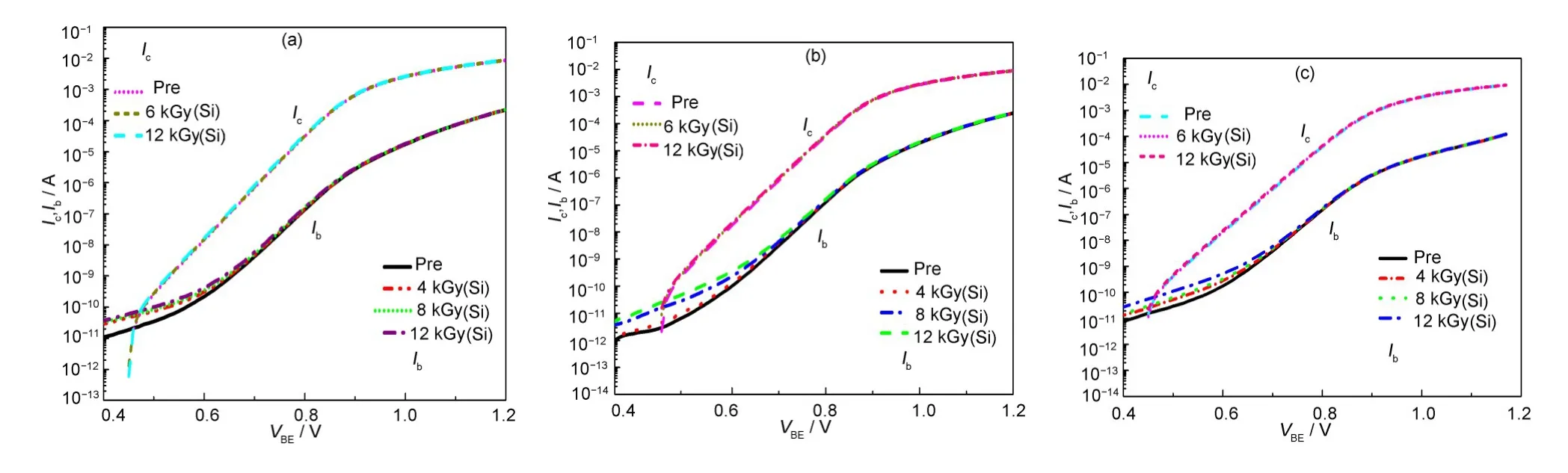
图1 SiGe BiCMOS器件Gummel特性曲线随累积剂量的变化:(a)正偏;(b)反偏;(c)零偏(彩色见网络版)Fig.1 Gummel characteristic curves of SiGe BiCMOS device changes with TID:(a)forward bias;(b)reverse bias;(c)zero bias(color online)
图1 和图2 给出了国产0.35 μm SiGe BiCMOS工艺器件正偏、反偏和零偏的Gummel特性和电流增益hEF(hEF=Ic/Ib)经电离总剂量辐照的变化示意图。从图1中可以明显看出,随着辐照累积剂量从0 增加到12 kGy(Si),器件的集电极电流Ic基本无明显变化,而基极电流Ib在低于VBE=0.8 V 时明显

图2 SiGe BiCMOS器件直流电流增益随累积剂量的变化:(a)正偏;(b)反偏;(c)零偏Fig.2 Variation of DC current gain of SiGe BiCMOS devices with TID:(a)forward bias;(b)reverse bias;(c)zero bias
为了进一步分析高剂量率辐照条件对不同偏置国产SiGe BiCMOS 工艺器件辐照响应特性的影响,我们引入两个参量分别是过剩基极电流ΔIB(Ib-post-Ib-pre)和归一化电流增益hEF-post/hEF-pre,其中Ib-post和Ib-pre以及hEF-post和hEF-pre分别选取了辐照前后VBE=0.7 V 时所对应的Ib和hEF,如图3~4 所示。从图3中可以看出,随着累积剂量的增加,各偏置条件下ΔIB不断增大,归一化电流增益不断减小,趋势如图4所示。直至电离总剂量累积到12 kGy(Si)时,发现反偏状态下过剩基极电流、归一化电流增益退化最严重,零偏次之,正偏最小。
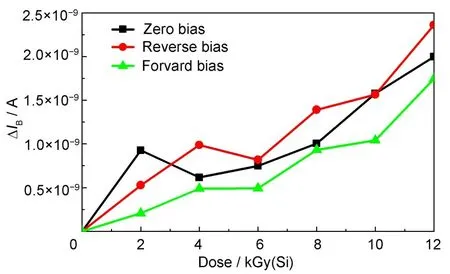
图3 SiGe BiCMOS器件正偏、反偏和零偏过剩基极电流随累积剂量的变化Fig.3 Variation of forward bias,reverse bias,and zero bias excess base currents with TID in SiGe BiCMOS devices
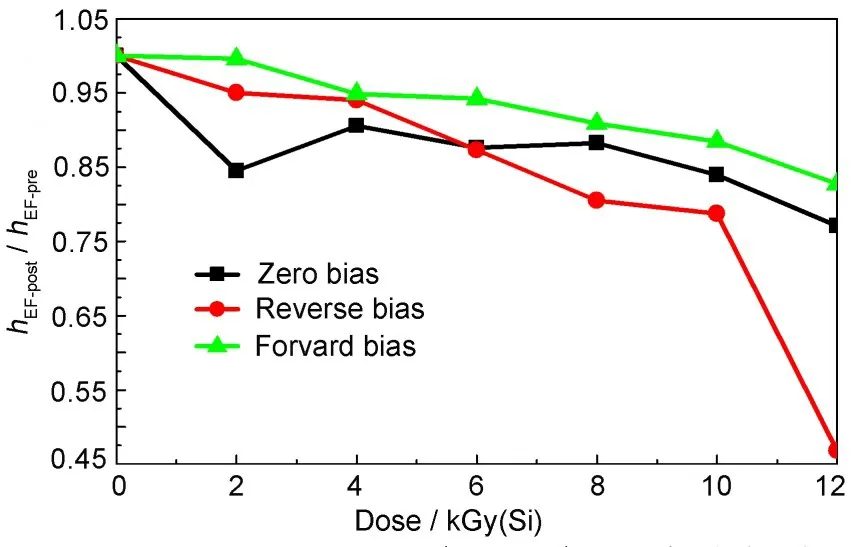
图4 SiGe BiCMOS器件正偏、反偏和零偏归一化电流增益随累积剂量的变化Fig.4 Variation of forward bias,reverse bias,and zero bias normalized current gain with TID in SiGe BiCMOS devices
3 分析和讨论
从上述实验结果可以看出,随着电离总剂量的累积,直流电流增益的退化主要是由于基极电流Ib的增加引起的。由于注入基极的载流子的数量只取决于基极的掺杂和施加的偏压,因此,在给定的偏置条件上,在发射极耗尽区增加的复合,并不会降低集电极电流。如果耗尽区复合增加,发射极和基极电流会增加,但集电极电流保持不变。
基极电流主要由体电流Iblunk和表面基极电流Isurface组成,基极电流Ib在器件中的组成如图5所示。其中基极电流Ib的组成如式(1)所示。

式中:Iseb为EB 结附近的表面复合电流;Ireb为EB结势垒区的表面复合电流;Irb为基区复合电流;Iep为基区向发射区注入的空穴电流;Icbo为BC结的反向饱和电流。
Ireb、Irb为主的体电流主要与辐射在基极造成深能级位移缺陷有关,由于γ射线的能量较小,无法在器件基极产生位移损伤,而且Icbo极小,可忽略,所以60Co γ辐射环境下基极电流的变化是由于表面基极电流Isurface增大引起的,Iep有效控制Ic几乎不变,基极表面复合电流Iseb对电离辐射更加敏感。基极表面复合电流Iseb如式(2)所示[20]。

式中:q为电子电荷量(C);Sb为基区表面复合速度(cm/s);Ab为基区表面复合表面积(cm2);ne为表面非平衡载流子电子浓度(cm-3)。
电离辐射引起器件增益退化的主要物理机制有以下几方面:(1)高剂量率电离辐射会在SiO2层中产生大量的电子-空穴对。(2)大部分电子-空穴对会在几个皮秒内复合,部分逃逸的电子-空穴对经电场作用发生分离。被复合的逃逸电子由于质量小、迁移率高,会在电场力的作用下快速地被扫出氧化层;质量大、低迁移率的空穴以“跳跃”的形式在氧化层中输运。(3)空穴的俘获及氢的释放。一方面空穴h+被氧化层中中性氧空位缺陷VO俘获产生氧化物陷阱,另一方面也可能被氧化层中中性含氢缺陷VH俘获生成氧化物陷阱并释放氢离子H+,且H+输运过程中很难被电子中性化。(4)界面陷阱电荷的生成。空穴输运过程中被俘获产生的氢离子扩散至界面处,与界面处Si-H 键发生钝化反应,造成Si-H 键断裂生成界面处陷阱,其过程如式(3)~(5)所示。
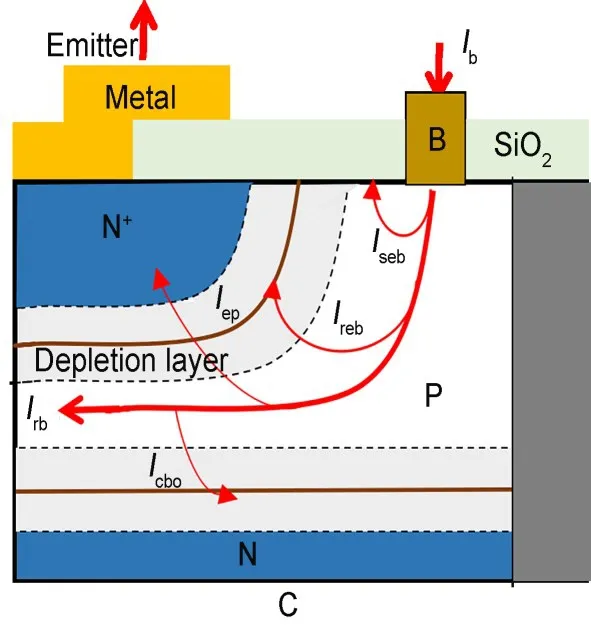
图5 基极电流的组成Fig.5 Composions of base current

电离辐照效应对器件发射结的影响如图6 所示。界面态在基区表面附近累积会使表面能带如图7 所示的弯曲,并会在表面产生一个附加正电场,影响器件表面特性,使PN 结耗尽区向P 型基区扩散,导致基区表面拓展,基区表面复合面积Ab增大。SiGe BiCMOS 工艺器件中发生的复合过程是以SRH 复合为主,其表面界态密度与电子、空穴的复合速度成正比。在基区Si/SiO2表面,辐照感生的界面陷阱密度增大也会大幅度地增加载流子的表面复合速度Sb。非平衡电子浓度与注入电流密度及氧化层中的正电荷密度有关,氧化物陷阱电荷增加和界面态增长都会使表面处非平衡电子浓度ne增大。
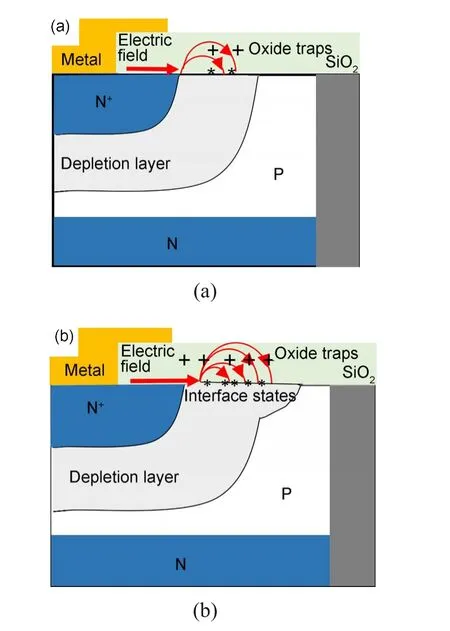
图6 电离辐照效应对器件发射结的影响:(a)未辐照;(b)辐照后Fig.6 Ionizing radiation effects on emitter of device:(a)before irradiation;(b)after irradiation
综上所述,在单一偏置条件下,高剂量率电离辐射会使Ab、Sb、ne增大,电子质量q 不变,从而导致Iseb增大,进而引起归一化直流电流增益的退化。

图7 界面态导致的能带弯曲Fig.7 Energy band bending caused by interface states
而图1和图2中不同偏置条件下电离辐射对器件基极电流及增益的变化的差别,是因为外加偏置的存在,影响器件氧化层中内电场,导致二氧化硅层中氧化物陷阱电荷和界面陷阱电荷产生数目差异,最终造成基射结反偏时损伤最大,零偏次之,正偏最小。发射结上方的SiO2层内电场是由边缘电场决定的,边缘电场如图8所示。若以发射结零偏(VBE=0 V)的内电场为参考点,发射结正偏时,由于外加电场的存在,内电场减弱,耗尽层变窄。边缘电场的减弱,SiO2层内电子-空穴对复合率增加,逃逸空穴数目减少,即“跳跃”的形式在氧化层中输运的空穴减少,与含氢氧空位型缺陷结合产生的氧化物陷阱电荷减少,释放的氢离子浓度降低,导致氧化层内氧化物陷阱电荷和界面态数量减少,所以累积相同剂量时正偏电流增益损伤程度较小;当发射结反偏时,情况正好相反,致使电流增益损伤程度更加严重。
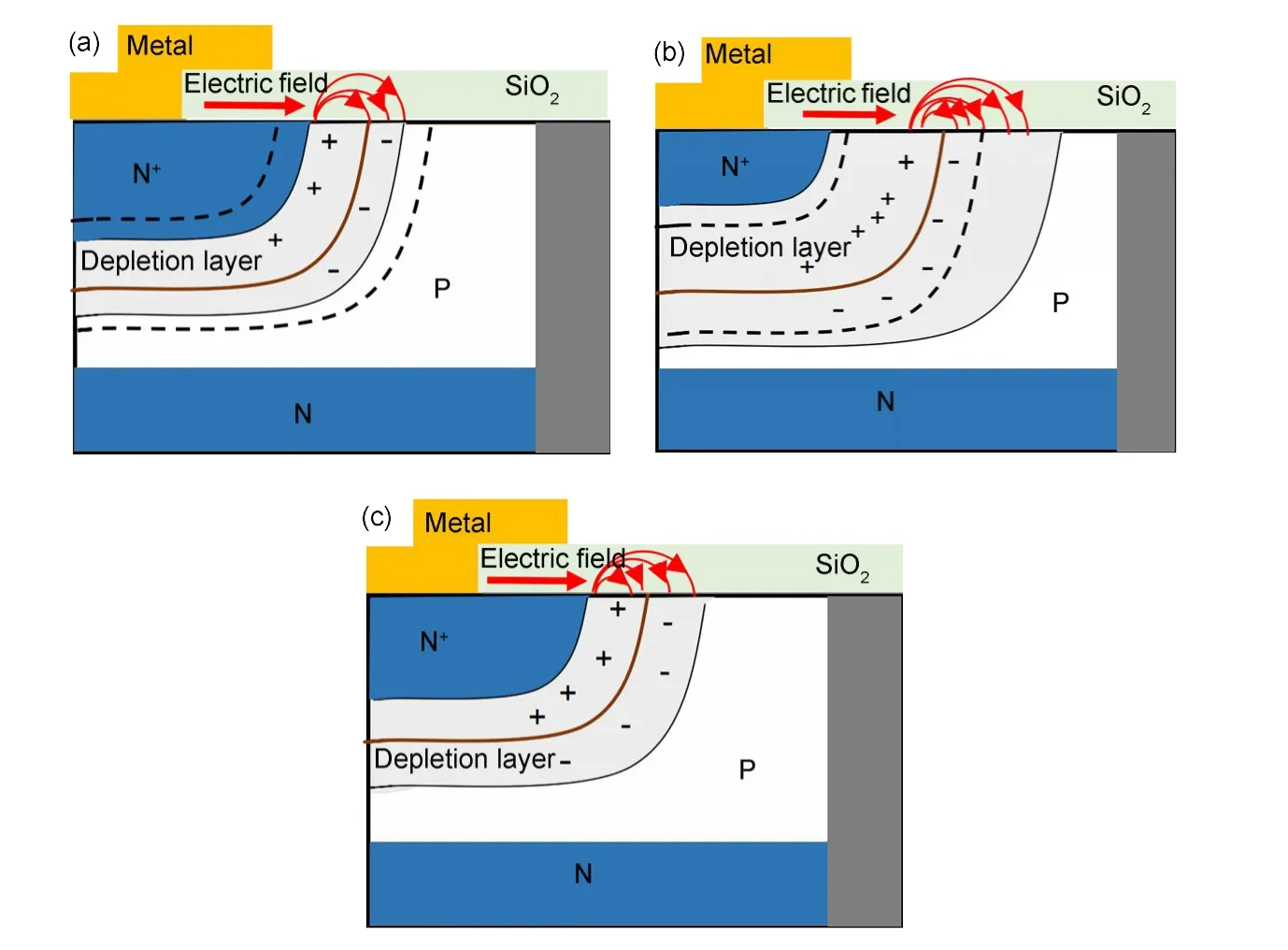
图8 电离辐照边缘电场对发射结的影响:(a)正偏;(b)反偏;(c)零偏Fig.8 Effects of edge electric field of ionizing radiation on emitter:(a)forward bias;(b)reverse bias;(c)zero bias
4 结论
实验结果表明:国产0.35 μm SiGe BiCMOS工艺器件在高剂量率辐照下抗电离总剂量辐照的性能非常好,可以达到数千戈瑞水平,且基极电流和电流增益比集电极电流对辐射更敏感。主要机制是辐射在SiGe BiCMOS 器件基射结氧化层中诱导产生的界面态和氧化物陷阱电荷,引起表面复合电流增大,使基极电流增大,从而导致器件电流增益退化。偏置条件对国产SiGe BiCMOS 工艺器件的影响非常大,在不同偏置条件辐射下,基射结反偏损伤最大,零偏次之,正偏最小,反偏为最劣偏置条件。其主要机制是器件在不同偏置条件下二氧化硅氧化层内电场不同,导致净氧化物陷阱电荷和界面陷阱电荷产生数目的差异所致。本实验为国产SiGe BiCMOS 工艺器件在空间辐射环境中的应用给出了参考。下一步将研究SiGe BiCMOS器件在低剂量率时不同偏置条件下的辐照效应。
