基于MBE替代硅衬底的材料综述
2020-07-07王亚妮
李 震,王亚妮,王 丛,高 达,周 朋,刘 铭
(华北光电技术研究所,北京 100015)
1 引 言
对于未来更先进红外焦平面探测器来说,探测器的规模变得越来越大,高性能双多色探测器的发展也逐渐呈上升趋势,使得对HgCdTe材料有着更高的要求。所以大面积、组分和厚度均匀以及高晶体质量的HgCdTe外延薄膜材料成为了HgCdTe红外焦平面器件技术研究的重点。因为在CdZnTe衬底上外延HgCdTe可以达到质量最佳的材料,不过CdZnTe衬底较为昂贵,而且到目前为止其衬底尺寸依然不能扩大。因此,人们在近几十年中研究出了若干种如Si、Ge、InSb、GaSb以及GaAs衬底等替代性衬底来取代CdZnTe衬底[1-3]。表1为部分薄膜材料的基本参数,这些衬底都具有高晶体质量、大面积、低成本以及取用方便等优点,使得它们在HgCdTe红外焦平面器件的发展中占据着重要位置。然而,可以从图1中看出,这些衬底与HgCdTe的晶格和热膨胀系数都有很大的失配问题,如Si与CdTe之间高达19.3 %的大晶格失配所导致的多晶、孪晶抑制问题以及外延层晶体质量问题,因此其应用只能局限在中短波范围,长波范围的应用进展并不理想[1-2,4-5]。
因为需要生长具有闪锌矿结构的HgCdTe层,所以衬底也最好是闪锌矿结构的材料。具有如此结构的材料有HgTe、CdTe、ZnTe、Cd1-zZnzTe(z为Zn的材料组分)等(HgTe、CdTe、ZnTe等也可能是闪锌矿结构,也可能是纤锌矿结构),另外GaAs、GaSb也是闪锌矿型结构[1]。Si和Ge是金刚石结构[5],并且金刚石结构类似闪锌矿结构。Al2O3是六方体结构,加工处理技术要求极高,只有高精密的加工才能获得大面积、低损伤的衬底材料。此外,它只能透过中短波红外,只有减薄除衬才可应用于长波波段[5]。HgCdTe晶体生长对于选取的不同衬底晶面有着很大的关系。例如,(111)面虽然台阶较多,但容易出现微孪晶;而在适当条件下,(211)B面不但具有较高的台阶密度,生长速率更快,能减少孪晶和微缺陷等现象的发生,是分子束外延(MBE) HgCdTe最为理想的晶面取向[1,6]。
所以,本次只讨论在Ge、InSb 、GaSb以及GaAs衬底上生长CdTe和HgCdTe。

图1 几种HgCdTe外延用衬底的室温晶格常数和热膨胀系数表格显示了四种替代衬底与HgCdTe之间的晶格常数和热膨胀系数失配情况

表1 HgCdTe外延衬底薄膜材料性能
2 GaAs衬底
GaAs材料是一种非常成熟的、仅次于Si单晶而广泛应用的半导体材料,可以做到大面积、高的晶体质量,与Si相比具有带宽(1.42 eV)、电子迁移率高(8500 cm2/V·s)等特性[7-8]。可以采用液相外延(LPE)、气相外延(VPE)和分子束外延(MBE)等外延技术在GaAs衬底上生长HgCdTe。GaAs衬底材料也有其不足:GaAs与MCT的晶格失配大(14.6 %);Ga和As易透过CdTe层扩散进入HgCdTe,造成污染[5]。
美国陆军实验室[9-11]早在2012年就应用VG-80分子束外延系统在3 in GaAs(211)衬底上生长出了CdTe薄膜。首先是在580 ℃时使用As4对脱氧后的GaAs衬底钝化,并在较低温度下退火,其CdTe薄膜厚度在9~13 μm。表2的CdTe膜厚平均为11.5 μm左右。之后再在CdTe薄膜上生长出HgCdTe薄膜,其平均厚度在9.5 μm左右。如表2[9]所示,连续的4片测试参数的半峰宽在130~152 arcsec之间,其半峰宽最优可以达到52 arcsec,不过通过在(100)和(111)晶向上生长的HgCdTe薄膜,其半峰宽最大可以降低10 arcsec左右。腐蚀坑密度(Etch Pit Density,EPD)大约为2.3×106cm-2。
西澳大利亚大学[12-15]在2017年应用Riber 32P分子束外延系统在生长了GaAs基HgCdTe 和CdZnTe 基HgCdTe。其生长的CdTe 膜厚为5.7~6.7 μm,生长的短波HgCdTe膜厚5.7~6.7 μm,腐蚀坑密度为 8~40×106cm-2;半峰宽为98~155 arcsec。同时,在GaAs衬底上生长过程中,对其中的一片生长上一层ZnTe薄膜,可以有效降低其位错密度。如图2[12]所示,腐蚀液采用Chen′s[2](H2O∶HCL∶HNO3∶K2Cr2O7=80 mL∶10 mL∶20 mL∶8 g) 腐蚀3 min,使用CdZnTe衬底上生长的HgCdTe其腐蚀坑密度相较在GaAs衬底上的低两个数量级。
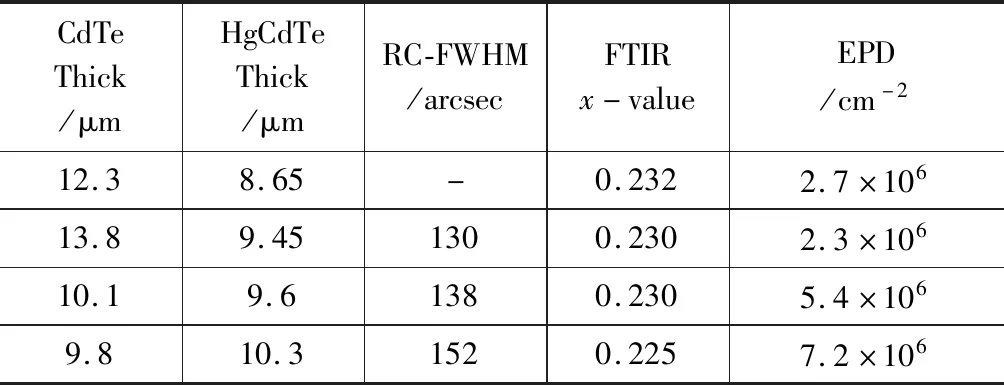
表2 连续的4片HgCdTe/CdTe/GaAs 的测试参数

(a)CdZnTe/HgCdTe,EPD=2×104cm-2

(b)GaAs/HgCdTe with ZnTe,EPD=2×107cm-2

(c)GaAs/HgCdTe with ZnTe,EPD=6×106cm-2
国内中科院上海技术物理研究所[2,16]何力等人报道了350~490 ℃的HgCdTe/GaAs 原位高低温退火,在样品表面沉积了一层ZnTe 或ZnSe 用来保护表面形貌和组分。通过退火,HgCdTe薄膜的EPD值从原生片9×106~2×107cm-2范围下降到了2×106~4×106cm-2。中国科学院大学[17]2017年在GaAs(100) 生长CdTe(100),俄罗斯Ioffe学院等[18-19]在2018年在GaAs(013)衬底上生长了HgCdTe,他们也都在采用了GaAs衬底生长HgCdTe。可以看出,越来越多的国家在对GaAs的关注度越来越大。
3 GaSb衬底
GaSb衬底最近被提议作为一种新的替代衬底从而取代CdZnTe成为外延优质HgCdTe的生长材料,因为其具有更低的成本和更大的阵列规模。GaSb衬底材料也有其不足:Ga和Sb易透过CdTe层扩散,造成污染[20-21]。
西澳大利亚大学[12-15]在2018年使用Riber 32P 分子束外延系统生长 CdTe薄膜。首先在580 ℃进行热处理,生长150~200 nm厚的ZnTe过度层,之后降温到280~300 ℃生长2~3 μm厚的CdTe薄膜,其半峰宽最优可以达到33 arcsec。采用Everson腐蚀液腐蚀15 s后,其腐蚀坑密度平均值可以达1.4×105cm-2。图3[12]CdTe/GaSb(211)B的AFM表面图及高度剖面,图4[12](a)和(b)分别为CdTe/GaSb(211)B原生及经腐蚀后的SEM表面。

图3 CdTe/GaSb(211)B的AFM表面图及高度剖面
西澳大利亚大学早在2015年就对GaAs(211)和 GaSb(211)衬底生长HgCdTe进行了比较,按照如图5[14]所示的生长顺序进行生长,在GaAs衬底上多生长了一层ZnTe过渡层,之后再依次生长CdTe与HgCdTe薄膜。图6[14]分别为在GaAs和 GaSb衬底上生长HgCdTe后的X-Ray Diffraction(XRD)曲线、生长HgCdTe时的RHEED图像和经腐蚀后的材料表面。

(a)CdTe/GaSb(211)B原生

(b)经腐蚀后的SEM表面

图5 GaAs(211)和GaSb(211)上生长HgCdTe图解

(a)GaSb衬底上HgCdTe的X-Ray Diffraction曲线

(b)GaSb上HgCdTe RHEED图像与经腐蚀后的材料表面

(c)GaAs衬底上HgCdTe的X-Ray Diffraction曲线

(d)GaAs上HgCdTe RHEED图像与经腐蚀后的表面
表3展示了部分测试参数,可以看出在不同衬底上生长出的HgCdTe薄膜质量相差不多,但是GaSb衬底上的腐蚀坑密度优于GaAs衬底。

表3 GaAs和GaSb衬底上生长HgCdTe测试参数
4 InSb衬底
InSb和Ge、Si相比虽是发现较晚的半导体材料,但是其制备工艺相对简单,且具有很小的禁带宽度很高的电子迁移率,晶圆尺寸可达4 in,可以外延大面积长HgCdTe材料。其缺点是In和Sb元素会在生长CdTe和HgCdTe时扩散进材料,造成污染。
华北光电技术研究所[22-23]在InSb(100)以及相应的带偏转角的2 in衬底的高温工作类型材料外延中取得了一定的进展,积累了一定的衬底湿化学(改良CP4)处理和外延预处理(热脱附)的经验;建立InSb表面RHEED相图体系;设备源炉配备完全,缓冲层外延技术成熟;外延的CdTe膜层RHEED图像条纹清晰且延长。在1.7 μm厚度条件下,CdTe膜层的半峰宽约为100 arcsec。图7[23]为材料表面SEM形貌图(×5000),图8[23]为InSb基CdTe复合衬底X光形貌图样。

图7 材料表面SEM形貌图(×5000)
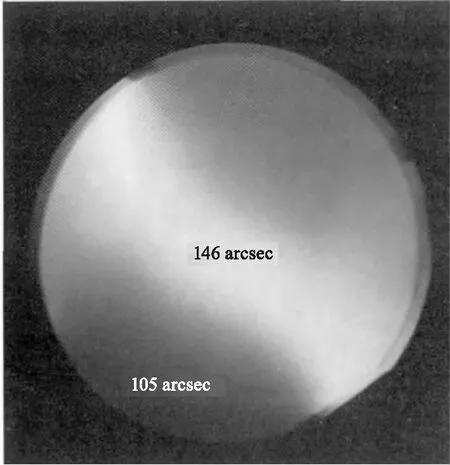
图8 InSb基CdTe复合衬底X光形貌图样
在生长工艺方面国外起步早所以成熟晶片尺寸已经发展到6 in,国内在2 in和3 in晶体的材料尺寸和工艺成熟度等方面与国外尚存有一定差距,未来随着探测器以及InSb材料的发展一定会需要尺寸更大,参数更优的InSb晶体材料。
5 Ge衬底
Ge晶体同样具有高质量、高机械性能,而且Ge能够使用Si的工艺设备进行加工。Ge衬底的缺点是:其是元素半导体,晶格结构是非极性的;Ge与CdTe在晶格方面存在大的热膨胀失配[5]。
昆明物理研究所[24]在2014年采用Riber 32P 型分子束外延系统在3 in 的Ge(211)衬底上生长了中波HgCdTe薄膜材料,组分为0.300和厚度为7.72 μm;其宏观缺陷密度低于200 cm-2,半峰宽优于90 arcsec,经0.5 %溴甲醇腐蚀液处理,采用EPD腐蚀溶液进行EPD腐蚀后的腐蚀坑密度低于2.9×106cm-2;采用标准的二代平面工艺制备了320×256 锗基中波碲镉汞红外焦平面探测器,其探测率达到 3.8×1011cm·Hz1/2W-1,等效噪音温差优于17.3 mK,非均匀性优于6.5 %,有效像元率高于99.7 %。
如图9[24]所示,在3 in Ge(211)上生长的HgCdTe/CdTe(211)B,表面为镜面光亮;在200倍显微镜下观察表面平整,以“十”字形选取9个视场平均得到表面宏观缺陷小于200 cm-2。
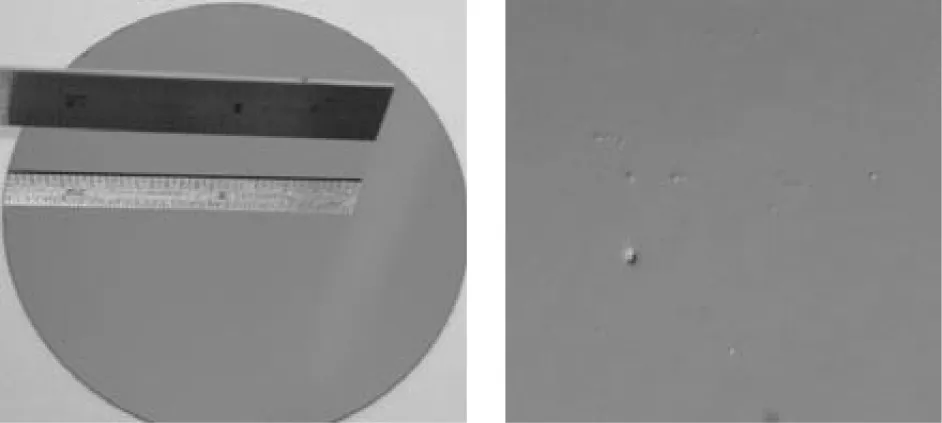
图9 3 in Ge基中波碲镉汞薄膜表面形貌
如图10[24]所示,在3 in Ge(211)上生长的HgCdTe/CdTe(211)B,在中心2 in范围内的半峰宽平均值为90.23 arcsec,半峰宽偏差3.03 arcsec,相对偏差为3.3 %。
在Ge(211)上生长的HgCdTe/CdTe(211)B,经0.5 %溴+甲醇腐蚀液处理,采用H2O∶HCl∶HNO3∶K2Cr2O7=80 mL∶10 mL∶20 mL∶8 g 溶液进行EPD 腐蚀后,在1000 倍显微镜下观察,以“十”字形选取9个视场平均得到腐蚀坑密度陷小于2.9×106cm-2。

图10 3 in Ge基中波碲镉汞薄膜半峰宽均匀性分布
6 结 论
通过上述介绍得到如下结论:
(1)低成本、大面积、高质量、易加工等原因是研究替代衬底材料的目的,MBE技术的快速发展,使替代衬底材料的发展前景更大。目前这些衬底几乎都可以生长出4~6 in的大面积晶体材料。这其中Al2O3因为加工和外延生长技术的复杂及红外透过等原因,使得它不会被广泛使用。
(2)GaAs和GaSb与Ge和Si相比,虽然有着不足(污染、机械性能差等),但是高质量GaSb衬底很容易获得,且由于GaSb的晶格和热膨胀系数失配率要小得多,从原理上讲,这是一种较好的材料选择。表4[25]对的GaAs和GaSb衬底的性质进行了对比,可以看出的是,GaSb衬底与GaAs衬底具有相同的透射性。另外,从X射线衍射半峰宽和腐蚀坑方面看,GaSb衬底的材料质量也是比较好的。虽然其成本比GaAs高,但是其较小的晶格失配可以生长出高质量的HgCdTe,从而降低成本并广泛应用在红外焦平面阵列上。
(3)虽然Ge衬底同样可以做到低成本、大面积和高质量,且没有Si的先天红外透过问题,但是由于Ge与HgCdTe之间存在严重的晶格失配,所以其在外延HgCdTe的衬底方面的应用前景不大。
(4)表5[25]对材料质量作了总结。对于复合型衬底材料来说,这些衬底已被成功地用在红外焦平面探测器方面。在77 K下,这些器件的性能已经比得上使用CdZnTe衬底制造的器件。不过,这些替代性衬底上制造的长波红外HgCdTe探测器和焦平面阵列的性能依然比不上在CdZnTe衬底上的同类器件。这些衬底发展的关键是需要解决晶格和热失配以及缺陷控制问题。

表4 用于生长HgCdTe的GaAs和GaSb替代性衬底的主要特性

表5 CdZnTe、Si和GaAs衬底上的CdTe和HgCdTe外延层的半峰宽和腐蚀坑密度值
本文通过一系列的对比,得出目前最有发展前景的替代衬底是GaSb衬底,虽然依旧有高成本和元素扩散等问题,但是相信这些问题以后都会得到解决,能够制造出最佳的红外探测器和焦平面阵列。
