基于工艺的GaN HEMT抗辐射加固研究进展
2019-05-08席善斌高金环高东阳尹丽晶
席善斌,高金环,裴 选,高东阳,尹丽晶,彭 浩
(1.中国电子科技集团公司第十三研究所,石家庄050051;2.国家半导体器件质量监督检验中心,石家庄050051)
1 引言
现代通讯和国防航天等高科技领域的迅猛发展,对微波电子器件功率特性、频率特性、耐高温特性以及抗辐射稳定性等均提出了更高的要求。第三代半导体材料(GaN、A1N、SiC等)具有带隙宽、击穿电压高等优势,有望满足现代微波技术发展的需求。通过对GaN材料调制掺杂形成的AlGaN/GaN异质结构具有很大的导带断续,延续了GaN材料击穿电场高、热传导率高和电子迁移率高等优点,利用这种异质结构做成的器件具有优异的微波功率特性,而且其宽禁带特点决定了它可以承受更高的工作结温,促使GaN HEMT以其高频、高温及大功率特性成为近年来微波微电子领域的研究热点。
另外,作为宽禁带半导体,GaN材料原子键能很强,因此AlGaN/GaN HEMT器件具有出色的抗辐射特性,其结合了优越的抗辐射和出色的微波功率、高温、高压等特性,故在卫星、太空探测、核反应堆等辐射环境中具有巨大的应用前景,受到广泛的关注和研究。
与Si基半导体器件相比,虽然GaN HEMT具有优越的抗辐射特性,但是与GaN材料自身的抗辐射能力和水平相比较,器件在抗辐射能力上还有较大差距,因此开展GaN HEMT制造工艺研究,进一步提高器件的抗辐射水平就显得尤为必要。故此梳理了国际上近五年公开报道的文献资料,通过对比和改进GaN HEMT制造工艺来提高器件抗辐射水平,从有源区隔离工艺、GaN沟道层厚度、钝化层结构和衬底材料四个方面进行了梳理和分析,并给出了加固工艺优选方法,以期对我国GaN HEMT制造工艺提供指导,促进我国抗辐射加固GaN HEMT的研制和应用。
2 器件隔离工艺影响
2018年,Dong-Seok Kim等人报道了台阶刻蚀和氮离子注入两种隔离工艺的GaN HEMT质子辐射效应[1]。基于两种隔离工艺的器件结构如图1所示。图1(a)采用台阶隔离,台阶刻蚀通过感应偶合等离子体(ICP)刻蚀工艺实现,刻蚀深度为~200nm,图1(b)采用氮离子注入隔离,利用离子注入机实现。在氮离子注入过程中,器件的有源区采用SiO2掩膜层做保护,氮离子注入的能量和注量分别为10keV和5×1015cm-2。器件欧姆接触采用Si/Ti/Al/Ni/Au(1nm/25nm/160nm/40nm/100nm)、肖特基接触采用Ni/Au(50nm/100nm)多层金属实现。栅长、栅宽、栅-漏间距分别为2μm、100μm和10μm。

图1 不同隔离工艺GaN HEMT器件结构
室温条件下,利用质子线性加速器对器件开展辐照试验,采用质子能量为5MeV,辐照注量累积至1×1014cm-2,评估了两种隔离工艺器件的参数退化情况,结果如图2所示,器件的漏极电流和跨导在辐照前后均发生了明显变化,两种工艺隔离的器件参数变化量如表1所示。采用台阶刻蚀工艺隔离的GaN HEMT在辐照前后漏极饱和电流(ID,sat)和最大跨导(gm,max)均降低了约50%,而采用氮离子注入隔离的GaN HEMT其漏极饱和电流和最大跨导仅降低了约10%~20%。

图2 辐照引起不同隔离工艺漏极电流和跨导变化

表1 不同隔离工艺GaN HEMT辐照前后参数变化
质子辐照引起GaN HEMT性能退化的主要原因是2DEG沟道中的位移损伤,入射的质子导致原子从原有晶格位置发生位移,产生了空位和带电的陷阱中心,空位通过形成陷阱的方式降低了载流子浓度,带电陷阱中心则通过引起载流子散射的方式降低了载流子的迁移率。
等离子体刻蚀会对台阶侧墙表面产生损伤,产生N空位,产生缺陷的区域距离器件有源区中的2DEG沟道相对较近,这些初始缺陷又会在辐照过程中与质子发生作用,从而产生更多的与N空位相关联的缺陷[2]。氮离子注入虽然也有一定的几率在材料中产生初始缺陷,但是产生的N空位浓度相对较低,并且产生缺陷的区域距离器件2DEG沟道相对较远[3]。因此,采用台阶隔离工艺形成有源区的GaN HEMT在质子辐照试验过程中其性能的退化,较采用氮离子注入隔离形成有源区的GaN HEMT更为严重。
所以,采用氮离子注入隔离工艺替代台阶隔离工艺形成有源区,可以提高GaN HEMT的抗辐射能力。
3 器件沟道层厚度影响
2018年,Maruf A.Bhuiyan等人报道了不同GaN沟道层厚度的GaN HEMT总剂量辐射效应[4]。作为研究对象的Al0.24Ga0.76N/GaN HEMT器件结构如图3所示,器件采用台阶刻蚀工艺,刻蚀深度为150nm,器件源/漏和栅极分别采用Ti/Al和Ni/Au金属化结构,欧姆接触采用Ti/Al/Au(厚度分别为15nm/60nm/50nm)叠层金属结构,并在N2气氛、温度为775℃的环境中作退火处理。表面采用SiO2作为钝化层,栅-源间距(Lgs)为5μm,栅-漏间距(Lgd)为10μm,Al0.24Ga0.76N层为24nm,GaN沟道层厚度分别为 0.5μm、2μm、3.5μm 和6.3μm。

图3 Al0.24Ga0.76N/GaN HEMT器件结构
室温条件下,采用能量为10keV、剂量率为31.5krad(SiO2)/min的X射线对不同GaN沟道层厚度器件开展辐照试验,在试验过程中器件所有管脚均作接地处理。图4所示为X射线辐照引起不同GaN沟道层厚度GaN HEMT阈值电压(Vth)的漂移情况,总剂量累积至3krad(SiO2)时,器件的阈值电压就发生了明显漂移,但随着总剂量的进一步累积,阈值电压漂移速率逐渐减缓。整个辐照试验过程中,GaN HEMT阈值电压(Vth)的漂移与GaN沟道层厚度呈负相关的关系,沟道层越薄,辐照引起器件阈值电压漂移就越明显。

图4 辐照引起不同沟道层厚度下阈值电压漂移
辐照引起GaN HEMT阈值电压漂移主要与如下因素相关:(1)AlGaN层中浅能级空穴陷阱的产生;(2)器件制造过程中产生的带电电子陷阱的中和;(3)利用氢气钝化处理的缺陷发生了脱氢作用。这三种因素均会引起器件辐照后I-V曲线的负向漂移,且均与器件在生长过程中的初始缺陷密度相关。
表2给出了不同GaN沟道层厚度AlGaN/GaN HEMT峰值迁移率值,有效的峰值沟道迁移率随沟道层厚度增加而增大,可能原因为AlGaN层和(或)GaN中陷阱密度的降低减少了哥伦布散射(Coulomb Scattering)的发生。

表2 厚度、峰值迁移率与位错密度关系
在AlGaN/GaN异质结生长的过程中,产生的位错缺陷会影响GaN基HEMT的电性能,异质结中的线位错会影响载流子迁移率和电荷的俘获等特性,通过增加GaN层的厚度可避免衬底层和GaN层因晶格失配产生的线位错接触上面的2DEG沟道,降低器件的电特性[6]。辐照引起厚GaN沟道层器件阈值电压发生较小幅度的漂移,可能原因为较厚的沟道层可以获得质量较高的GaN层,在高质量的GaN层上生长的AlGaN层质量也相应得到了改善,由于器件在生长过程中缺陷密度的降低,所以器件的抗辐射性能获得了较好的改善。
4 器件钝化层结构影响
2016年,Andrew D.Koehler等人报道了不同钝化层结构对AlGaN/GaN HEMT质子辐射效应的影响[7-8]。通常采用PECVD工艺淀积SiN的方法来钝化GaN HEMT界面态以抑制电流崩塌、动态导通电阻增加、DC-RF损耗等,在AlGaN/GaN外延层上采用相同制造工序淀积一层原位(in-situ)SiN层,可以有效降低界面态密度[9]。
器件结构如图5所示,基本工艺相同,均采用MOCVD工艺外延生长 2μm GaN缓冲层、17nm AlGaN势垒层,MOCVD条件为300℃、20W、650mT、20sccm CH4、23.5sccm NH3、980sccm N2。钝化层则采用了两种结构:(1)100nm PECVD的SiN层的肖特基栅HEMT结构,如图5(a)所示;(2)10nm原位SiN层和100nm PECVD的SiN层的MIS栅HEMT结构,如图5(b)所示。

图5 不同钝化层结构GaN HEMT示意图
室温条件下,利用能量为2MeV的质子对不同钝化层结构的AlGaN/GaN HEMT进行辐照试验,辐照注量为6×1014H+·cm-2,辐照过程中器件所有管脚均作浮空处理。质子辐照引起AlGaN/GaN HEMT参数变化如表3所示,其中2DEG迁移率(μ2DEG)、方块载流子浓度(n2DEG)、最大漏极电流(IDmax)、最大跨导均(gmmax)随辐照注量的增加而减小,但方块电阻(RSH)和静态导通电阻(RON)则随辐照注量的增加而增加。辐照引起两种钝化层结构器件的稳态I-V参数变化量类似,说明原位钝化层对稳态I-V参数影响较小,但是仅有PECVD SiN钝化层的HEMT阈值电压漂移量(1.3V)要大于原位SiN和PECVD SiN双重钝化层的HEMT阈值电压漂移量(0.6V)。

表3 质子辐照前后器件参数变化
质子辐照感生的、位于2DEG沟道附近的施主缺陷会捕获电子,从而耗尽2DEG,导致晶体管动态导通电阻(RONDYN)的严重退化。图6所示为处于导通状态下(ON-State)的GaN HEMT辐照前后I-V特性曲线变化。依据获得的I-V特性曲线提取晶体管的动态导通电阻,在VDSQ=0V条件下,辐照引起两种钝化层结构HEMT的RONDYN变化幅度相差不大(61%和72%);在VDSQ=50V条件下,辐照引起PECVD SiN钝化层HEMT的RONDYN变化了22750%,而原位SiN和PECVD SiN双重钝化层HEMT的RONDYN变化了303%。

图6 质子辐照引起不同钝化层结构I-V曲线变化
由于两种结构的晶体管的AlGaN/GaN外延层和制造工艺相同,因而辐照引起RONDYN不同程度的退化主要是表面原位钝化层导致的,而原位钝化层结构可有效抑制界面态密度,故采用原位钝化层可以降低辐照引起的GaN HEMT动态导通电阻的变化,提高器件的抗辐射能力。
5 器件衬底材料影响
2014年,Andrew D.Koehler等人还报道了不同衬底材料的AlGaN/GaN HEMT质子辐射效应和退化机理[10]。分别选择基于蓝宝石(Sapphire)衬底、Si衬底和SiC衬底生长的GaN HEMT器件,研究器件原生缺陷数量对GaN HEMT抗辐射性能的影响。采用MOCVD方法分别在蓝宝石衬底、Si衬底和SiC衬底上外延生长AlGaN/GaN层,GaN层厚度大于1μm,AlGaN层(27%~30%的Al组分)厚度为17~25nm,通过感应偶合等离子体(ICP)刻蚀工艺实现台阶刻蚀,采用Ti/Al/Ni/Au电子束淀积、剥离和快速热退火工艺形成欧姆接触的源/漏电极,采用淀积和剥离工艺形成肖特基接触的栅电极。最后对样品进行100nm的SiNx钝化处理、SF6反应离子刻蚀、接触窗口刻蚀和Ti/Au金属淀积。
分别对AlGaN/GaN外延层进行扫描电镜(SEM)成像,对外延层中的线位错(TD)进行了电子通道衬度成像(ECCI)[11],获得的形貌和线位错密度分布如表4所示,蓝宝石衬底外延层线位错密度最高,Si衬底次之,SiC衬底外延层线位错密度最低,可见衬底和外延层间的晶格和热失配是导致材料缺陷密度差异的主要原因。
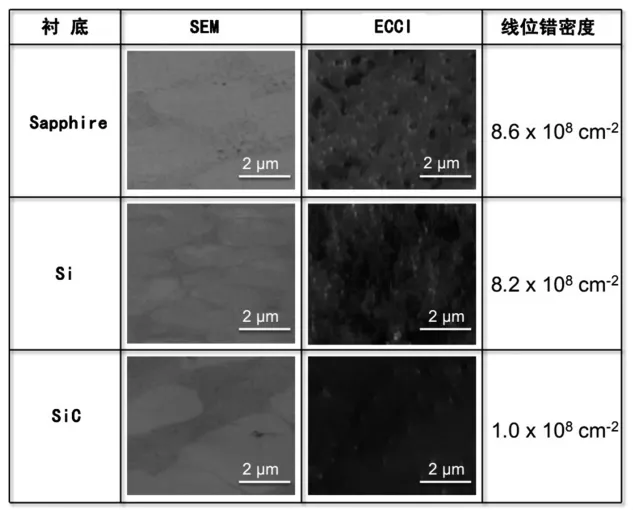
表4 不同材料衬底上外延层形貌及线位错密度
利用光致发光(PL)谱检查GaN材料质量,获得的结果如图7所示,SiC衬底GaN HEMT表现为最大的带边峰值(Band Edge Peak),蓝宝石衬底GaN HEMT带边峰值最小,但是蓝宝石衬底GaN HEMT表现出的黄带缺陷(500nm~700nm)信号却明显强于SiC衬底GaN HEMT,这一结果与ECCI结果一致,说明蓝宝石衬底生长的外延层中缺陷最多,其次为Si衬底,SiC衬底生长的外延层中缺陷最少。

图7 辐照前不同材料衬底GaN HEMT的PL谱
室温条件下,利用能量为2MeV的质子对不同衬底的AlGaN/GaN HEMTs进行辐照试验,辐照注量为6×1014H+·cm-2,辐照过程中器件管脚均作浮空处理。
辐照前后分别测试三种衬底GaN HEMT的静态、脉冲I-V特性曲线,结果如图8至图10所示,辐照均引起三种衬底GaN HEMT特性如开态电阻(ΔRon,Sapphire=48.2%、ΔRon,Si=86.0%、ΔRon,SiC=51.7%)、最大漏极电流(ΔIDmax,Sapphire=-36.6%、ΔIDmax,Si=51.8%、ΔIDmax,SiC=46.2%)发生显著退化。

图8 蓝宝石衬底GaN HEMT辐照前后I-V曲线

图9 Si衬底GaN HEMT辐照前后I-V曲线

图10 SiC衬底GaN HEMT辐照前后I-V曲线
图11所示为辐照引起三种衬底GaN HEMT的2DEG迁移率(μ2DEG)变化情况,从中可以看出,Δμ2DEG,SiC>Δμ2DEG,Si>Δμ2DEG,sapphire,2DEG 迁移率退化与衬底质量呈负相关的关系,衬底质量越高,μ2DEG退化幅度越大,对辐照表现就越敏感。
GaN HEMT器件表现出较强的抗辐射特性,可能的原因为GaN本身含有较多的原生缺陷。与自身缺陷数量相比较,辐照感生的缺陷数量相对较少,对器件性能的影响也就较小。随着GaN HEMT器件制造工艺的改进,材料中的原生缺陷数量控制的越来越低,那么器件的辐射效应就可能会变的越来越敏感。SiC衬底外延层缺陷密度最少,但SiC衬底GaN HEMT对辐照表现却最为敏感,而外延层缺陷密度最多的蓝宝石衬底GaN HEMT则表现出较好的抗辐射特性。

图11 辐照引起不同衬底HEMT霍尔迁移率变化
6 结束语
分别从器件有源区隔离工艺、GaN沟道层厚度、钝化层结构和衬底材料四个方面分析了国际最新研究进展,梳理了工艺对GaN HEMT辐射效应的影响和参数退化机理,认为采用氮离子注入隔离工艺、较厚的GaN沟道层厚度、在AlGaN/GaN外延层上淀积一层原位SiN层可有效降低工艺引入的缺陷,提高GaN HEMT的抗辐射性能。另外,虽然采用SiC衬底可有效降低材料的原生缺陷,提升GaN HEMT电特性,但辐射感生缺陷相对原生缺陷密度所占比例增加,器件对辐照表现更为敏感。在抗辐射GaN HEMT制造中,需综合考虑制造工艺对器件电性能和器件抗辐射能力的综合影响,以获得高可靠性、高性能的GaN HEMT。
