真空烧结粘片芯片脱落失效分析
2018-02-08寇凌霄
寇凌霄
(中国电子科技集团公司第四十七研究所,沈阳110032)
1 引言
真空烧结是指在一定的真空度下,利用熔点低于被焊接材料的合金做钎料,通过加热使钎料熔化,靠毛细作用将液态焊料填充到焊接接触面的间隙中,通过液态焊料与被焊金属之间相互扩散溶解形成金属间化合物,最后经过冷却形成高可靠的焊接[1]。某型集成电路采用真空烧结工艺粘接芯片封装后,进行筛选试验和质量一致性检验。在质量一致性检验中分组试验选取样管开盖试验,发现样管芯片碎裂、脱离底座。就此问题进行失效分析定位和失效机理分析,形成纠正措施以免再次发生失效。
2 故障描述
某型电路封装完成后,进行了筛选试验和质量一致性检验。筛选试验程序按试验顺序包括高温贮存、温度循环、恒定加速度、电测试、老化、密封试验。按规范要求质量一致性检验抽取15只样管,在B4分组时按GJB 548B-2005方法2014对1只样管进行内部目检和机械检查,开盖后发现芯片碎裂。出现问题后对剩余的14只样管进行开盖处理,另有1只芯片碎裂,2只芯片脱离底座,11只样管芯片无异常。
2.1 失效样管描述
该电路采用真空烧结工艺粘接芯片,开盖的失效电路在36倍显微镜下观察失效电路内部结构,芯片背面及管壳焊接界面状态见图1、图2。

图1 失效电路的芯片背面状态

图2 失效电路的管壳焊接界面状态
在开盖芯片无异常的11只样管中抽取5只(编号1#~5#)进行剪切强度试验。使用剪切强度/键合强度测试仪进行剪切强度测量,测量方法及检验标准按照GJB548B-2005方法2019的要求执行[2]。为检验真空烧结粘片工艺的粘接强度是否异常,将剪切强度试验量程设定为400N,确保试验能将芯片剪切掉并得到实际数值。试验结果见表1。

表1 芯片粘接剪切力强度
由表1可见,试验结果显示不同样管之间剪切强度数值差别很大。芯片的剪切强度测试是判断芯片粘接质量的常用方法。以芯片在应力作用下产生的失效类型,芯片脱离管座后残留的芯片附着材料和管壳各粘接界面的形貌进行判断。在此次剪切力试验中,芯片粘接强度一致性很差,并且芯片脱离状态不理想,无法满足芯片粘接可靠性的要求。
2.2 加工过程追溯
该电路采用真空烧结工艺粘接芯片,原材料均检验合格并在有效期内;真空共晶回流焊粘接芯片设备正常运行,工艺温度可控无异常;操作及检验人员均持证上岗;封装过程在超净间进行且环境满足要求[3];筛选试验和质量一致性检验的方法和条件均符合电路设计要求和GJB 548试验方法。
3 故障定位
基于以上分析定位,该问题出现在真空烧结芯片粘接过程中,分析可得芯片粘接后脱落失效故障树如图3。

图3 芯片粘接后脱落失效故障树
3.1 故障排查
由故障树可知,导致“芯片粘接后脱落失效”的故障有三种可能,下面分别进行排查。
3.1.1 对“真空烧结工艺异常”的排查
经查封装记录,该批问题电路封装周期为2017年3月份至6月份。在同时期内,采用同种粘接工艺的某电路封装1600只,封装过程中真空烧结工艺参数、粘接材料(钎焊料)、设备状态、人员配置、技术状态均未发生变化。目前已完成筛选试验及质量一致性试验,筛选试验程序与该问题电路筛选试验程序一致,1600只电路未发生芯片脱落失效。通过以上排查,排除故障树“真空烧结工艺异常”分支。
3.1.2 对“钎焊料异常”的排查
在排查故障树“真空烧结工艺异常”分支的过程时,经查1600只某电路与问题电路采用同种、同批次粘接材料-钎焊料(Pb-In-Ag),未发生芯片脱落失效,因此,排除故障树“钎焊料异常”分支。
3.1.3 对“芯片背金质量异常”的排查
在该批电路未进行封装的晶圆片中,随机抽样5片晶圆片(编号1#~5#),使用X射线荧光光谱仪测量晶圆片背金厚度。为检验问题芯片背金是否异常,每个晶圆片片选取测量上、中、下、左、右五个位置的背金厚度,确保试验能测量出背金厚度并掌握其均匀性[4],测量结果见表2。
由表2可见,该电路背金层厚度约为镍层0.022~0.035μm,金层 0.090~0.061μm。按照芯片加工背金工艺要求,背金为镍-金两层结构,技术指标应为镍层 0.050μm,金层 0.300μm,镍层、金层厚度均不符合工艺要求。由此,可确定“芯片粘接后脱落失效”是由于芯片背金厚度不足所致。

表2 问题电路芯片背金厚度 单位:μm
4 机理分析
金/镍体系的一个独有特点是它在组装过程和随后的使用寿命中暴露在较高温度下时具有较好的稳定性[5]。若镀层过薄或镀层的均匀性差,镀层对芯片表面的保护功能降低,导致芯片真空烧结粘片时芯片背金与钎焊料润湿性较差,才会出现芯片背面无钎焊料残留的现象。
在该批电路未进行封装的晶圆片中,随机抽样5只芯片(编号1#~5#),采用芯片背金可焊性试验模拟真空烧结粘片过程,同时增加同种封装工艺但不同时期加工的1只芯片,进行对比试验。
抽样芯片背金面向上并放置钎焊片,放进真空共晶回流焊设备里。按照真空烧结粘片工艺要求设定工艺参数,进行烧结。烧结完成后,观察芯片背金与钎焊料润湿状态[6],真空烧结完成后芯片试验照片如图4。
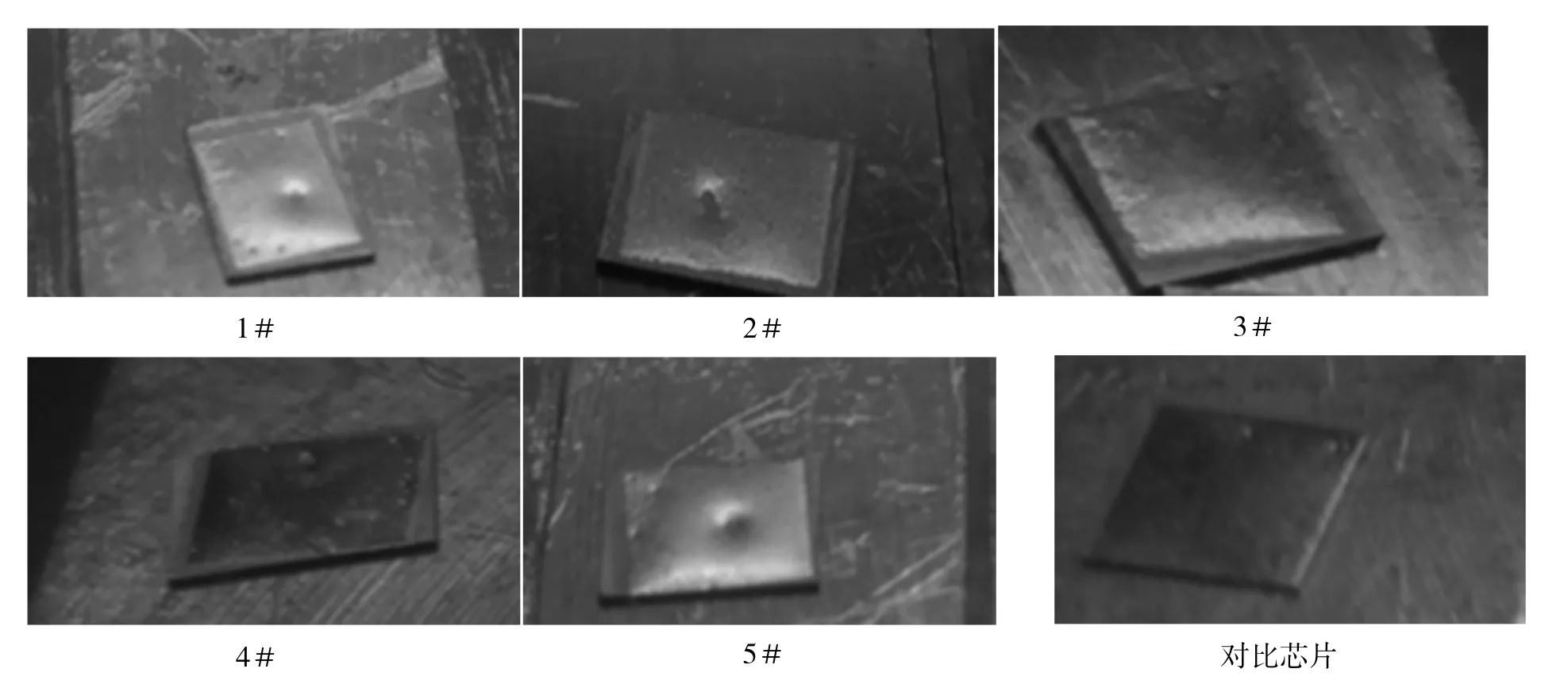
图4 钎焊料润湿状态比较
由图4可见,熔融钎焊料在芯片背金表面铺展开后又发生收缩,形成一个粗糙和不规则的表面,其表面上存在与薄钎焊料层相连的较厚钎焊料隆起现象[7]。对比芯片背金与钎焊料形成良好的润湿,通过目检可以看到背金表面上形成一个平滑、均匀和连续的钎焊料涂覆层,而抽样芯片(1#~5#)图片上出现粗糙、隆起和针孔现象。同时,在图1和图2中可见管壳上的钎焊料熔融形状规则,表面平整,芯片背面无钎焊料残留,呈现出暗银色,钎焊料超出芯片棱边的流淌区域宽度为1mm~2mm。
经上述试验分析,该问题电路的背金质量在片间及片内存在较大差异。镍层薄会影响镍层活性,金层薄或不够致密,造成空气穿过金层将镍层表面氧化,导致芯片可焊性差。真空烧结工艺粘片后,在筛选试验过程中经过环境与应力试验,将可焊性差的质量隐患放大,导致部分电路芯片脱落。
5 结束语
针对此次产品失效采取纠正预防措施,现已增加了背金工艺监控设备,确保芯片加工过程中背金工艺的稳定性。同时,封装过程中加强了首件检验观察及分析,对于较严重的背金质量问题,做到早期发现,减少损失,以达到提高成品率和可靠性[8],降低全寿命周期成本的目的。
[1]杜长华,陈方,黄福祥,等.电子微连接技术与材料[M].北京:机械工业出版社,2008.DU Changhua,CHEN Fang,HUANG Fuxiang,et al.Electronic micro bonding technology and materials[M].Beijing:China Machine Press,2008.
[2]刘洪涛.真空烧结技术研究[J].微处理机,2015,36(6):9-11.LIU Hongtao.Study on technology of vacuum sintering[J].Microprocessors,2015,36(6):9-11.
[3]杜中一.电子制造与封装[M].电子工业出版社,2010.DU Zhongyi.Electronics manufacturing and packaging[M].Beijing:Publishing House of Electronics Industry,2008.
[4]胡正明.集成电路中的现代半导体器件[M].英文版.科学出版社,2012.Hu ChenmingCalvin.Modernsemiconductor devices for integratedcircuits[M].Science Press,2012.
[5]许并社.材料界面的物理和化学[M].北京:化学工业出版社,2006.XUBingshe.Materialphysicsandchemistryoftheinterface[M].Beijing:Chemical Industry Press,2006.
[6]吉列奥.MEMS/MOEMS封装技术——概念、设计、材料及工艺[M].北京:化学工业出版社,2008.Gilleo,K.MEMS/MOEMS packaging:concepts,designs,materials,and processes[M].Beijing:Chemical Industry Press,2008.
[7]哈珀.电子封装与互联手册[M].贾松良,蔡坚,沈卓身,等译.北京:电子工业出版社,2009.CharlesA H.Electronic packaging and interconnection handbook[M].Jia Songliang,Cai Jian,Shen Zhuoshen Transl.Beijing:Publishing House of Electronics Industry,2009.
[8]娄文忠,孙运强.微机电系统集成与封装技术基础[M].北京:机械工业出版社,2007.LOU Wenzhong,SUN Yunqiang.Micro-electro-mechanical system integration and packaging technology[M].Beijing:China Machine Press,2007.
